Микроэлектроника, 2023, T. 52, № 2, стр. 127-151
Оксидные мемристоры для ReRAM: подходы, характеристики, структуры
А. Г. Исаев 1, 2, *, О. О. Пермякова 1, 2, А. Е. Рогожин 1
1 Физико-технологический институт имени К.А. Валиева Российской академии наук
117218 Москва,
Нахимовский проспект, 34, корп. 1, Россия
2 Московский физико-технический институт (государственный университет)
141701 Долгопрудный,
Институтский переулок, 9, Россия
* E-mail: isaev.ag@phystech.edu
Поступила в редакцию 20.10.2022
После доработки 21.11.2022
Принята к публикации 22.11.2022
- EDN: PYPMJK
- DOI: 10.31857/S0544126923700242
Аннотация
Эта обзорная статья посвящена оксидным мемристорам для резистивной памяти с произвольным доступом (ReRAM). Рассмотрены возможные практические реализации ReRAM и проблема утечек через соседние элементы в ReRAM. Кратко описаны основные типы резистивного переключения в мемристорах, а также разобраны основные механизмы резистивного переключения. Также описаны основные характеристики мемристоров, необходимые для ReRAM. Разобраны некоторые мемристорные структуры на основе оксидов титана, кремния, тантала, гафния, а также многослойные оксидные структуры. Выделены текущие проблемы при создании ReRAM.
1. ВВЕДЕНИЕ
В последнее время разработчики интегральных схем памяти столкнулись с проблемой невозможности дальнейшего уменьшения размеров элементов схемы. Поэтому необходимы новые виды памяти, в которых возможно достичь большей плотности элементов. Новый вид памяти не должен уступать в характеристиках скорости чтения и записи, энергопотребления и времени хранения информации. Перспективным кандидатом для замены традиционных видов памяти является резистивная память с произвольным доступом (ReRAM) [1]. Такая память может быть реализована на основе массива мемристоров. Мемристор – пассивный электрический двухполюсной элемент, значение сопротивления которого изменяется при протекании через него электрического заряда [2]. Подобное изменение значения сопротивления называют резистивным переключением (РП) [3]. Обычно мемристор имеет структуру металл-диэлектрик-металл (МДМ-структура) [4, 5] или металл-полупроводник-металл [6, 7]. Толщина активного слоя (диэлектрика или полупроводника) обычно составляет порядка единиц [4, 8] или десятков [5, 9] нанометров. Верхний и нижний электроды могут быть изготовлены из одного материала [9, 10], так и из разных материалов [8, 11].
За последнее десятилетие было создано несколько прототипов ReRAM. В 2013 г. компаниями SanDisk и Toshiba был представлен модуль ReRAM памяти объемом 32 ГБ [12], а в 2014 компания Sony представила модуль ReRAM памяти объемом 16 ГБ [13]. Однако на сегодняшний день существует ряд проблем, препятствующих массовому производству и созданию ReRAM с большим объемом памяти.
В данной работе описано текущее состояние дел в области разработки мемристоров для ReRAM. Описаны возможные реализации ReRAM, проблема утечек через соседние элементы в ReRAM. Затем кратко разобраны основные виды мемристоров, а также основные механизмы РП. Далее рассмотрены основные характеристики мемристоров, необходимые в ReRAM. Наконец разобраны некоторые перспективные мемристорные структуры и выделены текущие проблемы при создании ReRAM.
2. ReRAM
Резистивная память с произвольным доступом (ReRAM) – перспективный вид энергонезависимой памяти с произвольным доступом [1, 14]. ReRAM может быть реализована в виде массива мемристоров, где каждый мемристор является ячейкой памяти. Высокоомное состояние (ВОС) мемристора соответствует логическому нулю, а низкоомное состояние (НОС) – логической единице. Мемристоры способны сохранять свое состояние в отсутствии электрического питания, поэтому этот вид памяти является энергонезависимым. ReRAM потенциально обладает большей плотностью структур, чем современные флэш-накопители, так как размер мемристора может быть меньше десяти нм [4, 15]. ReRAM позволяет превзойти скорость работы современной оперативной памяти, так как скорость переключения мемристора порядка сотен пикосекунд [16, 17]. Сравнение основных характеристик традиционных видов памяти с потенциальными характеристиками ReRAM приведено в табл. 1 [18].
Таблица 1.
Сравнение характеристик разных видов памяти
| Вид памяти | SRAM | DRAM | NAND Flash (3D) | ReRAM |
|---|---|---|---|---|
| Размер ячейки (F – разрешение литографии) | >100F2 | 6F2 | 4F2 | 4F2 |
| Время чтения/записи | 1 нс/1 нс | 10 нс/10 нс | 10 мкс/0.1–1 мс | <10 нс/<10 нс |
| Время хранения информации | – | 64 мс | >10 лет | >10 лет |
| Число циклов перезаписи | ${{10}^{{16}}}$ | ${{10}^{{16}}}$ | ${{10}^{4}}$ | ${{10}^{6}}$–${{10}^{{12}}}$ |
| Энергопотребление при записи | ~1 фДж | ~10 фДж | ~10 фДж | ~0.1 пДж |
| Энергонезависимость | Нет | Нет | Да | Да |
2.1. Виды ReRAM
Два основных способа практической реализации 3D-массива ReRAM: 3D-структура типа кроссбар H-ReRAM [14] и вертикальная структура V-ReRAM (рис. 1) [19]. H-ReRAM (рис. 1a) представляет собой многослойный кроссбар массив [20]. V-ReRAM (рис. 1б) – массив вертикальных электродов, окруженных активным слоем, пересекающих плоские горизонтальные электроды. Ячейки памяти располагаются на каждом пересечении вертикальных и горизонтальных электродов.
Обе структуры имеют свои преимущества и недостатки. H-ReRAM потенциально может обеспечить более высокую плотность структур, однако для формирования каждого слоя требуется литография, что негативно сказывается как на времени производства, так и на его себестоимости и сложности [19]. V-ReRAM позволяет формировать нужное число слоев в одном процессе, но в данных структурах требуются технологии глубокого анизотропного травления стека материалов и конформного осаждения активного слоя в вертикальные отверстия с высоким аспектным соотношением. Требуемую конформность может обеспечить атомно-слоевое осаждение (АСО), однако использование этого метода ограничивает выбор материалов активного слоя. Также в V‑R-eRAM структурах сложнее реализовать интеграцию селекторов для предотвращения утечек через соседние элементы. Проблема ошибочного считывания состояния ячейки мемристора при утечке электрического тока через соседние элементы массива является общим недостатком H- и V-ReRAM архитектур [3].
2.2 Проблема утечек тока через соседние элементы (sneak path)
Внедрению ReRAM в производство препятствует проблема ошибочного считывания при утечке электрического тока через соседние элементы массива (sneak path) [21]. При измерении ВОС выбранного элемента может регистрироваться ток, протекающий не только через выбранный элемент, но и токи, протекающие через соседние элементы, имеющие НОС (рис. 2). При считывании состояния ячейки со значением “0”, окруженной ячейками со значением “1”, может происходить ложное считывание “1” в выбранной ячейке.
Решить эту проблему можно добавлением в структуру прибора селекторного элемента к каждому мемристору, например, последовательного диода (1D1R/1D1M-структура) [21]. Диоды хорошо подходят для массивов униполярных или неполярных мемристоров, однако однонаправленные селекторы невозможно использовать с мемристорами с биполярным РП. В работе [22] для решения данной проблемы использовался диод Зенера. Такой диод может иметь низкое напряжение обратимого пробоя, и принцип его действия будет схож с двунаправленным селектором.
Другим возможным решением является добавление транзистора к каждой ячейке (1Т1R/1Т1M-структура) [21]. Тем не менее использование транзисторов приводит к значительному снижению плотности элементов и необходимости формирования дополнительных контактов к затвору транзистора. Применение транзистора в качестве селектора делает невозможным создание многоуровневых кроссбар массивов.
Еще одним перспективным решением может стать применение двунаправленных селекторов, обеспечивающих нелинейные вольтамперные характеристики РП (рис. 3) [1]. Двунаправленный селектор представляет собой структуру с пороговым РП (например, Pt/VO2/Pt [23]). Для чтения состояния применяют схему половинного смещения [24]. Напряжение чтения Vread подбирается таким образом, чтобы напряжение включения селектора оказалось между Vread/2 и Vread. При чтении на заданную линию слов подается Vread/2, а на линию битов – –Vread/2. Поэтому общая разность напряжений на заданной ячейке – Vread, селектор на ячейке переходит в НОС и происходит чтение состояния. При этом разность напряжений на соседних ячейках не превышает Vread/2 и селекторы на этих ячейках выключены, а ток через них незначителен и не влияет на измерение. При правильно выбранном Vread проблема утечки тока через соседние элементы отсутствует, так как все ячейки массива, кроме выбранной, находятся в ВОС.
Рис. 3.
Вольтамперные характеристики (а) селектора и биполярного мемристора в ReRAM, (б) объединенной структуры [23].
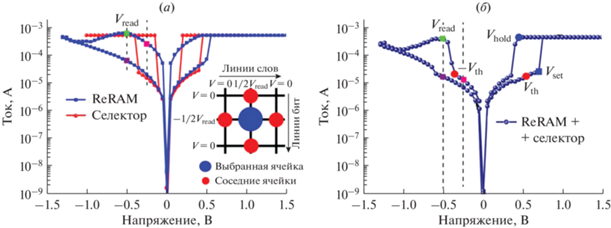
Существуют мемристоры с нелинейной характеристикой (например, p-Si/SiO2/n-Si [24]). Такие приборы ведут себя подобно 1D1R-структурам и могут быть использованы без селекторов.
Для приборов с комплементарным РП проблема утечек тока через соседние элементы может быть решена с помощью схемы половинного смещения для считывания состояния [1]. Комплементарное РП может быть реализовано, например, в двойной МДМДМ-структуре [26] и одиночных МДМ-структурах [27, 28]. Основным недостатком мемристоров с комплементарным РП является необходимость перезаписывать значение состояния сопротивления ячейки после каждого считывания состояния ячейки.
2.3. Особенности формирования структур для ReRAM
При формировании структур шероховатость подложки должна быть минимальной [29]. Кремниевая подложка покрытая слоем оксида кремния толщиной несколько сотен нанометров представляется оптимальным вариантом, так как ее среднеквадратичная шероховатость может быть менее 0.2 нм [30]. Чтобы выдерживать высокую плотность тока толщина НЭ должна быть достаточно велика (обычно более 50 нм). Предпочтительный метод осаждения электродов – электронно-лучевое испарение, так как он обеспечивает наименьшую шероховатость пленки. Распыление также позволяет достичь приемлемых значений шероховатости. Форма электродов задается при помощи литографии. После литографии необходимо тщательно удалять остатки резиста, так как они могут оказывать нежелательное влияние на параметры РП [31].
При формировании активного слоя мемристора даже сравнительно низкая шероховатость границы с электродом может привести к высокому разбросу значений характеристик РП устройства [29, 32]. Наиболее распространенные методы формирования активного слоя – атомно-слоевое осаждение и различные виды распыления. Несмотря на то, что атомно-слоевое осаждение обеспечивает меньшую шероховатость на границах с электродами, сформированные при помощи распыления устройства нередко демонстрируют лучшие характеристики РП [33, 34]. Распыление обеспечивает большую концентрацию дефектов в структуре пленки из-за чего устройство может работать при меньших значениях напряжений, что позволяет избежать необратимого пробоя устройства. Метод центрифугирования, как правило, не обеспечивает необходимой гладкости пленки, но может применяться при формировании активного слоя из полимеров или двумерных материалов [35, 36]. Для осаждения сложных оксидов (STO, PCMO) может использоваться импульсное лазерное осаждение [37]. Для формирования слоя простого оксида также могут использоваться термическое или плазменное окисление [6].
3. КЛАССИФИКАЦИЯ МЕМРИСТОРОВ
3.1. По числу состояний
Существуют мемристоры с двумя состояниями сопротивления [26], несколькими состояниями сопротивления [38] и с непрерывно изменяющимся сопротивлением (аналоговыми характеристиками) [11]. У мемристоров с двумя состояниями сопротивления, РП из ВОС в НОС называют включением, а обратное РП – выключением. Для того чтобы при включении высокое значение плотности тока в НОС не привело к повреждению или разрушению структуры обычно применяется ограничение тока. Мемристоры с двумя состояниями могут применяться в ReRAM. Количество состояний, большее двух, может быть получено в структурах, где возможно несколько механизмов РП, причем: 1) существует большая разница в значениях сопротивления НОС для каждого механизма РП; и 2) механизм РП с большим значением сопротивления НОС включается при меньшем значении напряжении включения [1]. Мемристоры с несколькими состояниями могут применяться в многоуровневой памяти. Мемристоры с аналоговыми характеристиками могут переключаться в пределах непрерывного диапазона состояний сопротивления. Нужное значение сопротивления достигается подбором правильного значения ограничения по току при включении или выбором значения напряжения остановки при выключении. Такие мемристоры подходят для использования и в ReRAM и в нейроморфных системах [14].
3.2. По механизму резистивного переключения
Механизмы РП можно разделить на две группы: филаментарные и нефиламентарные [29]. При филаментарном РП изменение состояния происходит за счет восстановления и разрыва проводящих нанонитей (филаментов) сечением менее 100 ${\text{н}}{{{\text{м}}}^{2}}$ (рис. 4) [3]. Обычно для образования филамента необходим процесс электроформовки, но существует приборы не требующие процесса электроформовки [39, 40]. При выключении происходит разрыв филамента в области с наименьшим сечением или вблизи одного из электродов. Тем не менее большая часть филамента сохраняется, поэтому значения напряжений включения при последующих РП ниже напряжения электроформовки. Если площадь мемристора не слишком велика, РП обычно происходит за счет одного филамента [3], поэтому сопротивление НОС практически не меняется при изменении площади устройства. Для филаментарных механизмов РП характерны возможность высокой плотности интеграции приборов (до 1011 бит/см2), высокое отношение сопротивлений в различных состояниях (до 109) и высокая скорость переключения (время переключения может быть около 100 пс) [29].
Нефиламентарное РП наблюдается в основном в структурах, где активным слоем является полупроводник [3]. Так как переключение, как правило, происходит на поверхности границы электрода и полупроводника, такой тип РП называют поверхностным [41]. В структурах с поверхностным РП, электроды подбираются так, чтобы на одном из них формировался омический контакт с полупроводником, а на втором – контакт Шоттки. Переключение происходит за счет снижения или увеличения барьера Шоттки вследствие миграции зарядов или вакансий в активном слое под действием внешнего напряжения. Так как переключение происходит равномерно по поверхности границы электрода и полупроводника, то проводимость в таких структурах линейно зависит от площади. Для поверхностного РП характерно низкое энергопотребление, но скорость переключения и отношение сопротивлений ниже, чем при филаментарном РП [29]. На сегодняшний день нефиламентарное РП плохо изучено, поскольку оно наблюдается лишь в небольшом количестве материалов (в основном в оксидах со структурой перовскита [3]).
3.3. По типу переключения
РП бывает биполярным, униполярным, неполярным, пороговым (неустойчивым) и комплементарным (рис. 5) [3, 29]. При биполярном РП, включение и выключение происходят при противоположных по знаку напряжениях (рис. 5а, б) [3]. В выключенном мемристоре при нарастании напряжения происходит слабый рост тока. При достижении напряжения включения происходит резкое падение сопротивления и увеличение тока до ограничения, устройство переходит в НОС, в котором остается и после отключения напряжения. Затем, при подаче напряжения обратной полярности, происходит линейное нарастание тока вплоть до напряжения выключения, после чего устройство возвращается в ВОС.
Рис. 5.
Вольтамперные характеристики (а, б) биполярного, (в) униполярного, (г) неполярного, (д) порогового и (е) комплементарного РП.

При униполярном РП (рис. 5в) включение и выключение происходят при напряжениях одной полярности. Включение происходит аналогично биполярному режиму. Во время выключения снимается ограничение по току и при достижении напряжения выключения высокая плотность тока, проходящая через филамент, приводит к Джоулеву нагреву филамента, а затем к разрыву филамента и переходу в ВОС.
При неполярном РП включение и выключение могут вызываться напряжением любого знака (рис. 5г) [29]. Униполярное и неполярное РП во многом схожи, поэтому во многих работах эти два типа не разделяются.
При пороговом РП (рис. 5д) НОС неустойчиво и при отключении напряжения устройство выключается. Устройства с этим типом РП не могут считаться мемристорами в широком смысле, так как в них не может сохраняться состояние, однако такие устройства могут применяться в структурах памяти в качестве двунаправленного селектора [23].
Комплементарное РП обычно наблюдается в двойных МДМДМ-структурах (рис. 5е), но возможно и в обычных МДМ-структурах [1]. Переключение происходит по следующей схеме. МДМДМ-структуру можно условно разделить на две МДМ-ячейки (А – верхняя ячейка, Б – нижняя). Изначально обе ячейки находятся в ВОС. Производится формовка, в зависимости от полярности переключающая структуру в состояние “0” (А – ВОС, Б – НОС) или “1” (А – НОС, Б – ВОС). При чтении состояния подается напряжение, переключающее ячейку А в ВОС. При значении “0” суммарное сопротивление МДМДМ-структуры не изменится, при значении “1” вся структура переключится в НОС. Комплементарное РП также возможно реализовать и в одиночных МДМ-структурах с помощью асимметрии формы филамента [27, 28] (рис. 6). Главной проблемой комплементарного РП является необходимость перезаписи состояния сопротивления ячейки после каждой операции чтения.
4. МЕХАНИЗМЫ РЕЗИСТИВНОГО ПЕРЕКЛЮЧЕНИЯ
Наиболее часто встречающихся механизмы РП: миграция положительных ионов металла электрода (филаментарный), миграция отрицательных ионов или вакансий в активном слое прибора (бывает как филаментарным так и нефиламетарным), термохимические реакции (филаментарный) и РП основанное на зарядовых ловушках (нефиламентарный). Существует также другие механизмы РП, например, изменение кристаллической структуры в слое углерода, но этот механизм встречается только в отдельных структурах на основе углерода [42]. Важно также отметить, что, несмотря на большое количество работ, посвященных механизмам РП [1, 5, 43], многие моменты остаются неясными. В одной и той же структуре могут наблюдаться несколько различных механизмов РП, или же переключение может происходить по некоторому промежуточному пути [1, 3].
4.1. Миграция положительных ионов (катионов)
Механизм РП на основе катионной миграции обычно встречается в структурах с активным (Cu [44], Ag [45] или Ru [8]) и инертным электродами (Pt [44], W [8]). Механизм катионной миграции называют электрохимической металлизацией (electrochemical metallization, ECM) [1]. При включении, вследствие электрохимического разложения активного электрода, в нем возникают катионы металла. Под действием электрического поля катионы движутся к противоположному электроду по диффузным каналам (например, по границам зерен [46]). Затем ионы металла нейтрализуются встречными электронами и оседают в активном слое. Осевшие вблизи электродов атомы металла выступают в роли электрода, проникающего в активный слой. Проникновение электрода в активный слой приводит к локальному увеличению электрического поля в этом месте и дальнейшему росту металлического филамента. Во время выключения, обратная полярность напряжения и нагрев филамента под действием электрического тока приводят к дрейфу атомов филамента в направлении активного электрода и разрыву филамента. Схема механизма ECM приведена на рис. 7 [47]. Рост филамента может происходить как от активного электрода к инертному (Cu/ZnO/Pt) [48] так и в обратном направлении (Cu/Ta2O5/Pt) [49], а в редких случаях – равномерно по всей толщине активного слоя [1]. Направление роста филамента определяется как подвижностью ионов металла внутри активного слоя, так и энергией нуклеации филамента [1].
4.2 Миграция отрицательных ионов (анионов)
Механизм РП на основе миграции анионов встречается в большинстве оксидов и нитридов [1]. Обычно миграция анионов описывается миграцией их положительно заряженных аналогов – кислородных или азотных вакансий. Во время РП миграция положительно заряженных вакансий под действием внешнего электрического поля может приводить к изменению валентности катионов в активном слое. Поэтому этот механизм называют механизмом изменения валентности (valence change mechanism, VCM). Миграция анионов/вакансий может происходить по-разному в полупроводящих и диэлектрических оксидах.
Нестехиометрические бинарные оксиды переходных металлов могут быть описаны, как полупроводники p-типа и n-типа [50]. Для оксидов p-типа характерно наличие ведренных атомов кислорода или катионных вакансий, которые нарушают стехиометрию оксида. Реакция образования в обозначениях Крегера–Винка для оксидов p-типа выглядит следующим образом [3]:
Для оксидов n-типа характерно наличие ведренных атомов металла или кислородных вакансий. Реакция образования в обозначениях Крегера–Винка для оксидов n-типа [3]:
Среди полупроводниковых оксидов, в которых РП происходит за счет миграции анионов, – оксиды никеля (p), кобальта (p), титана (n) и цинка (n). В полупроводниках р-типа изначально присутствуют подвижные ионы кислорода, например, вблизи кристаллических дефектов (рис. 8а). Когда на верхний электрод (ВЭ) подается положительное напряжение, эти подвижные ионы кислорода мигрируют к ВЭ и накапливаются в его окрестности, создавая на границе ВЭ высокую концентрацию катионных вакансий (рис. 8б). Эти скопления вакансий являются зародышами будущего филамента и действуют как часть ВЭ, увеличивая локальное электрическое поле, и стимулируют дальнейший рост филамента. Как только филамент полностью сформируется происходит РП в НОС (рис. 8в).
При режиме роста филамента от ВЭ к нижнему электроду (НЭ) самая тонкая часть филамента располагается вблизи НЭ. Когда к прибору со стороны ВЭ прикладывается отрицательное напряжение, наибольший нагрев будет происходить в этой области, приводя к увеличению подвижности ионов кислорода и их интенсивной миграции к НЭ под действием электрического поля. Следовательно, концентрация катионных вакансий в тонкой части филамента будет снижаться, что, в конечном итоге, приведет к его разрыву и переходу мемристора в ВОС (рис. 8г).
В n-полупроводнике изначально присутствуют кислородные вакансии, как схематически показано на рис. 8д. Когда на ВЭ подается положительное напряжение, вакансии мигрируют к НЭ и накапливаются в его окрестности, формируя зародыш будущего филамента (рис. 8е). Дальнейший рост филамента по направлению к ВЭ приводит к переключению структуры в НОС (рис. 8ж). Разрыв филамента происходит при подаче отрицательного напряжения на ВЭ аналогично вышеописанному механизму для р-полупроводников (рис. 8з).
К диэлектрическим оксидам, в которых РП происходит за счет миграции анионов, относятся оксиды гафния [27], тантала [26], циркония [51] и др. Для стабильного РП необходима повышенная концентрация вакансий в активном слое, которая обычно достигается добавлением специального обедненного кислородом слоя (рис. 9а) или использованием электрода с высоким сродством к кислороду (например, из тантала или титана) [1]. Дальнейшее формирование филамента происходит аналогично вышеописанному механизму для полупроводников n-типа (рис. 9б, в). В структурах на основе диэлектрических оксидов возможно как биполярное, так и униполярное РП. В униполярном режиме процесс выключения происходит за счет нагрева и разрыва филамента в области наименьшего сечения под действием больших токов, а в биполярном – аналогично механизмам в n-полупроводниках (рис. 9г).
4.3. Термохимические реакции
Термохимический механизм РП (thermochemical mechanism, TCM), как правило, наблюдается в мемристорах на основе полупроводниковых оксидов (оксиды никеля, титана) [1]. В структурах с термохимическим механизмом РП формовка и включение соответствуют химическому разложению материала активного слоя при нагреве и последующему образованию металлических филаментов. Выключение происходит за счет термостимулированной диффузии атомов металла филамента при снятии ограничения по току. Поскольку Джоулев нагрев не зависит от полярности напряжения, в термохимических ячейках наблюдается неполярное РП. Для полупроводниковых оксидов р-типа (NiO) локализованная инжекция дырок на границе с ВЭ в процессе формовки возможна в областях с более низким барьером Шоттки (например, в областях большой шероховатости границы между электродом и активным слоем, проникновения электрода в активный слой) [52]. Нагрев, сопутствующий инжекции дырок, вызывает термохимические реакции, приводящие к генерации ионов металла. Когда генерируется достаточное количество ионов металла, образуется металлический филамент, растущий от ВЭ к НЭ. При таком росте самая тонкая часть филамента находится вблизи НЭ. В полупроводниковом оксиде n-типа (TiO2) происходит локальная инжекция электронов на границе с НЭ в областях с более низким барьером Шоттки. Последующий нагрев может способствовать локальной генерации вакансий на границе оксида с ВЭ и их дрейфу к НЭ. Генерируемые вакансии дрейфуют к месту, где происходит инжекция электронов электростатической силой, а затем накапливаются там, что приводит к зарождению филамента. В случае полупроводников n-типа филамент будет расти от НЭ к ВЭ. Возникающие филаменты в обоих случаях обладают металлической проводимостью и состоят из проводящих оксидов [5] или из атомов металла [53]. Термохимическое РП также возможно в структурах на основе органических полимеров [1]. Переключение происходит за счет образования углеродных филаментов, возникающих вследствие термического разложения полимера.
4.4 Нефиламентарные механизмы переключения
Нефиламентарное РП обычно встречается в сложных полупроводящих оксидах со структурой перовскита, таких как Pr0.7Ca0.3MnO3 (PCMO) или SrTiO3 (STO) [3]. При этом материалы электродов должны быть подобраны таким образом, что один из них образует омический контакт с активным слоем, а второй – контакт Шоттки. Два основных механизма нефиламентарного РП – это нефиламентарная анионная миграция и переключение за счет зарядовых ловушек.
При нефиламентарной анионной миграции РП происходит за счет изменения концентрации кислородных вакансий вблизи контакта Шоттки [41]. При подаче отрицательного напряжения на ВЭ контакта Шоттки, к ВЭ будут притягиваться вакансии, что приведет к увеличению их концентрации на верхней границе активного слоя, но снижению концентрации по всей толщине активного слоя. При подаче положительного напряжения произойдет миграция вакансий от верхней границы, снижению их концентрации вблизи контакта Шоттки и более равномерное распределение по всей толщине активного слоя. Для p-полупроводников (PCMO) вакансии являются основными носителями, поэтому более равномерное распределение вакансий соответствует НОС, а миграция большей части вакансий к ВЭ (и появление обеднённого слоя или даже pn-перехода ближе к НЭ) приводит к ВОС [54]. В n-полупроводниках (STO) вакансии не являются основными носителями, поэтому более равномерное распределение вакансий приводило к ВОС, а неравномерное к НОС. При этом нужно учитывать, что для p-полупроводников (PCMO) вакансии являются акцепторами, увеличивающими ширину барьера, поэтому увеличение концентрации вакансий приводит к ВОС, а уменьшение – к НОС. Для n-полупроводников (STO) наоборот вакансии являются донорами, уменьшающими ширину барьера, поэтому их повышенная концентрация вызывает НОС, а пониженная – ВОС.
Нефиламентарное РП может происходить за счет захвата или освобождения заряда ловушками. Так, в структурах на основе STO легированного ниобием РП может происходить за счет захвата и высвобождения электрона в ловушках, представляющих собой дефекты на границе активного слоя и ВЭ, возникшие при осаждении ВЭ с помощью ионного распыления (рис. 10) [55]. Когда на ВЭ подаeтся положительное напряжение, электроны покидают ловушки. В результате ловушки приобретают положительный заряд, обеспечивая дополнительный потенциал, снижая высоту барьера и сопротивление. При отрицательном напряжении электроны снова попадают в ловушки и барьер возвращается в исходное состояние, переключая устройство в ВОС. Переключение также может происходить за счет слоя ловушек, сформированного в середине активного слоя, или за счет ловушек, равномерно распределенных в активном слое [1].
4.5. Методы исследования механизмов переключения
Исследование механизмов РП представляется наиболее сложной задачей при изучении РП. Некоторые предположения можно сделать на основе данных о свойствах материалов электродов и активного слоя, а также полярности и других параметров РП. Например, если в структуре присутствует электрод из меди или серебра, можно предположить ECM механизм, если РП неполярное – вероятен термохимический механизм. Анализ характера проводимости в ВОС и НОС позволяет сделать предположения о филаментарном или нефиламентарном механизме, форме и структуре филаментов [10, 56, 57]. Различные техники спектроскопии (энергодисперсионная рентгеновская спектроскопия (EDX) [9], спектроскопия характеристических потерь энергии электронами (EELS) [11], рентгеновская фотоэлектронная спектроскопия (XPS ) [58] и др.) позволяют определить состав активного слоя, его структуру, распределение элементов по глубине и их изменение после нескольких циклов РП, однако эти данные не позволяют определить форму, размер и другие параметры филаментов.
Широко распространено использование просвечивающего электронного микроскопа (ПЭМ) для наблюдения формы, размера, состава филамента [11], в том числе in situ [5]. Но исследования при помощи ПЭМ требуют сложной и разрушительной подготовки образца или же изготовления специальных образцов, структура которых может сильно отличаться от стандартной [29].
Сканирующая туннельная микроскопия (СТМ) позволяет получать распределение проводимости по поверхности активного слоя с атомной точностью, но не позволяет разделять топографию и проводимость, а также требует изначальной проводимости при подведении зонда к образцу [29]. Альтернативой СТМ служит атомно-силовая микроскопия с проводящим зондом (П-АСМ) [59, 60]. П-АСМ позволяет получать топографию поверхности и латеральное распределение проводимости активного слоя. При использовании зондов повышенной прочности возможно также получение распределения проводимости по глубине путем постепенного соскабливания материала активного слоя зондом [61]. Этот метод позволяет получать трeхмерное изображение филаментов, однако приводит к разрушению образца и быстрому износу зонда. Для исследования активного слоя методом П-АСМ необходимо отсутствие ВЭ. Поэтому после приведения мемристора в нужное состояние ВЭ может удаляться жидкостным травлением, механическим отслоением, соскабливанием зондом АСМ, может использоваться жидкий ртутный ВЭ или же переключение и формовка может производиться непосредственно зондом АСМ [62]. В последнем случае ВЭ в структуре изначально не формируется. П-АСМ может применяться для изучения проводимости филаментов, их размера, количества, расположения.
5. ХАРАКТЕРИСТИКИ МЕМРИСТОРОВ И МЕТОДЫ ИХ ИЗМЕРЕНИЯ
Для определения потенциала применения мемристорных структур в ReRAM необходимо знать характеристики РП в этих структурах. Значение рабочих напряжений и токов (включения и выключения), отношения сопротивлений в различных состояниях можно определить из вольт-амперных характеристик мемристора. Желаемые значения рабочих напряжений при использовании мемристоров в ReRAM – не более 1 В, желаемое отношение сопротивлений не менее 10 для двухуровневого РП [63]. Существует ряд других характеристик (число циклов переключения, время сохранения состояния, время переключения, энергопотребление и др.), не менее важных для использования мемристора в ReRAM.
5.1. Экспериментальные мемристорные структуры для получения хапактеристик РП
При исследовании характеристик РП в лабораторных условиях обычно используются три типа структур: структуры с общим НЭ [5, 10], одиночные перекрестные структуры (кросспоинт) [8, 25] и перекрестные массивы (кроссбар) [15, 26].
В структурах с общим НЭ в качестве НЭ, для всех формируемых структур, может использоваться проводящая подложках или изолирующая подложка, покрытая сплошным слоем проводника [29]. Поверх НЭ осаждается сплошной активный слой, после чего формируются ВЭ (с помощью теневой маски или литографии), размер и форма которых определяют размер и форму устройства. При использовании изолирующей подложки необходимо также сформировать контакт к НЭ или оставить открытой часть НЭ. Главным преимуществом структур с общим НЭ является простота изготовления, поэтому такие структуры удобно использовать при изучении мемристоров в лаборатории. Но этот метод позволяет изготавливать приборы только с большой площадью (>100 ${\text{мк}}{{{\text{м}}}^{2}}$). Другим недостатком таких структур является необходимость высокой точности при подведении зонда к ВЭ [64].
В одиночных перекрестных структуры (кросспоинтах) мемристор находится на пересечении двух тонких металлических дорожек, на концах которых располагаются большие контактные площадки. ВЭ и НЭ формируются при помощи фотолитографии (площади активной области, 2500 мкм2 – 16 мкм2) [24, 59], ультрафиолетовой литографии (25 мкм2 – 0.0625 мкм2) [65, 66], наноимпринт (0.01 мкм2 – 64 нм2) ([67], p. 8, [68]) или электронно-лучевой литографии (0.01 мкм2 – 100 нм2) [69]. Первым с помощью литографии формируется НЭ. Далее осаждается материал активного слоя. Затем, в ходе второго процесса литографии, с поверхности НЭ удаляется часть активного слоя и формируется ВЭ. При наличии в структуре активного электрода его формируют в качестве ВЭ и покрывают слоем инертного материала, например платиной. Благодаря тому, что активная площадь мемристора во много раз меньше площади контактных площадок, кросспоинт-структуры позволяют исследовать мемристоры размером несколько нанометров. К недостаткам таких структур следует отнести необходимость нескольких стадий литографии и высокой точности ограничения тока для того, чтобы избежать разрушения наноразмерных дорожек [70].
Наиболее приближенной структурой к реальной архитектуре ReRAM на сегодняшний день является перекрестный кроссбар-массив. Он представляет собой сетку из перпендикулярных пересекающихся металлических дорожек, на каждом пересечении которых сформирован мемристор. Как и у кросспоинт-структур, каждая дорожка заканчивается большой контактной площадкой. Методы формирования кроссбар-массивов аналогичны кросспоинт-структурам. При формировании многослойных кроссбар-массивов необходима химико-механическая планаризация, которая позволяет получить вертикальную монолитную интеграцию, а также избежать перегибы по краям [66]. Кроссбар-массив позволяет исследовать взаимодействие мемристоров, утечки тока через соседние элементы массива и возможные характеристики ReRAM [20], а также возможные характеристики аппаратных устройств для нейроморфных вычислений на основе мемристоров [71]. Основным недостатком кроссбар-массивов является сложность формирования структур.
5.2. Число циклов переключения
Под числом циклов переключения подразумевается количество переключений между состояниями сопротивления, при котором сохраняется достаточное отношение сопротивлений [3]. Для работы ReRAM требуется, чтобы составляющие ее мемристоры могли стабильно работать на протяжении более 109 циклов переключения [63]. Для определения числа циклов переключения могут использоваться несколько методов импульсных измерений [29]. В первом методе поочередно подаются импульсы для считывания и записи состояния, высота импульсов выбирается исходя из напряжений чтения, включения и выключения. В другом методе измерение тока, для определения состояния сопротивления прибора, производится лишь на некоторых циклах переключения, например, каждые 50 циклов. Это самый быстрый метод, однако он не позволяет убедиться, что РП успешно произошло на всех циклах. Так как измерение 109 циклов требует большого количества времени (более недели) предлагается измерять первый 106 циклов РП с помощью первого метода, а последующие циклы РП с помощью второго метода.
5.3. Время сохранения состояния
Под временем сохранения состояния понимают время, которое мемристор может сохранять состояние при определенной температуре [3]. Этот параметр определяет время хранения информации на носителе. Желаемое значение этого параметра – более 10 лет при температуре 85°С [63]. Как правило, основной проблемой является сохранение НОС, так как ВОС является базовым для большинства мемристоров до формовки, а сформированные филаменты могут со временем разрушиться [29]. При измерении времени сохранения состояния на устройство подается напряжение чтения (обычно порядка 0.1 В) до тех пор, пока не произойдет значительное изменение сопротивления. Поскольку проводить измерения в течение 10 лет не представляется возможным, обычно производятся измерения при повышенных температурах, а затем прогнозируется время сохранения состояния при требуемой температуре при помощи экстраполяции (рис. 11) [72].
5.4. Время переключения
Временем переключения мемристора называют длительность импульса напряжения, достаточную для переключения устройства [3]. Время включения и выключения могут быть как близки по значению [16], так и отличаться на несколько порядков [73]. Время РП определяет скорость записи информации в ReRAM. Желаемое время переключения составляет менее 10 нс [63]. Время переключения может определяться последовательным уменьшением длины импульса, до тех пор, пока длина импульса не окажется недостаточной для переключения [29]. Успешность переключения проверяется при напряжениях чтения после каждого импульса. При субнаносекундном переключении большую роль могут играть задержки, вызванные особенностями измерительного контура [16]. Для снижения этих задержек применяются специальные линии передачи напряжения и волноводы.
5.5. Энергопотребление за цикл
Большое энергопотребление в сверхплотных массивах памяти может приводить к значительному нагреву и разрушению структур. Энергопотребление за цикл определяет общее энергопотребление ReRAM. Желаемое энергопотребление ReRAM за цикл не должно превышать 10 пДж [63]. Для определения энергопотребления необходим осциллограф, способный измерять напряжения и токи с высоким разрешением по времени [28]. Энергия переключения определяется не только напряжением и током переключения, но и длиной импульса, поэтому энергопотребление можно снизить, уменьшая длину импульса до минимально возможной (время переключения) [4]. Ток при включении можно снизить, задав нужное ограничение по току.
5.6. Масштабируемость
РП носит стохастический характер, так как филаменты преимущественно формируются в местах дефектов, обеспечивающих более высокую локальную проводимость и диэлектрическую проницаемость [29]. Характеристики мемристора могут кардинально меняться при изменении его площади, так как количество таких дефектов зависит от площади структуры. Например, при уменьшении площади может значительно возрастать напряжение формовки [74].
В лабораторных условиях обычно исследуются структуры с латеральным размером порядка десятков микрон, так как их легко изготовить при помощи фотолитографии или теневой маски. Однако характеристики таких структур могут значительно отличаться от характеристик аналогичных структур в ReRAM, где для обеспечения достаточной плотности хранения информации площадь мемристоров не должна превышать 500 ${\text{н}}{{{\text{м}}}^{2}}$ [63]. Поэтому при исследовании мемристоров необходимо изучать наноразмерные структуры.
5.7. Воспроизводимость характеристик
Низкая воспроизводимость характеристик – одно из основных препятствий на пути массового использования ReRAM [29]. Она может проявляться от устройства к устройству и от цикла к циклу в одном устройстве. Низкая воспроизводимость от устройства к устройству чаще всего связана со стохастическим процессом образования филамента [75]. С другой стороны, низкая воспроизводимость характеристик РП одного устройства связана с нестабильностью филамента [76], а также с образованием нескольких филаментов [75].
Для повышения воспроизводимости характеристик РП от устройства к устройству можно использовать приборы, не требующие процесса электроформовки. Для повышения воспроизводимости характеристик РП от цикла к циклу можно использовать дополнительные активные слои (многослойные структуры) с различной подвижностью ионов, ответственных за РП, а также легирование активного слоя [1].
Для визуализации воспроизводимости характеристик могут применяться различные методы (рис. 12). Например, изображают вольтамперные характеристики для нескольких циклов или устройств на одном графике, выделив среднее значение (рис. 12а). Другой способ – гистограмма, демонстрирующая количество циклов или устройств с каждым значением параметра (рис. 12б). Также может быть построена функция распределения вероятностей для заданной характеристики (рис. 12в).
6. ReRAM НА ОСНОВЕ ОКСИДОВ
Наибольшее внимание привлекают к себе мемристоры на основе оксидов благодаря простой структуре, устойчивости к высоким температурам, относительной простоты формирования и лучшим характеристикам РП (для таких структур были получены рекордные значения скорости переключения, числа циклов переключения, размера ячейки и др.) [1]. В этом разделе будут рассмотрены структуры на основе оксидов титана, кремния, тантала и гафния, методы формирования этих структур, возможные механизмы РП, полученные значения характеристик РП, а также потенциал применения этих структур в ReRAM.
6.1. Приборы на основе оксида титана
Диоксид титана – полупроводник, который может существовать в трех кристаллических формах: анатаз, рутил и брукит [6]. Выделяют три механизма образования филамента в мемристорах на основе оксида титана (рис. 13) [6]. Во-первых, филамент может быть образован за счет миграции кислородных вакансий (рис. 13а). Во-вторых, филамент может образоваться не только из вакансий, но и из восстановленных ионов титана, а также атомов электрода (рис. 13б). Наконец, филамент может представлять собой проводящую фазу Магнели оксида титана (TinO2n–1), которая образуется по механизму термохимических реакций (рис. 13в).
В работе [5] филаменты состоящие из фаз Магнели в структурах Pt/TiO2/Pt изучались при помощи просвечивающей электронной микроскопии (ПЭМ) высокого разрешения. Слой диоксида титана толщиной 40 нм был сформирован плазмостимулированным атомно-слоевым осаждением. Общий НЭ толщиной 100 нм был осажден с помощью распыления, а ВЭ круглой формы диаметром 300 мкм и толщиной 50 нм были сформированы электронно-лучевым испарением. В приборах наблюдался униполярный тип РП. Исследование структур в НОС при помощи ПЭМ высокого разрешения показало наличие проводящих филаментов конической формы соединяющих два электрода (рис. 13г), а также частично сформированных филаментов. Анализ структуры филаментов показал, что они состоят из фаз Магнели Ti4O7. В структурах в ВОС после выключения наблюдались только разорванные филаменты, которые не исчезли полностью (рис. 13д).
Как правило, для мемристоров на основе оксида титана характерно большое время РП (порядка микросекунд), однако в работе [77] в структурах Pt/TiO2/TiN удалось добиться значения времени РП порядка единиц наносекунд. Электроды из платины (50 нм) и нитрида титана (200 нм) осаждались с помощью магнетронного распыления. Активный слой мемристора толщиной 80 нм формировался с помощью термического окисления НЭ в кислородной атмосфере при 550°С. Для приборов с площадью электрода 20 × 20 мкм2 требовалось напряжения электроформоки порядка 5 В. Тип РП (униполярное или биполярное) менялся в зависимости от полярности напряжения во время электроформовки. Для этого прибора были получены характеристики, свидетельствующие о многоуровневом РП. Все полученные состояния сопротивления оставались стабильными в течение 256 ч при температуре 85°C. РП наблюдалось в течение 2 × 106 циклов при 5-ти наносекундных импульсах с амплитудами напряжений –2 и 3 В для включения и выключения соответственно.
Можно заключить, что мемристоры на основе однослойного оксида титана не подходят для ReRAM, но могут найти применение в нейроморфных системах [6].
6.2 Приборы на основе оксида кремния
Для мемристоров на основе оксида кремния характерны низкая себестоимость и совместимость технологическими процессами микроэлектроники. РП в приборах на основе оксида кремния происходит за счет механизмов изменения валентности [24], или электрохимической металлизации ([44], p. 2).
В структуре Cu/SiO2/W РП происходило за счет образования и разрыва медных филаментов ([44], p. 2). Слой оксида кремния толщиной 10 нм и электроды были сформированы методом магнетронного распыления. Были сформированы кросспоинт-структуры с площадью активной области 100 ×100 мкм2. Для устройств были получены значения отношений сопротивлений >1000, низкие рабочие напряжения (>0.5 В) и низкое энергопотребление. По всей видимости, низкие рабочие напряжения и энергопотребление достигались за счет высокой подвижности ионов меди. Однако время сохранения состояния составляло лишь несколько часов, что исключает возможность использования этих структур для энергонезависимой памяти.
В структурах, в которых РП происходит за счет кремниевых филаментов (например p-Si/SiO2/n-Si), возможно получить диодные характеристики без добавления селекторных элементов [24]. Слой SiO2 толщиной 5 нм был сформирован при окислении НЭ из кремния n-типа в кислородной плазме. ВЭ формировался на другой подложке и затем переносился поверх активного слоя. При помощи фотолитографии и реактивного ионного травления формировалась кросспоинт-структура 5 × 5 мкм2. Напряжение электроформовки совпадало с напряжением включения (рис. 14а). Кремниевый филамент в сочетании с различно легированными кремниевыми электродами формирует диодную структуру, подавляющую токи в одном из направлений (рис. 14б). Эта структура обладает большим отношением сопротивлений (>${{10}^{4}}$) и большим временем сохранения состояния (при температуре 300°C после ${{10}^{5}}{\text{с}}$ значительной деградации не наблюдается). Однако высокое сопротивление кремниевых электродов приводит к большим значениям рабочих напряжений (>7 В). Большое значение времени выключения (порядка 500 мкс) также является существенным недостатком этой структуры.
Использование оксида кремния с наночастицами платины (рис. 14в) позволило получить отличные характеристики РП [78]. Слой оксида кремния с наночастицами платины формировался при помощи одновременного магнетронного распыления мишеней из платины и оксида кремния. Сформированные структуры Pt/SiO2 : Pt/Ta имели площадь от 0.01 до 31 ${\text{мк}}{{{\text{м}}}^{2}}$. Рабочие напряжения прибора были порядка 1 В. Деградации характеристик не наблюдалось после ${{10}^{7}}$ циклов переключения импульсами длительностью 100 пс и амплитудой порядка 5 В. Состояние сопротивления сохранялось в течение полугода. В наноразмерных структурах удалось добиться значения отношения сопротивлений более ${{10}^{3}}$.
6.3. Приборы на основе оксида тантала
Оксид тантала на сегодняшний день представляется одним из наиболее перспективных материалов для ReRAM. В работе [79] показано, что в мемристорах на основе оксида тантала потенциально возможно получить наибольшее число циклов переключения, по сравнению с другими материалами. В мемристорах на основе оксида тантала может наблюдаться в основном РП за счет миграции катионов или вакансий.
В структурах Pt/Ta2O5/Ru РП происходило за счет формирования и разрыва филаментов из рутения [8]. В этих структурах рутениевый НЭ был сформирован распылением при постоянном токе, активный слой был осажден радиочастотным распылением, а платиновый ВЭ – электронно-лучевым испарением. Были сформированы кросспоинт-структуры размерами 5 × 5 мкм и 70 × 100 ${\text{н}}{{{\text{м}}}^{2}}$ с толщиной активного слоя 5 нм (рис. 15а). Включение происходило при значениях напряжения ‒1.5 В с ограничением тока 1 мкА, а выключение при 4 В и 3 мкА (рис. 15б). При этом первый цикл РП практически идентичен последующим, т.е. структура не требовала электроформовки. Отношение сопротивлений – более ${{10}^{6}}.$ Также было достигнуто аналоговое РП. Структуры успешно переключались импульсами длительностью 50 нс и заметного ухудшения характеристик после ${{10}^{6}}$ циклов РП не наблюдалось. Прогнозируемое время сохранения состояния составляло более 10 лет при комнатной температуре. ПЭМ изображения структур во включенном и выключенном состояних подтверждают, что РП происходило за счет формирования и изменения рутениевых филаментов. При этом анализ характера проводимости прибора при различных температурах показывает, что во время процесса включении формировался не сплошной филамент, а филамент, состоящий из нескольких островков, между которыми может происходить туннелирование носителей заряда. При изменении ограничения по току или напряжения выключения может происходить увеличение или уменьшение этих островков, приводящее к изменению сопротивления. Формирование классического непрерывного филамента может происходить при ограничении тока свыше 1 мА. Нужно также отметить, что с течением времени металлические филаменты в оксидном активном слое могут окисляться. Но в отличие от серебра или меди, которые часто используются в качестве активных электродов, рутений и после окисления обладает высокой проводимостью. Поэтому время сохранения состояния у этих структур значительно превышает аналогичные структуры с электродами из серебра или меди.
Рис. 15.
(а) ПЭМ изображение Pt/Ta2O5/Ru структуры, (б) ВАХ структуры, (в) возникновение и (г) исчезновение рутениевых филаментов [8].
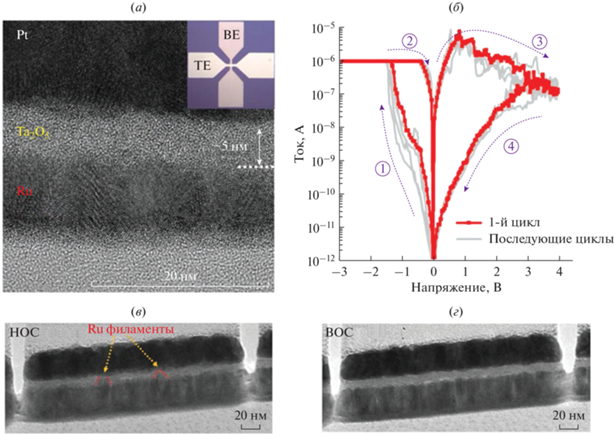
В структурах Pt/TaOx/Pt с общим НЭ наблюдалось два типа РП – требующий и не требующий электроформовки [10]. Платиновые электроды осаждались при помощи электронно-лучевого испарения. Активный слой формировался импульсным лазерным осаждением при комнатной температуре. Размер ВЭ – 90 × 90 ${\text{мк}}{{{\text{м}}}^{2}}$. При этом на одной и той же подложке в зависимости от расположения часть структур требовала электроформовки, а другая часть – нет. Такой эффект, вероятно, связан взаимным расположением подложки и мишени при осаждении оксида и связанной с этим различной структурой активного слоя. Ячейки, не требующие электроформовки, изначально находились в НОС. Первое выключение происходило при положительном значении напряжения, около 0.8 В. В дальнейшем РП происходило в униполярном режиме со значением напряжения включения от 1 до 2 В (рис. 16а). Для второго типа ячеек была необходима электроформовка при напряжении около 10 В. Дальнейшее переключение происходило также в униполярном режиме со значением напряжения выключения ~0.8 В и напряжения включения от 2 до 7 В (рис. 16б). Такие различия в значениях характеристик РП связаны с разной структурой активного слоя. В не требующих электроформовки ячейках изначально присутствовали случайно расположенные филаменты из проводящих оксидов (рис. 16в). При подаче напряжения эти филаменты начинали объединяться (рис. 16г), в итоге формируя один непрерывный филамент, соединяющий электроды (рис. 16д). В ячейках, требующих электроформовки, активный слой изначально непроводящий, и при электроформовке появлялся филамент конической формы, который соединял электроды по кратчайшему пути (рис. 16е). При дальнейшем росте филамента он утолщался и приобретал цилиндрическую форму (рис. 16ж, з).
Рис. 16.
Пример ВАХ ячеек (а) не требующих электроформовки, (б) требующих электроформовки; эволюция проводящих филаментов в ячейках (в–д) не требующих электроформовки, (е–з) требующих электроформовки [10].

В структурах Pt/Ta2O5–х/TaO2–х/Pt РП происходило за счет миграции ионов кислорода [26]. Слой TaO2 30–40 нм формировался реактивным распылением танталовой мишени в смеси аргона и кислорода. Для получения тонкого слоя Ta2O5 толщиной около 10 нм, полученный слой TaO2 обрабатывался в кислородной плазме. Латеральный размер изготовленных структур составлял от 30 нм до 50 мкм. В устройствах наблюдалось биполярное РП с напряжениями включения –1 В и выключения +2 В. Значение отношения сопротивлений составляло менее 100. В микроразмерных и наноразмерных структурах наблюдались схожие характеристики, однако в последних сопротивления в обоих состояниях были больше почти на порядок. Тем не менее рабочие напряжения для всех структур были одинаковы. Время переключения составляло 10 нс при амплитуде импульса 6 В. Количество циклов переключения такими импульсами – ${{10}^{{11}}}{\text{\;и\; }}{{10}^{{12}}}$ для структур с латеральным размером электрода 0.5 и 50 мкм, соответственно. Прогнозируемое время сохранения состояния – более 10 лет при 85°С. Также было продемонстрировано комплементарное РП в двух зеркально соединенных ячейках Pt/Ta2O5/TaO2/Pt. Таким образом, за исключением не достаточно низких рабочих напряжений, эти структуры обладают отличными характеристиками для применения в ReRAM.
Структуры на основе оксида тантала, обычно, обладают большим числом циклов РП. Возможно улучшение значения этого параметра при легировании активного слоя. Например, в кросспоинт структурах Pt/Ta/TaOх/Pt с латеральным размером активной области 2 мкм легирование цирконием привело к увеличению числа циклов переключения почти на 2 порядка [80]. Слои платины (30 и 25 нм) и тантала (15 нм) были нанесены с помощью распыления. Активный слой TaOx был осажден с помощью реактивного распыления, после чего в часть образцов был имплантирован цирконий со значением энергии 5 кэВ. Легирование позволило увеличить значение числа циклов переключения с $4.5 \times {{10}^{8}}$ до $3 \times {{10}^{{10}}}$, а также снизить значение напряжения электроформовки с 2.6 до 1.5 В.
В структурах Ta/Ta2O5/Ti площадью 2 × 2 ${\text{мк}}{{{\text{м}}}^{2}}$ было продемонстрированно субнаносекундное переключение [16]. Активный слой толщиной 7 нм был осажден распылением. Включение производилось импульсом длиной 105 пс и амплитудой ~2.5 В, выключение – при –4.5 В с длиной 120 пс. Измеренное значение времени переключения было ограничено параметрами генератора импульсов. Было подтверждено успешное РП в пяти последовательных циклах. При этом отношение сопротивлений колебалось в диапазоне от 100 до 1000.
В различных структурах на основе оксида тантала были продемонстрированы низкие рабочие напряжений (в пределах 1.5 В), отношение сопротивлений более ${{10}^{6}}$, большое количество циклов РП – более ${{10}^{{12}}}$, время сохранения состояния более 10 лет и время РП менее 1 нс, что говорит о значительном потенциале использования материала в ReRAM.
6.4. Приборы на основе оксида гафния
Оксид гафния, также является одним из наиболее перспективных материалов для активного слоя элемента ReRAM. Основным механизмом РП в приборах на основе оксида гафния является механизм миграции кислородных вакансий [27]. Встречаются также структуры, где РП происходит за счет миграции ионов активного электрода [11]. Например, в работе [11] структурах Ta/HfO2/Pt филаменты формировались из тантала. Платиновый НЭ толщиной 20 нм и танталовый ВЭ толщиной 50 нм осаждались при помощи электронно-лучевого испарения и распыления, соответственно. 5 нм оксида гафния были сформированы атомно-слоевым осаждением при температуре 250°С. Кросспоинт-структура с активной областью 10 × × 10 мкм2 формировалась с помощью фотолитографии. После электроформовки при напряжениях порядка 2 В структуры имели биполярное РП со напряжениями включения и выключения 0.65 и −1.10 В соответственно (рис. 17а). Максимальное отношение сопротивлений составляло около 10. В структурах было достигнуто многоуровневое РП. Исследование включенных структур при помощи ПЭМ показывает наличие танталовых филаментов (рис. 17б). Время переключения составляло 5 нс для импульсов амплитудой 2.2 и −4 В при включении и выключении, соответственно. Количество циклов переключения составляло более ${{10}^{{11}}}$ при переключении импульсами длиной 100 нс. Прогнозируемое время сохранения состояния составило более 104 лет при 85°С.
Рис. 17.
РП в структуре Ta/HfO2/Pt, (а) ВАХ структуры, (б) ПЭМ изображение танталового филамента [11].
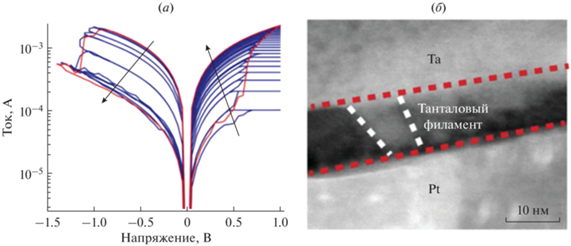
РП за счет образования филамента из кислородных вакансий является наиболее распространенным механизмом РП в мемристорах на основе оксида гафния. Путем изменения концентрации кислородных вакансий в структурах Pt/HfOx/TiN удалось добиться различных типов РП [27]. Слой оксида гафния толщиной 20 нм был осажден с помощью молекулярно-лучевой эпитаксией. Структуры с площадью 60 × 60 ${\text{мк}}{{{\text{м}}}^{2}}{\text{\;}}$ были сформированы с помощью фотолитографии. Исследовались структуры с диоксидом гафния HfO2 и с обедненным кислородом оксидом HfO1.5. В структурах с HfO2 было получено биполярное, униполярное и пороговое РП (рис. 18а, б); а в структурах с HfO1.5 – биполярное и комплементарное РП (рис. 18в, г). Различия в РП двух структур обусловлены разной концентрацией вакансий в объеме активного слоя (рис. 18д).
Рис. 18.
(а) Биполярное, (б) униполярное и пороговое РП в Pt/HfO2/TiN, (в) биполярное и (г) комплементарное РП в Pt/HfO1.5/TiN, (д) распределение вакансий в двух структурах [27].

Стехиометрия оксида может определяться выбором прекурсоров при АСО. Так в структурах Ni/HfO2/Si при осаждении оксида гафния в качестве второго прекурсора могли использоваться озон или вода [81]. Использование озона обеспечивало меньшую шероховатость поверхности и большее отношение сопротивлений. С другой стороны, применение воды позволяло добиться меньших напряжений формовки и большего числа циклов РП. Эти различия могут быть обусловлены наличием существенного числа атомов водорода в слое оксида в последнем случае.
Перспективных характеристик удалось достичь в структурах TiN/Hf/HfO2/TiN [4]. Электроды из нитрида титана, а также прослойка гафния толщиной от 2 до 10 нм были осаждены с помощью магнетронного распыления. Активный слой был сформирован атомно-слоевым осаждением. Исследовались кросспоинт структуры с площадью активной области от 10 × 10 ${\text{н}}{{{\text{м}}}^{2}}$ до 1 × 1 ${\text{мк}}{{{\text{м}}}^{2}}$. РП происходило в биполярном режиме с положительным напряжением на ВЭ при электроформовке и включении. Для структур 10 × 10 ${\text{н}}{{{\text{м}}}^{2}}$ среднее значение напряжения электроформовки составляло 5.3 и 2.3 В для структур с толщиной активного слоя 10 и 5 нм, соответственно. При толщине оксида менее 2.5 нм электроформовка не требовалась. Значения рабочих напряжений для различных структур находились в диапазоне от 0.3 до 0.6 В. Отношения сопротивлений составляло от 10 до 60. Было продемонстрированно успешное РП пяти-наносекундными импульсами и амплитудой менее 3 В. Анализ зависимости амплитуды импульса от времени переключения показал, что при наносекундном переключении напряжение не будет превышать 3 В. Количество циклов переключения составило 5 $ \times \,\,{{10}^{7}}$, время сохранения состояния – более 10 лет при 100°С. Для структур 10 × 10 ${\text{н}}{{{\text{м}}}^{2}}$ было достигнуто рекордно низкое значение энергии переключения – 0.1 пДж.
Структуры TiN/Ti/HfOx/TiN также представляют большой интерес. Электроды в таких структурах можно осадить распылением, а активный слой – с помощью атомно-слоевого осаждения [82]. В различных работах были достигнуты следующие результаты. Субнаносекундное переключение импульсами длиной 300 пс с амплитудой 1.4 В и числом циклов РП более 1010 [17]. В структурах 50 × 50 ${\text{н}}{{{\text{м}}}^{2}}$ были получены значения рабочих напряжений менее 1 В и достигнуто более ${{10}^{{11}}}$ циклов РП [83]. Также было получено время сохранения состояния более 10 лет, со значением отношения сопротивлений более 1000 [82].
В различных структурах на основе оксида гафния были продемонстрированы низкие значения рабочих напряжения (около 0.5 В), время сохранения состояния более 10 лет и масштабируемость до 10 нм. Также были продемонстрированы субнаносекундное РП с числом циклов переключения более ${{10}^{{11}}}$. Поэтому наряду с мемристорами на основе оксида тантала, мемристоры на основе оксида гафния имеют наибольшой потенциал использования в ReRAM.
6.5. Многослойные структуры
Добавление дополнительных слоев диэлектрика в мемристорных структурах позволяет улучшить некоторые характеристики РП, а также снизить дисперсию характеристик РП от цикла к циклу и от устройства к устройству. Например, формирование нескольких слоев из материалов с различной энергией активации электромиграции кислорода позволяет увеличить вероятность формирования филамента в определенных местах активного слоя. На сегодняшний день, наиболее популярны двух- и трехслойные структуры, однако в некоторых работах изучались структуры с большим числом слоев [84].
В структурах Pt/WSiOx/TiN добавление дополнительного слоя WSiON привело к заметному повышению стабильности РП [85]. Все слои в структурах Pt/WSiOx(25 нм)/TiN и Pt/WSiOx(20 нм)/WSiON(5 нм)/TiN были осаждены распылением. Обе структуры работали в биполярном режиме с близкими рабочими напряжениями. Двуслойные структуры демонстрировали меньший разброс параметров РП (токов и напряжений) от цикла к циклу (рис. 19а, б). Гистограмма напряжений включения для двухслойной структуры также демонстрирует меньшую дисперсию (рис. 19в, г). Однослойная структура выдержала ~${{10}^{6}}$ циклов РП, в то время как в двуслойной структуре деградация характеристик РП не наблюдалось даже после ${{10}^{8}}$ циклов. Время сохранения состояния – не менее ${{10}^{5}}$ с.
Добавление слоя оксида алюминия также может способствовать улучшению однородности характеристик. На примере структуры Al/HfOx(22 нм)/ITO было продемонстрировано, что добавление слоя оксида алюминия толщиной от 7 до 12 нм на границе с НЭ позволяет значительно снизить дисперсию значений сопротивлений и рабочих напряжений от ячейки к ячейке и от цикла к циклу, а также повысить значение отношения сопротивлений с ~ 102 до ~ 104 [86]. Схожих эффектов удалось добиться и при добавлении ультратонких слоев оксида алюминия (0.5 нм) в структурах ITO/HfO2(3 нм)/TiN [87]. Активные слои были осаждены плазмостимулированным АСО. Исследовались структуры без дополнительных слоев, со слоями оксида алюминия на границе с ВЭ или НЭ и на обеих границах с электродами. Наилучшая воспроизводимость характеристик была получена в структурах с оксидом алюминия на обеих границах с электродами, однако структуры со слоем оксида алюминия у одного из электродов также демонстрировали улучшение характеристик по сравнению со структурой без дополнительных слоев. Также в структуре ITO/Al2O3/HfO2/Al2O3/TiN были получены значения рабочих напряжений около 0.5 В, отношение сопротивлений более 103 и число циклов переключения более 106.
В структурах Pt/TiOx/HfO2/Pt удалось добиться рекордно низких размеров площади активной области – 2 × 2 ${\text{н}}{{{\text{м}}}^{2}}$ [15]. В качестве электродов использовались платиновые нанофины шириной 2 нм и высотой ~1 мкм. Такая форма позволяла увеличить площадь сечения линий кроссбара и снизить сопротивление электрода. Платина осаждалась электронно-лучевым испарением. Активный слой состоял из 3 нм оксида титана и 4 нм оксида гафния. Исследовались массивы структур 3 × 3 ячеек. Структуры переключались в биполярном режиме (рис. 19д) в диапазоне напряжений –1.5 и +1.5 В. Отношение сопротивлений составило более 450. Структуры обладали выпрямляющими свойствами. При этом ток при включении не превышал 50 нА, что позволяет сделать предположение о низком энергопотреблении.
В структурах Pt/Ti/оксид/Pt сравнивались в качестве материала активного слоя оксиды гафния, тантала и двухслойная структура HfOх/TaOx [9] (далее структуры M1, М2 и М3 соответственно). Слои платины толщиной около 30 нм были осаждены распылением, а 50 нм титана – электронно-лучевым испарением. Слои оксида были сформированы радиочастотным распылением. Толщина оксида составляла ~35 и 40 нм для структур М1 и М2. Для структуры М3 толщина оксидов гафния и тантала составила 34 и 13 нм соответственно. Структуры 100 × 100 ${\text{мк}}{{{\text{м}}}^{2}}$ были сформированы с помощью фотолитографии. В структурах М1 и М2 наблюдалось биполярное и униполярное РП, в М3 – только униполярное. В двухслойной структуре выключение происходило в два этапа: сначала происходил разрыв филамента в слое оксида гафния при напряжениях ±1 В, а затем в слое оксида тантала при напряжениях ±2.5 В. Двухслойные структуры демонстрировали большее отношение сопротивлений (650 против 65 и 100 у M1 и M2, соответственно). Структуры М3 также показали более высокую воспроизводимость характеристик от цикла к циклу и от устройства к устройству. В ходе измерения числа циклов переключения и времени сохранения состояния двухслойные структуры продемонстрировали наилучшие значения этих параметров.
ЗАКЛЮЧЕНИЕ
В данной работе рассмотрены оксидные мемристоры для ReRAM. Приведены возможные варианты практической реализации ReRAM, а также проблема ошибочного считывания при утечке электрического тока через соседние элементы массива. Кратко описаны основные типы и механизмы резистивного переключения в мемристорах. Описаны основные характеристики РП, необходимые для ReRAM, такие как рабочие напряжения, отношения сопротивлений в различных состояниях, число циклов переключения, время сохранения состояния, время переключения, энергопотребление и т.д.; а также методы их измерения. Наконец, были рассмотрены структуры на основе некоторых оксидов.
Несмотря на множество исследований, посвященных созданию энергонезависимой памяти на основе мемристоров, массовое производство такой памяти большого объема до сих пор невозможно. Основные причины: отсутствие структуры, которая удовлетворяла бы всем требованиям по характеристикам РП, большая неоднородность характеристик от цикла к циклу и от структуры к структуре, а также проблема утечек через соседние элементы. У мемристоров в ReRAM значения рабочих напряжений должны быть менее 1 В, энергопотребление за цикл – менее 10 пДж, время переключения – менее 10 нс, число циклов переключения – более 109, время сохранения состояния – более 10 лет, латеральный размер ячейки – менее 25 нм. Проблема утечек через соседние элементы может быть решена различными методами, однако эти методы усложняют производство памяти (добавление диодов, транзисторов, селекторов), сокращают число потенциальных структур (использование мемристоров с самовыпрямлением) или же усложняют работу памяти (использование комплементарного переключения). Неоднородность характеристик также является серьезной проблемой, которую пока решить не удалось.
Список литературы
Pan F., Gao S., Chen C. Recent progress in resistive random access memories: Materials, switching mechanisms, and performance // Mater. Sci. Eng. R Rep. 2014. V. 83. P. 1–59.
Chua L. Memristor – the missing circuit element // IEEE Trans. Circuit Theory. 1971. V. 18. № 5. P. 507–519.
Resistive Switching: From Fundamentals of Nanoionic Redox Processes to Memristive Device Applications / ed. Ielmini D., Waser R. Weinheim, Germany: Wiley-VCH Verlag GmbH & Co. KGaA, 2016.
Govoreanu B., Kar G.S., Chen Y.-Y. 10 × 10 nm2 Hf/HfOx crossbar resistive RAM with excellent performance, reliability and low-energy operation // 2011 International Electron Devices Meeting. Washington, DC, USA: IEEE, 2011. P. 31.6.1–31.6.4.
Kwon D.-H., Kim K.M., Jang J.H. Atomic structure of conducting nanofilaments in TiO2 resistive switching memory // Nat. Nanotechnol. 2010. V. 5. № 2. P. 148–153.
Illarionov G.A., Morozova S.M., Chrishtop V.V. Memristive TiO2: Synthesis, Technologies, and Applications // Front. Chem. 2020. V. 8. P. 724.
Sawa A., Fujii T., Kawasaki M. Colossal Electro-Resistance Memory Effect at Metal/La2CuO4 Interfaces // Jpn. J. Appl. Phys. 2005. V. 44. № 40. P. L1241–L1243.
Yoon J.H., Zhang J., Lin P. A Low-Current and Analog Memristor with Ru as Mobile Species // Adv. Mater. 2020. V. 32. № 9. P. 1904599.
Park M.R., Abbas Y., Abbas H. Resistive switching characteristics in hafnium oxide, tantalum oxide and bilayer devices // Microelectron. Eng. 2016. V. 159. P. 190–197.
Kurnia F., Liu C., Jung C.U. The evolution of conducting filaments in forming-free resistive switching Pt/TaOx/Pt structures // Appl. Phys. Lett. 2013. V. 102. № 15. P. 152902.
Jiang H., Han L., Lin P. Sub-10 nm Ta Channel Responsible for Superior Performance of a HfO2 Memristor // Sci. Rep. 2016. V. 6. № 1. P. 28525.
Liu T., Yan T.H., Scheuerlein R. A 130.7-mm2 2-Layer 32-Gb ReRAM Memory Device in 24-nm Technology // IEEE J. Solid-State Circuits. 2014. V. 49. № 1. P. 140–153.
Fackenthal R., Kitagawa M., Otsuka W. A 16Gb ReRAM with 200 MB/s write and 1 GB/s read in 27 nm technology // 2014 IEEE International Solid-State Circuits Conference Digest of Technical Papers (ISSCC). San Francisco, CA, USA: IEEE, 2014. P. 338–339.
Li H., Wang S., Zhang X., Wang W., Yang R., Sun Z. Memristive Crossbar Arrays for Storage and Computing Applications // Adv. Intell. Syst. 2021. V. 3. № 9. P. 2100017.
Pi S., Li C., Jiang H. Memristor crossbar arrays with 6-nm half-pitch and 2-nm critical dimension // Nat. Nanotechnol. 2019. V. 14. № 1. P. 35–39.
Torrezan A.C., Strachan J.P., Medeiros-Ribeiro G. Sub-nanosecond switching of a tantalum oxide memristor // Nanotechnology. 2011. V. 22. № 48. P. 485203.
Lee H.Y., Chen Y.S., Chen P.S. Evidence and solution of over-RESET problem for HfOX based resistive memory with sub-ns switching speed and high endurance // 2010 International Electron Devices Meeting. San Francisco, CA, USA: IEEE, 2010. P. 19.7.1–19.7.4.
Zahoor F., Azni Zulkifli T.Z., Khanday F.A. Resistive Random Access Memory (RRAM): an Overview of Materials, Switching Mechanism, Performance, Multilevel Cell (mlc) Storage, Modeling, and Applications // Nanoscale Res. Lett. 2020. V. 15. № 1. P. 90.
Baek I.G., Park C.J., Ju H. Realization of vertical resistive memory (VRRAM) using cost effective 3D process // 2011 International Electron Devices Meeting. Washington, DC, USA: IEEE, 2011. P. 31.8.1–31.8.4.
Meyer R., Schloss L., Brewer J. Oxide dual-layer memory element for scalable non-volatile cross-point memory technology // 2008 9th Annual Non-Volatile Memory Technology Symposium (NVMTS). Pacific Grove, CA, USA: IEEE, 2008. P. 1–5.
Zidan M.A., Fahmy H.A.H., Hussain M.M. Memristor-based memory: The sneak paths problem and solutions // Microelectron. J. 2013. V. 44. № 2. P. 176–183.
Maevsky O.V., Pisarev A.D., Busygin A.N., Udovichenko S.Yu. Complementary memristive diode cells for the memory matrix of a neuromorphic processor // Int. J. Nanotechnol. 2018. V. 15. № 4/5. P. 388.
Son M., Lee J., Park J. Excellent Selector Characteristics of Nanoscale VO2 for High-Density Bipolar ReRAM Applications // IEEE Electron Device Lett. 2011. V. 32. № 11. P. 1579–1581.
Chen A. Analysis of Partial Bias Schemes for the Writing of Crossbar Memory Arrays // IEEE Trans. Electron Devices. 2015. V. 62. № 9. P. 2845–2849.
Li C., Han L., Jiang H. Three-dimensional crossbar arrays of self-rectifying Si/SiO2/Si memristors // Nat. Commun. 2017. V. 8. № 1. P. 15666.
Lee M.-J., Lee C.B., Lee D. A fast, high-endurance and scalable non-volatile memory device made from asymmetric Ta2O5−x/TaO2−x bilayer structures // Nat. Mater. 2011. V. 10. № 8. P. 625–630.
Sharath S.U., Vogel S., Molina-Luna L. Control of Switching Modes and Conductance Quantization in Oxygen Engineered HfOx based Memristive Devices // Adv. Funct. Mater. 2017. V. 27. № 32. P. 1700432.
Nardi F., Balatti S., Larentis S. Complementary switching in metal oxides: Toward diode-less crossbar RRAMs // 2011 International Electron Devices Meeting. Washington, DC, USA: IEEE, 2011. P. 31.1.1–31.1.4.
Lanza M., Wong H.-S.P., Pop E. Recommended Methods to Study Resistive Switching Devices // Adv. Electron. Mater. 2019. V. 5. № 1. P. 1800143.
Shi Y., Ji Y., Sun H., Hui F., Hu J., Wu Y., Fang J. Nanoscale characterization of PM2.5 airborne pollutants reveals high adhesiveness and aggregation capability of soot particles // Sci. Rep. 2015. V. 5. № 1. P. 11232.
Hsu A., Wang H., Kim K.K., Kong J., Palacios T. Impact of Graphene Interface Quality on Contact Resistance and RF Device Performance // IEEE Electron Device Lett. 2011. V. 32. № 8. P. 1008–1010.
Sirotkin V.V. Computer Investigation of the Influence of Metal Contact Inhomogenees on Resistive Switching in a Heterostructure Based on Bismuth Selenide // Russ. Microelectron. 2021. V. 50. № 5. P. 326–332.
Lanza M., Bersuker G., Porti M., Miranda E., Nafría M., Aymerich X. Resistive switching in hafnium dioxide layers: Local phenomenon at grain boundaries // Appl. Phys. Lett. 2012. V. 101. № 19. P. 193502.
Bobylev A.N., Udovichenko S.Yu. Electrical properties of a TiN/Ti x Al1 – xOy /TiN memristor device manufactured by magnetron sputtering // Russ. Microelectron. 2016. V. 45. № 6. P. 396–401.
Lei B., Kwan W.L., Shao Y., Yang Y. Statistical characterization of the memory effect in polyfluorene based non-volatile resistive memory devices // Org. Electron. 2009. V. 10. № 6. P. 1048–1053.
He C.L., Zhuge F., Zhou X.F., Li M., Zhou G.C., Liu Y.W., Wang J.Z. Nonvolatile resistive switching in graphene oxide thin films // Appl. Phys. Lett. 2009. V. 95. № 23. P. 232101.
Liu X., Biju K.P., Bourim E.M., Park S., Lee W., Shin J., Hwang H. Low programming voltage resistive switching in reactive metal/polycrystalline Pr0.7Ca0.3MnO3 devices // Solid State Commun. 2010. V. 150. № 45–46. P. 2231–2235.
Yang Y.C., Chen C., Zeng F. Multilevel resistance switching in Cu/TaOx/Pt structures induced by a coupled mechanism // J. Appl. Phys. 2010. V. 107. № 9. P. 093701.
Wang T.-Y., Meng J.-L., Li Q.-X., Chen L., Zhu H., Sun Q.-Q., Ding S.-J., Zhang D.W. Forming-free flexible memristor with multilevel storage for neuromorphic computing by full PVD technique // J. Mater. Sci. Technol. 2021. V. 60. P. 21–26.
Srivastava S., Thomas J.P., Leung K.T. Programmable, electroforming-free TiOx/TaOx heterojunction-based non-volatile memory devices // Nanoscale. 2019. V. 11. № 39. P. 18159–18168.
Sawa A. Resistive switching in transition metal oxides // Mater. Today. 2008. V. 11. № 6. P. 28–36.
Fu D., Xie D., Feng T. Unipolar Resistive Switching Properties of Diamondlike Carbon-Based RRAM Devices // IEEE Electron Device Lett. 2011. V. 32. № 6. P. 803–805.
Permyakova O.O., Rogozhin A.E. Simulation of Resistive Switching in Memristor Structures Based on Transition Metal Oxides // Russ. Microelectron. 2020. V. 49. № 5. P. 303–313.
Nandakumar S.R., Minvielle M., Nagar S. A 250 mV Cu/SiO2/W Memristor with Half-Integer Quantum Conductance States // Nano Lett. 2016. V. 16. № 3. P. 1602–1608.
Hirose Y., Hirose H. Polarity-dependent memory switching and behavior of Ag dendrite in Ag-photodoped amorphous As2S 3films // J. Appl. Phys. 1976. V. 47. № 6. P. 2767–2772.
Yang Y., Zhang X., Gao M., Zeng F., Zhou W., Xie S., Pan F. Nonvolatile resistive switching in single crystalline ZnO nanowires // Nanoscale. 2011. V. 3. № 4. P. 1917.
Valov I., Waser R., Jameson J.R. Electrochemical metallization memories—fundamentals, applications, prospects // Nanotechnology. 2011. V. 22. № 25. P. 254003.
Peng S., Zhuge F., Chen X., Zhu X., Hu B., Pan L., Chen B. Mechanism for resistive switching in an oxide-based electrochemical metallization memory // Appl. Phys. Lett. 2012. V. 100. № 7. P. 072101.
Sakamoto T., Lister K., Banno N., Hasegawa T., Terabe K., Aono M. Electronic transport in Ta2O5 resistive switch // Appl. Phys. Lett. 2007. V. 91. № 9. P. 092110.
Jeong D.S., Thomas R., Katiyar R.S., Scott J.F., Kohlstedt H., Petraru A., Hwang C.S. Emerging memories: resistive switching mechanisms and current status // Rep. Prog. Phys. 2012. V. 75. № 7. P. 076502.
Wang S.-Y., Lee D.-Y., Huang T.-Y., Wu J.-W., Tseng T.-Y. Controllable oxygen vacancies to enhance resistive switching performance in a ZrO2 -based RRAM with embedded Mo layer // Nanotechnology. 2010. V. 21. № 49. P. 495201.
Kim K.M., Jeong D.S., Hwang C.S. Nanofilamentary resistive switching in binary oxide system; a review on the present status and outlook // Nanotechnology. 2011. V. 22. № 25. P. 254002.
Park G.-S., Li X.-S., Kim D.-C., Jung R.-J., Lee M.-J., Seo S. Observation of electric-field induced Ni filament channels in polycrystalline NiOx film // Appl. Phys. Lett. 2007. V. 91. № 22. P. 222103.
Dittmann R., Muenstermann R., Krug I., Park D., Menke T. Scaling Potential of Local Redox Processes in Memristive SrTiO3 Thin-Film Devices // Proc. IEEE. 2012. V. 100. № 6. P. 1979–1990.
Yan Z.B., Liu J.-M. Coexistence of high performance resistance and capacitance memory based on multilayered metal-oxide structures // Sci. Rep. 2013. V. 3. № 1. P. 2482.
Orlov O.M., Gismatulin A.A., Gritsenko V.A., Mizginov D.S. Charge Transport Mechanism in a Formless Memristor Based on Silicon Nitride // Russ. Microelectron. 2020. V. 49. № 5. P. 372–377.
Iskhakzay R.M.Kh., Kruchinin V.N., Aliev V.Sh., Gritsenko V.A., Dementieva E.V., Zamoryanskaya M.V. Charge Transport in Nonstoichiometric SiOx Obtained by Treatment of Thermal SiO2 in Hydrogen Plasma of Electronic-Cyclotron Resonance // Russ. Microelectron. 2022. V. 51. № 1. P. 24–35.
Wang L.-G., Qian X., Cao Y.-Q. Excellent resistive switching properties of atomic layer-deposited Al2O3/HfO2/Al2O3 trilayer structures for non-volatile memory applications // Nanoscale Res. Lett. 2015. V. 10. № 1. P. 135.
Avila A., Bhushan B. Electrical Measurement Techniques in Atomic Force Microscopy // Crit. Rev. Solid State Mater. Sci. 2010. V. 35. № 1. P. 38–51.
Hui F., Lanza M. Scanning probe microscopy for advanced nanoelectronics // Nat. Electron. 2019. V. 2. № 6. P. 221–229.
Hui F., Wen C., Chen S. Emerging Scanning Probe–Based Setups for Advanced Nanoelectronic Research // Adv. Funct. Mater. 2020. V. 30. № 18. P. 1902776.
Electrical Atomic Force Microscopy for Nanoelectronics / ed. Celano U. Cham: Springer International Publishing, 2019.
Hui F., Grustan-Gutierrez E., Long S. Graphene and Related Materials for Resistive Random Access Memories // Adv. Electron. Mater. 2017. V. 3. № 8. P. 1600195.
Zuo Y. et al. Effect of the Pressure Exerted by Probe Station Tips in the Electrical Characteristics of Memristors // Adv. Electron. Mater. 2020. V. 6. № 3. P. 1901226.
Jiang H., Belkin D., Savel’ev S.E. A novel true random number generator based on a stochastic diffusive memristor // Nat. Commun. 2017. V. 8. № 1. P. 882.
Kim H., Mahmoodi M.R., Nili H. 4K-memristor analog-grade passive crossbar circuit // Nat. Commun. 2021. V. 12. № 1. P. 5198.
Xia Q., Yang J.J., Wu W., Williams R.S. Self-Aligned Memristor Cross-Point Arrays Fabricated with One Nanoimprint Lithography Step // Nano Lett. 2010. V. 10. № 8. P. 2909–2914.
Pi S., Lin P., Xia Q. Cross point arrays of 8 nm × 8 nm memristive devices fabricated with nanoimprint lithography // J. Vac. Sci. Technol. B Nanotechnol. Microelectron. Mater. Process. Meas. Phenom. 2013. V. 31. № 6. P. 06FA02.
Niu J., Zhang M., Li Y. Highly scalable resistive switching memory in metal nanowire crossbar arrays fabricated by electron beam lithography // J. Vac. Sci. Technol. B Nanotechnol. Microelectron. Mater. Process. Meas. Phenom. 2016. V. 34. № 2. P. 02G105.
Meng J., Zhao B., Xu Q., Goodwill J.M., Bain J.A., Skowronski M. Temperature overshoot as the cause of physical changes in resistive switching devices during electro-formation // J. Appl. Phys. 2020. V. 127. № 23. P. 235107.
Li Y., Ang K.-W. Hardware Implementation of Neuromorphic Computing Using Large-Scale Memristor Crossbar Arrays // Adv. Intell. Syst. 2021. V. 3. № 1. P. 2000137.
Wei Z., Kanzawa Y., Arita K. Highly reliable TaOx ReRAM and direct evidence of redox reaction mechanism // 2008 IEEE International Electron Devices Meeting. San Francisco, CA, USA: IEEE, 2008. P. 1–4.
Choi B.J., Choi S., Kim K.M. Study on the resistive switching time of TiO2 thin films // Appl. Phys. Lett. 2006. V. 89. № 1. P. 012906.
Kim S., Choi S., Lu W. Comprehensive Physical Model of Dynamic Resistive Switching in an Oxide Memristor // ACS Nano. 2014. V. 8. № 3. P. 2369–2376.
Baeumer C., Valenta R., Schmitz C., Locatelli A., Rogers S.P., Sala A., Raab N. Subfilamentary Networks Cause Cycle-to-Cycle Variability in Memristive Devices // ACS Nano. 2017. V. 11. № 7. P. 6921–6929.
Zhu Y.-L., Xue K.-H., Cheng X.-M., Qiao C., Yuan J.-H., Li L.-H., Miao X.-S. Uniform and robust TiN/HfO2/Pt memristor through interfacial Al-doping engineering // Appl. Surf. Sci. 2021. V. 550. P. 149274.
Yoshida C., Tsunoda K., Noshiro H. High speed resistive switching in Pt/TiO2/TiN film for nonvolatile memory application // Appl. Phys. Lett. 2007. V. 91. № 22. P. 223510.
Choi B.J., Torrezan A.C., Norris K.J. Electrical Performance and Scalability of Pt Dispersed SiO2 Nanometallic Resistance Switch // Nano Lett. 2013. V. 13. № 7. P. 3213–3217.
Fadeev A.V., Rudenko K.V. To the Issue of the Memristor’s HRS and LRS States Degradation and Data Retention Time // Russ. Microelectron. 2021. V. 50. № 5. P. 311–325.
Kempen T., Waser R., Rana V. 50x Endurance Improvement in TaOx RRAM by Extrinsic Doping // 2021 IEEE International Memory Workshop (IMW). Dresden, Germany: IEEE, 2021. P. 1–4.
Ryu H., Kim S. Effects of Oxygen Precursor on Resistive Switching Properties of CMOS Compatible HfO2-Based RRAM // Metals. 2021. V. 11. № 9. P. 1350.
Lee H.Y., Chen P.S., Wu T.Y. Low power and high speed bipolar switching with a thin reactive Ti buffer layer in robust HfO2 based RRAM // 2008 IEEE International Electron Devices Meeting. San Francisco, CA, USA: IEEE, 2008. P. 1–4.
Koveshnikov S., Matthews K., Min K. Real-time study of switching kinetics in integrated 1T/HfOx 1R RRAM: Intrinsic tunability of set/reset voltage and trade-off with switching time // 2012 International Electron Devices Meeting. San Francisco, CA, USA: IEEE, 2012. P. 20.4.1–20.4.3.
Yin B., Wang Y., Xie G., Guo B., Gong J.R. Memristors based on TiOx/HfOx or AlOx/HfOx Multilayers with Gradually Varied Thickness // Phys. Status Solidi RRL – Rapid Res. Lett. 2021. V. 15, № 6. P. 2000607.
Syu Y.-E., Zhang R., Chang T.-C. Endurance Improvement Technology With Nitrogen Implanted in the Interface of WSiOx Resistance Switching Device // IEEE Electron Device Lett. 2013. V. 34. № 7. P. 864–866.
Biswas S., Paul A.D., Das P., Tiwary P., Edwards H.J., Dhanak V.R., Mitrovic I.Z., Mahapatra R. Impact of AlO y Interfacial Layer on Resistive Switching Performance of Flexible HfOx/AlOy ReRAMs // IEEE Trans. Electron Devices. 2021. V. 68. № 8. P. 3787–3793.
Persson K.-M., Ram M.S., Wernersson L.-E. Ultra-Scaled AlOx Diffusion Barriers for Multibit HfOx RRAM Operation // IEEE J. Electron Devices Soc. 2021. V. 9. P. 564–569.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника