Микроэлектроника, 2022, T. 51, № 1, стр. 28-40
Транспорт заряда в нестехиометрическом SiOx, полученном обработкой термического SiO2 в водородной плазме электронно-циклотронного резонанса
Р. М. Х. Исхакзай a, *, В. Н. Кручинин a, В. Ш. Алиев a, c, В. А. Гриценко a, b, c, Е. В. Дементьева d, М. В. Заморянская d
a Федеральное государственное бюджетное учреждение науки Институт физики полупроводников
им. А.В. Ржанова СО Российской АН
630090 Новосибирск, пр. Академика Лаврентьева, 13, Россия
b Новосибирский государственный университет
630090 Новосибирск, ул. Пирогова, 2, Россия
c Новосибирский государственный технический университет
630073 Новосибирск, пр. Маркса, 20, Россия
d Физико-технический институт им. А.Ф. Иоффе
194021 Санкт-Петербург, ул. Политехническая, 26, Россия
* E-mail: iskhakzay@gmail.com
Поступила в редакцию 12.04.2021
После доработки 23.04.2021
Принята к публикации 28.05.2021
- EDN: ZBLHGB
- DOI: 10.31857/S0544126921060089
Аннотация
В настоящее время разрабатывается новое поколение быстродействующей, информационно-емкой резистивной памяти на основе нестехиометрических диэлектриков. Электронная структура нестехиометрического оксида кремния SiOx задается величиной параметра х. Было установлено, что обработка термического SiO2 в водородной плазме электронно-циклотронного резонанса приводит к обогащению оксида кремния избыточным кремнием, что в свою очередь приводит появлению в SiOx электронных и дырочных ловушек. Проводимость SiOx является биполярной: из отрицательно смещенного кремния инжектируются электроны, из положительно смещенного кремния инжектируются дырки. Эксперименты по катодолюминесценции подтвердили предположение о том, что ловушки в SiOx обусловлены избыточным кремнием. На основе отработанной методики приготовления нестехиометрического оксида в водородной плазме электронно-циклотронного резонанса изготовлены мемристорные МДП структуры p++-Si(100)/SiOx/Ni. Такие структуры продемонстрировали свойства резистивного переключения SiOx, не требующие операции формовки.
ВВЕДЕНИЕ
Оксид кремния является ключевым диэлектриком в кремниевых приборах. Термический SiO2 используется в качестве туннельного диэлектрика в современных приборах flash-памяти [1]. Физические свойства нестехиометрического оксида кремния SiOx задаются параметром x = [O]/[Si]. Ширина запрещенной зоны SiOx меняется в диапазоне от Eg = 8.0 эВ в аморфном SiO2 до Eg = 1.6 эВ в аморфном Si [2–5]. В настоящее время резистивная память (Resistive Random–Access Memory, ReRAM) на основе обратимого изменения проводимости диэлектрического слоя под действием электрических импульсов напряжения превосходит традиционную flash-память по всем ключевым параметрам: большое количество циклов переключения ~1010 [6, 7], малое энергопотребление <10 фДж, высокое быстродействие ~0.3 нс. Ключевым элементом ячейки ReRAM является структура металл диэлектрик металл (МДМ). В качестве активной среды изучаются различные нестехиометрические диэлектрики, такие, как HfOx, TaOx, TiOx, SiOx, GeOx, AlOx, NbOx, SiNx, SiNyOy. Свойства резистивного переключения МДМ структур проявляются после проведения процедуры, так называемой “формовки”, в ходе которой МДМ структура подвергается мягкому электрическому пробою [8]. Эта операция в настоящее время является критической для широкого внедрения ReRAM. Операция формовки заключается в подаче импульса напряжения превышающего, как правило, в несколько раз амплитуду переключающих импульсов мемристора, что может приводить к необратимому пробою диэлектрика или быстрой деградации свойств резистивных переключений. Ранее было показано, что операции формовки можно избежать за счет понижения напряжения формовки до величин равных напряжениям переключения мемристора, если использовать нестехиометрические оксиды определенного состава, полученные методом ионно-лучевого распыления осаждения (англ. IBSD – ion beam sputtering deposition) [9]. Однако, метод IBSD не пригоден для технологии ReRAM, т. к. не позволяет получить конформные и однородные слои толщиной менее 10 нм. С другой стороны, термическое окисление Si обеспечивает конформность и однородность SiO2, но не позволяет управлять стехиометрией оксидных слоев. Одной из возможностей управляемо вносить вакансии кислорода в оксидные слои является обработка их в водородной плазме электронно-циклотронного резонанса (ЭЦР). Этот метод был успешно опробован нами при восстановлении SiO2 до SiOx [4, 10] и V2O5 до VO2 [11].
Важным достоинством плазмы электронно-циклотронного резонанса для процесса восстановления является высокая степень ионизации плазмы при низкой ионной температуре. Известно, что эффективность ионизации в условиях электронно-циклотронного резонанса значительно выше, чем, например, в планарных ВЧ плазменных реакторах. ВЧ ЭЦР реактор допускает снижение давления горения плазмы до 10–2–10–3 Па. Во время процесса обработки в ЭЦР плазме, при давлении водорода меньше 2 × 10–2 Па, тепловое воздействие на поверхность пленки незначительное, и можно добиться того, что температурный режим восстановления останется неизменным в течение всего процесса.
Известно, что транспорт заряда в термическом оксиде кремния лимитируется туннельной инжекцией Фаулера–Нордгейма [12]. Целью настоящей работы является исследование механизма транспорта заряда в нестехиометрическом оксиде кремния SiOx (x < 2), полученным путем восстановления термического SiO2 в водородной ЭЦР плазме, применительно к задаче создания бесформовочного мемристора на основе SiOx.
ОСНОВЫ МЕТОДА РАЗДЕЛЕНИЯ ЭЛЕКТРОННОЙ И ДЫРОЧНОЙ КОМПОНЕНТ ТОКА В РЕЖИМЕ НЕРАВНОВЕСНОГО ОБЕДНЕНИЯ КРЕМНИЯ
В полупроводниках определение знака носителей заряда (электронов и дырок) осуществляется с помощью измерений эффекта Холла либо термо-ЭДС. Поскольку в диэлектриках концентрация свободных носителей заряда пренебрежимо мала, для них вышеописанные методы неприменимы. В общем случае проводимость диэлектрика является биполярной двузонной, из отрицательно смещенного контакта (катода) инжектируются электроны, из положительно смещенного контакта (анода) – дырки [13]. Однако, в диэлектриках вклад электронной и дырочной компонент в инжекционный ток может сильно варьироваться в зависимости от следующих факторов: высота барьера на границе контакт-диэлектрик, длительность импульса, полярность потенциала, толщина диэлектрика [13]. Для определения вклада электронов и дырок в проводимость SiOx, полученного обработкой SiO2 в водородной ЭЦР плазме, в настоящей работе, используется метод разделения электронной и дырочной компонент тока в режиме неравновесного обеднения металл-диэлектрик-полупроводник (МДП) на кремнии n- и p-типов, рис. 1д, е. Данный метод на примере Si3N4 был предложен и разработан в работах [14–17]. В последующем, этот метод был использован для разделения токов в HfO2 [18], TiO2 [19], GeO2 [20]. Сущность метода заключается в использовании внешней оптической подсветки для генерации неосновных носителей и для определения их знака в процессах инжекции из кремния в диэлектрик.
Рис. 1.
Энергетическая диаграмма структуры p-Si/SiOx/Ni и n-Si/SiOx/Ni в режиме плоских зон (а, б), в режиме обогащения (в, г) и в режиме неравновесного обеднения (д, е). Изогнутая стрелка указывает на фотогенерацию носителей при внешней подсветке.
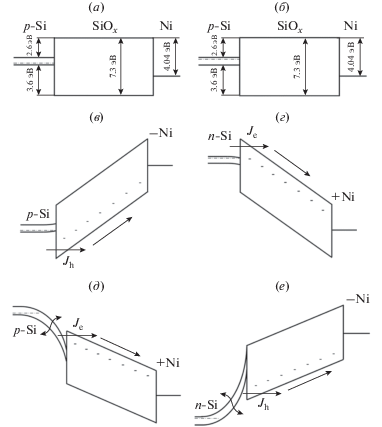
На рис. 1а, б представлена энергетическая диаграмма МДП структуры на основе n-Si/SiOx/Ni и p-Si/SiOx/Ni в режиме плоских зон, без приложенного напряжения. Величины электронных и дырочных барьеров на границе Si/SiOx, Ni/SiOx, ширина запрещенной зоны (Eg = 7.3 эВ) SiOx (x = = 1.96) определялись с использований данных квантово-химических расчетов, выполненных в [5].
На рис. 1в, г представлена энергетическая диаграмма МДП структур на основе n-Si- и p-Si в режиме обогащения. В режиме обогащения кремния, практически все приложенное напряжение, падает на диэлектрике, т. к. падение потенциала на кремнии мало. В этом случае область пространственного заряда нечувствительна к знаку носителей в диэлектрике.
В режиме обеднения кремния возможны два варианта. В первом случае, когда из металла в диэлектрик инжектируются электроны, или дырки, практически все приложенное напряжение падает на диэлектрике. Ток в МДП структуре экспоненциально растет с увеличением приложенного напряжения. Во втором случае, когда из полупроводника в диэлектрик инжектируются неосновные носители из-за ограниченного темпа термической генерации неосновных носителей имеет место уменьшение емкости, переход емкости из режима инверсии в режим неравновесного обеднения и насыщение сквозного тока. Подсветка увеличивает темп генерации неосновных носителей в области пространственного заряда кремния, что приводит к увеличению тока насыщения. Насыщение тока в режиме неравновесного обеднения указывает на инжекцию неосновных носителей заряда из кремния в диэлектрик.
На рис. 1д, е представлена энергетическая диаграмма МДП структур на основе n-Si- и p-Si в режиме обеднения в случае, когда транспорт заряда осуществляется неосновными носителями, инжектированными из кремния. Падение напряжения в кремнии приводит к насыщению тока неосновных носителей из полупроводника.
Независимо, знак носителей заряда, инжектированных в диэлектрик может быть определен по накоплению инжектированных из кремния носителей заряда с помощью измерения сдвига вольт-фарадных характеристик [20].
МЕТОДИКА ЭКСПЕРИМЕНТА
На подложках Si(100) КДБ – 10 и Si(100) КЭФ – 4.5 диаметром 100 мм методом термического окисления были выращены слои SiO2 толщиной 45 и 20 нм. После получения пленок термического SiO2 подложки раскалывались на прямоугольные образцы размером 10 × 18 мм2, которые подвергались воздействию водородной ЭЦР плазмы в течение 15 и 30 мин.
Восстановление пленок SiO2 проводилось в вакуумной установке, собранной на базе откачного поста с турбомолекулярным насосом (остаточное давление в камере ≈10–4 Па), в которую был встроен источник ЭЦР плазмы антенного типа с многополюсной магнитной системой, рис. 2. Рабочая частота источника 2.45 ГГц. ЭЦР плазма возбуждалась при давлении водорода в вакуумной камере 1.8 × 10–2 Па, так как при таком давлении наблюдалось наиболее устойчивое горение плазмы.
Для проведения электрофизических исследований на образцы после обработки методом электронно-лучевого испарения через металлическую маску был нанесен слой Ni толщиной 50 нм. Схематическое изображение структур для электрофизических измерений представлено на рис. 3.
Дополнительно были изготовлены мемристорные МДП структуры на вырожденном кремнии р-типа с удельным сопротивлением Ω = = 0.001–0.003 [Ом ⋅ см] и толщиной слоя SiOx равной 20 нм и временем экспозиции в плазме 2, 6, 15 и 30 мин. Данная серия образцов изготовлена для изучения резистивных свойств пленок SiOx, полученных в водородной ЭЦР плазме. Для измерения спектров катодолюминесценции (КЛ) подготовлены аналогичные образцы (с толщиной слоя SiOx равной 20 нм и временем экспозиции в плазме 2, 6, 18 мин).
Для определения вклада носителей заряда в проводимость SiOx на зондовой станции Cascade Microtech, подключенной к анализатору полупроводниковых приборов Agilent Technologies B1500A, измерялись вольт-амперные характеристики (ВАХ) и вольт-фарадные характеристики (ВФХ) МДП структур (${{{\text{d}}}_{{{\text{Si}}{{{\text{O}}}_{x}}}}}$ ≈ 45 нм). ВАХ измерялись в режиме неравновесного обеднения, без подсветки и с подсветкой. Для определения механизма транспорта заряда измерялись ВАХ МДП структур p-Si/SiOx/Ni, с толщиной SiOx равной 45 нм. Измерения ВАХ проводились при различных температурах (300–450 К) с использованием нагревательного столика Linkam LTS420E и электрометра Keithley 6517а. Измерения вольт-амперных характеристик мемристорных МДП структур с толщиной SiOx равной 20 нм проводились на зондовой станции Cascade Microtech, подключенной к анализатору полупроводниковых приборов Agilent Technologies B1500A.
Катодолюминесция (КЛ) пленок SiOx изучалась с помощью электронно-зондового микроанализатора CAMEBAX (Cameca, Франция), оснащенного оригинальным оптическим спектрометром для регистрации катодолюминесцентных спектров (КЛ) [21]. Спектры КЛ измерялись при энергии электронного пучка 10 кэВ, токе электронного пучка 20 нА и его диаметре 14 мкм. Глубина проникновения электронов первичного электронного пучка с энергией 5 кэВ в этих образцах составляет около 200 нм, что значительно превышает толщину пленки диоксида кремния. Таким образом, генерация катодолюминесценции происходит равномерно по толщине пленки.
Для эллипсометрического исследования влияния ЭЦР плазмы на оптические характеристики пленок SiO2 были использованы 2 образца с толщиной пленок термического оксида 45 нм. Один из образцов был обработан в водородной плазме ЭЦР в течение 15 мин. Измерения спектральных зависимостей эллипсометрических углов Ψ(E) и Δ(E) проводились с помощью спектрального эллипсометра “Эллипс-1891-САГ” (ИФП СО РАН, Новосибирск) при следующих условиях: диапазон энергий фотонов E = 1.13–4.96 эВ, спектральное разрешение прибора: 0.01 эВ, угол падения луча света на образец 70°, время записи одного спектра не превышало ~20 c. Использовалась четырехзонная методика измерений с последующим усреднением по всем зонам. Измеренные спектры Ψ(E) и Δ(E) использовались далее для решения обратной задачи эллипсометрии и определения дисперсионных зависимостей n(E) плeнок SiOx путем подгонки расчетных спектральных зависимостей эллипсометрических углов к экспериментальным в соответствии с однослойной оптической моделью системы [22]. Дисперсионные зависимости описывались с помощью полинома Коши [23]:
где a, b, c – коэффициенты. Оптические константы n, kSi-подложки для расчeтов брались из базы данных [24].Пленка SiOx после обработки в ЭЦР плазме водорода моделировалась смесью SiO2 + SiO [25]. Для оценки вклада каждой компоненты в оптические свойства оксида, т.е., для оценки величины “x” в SiOx была использована модель эффективной среды Бруггемана [26]:
(2)
$\sum\limits_i {\left( {{{q}_{i}}\frac{{{{\varepsilon }_{i}} - {{\varepsilon }_{{{\text{eff}}}}}}}{{{{\varepsilon }_{i}} + 2{{\varepsilon }_{{{\text{eff}}}}}}}} \right)} = 0;\,\,\,\,\sum\limits_i {{{q}_{i}}} = 1,$Для исследования однородности толщины (d) и показателя преломления (n) по площади образцов исходных пленок и после обработки в плазме был использован быстродействующий сканирующий эллипсометр высокого разрешения “Микроскан-3М” (ИФП СО РАН) [27]. Минимальный шаг сдвига столика эллипсометра по осям X, Y составлял 5 мкм, что и определяло латеральное разрешение прибора. Эллипсометрические углы считывались по участку поверхности 3–18 мм образцов с шагом по осям x и y 0.1 мм. Использовался He-Ne-лазер (E = 1.96 эВ), угол падения луча света на образец составлял 60°, лазерный луч фокусировался в световое пятно 10 мкм на поверхности образца с помощью высококачественного не поляризующего микрообъектива. В каждой отсканированной точке образца вычисление d и n-плeнки осуществлялось независимо по методике, описанной выше.
ЭКСПЕРИМЕНТАЛЬНЫЕ РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
Изучение поверхности образцов с помощью сканирующего эллипсометра показало, что пленка с термическим SiO2 на исходном образце имеет высокую однородность с отсутствием градиентов по d и n (рис. 4а, б, 0 мин). Обработка в водородной плазме не привела к появлению экспериментально заметного поглощения в пленке. Поэтому для анализа эллипсометрических результатов также была применена однослойная модель не поглощающей пленки.
Рис. 4.
Распределение толщины (а) и показателя преломления (б) по поверхности исходной пленки SiO2 (0 мин) и после обработки водородной в ЭЦР плазме (15 мин), (в) дисперсионные кривые n(E) для пленки SiO2 до (1) и после обработки 15 мин (2) в водородной ЭЦР плазме. Красный пунктир – результат расчета в соответствии с моделью Бруггемана (2).

Обработка в водородной плазме приводила к появлению неоднородностей по n и d, однако значения этих неоднородностей не превышают Δn ≈ 1% и Δd ≈ 2% (рис. 4а, б, 15 мин). Кроме того, показатель преломления пленок незначительно увеличивается, а толщина пленки практически не изменяется (табл. 1).
Таблица 1.
Результаты эллипсометрических измерений образцов до и после обработки в водородной плазме
| Время обработки в плазме, мин | Эллипсометрические данные | ||||
|---|---|---|---|---|---|
| d, нм | n, (E = 1.96 эВ) | параметры модели Коши | |||
| a | b, ×10–3 | c, ×10–4 | |||
| 0 | 40.3 | 1.462 | 1.447 | 3.970 | –0.166 |
| 15 | 40.4 | 1.473 | 1.457 | 4.138 | –0.162 |
На рис. 4в показаны спектральные зависимости n(E) исследуемых образцов, полученные обработкой экспериментальных спектров Ψ(E), Δ(E). Видно, что обработка SiO2 в водородной плазме приводит к сдвигу спектра n(E) в область более высоких значений показателя преломления. После 15-мин обработки сдвиг спектра n(E) составлял ≈0.01. Увеличение показателя преломления пленки, как это было показано методом катодолюминесценции (см. ниже), определяется процессом частичного восстановления оксида с образованием нестехиометрического SiOx [3].
Для оценки параметра “х” в SiOx из оптических измерений была применена модель эффективной среды Бруггемана (2). Предположено, что нестехиометрический SiOx образуется в виде моноксида кремния SiO. Наилучшее совпадение с экспериментальными кривыми было достигнуто (красная пунктирная линия, см. рис. 4в) в том случае, когда доля SiO в слое составляла ~0.024, что позволило оценить значение “x”, которое оказалось равным ~1.96.
На рис. 5 показаны экспериментальные ВАХ структуры p-Si/SiOx/Ni, измеренные при различных температурах и различных полярностях потенциала на Ni. Нестехиометрический оксид SiOx был получен путем 15-минутной обработки SiO2 пленки в водородной ЭЦР плазме. Для аппроксимации экспериментальных результатов была использована модель фонон-облегченного туннелирования электронов между ловушками (модель Насырова–Гриценко) [28, 29].
Рис. 5.
Экспериментальные ВАХ структуры p-Si/SiOx/Ni, измеренные при различных температурах и различных полярностях потенциала на Ni, и расчетные кривые, полученные из модели Насырова–Гриценко. Точки – экспериментальные данные, линии – расчетные кривые.

Идея данной модели заключается в том, что электрон, находящийся в ловушке, переходит в возбужденное состояние и туннелирует в соседнюю ловушку при поглощении фононов. Установлено, что модель фонон-облегченного туннелирования между соседними ловушками непротиворечиво описывает перенос электронов в Ta2O5 [30], SiO2 [31], HfO2 [32], Hf0.5Zr0.5O2 [33], Si3N4 [34], Sc2O3 [35].
Выражение для вероятности фонон облегченного туннелирования и плотности тока имеет вид (3), (4):
(3)
$P = \frac{{2\sqrt \pi \hbar {{W}_{{\text{t}}}}}}{{m{\text{*}}{{s}^{2}}\sqrt {2kT\left( {{{W}_{{{\text{opt}}}}} - {{W}_{{\text{t}}}}} \right)} }}{{e}^{{ - \frac{{{{W}_{{{\text{opt}}}}} - {{W}_{{\text{t}}}}}}{{kT}}}}}{{e}^{{ - \frac{{2s\sqrt {2m{\text{*}}{{W}_{{\text{t}}}}} }}{\hbar }}}}\sinh \left( {\frac{{qFs}}{{2kT}}} \right),$На рис. 6а, б представлены вольт-фарадные характеристики (ВФХ) структуры p-Si/SiO2/Ni и n‑Si/SiO2/Ni для исходного образца с необработанным в плазме слоем термического SiO2. В этих структурах, практически, отсутствует гистерезис, что указывает на отсутствие электронных и дырочных ловушек в термическом SiO2.
Рис. 6.
ВФХ образцов p-Si/SiO2/Ni (а) и n-Si/SiO2/Ni (б), где слой термического SiO2 не подвергался обработке в ЭЦР плазме; ВФХ образцов p-Si/SiOx/Ni (в) и n-Si/SiOx/Ni (г). Обработка слоя SiOx в водородной ЭЦР плазме в течение 15 мин; ВФХ образцов p-Si/SiOx/Ni (д) n-Si/SiOx/Ni (е). Обработка слоя SiOx в водородной ЭЦР плазме в течение 30 мин.
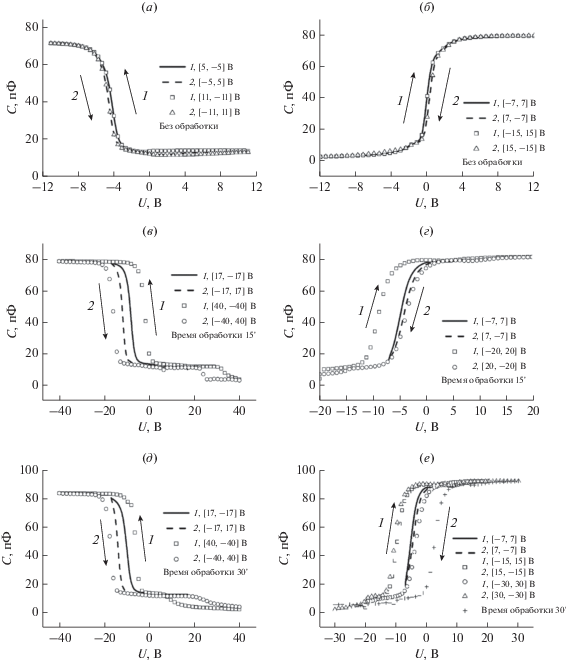
Обработка в плазме в течении 15 мин приводит к накоплению в диэлектрике электронов и дырок рис. 6в, г. Величина накопленного заряда увеличивается с возрастанием времени обработки в плазме, рис. 6д, е, обработка в данном случае проводилась в течение 30 мин. При больших обедняющих напряжениях имеет место переход емкости из режима инверсии в режим неравновесного обеднения. Это явление указывает на инжекцию неосновных носителей, электронов из кремния в диэлектрик. Гистерезис вольт-емкостных характеристик указывает на инжекцию и последующий захват электронов и дырок, т.е. проводимость SiOx является двузонной.
На рис. 7а, б представлены вольтамперные характеристики структур p-Si/SiO2/Ni и n-Si/SiO2/Ni для образцов со слоем термического SiO2. В режиме обогащения, ток для обоих образцов не зависит от подсветки внешним источником оптического излучения и экспоненциально растет с увеличением напряжения. На ВАХ образца p-Si/SiO2/Ni в режиме обеднения, при положительном потенциале на металле, наблюдается насыщение тока, уровень которого возрастает при включении подсветки. Как известно из [14] транспорт заряда в SiO2 лимитируется туннельной инжекцией Фаулера–Нордгейма носителей заряда из кремния в диэлектрик:
(5)
${{j}_{{{\text{FN}}}}} = \frac{{{{q}^{3}}{{m}_{0}}}}{{8\pi m{\text{*}}\Phi }}{{F}^{2}}{{e}^{{ - \frac{{8{{\pi }}\sqrt {2qm{\text{*}}} }}{{3q\hbar F}}{{\Phi }^{{{3 \mathord{\left/ {\vphantom {3 2}} \right. \kern-0em} 2}}}}}}}.$Рис. 7.
ВАХ образцов (а) p-Si/SiO2/Ni; (б) n-Si/SiO2/Ni. Пунктирными линиями показаны теоретические ВАХ по механизму Фаулера–Нордгейма; ВАХ образцов (в) p-Si/SiOx/Ni; (г) n-Si/SiOx/Ni. Обработка слоя SiOx в ЭЦР плазме производилась в течение 15 мин; ВАХ образцов (д) p-Si/SiOx/Ni; (е) n-Si/SiOx/Ni. Обработка слоя SiOx в ЭЦР плазме производилась в течение 30 мин. ВАХ получены в режиме обогащения – 1, в режиме неравновесного обеднения в темноте – 2 и с подсветкой – 3.

При положительном потенциале на кремнии, ВАХ структур p-Si/SiOx/Ni и n-Si/SiOx/Ni количественно описываются инжекцией дырок из кремния. Это обстоятельство обусловлено тем, что барьер для электронов на границе Ni-SiOx (4.04 эВ) больше барьера для дырок на границе Si-SiOx (3.6 эВ) рис. 1в, е.
На рис. 7в–е представлены вольтамперные характеристики структур p-Si/SiOx/Ni и n-Si/SiOx/Ni для образцов, обработанных в водородной плазме при разном времени обработки. Как уже было описано выше, транспорт заряда в таких образцах описывается моделью Насырова–Гриценко, рис. 5.
В режиме обогащения, ток не зависит от подсветки и экспоненциально растет с увеличением напряжения. В режиме обеднения, наблюдается насыщение тока, уровень которого возрастает при включении подсветки. Следовательно, по данным транспорта заряда, проводимость SiOx, обработанного в плазме является биполярной. Из отрицательно смещенного электрода (кремния) инжектируются электроны, из положительно смещенного электрода инжектируются дырки.
Инжекция дырок из кремния в SiOx объясняется уменьшением дырочного барьера на границе Si/SiOx. Обогащение кремнием сопровождается уменьшением электронного и дырочного барьеров на границе Si/SiOx. Для x = 1.96 эВ высота дырочного барьера составляет 3.6 эВ, что на 0.2 эВ меньше барьера для дырок на границе Si/SiO2 [5].
Спектры КЛ пленок оксида кремния измерялись до и после плазменной обработки (рис. 8а). Известно, что в видимом диапазоне наблюдаются три полосы, связанные с люминесценцией точечных дефектов в оксиде кремния. Полоса 1.9 эВ является немостиковым атомом кислорода [39], полоса 2.2 эВ не имеет однозначной интерпретации, однако это происходит при дефиците кислорода [40] и 2.7 эВ – кислородно-дефицитный центр (ODC – oxygen-deficiency center) [41]. В литературе в основном описываются две модели ODC: нейтральная кислородная вакансия ODC (I) [42] и двухкоординированная кремниевая ODC (II), обозначаемая как = Si: [42, 43].
Рис. 8.
(а) Спектры КЛ в видимом диапазоне пленок оксида кремния при различных временах обработки в плазме. (б) Спектр КЛ исходного образца (черная линия) с SiO2 пленкой, гауссовы кривые (красные линии) и их сумма (синяя линия); (в) зависимость интенсивности полос КЛ от содержания ловушек. (г) Спектры КЛ в УФ диапазоне пленок диоксида кремния при различных временах плазменной обработки; (д) зависимость интенсивности полосы КЛ 4.45 эВ от содержания ловушек.

На рис. 8б представлено разложение спектра КЛ для исходного образца с SiO2 пленкой на указанные выше три компоненты. Аналогично были разложены спектры КЛ для образцов прошедших обработку в водородной ЭЦР плазме. Изменение амплитуды гауссовых пиков показаны на рис. 8в. Концентрация ловушек Nt ранее была вычислена путем аппроксимации по модели фонон-облегченного туннелирования температурных зависимостей ВАХ МДП структур с соответствующими различным временам обработки слоями SiOx диэлектрика. Видно, что интенсивность полосы 2.7 эВ значительно изменяется, она достигает максимума при времени плазменной обработки 6 мин, затем наблюдается небольшое снижение интенсивности, которое может быть связано с концентрационным тушением. Интенсивность полос 1.9 и 2.2 эВ увеличивается после обработки в плазме в течение 2 мин и затем не изменяется с учетом ошибки определения интенсивности для этих полос.
Спектры КЛ в УФ-диапазоне представлены на рис. 8г. В этом диапазоне наблюдается полоса с максимумом 4.5 эВ, связанная с ODC [41]. Как и для полосы 2.7 эВ, до 6 мин обработки наблюдается увеличение интенсивности, а затем падение, что также может быть связано с концентрационным тушением. Таким образом, можно утверждать, что плазменная обработка приводит к дефициту кислорода в пленке диоксида кремния и увеличению интенсивности полос, связанных с центрами кислородного дефицита.
На рис. 9а, б представлены ВАХ МДП мемристорных структур p++-Si/SiOx/Ni, с толщиной SiOx равной 20 нм, на которых наблюдаются резистивные переключения. Время обработки функционального слоя (SiOx) в водородной ЭЦР плазме 6 и 15 мин, соответственно. Кривая 1 – соответствует начальной ВАХ МДП структур, в литературе такой процесс называют “формовкой”. В ходе формовки, структура переходит из начального состояния в состояние с низким сопротивлением (LRS). При повторной подаче напряжения той же величины, структура сохраняет состояние с низким сопротивлением. Для переключения состояния МДП структуры в состояние высокого сопротивления (HRS) необходимо подать напряжение обратной полярности – кривая 2. Аналогичным образом, для обратного переключения в состояние LRS необходимо приложить положительное напряжение – кривая 3. Такие переключения называют биполярными. Хорошо видно, что напряжение первого включения либо совпадает, либо меньше чем напряжение последующего переключения. Такие резистивные переключения называют бесформовочными.
ЗАКЛЮЧЕНИЕ
В объеме SiO2 кремния концентрация электронных и дырочных ловушек незначительная. Электронная и дырочная проводимость термического SiO2 описывается туннельным механизмом Фаулера–Нордгейма.
Обработка термического SiO2 в водородной плазме приводит к тому, что появляется гистерезис вольтемкостных характеристик, который указывает на наличие электронных и дырочных ловушек в SiOx. После обработки в плазме проводимость SiOx является биполярной, из отрицательно смещенного контакта в диэлектрик инжектируются электроны, из положительно смещенного контакта в диэлектрик инжектируются дырки. Этот результат следует из насыщения вольт-амперных характеристик в режиме неравновесного обеднения на кремнии n- и p-типов. Измерение вольтфарадных и вольтамперных характеристик структур p-Si/SiOx/Ni и n-Si/SiOx/Ni показало, что обработка в водородной ЭЦР плазме сопровождается существенным возрастанием концентрации точечных дефектов в диэлектрике. Учитывая, что водородная плазма восстанавливает оксиды, точечными дефектами, вероятно, являются вакансии кислорода. Данный результат подтверждается тем, что проводимость в таких структурах хорошо описывается моделью фонон-облеченного туннелирования. Из результатов моделирования получено, что энергии электронных и дырочных ловушекв SiOx одинаковы: Wt = 1.6 эВ, Wopt = 3.2 эВ, а концентрация ловушек зависит от времени обработки в плазме.
По результатам КЛ можно утверждать, что плазменная обработка приводит к дефициту кислорода в пленке SiOx и увеличению интенсивности полос, связанных с центрами дефицита кислорода.
На основе разработанной методики обработки SiO2 пленок в водородной ЭЦР плазме созданы ReRAM структуры, не нуждающиеся в операции формовки, что имеет большое практическое значение.
Работа выполнена при поддержке РНФ, проект № 19-19-00286, “Исследование и разработка бесформовочного мемристора на основе оксидных диэлектриков, обработанных в водородной плазме, для флеш-памяти нового поколения”. Авторы выражают благодарность Ю.А. Живодкову за помощь в проведении измерений в Центре коллективного пользования “Наноструктуры” ИФП СО РАН. За предоставление измерительного оборудования авторы благодарят ЦКП “ВТАН” НГУ.
Список литературы
Gritsenko V.A. Silicon Nitride on Si: Electronic Structure for Flash Memory Devices // Thin Films on Silicon: Electronic and Photonic Applications. 2017. P. 273–322.
Перевалов Т.В. и др. Наноразмерные флуктуации потенциала в SiOx, синтезированном плазмохимическим осаждением // Физика твердого тела. 2019. Т. 61. № 12. С. 2528–2535.
Кручинин В.Н. и др. Оптические свойства нестехиометрического оксида кремния SiOx (x < 2) // Оптика и спектроскопия. 2019. Т. 127. № 11. С. 769–773.
Кручинин В.Н. и др. Оптические свойства тонких пленок SiOx (x < 2), полученных обработкой термического диоксида кремния в водородной плазме // Оптика и спектроскопия. 2020. Т. 128. № 10. С. 1467–1472.
Карпушин А.А., Гриценко В.А. Электронная структура аморфного SiOx переменного состава // Письма в Журн. экспериментальной и теоретической физики. 2018. Т. 108. № 2. С. 114–118.
Lee H.Y. et al. Evidence and solution of over-RESET problem for HfOx based resistive memory with sub-ns switching speed and high endurance // 2010 International Electron Devices Meeting. IEEE, 2010. P. 19.7. 1–19.7. 4.
Wei Z. et al. Highly reliable TaOx ReRAM and direct evidence of redox reaction mechanism // 2008 IEEE International Electron Devices Meeting // IEEE. 2008. P. 1–4.
Diokh T. et al. Study of resistive random access memory based on TiN/TaOx/TiN integrated into a 65 nm advanced complementary metal oxide semiconductor technology // Thin Solid Films. 2013. V. 533. P. 24–28.
Способ изготовления активного слоя для универсальной памяти на основе резистивного эффекта: пат. 2611580 Рос. Федерация: МПК7 H 01 L 27/115 / Гриценко В.А., Алиев В.Ш., Исламов Д.Р., Воронковский В.А.; заявитель и патентообладатель ИФР СО РАН. – № 20150147121; заявл. 02.11.2015; опубл. 28.02.2017.
Voronkovskii V.A. et al. Phonon-assisted electron tunneling between traps in silicon oxide films treated in hydrogen plasma // J. Non-Crystalline Solids. 2020. V. 546. P. 120256.
Алиев В.Ш. Объемная аморфизация поликристаллических пленок V2O5 при низкотемпературном восстановлении в водородной плазме электронного циклотронного резонанса // Фундаментальные проблемы современного материаловедения. 2008. Т. 5. № 2. С. 11–14.
Lenzlinger M., Snow E.H. Fowler-Nordheim Tunneling into Thermally Grown SiO2 // J. Appl. Phys. 1969. V. 40. P. 278.
Насыров К.А., Гриценко В.А. Механизмы переноса электронов и дырок в диэлектрических пленках // Успехи физических наук. 2013. Т. 183. № 10. C. 1099–1114.
Hielscher F.H., Preier H.M. Non-equilibrium C-V and I-V characteristics of metal-insulator-semiconductor capacitors // Solid-State Electronics. 1969. V. 12. № 7. P. 527–538.
Quast W. Experimental determination of the ratio of injected hole current and total current in silicon nitride // Electronics Letters. 1969. V. 5. № 20. P. 485–487.
Гриценко В.А., Гиновкер А.С., Синица С.П. // Микроэлектроника. 1973. Т. 2. С. 283.
Gritsenko V.A., Meerson E.E. On silicon nitride conductivity // Phys. Stat. Sol. (a) 1980. V. 62. P. K131.
Islamov D.R., Gritsenko V.A., Cheng C.H., Chin A. Bipolar conductivity in amorphous HfO2 // Appl. Phys. Lett. 2011. V. 99. P. 072109.
Islamov D.R., Gritsenko V.A., Cheng C.H., Chin A. Bipolar conductivity in nanocrystallized TiO2 // Appl. Phys. Lett. 2012. V. 101. P. 032101.
Islamov D.R., Gritsenko V.A., Cheng C.H., Chin A. Evolution of the conductivity type in germania by varying the stoichiometry // Appl. Phys. Lett. 2013. V. 103. P. 232904.
Zamoryanskaya M.V., Konnikov S.G., Zamoryanskii A.N. A high-sensitivity system for cathodoluminescent studies with the Camebax Electron Probe Microanalyzer // Instruments and Experimental Techniques. 2004. V. 47. № 4. P. 477–483.
Гриценко В.А. и др. Строение и электронная структура a-SiNx: H // Журн. экспериментальной и теоретической физики. 2019. Т. 156. № 5. С. 1003–1015.
Кручинин В.Н. и др. Оптические свойства нестехиометрического оксида тантала TaOx (x < 5/2) по данным спектроэллипсометрии и комбинационного рассеяния // Оптика и спектроскопия. 2018. Т. 124. № 6. С. 777–782.
Adachi S. Optical constants of crystalline and amorphous semiconductors: numerical data and graphical information. Springer Science & Business Media, 1999.
Palik E.D. (ed.). Handbook of optical constants of solids. Academic press, 1998. V. 1. P. 798.
Tompkins H., Irene E.A. Handbook of ellipsometry. William Andrew, 2005.
Рыхлицкий С.В. и др. Сканирующий эллипсометрический комплекс МИКРОСКАН-3М // Приборы и техника эксперимента. 2009. № 3. С. 155–156.
Nasyrov K.A., Gritsenko V.A. Charge transport in dielectrics via tunneling between traps // J. Appl. Phys. 2011. V. 109. P. 097705.
Насыров К.А., Гриценко В.А. Перенос заряда в диэлектриках туннелированием между ловушками // Журн. экспериментальной и теоретической физики. 2011. Т. 139. № 6. С. 1172–1181.
Gritsenko V.A. et al. Charge transport and the nature of traps in oxygen deficient tantalum oxide // ACS Applied Materials & Interfaces. 2018. V. 10. № 4. P. 3769–3775.
Islamov D.R. et al. Mechanism of charge transport of stress induced leakage current and trap nature in thermal oxide on silicon // J. Physics: Conference Series. IOP Publishing, 2017. V. 864. № 1. P. 012003.
Gritsenko V.A., Perevalov T.V., Islamov D.R. Electronic properties of hafnium oxide: A contribution from defects and traps // Physics Reports. 2016. V. 613. P. 1–20.
Islamov D.R. et al. Charge transport in amorphous Hf0.5Zr0.5O2 // Applied Physics Letters. 2015. V. 106. № 10. P. 102906.
Gritsenko V.A., Gismatulin A.A., Chin A. Multiphonon trap ionization transport in nonstoichiometric SiNx // Materials Research Express. 2018. V. 6. № 3. P. 036304.
Lebedev M.S. et al. Optical properties and charge transport of textured Sc2O3 thin films obtained by atomic layer deposition // Applied Surface Science. 2019. V. 478. P. 690–698.
Lenzlinger M., Snow E.H. Fowler-Nordheim tunneling into thermally grown SiO2 // J. Applied physics. 1969. V. 40. № 1. P. 278–283.39.
Weinberg Z.A., Johnson W.C., Lampert M.A. High-field transport in SiO2 on silicon induced by corona charging of the unmetallized surface // J. Applied Physics. 1976. V. 47. № 1. P. 248–255.
Chanana R.K. et al. Fowler–Nordheim hole tunneling in p-SiC/SiO2 structures // Applied Physics Letters. 2000. V. 77. № 16. P. 2560–2562.
Skuja L. et al. Oxygen-excess-related point defects in glassy/amorphous SiO2 and related materials // Nuclear Instruments and Methods in Physics Research Section B: Beam Interactions with Materials and Atoms. 2012. V. 286. P. 159–168.
Ivanova E.V. et al. Growth of silicon nanoclusters in thermal silicon dioxide under annealing in an atmosphere of nitrogen // Semiconductors. 2016. V. 50. № 6. P. 791–794.
Imai H. et al. Two types of oxygen-deficient centers in synthetic silica glass // Physical Review B. 1988. V. 38. № 17. P. 12772.
Trukhin A.N. et al. Sub-band-gap-excited luminescence of localized states in SiO2–Si and SiO2–Al glasses // J. non-crystalline solids. 2010. V. 356. № 20–22. P. 982–986.
Fitting H.J. et al. Silicon nanocluster aggregation in SiO2:Si layers // Physica status solidi (a). 2010. V. 207. № 1. P. 117–123.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника