Микроэлектроника, 2022, T. 51, № 1, стр. 19-27
Ограничения методов оценки стойкости изделий микроэлектроники к одиночным радиационным эффектам на ускорителях ионов
А. И. Чумаков a, *, А. В. Согоян a, А. В. Яненко a
a Национальный исследовательский ядерный университет “МИФИ”, АО “ЭНПО СПЭЛС”
115409 Москва, Каширское шоссе, 31, Россия
* E-mail: aichum@spels.ru
Поступила в редакцию 23.02.2021
После доработки 15.05.2021
Принята к публикации 30.05.2021
- EDN: LPEQSZ
- DOI: 10.31857/S0544126922010045
Аннотация
Представлены результаты анализа ограничений на параметры пучков ионов при проведении экспериментальных исследований по оценке чувствительности СБИС к воздействию тяжелых заряженных частиц по одиночным радиационным эффектам. Обоснованы ограничения на пробеги ионов, банчевую структуру пучка ионов, возможностям изменения линейных потерь энергии за счет изменения угла падения ионов, типа ионов и использования ослабителей энергии.
1. ВВЕДЕНИЕ
Одиночные радиационные эффекты (ОРЭ), возникающие при воздействии отдельных ядерных частиц, являются наиболее значимым механизмом отказов и сбоев современных изделий микроэлектроники [1, 2]. Актуальность этой проблемы возрастает в связи с повышением чувствительности СБИС к этим эффектам, в первую очередь, из-за уменьшения пороговой энергии возникновения ОРЭ. Современные СБИС с проектными нормами менее 100 нм имеют пороговую энергию переключения на уровне долей МэВ (долей и единиц фКл), вследствие чего ОРЭ могут иметь место даже при фоновом нейтронном воздействии.
Современная система испытаний изделий ЭКБ на стойкость к воздействию тяжелых заряженных частиц (ТЗЧ) в части оценки чувствительности по ОРЭ базируется на определении зависимости сечений эффектов от значений линейных потерь энергии (ЛПЭ) [2]. При этом основное внимание уделяется области больших значений ЛПЭ ТЗЧ, которые должны быть на уровне 60–80 МэВ⋅ см2/мг. С учетом этого оценку чувствительности к эффектам воздействия ТЗЧ проводят на ускорителях ионов или лазерных установках пикосекундной длительности со сфокусированным излучением. Если для лазерных установок достаточно подробно определены ограничения на области применения и на сами параметры лазерного излучения [3, 4], то для ионных пучков подробная информация фактически отсутствует. В настоящей работе представлены результаты оценок на параметры ионного пучка, необходимые для адекватного определения параметров чувствительности изделий микроэлектроники к воздействию ТЗЧ по ОРЭ.
Как правило, оценка чувствительности изделий микроэлектроники к воздействию ТЗЧ по ОРЭ проводится на ускорителях ионов с разными значениями ЛПЭ. В ходе экспериментов определяется сечение ОРЭ σs при определенном значении ЛПЭ – Lz:
где Ns – количество зарегистрированных ОРЭ определенного типа при фиксированном флюенсе ионов Φz(Lz) с известным значением ЛПЭ. В ряде случаев для увеличения значений ЛПЭ проводится облучение под углом. При этом предполагается, что эффективное значение ЛПЭ увеличивается по закону обратного косинуса.Наиболее важный для оценки параметров чувствительности БИС к эффектам воздействия ТЗЧ диапазон значений ЛПЭ лежит в пределах 10–100 МэВ⋅ см2/мг. В силу особенностей взаимодействия ионов с веществом на ускорителях ионов значения ЛПЭ более 50 МэВ⋅ см2/мг достигаются при значениях их энергии в районе 3–10 МэВ/нуклон. При таких сравнительно небольших энергиях пробеги средних и тяжелых ионов в кремнии варьируются от 30 до 100 мкм. Эти ограничения, с одной стороны, однозначно приводят к необходимости декапсулирования изделия микроэлектроники и проведения процедуры облучения в вакууме. Остается открытым вопрос учета потерь в защитных покрытиях микросхем и металлизации. Толщина системы медной металлизации в современных КМОП СБИС может превышать 10 мкм, что с точки зрения величины пробега ТЗЧ эквивалентно более, чем 20 мкм кремния. С другой стороны, существуют изделия ЭКБ с толщиной чувствительной области на уровне 100 мкм и больше. Поэтому для ряда изделий, в частности, высоковольтных МОП транзисторов, толщина чувствительной области может превышать остаточные пробеги ионов. Остается открытым вопрос, какое в этом случае использовать значение ЛПЭ.
Не решен вопрос и о возможности воздействия ионов с донной стороны кристалла, например, для изделий с перевернутыми кристаллами в корпусах BGA. Методики утонения подложки на данном этапе должным образом не обоснованы, так как подобная процедура может приводить не только к потере функционирования в динамическом режиме из-за нарушения теплового сопротивления, но и к изменению процессов собирания заряда с трека ТЗЧ.
Затронутые выше вопросы известны, хотя окончательных решений по ним до сих пор нет. При этом вне рамок обсуждения остается проблема импульсной временной структуры пучка ионов.
2. ОЦЕНКА ВЛИЯНИЯ ИНТЕНСИВНОСТИ
С точки зрения временной структуры пучка можно выделить три типовых случая:
– микробанчевая структура пучка, формируемая оборудованием ионных ускорителей (СВЧ- накачка);
– импульсный характер пучка, сформированного на выходах ряда установок;
– сканирование пучка с небольшим диаметром по большой площади зоны облучения.
Оценку влияния интенсивности ионного пучка необходимо проводить с учетом двух основных факторов:
– отсутствие эффектов “двойного” попадания ионов в одну и ту же чувствительную область за время формирования ОРЭ;
– отсутствие влияния эффектов мощности поглощенной дозы, формируемой потоком ТЗЧ (по аналогии с воздействием импульса гамма-излучения [2]).
Учет первого фактора проводится достаточно просто. Необходимо обеспечить, чтобы в одну и ту же чувствительную область элемента СБИС не попало одновременно два иона за время формирования ОРЭ. В этом приближении, с одной стороны, необходимо определить размеры чувствительной области As, а с другой,τs – время, в течение которого двойного попадания не должно быть. Таким образом, ограничения на максимальную плотность потока ионов φzmx можно записать в следующем виде:
Величина As может быть оценена через сечение насыщение ОРЭ для отдельного чувствительного элемента, и в качестве консервативного значения для СБИС ее можно принять равной не более 1000 мкм2 (площадь одного кармана). Значениеτs определятся временем формирования ионизационной реакций для возникновения конкретного ОРЭ, и ее величина не превышает 1 мкс для большинства элементов СБИС. Только для изделий микроэлектроники, которые построены по принципу интегрирования заряда (ячейки динамической памяти, элементы ПЗС матрицы и ряд других ИС), это время определяется условиями функционирования, например, временем интегрирования в ЦАП, частотой кадра в ПЗС и т.п. С учетом этих ограничений можно утверждать, что для большинства изделий микроэлектроники максимальная плотность потока частиц не должна превышать 109 ион/(см2 ⋅ с), а для ряда изделий, использующих принцип работы на основе интегрирования заряда – не более 105 ион/(см2 ⋅ с).
Более существенное ограничение может быть связано с микробанчевой структурой ионного пучка (рис. 1). Например, для линейного ускорителя ионов типа HILAC [5] длительность импульса составляет Тp = 10 мкс при частоте их следования до 10 Гц. При этом сам выходной импульс имеет микробанчевую структуру с частотой наполнения около 100 МГц.
Рис. 1.
Временная структура пучка: Тp – длительность импульса, Т0 – длительность отдельного импульса в банче, Т – интервал между импульсами.

Оценка уровня стойкости к подобным импульсам может быть приведена на основе асимптотической модели, с помощью которой уровень сбоеустойчивости (мощности поглощенной дозы Pc) СБИС при заданной длительности импульса Tp оценивается с помощью соотношения [6]:
(3)
${{P}_{c}}\left( {{{T}_{p}}} \right) = {{P}_{{c\infty }}}{{\left[ {1 + {{{\left( {\frac{{{{\tau }_{s}}}}{{{{T}_{p}}}}} \right)}}^{{1/v}}}} \right]}^{v}},$Интересно отметить, что по мере увеличения степени интеграции СБИС, несмотря на увеличение быстродействия входящих в нее элементов, характерное время τs, как правило, возрастает. Подобное поведение в некоторой степени объясняется интегрированной ионизационной реакцией СБИС по цепи питания из-за роста суммарной емкости микросхемы [7], которая при площади кристалла около 1 см2 достигает значений 10 нФ и более.
Однако применение соотношения (3) для импульсов сложной формы в ее первоначальном виде не представляется возможным, а процедура разбиения их на несколько более простых форм [8] не всегда очевидна. Более оправданным, на наш взгляд, является применение сверток, несмотря на то, что этот аппарат применим только для линейных моделей. Можно ожидать, что это ограничение не существенно, так как соотношение (3) применимо как к линейным, так и к нелинейным эффектам. В этом приближении оценка параметра U(t) будет производиться с помощью следующего соотношения:
(4)
$U\left( t \right) = {{k}_{U}}{{P}_{m}}\mathop \smallint \limits_0^t f\left( {t - x} \right)h\left( x \right)dx,$(5)
$h\left( t \right) = {{\left[ {1 + \left( {\frac{{{{\tau }_{s}}}}{t}} \right)} \right]}^{{ - v - 1}}}{{\left( {\frac{{{{\tau }_{s}}}}{t}} \right)}^{{1 + 1/v}}}.$Величина порогового уровня мощности дозы для возникновения массовых сбоев при заданной форме импульса ионизирующего излучения определяется из условия достижения U(t) некоторой критичной величины. Это может быть напряжение отпирания закрытого p-n перехода, уровень помехоустойчивости логического элемента, амплитуда скачка напряжения в цепи питания и т.п. Типичное значение этой величины для СБИС лежит около 1 В.
На рис. 2 в качестве примера представлены изменения U(t) при воздействии прямоугольного импульса с банчевым заполнением с частотой 100 МГц и двух разных значениях характерной постоянной времени ионизационной реакции: 30 и 200 нс. Несмотря на микробанчевую структуру заполнения импульса, с приемлемой для практики точностью можно ориентироваться на его огибающую, что позволяет использовать для оценок соотношение (3). Другими словами, для определения влияния эффектов мощности дозы на установках типа HILAC можно ориентироваться только на общую огибающую импульса ионов с учетом полной энергии в импульсе.
Рис. 2.
Формирование ионизационной реакции при воздействии синусоидального импульса частотой 100 МГц и длительностью 250 нс при двух постоянных времени ионизационной реакции ИС.

Оценка допустимой плотности потока ионов φz при сделанных предположениях производится из соотношения:
(6)
${{P}_{{mc}}} = 1.6 \times {{10}^{{ - 5}}}{{L}_{z}}{{\varphi }_{z}},\,\,\,\,{\text{рад}}({\text{Si}}){\text{/с}},$Таким образом, для оценки максимальной и средней плотности потока ионов с известными значениями ЛПЭ необходимо еще определиться с параметрами τs и Dco. В современных СБИС величина Dco лежит в районе единиц рад(Si), а значение τs, как было отмечено, варьируется в достаточно широких пределах и зависит от технологии изготовления СБИС, функционального назначения, проектных норм и ряда других. Например, в КНИ малой степени интеграции оно может быть в районе единиц нс, а для ПЛИС с проектными нормами 28 нм оно может достигать величины порядка 10 мкс.
На рис. 3 представлены ограничения на максимальную плотность потока разных ионов с энергиями 3.2 МэВ/нуклон в зависимости от постоянной времени ионизационной реакции при длительности импульса 10 мкс, частоте следования 10 Гц и Dco = 1 рад(Si). Очевидно, что в подобной ситуации ограничения на максимальную плотность потока не будут меняться даже, если средняя плотность потока будет увеличиваться за счет роста частоты следования импульсов до десятков кГц. Как и следовало ожидать, наиболее жесткие ограничения накладываются на ионы золота, как заряженной частицы с максимальными значениями ЛПЭ. Если принять значения Dco = 3 рад(Si) и τs = 300 нс, то максимальная плотность потока в одном макроимпульсе не может быть более 6 × 109 частиц/(с ⋅ см2) для ионов золота с энергией 3.2 МэВ/нуклон.
3. ОЦЕНКА ВЛИЯНИЯ ПРОБЕГОВ
Другим важным фактором, влияющим на результаты оценки стойкости СБИС, являются короткие пробеги ионов. Как было отмечено, для обеспечения максимальных значений ЛПЭ в районе 40–80 МэВ ⋅ см2/мг при проведении испытаний приходится применять ионы с энергиями, немного превышающими пик Брэгга (рис. 4 ). Уход в большие значения приводит к заметному снижению значений ЛПЭ. Даже переход на энергии в районе 25 МэВ/нуклон приводит к тому, что при облучении ионами криптона обеспечивается величина чуть менее 19 МэВ ⋅ см2/мг при пробегах около 300 мкм. При облучении ионами золота ЛПЭ будет ~65 МэВ ⋅ см2/мг с пробегами 280 мкм.
Использование ионов с небольшими энергиями приводит к малым значениям пробегов. Как несложно заметить (рис. 4 ), для тяжелых ионов пробеги вблизи пика Брэгга лежат в районе 30–100 мкм. Применение ионов с пробегами меньшими, чем 30 мкм для СБИС следует исключить из-за очень большой неопределенности в получаемых значениях ЛПЭ. Действительно, как указывалось выше, в современных СБИС эквивалентная толщина системы металлизации по кремнию может достигать 20 мкм (это линия выделена на рис. 4 ). В этом случае даже при облучении ионами с пробегами 40 мкм неопределенность по ЛПЭ может достигать ±30%.
Поэтому при облучении ионами высоких энергий (более 30–50 МэВ/нуклон) для обеспечения требуемых значений ЛПЭ приходится уменьшать энергию (обычно с помощью ослабителей). При использовании ослабителей с толщиной на уровне пробега иона сильное влияние будет оказывать разброс пробегов (страгглинг), который обычно составляет величину около 4% от среднего значения пробега. Чтобы этот эффект сильно не влиял, необходимо выбирать толщину ослабителя меньше минимум на (2–3) величины страгглинга от полного пробега. Второй значимый фактор наряду с расширением спектра ЛПЭ – это генерация вторичных частиц в ослабителе, которые способны повлиять на результаты экспериментальных исследований [9]. Анализ показывает, что влияние вторичных частиц и разброс в пробегах будет оказывать несущественное влияние при уменьшении исходной энергии иона не более чем в (4–6) раз (рис. 5).
Рис. 5.
Распределение ЛПЭ (в кремнии) ионов аргона с начальной энергией 250 МэВ/нуклон после прохождения титанового окна толщиной 100 мкм и ослабителей из полиэтилена различной толщины d (расчет GEANT).
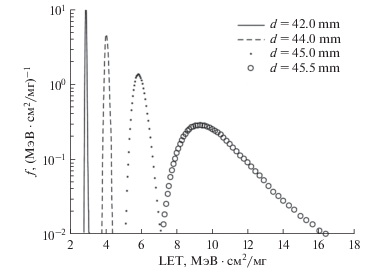
Поэтому в практике радиационных испытаний наиболее широко используются источники ионов с относительно небольшими энергиями в районе 3–10 МэВ/нуклон, что приводит к необходимости проведения испытаний в вакууме. Однако возникает вопрос, что делать со СБИС, конструктивное исполнение которых не позволяет обеспечить доступ ионов с такими энергиями к чувствительным объемам. Наиболее яркий пример – микросхемы в BGA корпусах с перевернутым кристаллами. Очевидное решение за счет увеличения энергии ионов на практике не реализуемо из-за отсутствия в РФ ускорителей с энергиями более 50 МэВ/нуклон.
Одно из возможных решений – утонение подложки. Однако при этом возможны побочные эффекты, в частности, увеличения сопротивления подложки, изменение ионизационной реакции за счет меньшей толщины и ряд других. Проведенные оценки показали, что утонение подложки вплоть до 30–50 мкм не приводит к заметным изменения сопротивления подложки, а изменение ионизационной реакции может иметь место только для схем с большими значениями постоянной времени τs (более 300–500 нс) (рис. 6). Последний вывод имеет простое физическое объяснение. Граничные условия будут оказывать влияние на формирование ионизационной реакции, как только процесс диффузии их “почувствует”, т.е. за времена порядка $ \sim {\kern 1pt} W_{n}^{2}{\text{/}}{{D}_{n}}$, где Wn – толщина утоненной подложки, Dn – коэффициент диффузии.
Рис. 6.
Ионизационный ток для перехода карман – подложка при воздействии излучения пикосекундной длительности с шириной области облучения 2 мкм при двух толщинах подложки: 50 и 500 мкм.
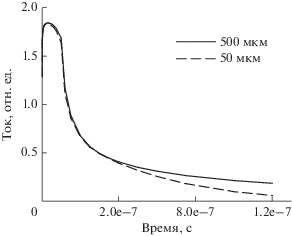
Более существенным фактором является изменение условий теплообмена. Действительно, только за счет сокращения толщины подложки со значения Wp до Wn, фактически происходит снижение теплоемкости кристалла в Wp/Wn раз. Кроме того происходит нарушение теплового контакта с корпусом СБИС. Таким образом, даже уменьшение толщины в 3 раза может существенно ухудшить условия теплообмена кристалла, что приводит к заметному увеличению его температуры при протекании больших токов.
Значительные токи в цепи питания имеют место в динамическом режиме работы, поэтому облучение СБИС с утоненной подложкой на предельных частотах фактически невозможно из-за возможных отказов вследствие значительного увеличения температуры. Но именно динамический режим работы СБИС является наиболее критичным режимом при оценке стойкости СБИС к эффектам одиночных и функциональных сбоев при воздействии ТЗЧ.
Другое ограничение связано с оценкой стойкости СБИС в статическом режиме в поле ионов на чувствительность к тиристорным эффектам или эффектам лавинного пробоя. Возникающие в состоянии тиристорного эффекты токи способны также вызвать разрушение утоненного кристалла, тогда как в обычном кристалле этого эффекта может не быть.
Другая потенциальная опасность связана с возможностью перехода тиристорного эффекта в нестационарное состояние [10]. Действительно, условия возникновения ОРЭ на начальной стадии слабо зависят от толщины подложки. Однако по мере формирования ионизационной реакции от всего кристалла за времена ~1 мкс даже без учета большего разогрева кристалла СБИС для не утонённой подложки возможен срыв тиристорного эффекта за счет “просадки” питания, тогда как этот эффект потенциально может отсутствовать в СБИС с малой толщиной подложки.
Тем не менее, в случае утонения подложки, основным эффектом, который способен привести к неадекватности эффектом, является изменение температуры кристалла. Разогрев кристалла с одной стороны приводит к уменьшению порога возникновения тиристорного эффекта, а с другой – к появлению катастрофических отказов.
4. ВЛИЯНИЕ УГЛА ПАДЕНИЯ ИОНОВ
В настоящее время на практике для увеличения эффективных значений ЛПЭ широко применяется облучение под углом. При этом считается, что эффективное значение ЛПЭ Lz_ef меняется по закону обратного косинуса:
где θ – угол падения ТЗЧ на поверхность кристалла СБИС.Анализ в рамках диффузионной модели [11, 12] показывает два существенных ограничения. Во-первых, максимальное изменение эффективного значения ЛПЭ при увеличении угла θ [11, 12] не превосходит приблизительно двух раз, тогда как выражение (7) позволяет формально получить неограниченные значения. Во-вторых, вблизи порогового значения ЛПЭ могут сильно проявляться анизотропные эффекты из-за неоднородности технологических структур (протяженных карманов, наличие диэлектрической изоляции и т.п.). С учетом этих ограничений, как показывает анализ, пользоваться соотношением (7) можно при углах падения частиц менее 60° и при исходных значений ЛПЭ Lz не менее, чем в 1.5 раза, превышающих пороговую величину.
5. ВЫБОР ТИПА ИОНА
На сегодняшний день принято считать, что чувствительность СБИС по ОРЭ определяется только значениями ЛПЭ ТЗЧ. Данное предположение достаточно хорошо работает в области относительно больших значений ЛПЭ, когда сечение ОРЭ отличается от своего максимального значение не более чем на два порядка. Однако в области небольших значений ЛПЭ при облучении ионами наблюдается “хвост”, который уходит в область значений ЛПЭ меньших, чем асимптотическое значение порога (рис. 7).
Рис. 7.
Типовая зависимость сечений ОРЭ от ЛПЭ при облучении сфокусированным лазерным лучом (L) и ионами разной энергии; E1/A1 < E2/A2, где A1, A2 – атомные номера ионов.
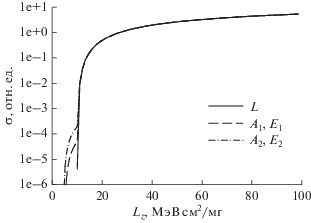
Причина подобного поведения обусловлена появлением вторичных ядерных частиц при взаимодействии иона с конструкционными материалами СБИС. Например, при облучении ионами неона со значениями ЛПЭ 5 МэВ ⋅ см2/мг образуются ионы кремния, у которых ЛПЭ может достигать величины 15 МэВ ⋅ см2/мг. Поэтому при значении порога в диапазоне 5 МэВ ⋅ см2/мг < Lzo < 15 МэВ ⋅ см2/мг и будет наблюдаться “хвост”. В рассматриваемом примере, чем больше исходное значение энергии налетающего иона на нуклон, тем выше вероятность подобного эффекта (рис. 7). При облучении ионами со значением атомного номера больше чем кремний подобный эффект будет проявляться из-за зависимости ЛПЭ от энергии иона и появления вторичных частиц – продуктов ядерных реакций .
Представленный пример характерен для микросхем не очень высокой степени интеграции. В современных СБИС используется широкий набор элементов с относительно большими атомными номерами (титан, молибден, медь и другие). Анализ показывает, что в СБИС наибольшее влияние будут оказывать вторичные ядерные частицы, образующиеся в результате ядерных реакций в слоях меди, так как они наиболее близко расположены к чувствительным областям элементов СБИС.
На рис. 8 показаны результаты расчета спектра вторичных частиц, образующихся в медной металлизации ИС при воздействии иона Ni с энергией 325 МэВ. Расчет проводился для системы металлизации, содержащей 85% Cu и 15% SiO2 (по массе) с помощью пакета GEANT в рамках системы моделей QGSP_BIC. Отметим существенную долю вторичных частиц с ЛПЭ, превышающей ЛПЭ первичного иона (26.3 МэВ ⋅ см2/мг в кремнии).
Рис. 8
. Спектр ЛПЭ тяжелых частиц (Z > 2), образующихся в медной металлизации ИС (а) и выходящих из металлизации в подложку (б) при воздействии иона Ni с энергией 325 МэВ (ЛПЭ в кремнии – 26.3 МэВ ⋅ см2/мг). Количество вторичных частиц, выходящих в подложку – 9.4 × 10–5 частиц на первичный ион Ni. Выход частиц с ЛПЭ, превышающий ЛПЭ первичного иона – 6.4 ×10–5.

В общем случае учет влияния вторичных частиц расчетным путем затруднителен, поскольку требует информации о топологии ИС и параметрах, отвечающих за собирание заряда активным элементом. Поэтому целесообразно исключить либо максимально снизить влияние подобного эффекта на экспериментальные результаты. Получить “истинную” зависимость сечений ОРЭ от ЛПЭ в этом случае возможно двумя способами: либо использование лазерных методов, если они применимы, либо проводить обучение тяжелыми ионами во всем диапазоне изменений ЛПЭ, что потребует перехода на ускорители ионов с энергиями более 100 МэВ/нуклон. В данном случае под тяжелыми ионами подразумеваются ионы, атомный номер которых превышает атомные номера наиболее критичных химических элементов, входящих в состав микросхемы. Для современных СБИС необходимо выбирать ионы, имеющие атомный номер выше, чем медь, например, ионы криптона, золота и т.п.
6. ЗАКЛЮЧЕНИЕ
Результаты представленной работы позволяют выделить следующие ограничения на применение ионных пучков для оценки параметров чувствительности СБИС по одиночным радиационным эффектам:
– импульсная структура пучка ограничивает максимальную плотность потока ионов из-за возможных эффектов мощности дозы. Эта величина зависит как от исходных ионов, так и от длительности всего банча. Микробанчевая структура пучка не оказывает заметного влияния;
– для СБИС при облучении со стороны приборного слоя пробеги ионов должны быть не менее 30 мкм;
– утонение подложки позволяет облучать СБИС с тыльной стороны, но только в статическом режиме ее работы. Минимальная толщина слоя определяется постоянной времени ионизационной реакции. Потенциально в утоненных структурах могут наблюдаться катастрофические отказы, которые отсутствуют при облучении со стороны приборного слоя;
– изменение значений ЛПЭ за счет использования ослабителей энергии возможно в диапазоне не более чем в 2–3 раза. При использовании более толстых ослабителей необходимо принимать во внимание наличие вторичных ядерных частиц и немонохромность спектра ЛПЭ;
– увеличение эффективных значений ЛПЭ за счет облучения под углом возможно при условии, что угол падения не превышает 60°, а исходные значения ЛПЭ не менее чем в 1.5 раза превышают пороговые значения ЛПЭ для возникновения ОРЭ;
– при облучении ионами сечение ОРЭ может распространится в область значений ЛПЭ, меньших чем порог, что связано с влиянием вторичных ядерных частиц. Облучение тяжелыми ионами во всем диапазоне изменений ЛПЭ в ряде случаев позволяет уменьшить влияние этого эффекта.
Список литературы
Чумаков А.И. Действие космической радиации на ИС. М.: Радио и Связь. 2004, 320 с.
Радиационная стойкость изделий ЭКБ: Научное издание // под ред. А.И. Чумакова. М.: НИЯУ МИФИ. 2015, 512 с.
Чумаков А.И. Возможности и ограничения лазерных методов при оценке параметров чувствительности БИС к эффектам воздействия тяжелых заряженных частиц // Безопасность информационных технологий. 2019. Т. 26. № 3. С. 58–67.
Маврицкий О.Б., Чумаков А.И., Егоров А.Н., Печенкин А.А., Никифоров А.Ю. Технические средства проведения лазерных испытаний полупроводниковых элементов на стойкость к воздействию тяжелых заряженных частиц (Обзор) // Приборы и техника эксперимента. 2016. № 5. С. 5–29.
https://nica.jinr.ru/ru/projects/injection.php
Чумаков А.И., Гонтарь В.В. Прогнозирование уровней отказов и сбоев ИС при воздействии ионизирующего излучения с произвольной формой импульса // Микроэлектроника. 2004. Т. 33. № 2. С. 134–141.
Чумаков А.И. Моделирование эффекта “просадки” питания в ИС при воздействии импульса ионизирующего излучения // Микроэлектроника, 2006. T. 35. № 3. C. 184–190.
Чумаков А.И., Гонтарь В.В. Оценка уровней сбоев интегральных схем при воздействии последовательности импульсов ионизирующего излучения // Микроэлектроника. 2006. Т. 35. № 3. С. 178–183.
Бутенко А.В., Сыресин Е.М.,Тютюнников С. И., Батяев В.Ф., Кулевой Т.В., Павлов К.В., Рогов В.И., Титаренко А.Ю., Титаренко Ю.Е., Берлянд В.А., Соболевский Н.М., Бобровский Д.В., Чумаков А.И., Сабуров В.О., Соловьев А.Н., Пешич М.П. Анализ проблем метрологического обеспечения испытательного стенда для проведения испытаний радиоэлектронных изделий на стойкость к воздействию тяжелых ионов высокой энергии // Письма в журнал физика элементарных частиц и атомного ядра. 2019. Т. 16. № 6. С. 522–534.
Чумаков А.И., Бобровский Д.В., Печенкин А.А., Савченков Д.В., Сорокоумов Г.С., Швецов-Шиловский И.И. Механизмы возникновения нестабильных тиристорных эффектов в КМОП ИС // Микроэлектроника. 2019. Т. 48. № 4. 2019. С. 295–299.
Согоян А.В., Чумаков А.И. Диффузионная модель ионизационной реакции элементов БИС при воздействии ТЗЧ // Микроэлектроника, 2017. Т. 46. № 4. С. 305–312.
Sogoyan A.V., Chumakov A.I., Smolin A.A. SEE rate estimation based on diffusion approximation of charge collection // Nuclear Instruments and Methods in Physics Research, Section B: Beam Interactions with Materials and Atoms. 2018. V. 418. № 3. P. 87–93.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника