Микроэлектроника, 2021, T. 50, № 4, стр. 264-273
Применение метода спектральной эллипсометрии для исследования процессов атомно-слоевого осаждения
А. В. Мяконьких a, *, Е. А. Смирнова a, И. Э. Клементе a
a Федеральное государственное бюджетное учреждение науки Физико-технологический институт
им. К.А. Валиева Российской академии наук
117218 Москва, Нахимовский пр-т, 36/1, Россия
* E-mail: miakonkikh@ftian.ru
Поступила в редакцию 23.12.2020
После доработки 04.01.2021
Принята к публикации 21.01.2021
Аннотация
Исследованы возможности метода спектральной эллипсометрии для прецизионных измерений при разработке и исследовании технологических процессов атомно-слоевого осаждения в микроэлектронике. Показана применимость метода для тонких диэлекрических слоев приборов микроэлектроники. Приведены результаты измерений in situ для процессов плазмостимулированного атомно-слоевого осаждения оксидов алюминия, тантала, гафния и циркония на поверхности монокристаллического кремния (100). Точность метода позволяет измерять скорость роста за цикл и наблюдать адсорбцию прекурсора и его десорбцию в зависимости от температуры образца. Полученные результаты могут быть применены для оптимизации и теоретических исследований процессов атомно-слоевого осаждения диэлектриков в высокоаспектные структуры.
ВВЕДЕНИЕ
Развитие технологии производства ультрабольших интегральных схем (УБИС) ведет к планомерному уменьшению толщин слоев применяемых диэлектриков и металлов, а также барьерных слоев, при этом требования по однородности таких покрытий по пластине с ростом диаметра пластин неуклонно возрастают [1]. В последнее десятилетие эти тенденции привели к стимулированию внедрения в технологию производства УБИС метода атомно-слоевого осаждения [2]. Этот метод, несмотря на высокую однородность и конформность осаждаемых покрытий, характеризуется значительными трудностями при разработке процессов. К ним относятся задержка нуклеации, специфичность получаемых результатов в зависимости от нижележащего слоя [3].
Понимание процессов, происходящих на поверхности подложки во время осаждения моноатомного слоя, необходимо для оптимизации существующих и разработки новых процессов атомно-слоевого осаждения (atomic layer deposition, ALD). Процесс ALD основан на чередовании экспозиции поверхности парами прекурсоров и сореагентов, что приводит к самоограничивающимся поверхностным реакциям. Повторение этих воздействий в циклах ALD позволяет производить послойное осаждение с точным контролем толщины, высокой однородностью на больших пластинах и беспрецедентной конформностью на наноструктурированных поверхностях. Процессы ALD сильно зависят от химии поверхности, что приводит к необходимости изучения начальных стадий роста на разных материалах подложки.
Начальные стадии роста пленки и проявляющаяся при этом задержка нуклеации также представляют интерес в задаче исследования и оптимизации процессов селективного атомно-слоевого осаждения (area selective atomic layer deposition, ASD). Этот процесс возможен, если процесс ALD приводит к немедленному росту на поверхности одного материала, в то время как существует задержка зародышеобразования на поверхностях других материалов, присутствующих в том же образце.
Исследования селективного атомно-слоевого осаждения в первую очередь были сфокусированы в основном на формировании рисунка в структурах, выращенных методом ALD, для приложений наноэлектроники. Нанося материал только там, где это необходимо, можно синтезировать наноструктуры без необходимости в дополнительных этапах субтрактивной обработки, таких как травление или взрывная литография (lift-off). В последние годы процесс селективного осаждения привлек к себе повышенное внимание в полупроводниковой промышленности в основном из-за его потенциального применения в подходах формирования самосовмещенных наноструктур [4].
В случае, когда количества латентных циклов недостаточно, применяется плазменная реактивация поверхности. В этом случае используется суперцикл, в котором после повторения нескольких циклов ALD происходит цикл плазменной обработки, позволяющий отложить нуклеацию еще на какое-то время [5], таким образом можно обеспечить селективность осаждения близкую к бесконечности.
В настоящей работе спектральная эллипсометрия (СЭ) [4] была использована как неразрушающий оптический метод, применимый для измерения in situ: без прерывания технологического процесса, изменения температуры образца, разрыва вакуума. Образец не требует специальной подготовки для измерения методом СЭ. Высокая чувствительность СЭ к толщине пленки и оптическим свойствам материала позволяет измерять толщину с точностью до монослоя и различать пленки разных материалов [5, 6]. Таким образом, эллипсометрия может быть применена, чтобы наблюдать in situ рост пленки и кинетику десорбции прекурсора в процессе ALD. Это может иметь решающее значение для осаждения пленок на боковых стенках и дне тренчей (канавок) с высоким аспектным отношением, поскольку обычно в таких процессах для компенсации затрудненного транспорта активных частиц в глубокую часть тренча время дозирования прекурсоров значительно увеличивают.
Существует широкий ряд методов исследования тонких пленок ex situ, такие как просвечивающая электронная микроскопия, рентгеновская дифракция и рефлектометрия, резерфордовское обратное рассеяние и др. Среди методов, применение которых возможно in situ, можно отметить кварцевые микровесы и рентгеновскую фотоэлектронную спектроскопию.
В настоящей работе начальная стадия процессов осаждения оксидов гафния, циркония, алюминия и тантала изучалась методами спектральной эллипсометрии в плазмостимулированном процессе ALD [7]. Процесс осаждения оксида алюминия является в некотором смысле базовым и наиболее изученным в технологии атомно-слоевого осаждения и исследуется для верификации результатов. Оксиды HfO2, ZrO2, Ta2O5 перспективны для разработки мемристорных устройств, и разработка методов in situ диагностики осаждения таких слоев является актуальной задачей.
СПЕКТРАЛЬНАЯ ЭЛЛИПСОМЕТРИЯ ДЛЯ ПРОЦЕССОВ АТОМНО-СЛОЕВОГО ОСАЖДЕНИЯ
Эллипсометрия – поляризационно-оптический метод исследования поверхностей, границ раздела и объемных сред, основанный на анализе изменения поляризации света при его взаимодействии с исследуемым образцом [7, 8]. Экспериментальная реализация эллипсометрии и ее теоретические основы достаточно хорошо разработаны [9]. Термин “эллипсометр” (от которого происходит название метода эллипсометрии) впервые был введен Ротеном [10] для обозначения оптического прибора, позволяющего измерять параметры тонких пленок путем анализа поляризации отраженного света. Обычно под эллипсометрией понимают анализ изменения поляризации отраженного света (отражательная эллипсометрия), хотя изменения поляризации можно наблюдать и в проходящем свете (эллипсометрия пропускания, поляриметрия).
Физические основы метода определяются тем, что общем случае, линейно поляризованный свет при отражении от исследуемого образца становится эллиптически поляризованным. Параметры эллипса поляризации определяются комплексными коэффициентами отражения:
(1)
${{R}_{p}} = \frac{{{{E}_{{p~{\text{ОТР}}}}}}}{{{{E}_{{p~{\text{ПАД}}}}}}} = {{r}_{p}} \cdot {{e}^{{i{{{{\Delta }}}_{p}}}}};\,\,\,\,{{R}_{s}} = \frac{{{{E}_{{s~{\text{ОТР}}}}}}}{{{{E}_{{s~{\text{ПАД}}}}}}} = {{r}_{s}} \cdot {{e}^{{i{{{{\Delta }}}_{s}}}}}.$(2)
$\rho = {\text{tg}}~{{\Psi }} \cdot {{e}^{{i{{\Delta }}}}} = \frac{{{{R}_{{p~}}}}}{{{{R}_{s}}}},$(3)
${\text{tg}}~{{\Psi }} = \frac{{{{r}_{{p~}}}}}{{{{r}_{s}}}};\,\,\,\,{{\Delta }} = {{{{\Delta }}}_{p}} - {{{{\Delta }}}_{s}}.$Параметры Ψ и Δ называются эллипсометрическими параметрами (углами), ρ – комплексным
эллипсометрическим параметром. Физический смысл эллипсометрических параметров: tg Ψ
показывает отношение амплитуд коэффициентов отражения для р- и s-волн, а параметр Δ равен разности между изменениями фазы этих волн при отражении.
Поскольку тангенс и комплексная экспонента периодически зависят от аргумента, для
определенности эллипсометрические параметры выбираются из интервалов, в которых функции
 и ${{e}^{{i{{\Delta }}}}}$ определены однозначно, например
и ${{e}^{{i{{\Delta }}}}}$ определены однозначно, например
(4)
${{\Psi }} \in \left[ { - 90^\circ ;\,\,90^\circ } \right];\,\,\,\,{{\Delta }} \in \left[ { - 90^\circ ;\,\,270^\circ } \right].$Эллипсометрические параметры исследуемого образца определяются его структурой, геометрией, оптическими свойствами составляющих его материалов и внешней среды, углом падения светового пучка на образец. Оптические свойства материала описывает его комплексная диэлектрическая проницаемость ε либо оптические константы: n – показатель преломления и k – коэффициент поглощения. Расчет эллипсометрических параметров при наличии полной информации об образце называется прямой задачей эллипсометрии. Однако на практике необходимо решать обратную задачу – определять по измеренным параметрам Ψ и Δ неизвестные параметры образца; для этого, как правило, применяют алгоритмы, основанные на подгонке решения методом многократного решения прямой задачи на исследуемом пространстве параметров с оптимизацией функции невязки [11].
Коэффициенты отражения и пропускания s- и p-компонент света на границе двух сред выражаются через формулы Френеля, которые могут быть распространены на случай отражения света от многослойных систем. Рассмотрим случай отражения плоской волны единичной амплитуды от подложки, покрытой однородной пленкой толщиной d (рис. 1).
Как видно из рисунка, световая волна испытывает многократные отражения внутри пленки. При этом часть волны проникает в подложку, где все излучение поглощается, и часть отражается во внешнею среду, порождая в ней последовательный ряд парциальных волн. Расчет коэффициентов отражения многослойных структур можно свести к последовательному расчету коэффициентов отражения системы среда–пленка–подложка: определив коэффициент отражения от слоя, лежащего на подложке, можно считать его новой подложкой с известным коэффициентом отражения.
Комплексное уравнение позволяет определить не более двух вещественных неизвестных, но на практике, при проведении эллипсометрического эксперимента, часто возникает задача определения большего числа параметров исследуемой структуры. Эффективным решением этой проблемы является измерение эллипсометрических параметров на нескольких длинах волн – спектральная эллипсометрия. Данный метод является более информативным за счет того, что геометрические параметры исследуемого образца не зависят от длины волны, а изменение оптических констант веществ с длиной волны подчиняется закону дисперсии.
Показатель преломления для прозрачных пленок в видимой области спектра в широком диапазоне длин волн (при длинах волн больше чем край поглощения) хорошо описывается дисперсионной формулой Коши:
Для нахождения неизвестных параметров необходимо решать обратную задачу эллипсометрии, которая может не иметь точного математического решения, особенно в случае спектральной эллипсометрии. Поэтому используются вычислительные методы, которые сводятся к аппроксимации спектральных зависимостей Ψ и Δ в заданном диапазоне длин волн. При этом возникает необходимость в численной оценке качества согласования модельных значений Ψ и Δ с экспериментальными – введении функции ошибки (невязки). Функция ошибки может быть выбрана многими способами, при этом решение задачи будет зависеть от нее. Однако если модель достаточно точно описывает исследуемый образец, разница между результатами, полученными при использовании различных функций ошибки, незначительна.
При этом, строго говоря, задача оптимизации функции ошибки на пространстве [Ψ, Δ] некорректна, так как целевая функция не непрерывно зависит от параметров на границах области определения. Для устранения этой проблемы обычно выбираются параметры N, C, S, связанные с эллипсометрическими параметрами соотношениями:
(6)
$\begin{gathered} {\text{N}} = {\text{\;}}\cos \left( {2{{\Psi }}} \right);\,\,\,\,{\text{C}} = \sin \left( {2{{\Psi }}} \right)\cos \left( {{\Delta }} \right); \\ {\text{S}} = \sin \left( {2{{\Psi }}} \right)\sin \left( {{\Delta }} \right). \\ \end{gathered} $При обработке экспериментальных результатов в данной работе в качестве функции ошибки использовалась функция вида [12]:
(7)
${{{{\chi }}}^{2}} = \sqrt {\frac{1}{{3n - m}}\sum\limits_{i = 1}^n {\left[ {\frac{{{{{\left( {{{{\text{N}}}_{{{{{\text{E}}}_{i}}}}} - {{{\text{N}}}_{{{{{\text{M}}}_{i}}}}}} \right)}}^{2}}}}{{{{\sigma }}_{{\text{N}}}^{2}}} + \frac{{{{{\left( {{{{\text{C}}}_{{{{{\text{E}}}_{i}}}}} - {{{\text{C}}}_{{{{{\text{M}}}_{i}}}}}} \right)}}^{2}}}}{{{{\sigma }}_{{\text{C}}}^{2}}} + \frac{{{{{\left( {{{{\text{S}}}_{{{{{\text{E}}}_{i}}}}} - {{{\text{S}}}_{{{{{\text{M}}}_{i}}}}}} \right)}}^{2}}}}{{{{\sigma }}_{{\text{S}}}^{2}}}} \right]} } ,$При необходимости эта модель может быть дополнена несколькими слоями с известными или рассчитываемыми по экспериментальным данным оптическими характеристиками. Трудность возникает при необходимости измерения характеристик монослоев адсорбированных на поверхности веществ. В этом случае толщина слоя не позволяет адекватно рассчитать его оптические характеристики, однако довольно надежно измеряется его кажущаяся толщина, поскольку поляризуемость вещества такого слоя пропорциональна концентрации его молекул на поверхности. В таком случае обычно предполагается, что адсорбированный слой имеет такой же показатель преломления, как и нижележащий диэлектрик, при расчетах эллипсометрической модели по данным эксперимента это приводит к значению “кажущейся толщины” монослоя адсорбированного прекурсора. При проведении эллипсометрических измерений in situ в установке осаждения отдельную сложность представляет собой учет температурных зависимостей оптических констант. Для тонких слоев диэлектриков этой зависимостью можно пренебречь, однако для оптики кремния температура играет большую роль (рис. 2), ситуация усугубляется тем, что в процессе измерений возможен небольшой дрейф температуры образца, и даже колебания температуры на 10°С проявляются в ухудшении точности подгонки модели. Для этого, в нашем эксперименте была учтена температурная зависимость спектра показателя преломления и показателя поглощения. Температура кремниевой подложки вычислялась в каждой точке измерений, что позволило нивелировать влияние ее дрейфа.
Рис. 2.
Зависимость оптических констант монокристаллического кремния от температуры в исследуемом диапазоне: а – коэффициент преломления; б – коэффициент поглощения.
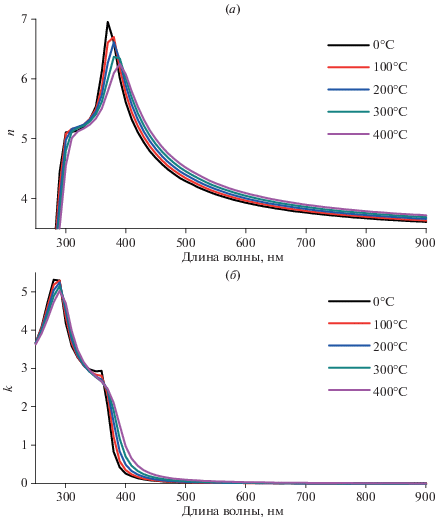
Стоит отметить, что эллипсометрические измерения являются бесконтактными и неразрушающими. Они могут проводиться в широких диапазонах температур, в лабораторных условиях, в условиях вакуума или агрессивных внешних сред. Кроме того, исследуемые образцы не требуют специальной подготовки. Эллипсометрия очень чувствительна к слабым эффектам на границе раздела (дефекты, адсорбированные слои толщиной порядка мономолекулярных). Все это позволяет использовать эллипсометрические измерения для in situ исследования различных физико-химических процессов на поверхности образца [12].
Наиболее изучены поверхностные реакции при осаждении оксида алюминия с использованием прекурсора триметилалюминия Al(CH3)3 и плазмы кислорода или паров воды в качестве второго реагента. Экспериментально установлено и подтверждается теоретически, что реакция протекает по следующим стадиям [13]:
1) физическая адсорбция прекурсора;
2) химическая (диссоциативная) адсорбция с высвобождением радикала CH3, например:
(8)
$\left\| {--{\text{OH}} + {\text{Al}}{{{\left( {{\text{C}}{{{\text{H}}}_{{\text{3}}}}} \right)}}_{3}} \to \,} \right\|--{\kern 1pt} {\text{O}}{\kern 1pt} --{\kern 1pt} {\text{Al}}{{\left( {{\text{C}}{{{\text{H}}}_{{\text{3}}}}} \right)}_{2}} + {\text{C}}{{{\text{H}}}_{4}}{\kern 1pt} \uparrow ,$3) гетерогенная реакция со вторым прекурсором.
В редких случаях адсорбции прекурсора металла хемосорбция происходит без реакций между прекурсором и химически активными центрами поверхности. Тогда удаление лигандов прекурсора происходит исключительно за счет реакции с кислородом плазмы.
Как правило, температура поверхности образца, на которой происходит осаждение, выше температуры разложения прекурсора. В этом случае прекурсоры имеют тенденцию частично разлагаться во время адсорбции. Эти механизмы разложения могут происходить без прямой реакции с поверхностными активными группами (например, гидроксилами) и приводить к высвобождению множества побочных продуктов газовой фазы, которые в дальнейшем могут повторно адсорбироваться на поверхности и продолжать реагировать. Такое поведение приводит к множеству путей адсорбции, при которых десорбция, реадсорбция и перегруппировка на поверхности так же важны для насыщения поверхности, как и начальные реакции.
В [14] метод спектральной эллипсометрии с высоким временным разрешением был применен для исследования процесса осаждения оксида стронция SrO с использованием бис-три-изопропилциклопентадиенила стронция и паров воды H2O. Было продемонстрировано, что спектроскопическая эллипсометрия может быть применена как неинвазивная методика для контроля поверхностных реакций с устойчивой субмонослойной чувствительностью. Процесс был самоограниченным при температуре от 150 до 350°C, и наблюдалась сильная зависимость скорости роста пленки от температуры осаждения в диапазоне от 0.05 до 0.33 нм/цикл. Возможные факторы, способствующие изменению полученной скорости роста за цикл, включают многосайтовые реакции обмена лигандов, десорбцию и перегруппировку прекурсоров.
ПОСТАНОВКА ЭКСПЕРИМЕНТА
В настоящей работе анализируются возможности разработки методики измерения нанометровых оксидных покрытий на основе оксидов металлов с использованием спектрального эллипсометра Woollam Co. Inc. (США) модели M2000X. Источником света служит ксеноновая лампа высокого давления мощностью 75 Вт. Пленки осаждали в установке FlexAl ALD (Oxford Instruments, Великобритания) (рис. 3). Измерения СЭ проводились в диапазоне длин волн 245–998 нм при угле падения 71° с временным разрешением не хуже 1 с.
Рис. 3.
Экспериментальная установка: 1 – камера реактора; 2 – образец; 3 – турбомолекулярный насос; 4 – клапан автоматического регулирования давления; 5 – индуктор источника ICP; 6 – вход газа; 7 – оптический порт; 8, 9 – источник и приемник спектрального эллипсометра; 10 – подача прекурсоров; 11 – клапан источника, 12 и 13 – оптические порты с задвижками.

Эллипсометр построен по схеме с вращающимся компенсатором. Приемником излучения служит диодная матрица. Измерение интенсивности света происходит одновременно на 479 длинах волн, равномерно по спектральному диапазону прибора. Длительность одного измерения определяется необходимой точностью измерения по отношению к шумам, зависящей от накопления сигнала. Для хорошо отражающих подложек (кремний, металлы, прозрачные слои на кремнии и т.п.) эллипсометрические кривые могут быть отсняты с приемлемой точностью за время менее 1 с.
Эллипсометр допускает проведение измерений in situ, в частности может входить как опция при поставке оборудования атомно-слоевого осаждения пленок. Есть возможность синхронизации эллипсометрических измерений сигналом от технологического оборудования. Этот режим применяется в процессах осаждения, когда оптические окна в камеру реактора держат закрытыми в течение цикла осаждения и открывают на время эллипсометрических измерений между циклами, что предотвращает осаждение пленок на оптическом стекле окон.
Процессы плазмостимулированного атомно-слоевого осаждения оксидов алюминия, тантала, гафния и циркония проводились при температурах образца 200, 250, 300, 350, 400°С. Для исключения влияния материала подложки и ее состояния поверхности после помещения образца в камеру предварительно проводилось несколько циклов осаждения исследуемого материала. Циклограмма исходного процесса для осаждения оксида гафния приведена на рис. 4. В каждом эксперименте выполнялось 10 циклов осаждения материала, при этом эллипсометрические измерения проводились после адсорбции прекурсора и после плазменного шага, далее прекурсор дозировался еще раз, и затем проводилось длительная (2 мин) серия измерений с временным шагом около 0.5 с. Таким образом, с достаточной надежностью можно измерить относительное количество адсорбированного прекурсора, скорость роста пленки за цикл и характерное время протекания реакций прекурсора на поверхности. Поверхность камеры реактора и трубок поддерживалась при температуре 120°С для предотвращения конденсации прекурсора.
Для осаждения оксида алюминия в качестве металлорганического прекурсора использовался триметилалюминий (Al(CH3)3). Его температура поддерживалась на значении 35°С, время дозировки составляло 20 мс, плазма кислорода возбуждалась при вложенной мощности 400 Вт и давлении 15 мТорр в течение 2 с.
Металлорганический прекурсор тетраэтилметиламиногафний (Hf(N(CH3)(C2H5)4) использовался для осаждения оксида гафния, температура прекурсора поддерживалась на значении 70°С, дозировка осуществлялась при помощи барботирования аргона через сосуд с прекурсором при потоке 250 ст. см3/мин, время дозировки составляло 1000 мс, плазма кислорода возбуждалась при вложенной мощности 250 Вт и давлении 15 мТорр в течение 3 с.
Для осаждения оксида циркония был использован тетраэтилметиламиноцирконий Zr(N(CH3)(C2H5)4). Параметры процесса были такими же, как для оксида гафния за исключением времени дозирования прекурсора, которое составляло 1100 мс.
Оксида тантала осаждался с использовавнием трет-бутилимидо-трис(диметиламино)тантала (V) (C4H9N)Ta(N(CH3)2)3, температура прекурсора поддерживалась на значении 60°С, время дозировки составляло 3000 мс, плазма кислорода возбуждалась при вложенной мощности 300 Вт и давлении 15 мТорр в течение 3 с.
Указанные параметры процессов были установлены при проведении оптимизации процессов для получения наиболее однородных пленок с минимальными токами утечки.
РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
Измеренные значения толщины пленок в ходе процесса (кажущаяся толщина слоя диэлектрика и адсорбированного прекурсора) в зависимости от времени приведены на рис. 5. Для всех исследованных процессов в диапазоне температур 200–400°С наблюдается линейный рост пленки – приращение толщины пленки за цикл не зависит от номера цикла, но зависит от температуры образца. Также проявляется и зависимость кажущейся толщины адсорбированного прекурсора от температуры. Для всех процессов наблюдается снижение скорости роста пленки при повышении температуры, причем для оксида циркония и оксида тантала это явление носит пороговый характер – скорость роста резко падает при повышении температуры выше 200°С. Это можно объяснить тем, что при температуре 200°С физисорбированные молекулы прекурсора не успевают покинуть образец на этапе продувки реактора.
Рис. 5.
Кажущаяся толщина слоя диэлектрика и адсорбированного прекурсора при осаждении: а – Al2O3, б – HfO2, в – ZrO2, г – Ta2O5. Показаны 10 циклов осаждения и процесс десорбции или химической модификации прекурсора после последнего полуцикла.

Рис. 6а показывает среднюю скорость роста пленки за цикл. Для оксидов алюминия, тантала и циркония наблюдается уменьшение скорости роста с повышением температуры, для оксида гафния – обратная ситуация. Нужно отметить, что результирующая скорость роста определяется двумя конкурирующими процессами. С одной стороны десорбция прекурсора в неизменном виде приводит к уменьшению толщины пленки, что должно проявляться при росте температуры, с другой стороны, если происходит декомпозиция прекурсора или образование химических связей с нижележащими молекулами, то рост температуры, активируя эти процессы, будет приводить к увеличению скорости роста пленки за цикл.
Рис. 6.
Характеристики процесса атомно-слоевого роста: а – средняя скорость роста за цикл и б – кажущаяся толщина адсорбирующегося прекурсора.
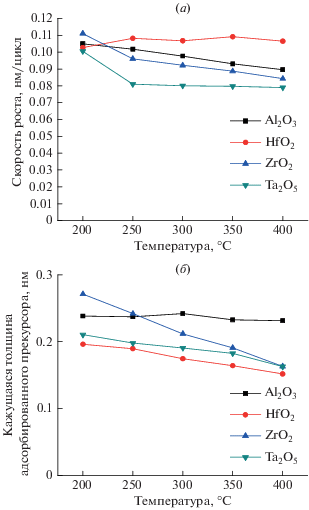
На рис. 6б видно монотонное снижение равновесного количества адсорбированного прекурсора с ростом температуры, выраженное для всех процессов кроме случая роста пленки оксида алюминия.
Кроме этого, по графиками рис. 4 можно определить скорость десорбции прекурсора в вакуум после последнего шага дозирования прекурсора, а по ней энергию активации десорбции. В этом случае термическая зависимость скорости десорбции описывается соотношением Аррениуса:
(9)
$\ln \left( {~\frac{{\left| {\dot {\theta }} \right|}}{\theta }} \right) = A - \frac{{{{E}_{а}}}}{{RT}},$Для определения энергии десорбции каждого прекурсора был построен график в аррениусовских координатах в зависимости от обратной температуры (рис. 7). Видно, что для прекурсоров тантала и циркония во всем исследованном диапазоне температур наблюдается аррениусовская зависимость, из которой можно получить значения энергий активации (для прекурсора тантала Еа = 10.9 кДж/моль, для прекурсора циркония Еа = 10.0 кДж/моль). Для прекурсоров гафния и алюминия аррениусовский характер зависимости наблюдается только для низких температур (для прекурсора гафния Еа = 24.7 кДж/моль, для прекурсора циркония Еа = 33.8 кДж/моль), при температурах свыше 350°С доминирует процесс термического разложения.
ЗАКЛЮЧЕНИЕ
В работе исследованы возможности метода спектральной эллипсометрии для прецизионных измерений при разработке и исследовании технологических процессов атомно-слоевого осаждения в микроэлектронике. Показана применимость метода для тонких диэлектрических слоев приборов микроэлектроники. Приведены результаты измерений in situ для процессов плазмостимулированного атомно-слоевого осаждения оксидов алюминия, тантала, гафния и циркония на поверхности монокристаллического кремния (100).
Показано, что наблюдается линейный рост пленки с увеличением количества циклов. Измерены температурные зависимости скорости роста пленки за цикл, а также количества адсорбирующегося прекурсора. Показано, что для триметилалюминия и тетраэтилметиламиногафния по сравнению с механизмом десорбции более важную роль играет механизм термического разложения, при котором атом металла остается на поверхности.
Точность метода позволяет измерять скорость роста за цикл, и наблюдать адсорбцию прекурсора и его десорбцию в зависимости от температуры образца. Полученные результаты могут быть применены для оптимизации и теоретических исследований процессов атомно-слоевого осаждения диэлектриков в высокоаспектные структуры.
Работа выполнена в рамках Государственного задания ФТИАН им. К.А. Валиева РАН Минобрнауки РФ по теме № 0066-2019-0004 (обеспечение работы оборудования), частично поддержана РФФИ, грант № 18-37-00354 мол_а (проведение эксперимента и расчеты).
Список литературы
International Roadmap for Devices and Systems (IRDS™). 2017 Edition. Beyond CMOS. 50 p. https:// irds.ieee.org/editions/2017
George S.M. Atomic Layer Deposition: An Overview // Chem. Rev. 2010. V. 110. P. 111–131.
Kim H., Oh I.-K. Review of plasma-enhanced atomic layer deposition: Technical enabler of nanoscale device fabrication // Jpn. J. Appl. Phys. 2014. V. 53. P. 03DA01.
Mackus A.J.M., Merkx M.J.M., Kessels W.M.M. From the Bottom-Up: Toward Area-Selective Atomic Layer Deposition with High Selectivity // Chemistry of Materials. 2019. V. 31(1). P. 2–12.
Fujiwara H. Spectroscopic Ellipsometry: Principles and Applications// John Wiley & Sons, Chichester, England; Hoboken, NJ, 2007. P. 392. ISBN: 978-0-470-01608-4.
Mameli A., Merkx M.J.M., Karasulu B., Roozeboom F., Kessels E.M.M., Mackus A.J.M. Area-Selective Atomic Layer Deposition of SiO2 Using Acetylacetone as a Chemoselective Inhibitor in an ABC-Type Cycle // ACS Nano. 2017. V. 11(9). P. 9303–9311.
Langereis E., Heil S.B.S., Knoops H.C.M., Keuning W., van de Sanden M.C.M., Kessels W.M.M In situ spectroscopic ellipsometry as a versatile tool for studying atomic layer deposition // J. Physics D: Applied Physics. 2009. V. 42. P. 73001.
Clemente I.E., Miakonkikh A.V. Application of spectral ellipsometry to in situ diagnostics of atomic layer deposition of dielectrics on Silicon and AlGaN // Proc. of SPIE. 2016. V. 10224. P. 1022425-1–1022425-7.
Аззам Р., Башара Н. Эллипсометрия и поляризованный свет. М.: Мир, 1981. 583 с.
Rothen A. The ellipsometer, an apparatus to measure thicknesses of thin surface films // Rev. Sci. Instr. 1945. V. 16. P. 26.
Complete EASE™ Data Analysis Manual / By J.A. Woollam Co., Inc. 2009. 266 p.
Швец В.А., Спесивцев Е.В., Рыхлицкий С.В., Михайлов Н.Н. Эллипсометрия – прецизионный метод контроля тонкопленочных структур с субнанометровым разрешением // Российские нанотехнологии. 2009. T. 9. № 3–4. С. 72–84.
Weckman T., Laasonen K. First principles study of the atomic layer deposition of alumina by TMA–H2O-process // Phys. Chem. 2015. V. 17. P. 17322–17334.
Wang H., Jiang X., Willis B. Real-time spectroscopic ellipsometric investigation of adsorption and desorption in atomic layer deposition: A case study for the strontium bis(triisopropylcyclopentadienyl)/water process // J. Vacuum Science & Technology A. 2012. V. 30. P. 01A133.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника