Микроэлектроника, 2020, T. 49, № 4, стр. 287-296
Влияние давления кислорода на переключения в мемристорах на основе электроформованных открытых “сэндвич”-структур
В. М. Мордвинцев a, *, Е. С. Горлачев a, С. Е. Кудрявцев a, В. Л. Левин a
a Ярославский филиал Физико-технологического института им. К.А. Валиева РАН
150007 Ярославль, ул. Университетская, 21, Россия
* E-mail: Mordvintsev-Viktor@yandex.ru
Поступила в редакцию 20.01.2020
После доработки 27.01.2020
Принята к публикации 13.02.2020
Аннотация
Объектом исследования были образцы элементов энергонезависимой электрически перепрограммируемой памяти (мемристоров) на основе электроформованных открытых “сэндвич”-структур TiN–TiO2–SiO2–W, изготовленные по тонкопленочной технологии. Разработана методика и выполнены экспериментальные исследования влияния давления кислорода над поверхностью изолирующей щели структур и режима ограничения тока во время действия импульса переключения из низко- в высокопроводящее состояние на характеристики элементов памяти. Показано наличие порогового значения давления кислорода, при котором переключения прекращаются, и его зависимости от величины тока ограничения. Приведена трактовка экспериментальных результатов на основе развитых представлений о механизмах процессов образования и исчезновения частиц проводящей фазы в изолирующей щели электроформованной структуры.
ВВЕДЕНИЕ
Элементы энергонезависимой электрически перепрограммируемой памяти, в которой информация кодируется величиной сопротивления (мемристоры), являются перспективным направлением исследований [1, 2]. В качестве среды, в которой происходят переключения сопротивления, используются самые разные материалы, в том числе и оксиды кремния [3–5]. Одной из разновидностей мемристоров является униполярная память, основанная на явлении электроформовки в структурах металл-диэлектрик-металл (МДМ) при помещении их в вакуум и подаче на них напряжения амплитудой около десяти вольт. При этом структуры приобретают N-образные вольтамперные характеристики (ВАХ) и эффекты бистабильности (памяти и переключений с помощью импульсов электрического напряжения). Исследование электроформовки началось задолго до бума с мемристорами [6, 7]. В последние годы интерес к ней был обусловлен тем, что возникло понимание принципиально нанометрового масштаба этого явления [8, 9].
Открытые “сэндвич”-МДМ-структуры получаются путем локального удаления верхнего электрода и диэлектрика в обычных (“закрытых”) МДМ-“сэндвич”-структурах. Формирующийся при этом свободный торец слоя диэлектрика, располагающийся между двумя электродами, образует изолирующую щель, открытую в газовую среду, с которой возможен обмен веществом. Ширина изолирующей щели определяется толщиной слоя диэлектрика. Ее значения, как правило, лежит в диапазоне нескольких десятков нанометров, поэтому в изолирующей щели при используемых для электроформовки напряжениях между электродами (около 10 В) достигаются высокие электрические поля (более 106 В/см), которые необходимы и для переключений между высоко- и низкопроводящим состояниями. Для возникновения эффектов бистабильности в структурах на основе SiO2 необходимо наличие именно открытой в газовую среду изолирующей щели шириной порядка десятков нанометров [8]. Такая конструкция позволяет устранить неконтролируемые разрушения за счет электрического пробоя обычной “сэндвич”-МДМ-структуры в микрометровом масштабе при выполнении электроформовки, представляющей собой операцию подачи на структуру напряжения по определенному алгоритму. Результатом электроформовки является образование в изолирующей щели частиц проводящей фазы (ЧПФ), в случае оксидов кремния – это атомы кремния, возникающие за счет деструкции молекул SiO2 при электронном ударе. Накопление ЧПФ приводит к формированию связного кластера – проводящей среды, отделенной от металлического электрода изолирующим зазором нанометровой ширины h, которые вместе образуют проводящую наноструктуру. После электроформовки структуры могут выполнять все функции элемента памяти [10].
В первых вариантах экспериментальные образцы матриц такой памяти были выполнены на основе открытой “сэндвич”-структуры n+-Si–SiO2–W [10]. В дальнейшем было показано, что ее замена на структуру TiN–SiO2–W дает возможность улучшить некоторые характеристики [11], а введение дополнительного слоя TiO2 толщиной несколько нанометров на поверхности нитрида титана позволяет заметно уменьшить вероятность возникновения разрушающего электрического пробоя в структурах [12].
Особенностью элементов памяти на электроформованных структурах является их чувствительность к составу и давлению газовой среды (прежде всего, кислорода) над поверхностью изолирующей щели, что следует уже из самого механизма процесса электроформовки (без высокого вакуума он не идет). Предварительные исследования влияния давления воздуха на процессы переключений для структур Si–SiO2–W, причем, в основном в квазистатических режимах подачи напряжения, были выполнены в [13]. В данной работе представлены результаты по воздействию кислорода на структуры TiN–TiO2–SiO2–W в режиме импульсных переключений.
ОБРАЗЦЫ И ТЕХНОЛОГИЯ ИХ ИЗГОТОВЛЕНИЯ
На рис. 1 показана конструкция используемых образцов открытых “сэндвич”-структур TiN–TiO2–SiO2–W. В качестве нижнего электрода применялся слой нитрида титана толщиной 40–50 нм. На поверхности TiN находилась тонкая пленка TiO2 толщиной около 3 нм. Толщина слоя SiO2 составляла около 23 нм. Верхний электрод выполнялся из пленки вольфрама толщиной 100–120 нм. Изолирующая щель в виде открытого торца слоя SiO2 в плане представляла собой квадрат со стороной 8 мкм. Проводящие дорожки от электродов структуры TiN–TiO2–SiO2–W (на рис. 1 не показаны) и контактные площадки к чипу изготавливались в виде пленки Al толщиной около 0.6 мкм. В отличие от предыдущей конструкции [12], ячейки памяти не включали биполярный транзистор, который обеспечивал бы индивидуальную выборку каждой открытой “сэндвич”-структуры в случае соединения их в матрицу.
Рис. 1.
Схематическое изображение элемента памяти, включающего открытую “сэндвич”-структуру TiN–TiO2–SiO2–W после выполнения электроформовки: 1 – проводящая шина и нижний электрод изолирующей щели (TiN); 2 – слой диэлектрика (TiO2); 3 – слой диэлектрика (SiO2) толщиной 25 нм; 4 – проводящая шина и верхний электрод изолирующей щели (W); 5 – проводящая среда (наноструктура) на поверхности открытого торца; 6 – изолирующий зазор переменной ширины h; 7 – изолирующая щель в форме открытого торца слоя диэлектрика; 8 – слой толстого (0.6 мкм) диоксида кремния; 9 – подложка кремния.
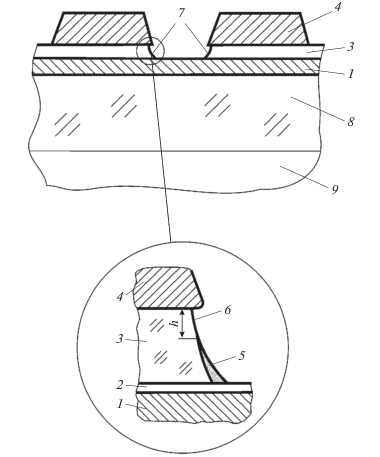
При изготовлении структур в качестве исходной подложки (рис. 1) использовались пластины монокристаллического кремния, окисленного во влажном кислороде. Толщина сплошного слоя термического диоксида кремния составляла 0.6–0.7 мкм. Пленка нитрида титана осаждалась методом реактивного магнетронного распыления титана в атмосфере азота. Тонкая пленка TiO2 создавалась окислением поверхности нитрида титана в кислородной плазме [14]. Затем, тоже реактивным магнетронным распылением кремния в атмосфере кислорода, получался слой тонкого SiO2. Пленки W и Al осаждались магнетронным распылением соответствующих металлов. Рисунок во всех слоях формировался методами контактной фотолитографии. Изолирующая щель в форме открытого торца слоя диэлектрика создавалась прецизионным жидкостным травлением тонкого слоя диоксида кремния.
Кремниевая пластина скрайбировалась и разделялась на чипы, которые приклеивались и разваривались в круглые металлостеклянные корпуса. Корпуса не герметизировались, что позволяло в дальнейшем размещать структуры в газовой среде вакуумной установки. В данной работе использовались чипы с одной кремниевой пластины.
Структуры хранились на воздухе под защитным слоем фоторезиста, удалявшимся непосредственно перед выполнением электроформовки, которая была последней операцией в цикле изготовления образцов. Она включала помещение структур в вакуум с остаточным давлением порядка 10–2 Па, создаваемым масляным диффузионным насосом, и подачу на их электроды напряжения по определенному алгоритму (использовались треугольные импульсы амплитудой около 10 В со скоростью изменения напряжения 2 В/с) с применением прибора ИППП-1. Принципиальным отличием от предыдущих конструкций ячейки памяти было отсутствие в ней транзистора, что позволяло подавать на открытую “сэндвич”-структуру напряжения любой полярности. Оказалось, что при “плюсе” на W электроде процесс электроформовки идет более устойчиво, а вероятность возникновения электрического пробоя при дальнейшем снятии ВАХ и переключениях состояний ячейки на порядки меньше, чем при ранее применявшейся обратной полярности [11, 12]. В связи с этим, в данной работе почти во всех случаях на W электроде было положительное напряжение. ВАХ процесса электроформовки при этом не отличались от обычных. В то же время, получить аналогичные результаты в процессах переключения состояний структуры при отрицательном напряжении на W было невозможно.
Результатом выполнения электроформовки является формирование на поверхности изолирующей щели (рис. 1) проводящей наноструктуры с переменной шириной h нанометрового изолирующего зазора. Возникновение такого объекта является причиной всех нетривиальных особенностей электроформованных структур: N-образных ВАХ и эффектов бистабильности (переключения и памяти) [8].
ЭКСПЕРИМЕНТАЛЬНАЯ УСТАНОВКА, МЕТОДИКА ПЕРЕКЛЮЧЕНИЙ И ИЗМЕРЕНИЙ
Экспериментальная установка для исследования влияния состава и давления газовой среды на процессы переключения элементов памяти собрана на базе вакуумной системы УСУ-4. На отдельном фланце установлена вакуумная камера, в которой размещались исследуемые образцы. Металлостеклянные корпуса с чипами, содержащими элементы памяти, без крышек крепились так, что чип оказывался внутри вакуумной камеры, а его выводы – снаружи. Уплотнение осуществлялось с помощью фторопластового кольца по кромке металлостеклянного корпуса, которая через металлическую шайбу поджималась винтовым держателем. Откачка объема камеры проводилась с помощью турбомолекулярного насоса VARIAN Mini-TASK, позволяющего получать безмасляный высокий вакуум. Для контролируемой подачи газа в камеру использовалась система напуска газа СНА-2. Применялся газообразный кислород с содержанием паров воды менее 0.007%. Давление P газа до значений 103 Па измерялось вакуумметром Thyracont VSM72 с датчиком Пирани и холодным катодом, а для значений выше 103 Па – с помощью манометра РОСМА ТВ5. После предварительной продувки газовой системы и откачки камеры до остаточного давления около 10–2 Па (паразитное натекание приводило к его увеличению в 2–3 раза за время одной серии экспериментов, занимавшей около 0.5 ч), насос отсекался и выполнялся напуск газа до нужного значения P. Между отдельными сериями измерений газовая среда “освежалась”, т.е. камера откачивалась до 10–2 Па и газ напускался заново.
Исследование функционирования элементов памяти проводилось с помощью прибора ИППП-1/2, сопряженного с персональным компьютером. Подключение выводов образца к ИППП-1/2 осуществлялось экранированными проводами через коммутирующее устройство, обеспечивающее выборку нужного элемента памяти на чипе. Для подачи коротких (около 100 нс) импульсов напряжения применялся генератор импульсов Г5-56. Каждый элемент памяти после помещения в высокий безмасляный вакуум “прирабатывался” с целю достижения более стабильного состояния: на него подавался треугольный импульс напряжения амплитудой около 10 В и длительностью 120 с, при этом использовался режим ограничения тока на уровне 190 мкА. Фактически эту процедуру можно считать частью операции электроформовки.
Методика импульсных переключений основывалась на предварительных исследованиях процессов в электроформованных структурах при подаче на них импульсов напряжений различной формы, амплитуды и длительности. На рис. 2 показана типичная квазистатическая N-образная ВАХ исследуемого элемента памяти после выполнения электроформовки и перевода в низкопроводящее состояние, полученная при использовании треугольного импульса со скоростью изменения напряжения 2 В/с. По достижении порогового напряжения Uth, обычно около 3 В, происходит резкое увеличение проводимости структуры (накопление ЧПФ). Она переходит в высокопроводящее состояние (“включение”), после чего ток начинает флуктуировать (одновременно идут процессы и образования, и удаления ЧПФ за счет их “выгорания”, см. ниже), в среднем, однако уменьшаясь с ростом напряжения, т.е. на кривой наблюдается максимум, положение которого близко к значению Uth. На обратном ходе напряжения после Uth скачки тока прекращаются, и высокопроводящее состояние сохраняется до конца импульса. Возможность устойчиво прорисовывать квазистатические ВАХ практически без ограничения тока при отсутствии электрического пробоя демонстрирует отмечавшуюся выше большую стабильность структуры при “плюсе” на вольфрамовом электроде, чем при использовавшейся ранее противоположной полярности. Надежный перевод элемента памяти обратно в состояние с низкой проводимостью (“выключение”), чему соответствует выжигание проводящей среды, выполнялся с помощью одиночного прямоугольного импульса напряжения длительностью порядка 100 нс и амплитудой около 8 В. Это возможно, поскольку процесс накопления ЧПФ значительно более “инерционен”, чем процесс их удаления, поэтому вероятность “отключения” при таких малых длительностях импульса близка к 1.
Рис. 2.
Типичная квазистатическая ВАХ элемента памяти после выполнения электроформовки и перевода в низкопроводящее состояние. Скорость изменения напряжения 2 В/с.

В то же время, наблюдение процесса “включения” элемента памяти с высоким временным разрешением (использовался генератор импульсов WW2572A и цифровой осциллограф WS423) показывает более сложную картину (рис. 3). При подаче импульса напряжения, превышающего Uth на 1–2 В, стабильное увеличение проводимости достигается путем быстрых (<30 нс) ее скачков, которые могут происходить в обе стороны, что выражает собой как процессы образования ЧПФ, так и их выгорания. Амплитуда и длительность таких наносекундных импульсов определяется внутренними процессами в формирующейся проводящей наноструктуре. Тем не менее, в итоге проводимость увеличивается на несколько порядков по сравнению с начальным “выключенным” состоянием. Осциллограмма рис. 3 получена для случая, когда не использовалось ограничение тока. Ясно, что применение какой-либо схемы ограничения тока в процессе “включения” (в простейшем случае – последовательного сопротивления) должно стабилизировать процесс, поскольку рост проводимости будет приводить к уменьшению фактического напряжения на структуре, и вероятность самопроизвольных “выключений” значительно понижается. Однако не всегда процесс “включения” идет так быстро, как показано на рис. 3, в некоторых случаях наблюдаются задержки на несколько мс и более. Поэтому оптимальные длительности импульса “включения” – порядка 10 мс, при обязательном контроле полученного состояния. Если элемент памяти не “включился”, импульс должен повторяться. Использование значительно больших длительностей импульсов нецелесообразно, поскольку это увеличивает экспозицию структуры под напряжением, что может приводить к лишней выработке ресурса ее работы.
Рис. 3.
Осциллограмма процесса “включения” элемента памяти импульсом напряжения. С1 и С2 обозначают уровни нулевых значений для напряжения и тока соответственно. Цена делений: для напряжения – 2 В, для тока – 0.1 мА, для времени – 5 мкс. Измерения выполнялись при “минусе” на вольфрамовом электроде.

В данной работе для “включения” применялись прямоугольные импульсы напряжения амплитудой 5 В и длительностью 30 мс, вырабатываемые прибором ИППП-1/2 с одновременным ограничением тока на уровне Ilim и измерением среднего значения тока iav за время около 1 мс в конце импульса напряжения. Использовалась заложенная в ИППП-1/2 схема ограничения тока, с постоянной времени порядка 1 мкс. Ток ограничения Ilim варьировался в диапазоне от 1 до 200 мкА. Мог применяться режим автоматического повторения импульсов до достижения током iav значения 0.95 Ilim, либо режим одиночных импульсов с контролем квазистатической ВАХ элемента памяти в диапазоне от 0 до 1 В, при этом фиксировалось значение тока при напряжении 1 В (ток iON “включенного” состояния). Использование напряжений до 1 В (значительно меньше Uth) гарантировало от случайных переключений элемента памяти. При считывании высокопроводящего состояния ограничение тока составляло 10 мА. “Выключение” элемента проводилось подачей одиночного прямоугольного импульса длительностью 100 нс с амплитудой 6–9 В с внешнего генератора Г5-56, схема ограничения тока при этом отключалась. Контроль низкопроводящего состояния осуществлялся тоже путем снятия квазистатической ВАХ в диапазоне от 0 до 1 В, фиксировался ток при напряжении 1 В (ток iOFF “выключенного” состояния). Конкретное значение амплитуды “выключающего” импульса выбиралась предварительно для каждого элемента так, чтобы iOFF был в интервале 1–100 нА.
Методика экспериментальных исследований переключений электроформованных структур в контролируемой атмосфере различного давления состояла в следующем. Для каждого исследуемого элемента памяти для каждого значения давления и тока ограничения Ilim выполнялась серия из 30 циклов “включения”/“выключения” в режиме одиночных импульсов. “Включение” считалось успешным, если ток iav был более 0.95Ilim. В противном случае импульс “включения” повторялся. Для каждого цикла фиксировались значения iON и потребовавшееся количество n импульсов “включения”. iON и n могли отличаться для разных циклов в несколько раз, поэтому вычислялись средние по серии значения тока ION “включенного” состояния и числа N потребовавшихся импульсов “включения”. Отказ по “включению” элемента памяти фиксировался, если он не “включался” после подачи 200 последовательных импульсов.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Рис. 4 иллюстрирует влияние тока ограничения Ilim на средние ток ION “включенного” состояния и необходимое число N импульсов “включения” на примере трех элементов памяти. Переключения проводились в высоком вакууме. В ходе эксперимента ток ограничения менялся от 190 мкА (такое значение использовалось и при выполнении электроформовки) в сторону уменьшения. Сразу после электроформовки ток “включенного” состояния для разных образцов может отличаться в несколько раз, что отражает индивидуальные особенности элемента памяти в нанометровом масштабе. Поэтому на рис. 4 показаны относительные величины ION, приведенные к значению при Ilim = 190 мкА для своего образца. Абсолютные величины токов для каждого элемента могут быть восстановлены умножением соответствующей ординаты графика рис. 4 на значение ION при Ilim = 190 мкА, которое дано в подписи к рисунку.
Рис. 4.
Зависимости относительного среднего тока ION/(ION)190 “включенного” состояния (зачерненные фигуры) и среднего числа N необходимых для “включения” импульсов (полые фигуры) от тока ограничения Ilim. Средний ток (ION)190 “включенного” состояния (в мкА) при Ilim = 190 мкА для трех образцов: кружки – 168.1, треугольники – 100.0, квадраты – 51.7.

Токи ION “включенного” состояния могут быть как меньше, так и больше используемого значения Ilim, что вызвано наличием быстрых случайных скачков проводимости электроформованной структуры в обе стороны в ходе действия “включающего” импульса напряжения (рис. 3). Из-за того же фактора возможны и значительные случайные отклонения ION, что видно на рис. 4. Однако, в среднем ток ION практически монотонно растет с увеличением Ilim. Это связано с тем, что образование ЧПФ активируется электронным ударом [15], а значит, самим током, и происходит до тех пор, пока напряжение на структуре превышает пороговое значение Uth (рис. 2). В то же время, когда, из-за искусственного ограничения тока, напряжение на структуре падает ниже Uth, образование ЧПФ прекращается. При малых токах ограничения зависимость ION(Ilim) более крутая, чем при больших. Последнее обусловлено, тем, что накопление ЧПФ ограничено и по количеству, и по величине проводимости внутренними процессами в наноструктуре, поэтому с ростом тока Ilim вероятность достижения наноструктурой сопротивления, соответствующего линейной зависимости, уменьшается. Это подтверждается и данными (рис. 4) по среднему числу импульсов “включения”: N всегда равно 1 (т.е. вероятность включения одним импульсом равна 1) для значений тока Ilim, меньших 50 мкА, но часто становится больше 1 для больших токов. Таким образом, можно констатировать, что высокопроводящие состояния при использовании различных токов ограничения во время действия “включающего” импульса значимо и закономерно различаются по величине сопротивления проводящей наноструктуры.
Было исследовано влияние давления P кислорода на процессы переключения электроформованных структур с использованием различных значений Ilim, которые изменялись при переходе от одного образца (элемента памяти) к другому. В то же время, для каждого элемента давление кислорода менялось от минимального (остаточный вакуум на уровне 10–2 Па) до значения, при котором “включение” становилось невозможным. На рис. 5 показаны характерные изменения тока ION “включенного” состояния и среднего числа N импульсов, необходимых для “включения”, с ростом давления кислорода для трех образцов с разными токами ограничения. Как видно, увеличение давления может приводить и к уменьшению, и к увеличению ION, причем, как тенденция (она подтверждается и на большей выборке), действует следующая закономерность: для малых Ilim более характерно уменьшение токов ION с увеличением давления, а для больших Ilim – их увеличение. В то же время есть достаточно четкое влияние тока ограничения на то давление P кислорода, после которого элемент памяти перестает “включаться” (пороговое давление Pth) – отсутствие экспериментальных точек для каждой кривой при больших давлениях означает, что на следующем значении давления “включение” оказалось невозможным (элемент не “включался” даже после 200 импульсов). Видно также, что перед приближением к значению Pth заметно увеличивается необходимое число N импульсов “включения”, которое до этого, при малых P, было равно 1. Это означает, что вероятность “включения” значительно уменьшается уже при подходе к пороговому давлению, и становиться равной 0 после его достижения.
Рис. 5.
Зависимости среднего тока ION “включенного” состояния (зачерненные фигуры) и среднего числа N необходимых для “включения” импульсов (полые фигуры) от давления P кислорода. Ток ограничения Ilim (в мкА) для трех образцов: кружки – 25, треугольники – 62.5, квадраты – 190.
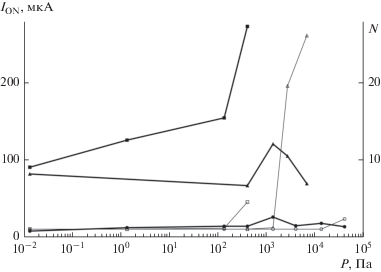
В принципе, качественно также может проявляться выработка ресурса элемента памяти просто по мере нарастания общего числа переключений, а не в связи с ростом давления кислорода. Поэтому были выполнены контрольные эксперименты, в которых давление менялось от максимально возможного, но меньшего Pth, в сторону уменьшения. При этом характер зависимостей ION(P) и N(P) не изменился. Такой результат позволяет однозначно утверждать, что в используемых условиях выработка ресурса элемента памяти незначительна, и основные особенности зависимостей рис. 5 определяются именно давлением кислорода.
На рис. 6 приведена зависимость Pth от Ilim, построенная на основе всего массива данных. Зачерненным кружкам соответствует ситуация, когда элемент памяти прекратил переключаться “внутри” серии из 30 циклов при определенном давлении кислорода, полым кружкам и вертикальным отрезкам – когда при меньшем давлении элемент полностью отработал все 30 циклов, а на следующем, большем, давлении его не удалось ни разу включить. В этом случае можно сказать только, что пороговое давление Pth лежит между этими двумя значениями.
Рис. 6.
Зависимость порогового давления Pth, при котором элемент памяти перестает “включаться”, от тока ограничения Ilim. Цифра 2 означает, что при Ilim = = 25 мкА данные получены для двух образцов.
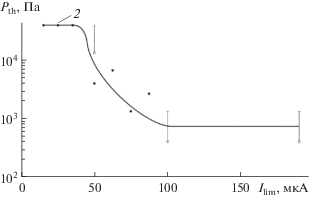
Зависимость рис. 6 имеет две “полочки”: при больших и малых значениях Ilim, – и область, в которой пороговое давление меняется, хотя и с большими случайными отклонениями, приблизительно на два порядка. Для объяснения такого характера зависимости Pth(Ilim) надо более детально рассмотреть механизм процесса “включения” электроформованной структуры с изолирующей щелью из SiO2, который состоит в следующем. При подаче на нее напряжения, большего Uth, начинается не просто накопление ЧПФ в виде атомов избыточного кремния в приповерхностных слоях SiO2, эта, относительно медленная стадия, была выполнена в процессе электроформовки. При “включении” начинается быстрая перестройка состояния поверхности с участием атомов кислорода, тоже активируемая электронным ударом, приводящая к резкому увеличению проводимости вдоль поверхности изолирующей щели [15]. Будем называть это состояние “высокопроводящая конфигурация поверхности” (ВКП). Оно может разрушаться термически даже в условиях высокого вакуума, когда за счет роста общей проводимости наноструктуры увеличивается ток через нее, что приводит к ее омическому разогреву. Этот процесс тоже является быстрым, поэтому на осциллограмме рис. 3 наблюдаются резкие скачки тока в обе стороны. Из полученных экспериментальных данных ясно также, что процессу перехода структуры в высокопроводящее состояние дополнительно препятствует поступление кислорода из газовой фазы, т.е. окисление избыточных атомов кремния (ЧПФ) на поверхности изолирующей щели кислородом тоже приводит к разрушению ВКП. Учитывая термически активируемый характер этого процесса, его, в буквальном смысле, можно назвать “выгоранием”.
В свете сказанного выше, понятно уменьшение величины порогового давления Pth кислорода с ростом тока ограничения (рис. 6). Увеличение Ilim приводит к такому же росту среднего тока в процессе “включения” элемента памяти, который, в свою очередь, пропорционален току ION во “включенном” состоянии. Если считать, что большая часть рассеянной мощности W = UION отводится от поверхности изолирующей щели за счет теплопроводности, то, в первом приближении, средняя за импульс температура T наноструктуры увеличивается пропорционально Ilim, поскольку амплитуда U импульса напряжения “включения” поддерживается постоянной:
где a1 и a2 – константы. Это увеличивает вероятность соединения кислорода с атомами избыточного кремния (ускоряет реакцию выгорания ЧПФ), поэтому для достижения того же эффекта с ростом Ilim требуются меньшие потоки кислорода.Существенно, что воздействие газообразного кислорода на изолирующую щель структуры имеет чисто поверхностный и обратимый характер. Это проявляется в том, что после достижения порогового давления, и прекращения переключений структуры, откачка камеры до высокого вакуума сразу восстанавливает ее обычную переключаемость. Не требуется проведение повторной электроформовки (которая на много порядков более медленна, чем “включение” [15]), как можно было бы ожидать, если бы “прокислению” подвергались все поверхностные слои изолирующей щели.
Учитывая экспоненциальный характер зависимости константы скорости реакции K от обратной температуры T и линейную зависимость скорости реакции V от потока j молекул кислорода на поверхность изолирующей щели (он пропорционален давлению P), в первом приближении, с учетом (1) можно записать:
(2)
$V = Kj = AP\exp \left( { - \frac{E}{{\kappa T}}} \right) = AP\exp \left( { - \frac{E}{{B{{I}_{{\lim }}}}}} \right),$(3)
$P = {{P}_{{th}}} = \frac{V}{A}\exp \left( {\frac{E}{{B{{I}_{{\lim }}}}}} \right) = C\exp \left( {\frac{E}{{B{{I}_{{\lim }}}}}} \right),$“Полочка” на зависимости рис. 6 при больших значениях тока ограничения может быть связана с тем, что, как видно из рис. 4, ION, а значит и средний ток в течение действия импульса “включения” слабо зависят от Ilim в диапазоне от 100 до 200 мкА. Это объясняется тем, что в таких условиях токи начинают ограничиваться внутренними процессами в формирующейся проводящей наноструктуре. Поэтому фактически температура T наноструктуры, а поэтому и скорость реакции, и пороговое давление Pth, перестают меняться с изменением Ilim в этом диапазоне.
Что касается “полочки” при малых Ilim, то она может быть следствием следующих факторов. Уменьшение Ilim приводит к уменьшению средней температуры поверхности изолирующей щели, однако увеличение давления Pth и, соответственно, потока j на нее молекул кислорода принципиальным делает не среднее, а “мгновенное” значение температуры. Как известно [16], выражение для потока j молекул газа имеет вид
(4)
$j = \frac{1}{4}M{v} = \frac{1}{4}\frac{P}{{\kappa {{T}_{g}}}}\sqrt {\frac{{8\kappa {{T}_{g}}}}{{\pi m}}} = P\sqrt {\frac{1}{{2\pi \kappa {{T}_{g}}m}}} \approx 3 \times {{10}^{{22}}}P,$ЗАКЛЮЧЕНИЕ
Экспериментально получены данные, демонстрирующие наличие порогового давления кислорода, выше которого становится невозможным импульсное “включение” элементов памяти на основе электроформованных открытых “сэндвич”-структур TiN–TiO2–SiO2–W. Показано, что пороговое давление экспоненциально зависит от значения тока ограничения во время действия импульса “включения”, на соответствующей кривой наблюдаются также две “полочки”: при малых и больших токах. Полученные результаты могут быть объяснены, исходя из самых общих физических представлений и развиваемых авторами механизмов процессов накопления и исчезновения частиц проводящей фазы в таких структурах.
В отличие от [13], в исследуемых структурах TiN–TiO2–SiO2–W практически не наблюдался выход из строя элементов памяти за счет катастрофического роста тока при многократных переключениях в высоком вакууме. Это имеет большое значение для практического применения такой памяти, поскольку отпадает необходимость поддержания некоторого оптимального давления кислорода над поверхностью чипа в процессе ее функционирования.
Авторы выражают признательность за участие в изготовлении экспериментальных образцов В.В. Наумову, Ю.В. Поздняковой, Л.В. Левиной, Д.Н. Сергушову, А.А. Хребтюгову, А.И. Якубинской.
Работа выполнена в рамках Государственного задания Ярославского филиала Федерального государственного бюджетного учреждения науки Физико-технологического института им. К.А. Валиева Российской академии наук Министерства образования и науки Российской Федерации по теме № 0066-2019-0003.
Список литературы
Abunahla H., Mohammad B. Memristor Device Overview. In: Memristor Technology: Synthesis and Modeling for Sensing and Security Applications. Analog Circuits and Signal Processing. Springer. Cham. 2018. 106 p.
Белов А.Н., Перевалов А.А., Шевяков В.И. Мемристорные структуры для микро- и наноэлектроники. Физика и технология // Изв. Вузов. Электроника. 2017. Т. 22. № 4. С. 305–321.
Mehonic A., Munde M.S., Ng W.H., Buckwell M., Montesi L., Bosman M., Shluger A.L., Kenyon A.J. Intrinsic resistance switching in amorphous silicon oxide for high performance SiOxReRAM devices // Microelectronic Engineering 2017. V. 178. P. 98–103.
Тихов C.B., Горшков О.Н., Антонов И.Н., Касаткин А.П., Королев Д.С., Белов А.И., Михайлов А.Н., Тетельбаум Д.И. Изменение иммитанса при электроформовке и резистивном переключении в мемристивных структурах “металл-диэлектрик-металл” на основе SiOx // ЖТФ. 2016. Т. 86. Вып. 5. С. 107–111.
Захаров П.С., Итальянцев А.Г. Эффект переключения электрической проводимости в структурах металл–диэлектрик–металл на основе нестехиометрического оксида кремния // Труды МФТИ. 2015. Т. 7. № 2. С. 113–118.
Дирнлей Дж., Стоунхэм А., Морган Д. Электрические явления в аморфных пленках окислов // УФН. 1974. Т. 112. № 1. С. 83–127.
Pagnia H., Sotnik N. Switching in Electroformed Metal-Insulator-Metal Devices // Phys. Stat. Sol. (a). 1988. V. 108. № 11. P. 11–65.
Мордвинцев В.М., Кудрявцев С.Е., Левин В.Л. Электроформовка как процесс самоформирования проводящих наноструктур для элементов энергонезависимой электрически перепрограммируемой памяти // Российские нанотехнологии. 2009. Т. 4. № 1–2. С. 174–182.
Chang Y.F., Fowler B., Zhou F., Chen Y.-C., Lee J.C. Study of self-compliance behaviors and internal filament characteristics in intrinsic SiOx-based resistive switching memory // Appl. Phys. Lett. 2016. V. 108. 033504.
Мордвинцев В.М., Кудрявцев С.Е., Левин В.Л. Высокостабильная энергонезависимая электрически перепрограммируемая память на самоформирующихся проводящих наноструктурах // Российские нанотехнологии. 2009. Т. 4. № 1–2. С. 183–191.
Мордвинцев В.М., Кудрявцев С.Е. Исследование электрических характеристик элементов памяти на самоформирующихся проводящих наноструктурах в виде открытой “сэндвич”-структуры TiN–SiO2–W // Микроэлектроника. 2013. Т. 42. № 2. С. 92–104.
Мордвинцев В.М., Кудрявцев С.Е. Влияние особенностей конструкции изолирующей щели открытых “сэндвич”-структур TiN–SiO2–W и Si–SiO2–W на процесс их электроформовки // Микроэлектроника. 2017. Т. 46. № 4. С. 266–274.
Мордвинцев В.М., Кудрявцев С.Е., Левин В.Л., Цветкова Л.А. Влияние давления газовой среды и длительности управляющих импульсов на стабильность характеристик элементов памяти на основе электроформованных структур Si–SiO2–W // Микроэлектроника. 2010. Т. 39. № 5. С. 337–347.
Мордвинцев В.М., Наумов В.В., Симакин С.Г. Исследование процесса образования окисной пленки нанометровой толщины на поверхности нитрида титана методом вторично-ионной масс-спектрометрии // Микроэлектроника. 2016. Т. 45. № 4. С. 258–272.
Мордвинцев В.М., Кудрявцев С.Е., Левин В.Л. Влияние толщины слоя диоксида кремния на процесс электроформовки в открытых “сэндвич”-структурах TiN–SiO2–W // ЖТФ. 2018. Т. 88. Вып. 11. С. 1681–1688.
Пипко А.И., Плисковский В.Я., Пенчко Е.А. Конструирование и расчет вакуумных систем. М.: Энергия. 1979. 504 с.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника


