Микроэлектроника, 2020, T. 49, № 4, стр. 281-286
Модифицирование диэлектрических свойств монокристалла TlGaS2 под воздействием электронного облучения
С. М. Асадов a, С. Н. Мустафаева b, *, В. Ф. Лукичев c, **
a Институт катализа и неорганической химии Национальной академии наук Азербайджана
AZ-1143 г. Баку, пр. Г. Джавида, 113, Азербайджан
b Институт физики Национальной академии наук Азербайджана
AZ-1143 г. Баку, пр. Г. Джавида, 131, Азербайджан
c Физико-технологический институт им. К.А. Валиева Российской академии наук
117218 г. Москва, Нахимовский пр-т, 36, корп. 1, Россия
* E-mail: solmust@gmail.com
** E-mail: lukichev@ftian.ru
Поступила в редакцию 16.01.2020
После доработки 27.01.2020
Принята к публикации 13.02.2020
Аннотация
Изучены диэлектрические свойства и ac-проводимость электронно-облученного слоистого монокристалла TlGaS2 в диапазоне частот 5 × 104–3.5 × 107 Гц. Установлено, что электронное облучение образцов монокристалла TlGaS2 дозами 2 × 1012–2.4 × 1013 э/см2 приводит к уменьшению действительной составляющей (ε') комплексной диэлектрической проницаемости в области высоких частот (f > 106 Гц), увеличению ее мнимой составляющей (ε''), тангенса угла диэлектрических потерь (tgδ) и ac-проводимости (σac) поперек слоев во всей изученной области частот. При дозах облучения 2 × 1012–2.4 × 1013 э/см2 в TlGaS2 имеют место потери сквозной проводимости и по мере накопления дозы электронного облучения значительно увеличивается дисперсия ε'' и tgδ. В области частот f = 5 × 104–2 × 107 Гц в облученных образцах TlGaS2 ac-проводимость изменялась по закону σac ∼ f n (где n = 0.7–0.8), характерному для прыжкового механизма переноса заряда по локализованным состояниям вблизи уровня Ферми. Оценены параметры локализованных состояний в TlGaS2 в зависимости от дозы электронного облучения: плотность состояний вблизи уровня Ферми и их энергетический разброс.
ВВЕДЕНИЕ
Двумерные соединения (2D) класса AIIIBVI имеют многообразные кристаллические модификации, проявляющие уникальные физические свойства. Это связано с особенностью строения электронных оболочек их атомов, позволяющих образовывать соединения с различной структурой [1–5]. Зонная структура 2D соединений класса AIIIBVI резко изменяется при переходе от объемных к пленочным образцам. Меняется структура запрещенной зоны, переходя от непрямой щели в объемных материалах AIIIBVI к прямой щели в монослоях. Это указывает на важную роль межслойной связи в 2D материалах. Их электронные свойства чувствительны к внешним воздействиям, таким как электрическое поле, температура, давление, ионизирующее излучение [5–10].
Тройные аналоги AIIIBVI, в частности, соединение TlGaS2, относятся к числу 2D кристаллов. Монокристалл TlGaS2 является высокоомным полупроводником и проявляет чувствительность к видимой и рентгеновской области спектра [11, 12], а также к γ-облучению [13]. В [14, 15] изучены диэлектрические свойства, dc и ас-проводимость монокристалла TlGaS2.
Диэлектрические свойства и ас-проводимость монокристалла TlGaS2 под воздействием электронного облучения до настоящего времени не изучены.
Цель настоящей работы – выяснение природы диэлектрических потерь и механизма переноса заряда на переменном токе электронно облученного монокристалла TlGaS2.
МЕТОДИКА ЭКСПЕРИМЕНТА
Согласно T–x диаграмме системы Ga2S3–Tl2S в ней образуется соединение состава TlGaS2. Поликристаллы TlGaS2 синтезировали из высокочистых химических элементов Ga, Tl (≥99.999%) и S (ОСЧ-17-3) в вакууме до 10–2 Па кварцевой ампуле [16]. Индивидуальность cинтезированного TlGaS2 контролировали методом рентгенофазового анализа. TlGaS2 имеет структуру с параметрами решетки: a = 10.2917; b = 10.2843; c = 15.1753 Å; β = 99.603° (пространственная группа C2/c) при комнатной температуре.
По данным дифференциально-термического анализа TlGaS2 плавится конгруэнтно при 1160 К. Из поликристаллов TlGaS2 выращивали монокристаллы методом Бриджмена–Стокбаргера. Монокристаллы TlGaS2 скалывали на пластинки толщиной ∼300 мкм и готовили образцы, на которые наносили контакты из серебряной пасты. Площадь контактов составляла ~0.25 см2. TlGaS2 является слоистым полупроводником с высоким удельным сопротивлением. Измеряли электрические и диэлектрические характеристики монокристаллических образцов из TlGaS2.
Диэлектрическую проницаемость (ε'), тангенс угла диэлектрических потерь (tgδ) и ac-проводимость (σac) образцов измеряли резонансным методом в диапазоне частот 50 кГц–35 МГц при Т = = 300 К [2]. Измеряемые образцы TlGaS2 помещали в экранированную ячейку. Перед измерениями образцы TlGaS2 облучали потоком электронов (e–) с энергией 4 МэВ на электронном ускорителе марки ЭЛУ-4. Дозу e–-облучения (D) образцов варьировали в пределах от 2 × 1012 до 2.4 × 1013 э/см2.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
На рис. 1 приведены частотные зависимости диэлектрической проницаемости образца TlGaS2 до и после e–-облучения различными дозами. Кривые зависимости ε'( f) до и после e– облучения характеризовались спадом в области частот 5 × 104–6 × × 106 Гц. Наблюдаемое в экспериментах монотонное уменьшение диэлектрической проницаемости монокристалла TlGaS2 с ростом частоты свидетельствует о релаксационной дисперсии. При частотах f > 6 × 106 Гц на кривых 1–4 рис. 1 спадающие ветви зависимости ε'(f) сменялись возрастающими. По мере накопления дозы e–‑облучения от 2 × 1012 до 2.4 × 1013 э/см2 диэлектрическая проницаемость монокристалла TlGaS2 уменьшалась в области высоких частот.
Рис. 1.
Частотная дисперсия диэлектрической проницаемости монокристалла TlGaS2 до (кривая 1) и после электронного облучения дозами D, э/см2: 2 – 2 × 1012; 3 – 6 × 1012; 4 – 2.4 × 1013.

Уменьшение значений ε' монокристалла TlGaS2 наблюдалось также под действием γ-облучения [13]. Причиной такого поведения ε' в TlGaS2 авторы считали радиационно-стимулированное старение образцов, связанное с активизацией процесса миграции естественных дефектов под влиянием γ-облучения. С этим, видимо, и связан характер зависимости параметра ε' образца TlGaS2 от дозы e–-облучения.
В отличие от ε' мнимая составляющая (ε'') комплексной диэлектрической проницаемости монокристалла TlGaS2, измеренная во всей области частот от 5 × 104 до 3.5 × 107 Гц, возрастала после e–-облучения (рис. 2). При этом по мере накопления дозы в образце значительно возрастала также дисперсия ε''.
Рис. 2.
Частотные зависимости мнимой составляющей комплексной диэлектрической проницаемости монокристалла TlGaS2 до электронного облучения (1) и после электронного облучения дозами D, э/см2: 2 – 2 × 1012; 3 – 6 × 1012; 4 – 2.4 × 1013.
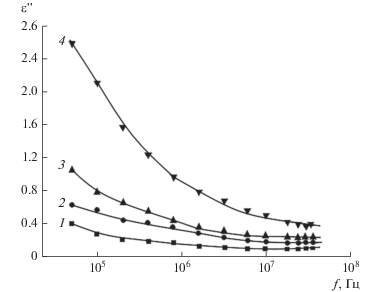
На рис. 3 приведена дозовая зависимость ε'' (D) монокристалла TlGaS2 при различных частотах. Наиболее крутая дозовая зависимость ε'' имела место при низкой частоте (кривая 1, рис. 3). Видно, что при при f = 5 × 104 Гц после максимальной дозы e–-облучения (D = 2.4 × 1013 э/см2) значение ε'' увеличивалось более чем в 6 раз по сравнению с ε'' необлученного образца TlGaS2. С ростом частоты зависимость ε'' (D) становилась более пологой (кривые 2 и 3, рис. 3).
Рис. 3.
Дозовые (электронное облучение) зависимости мнимой составляющей комплексной диэлектрической проницаемости монокристалла TlGaS2 на частотах f, Гц: 1 – 5 × 104; 2 – 2 × 105; 3 – 1.6 × 106.
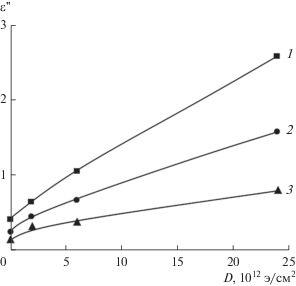
После электронного облучения увеличивался также тангенс угла диэлектрических потерь в TlGaS2 во всем изученном диапазоне частот (рис. 4). Наиболее существенное изменение tg δ за счет e–-облучения наблюдалось при f = 5 × 104 Гц, а при f > 107 Гц изменение tg δ было слабым. Характер частотной зависимости tg δ в монокристалле TlGaS2 до и после e–-облучения свидетельствует о потерях сквозной проводимости.
Рис. 4.
Частотные зависимости tgδ в монокристалле TlGaS2 до (1) и после электронного облучения дозами D, э/см2: 2 – 2 × 1012; 3 – 6 × 1012; 4 – 2.4 × 1013.
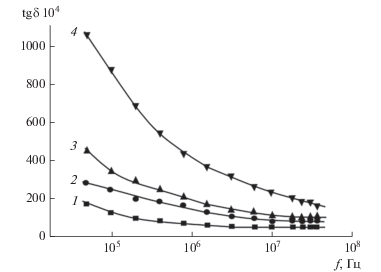
На рис. 5 представлены частотные зависимости ac-проводимости поперек слоев монокристалла TlGaS2 до (кривая 1) и после e–-облучения различными дозами (кривые 2–4).
Рис. 5.
Ac-проводимость монокристалла TlGaS2 в зависимости от частоты: 1 – до электронного облучения; 2, 3 и 4 – после электронного облучения дозами D, э/см2: 2 – 2 × 1012; 3 – 6 × 1012; 4 – 2.4 × 1013.

Отметим, что ac-проводимость существенно превышала dc-проводимость монокристалла TlGaS2 [15]. Из рис. 5 видно, что ac-проводимость монокристалла TlGaS2 после электронного облучения увеличивается.
Во всей изученной области частот ac-проводимость монокристалла TlGaS2 как до, так и после e–-облучения изменяется по закону σac ∼ f n. В области частот f = 5 × 104–2 × 105 Гц ac-проводимость TlGaS2 возрастала с частотой по закону f 0.6, а при f > 2 × 105 Гц –по закону f 0.8 вплоть до f = 2 × × 107 Гц. Далее наблюдался квадратичный участок σac ∼ f 2. Такого типа высокочастотная проводимость обусловлена оптическими переходами в полупроводниках [17].
После e–-облучения дозами D = 2 × 1012 и 6 × × 1012 э/см2 частотная зависимость ac-проводимости монокристалла TlGaS2 подчинялась закономерности σac ∼ f 0.7–0.8 при f = 5 × 104–2 × 107 Гц, а при f > 2 × 107 Гц имел место закон σac ∼ f 1.6. После e–-облучения дозой 2.4 × 1013 э/см2 во всей изученной области частот σac ∼ f 0.7 (кривая 4, рис. 5). Полученный нами вид зависимости σac ∼ f 0.7–0.8 свидетельствует о прыжковом механизме переноса заряда по состояниям, локализованным вблизи уровня Ферми [17].
По экспериментально найденным значениям σac(f) с помощью формулы [17]
(1)
${{{\sigma }}_{{{\text{ac}}}}}(f) = \frac{{{{{\pi }}^{3}}}}{{96}}~{{e}^{2}}kTN_{F}^{2}{{a}^{5}}f{{\left[ {\ln \left( {\frac{{{{{\nu }}_{{\text{ф}}}}}}{f}} \right)} \right]}^{4}},$Значения NF до и после e–-облучения монокристалла TlGaS2 приведены в табл. 1. При вычислениях NF для радиуса локализации монокристалла TlGaS2 взято значение а = 14 Å по аналогии с бинарными сульфидами [14]. Значение νф для TlGaS2 порядка 1012 Гц [18]. Из таблицы видно, что NF в TlGaS2 по мере роста дозы e–-облучения увеличивается.
Таблица 1.
Параметры локализованных состояний в запрещенной зоне монокристалла TlGaS2, полученные из высокочастотных диэлектрических измерений
| Доза электронного облучения, D, [э/см2] |
NF, [эВ–1 · см–3] | ΔE, [эВ] |
|---|---|---|
| 0 | 5.9 × 1018 | 0.15 |
| 2 × 1012 | 8.4 × 1018 | 0.106 |
| 6 × 1012 | 9.5 × 1018 | 0.094 |
| 2.4 × 1013 | 1.5 × 1019 | 0.066 |
По теории прыжковой проводимости в переменных электрических полях среднее расстояние прыжков (R) определяется по формуле [17]
где α – постоянная спада волновой функции локализованного носителя заряда ψ ~ e–αr, α = 1/a (a – радиус локализации); 1/f = τ – среднее время прыжков. Для образца TlGaS2 до и после e–-облучения дозами 2 × 1012 и 6 × 1012 э/см2 вычисленное по формуле (2) значение R составляло ∼81 Å, а среднее время прыжков τ = 10–7 с. После e–-облучения дозой 2.4 × 1013 э/см2 для R получено значение 78 Å, а для τ – 6.6 × 10–8 с.По формуле [17]:
оценили энергетический разброс локализованных вблизи уровня Ферми состояний (ΔE) в TlGaS2 до и после e–-облучения (табл. 1).
Данные табл. 1 показывают, что по мере накопления дозы e–-облучения в образце энергетическая полоса локализованных вблизи уровня Ферми состояний сужается. Как известно, облучение монокристалла не только вызывает рождение радиационных дефектов, но и стимулирует отжиг и миграцию имеющихся в кристалле дефектов [19]. Это и приводит, по-видимому, к энергетическому перераспределению локальных состояний в окрестности уровня Ферми, в частности, их уплотнению. Сужение полосы ΔE имело место также после гамма-облучения изоструктурного монокристалла TlInS2 [20 ] .
ЗАКЛЮЧЕНИЕ
Таким образом, облучение монокристалла TlGaS2 потоком электронов с энергией 4 МэВ и дозами D = 2 × 1012–2.4 × 1013 э/см2 приводит к изменению диэлектрических коэффициентов и ас-проводимости поперек слоев. Управление указанными параметрами за счет e–-облучения создает возможности применения монокристалла TlGaS2 для детектирования потока быстрых электронов.
Настоящая работа выполнена при финансовой поддержке Фонда развития науки при Президенте Азербайджанской Республики (гранты № EİF-BGM-3-BRFTF-2+/2017-15/05/1-M-13 и EİF-BGM-4-RFTF-1/2017-21/05/1-M-07).
Авторы заявляют, что у них нет конфликта интересов.
Список литературы
Лукичев В.Ф., Амиров И.И. Исследования и разработки в области микро- и наносистемной техники // История науки и техники. 2018. № 8. С. 92–99.
Asadov S.M., Mustafaeva S.N., Lukichev V.F., Guseinov D.T. Effect of the Composition on the Dielectric Properties and Charge Transfer in 2D GaS1 – xSex Materials // Russian Microelectronics. 2019. V. 48. № 4. P. 203–207.
Asadov S.M., Mustafaeva S.N., Lukichev V.F. Charge transport in layer gallium monosulfide in direct and alternate electric fields // Russian Microelectronics. 2019. V. 48. № 6. P. 422–427.
Gamal G.A., Azad M.I. Photoelectric studies of gallium monosulfide single crystals // J. Phys. Chem. Solids. 2005. V. 66. P. 5–10.
Shigetom S., Sakai K., Ikari T. Impurity Levels in Layered Semiconductor GaS Doped with Cu // Jpn. J. Appl. Phys. 2005. V. 44. № 3. P. 1306–1309.
Мустафаева С.Н., Асадов М.М., Исмаилов А.А. Перенос заряда по локализованным состояниям в монокристалле TlS // ФТТ. 2008. Т. 50. № 11. С. 1958–1960.
Мустафаева С.Н., Асадов М.М., Исмайлов А.А. Перенос заряда по локализованным состояниям в монокристаллах InSe и InSe〈Sn〉 // Физика низких температур. 2010. Т. 36. № 4. С. 394–397.
Мустафаева С.Н., Асадов М.М., Исмаилов А.А. Влияние легирования таллием на параметры локализованных состояний в монокристаллах p-GaSe // Неорганические материалы. 2011. Т. 47. № 9. С. 1040–1043.
Мустафаева С.Н., Асадов М.М. Комплексная диэлектрическая проницаемость и Ас-проводимость монокристаллов GaSe, выращенных из газовой фазы // Журн. радиоэлектроники. 2011. № 8. С. 1–9.
Mustafaeva S.N., Asadov M.M., Ismailov A.A. Dielectric and baric characteristics of TlS single crystal // PhysicaB: Physics of Condensed Matter. 2014. V. 453. P. 158–160.
Мустафаева С.Н. Фотоэлектрические и рентгендозиметрические свойства монокристаллов TlGaS2〈Yb〉 // ФТТ. 2005. Т. 47. № 11. С. 1937–1940.
Мустафаева С.Н. Фотоэлектрические и рентгенoдозиметрические свойства монокристаллов TlGa0.97Mn0.03S2 // Неорганические материалы. 2009. Т. 45. № 6. С. 659–662.
Шелег А.Н., Иодковская К.В., Курилович Н.Ф. Влияние γ-облучения на диэлектрическую проницаемость и элекропроводность кристаллов TlGaS2 // ФТТ. 2003. Т. 45. № 2. С. 68–70.
Мустафаева С.Н. Частотная дисперсия диэлектрических коэффициентов слоистых монокристаллов TlGaS2 // ФТТ. 2004. Т. 46. № 6. С. 979–981.
Мустафаева С.Н., Алиев В.А., Асадов М.М. Прыжковая проводимость на постоянном токе в монокристаллах TlGaS2 и TlInS2 // ФТТ. 1998. Т. 40. № 4. С. 612–615.
Mustafaeva S.N., Asadov M.M., Kyazimov S.B., Gasanov N.Z. T–x phase diagram of the TlGaS2–TlFeS2 system and band gap of TlGa1 – xFexS2 (0 ≤ x ≤ 0.01) single crystals // Inorganic Materials. 2012. V. 48. № 10. P. 984–986.
Mott N., Davis E. Electronic Processes in Non-Crystalline Materials. 2nd ed. Oxford: Clarendon Press; New York: Oxford University Press. 1979. 590 p.
Аллахвердиев К.Р., Виноградов Е.А., и др. Колебательный спектр кристалллов TlGaS2, TlGaSe2 и β‑TlInS2. В кн.: Физические свойства сложных полупроводников. Баку: Элм, 1982. С. 55–63.
Вавилов В.С., Кекелидзе Н.П., Смирнов Л.С. Действие излучений на полупроводники. М.: Наука, 1988. 191 с.
Мустафаева С.Н., Асадов М.М., Исмайлов А.А. Влияние γ-облучения на диэлектрические свойства и ас-проводимость монокристалла TlInS2 // ФТТ. 2009. Т. 51. № 11. С. 2140–2143.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника



