Микроэлектроника, 2019, T. 48, № 4, стр. 249-262
Оценка взаимосвязи скорости атомно-слоевого осаждения тонких пленок металлов платиновой группы и молекулярной массы реагентов-предшественников
В. Ю. Васильев *
Новосибирский государственный технический университет, кафедра полупроводниковых приборов
и микроэлектроники (ППиМЭ)
630073 г. Новосибирск, просп. К. Маркса, 20, Россия
* E-mail: vasilev@corp.nstu.ru
Поступила в редакцию 21.01.2019
После доработки 23.01.2019
Принята к публикации 23.01.2019
Аннотация
Применительно к технологиям микроэлектроники в работе обобщены результаты данных литературы по исследованиям атомно-слоевого осаждения (АСО) тонких пленок (ТП) металлов платиновой группы (Ru, Rh, Pd, Os, Ir, Pt) с участием различных типов реагентов-предшественников (прекурсоров) и вторых реагентов (O2, O3, H2 и т.д.). Обсуждается методика анализа данных кинетики АСО. При АСО металлического рутения скорости осаждения не превышают 0.15 нм/цикл. Установлена обратная зависимость предельной скорости роста при АСО от молекулярной массы прекурсоров. Для остальных ТП металлов группы скорости АСО находятся в интервале 0.03–0.07 нм/цикл, что в несколько раз меньше величин для монослоя этих металлов. Обсуждаются методические вопросы и приемы повышения достоверности кинетических данных для АСО, в частности, необходимость учета типов поверхностей образцов и эффектов нуклеационных задержек на начальных стадиях роста ТП металлов платиновой группы. Обсуждаются возможности протекания реакций химического осаждения с участием промежуточных продуктов при импульсном напуске реагентов.
ВВЕДЕНИЕ
Конструкционные материалы для микроэлектронных, микроэлектромеханических, оптических и других прецизионных приборных технологий применяются в виде тонких пленок с толщинами порядка единиц – сотен нанометров. Тонкие пленки (ТП) металлов и других проводящих материалов на различных по составу и размеров подложках (обычно – тонких дисках различного диаметра) традиционно получают низкотемпературными методами распыления (Physical Vapor Deposition, PVD) из соответствующих особо чистых мишеней. Для случаев сложных рельефов структур современных приборов (включающих вертикальные ступеньки, канавки и отверстия с вертикальными стенками) в силу направленности движения распыляемых частиц метод напыления не позволяет получать приемлемо равномерные (конформные) по толщине покрытия на разных участках поверхности структур. При предельной неконформности могут иметь место неприемлемые нарушения сплошности ТП в глубине рельефов структур приборов.
Использование методов химического осаждения из газовой фазы (ХОГФ) позволяет существенно улучшить конформность ТП. В зарубежной литературе методы ХОГФ именуются Chemical Vapor Deposition (CVD), а для металлических материалов также используется термин Metal-Organic Chemical Vapor Deposition (MOCVD). Методы ХОГФ основаны на использовании необратимых химических реакций исходных реагентов, к которым относятся источник основного компонента ТП и “вторые реагенты”, например, окислители (O2, O3, N2O), или восстановители (H2, NH3). При “традиционном” ХОГФ исходные химические реагенты подаются в реакционные камеры к нагретым подложкам одновременно и непрерывно. При этом выдерживаются определенные начальные условия (температура осаждения Td, давление, скорость потока реагентов) обеспечивающие концентрации реагентов в реакционных камерах порядка 10–4–10–6 моль/л. Такие концентрации реагентов обеспечивают высокие скорости наращивания ТП в диапазоне 10–100 нм/мин.
В ходе процессов ХОГФ имеют место явления массопереноса, многостадийное и многомаршрутное формирование и расходование промежуточных продуктов (ПП) реакций в газовой фазе (гомогенные процессы), превращение ПП на подложках и на стенках реакционных камер в растущую пленку (гетерогенные процессы). Конечным итогом процесса ХОГФ является формирование ТП с определенной скоростью наращивания (Wd), составом, структурой, физико-химическими и электрическими свойствами, зависящими от многих факторов. Последние являются предметом исследований и оптимизации процессов ХОГФ для получения необходимой совокупности характеристик ТП. Благодаря высоким скоростям наращивания, высокой производительности и адаптации оборудования под подложки диаметром до 300 мм процессы ХОГФ уже многие годы успешно используются в прецизионных технологиях и, прежде всего – в микроэлектронике [1, 2].
Однако нарастающее усложнение приборов по ходу развития технологий сохраняет актуальность получения конформных покрытий на рельефах с глубокими отверстиями/канавками. Для рельефов шириной к настоящему моменту времени всего в десятки нанометров традиционные методы ХОГФ обнаружили ряд ограничений конформности осаждения, обусловленных явлениями гомогенного формирования ПП и их массопереноса. Хотя для некоторых процессов ХОГФ удалось найти условия лимитирования процесса роста ТП на поверхности подложек, проблемы конформности для нарастающих по сложности рельефов приборов потребовали новых решений [2]. Еще одним ограничением является сложность управления традиционными процессами ХОГФ для получения ТП все меньшей толщины, требуемой для современных приборов. Одним из способов решения перечисленных выше ограничений стало использование вариантов методов ХОГФ – метода импульсного ХОГФ (pulsed-CVD) [2] и метода атомно-слоевого осаждения (АСО), по зарубежной терминологии – Atomic Layer Deposition (ALD) [3, 4]. В отличие от традиционного ХОГФ с одновременной и непрерывной подачей реагентов в этих процессах реагенты в реакционную камеру подаются импульсами. При организации импульсного процесса ХОГФ с последовательной подачей реагентов и промежуточными импульсными продувками инертными газами или вакуумной откачкой для удаления остатков предыдущего реагента процесс становится циклическим. В простейшем случае полный цикл такого процесса включает импульсы двух реагентов и два импульса продувки реакционной камеры. За один цикл осаждения происходит наращивание определенной толщины ТП, а полный процесс роста представляет собой сумму необходимого количества циклов. Циклическая организация процессов ХОГФ позволяет минимизировать взаимодействие реагентов в газовой фазе с образованием ПП, в результате чего химическая реакция локализуется на подложке с участием только гетерогенных процессов. Циклические процессы получения ТП рассматриваются наиболее перспективными для применения в будущих прецизионных технологиях.
ИМПУЛЬСНЫЕ ПРОЦЕССЫ ОСАЖДЕНИЯ ТОНКИХ ПЛЕНОК
При импульсном ХОГФ подача реагентов может осуществляться разными способами: (1) одновременными импульсами реагентов, (2) импульсами одного реагента при постоянном напуске другого, и (3) последовательными импульсами исходных реагентов с их разделением по времени импульсами продувочных газов и/или вакуумной откачкой. ХОГФ по способам (1), (2) фактически не цикличны и возможность протекания процессов в газовой фазе сохраняется, что является недостатком. Концентрации реагентов в реакционной камере в импульсе (фактически регистрируются как “подскок” давления) задаются дозами реагентов, например, с помощью вспомогательных откалиброванных камер известного объема на газовых линиях, в которые реагенты напускаются до определенного давления. Такие процессы используются при тех же температурах, что и традиционные ХОГФ. Достоинством импульсного ХОГФ является приемлемо высокие скорости осаждения и повышенная точность управления процессом за счет точного контроля и воспроизведения толщины ТП по количеству импульсов. Последнее важно для получения ТП малой толщины.
Вариант организации процесса импульсного ХОГФ, обозначенный выше как способ (3), является циклическим. Для него в единичном цикле осаждения используется только последовательный напуск реагентов, продувочных газов, а также промежуточная вакуумная откачка. Эти процессы могут использоваться при любой температуре осаждения, а регулирование доз реагентов проводится аналогично описанному выше.
Протекание процесса импульсного ХОГФ в общем случае можно описать следующим образом. Импульсный напуск исходного реагента в реакционную камеру может привести к следующим процессам:
– при высокой температуре – к частичному или полному термораспаду реагента в объеме или на подложке с образованием конечной ТП или ПП. Очевидно, что случай полного термораспада реагента просто не требует второго реагента. Если образуются ПП, то они могут либо удаляться из газовой фазы в ходе последующей продувки, либо оставаться на подложке. В последнем случае напуск второго реагента приводит к его реакции с ПП на подложке с образованием конечной ТП;
– при низкой температуре процессы в газовой фазе протекают с меньшей скоростью и более предпочтительными становятся процессы на подложке. Могут происходить процессы частичного термораспада реагента на подложке с образованием ПП и их последующими реакциями со вторым реагентом при его импульсе.
Однако при низкой температуре могут проявляться особенные гетерогенные процессы, которые легли в основу АСО. С точки зрения организации процесса циклический метод АСО правильно рассматривать как вариант импульсного ХОГФ с подачей реагентов по способу (3). Согласно основной идее АСО при определенных низких температурах в ходе импульса первого реагента (называемого в этом случае предшественник, или чаще всего – прекурсор, precursor) может происходить его самоограниченная адсорбция (self-limited adsorption) на нагретой поверхности подложки. Прекурсор покрывает подложку полностью, но при этом не происходит его частичного термораспада и превращений в ПП. После удаления из реакционной камеры газообразных остатков первого реагента путем продувки или вакуумной откачки, осуществляется напуск второго реагента. В результате происходит прямая реакция адсорбированного на поверхности подложки прекурсора с поступающим в ходе второго импульса вторым реагентом. При правильно выбранных дозах исходных реагентов в ходе такого взаимодействия в теории должно происходить формирование монослоя синтезируемого вещества за один полный цикл АСО.
Важно отметить, что для реализации идеи АСО необходимо экспериментально устанавливать существование довольно узких и специфичных для разных процессов температурных диапазонов, называемых “окно АСО” (“ALD window”), см. область I на рис. 1. Именно внутри этого “окна АСО” скорость наращивания должна быть постоянна в силу самоограничения адсорбцией. Вне этого диапазона (а для любых процессов ХОГФ это обычно подразумевает повышение температуры) возможны два варианта: либо имеют место десорбционные процессы, снижающие заполнение поверхности и приводящие к снижению скорости осаждения (область II), либо начинается развитие описанных выше процессов ХОГФ с существенным нарастанием скоростей наращивания (область III) и последующими ограничениями скорости из-за лимитирования процессами массопереноса (область IV).
Рис. 1.
Иллюстрация температурной зависимости скорости осаждения ТП при наличии “окна АСО” (область I) и десорбционных процессов (область II). Развитие процессов ХОГФ с участием гомогенных/гетерогенных процессов, контролируемых кинетикой реакции, происходит в области III, ограничения роста ТП явлениями массопереноса имеют место в области IV.
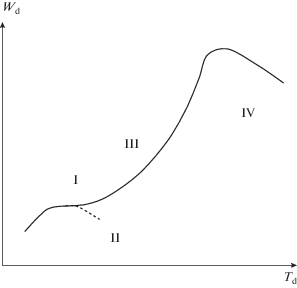
Таким образом, в областях I, III, IV могут использоваться любые способы реализации циклического импульсного ХОГФ (1), (2), (3). Если в ходе кинетических исследований с использованием способа (3) четко обнаруживается область I с примерно постоянной скоростью осаждения, то такой процесс получения ТП отвечает идее АСО благодаря реализации возможности самоограниченной адсорбции. Однако если скорость осаждения в области I заметно возрастает с ростом температуры, то однозначная трактовка результатов в пользу АСО является спорной. Как следствие прецизионного контроля толщины путем контроля количества циклов осаждения при АСО достигается высокая конформность осаждения ТП на различных участках рельефов. Принципиально важным является то, что объекты могут иметь рельеф повышенной сложности, что и послужило локомотивом исследований и использования метода АСО в современных микроэлектронных технологиях с нанометровыми размерами элементов.
Металлы платиновой группы (Ru, Rh, Pd, Os, Ir, Pt) благодаря своим уникальным физико-химическим свойствам в последние годы все активнее рассматриваются как потенциально пригодные материалы для новых прецизионных приложений [5, 6]. Привлекательными для технологий в целом являются высокие температуры плавления, устойчивость к часто используемым в технологиях окислительным процессам и химическим агентам, хорошая электропроводность (в том числе, например, оксидов рутения и иридия). Последнее делает данные металлы перспективными для использования в качестве проводящих ТП материалов. Например, с конца прошлого столетия развитие микроэлектроники в кратко-, средне- и долгосрочной перспективе детально прогнозировалось международной дорожной картой ITRS (International Technology Roadmap for Semiconductors), материалы которой публикуются на веб-сайте https://www.semiconductors.org в свободном доступе. Начиная с 2005 г. в разделе ITRS “Interconnect” (технология и материалы, используемые в межсоединениях микроэлектронных приборов) рассматривалась перспективность применения тонких слоев металлического рутения. Это стимулировало проведение исследований и публикационную активность по получению тонких пленок рутения во многих исследовательских центрах и лабораториях. При этом подавляющее большинство результатов исследований с участием самых различных прекурсоров рутения и вторых реагентов трактовались авторами как “АСО рутения”. К настоящему моменту времени в большей степени исследованы процессы получения ТП металлических Ru и Ir, в меньшей степени – ТП металлической Pt, а тонкие пленки остальных металлов группы изучены слабо.
ФОРМУЛИРОВКА ПРОБЛЕМ, ПОСТАНОВКА ЦЕЛИ И ЗАДАЧ
Обзор работ по АСО металлов платиновой группы выполнен в [5], результаты детальных обзоров по ХОГФ и АСО тонких пленок Ru и Ir применительно к нуждам микроэлектроники выполнены в работах [7, 8]. Проведенный анализ показал, что осаждение ТП проводилось из различных типов исходных прекурсоров, в состав молекул которых помимо металла входили С, Н, О, N, галогены, и т.д. Вторыми реагентами чаще всего служил кислород, смеси кислорода с азотом, озон, N2O, реже водород и аммиак. Использование сильных окислителей обусловлено необходимостью окисления органических групп в молекулах прекурсоров с образованием газообразных побочных продуктов реакций. В ряде публикаций использовали сложные комбинации вторых реагентов – последовательности окислитель → восстановитель. В этом случае восстановитель позволяет удалять оксидную фазу в свежеосажденном с использованием окислителя металле. В любом случае проблема чистоты получаемых ТП металлов является одной из важнейших, прежде всего по отношению к примесям углерода.
Ввиду потенциальной неконформности ТП при традиционных методах ХОГФ основное внимание в исследованиях последних лет справедливо уделяется циклическим процессам получения ТП. Здесь автор хотело бы отметить в качестве проблемы явную недостаточность, неполноту и, в ряде случаев, методическую ошибочность исследований кинетики роста ТП металлов платиновой группы при АСО, что характерно для многих опубликованных работ. Это может быть объяснено тремя причинами.
Первой причиной автор считает высокую стоимость экспериментальных исследований. Это обусловлено как стоимостью особо чистых прекурсоров, так и использованием специализированного оборудования для АСО для работы с подложками избыточно большого размера. По совокупности публикаций для ТП рутения можно видеть, что следствием является малый и/или сильно ограниченный объем кинетических экспериментов, который выполняется, например, для вновь синтезированных прекурсоров.
Второй причиной, по мнению автора, является частая ошибочность однозначной трактовки полученных результатов как АСО. Здесь важно отметить, что теоретическое монослойное осаждение практически редко реализуется, как правило, скорости наращивания существенно меньше. При этом фактические дозы реагентов, как правило, на порядки величин превышают необходимые для формирования слоя адсорбированного прекурсора. Свидетельством достижения “самоограниченной адсорбции” большинством авторов публикаций считаются кривые скоростей осаждения при увеличении времени импульса (t) прекурсора и второго реагента (см. пример в общем виде на рис. 2). Такие кривые в литературе приводятся, как правило, для произвольной температуры осаждения. Однако во многих случаях реального выхода кривых на насыщение не происходит, а удлинять время напуска реагентов (т.е. – их дозу) неприемлемо дорого. В связи с этим под выходом на “насыщение” (достижение самоограниченной адсорбции) принимается длительность импульса в точках, указанных стрелками на рис. 2. Далее, приняв существование “самоограниченной адсорбции” для какой-либо выбранной температуры, во многих случаях авторы весьма ограничено или вообще не исследуют температурные зависимости скоростей осаждения. При этом при “самоограниченной адсорбции” в условиях больших запасов по дозе реагентов, объяснения крайне малых скоростей наращивания за цикл осаждения (зачастую в десятки раз меньше монослоя) авторами не приводятся. Кроме того, во многих работах температурные зависимости скорости наращивания имеют резко возрастающий характер, как показано на рис. 1 в виде области III, что некоторыми авторами также трактуется как АСО.
Для ТП металлов платиновой группы наличие “окон АСО” фактически подтверждено в очень редких случаях [8]. При этом скорости осаждения в них также были существенно менее монослоя за цикл, что, строго говоря, не соответствует идее АСО. В целом рост менее монослоя при АСО отмечался для многих типов ТП материалов, а попытки объяснения, например, в [9], связывали это, в том числе, с размерами молекул прекурсоров. С точки зрения логики обратная зависимость скорости осаждения от размера молекулы прекурсора может быть понятна как геометрические ограничения размещения молекул прекурсоров на поверхности. Однако, как именно происходит адсорбция сложных прекурсоров на настоящий момент времени неизвестно.
Третьей причиной, общей для АСО металлов платиновой группы, автор считает наличие т.н. “нуклеационной задержки” (nucleation delay, incubation period), см. пример на рис. 3. Суть такой задержки заключается в отсутствии роста ТП в течение многих десятков и даже сотен единичных циклов (N) из-за отсутствия центров роста. В отсутствии нуклеационных задержек прямые начинаются прямо из начала координат (прямая 2 на рис. 3). Длительность нуклеационных задержек зависит от температуры осаждения, материала поверхности подложки, характеристик прекурсоров и т.д. В итоге рост ТП для всех металлов платиновой группы происходит медленно, по островковому механизму, на зародышах, хаотично формирующихся во время первых циклов осаждения. С точки зрения свойств, зернистая структура ТП в совокупности с пониженной толщиной и наличием примесей углерода оказывает неприемлемое ухудшение электропроводности металлических пленок. Нуклеационные задержки при росте ТП оказывают негативное влияние на правильность трактовки результатов кинетических исследований. Для улучшения нуклеации используется ряд приемов, особенно популярным является плазменная активация вторых реагентов, использование озона в качестве второго реагента, обработка поверхности подложки, применение затравочных сверхтонких слоев металлов [7, 8]. Такие приемы, в частности, позволили в некоторых случаях выделить “окна АСО” на кинетических кривых, типа приведенной на рис. 1. Отметим, что синтез многочисленных разнообразных прекурсоров для получения ТП рутения также проводился с целью поиска наилучшего, минимизирующего длительность нуклеационных задержек.
Рис. 3.
Зависимости толщины ТП (D) при АСО от количества циклов осаждения (N) с нуклеационной задержкой (нулевой толщиной) на начальном этапе роста 1 и без задержки 2.
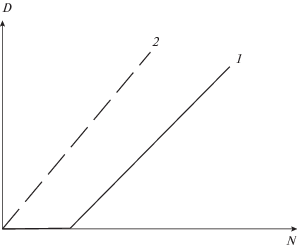
К настоящему моменту времени исследования кинетики роста ТП металлов платиновой группы при АСО явно недостаточны, а трактовка многих результатов достаточно спорна. Методы ХОГФ и импульсного ХОГФ при приемлемых скоростях наращивания и свойствах ТП потенциально имеют ограничения по конформности осаждения на сложных рельефах приборов. Напротив, метод АСО, демонстрируя явные преимущества по конформности осаждения, однозначно является перспективным. Однако во многих случаях он дает скорости роста для ТП металлов платиновой группы существенно ниже предполагаемого теоретического монослоя за один цикл осаждения для всех исследованных прекурсоров и условий.
Целью настоящей работы является поиск и оценка взаимосвязей скоростей наращивания и молекулярной массы реагентов-предшественников при АСО ТП металлов платиновой группы на основании обобщения результатов опубликованных исследований. Этот вопрос в литературе пока не освещен и рассматривается автором как важнейшая составляющая кинетических исследований. Несмотря на явное преобладание публикаций по рутению, в работе анализируются опубликованные результаты исследований всех металлов платиновой группы. Такой подход объясняется, с одной стороны, возможным интересом и к другим, пока что слабо исследованным, представителям группы, а с другой стороны – явным сходством подходов при АСО с точки зрения применяемых типов, составов прекурсоров, и методов синтеза с их участием.
К задачам работы автор отнес следующие:
– формулировка методики анализа данных;
– поиск и анализ результатов исследований температурных зависимостей скоростей осаждения при АСО для разных типов прекурсоров, вторых реагентов, для разных металлов платиновой группы;
– обобщение результатов и выявление взаимосвязей скоростей наращивания и характеристик прекурсоров для АСО металлов платиновой группы.
МЕТОДИКА АНАЛИЗА ДАННЫХ
При анализе были использованы систематизированные данные обзорных работ [5, 7, 8], дополненные данными из более поздних публикаций (см. табл. 1). Сведения о свойствах прекурсоров могут быть найдены в [7, 8].
Таблица 1.
Обобщение результатов опубликованных работ
| Металл (АМ) |
Предшественник | MM | Второй реагент* |
Td (°C) | Wd (нм/цикл) | m | Ссылка |
|---|---|---|---|---|---|---|---|
| Ru (101.07) |
RuCp2 | 231.3 | O2 | 225…400 | 0.01…0.12 | 0.44 | [5] |
| Ru(EtCp)2 | 287.4 | O2 | 270…300 | 0.04…0.10 | 0.35 | [5] | |
| O3 | 225; 250; 275 | 0.09; 0.11; 0.12 | [11] | ||||
| (EtCp)Ru(dmpd) | 261.3 | O2 | 210…290 | 0.02…0.05 | 0.39 | [5] | |
| (EtCp)Ru(MeCp) | 273.4 | O2 | 250; 275…300 | 0.02…0.03; 0.04…0.05 | 0.37 | [12] | |
| (Me2NEtCp)RuCp | 302.1 | O2 | 325…350; 375; 400…450; 500 | 0.02; 0.04; 0.05; 0.08 | 0.33 | [13] | |
| Ru(dmpd)2 | 291.4 | O2 | 175…210; 225…250 | 0.005; 0.01 | 0.34 | [14] | |
| Ru(tBu-Me-amd)2(CO)2 | 495.2 | O2 | 300; 325 | 0.05; 0.10 | 0.20 | [15] | |
| NH3 | 250; 280; 300 | 0.008; 0.03; 0.07 | [16] | ||||
| Ru(od)3 | 524.3 | O2 | 275; 325; 400 | 0.06; 0.08; 0.1 | 0.19 | [17] | |
| Ru(tmhd)3 | 650.9 | O2 | 250; 325; 350…400; 450 | 0.02; 0.03…0.04; 0.04; 0.05 | 0.16 | [18, 19] | |
| Ru(Cp)(CO)2Et | 251.1 | O2 | 300 | 0.085 | 0.40 | [20] | |
| RuO4 | 165.1 | H2 | 100…175; 200…225; 250 | 0.13; 0.14; 0.15 | 0.61 | [21] | |
| Ru(Me-Me2-chd)2 | 321.1 | O2 | 200; 235; 250…310; 325 | 0.01; 0.03; 0.05; 0.02 | 0.31 | [22] | |
| (Et-Be)Ru(Et-chd) | 315.1 | O2 | 225 | 0.04 | 0.32 | [23] | |
| (EtCp)Ru(Py) | 261.2 | O2 | 275; 300; 325; 350 | 0.04; 0.03; 0.05; 0.055 | 0.36 | [24] | |
| Ru(Me2Py)2 | 291.2 | O2 | 250; 300 | 0.02; 0.06 | 0.35 | [25] | |
| Ru(CO)3(chd) | 265.1 | NH3, N2O | 200 | 0.15 | 0.38 | [26] | |
| RuC16H22O6 (beta-diketonate) |
411.1 | H2 | 250 | 0.12 | 0.24 | [27] | |
| NH3* | 225 | 0.063 | [28] | ||||
| Rh (102.91) |
Rh(acac)3 | 400.2 | O2 | 225; 250; 275; 310 | 0.05; 0.06; 0.1; 0.09 | 0.26 | [29] |
| O3 → H2 | 160…180 | 0.02…0.03 | [30] | ||||
| Pd (106.42) |
Pd(hfac)2 | 520.5 | H2 | 80; 130 | 0.020; 0.025; 0.01 | 0.20 | [31, 32] |
| H2* | 100 | 0.017; 0.02 | [33] | ||||
| H2* → O2* | 100 | 0.013 | [34] | ||||
| CH2O | 200 | 0.015; 0.022; 0.033 | [10, 35] | ||||
| Pd(keim2)2 | 630.4 | O2 | 250 | 0.06 | 0.17 | [36] | |
| Pd(thd)2 | 472.9 | O3 → H2 | 140 | 0.04; 0.09 | 0.22 | [30] | |
| Os (190.20) |
OsCp2 | 320.2 | O2 | 300; 325; 350; 375 | 0.005; 0.023; 0.03; 0.03 | 0.59 | [37] |
| Ir (192.22) |
Ir(acac)3 | 489.5 | O2 | 225…400 | 0.02…0.08 | 0.39 | [5] |
| O3 → H2 | 165…200 | 0.02 | [38] | ||||
| (EtCp)Ir(cod) | 393.5 | O2 | 240; 270; 300…420 | 0.02; 0.03; 0.04 | 0.49 | [39, 40] | |
| (MeCp)Ir(chd) | 315.0 | O2 | 225; 300; 350 | 0.02; 0.03; 0.03 | 0.54 | [41] | |
| O3 → H2 | 120; 180 | 0.02; 0.03 | [42] | ||||
| Pt (195.08) |
Pt(acac)2 | 393.3 | O3 | 140; 150…170; 200 | 0.05; 0.06; 0.07 | 0.49 | [43] |
| O3 → H2 | 120…130 | 0.03 | [30] | ||||
| MeCpPtMe3 | 319.3 | O2 | 200…350 | 0.01…0.06 | 0.61 | [5] | |
| O2 → H2 | 300 | 0.03 | [44] |
При поиске результатов фиксировалась следующая информация, необходимая для адекватного обобщения:
– метод получения ТП, постулированный авторами исследования (импульсный ХОГФ или АСО);
– тип оборудования, размер подложек, тип поверхности подложек;
– тип исходного прекурсора, а также применяемые вторые (а в ряде случаев – и третьи) вещества;
– длительность цикла осаждения;
– подтверждение авторами работ получения кривых выхода скоростей осаждения на постоянные величины насыщения (по длительности цикла или дозе вещества), которые однозначно отвечают термину “скорость наращивания Wd”. Эти данные свидетельствуют в пользу того, что осаждение проводилось в избыточных дозах реагентов, т.е. они не лимитировали процессы роста ТП.
Анализу подвергались экспериментальные результаты по диапазонам исследованных температур (Td) и полученным для них экспериментальным величинам Wd. Здесь необходимо отметить следующие важные моменты:
– для упрощения под “величинами скоростей осаждения, равными монослою” автор подразумевает величину 0.27 нм/цикл, что отвечает примерному удвоенному значению усредненных справочных величин для радиусов атомов металлов платиновой группы. Такой подход может давать несколько завышенные величины (например, толщина монослоя Pd в работе [10] оценена в 0.245 нм), однако для цели настоящей работы вполне приемлем.
Процессы АСО исследовались различными группами, а приведенные результаты обнаружили несколько типичных по форме температурных зависимостей (см. рис. 4 для рутения). Можно видеть характерные для большинства публикаций пологие, чуть нарастающие зависимости, приведенные авторами в одной работе, резко нарастающие зависимости (похожие на приведенную на рис. 1 зависимость) и разные группы точек, полученные для одного прекурсора разными группами авторов. При анализе не принимались во внимание довольно немногочисленные точки на резко возрастающих участках точки (показаны стрелками на рис. 4), априори не соответствующие идее АСО на рис. 1;
Рис. 4.
Примеры обнаруженных экспериментальных температурных зависимостей роста ТП рутения из разных прекурсоров для пояснения методики анализа данных. Прекурсоры: 1 – RuO4; 2 – Ru(tmhd)3; 3 – RuCp2; 4 – Ru(tBu-Me-amd)2(CO)2.

– величины скоростей наращивания для конкретной температуры осаждения Wd (нм/цикл).
ОБОБЩЕНИЕ И ОБСУЖДЕНИЕ РЕЗУЛЬТАТОВ
Следующие исходные данные сведены в таблице со ссылками на исходные источники информации:
– справочные данные для атомной массы (АМ) металлов платиновой группы;
– тип прекурсора (в общепринятом написании в зарубежной литературе);
– молекулярная масса прекурсора MM (либо справочная величина, либо приведенная авторами публикаций, либо рассчитанная автором по брутто-формулам для новых прекурсоров, восстановленным из их схематического изображения);
– тип второго реагента;
– исследованные величины температур осаждения Td (°C);
Отметим, что большинство авторов позиционировало свои исследования как АСО, а в качестве подложек большей частью использовались кремний, диоксид кремния и подложки, покрытые тонким слоем оксида алюминия, выращенного методом АСО.
Данные по скоростям осаждения для исследованных температур приведены в табл. 1. Для прекурсоров RuCp2, Ru(EtCp)2, (EtCp)Ru(dmpd), Ir(acac)3, MeCpPtMe3 исследования АСО выполнялись очень многими авторами и систематизированы в [5]. Для этих прекурсоров по данным [5] были определены крайние точки исследованных температур и соответствующие им крайние точки скоростей наращивания, приведенные в табл. 1. При графическом обобщении результатов для этих прекурсоров автор использовал все фактические температурные точки из публикаций, приведенные в [5].
По приведенным в табл. 1 данным можно сделать следующие выводы:
– для получения ТП использованы самые различные типы прекурсоров (в особенности – для рутения), в составе которых присутствуют разнообразные органические группы. Некоторые особо сложные рутениевые прекурсоры были позиционированы авторами как решение проблем с нуклеацией;
– исследованный температурный диапазон для всех металлов платиновой группы составлял 150–500°С. Отметим, что температуры осаждения 300–500°С типичны для традиционных ХОГФ металлов платиновой группы [7, 8]. В конкретных работах температурные диапазоны обычно составляют не более ста градусов Цельсия. Это превышает разумные величины, предполагаемые идеей АСО (обычно не более нескольких десятков градусов). Тем не менее, для анализа результатов такие данные использованы как соответствующие АСО. Заведомо неприемлемые для АСО завышенные величины скоростей роста ТП, как было отмечено выше, не принимались во внимание;
– по многочисленным данным для АСО металлического рутения скорости осаждения не превышают 0.12 нм/цикл, что примерно вдвое меньше предположенной величины монослоя. Максимальную скорость осаждения 0.15 нм/цикл обнаружил прекурсор с минимальной массой RuO4, для самого массивного прекурсора Ru(tmhd)3 максимальная скорость роста составляла около 0.05 нм/цикл. Минимальные величины скоростей осаждения составляют менее 0.01 нм/цикл.
В качестве основной характеристики для сравнения результатов автор выбрал массу прекурсора, в связи с чем хотел бы отметить следующее. Величины молекулярной массы прекурсоров известны или могут быть легко рассчитаны по бруто-формулам. Как уже отмечалось выше, меньшие скорости наращивания при использовании различных прекурсоров связывались с большей занимаемой площадью на поверхности подложки [9], допуская различные варианты расположения молекул прекурсоров на подложке при адсорбции. Поскольку расположение прекурсоров на поверхности неизвестно, использование их геометрических размеров для сравнения и обобщения результатов невозможно. Еще одним параметром для сравнения можно было бы рассматривать температуры кипения прекурсоров и давления их паров – типичные характеристики прекурсоров. Однако поскольку на практике используется многократное превышение доз прекурсоров при АСО, учет этих параметров также не имеет смысла.
Построенный по данным табл. 1 график зависимости скорости осаждения от молекулярной массы прекурсоров приведен на рис. 5. Отметим, что в данном случае построения графика температура осаждения как таковая была исключена как параметр, поскольку выше было допущено, что для каждого процесса авторы определили “окно АСО”. Однако возрастающие в вертикальном направлении по величине Wd точки для выбранного прекурсора примерно соответствуют возрастанию Td.
Рис. 5.
Зависимости скоростей роста при АСО для металлов платиновой группы от молекулярной массы прекурсора. Пунктиром показан принятый в работе уровень монослоя для металлов платиновой группы.
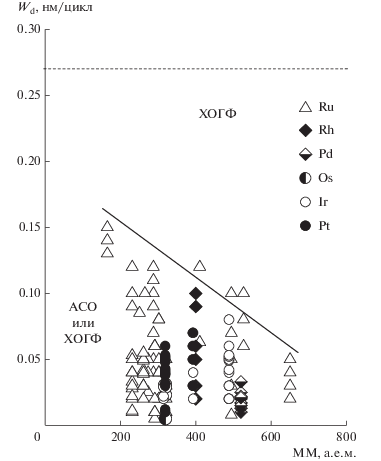
На графике по величинам максимальных экспериментально найденных скоростей осаждения рутения проведена наклонная прямая линия. Положение линии достаточно условно, поскольку она проведена с учетом принятых выше допущений по отсеиванию экспериментальных точек с аномально для высокими АСО скоростями роста. Можно допустить, что в случае появления большего количества экспериментальных кинетических данных положение прямой может быть уточнено. Однако это уточнение можно ожидать скорее в сторону ее снижения положения прямой по оси ординат.
Наклон линии определенно указывает на тенденцию снижения предельно достижимой скорости осаждения при АСО для прекурсоров с большей молекулярной массой. Представляется, что выше проведенной прямой рост ТП платиновых металлов в соответствии с идеей АСО не происходит. Весь массив экспериментальных данных находится ниже проведенной прямой. Для Rh, Pd, Os, Ir, Pt скорости АСО находятся в интервале 0.03–0.07 нм/цикл, каких-либо зависимостей для них не обнаруживается. Этот диапазон величин скорости наращивания в несколько раз меньше теоретических величин для монослоя этих металлов, очерченного пунктиром на рис. 5.
Для анализа было предположено, что более информативно взаимосвязь скорости осаждения и молекулярной массы прекурсоров может отразить параметр “массовая доля металла в молекулярной массе прекурсора, m”. Расчетные данные для m приведены в табл. 1, а график зависимости в координатах Wd – m приведен на рис. 6. Проведенная на рисунке прямая линия для данных по рутению показывает тенденцию в направлении к монослойному росту с ростом доли массы металла в массе прекурсора. Действительно, мысленная аппроксимация прямой для условного прекурсора с массовой долей рутения 1.0 приближается к величине монослоя.
Рис. 6.
Зависимости скоростей АСО для металлов платиновой группы от доли массы металла в прекурсоре. Пунктиром показан принятый уровень монослоя для металлов платиновой группы.
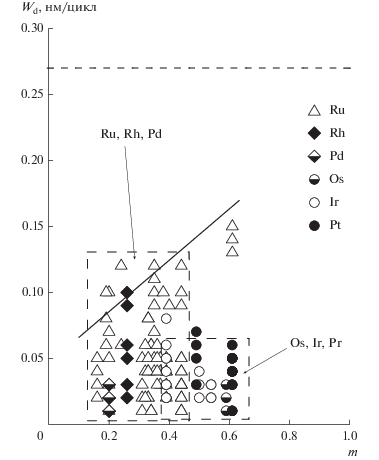
При обсуждении полученных результатов остановимся на нескольких важных вопросах.
1. Одной из причин существенно (в наиболее типичном случае – в пять-десять раз) меньшей монослоя скорости осаждения автор считает отсутствие определенности в учете явлений нуклеации. В рассмотренных публикациях были использованы различные поверхности: кремний, диэлектрики, металлы. Как правило, вопросы подготовки поверхности подложек перед АСО рассматриваются в публикациях очень сжато или не приводятся вообще. В ряде публикаций [10, 30, 35–37, 43] осаждение проводилось на тонкие пленки оксида алюминия методом АСО, свежеосажденные в той же реакционной камере до процесса АСО металлов. Такой прием позволяет воспроизводить свойства поверхности перед экспериментами, однако не исключает проявления нуклеационных задержек.
2. Улучшение нуклеационных свойств поверхностей позволяет существенно увеличить скорости наращивания и, в частности, четко выделять “окна АСО”. В частности, использование металлических затравок PtPd нанометровой толщины позволило получать ТП рутения из прекурсора Ru(CO)3(chd) и NH3, N2O [26] в области температур 110–180°С, чего не наблюдалось на кремнии и диэлектрических поверхностях. Авторами [38, 42] при использовании “двойного” второго реагента (импульса озона с последующим за ним импульсом водорода) были четко выделены “окна АСО” на возрастающих кинетических кривых при получении иридия из прекурсоров Ir(acac)3 и (MeCp)Ir(chd) в присутствии кислорода. Аналогичные результаты были получены для платины [30]. При этом не обнаруживается монослойное осаждение, что указывает на существование и иных влияющих факторов, помимо замедленной нуклеации.
3. На рис. 6 пунктирными областями объединены экспериментальные точки для подгрупп Ru, Rh, Pd и Os, Ir. Pt. Можно видеть, что для почти вдвое более тяжелых металлов Os, Ir, Pt скорости осаждения примерно вдвое ниже, при этом не обнаруживая какого-либо тренда. Пока объяснения этому нет, возможно необходимо выполнение большего числа исследований.
Возможной причиной снижения скоростей осаждения при возрастании молекулярной массы исследованных прекурсоров может быть неполное окисление последних при импульсах окислительных реагентов. Действительно для массивных прекурсоров необходимо короткими импульсами (для увеличения производительности процессов длительности циклов принято сокращать) окислять с переводом в газовую фазу большие органические группы в прекурсорах. Во многих случаях эти группы имеют различную природу и часть групп (прежде всего – углеродсодержащих) может окисляться не полностью и оставаться на поверхности. Это замедляет формирование ТП при последующем цикле осаждения. В пользу этого объяснения свидетельствует островковый механизм роста ТП всех металлов платиновой группы на редких зародышах, на которых при самых низких температурах формируются крупные зерна металлов [45].
4. Проведенные на рис. 5, 6 прямые достаточно условны, поскольку основаны на обоснованной автором методике анализа опубликованных температурных зависимостей. Обращаясь к кривым на рис. 4 автор хотел бы подчеркнуть, что резко возрастающие кинетические кривые указывают скорее на рост ТП в соответствии с обычными механизмами ХОГФ с образованием и расходованием ПП. Поскольку величины скоростей осаждения для резко возрастающих кривых находятся выше прямой на рис. 5, процессы роста ТП в этой области можно однозначно характеризовать как процессы ХОГФ.
5. В области скоростей осаждения ниже прямой на рис. 5 автор предполагает возможность реализации как АСО, так и ХОГФ с образованием и расходованием ПП. Процесс АСО по своей идее предполагает только прямое взаимодействие адсорбированного прекурсора и второго реагента в одну стадию. Для “окна АСО” температурная зависимость должна отсутствовать, то есть должны иметь место низкие и близкие по величине скорости наращивания. Однако на настоящий момент времени для металлов платиновой группы это подтверждено очень небольшим количеством публикаций.
В случае невозможности четкого выделения “окна АСО” следует также рассматривать возможность протекания реакций частичного термического разложения прекурсора в ходе его импульса и последующей продувки. Действительно, при длительностях импульсов порядка секунд такие реакции вполне могут иметь место. Для исключения сомнений в возможности протекания реакций ХОГФ целесообразно исследовать температурные зависимости процессов с участием только исходного прекурсора. Такие исследования, например, были выполнены автором в работе [45] и позволили обнаружить возможность роста ТП с низкой, но значимой, скоростью непосредственно из прекурсора Ru(CO)3(chd).
Таким образом, в случае обнаружения значимой скорости наращивания при термораспаде прекурсора предположения о процессе АСО в этих условиях будут ошибочными. При этом надо учитывать, что проявление процесса с малой скоростью может существенно тормозиться нуклеационными явлениями и для его обнаружения потребуется увеличенная длительность циклов осаждения.
Несмотря на возможность протекания явлений термораспада прекурсора в ходе импульса его подачи в реакционную камеру вторые реагенты могут оказывать сильное влияние на скорость осаждения, увеличивая ее в разы [46]. Было показано, что предполагаемый промежуточный продукт реакции термического разложения прекурсора Ru(CO)3(chd) в дальнейшем по-разному реагирует с индивидуальными вторыми реагентами (NH3, N2O), а также с их последовательностями (NH3 → N2O или N2O → NH3).
Таким образом, в области ниже прямой на рис. 5 формирование ТП может иметь место и при ХОГФ, и при АСО. В настоящий момент времени по совокупности обобщения экспериментальных данных автор склоняется в пользу процессов ХОГФ для большинства изученных процессов осаждения металлов платиновой группы.
ЗАКЛЮЧЕНИЕ
Скорости осаждения рутения при АСО максимальны среди металлов платиновой группы, достигают 0.15 нм/цикл для прекурсора RuO4 и обнаруживают обратную зависимость от молекулярной массы прекурсоров. Это наблюдение может указывать на необходимость переоценки целесообразности усложнения молекул прекурсоров. Для остальных металлов группы скорости осаждения находятся в интервале 0.03–0.07 нм/цикл, что в несколько раз меньше теоретических величин для монослоя этих металлов. Прекурсоры с тяжелыми металлами группы Os, Ir, Pt обнаруживают примерно вдвое меньшие величины скоростей осаждения, чем прекурсоры Ru, Rh, Pd.
В настоящий момент времени причины очень малых скоростей наращивания ТП металлов платиновой группы не ясны, также как и причины островкового роста ТП и присутствия в ТП значительного количества примесей. Результаты кинетических исследований, опубликованных к настоящему моменту времени, не дают ответов на многие вопросы и, прежде всего, на вопрос о том, какие прекурсоры могут быть максимально приемлемыми для перспективных технологий.
Автор считает, что для ответов на эти вопросы необходимо проведение адекватных кинетических исследований в условиях устранения ограничений, вызываемых нуклеационными явлениями. Это можно подтвердить, получив зависимости роста, подобные прямой 2 на рис. 3. Подготовка подложек для исследований процессов АСО металлов платиновой группы является отдельной задачей. По сути, только первые импульсы прекурсоров и, соответственно, первые циклы роста определяют всю последующую кинетику роста ТП.
Вопрос унификации поверхности подложек для исследований пока еще открыт. По мнению автора, одним из приемлемых вариантов проведения кинетических исследований и поиска “окон АСО” для металлов платиновой группы может быть использование подложек с затравками нанометровой толщины из тех же металлов, но полученных “чистыми” методами, например, распылением из особо чистых мишеней. Такой прием полностью снимет искажения кинетических исследований, связанные с невоспроизводимостью нуклеационных задержек.
Для оценки возможности существования реакций термораспада прекурсоров без участия вторых реагентов целесообразно регистрировать температурные зависимости не только для роста ТП со вторыми реагентами, но также и без них. Регистрация кривых скоростей насыщения по реагентам (рис. 2) должна выполняться для всего изучаемого температурного диапазона, что позволит определить температуру начала перехода процесса в область протекания по механизмам ХОГФ.
Совокупность описанных выше методических приемов даст возможность количественно оценить и сравнить в идентичных начальных условиях эффективность различных (в том числе и по массе) прекурсоров как с точки зрения ростовых характеристик и возможности реализации АСО, так и с точки зрения чистоты металлических материалов и из структуры. Такой подход, кроме того, позволит существенно снизить затраты на экспериментальные работы для исследований АСО других металлов платиновой группы.
Материал публикации был использован автором в составе стендового доклада на 2-м Международном семинаре по атомно-слоевому осаждению (ALD-2017) в Санкт-Петербурге, 24–30 сентября 2017 г., тезисы докладов, с. 62.
Список литературы
Xia L.-Q., Chang M. Chemical Vapor Deposition / In Handbook of Semiconductor Manufacturing Technology, second edition. Ed. by Doering R. and Nishi Y. // CRC press, 2008. P. 13-1–13-87.
Vasilyev V.Yu. Thin Film Chemical Vapor Deposition in Integrated Circuit Technology: Equipment, Methodology and Thin Film Growth Experience / N.Y.: Nova Science Publishers, Inc.: 2014. 314 p.
Ritala M., Leskelä M. / In Handbook of Thin Film Materials. V. 1. Nalwa H.S. Ed. Academic Press. San Diego. 2001. P. 103–159.
George S.M. Atomic Layer Deposition: An Overview // Chem. Rev. 2010. V. 110. № 1. P. 111–131
Hamalainen J., Ritala M., Leskelä M. Atomic Layer Deposition of Noble Metals and Their Oxides // Chemistry of Materials. 2014. V. 26. № 1. P. 786–801.
Васильев В.Ю. Сверхтонкие пленки металлов платиновой группы для применения в микро- и нанотехнологиях // Нано- и микросистемная техника. 2016. Т. 18. № 7. Р. 454–464.
Васильев В.Ю., Морозова Н.Б., Игуменов И.К. Химическое осаждение рутенийсодержащих тонких пленок из газовой фазы // Успехи химии. 2014. Т. 83. № 8. С. 758–782.
Vasilyev V.Yu., Morozova N.B., Basova N.D., Igumenov I.K., Hassan A. Chemical Vapour Deposition of Ir-based coatings: chemistry, processes and applications // RCS Advances. 2015. V. 5. P. 32034–32063.
Puurunen R.L. Surface chemistry of atomic layer deposition: A case study for the trimethylaluminum/water process // J. Appl. Phys. 2005. V. 97. paper № 121301 (52 pages).
Elam J.W., Zinovev A., Han C.Y., Wang, H.H., Welp U., Hryn J.N., Pellin M.J. Atomic Layer deposition of palladium films om Al2O3 surfaces // Thin Solid Films. 2006. V. 515. № 1–2. P. 1664–1673.
Kim J.-Y., Kil D.-S., Kim J.-H., Kwon S.-H., Ahn J.-H., Roh J.-S., Park S.-K. Ru Films from Bis(ethylcyclopentadienyl)ruthenium Using Ozone as a Reactant by Atomic Layer Deposition for Capacitor Electrodes // J. Electrochem. Soc. 2012. V. 159. № 6. P. H560–H564.
Kukli K., Aarik J., Aidla A., Uustare T., Jogi I., Lu, J., Tallarid M., Kemell M., Kiisler A.-A., Ritala M., Leskelä M. Structure and morphology of Ru films grown by atomic layer deposition from 1-ethyl-1'-methyl-ruthenocene // J. Cryst. Growth. 2010. V. 312. № 12–13. P. 2025–2032.
Kukli K., Ritala M., Kemell M., Leskelä M. High Temperature Atomic Layer Deposition of Ruthenium from N,N-Dimethyl-1-ruthenocenylethylamine // J. Electrochem. Soc. 2010. V. 157. № 1. D35–D40.
Methaapanon R., Geyer S.M., Lee H.-B.-R., Bent S.F. The low temperature atomic layer deposition of ruthenium and the effect of oxygen exposure // J. Mater. Chem. 2012. V. 22. P. 25154–25160.
Wang H., Gordon R.G., Alvis R., Ulfig R.M. Atomic Layer Deposition of Ruthenium Thin Films from an Amidinate Precursor // Chem. Vap. Deposition. 2009. V. 15. № 10–12. P. 312–319.
Li H., Farmer D.B., Gordon R.G., Lin Y., Vlassak J. Vapor Deposition of Ruthenium from an Amidinate Precursor // J. Electrochem. Soc. 2007. V. 154. № 12. D642–D647.
Min Y.-S., Bae E.J., Jeong K.S., Cho Y.J., Lee J.-H., Choi W.B., Park G.-S. Ruthenium Oxide Nanotube Arrays Fabricated by Atomic Layer Deposition Using a Carbon Nanotube Template // Adv. Mater. 2003. V. 15. № 12. P. 1019–1022.
Aaltonen T., Ritala M., Arstila K., Keinonen J., Leskelä M. Atomic Layer Deposition of Ruthenium Thin Films from Ru(thd)3 and Oxygen // Chem. Vap. Deposition. 2004. V. 10. № 4. P. 215–219.
Aaltonen T., Ritala M., Tung Y.-L., Chi Y., Arstila K., Meinander K., Leskelä M. Atomic layer deposition of noble metals: Exploration of the low limit of the deposition temperature // J. Mater. Res. 2004. V. 19. № 11. P. 3353–3358.
Park S.K., Kanjolia R., Anthis J., Odedra R., Boag N., Wielunski L., Chabal Y. Atomic Layer Deposition of Ru/RuO2 Thin Films Studied by In-situ Infrared Spectroscopy // J. Chem. Mater. 2010. V. 22. № 17. P. 4867–4878.
Schaekers M., Capon B., Detavernier C., Blasco N. The Deposition of Ru and RuO2 Films for DRAM Electrode // ECS Trans. 2010. V. 33. № 2. P. 135–144.
Gregorczyk K., Henn-Lecordier L., Gatineau J., Dussarrat C., Rubloff G. Atomic Layer Deposition of Ruthenium Using the Novel Precursor bis(2,6,6-trimethyl-cyclohexadienyl)ruthenium // Chem. Mater. 2011. V. 23. № 10. P. 2650–2656.
Kim S.-H. Low Temperature Atomic Layer Deposition of Ru Thin Films with Enhanced Nucleation Using Various Ru(0) Metallorganic Precursors and Molecular O2 // ECS Trans. 2011. V. 41. № 2. P. 19–23.
Kukli K., Kemell M., Puukilainen E., Aarik J., Aidla A., Sajavaara T., Laitinen M., Tallarida M., Sundqvist J., Ritala M., Leskelä M. Atomic Layer Deposition of Ruthenium Films from (Ethylcyclopentadienyl)(pyrrolyl)ruthenium and Oxygen // J. Electrochem. Soc. 2011. V. 158. № 3. P. D158–D165.
Kukli K., Aarik J., Aidla A., Jogi I., Arroval T., Lu J., Sajavaara T., Laitinen M., Kiisler A.-A., Ritala M., Leskelä M., Peck J., Natwora J., Geary J., Spohn R., Meiere S., Thompson D. M. Atomic layer deposition of Ru films from bis(2,5-dimethylpyrrolyl)ruthenium and oxygen // Thin Solid Films. 2012. V. 520. № 7. P. 2756–2763.
Vasilyev V.Yu., Mogilnikov K.P., Song Y.W. Surface Selective Growth of Ruthenium Films under Low Temperature CVD Conditions // Electrochem. Solid State Lett. 2008. V. 11. № 12. P. D89–D93.
Lee S.-J., Kim S.-H., Saito M., Suzuki K., Nabeya S., Lee J., Kim S., Yeom S., Lee D.-J. Plasma-free atomic layer deposition of Ru thin films using H2 molecules as a nonoxidizing reactant // J. Vac. Sci. Technol. A. 2016. V. 34. № 3. Paper № 031509 (7 pages).
Yung J.-H., Lee S.-J., Lee H.-J., Lee M.-Y., Cheon T., Bae S.I., Saito M., Suzuki K., Nabeya S., Lee J., Kim S., Yeom S., Seo J.H., Kim S.-H. Atomic Layer Deposition of Ru Thin Films Using a New Beta-Diketonate Ru Precursor and NH3 Plasma as a Reactant // J. Nanosci. Nanotechnol. 2015. V. 15. № 11. P. 8472–8477.
Park K.J., Parsons G.N. Selective area atomic layer deposition of rhodium and effective work function characterization in capacitor structures // Appl. Phys. Lett. 2006. V. 89. № 4. Paper № 043111 (3 pages).
Hämäläinen J., Puukilainen E., Sajavaara T., Ritala M., Leskelä M. Low temperature atomic layer deposition of noble metals using ozone and molecular hydrogen as reactants // Thin Solid Films. 2013. V. 531. P. 243–250.
Senkevich J.J., Tang F., Rogers D., Drotar J.T., Jezewski C., Lanford W.A., Wang G.-C., Lu T.-M. Sustrate-Independent Palladium Atomic Layer Deposition // Chem. Vap. Deposition. 2003. V. 9. № 5. P. 258–264.
Ten Eyck G.A., Pimanpang S., Bakhru H., Lu T.-M., Wang G.-C. Atomic Layer Deposition of Pd on an Oxidized Metal Substrate // Chem. Vap. Deposition. 2006. V. 12. P. 290–294.
Weber M.J., Mackus A.J.M., Verheijen M.A., van der Marel C., Kessels W.M.M. Supported Core/Shell Bimetallic Nanoparticles Synthesis by Atomic Layer Deposition // Chem. Mater. 2012. V. 24. P. 2973–2977.
Weber M.J., Mackus A.J.M., Verheijen M.A., Longo V., Bol A.A., Kessels W.M.M. Atomic Layer Deposition of High-Purity Palladium Films from Pd(hfac)2 and H2 and O2 Plasmas // J. Phys. Chem. C. 2014. V. 118. P. 8702–8711.
Feng H., Elam J.W., Libera J.A., Setthapun W., Stair P.C. Palladium Catalysts Synthesized by Atomic Layer Deposition for Methanol Decomposition // Chem. Mater. 2010. V. 22. P. 3133–3142.
Aaltonen T., Ritala M., Tung Y.-L., Chi Y., Arstila K., Meinander K., Leskelä M. Atomic layer deposition of noble metals: Exploration of the low limit of the deposition temperature // J. Mater. Res. 2004. V. 19. № 11. P. 3353–3358.
Hämäläinen J., Sajavaara T., Puukilainen E., Ritala M., Leskelä M. Atomic Layer Deposition of Osmium // Chem Mater. 2012. V. 24. P. 55–60.
Hämäläinen J., Puukilainen E., Kemell M., Costelle L., Ritala M., Leskelä M. Atomic Layer Deposition of Iridium Thin Films by Consecutive Oxidation and Reduction Steps // Chem. Mater. 2009. V. 21. P. 4868–4872.
Choi B.H., Lee J.H., Lee H.K., Kim J.H. Effect of interface layer on growth behavior of atomic-layer-deposited Ir thin film as novel Cu diffusion barrier // Appl. Surf. Sci. 2011. V. 257. № 22. P. 9654–9660.
Lim Y.H., Yoo H., Choi B.H., Lee J.H., Lee H.-N., Lee H.K. Atomic-layer-deposited Ir thin film as a novel diffusion barrier layer in Cu interconnection // Phys. Status Solidi C. 2011. V. 8. № 3. P. 891–894.
Hämäläinen J., Hatanpää T., Puukilainen E., Costelle L., Pilvi T., Ritala M., Leskelä M. (MeCp)Ir(CHD) and molecular oxygen as precursors in atomic layer deposition of iridium // J. Mater. Chem. 2010. V. 20. № 36. P. 7669–7675.
Hämäläinen J., Hatanpäaä T., Puukilainen E., Sajavaara T., Ritala M., Leskelä M. Iridium metal and iridium oxide thin films grown by atomic layer deposition at low temperatures // J. Mater. Chem. 2011. V. 21. № 41. P. 16488–16483.
Hämäläinen J., Munnik F., Ritala M., Leskelä M. Atomic Layer Deposition of Platinum Oxide and Metallic Platinum Thin Films from Pt(acac)2 and Ozone // Chem. Mater. 2008. V. 20. № 21. P. 6840–6846.
Mackus A.J.M., Leick N., Baker L., Kessels W.M.M. Catalytic Combustion and Dehydrogenation Reactions during Atomic Layer Deposition of Platinum // Chem. Mater. 2012. V. 24. № 10. P. 1752–1761.
Vasilyev V.Yu. Ruthenium Thin Film Growth Kinetics under Thermally-Activated Pulsed Chemical Vapor Deposition Conditions / In “Advances in Chemistry Research”. V. 39. Ed. Taylor J.C. N.Y. Nova Science Publishers Inc. 2017. P. 109–140.
Vasilyev V.Yu. Low-temperature thermally-activated pulsed chemical vapor deposition of ruthenium thin films using carbonyl-diene precursor / In “Ruthenium: Properties, Production and Applications” / Ed. David B. Watson. N.Y. Nova Science Publishers Inc. 2011. P. 2–85.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника