Микроэлектроника, 2019, T. 48, № 4, стр. 243-248
Влияние состава на диэлектрические свойства и перенос заряда в 2D мaтериалах GaS1 – хSeх
С. М. Асадов 1, С. Н. Мустафаева 2, *, В. Ф. Лукичев 3, **, Д. Т. Гусейнов 2
1 Институт катализа и неорганической химии Азербайджанской Республики НАН
1145 Баку, пр. Г. Джавида, 131, Азербайджан
2 Институт физики Азербайджанской Республики НАН
1141 Баку, пр. Г. Джавида, 33, Азербайджан
3 Физико-технологический институт им. К.А. Валиева Российской АН
117218 Москва, Нахимовский проспект, 36, к. 1, Россия
* E-mail: solmust@gmail.com
** E-mail: lukichev@ftian.ru
Поступила в редакцию 10.01.2019
После доработки 15.02.2019
Принята к публикации 15.02.2019
Аннотация
Изучено влияние состава твердых растворов со слоистой структурой системы GaS–GaSe на диэлектрические характеристики и проводимость на переменном токе в диапазоне частот 5 × 104–3.5 × 107 Гц. Показано, что с увеличением содержания селена в монокристаллах GaS1 –хSeх действительная и мнимая составляющие комплексной диэлектрической проницаемости, тангенс угла диэлектрических потерь и проводимость на переменном токе существенно увеличиваются. Наблюдаемое в экспериментах уменьшение диэлектрической проницаемости изученных твердых растворов с ростом частоты от 5 × 104 до 3.5 × 107 Гц свидетельствует о релаксационной дисперсии. Установлены природа диэлектрических потерь в монокристаллах GaS1 – хSeх (потери сквозной проводимости) и прыжковый механизм переноса заряда по локализованным вблизи уровня Ферми состояниям. Оценены основные параметры локализованных состояний в запрещенной зоне GaS1 – хSeх.
ВВЕДЕНИЕ
В последние годы наблюдается быстрый рост различных применений полупроводниковых низкоразмерных материалов, в частности 2D-халькогенидов, в микро- и наноэлектронике, фотонике и спинотронике [1–10]. Слоистые 2D-кристаллы на основе соединений АIIIВVI [1–10] обладают анизотропными свойствами, которые обусловлены наличием двух видов связей между атомами в кристалле. В таких кристаллах, например, в сульфиде галлия (GaS), каждый слой содержит четыре атомные плоскости S–Ga–Ga–S, расположенные перпендиуклярно оси C-кристалла. Внутри 2D-слоев связь имеет ионно-ковалентный характер, соседние слои связаны слабыми силами типа Ван-дер-Ваальса. Принимая во внимание практическое применение этих материалов важно модифицировать их свойства путем легирования или получения твердых растворов на их основе и установить концентрационные зависимости свойств образцов системы. В системе GaS–GaSe образуется непрерывный ряд твердых растворов. Обзор известных фаз в системе GaS–GaSe приведен в [11].
Цель настоящей работы – изучение влияния состава образцов 2D-системы GaS–GaSe на их диэлектрические свойства, выяснение механизма переноса заряда в них на переменном токе (ac) и определение параметров локализованных в запрещенной зоне состояний.
МЕТОДИКА ЭКСПЕРИМЕНТА
Исходные химические элементы Ga-5N галлий, B5 сера и ОСЧ-17-3 селен с содержанием примесей не более 5 × 10–4 мас. % мы использовали без дополнительной очистки. Бинарные соединения GaS и GaSe получали по стехиометрическим навескам из соответствующих элементов. Образцы GaSe1 – хSх (х = 0, 0.2, 0.3, 0.5, 0.8 и 1) синтезировали из стехиометрических количеств полученных 2D бинарных соединений GaS и GaSe [11–14].
Монокристаллы получали из синтезированных образцов GaSe1 – хSх методом Бриджмена. В процессе выращивания кристаллов GaSe1 – хSх в верхней зоне печи поддерживалась температура 1293 К, т.е. на 5 К выше температуры плавления GaS, в нижней зоне – 1161 К, т.е. на 50 К ниже температуры плавления GaS. Скорость перемещения ампулы в печи была 0.3–0.5 см/ч, градиент температуры у фронта кристаллизации составлял 25 ± 5 К [14].
Рентгенофазовый анализ образцов GaSe1 – хSх проведен на дифрактометре марки D8-ADVANCE в режиме 0.5° < 2Θ < 100° (CuKα-излучение, λ = = 1.5406 Å) при 40 кВ и 40 мА.
Параметры элементарной ячейки изученных нами образцов на основе GaSe1 –хSх согласуются с данными для системы GaS–GaSe. Для GaSe гексагональной 2D-структуры получены следующие параметры ячейки:
при комнатной температуре. Параметры элементарной ячейки 2D-структуры GaS имели следующие значения:
Диэлектрические коэффициенты монокристаллов системы GaS–GaSe измерены резонансным методом [12]. Диапазон частот переменного электрического поля составлял 5 × 104–3.5 × 107 Гц. Образцы системы GaS–GaSe для электрических измерений были изготовлены в виде плоских конденсаторов, плоскость которых была перпендикулярна кристаллографической C-оси монокристаллических образцов. В качестве электродов использована серебряная паста. Толщина изученных монокристаллических образцов составляла 200–700 мкм, а площадь обкладок – 7 × 10–2 см2. Все диэлектрические измерения проведены при 300 K. Воспроизводимость положения резонанса составляла по емкости ±0.2 пФ, а по добротности (Q = 1/tgδ) ± 1.0–1.5 деления шкалы. При этом наибольшие отклонения от средних значений составляли 3–4% для ε' и 7% для tgδ.
РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
На рис. 1 приведены частотные зависимости действительной составляющей комплексной диэлектрической проницаемости (ε') образцов с 2D-структурой GaS, GaS0.5Se0.5 и GaS0.3Se0.7. Видно, что с увеличением содержания селена в твердых растворах GaS1 – хSeх значение ε' существенно увеличивается. В указанных монокристаллах во всем изученном диапазоне частот имеет место существенная дисперсия ε'. Так, в GaS с увеличением частоты от 5 × 104 до 3.5 × 107 Гц значение ε' уменьшалось в 1.5 раза, в GaS0.5Se0.5 – в 1.7 раз, а в GaS0.3Se0.7 – более, чем в 2 раза. Наблюдаемое в экспериментах уменьшение диэлектрической проницаемости в монокристаллах GaS, GaS0.5Se0.5 и GaS0.3Se0.7 с ростом частоты от 5 × 104 до 3.5 × × 107 Гц свидетельствует о релаксационной дисперсии [15].
Рис. 1.
Частотная дисперсия действительной составляющей комплексной диэлектрической проницаемости образцов GaS (1), GaS0.5Se0.5 (2) и GaS0.3Se0.7 (3).
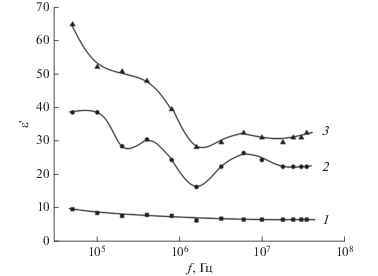
Частотные зависимости мнимой части комплексной диэлектрической проницаемости ε" монокристаллов GaS, GaS0.5Se0.5 и GaS0.3Se0.7 приведены на рис. 2. Эти зависимости также носят спадающий характер с ростом частоты и свидетельствуют о релаксационной дисперсии. Наиболее существенная частотная дисперсия наблюдалась в кристаллах GaS0.3Se0.7 (кривая 3).
Рис. 2.
Частотные зависимости мнимой части комплексной диэлектрической проницаемости образцов GaS (1), GaS0.5Se0.5 (2) и GaS0.3Se0.7 (3).
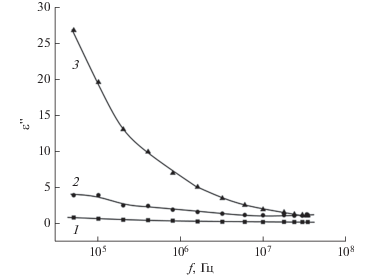
На рис. 3 показаны частотные зависимости тангенса угла диэлектрических потерь (tgδ) в изученных кристаллах. Видно, что с ростом содержания селена в образцах GaS1 – хSeх tgδ существенно увеличивается. Частотный ход кривых tgδ(f) свидетельствует о потерях сквозной проводимости в монокристаллах GaS1 – хSeх [15].
Рис. 3.
Частотные зависимости тангенса угла диэлектрических потерь (tgδ) в монокристаллах GaS (1), GaS0.5Se0.5 (2), GaS0.3Se0.7 (3) и GaS0.2Se0.8 (4).
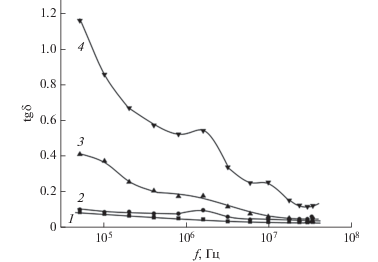
На рис. 4 представлены результаты изучения частотно-зависимой ac-проводимости (σac) монокристаллов GaS1 – хSeх при 300 K.
Рис. 4.
Частотно-зависимая ac-проводимость монокристаллов GaS (1), GaS0.5Se0.5 (2), GaS0.3Se0.7 (3) и GaS0.2Se0.8 (4) при 300 K.

Как следует из рис. 4 увеличение содержания селена в образцах GaS1 – хSeх приводит к значительному возрастанию ас-проводимости, так при 5 × 104 Гц проводимость монокристалла GaS0.2Se0.8 c наибольшим содержанием селена почти на два порядка превышает σac монокристалла GaS. С увеличением частоты разница в значениях σac изученных кристаллов несколько уменьшается.
Во всей изученной области частот ac-проводимость монокристаллов GaS1 – хSeх изменялась по степенному закону σac ~ f n, где n ≤ 1. В GaS дисперсионная кривая σac(f) подчинялась закономерности σac ~ f 0.8, а в GaS0.5Se0.5 после участка σac ~ f 0.8 при высоких частотах (f ≥ 6 × 106 Гц) наблюдалась линейная зависимость σac ~ f. В кристаллах же GaS0.3Se0.7 и GaS0.2Se0.8 во всей области частот наблюдалась зависимость σac ~ f 0.5. Аc-проводимость зонного типа, как известно, в основном частотно-независимая вплоть до 1010–1011 Гц. Наблюдаемая нами экспериментальная зависимость σac ~ f 0.8 в кристаллах GaS и GaS0.5Se0.5 свидетельствует о том, что она обусловлена прыжками носителей заряда между локализованными в запрещенной зоне состояниями. Это могут быть локализованные вблизи краев разрешенных зон состояния или локализованные вблизи уровня Ферми состояния [16]. Так как в экспериментальных условиях проводимость по состояниям вблизи уровня Ферми всегда доминирует над проводимостью по состояниям вблизи краев разрешенных зон, полученный нами закон σac ~ ~ f 0.8 свидетельствует о прыжковом механизме переноса заряда по состояниям, локализованным в окрестности уровня Ферми. Формула для такой проводимости имеет вид:
(1)
${{\sigma }_{{{\text{ac}}}}}(f) = \frac{{{{\pi }^{3}}}}{{96}}\quad{{{\text{e}}}^{2}}kTN_{{\text{F}}}^{2}{{a}^{5}}f{{\left[ {\ln \left( {\frac{{{{\nu }_{{{\text{ph}}}}}}}{f}} \right)} \right]}^{4}},$С помощью формулы (1) по экспериментально найденным значениям σac(f) образцов GaS и GaS0.5Se0.5 вычислили плотность состояний на уровне Ферми:
соответственно. При вычислениях NF для радиуса локализации взято значение a = 14 Å, полученное экспериментально для монокристалла GaS [17]. Значение νph для GaS порядка 1012 Гц.
Согласно теории прыжковой проводимости на переменном токе среднее расстояние прыжков (R) определяется по формуле [16]:
В формуле (2) значение f соответствует средней частоте, при которой наблюдается f 0.8 – закон. Вычисленное по формуле (2) значение R для монокристалла GaS составляло 87 Å, для GaS0.5Se0.5 – 90 Å. Это значение R примерно в 6 раз превышает среднее расстояние между центрами локализации носителей заряда в изученных монокристаллах. Значение R позволило по формуле
определить среднее время прыжков в монокристаллах GaS и GaS0.5Se0.5:
соответственно. По формуле [16]:
в этих монокристаллах оценен энергетический разброс локализованных вблизи уровня Ферми состояний:
По формуле
определена концентрация глубоких ловушек, ответственных за ac-проводимость в этих образцах:
На дисперсионных кривых σac(f) образцов GaS0.3Se0.7 и GaS0.2Se0.8 (рис. 4, кривые 3 и 4) нам не удалось достичь участка σac ~ f 0.8, так как для этого требовались более высокие частоты (>3.5 × × 107 Гц).
ЗАКЛЮЧЕНИЕ
В синтезированных нами монокристаллах твердых растворов со слоистой 2D-структурой GaS1 – хSeх (х = 0, 0.2, 0.3, 0.5, 0.8 и 1) изучены диэлектрические характеристики и проводимость на переменном токе в диапазоне частот 5 × 104–3.5 × × 107 Гц. Установлено, что с увеличением содержания селена в монокристаллах GaS1 – хSeх действительная и мнимая составляющие комплексной диэлектрической проницаемости, тангенс угла диэлектрических потерь и проводимость на переменном токе существенно увеличиваются. Уменьшение диэлектрической проницаемости твердых растворов GaS1 – хSeх с ростом частоты от 5 × 104 до 3.5 × 107 Гц свидетельствует о релаксационной дисперсии. Установлено, что в монокристаллах GaS1 –хSeх имеют место потери сквозной проводимости. Перенос носителей заряда в твердых растворах GaS1 – хSeх системы GaS–GaSe осуществляется прыжками по локализованным вблизи уровня Ферми состояниям. Оценены параметры локализованных состояний в запрещенной зоне GaS1 –хSeх, такие как плотность NF = 8.8 × × 1018–2 × 1019 эВ–1 см–3 и энергетический разброс ∆Е = 33–82 мэВ локализованных состояний в окрестности уровня Ферми, средняя длина R = = 87–90 Å и время τ = (2–3.3) × 10–7с прыжков, а также концентрация Nt = (6.6–7.3) × 1017 см–3 глубоких ловушек, ответственных за перенос заряда на переменном токе.
Настоящая работа выполнена при финансовой поддержке Фонда развития науки при Президенте Азербайджанской Республики (гранты № EİF-BGM-3-BRFTF-2+/2017-15/05/1-M-13 и № EİF-BGM-4-RFTF-1/2017-21/05/1-M-07) и РФФ-И (проект “Аз_а”2018).
Список литературы
Madelung O. Semiconductors Data Handbook, Springer-Verlag, Berlin, 2004.
Terhell I.C.I. Polytypism in the III–VI layer compounds // Prog. Cryst. Growth Charact. Mater. 1983. 7. P. 55–110.
Mustafaeva S.N., Asadov M.M. Currents of isothermal relaxation in GaS〈Yb〉 single crystals // Solid State Communications. 1983. V. 45. P. 491–494.
Mustafaeva S.N., Asadov M.M. High field kinetics of photocurrent in GaSe amorphous films // Materials Chemistry and Physics. 1986. V. 15. P. 185–189.
Fernelius N.C. Properties of gallium selenide single crystal // Prog. Cryst. Growth and Charact. 1994. V. 28. P. 275–353.
Nazarov M.M., Kosobutsky A.V., Sarkisov S.Yu., Brudnyi V.N., TolbanovO.P., Shkurinov A.P. Electronic properties and influence of doping on GaSe crystal nonlinear optical parameters for the applications in terahertz range // Intern. Conf. on Coherent and Nonlinear Optics. Proc. of SPIE. 2010. V. 7993 799326-1.
Ni Y., Wu H., Huang C., Mao M., Wang Z., Cheng X. Growth and quality of gallium selenide (GaSe) crystals // J. Crystal Growth. 2013. V. 381. P. 10–14.
Asadov S.M., Mustafaeva S.N., Lukichev V.F. Transport phenomena and physical properties of low-dimensional solid solutions TlGa1 – xSbxS2 // Book of Abstracts of III International Conference on Modern Problems in Physics of Surfaces and Nanostructures. Yaroslavl, Russia. 9–11 October, 2017. P2-25: P. 111.
Асадов С.М., Мустафаева С.Н., Лукичев В.Ф. Явления переноса и диэлектрические свойства низкоразмерных твердых растворов // Сборник материалов Третьего Междисциплинарного Научного Форума с Международным участием “Новые Материалы”. Москва. 21–24 ноября, 2017. С. 244–246.
Asadov S.M., Mustafaeva S.N., Lukichev V.F. Effect of doping with gallium on the electrical conductivity of TlSbS2 single crystals // Тезисы докладов Всероссийской конференции с международным участием “Химия твердого тела и функциональные материалы” и XII Всероссийского симпозиума с международным участием “Термодинамика и материаловедение”. Санкт-Петербург. Россия. 21–27 мая 2018. С. 355.
Asadov S.M., Mustafaeva S.N., Mammadov A.N. Thermodynamic assessment of phase diagram and concentration–temperature dependences of properties of solid solutions of the GaS–GaSe system // J. Thermal Analysis and Calorimetry. 2018. V. 133. № 2. P. 1135–1141.
Мустафаева С.Н. Методика измерения проводимости высокоомных материалов на переменном токе // Все материалы. Энциклопедический справочник. 2016. № 10. С. 74–79.
Asadov S.M., Mustafaeva S.N. Dielectric losses and charge transfer in antimony-doped TlGaS2 single crystal // Physics of the Solid State. 2018. V. 60. № 3. P. 499–503.
Mustafaeva S.N., Asadov S.M., Kerimova E.M. Dielectric properties and conductivity of Ag-doped TlGaS2 single crystals // Semiconductors. 2018. V. 52. № 2. P. 156–159.
Пасынков В.В., Сорокин В.С. Материалы электронной техники. СПб.–М.–Краснодар. 2004. 368 с.
Мотт Н., Дэвис Э. Электронные процессы в некристаллических веществах. Пер. с англ. 2-e изд., перераб. и доп. В 2-х томах. М.: Мир, 1982. Т. 1. 368 с. Т. 2. 664 с.
Augelli V., Manfredotti C., Murri R., Piccolo R., Vasanelli L. Anomalous impurity conductivity in n-GaSeand n-GaS // NuovoCimentoSoc. Ital. Fis. B. 1977. V. 38. № 2. P. 327–336.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника


