Микроэлектроника, 2019, T. 48, № 4, стр. 308-314
Микропотребляющие усилители мощности на нитриде галлия для диапазона частот 8–12 ГГц
С. А. Гамкрелидзе 1, *, Д. Л. Гнатюк 1, А. В. Зуев 1, М. В. Майтама 1, П. П. Мальцев 1, А. О. Михалев 1, **, Ю. В. Федоров 1
1 Институт сверхвысокочастотной полупроводниковой электроники Российской АН
117105 Москва, Нагорный проезд, 7, стр. 5, Россия
* E-mail: Iuhfseras2010@yandex.ru
** E-mail: m2lkeny@yandex.ru
Поступила в редакцию 12.12.2018
После доработки 09.01.2019
Принята к публикации 09.01.2019
Аннотация
Рассмотрены характеристики каскадной схемы усилителя мощности на нитриде галлия с площадью кристалла в 4–6 раз меньшей по сравнению с традиционными усилителями на подложках карбида кремния для обеспечения выходной мощности до 3 Вт на частотах 8–12 ГГц при использовании в микропотребляющих усилителях мощности радиоэлектронной аппаратуры, применяемой в робототехнике и космических аппаратах.
ТЕОРЕТИЧЕСКИЕ ИССЛЕДОВАНИЯ
Создание электронной компонентной базы для обеспечения работоспособности твердотельных электронных систем в экстремальных условиях околоземного пространства или в специальной аппаратуре является чрезвычайно актуальной задачей [1, 2]. При этом большое значение имеет повышение энергетической эффективности монолитных интегральных схем (МИС).
Существует ряд областей радиоэлектроники, требующих достижения максимальной выходной мощности в СВЧ-диапазоне при отсутствии дополнительных теплоотводящих элементов, т.е. теплообмен только с кристалла МИС для обеспечения минимальных массогабаритных характеристик устройств. Прежде всего, такие требования возникают у разработчиков робототехнических устройств и космических аппаратов. Предельным ограничением рассеиваемой мощности с кристалла общепринято считать обеспечение выходной мощности до 3–4 Вт при рассеивании мощности на кристалле до 10 Вт.
Введем определение, что микро потребляющая электронная компонентная база должна потреблять ток менее 1 А на кристалл.
Таким образом, достичь необходимую величину выходной мощности можно варьируя значениями тока и напряжения, а также конструктивно-технологическим базисом и схемотехническими решениями для формирования максимального коэффициента полезного действия (КПД) при минимальной массе и габаритах устройств.
Рассмотрим гипотетический подход к достижению предельного значения выходной мощности 3 Вт при условии 100% КПД и условия микро потребления усилителя мощности.
Например, основную проблему создания микро потребляющих мощных усилительных модулей СВЧ диапазона 8–12 ГГц можно решить за счет уменьшения тока потребления для обеспечения заданной мощности в соответствие законом Ома (P = IU).
Возможны два крайних варианта:
Рассмотрим, как можно реализовать эти варианты, используя два конструктивно-технологических решения на основе арсенида галлия (широко применяемого в промышленности) и нитрида галлия (перспективного технологического базиса).
Например, для достижения непрерывной выходной мощности Pвых = 3.0 Вт потребуется:
– при напряжении Uп = 3.0 В ток потребления I = 1.0 А при КПД = 100% (данные режимы могут обеспечиваться на арсениде галлия);
– при напряжении Uп = 30.0 В ток потребления I = 0.1 А (данные режимы могут обеспечиваться на нитриде галлия).
Для гармонического сигнала при усилительном режиме класса А потребляемая мощность определяется как произведение действующих значений напряжения и тока от источника питания, т.е. каждое значение деленное на $\sqrt {\text{2}} .$
Запишем выражение для КПД:
гдеДля КПД равному 50% ток потребления от источника питания увеличится в 4 раза при заданном напряжении питания. Таким образом, ток потребления Iп для арсенида галлия при Uп = 3 В составит 4 А и для нитрида галлия при Uп = 30 В составит 0.4 А.
При КПД = 30% амплитудное значение тока потребления от источника питания возрастет в 6.6 раз по сравнению с КПД = 100%.
Следовательно, для микропотребляющих мощных усилительных модулей СВЧ-диапазона можно снизить на порядок величины тока потребления и обеспечить потребление менее 1 А на основе перспективных технологических процессов с использованием наногетероструктур нитрида галлия вместо арсенида галлия или кремния-германия [3–5].
Оптимизация параметров микропотребляющих усилительных модулей по массе и габаритам связана с отсутствием дополнительных теплоотводящих конструкций и подразумевает сведение к минимально необходимому значению ширины токопроводящих частей под управлением затвора транзистора.
Удельный ток на 1 мм ширины затвора транзистора усилителя мощности для транзистора на образцах разработанных в ИСВЧПЭ РАН составляет:
– на арсениде галлия до 2.5 А/мм при пробивном напряжении 10 В;
– на нитриде галлия до 1.6 А/мм при пробивном напряжении 80 В. Таким образом, для нитрида галлия потребуется примерная ширина транзистора в 5 раз меньше чем на арсениде галлия для обеспечения выходной мощности 3 Вт.
Кроме того, в литературе [6] приведена плотность мощности на миллиметр ширины затвора для мощных транзисторов и отмечено:
– на арсениде галлия: полевые транзисторы имеют 1 Вт/мм на 10 ГГц и РНЕМТ 1.5 Вт/мм на 30 ГГц;
– на нитриде галлия НЕМТ имеют более 7 Вт/мм на 30 ГГц.
Следовательно, для микропотребляющих мощных усилительных модулей СВЧ диапазона частот 8–12 ГГц можно снизить в 5–7 раз как ток потребления, так и массогабаритные размеры мощных транзисторов на основе перспективных технологических процессов с использованием нано- гетероструктур нитрида галлия по сравнению с арсенидом галлия.
Миниатюризация усилителей открывает перспективы создания однокристальных ППМ с уменьшенными габаритами и Рвых до 3 Вт.
ЭКСПЕРИМЕНТАЛЬНЫЕ ИССЛЕДОВАНИЯ
Микропотребляющие усилители мощности должны работать при напряжении питания до 30 В, что соответствует напряжению бортовой сети 28 В (безопасное напряжение), и обеспечивать минимальное потребление тока (менее 1 А).
В ИСВЧПЭ РАН разработан микропотребляющий усилитель мощности (УМ) на нитриде галлия для диапазона частот 8–12 ГГц с выходной мощностью около 3 Вт при напряжении питания 30 В, токе потребления 0.6 А и КПД не менее 30%, т.е. потребляемой или рассеиваемой мощностью на кристалле не более 10 Вт.
Одним из эффективных способов снижения потребляемой мощности МИС является уменьшение количества каскадов усиления (в идеале – до одного) путем повышения коэффициента усиления единичного каскада. В этой связи уникальными возможностями обладает каскадная схема включения транзисторов (первый транзистор включен с общим истоком и второй транзистор включен с общим затвором), которая особенно интересна при использовании нитрид-галлиевой технологии, т.к. позволяет технологически совмести два транзистора в одном каскаде и значительно уменьшить его площадь. Потребность в минимизации площади кристалла СВЧ МИС связана с высокой стоимостью подложки карбида кремния по сравнению с арсенидом галлия. При этом разница в цене достигает двух порядков величины.
Электрическая схема МИС УМ выполнена на основе двух параллельно соединенных схем транзисторов в каскадном включении на Т1 с Т3 и Т2 с Т4, работающих на общую нагрузку, и показана на рис. 1. Топология МИС приведена на рис. 2.
Для работы в классическом непрерывном режиме усиления класса А без проявления коротко-канальных эффектов транзисторы должны иметь аспектное соотношение длины затвора к толщине барьерного слоя Lg/tbar > 10–15 [1, 2]. Использованные AlGaN/AlN/GaN гетероструктуры отечественного производства (ЗАО “Элма-Малахит”) на подложке карбида кремния (SiC) имели толщину барьерного слоя 14.7 нм и была выбрана длина затворов транзисторов 0.25 мкм, что обеспечило аспектное соотношение 17, а для подложки сапфира (Al2O3) – толщина барьерного слоя 13.0 нм и аспектное отношение 19.
Проектирование усилителя производилось под разработанную в ИСВЧПЭ РАН технологию [3–10], заключающуюся в создании заземляющей плоскости над лицевой поверхностью пластины с уже изготовленными активными и пассивными СВЧ элементами поверх слоя полимерного диэлектрика толщиной 10–14 мкм, что позволяет избежать необходимости формирования сквозных отверстий в подложках SiC и Al2O3. Заземление элементов схемы выполняется через отверстия в слое диэлектрика. Конструктивно-технологический разрез МИС с металлизацией на верхнем слое пластины показан на рис. 3.
Ширина затворов выходного транзистора каскадной схемы составляет 10 × 160 мкм = 1.6 мм (3.2 для параллельно работающих каскадных схем), что обеспечивает плотность мощности примерно 1 Вт/мм на частоте 10 ГГц.
В табл. 1 приведены основные параметры на частоте 10 ГГц разработанных в ИСВЧПЭ РАН монолитных интегральных схем УМ на каскодных транзисторах с общей нагрузкой для двух типов подложек – сапфире (Al2O3) и карбиде кремния (SiC), а также ближайших зарубежных аналогов – трехкаскадным УМ TriQuint TGA2238 (производитель США) [11] на GaN/SiC и Sandra-semi SDC2016 (производитель Малайзия) [12] на GaAs.
Таблица 1.
Сравнение технических характеристик МИС УМ
| МИС (габариты) | Uпит, В | Iпотр, мА | Pвых max | Кро, дБм (Pвх = 10 дБм) | Крm, дБм (Pвх = 20 дБм) |
Pпотр, Вт | КПД, % | |
|---|---|---|---|---|---|---|---|---|
| дБм | Вт | |||||||
| GaN/Al2O3 (1.8 × 1.9 мм) ИСВЧПЭ РАН |
30 | 600 | 34.46 | 2.79 | 17.5 | 14.5 | 9 | 30.1 |
| GaN/SiC (1.8 × 1.9 мм) ИСВЧПЭ РАН |
20 | 600 | 32.96 | 1.98 | 18.1 | 12.5 | 6 | 33 |
| 30 | 600 | 34.73 | 2.96 | 17.3 | 14.27 | 9 | 32.8 | |
| 40 | 4* | |||||||
| GaN/SiC (5.49 × 7.0) TriQuint, США |
28 | 650 | 36.02 | 4** | 31 | 25 | 9 | 40 |
| GaAs (3.2 × 5.8) Sandra-Semi, Малайзия |
8 | 1300 | 36.99 | 5** | 40 | |||
| GaN/SiC (1.0 × 0.8) АО “Светлана-рост” |
28 | 400 | 2.7 | 8 | 5.6 | 50 | ||
В зарубежных МИС использованы сквозные отверстия в кристалле для отвода тепла от истока и стока на заземляющую плоскость с обратной поверхности пластины и эта конструкция является стандартной. Аналогичный конструктивно-технологический базис использован в транзисторе АО “Светлана-рост” на GaN/SiC [13]. Транзистор Х-диапазона с проектной нормой длины транзистора 0.25 мкм и суммарной периферией 4 × 150 = 600 мкм для обеспечения плотности мощности 4.6 Вт/мм и выходной мощности 2.7 Вт при КПД = 50%.
В ИСВЧПЭ РАН Рвых измерялась на зондовой станции без теплоотвода в импульсном режиме по питанию при скважности Q = 100 длительностью t = 1 мкс для обеспечения допустимого теплового режима при Pпотр не более 10 Вт, а у американского аналога измерения проведены при Q = 10 и t = 100 мкс.
По расчетам при подаче напряжения питания 40 В и размещении в теплоотводящем корпусе МИС на подложке карбида кремния, разработанная в ИСВЧПЭ РАН, обеспечит на выходе мощность 4 Вт.
Важно подчеркнуть значительное уменьшение массогабаритных характеристик в 5–7 раз при изготовлении МИС с Pвых = 3 Вт в конструктивно технологическом базисе, разработанном ИСВЧПЭ РАН, по сравнению с зарубежными аналогичными усилителями мощности на подложке карбида кремния.
Кроме того, важно рассмотреть возможность замены дорогих карбид кремниевых подложек на дешевые отечественные сапфировые подложки, стоимость которых в 10 раз меньше для микропотребляющих УМ.
С этой целью в ИСВЧПЭ РАН были изготовлены МИС на нано гетеро структурах нитрида галлия по одной технологии и одинаковых фотошаблонах на двух типах изолирующих подложек: карбиде кремния (производитель Китай) и сапфире (производитель Россия). Производитель нано гетероструктур нитрида галлия – ЗАО “Элма-Малахит” (г. Зеленоград).
Из сравненных характеристик МИС табл. 1 видно, что выходная мощность нитрид-галлиевых МИС на отечественных подложках сапфира примерно на 5–10% меньше, чем на подложках карбида кремния, а стоимость МИС в 5–7 раз меньше, что является важным экономическим показателем для микропотребляемых усилительных модулей.
Зависимость выходной мощности и коэффициента усиления по мощности от входной мощности Рвх приведены на рис. 4 для двух типов подложек: карбида кремния и сапфира. Амплитудно-частотные характеристики (АЧХ) МИС приведены на рис. 5.
Рис. 4.
Зависимость выходной мощности Рвых (а) и коэффициента усиления Кр (б) GaN МИС от входной мощности Рвх для двух типов подложки – карбида кремния и сапфира.

Рис. 5.
Амплитудно-частотные характеристики (АЧХ) GaN МИС усилителей мощности диапазона частот 8–12 ГГц для двух типов подложек: карбид кремния и сапфира.
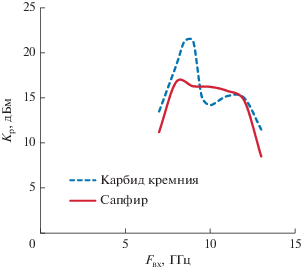
Представляет интерес рассмотреть влияние изменения напряжения в широком диапазоне на выходную мощность МИС на сапфировой подложке. Для этой цели экспериментальный образец был установлен на теплоотвод и исследован при максимальном напряжении питания 50 В.
В табл. 2 приведены значения параметров для образца МИС GaN/Al2O3 при напряжениях 20, 30, 40 и 50 В.
Таблица 2.
Значения параметров МИС УМ GaN/Al2O3
| МИС | Uпит, В | Iпотр, мА | Pвых max | Кро, дБм (Pвх = 10 дБм) | Крm, дБм (Pвх = 20 дБм) |
Pпотр, Вт | КПД, % | |
|---|---|---|---|---|---|---|---|---|
| дБм | Вт | |||||||
| Сапфир
(образец № 88) ИСВЧПЭ РАН |
20 | 700 | 30.86 | 1.22 | 15.4 | 10.89 | 7 | 17.4 |
| 30 | 700 | 32.66 | 1.85 | 15.4 | 12.88 | 10.5 | 17.6 | |
| 40 | 750 | 33.91 | 2.45 | 15.4 | 13.89 | 15 | 16.4 | |
| 50 | 750 | 34.79 | 3.01 | 15.4 | 14.69 | 18.75 | 16.0 | |
Из таблицы видно, что увеличение напряжения питания на каждые 10 В приводит к увеличению выходной мощности, примерно, на 0.6 Вт при изменении тока потребления в пределах 5–10%. При этом линейность растет с ростом Uпит, однако данный образец имеет низкий КПД 16–17% и выходную мощность ниже типичной.
Замена арсенида галлия на нитрид галлия позволяет создавать микропотребляющие усилительные модули с током потребления менее 1 А.
В ИСВЧПЭ РАН разработана технология изготовления МИС при напряжении питания 30 В на нитриде галлия с плотностью мощности 1 Вт/мм, которая аналогична МИС на арсениде галлия и позволяет использовать ранее применяемые материалы и технологические приемы. По данной технологии разработан комплект МИС серии 5411 [14] и прошедший необходимые испытания на надежность и безотказность.
ВЫВОДЫ
Разработанные в ИСВЧПЭ РАН МИС УМ на основе нитрид-галлиевых МИС при напряжении питания до 30 В в диапазоне частот 8–12 ГГц обеспечивают выходную мощность до 3 Вт на подложках карбида кремния, и занимают в 4–6 раз меньшую площадь кристалла, чем зарубежные.
Для микропотребляющих усилительных модулей с выходной мощностью до 3–4 Вт с кристалла при КПД 30–50%, соответственно, можно использовать подложку сапфира вместо карбида кремния для нитридных монолитных интегральных схем, практически, с незначительным ухудшением параметров до 10%, что значительно уменьшает стоимость кристаллов.
В ближайшей перспективе до 2025 г. для микропотребляющих усилителей мощности на нитрида галлия с выходной мощностью до 3–5 Вт с кристалла целесообразно перейти от дорогих подложек карбида кремния к более дешевым сапфировым для экстремальных условий применения и кремниевым для общепромышленного исполнения.
Работа выполнена при финансовой поддержке Министерства образования и науки РФ (соглашение о предоставлении субсидии № 14.607.21.0011, уникальный идентификатор проекта RFMEFI60714X0011).
По результатам работы получены свидетельства на топологии интегральных микросхем МИС УМ и МШУ [15].
Список литературы
Сечи Ф., Буджатти М. Мощные и твердотельные СВЧ-усилители // Москва. Техносфера. 2015. 416 с.
Мальцев П.П., Федоров Ю.В. Современное состояние и перспективы развития нитридных СВЧ приборов миллиметрового диапазона за рубежом и в России // Интеграл. 2013. № 3. С. 25–29.
Федоров Ю.В., Михайлович С.В. Перспективы замены арсенидных МИС на нитридные // Нано- и микросистемная техника. 2016. Том 18. № 4. С. 217–226.
Галиев Р.Р., Гнатюк Д.Л., Зуев А.В., Крапухин Д.В. Нитридные технологии для освоения миллиметрового диапазона длин волн // Нано- и микросистемная техника. 2015. № 2. С. 21–32.
Павлов В.Ю., Павлов А.Ю. Технологии формирования сплавных и несплавных омических контактов к гетероструктурам на основе GaN // Нано- и микросистемная техника. 2016. Т. 18. № 10. С. 635–644.
Томош К.Н., Павлов А.Ю., Павлов В.Ю., Хабибуллин Р.А. Исследование процессов изготовления HEMT AlGaN/AlN/GaN c пассивацией Si3N4in situ // Физика и техника полупроводников. 2016. Т. 50. Вып. 10. С. 1434–1438.
Павлов А.Ю. Переход от сплавной к несплавной технологии омических контактов при росте диапазона рабочих частот СВЧ МИС на основе нитрида галлия // Нано- и микросистемная техника. 2017. Т. 19. № 9. С. 541–550.
Федоров Ю.В., Бугаев А.С., Павлов А.Ю., Гнатюк Д.Л. Технология изготовления и разработка монолитных интегральных схем на основе нитрида галлия // Нано- и микросистемная техника. 2017. № 5. С. 273–293.
Климов Е.А., Лаврухин Д.В., Пушкарев С.С., Рубан О.А., Алешин А.Н. Неразрушающие методы контроля арсенидных и нитридных гетероструктур с квантовой ямой // Нано- и микросистемная техника. 2017. Т. 19. № 5. С. 302–316.
Щаврук Н.В., Редькин С.В., Трофимов А.А., Иванова Н.Е. Разделение полупроводниковых пластин из твердого материала на кристаллы // Нано- и микросистемная техника. 2017. Т. 19. № 5. С. 317–320.
Triquint TGA2238 [Электронный ресурс] // TGA2238 8 – 11GHz 60W GaN Power Amplifier URL: https://www.qorvo.com/products/p/TGA2238. (Дата обращения: 16.11.2018).
Sandra-semi SDC2016 [Электронный ресурс] // SDC2016 8-12.5 GHz GaAs MMIC Power Amplifier URL: http://sandra-semi.com/pdf/SDC2016.pdf. (Дата обращения: 16.11.2018).
Get your GaN Here: RF GaN Foundry Survey. Microwave J., June 2016. P. 21–34.
[Электронный ресурс] Справочный лист комплекта монолитных интегральных схем на нитриде галлия для диапазона 57–64 ГГц серии 5411. URL: http://isvch.ru/wordpress/wp-content/uploads/2016/03/ list.pdf
Федоров Ю.В., Майтама М.В. Топология ИМС “Интегральный усилитель мощности для диапазона частот 8–12 ГГц”, свидетельство о государственной регистрации № 2016630104 от 19 августа 2016 г.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника