Микроэлектроника, 2019, T. 48, № 4, стр. 315-320
Межприборные радиационно-индуцированные утечки в объемной КМОП технологии 180 нм
А. Б. Боруздина 1, *, Ю. М. Герасимов 2, Н. Г. Григорьев 2, А. В. Кобыляцкий 2, А. В. Уланова 1, И. И. Швецов-Шиловский 1
1 АО “ЭНПО Специализированные электронные системы”
115409 Москва, Каширское ш., 31, Россия
2 Национальный исследовательский ядерный университет “МИФИ”
115409 Москва, Каширское ш., 31, Россия
* E-mail: abbor@spels.ru
Поступила в редакцию 22.11.2018
После доработки 12.12.2018
Принята к публикации 16.12.2018
Аннотация
Работа посвящена исследованию радиационно-индуцированных утечек между n-областями различных типов с использованием тестовых структур, выполненных по 0.18 мкм КМОП технологии. Показано, что в зависимости от дозы радиационного воздействия утечки между n+-областями и n-карманом могут в 3–9 раз превышать утечки между n+-областями, что необходимо учитывать при разработке радиационно-стойких СБИС.
ВВЕДЕНИЕ
Радиационная стойкость современных КМОП СБИС по эффекту накопленной дозы определяется в основном радиационно-индуцированными токами утечками, обусловленными накоплением положительного заряда в STI-диэлектрике [1–3]. Эти утечки принято делить на внутриприборные (intra-device) и межприборные (inter-device) [2]. Первые определяются краевыми сток-истоковыми утечками n-канальных транзисторов, а вторые – утечками между n-областями, включая n-карманы. В данной работе рассматривается второй вид утечек, включающий в себя две разновидности – утечки между n+-областями (рис. 1а), и между n+-областью и n-карманом (рис. 1б).
Рис. 1.
Межприборные радиационно-индуцированные утечки: между n+-областями (а) и между n+-областью и n-карманом (б): LP – область утечек.
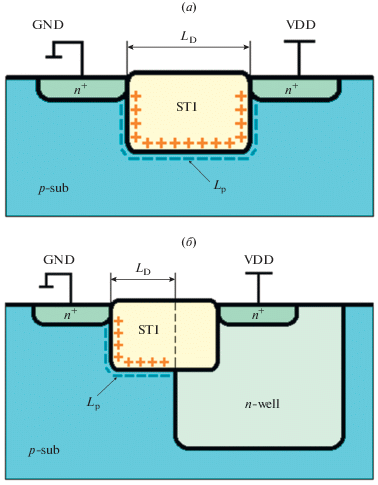
В литературе межприборным утечкам посвящен ряд работ [1–9], в которых описаны физические механизмы радиационно-индуцированных утечек и различные подходы по их моделированию. При этом недостаточное внимание уделено экспериментальному исследованию таких утечек и сравнению различных видов утечек между собой. Так в работах [5, 7] приведены экспериментальные данные по утечкам между n-карманами, которые, во-первых, в СБИС практически не встречаются (абсолютное большинство n-карманов СБИС находятся под одним потенциалом и поэтому утечки между ними отсутствуют), а во-вторых, режим облучения с нулевым потенциалом n-кармана, не соответствует типовому рабочему режиму, в котором на n-карманы подается напряжение питания.
В данной работе сделан акцент на исследовании межприборных утечек в реальных на практике режимах работы, позволяющих дать разработчикам СБИС конкретные данные по межприборным утечкам и рекомендации по проектированию, полученные на основе анализа тестовых структур по 0.18 мкм КМОП технологии с STI-изоляцией.
1. ОБОСНОВАНИЕ ВЫБОРА ТЕСТОВЫХ СТРУКТУР
Основными технологическими параметрами, определяющими радиационно-индуцированные межприборные утечки, являются концентрация примесей в областях утечек и толщина STI-изоляции. В отличие от концентрации примесей, толщина STI-изоляции для КМОП технологий уровня 0.25 мкм и менее практически не масштабируется при изменении проектных норм, оставаясь в пределах 350–450 нм. При такой толщине STI пороговое напряжение паразитного МДП-транзистора составляет 40–60 В, а область под пороговых токов начинается от 30–40 В [2, 7].
Основными конструктивно-схемотехническими параметрами, влияющими на межприборные утечки, являются расстояния между n-областями (LD на рис. 1) и уровни напряжений, подаваемые на n+-области, n-карман и STI-области. Для обеспечения повышенной точности сравнения тестовых структур они были размещены на одном кристалле и расположены в непосредственной близости друг от друга.
Для оценки эффективности использования разделительной p+-охраны для подавления межприборных утечек рядом с основными тестовыми структурами на рис. 1 расположены структуры, показанные на рис. 2, содержащие разделительные p+-области между n+-областями (рис. 2а) и между n+-областью и n-карманом (рис. 2б).
Рис. 2.
Структуры с p+-охранными областями: между n+-областями (а) и между n+-областью и n-карманом (б).
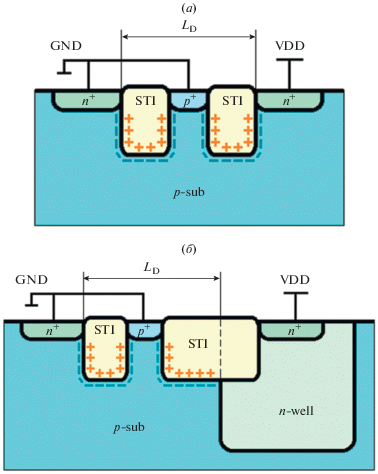
Исследуемые тестовые структуры изготовлены в России по КМОП технологии уровня 0.18 мкм с использованием STI-изоляции толщиной около 350 нм и ретроградного профиля карманов. Концентрация примесей в подложке вблизи донной области STI-изоляции составляет около 5 × 1016 см–3.
Параметры тестовых структур представлены в табл. 1. Топология структур выполнена таким образом, что не содержит области металла нижнего уровня над STI-областью между исследуемыми областями на рис. 1. При этом на одной из n+-областей на рис. 1а и области n-кармана на рис. 1б во время облучения поддерживается напряжение 1.8 В.
2. ЭКСПЕРИМЕНТАЛЬНЫЕ РЕЗУЛЬТАТЫ
Исследования проводились с использованием аппаратно-программного комплекса (АПК) на основе оборудования National Instruments [10, 11] с использованием цифрового модуля генератора/ анализатора сигналов NIPXI e-6556. Модуль P-XIe-6556 использовался в аналоговом режиме в качестве источника-измерителя, для которого программным способом была реализована возможность автоматического выбора предела измерения тока с точностью до 0.06 нА. Структурная схема АПК приведена на рис. 3.
Облучения проводились на базе установки “Гамма-Панорама НИЯУ МИФИ” [11 ] при интенсивности 12 ед./сс помощью изотопа Сs137, средняя энергия излучения которого составляла 0.529 МэВ, а максимальная энергия – 0.662 МэВ.
Зависимости нормированного тока утечки всех четырех тестовых структур от дозы облучения представлены на рис. 4.
Наибольших абсолютных значений при облучении достигает приведенный на единицу ширины структуры ток утечки между n-карманом и n+-областью без разделительной p+-области (рис. 1б), достигая величины 444 пA/мкм при максимальной дозе облучения 2.7 Мрад.
Ток утечки между n-областями (рис. 1а) оказался существенно меньше по сравнению с током утечки между n-карманом и n+-областью (рис. 1б), особенно в области малых доз облучения 50–100 к рад, где токи структур различаются почти на порядок.
При этом необходимо учесть, что топологическое расстояние LD между n-карманом и n+-областью в тестовой структуре на рис. 1б примерно на 20% меньше по сравнению с расстоянием между n+-областями на рис. 1а. Поэтому для более корректного сравнения, на рис. 5 показана зависимость отношений токов утечки структур, приведенных к равным расстояниям между n-областями. Однако и в этом случае различие между структурами по токам утечки оказывается существенным, достигая 7–8 раз в области доз облучения до 50–100 к рад.
Рис. 5.
Зависимость отношения тока утечки структуры N2 к току структуры N1 от дозы облучения для расстояний между структурами: 1 – в соответствии с табл. 1; 2 – нормированных на LD; 3 – нормированных на LP.
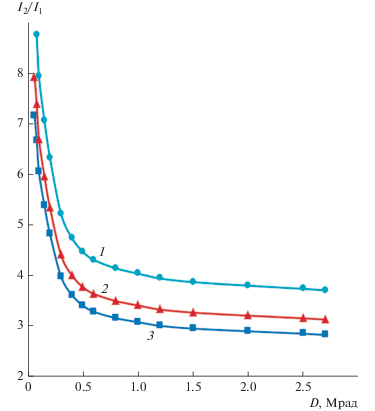
В результате исследований установлено, что в обеих структурах с разделительными p+-областями (рис. 2) практически не наблюдалось увеличения тока утечки по сравнению с начальными значениями, что свидетельствует об эффективности использования разделительной p+-охраны для подавления радиационно-индуцированных токов утечки.
ЗАКЛЮЧЕНИЕ
На основе исследования двух типов межприборных радиационно-индуцированных утечек показано, что во всем диапазоне доз облучения до 2.7 Мрад утечки между n+-областями и n-карманом существенно превышают утечки между n+-областями. Наибольшее различие (до 7–8 раз) утечек наблюдается при дозе облучения 50–100 к рад.
С увеличением дозы облучения наступает эффект насыщения и различие уровней утечек уменьшается. Однако оно остается существенным (3-х кратным) вплоть до максимальной дозы 2.7 Мрад.
Использование разделительных p+-охранных областей между n-карманом и n+-областями является эффективным способом подавления межприборных утечек. При этом подавляется и тиристорный эффект за счет сопутствующего увеличения ширины базы паразитного биполярного npn-транзистора (приводящего к уменьшению его усиления), а также уменьшения паразитного сопротивления базы и лучшей фиксации ее потенциала.
Список литературы
Barnaby H. Total-ionizing-dose effects in modern CMOS technologies // IEEE Trans. on Nucl. Sci. 2006. V. 53. № 6. P. 3103–3121.
Lacoe R.C. CMOS scaling, design principles and hardening-by-design methodologies // IEEE NSREC Short Course. 2003. Section II. P. 1–142.
Schwank J.R., Shaneyfelt M.R., Fleetwood D.M., Felix J.A., Dodd P.E., Paillet P., Ferlet-Cavrois V. Radiation Effects in MOS Oxides // IEEE Trans. on Nucl. Sci. 2008. V. 55. № 4. P. 1833–1852.
Zebrev G.I., Gorbunov M.S. Modeling of Radiation-Induced Leakage and Low Dose-Rate Effects in Thick Edge Isolation of Modern MOSFETs // IEEE Trans. on Nucl. Sci. 2009. V. 56. № 4. P. 2230–2236.
Barnaby H.J., McLain M.L., Esqueda I.S., Xiao J.C. Modeling Ionizing Radiation Effects in Solid State Materials and CMOS Devices // IEEE Trans. on Nucl. Sci. 2009. V. 56. № 8. P. 1870–1883.
Esqueda I.S., Barnaby H.J., Holbert K.E., Boulghassoul Y. Modeling Inter-Device Leakage in 90 nm Bulk CMOS Devices // IEEE Trans. on Nucl. Sci. 2011. V. 58. № 3. P. 793–799.
Селецкий А.В., Шелепин Н.А., Смолин А.А., Уланова А.В. Исследование влияния разброса технологических параметров СБИС на стойкость к эффектам накопленной дозы радиации с помощью средств приборно-технологического моделирования // Проблемы разработки перспективных микро- и наноэлектронных систем – 2016. Сборник трудов / Под общ. ред. академика РАН Стемпковского А.Л. М.: ИППМ РАН, 2016. Часть IV. С. 178–183.
Zebrev G.I., Drosdetsky M.G. Temporal and Dose Kinetics of Tunnel Relaxation of Non-Equilibrium Near-Interfacial Charged Defects in Insulators // IEEE Trans. on Nucl. Sci. 2016. V. 63. № 6. P. 2895–2902.
Shvetsov-Shilovskiy I.I., Nekrasov P.V., Ulanova A.V., Nikiforov A.Y. Advanced system for CMOS SOI test structures measurements // in Proc. 2016 International Siberian Conference on Control and Communications, SIBCON 2016 National Research University “Higher School of Economics” Moscow; Russian Federation, 2016, May 12–14, article number 7 491 817.
Shvetsov-Shilovskiy I.I., Boruzdina A.B., Ulanova A.V., Orlov A.A., Amburkin K.M., Nikiforov A.Y. Measurement system for test memory cells based on keysight B1500A semiconductor device analyzer running LabVIEW software // in Proc. 2017 International Siberian Conference on Control and Communications, SIBCON 2017, S. Seifullin Kazakh Agrotechnical University, Astana; Kazakhstan, 2017, June 29–30, article number 7 998 542.
Artamonov A.S., Sangalov A.A., Nikiforov A.Y., Telets V.A., Boychenko D.V. The new gamma irradiation facility at the National Research Nuclear University MEPhI // in 2014 IEEE Radiation Effects Data Workshop, REDW 2014, Paris, France, 2014, Jul. 14–18. P. 258–261, article number 7 004 600.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника