Микроэлектроника, 2019, T. 48, № 2, стр. 106-110
Формирование диэлектрических нанослоев оксидов алюминия и кремния на полупроводниках AIIIBV
Ю. К. Ежовский *
Санкт-Петербургский Государственный технологический институт (технический университет)
190013 Санкт-Петербург, Россия
* E-mail: ezhovski1@mail.ru
Поступила в редакцию 14.06.2018
Аннотация
Представлены обобщенные результаты изучения процессов формирования нанослоев оксидов кремния и алюминия, полученных методом молекулярного наслаивания (атомно-слоевого осаждения) на поверхности бинарных полупроводников GaAs, InAs и InSb. Определены условия слоевого механизма роста поверхностных наноструктур и проведена оценка их некоторых диэлектрических характеристик.
ВВЕДЕНИЕ
Создание различного типа наноустройств представляет собой задачу, для решения которой необходимо разработать методы синтеза соответствующих материалов и изучить фундаментальные закономерности поведения нанообектов [1]. Особое место занимает электронная техника, где интенсивно ведутся разработки новых технологий, позволяющих создавать твердотельные наноструктуры на атомно-молекулярном уровне. Появление метода молекулярно-лучевой эпитаксии (МЛЭ) [2] позволило не только решить ряд важнейших задач микроэлектроники, но и создавать новый тип твердотельных структур – сверхрешетки. Однако высокая стоимость оборудования МЛЭ и невозможность групповой обработки изделий, вызвали развитие альтернативных методов. В последние годы для создания качественных ультратонких слоев интенсивно изучаются процессы атомно-слоевого осаждения (АСО) или “ALD-технология” (Atomic layer deposition) [3–5]. Достоинства и перспективность этого метода при создании субмикронных элементов интегральных устройств продемонстрировано в ряде работ [6–8]. ALD-технология базируется на процессах, известных ранее как молекулярное наслаивание (МН), физико-химические основы которого были разработаны еще в 70-е годы школой российских ученых под руководством В.Б. Алесковского [9]. Использующие газо-фазную подачу реагента и имеющие самоорганизующийся характер, такие процессы позволяют осуществлять групповую обработку изделий, что обеспечивает их рентабельность.
В настоящей работе представлены результаты исследований процессов синтеза и основных диэлектрических характеристик (проводимость, диэлектрическая проницаемость) нанослоев Al2O3, и SiO2, полученных методом молекулярного наслаивания на поверхности монокристаллических пластин GaAs, InAs и InSb.
ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
Использование поверхностных химических реакций позволяет осуществлять синтез низкоразмерных структур с контролем состава и толщины в пределах одного монослоя. Получение оксидных слоев обычно базируется на самоограничивающихся процессах хемосорбции галогенида металла (МCln) и паров воды в условиях предельного заполнения поверхности. Например, на гидроксилированной поверхности (символ |) процесс проводят по реакциям:
(1)
$\left| { - {\text{OH}}} \right.{{)}_{m}} + {\text{MC}}{{{\text{l}}}_{n}} \to \left| { - {\text{O}} - } \right.{{)}_{m}}{\text{MC}}{{{\text{l}}}_{{n--m}}} + m{\text{HCl,}}$(2)
$\left| { - {\text{O}} - } \right.{{)}_{m}}{\text{MC}}{{{\text{l}}}_{{n - m}}}\quad + {\text{ }}(n--m){{{\text{Н }}}_{2}}{\text{О }} \to \left| { - {\text{O}}\, - } \right.{{)}_{m}}{\text{M}}{{\left( {{\text{О Н }}} \right)}_{{n - m}}} + {\text{ }}(n - m){\text{HCl}}.$Значение m зависит от поверхностной концентрации гидроксильных групп и, например, для кремниевой матрицы m ≈ 2 [10]. Многократное повторение реакций (1) и (2), с промежуточным удалением избытка реагентов и продуктов реакции, приводит к формированию оксидного слоя заданной толщины. При этом необходимо, чтобы температурные условия (Тп) роста пленок бинарных соединений АВ отвечали соотношению:
где $T_{A}^{\centerdot },T_{B}^{\centerdot },T_{{AB}}^{\centerdot }$ – критические температуры конденсации компонентов А, В и соединения АВ соответственно. Это исключают прямую конденсацию компонента А или В и процесс ограничивается формированием хемосорбированного монослоя. Кроме этого, поверхностные реакции (1) и (2) должны проходить в условиях, обеспечивающих полноту их протекания. Для этого необходима достаточно высокая активность гидроксильных групп поверхности. Ее оценка по шкале индуктивных констант Тафта для арсенид-галлиевой матрицы, проведенная, дало значение σS = 5.25 [11], что удовлетворяет условиям ($\sigma _{S}^{*}$ > $\sigma _{i}^{*}$), для проведения поверхностных реакций с парами хлоридов ($\sigma _{{i\left( {{\text{Cl}}} \right)}}^{*}$ = 2.88) кремния и алюминия [11].В качестве подложек в работе использовались пластины арсенида галлия (АГЧТ-23-17 с ориентацией (100) и АГЭ-4-16 с ориентацией (110)); арсенида индия (эпитаксиальные структуры ИМН10/ПАИ-380-25,5 с ориентацией (111) и (100)) и антимонида индия (ИСЭ-0 с ориентацией (111)), прошедшие предварительное травление в метонол-бромном травителе (1–5% Br). По эллипсометрическим оценкам толщина остаточного оксидного слоя при этом на всех матрицах не превышала 2 нм.
Синтез оксидных нанослоев проводился в соответствие с реакциями (1) и (2) при давлении паров хлоридов соответствующего металла (Р = 1–10 Па) и воды (Р ≈ 100 Па) с промежуточным удалением избытка реагентов и продуктов реакции. Процесс проводился в вакуумно-проточной установке при давлении остаточных газов не выше 10–1 Па.
Толщина слоев определялась по эллипсометрическим измерениям параметров Δ и Ψ, и рассчитывалась в приближении однослойной модели Друде–Тронстона [12]. Параметры Δ и Ψ измерялись на эллипсометре, собранном по схеме PQSA [13] с фиксированным компенсатором. В качестве источника линейно поляризованного света использовался лазер ЛГ-75 с длиной волны излучения 632.8 нм. Для повышения точности измерений осуществлялась магнитная модуляция светового луча. Погрешность в определении этих параметров не превышала ±0.01′. Эллипсометрический контроль показателя преломления синтезированных структур позволял идентифицировать их состав, который контролировался также по данным рентгено-фотоэлектронной спектроскопии (РФЭС), с использованием спектрометра НР-5950А (излучение AlKα c ${{E}_{{{{K}_{\alpha }}}}}$ = 1486 эВ) и СЭР-1 (излучение MgKα c ${{E}_{{{{K}_{\alpha }}}}}$ = 1253 эВ).
Определение диэлектрических характеристик слоев проводилось как на используемых матрицах, так и на вакуумно-напыленных пленках алюминия на кремнии толщиной около 0.1 мкм. В качестве противоэлектрода использовались металлы никель или олово, имеющие необходимую работу выхода электронов.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Изучение динамики роста слоев указанных оксидов при различных температурах подложки (рис. 1) и давлении паров реагентов показало, что для синтезируемых слоев SiO2, и Al2O3, наблюдалась линейная зависимость d = f(N), что указывало на сохраняющуюся активность гидроксилов и равномерное количество синтезированного поверхностного соединения в каждом цикле. Во всех случаях толщина пленки (d) была пропорциональна количеству циклов обработки (N) поверхности матрицы по реакциям (1) и (2):
где d0 – параметр роста слоев, показывающий усредненную толщину слоя за один цикл обработки одним и другим компонентами и характеризующий строение синтезированного слоя. Эта величина позволяет также оценивать степень заполнения поверхности растущим слоем и определять механизм его формирования.Рис. 1.
Зависимость толщины от количества циклов для слоев SiO2 и Al2O3 полученных, на (100) GaAs при Т = 403 K (1); Т = 453 K (2); Т = 523 K (3) при давлении паров реагентов Р = 13 Па.

Анализ серии зависимостей d = f(N), полученных при различных температурах, позволил установить влияние температурных условий синтеза (Тп) на параметр роста слоев (рис. 2). Как видно из представленных результатов зависимости d0= f (Тп) для SiO2 и Al2O3 заметно отличаются, что объясняется, в первую очередь, особенностями хемосорбции хлоридов кремния и алюминия. Возрастание выхода поверхностных реакций для слоев SiO2 с ростом температуры, указывало на активационный характер хемосорбции SiCl4. В этом случае наиболее вероятно образование с гидроксильной группой активированного комплекса типа:
который сохраняет устойчивость вплоть до T ≈ 500 K. Реализовать слоевой рост SiO2 оказалось возможным только на GaAs и InAs при T > 525 K, когда параметр d0 приближался к толщине монослоя для данного оксида. Для InSb заполнение поверхности кремний-оксидными группировками не превышало 0.5. Снижение значений d0 для InAs и InSb при Тп > 525 и 550 K соответственно, вызвано как снижением плотности гидроксильных групп, так и термохимической неустойчивостью этих матриц в атмосфере галогенида кремния. В пользу этого указывают экспериментальные данные на GaAs, где ОН-группы в этих же условиях термоустойчивы (рис. 2).Рис. 2.
Зависимость параметра d0 для слоев SiO2 (а) и Al2O3 (б) на GaAs (1), InAs (2) и InSb (3) от температуры синтеза при давлении паров реагентов Р = 13 Па.
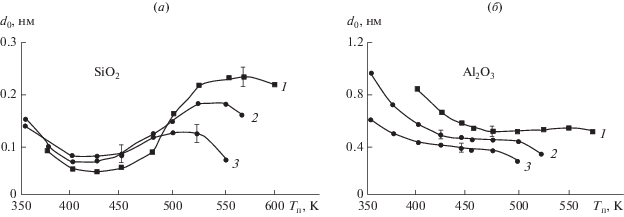
В отличие от диоксида кремния, при формировании слоев Al2O3 активационный характер хемосорбции не наблюдался. Высокие значения d0 для слоев оксида алюминия, значительно превышающие средние размеры алюмокислородных тетраэдров, обусловлены тем, что их формирование осуществлялось за счет хемосорбции димера (Al2Cl6), преобладающего в составе паров. В этом случае реакции (1) и (2) могут протекать с m = 1, 2, 3. Преобладание того или иного направления определяется топографией гидроксильного покрова. При пониженных температурах (Тп < 400 K), когда условия 1 не соблюдаются, а плотность гидроксильных групп велика и возможно даже наличие молекул адсорбированной воды, формирование слоев Al2O3 осуществляется главным образом за счет взаимодействия реагентов в адсорбированном слое с максимальным значением m. Высокие значения d0, при Тп < 400 K указывали на полимолекулярную сорбцию реагентов. Только при Тп > 400 K для InAs и InSb и Тп > 475 K для GaAs значения параметра роста слоев приближались к удвоенным размерам алюмо-кислородных тетраэдров. Это позволило полагать, что в данных условиях реализуется слоевой механизм формирования слоев Al2O3 с преобладанием реакции с m = 2 (рис. 2б).
Снижение значений d0 при Т > 473 K для InAs и Т > 453 K для InSb вызвано, по всей вероятности не столько снижением плотности гидроксильных групп, сколько термохимической неустойчивостью этих матриц в атмосфере галогенида. В пользу этого указывает симбатное сужение диапазона слоевого роста слоев как для Al2O3, так и SiO2 с теплотой образования соединения в ряду GaAs, InAs, InSb (рис. 2). Следует отметить, что формирование слоев Al2O3 и SiO2 на GaAs, InAs и InSb проходило по закономерностям аналогичным для кремниевой матрицы и других оксидов [10, 14], что указывало на их общий характер, свойственный процессу молекулярного наслаивания.
Электронографическое исследование структуры синтезированных пленок показало, что слои SiO2 при всех толщинах и во всем диапазоне температур были аморфны. Алюмооксидные слои при Тп < 450 K при толщинах до 100 нм также были аморфны, и только при Тп > 450 K содержали α‑Al2O3, причем, по мере увеличения толщины и температуры синтеза количество кристаллической фазы заметно возрастало. Наблюдаемое уширение дифракционных колец на электронограммах позволило оценить средний размер кристаллитов, который составлял от 2 до 20 нм в зависимости от толщины слоев. По всей вероятности в остове этих кристаллитов лежат оксидные группировки, образующиеся на ансамблях регулярно расположенных гидроксильных групп относительно однородных участков поверхности. Термообработка алюмооксидных слоев на GaAs (Т = 623 K) вызывала значительное повышение интенсивности рефлексов на электронограммах и резкое увеличение размеров кристаллитов до 20–50 нм, т.е. приводила к практически полной кристаллизации слоя оксида алюминия.
По данным РФЭ спектров нанослоев указанных оксидов в них не обнаружены пики в области энергий 190–200 и 260–270 эВ, характерные для 2s и 2p уровней хлора. Некоторое расширение спектра по состояниям кислорода (530–531 эВ) указывало на присутствия гидроксильных групп. При толщинах оксидных слоев более 8 нм (глубина выхода электронов) сигнал от подложки в РФЭ спектрах полностью отсутствовал. Данный факт указывал на сплошность слоев при толщинах более 8 нм.
По сопоставлению площадей пиков РФЭС кислорода и металла было определено их соотношение в оксидном слое, синтезированном на GaAs при различных температурах (табл. 1). Результаты показали, что при Тп = 423 K оно повышено и с ростом температуры снижалось до стехиометрических значений. Аналогичные результаты наблюдались для слоев Al2O3 на кремниевой матрице [14]. Повышенное содержание кислорода при Т < 553 K вызвано, по всей вероятности, гидратацией оксидного слоя, причем для оксида алюминия оно более существенно, что отражалось на его диэлектрических характеристиках.
Таблица 1.
Соотношение кислорода и металла в слоях оксида алюминия при различных температурах синтеза
| Тп, K | 423 | 473 | 523 | 553 | 573 | 773* |
|---|---|---|---|---|---|---|
| [O]/[Al] | 4.0 | 2.3 | 1.8 | 1.5 | 1.5 | 1.5 |
| [O]/[Si] | 3 | 2.5 | 2 | 2 | 2 | 2 |
ИК-спектроскопические исследования проведенные методом многократного нарушенного полного внутреннего отражения (МНПВО) пленок оксида алюминия, синтезированных на элементах GaAs при Тп = 553 K, подтвердили результаты, полученные по данным РФЭС. Хорошо различались максимумы поглощения с ν = 744 и 835 см–1, характерные для связи Al–O с координацией металла шесть и четыре.
Изучение диэлектрических характеристик нанослоев проводилось при напряженности электрического поля Е = 5 × 104 – 1 × 105 В см–1 на образцах с толщиной оксидного слоя 10–30 нм, когда исключались туннельные эффекты и проводимость уже не зависела от толщины слоя, а определялась только температурными условиями синтеза (рис. 3). Во всех случаях с повышением Тп наблюдалось снижение проводимости до минимальных значений, которые характерны для условий слоевого роста наноструктур. Повышенная проводимость слоев при Тп < 400 K вызвана гидратацией оксидов и хорошо согласуется с данными РФЭС по соотношению [O]/[Al] в синтезированных слоях. В табл. 2 представлены экспериментальные результаты по определению основных диэлектрических характеристик нанослоев синтезированных в условиях слоевого роста.
ЗАКЛЮЧЕНИЕ
Методом молекулярного наслаивания (атомно-слоевого осаждения) на поверхности GaAs и InAs и InSb осуществлен синтез нанослоев оксидов кремния и алюминия. Анализ влияния температурного фактора показал, что формирование оксидных наноструктур попеременной хемосорбцией паров галогенида металла и воды, может осуществляться по трем механизмам: реакцией между компонентами в полимолекулярном адсорбированном слое с образованием гидратированных оксидов, последовательном наращивании мономолекулярных слоев (слоевой механизм роста), образованием и последующим развитием двумерных островковых структур. При этом если в условиях слоевого роста хемосорбция SiCl4 носила активационный характер и слоевой рост SiO2 наблюдался только при Тп > 500 K, то для хлорида алюминия она протекает в виде димера по безактивационному механизму. Это приводит к высоким значениям параметра d0 для Al2O3 для всех температурных режимов.
Результаты оценки основных диэлектрических характеристик пленок SiО2 и Al2O3, полученных в условиях слоевого роста показали, что нанослои обладают достаточно высокими параметрами. Это позволяет использовать метод молекулярного наслаивания для создания качественных диэлектрических структур, в том числе и многослойных, в элементной базе микро- и наноэлектронных систем, например, подзатворного диэлектрика МДП-структур, емкостных элементов и барьерных слоев.
Работа выполнена при частичной финансовой поддержке Минобрнауки (Проект 16.1798.2017/ПЧ).
Список литературы
Нанотехнология в ближайшем десятилетии. Прогноз направления исследований / Под ред. Роко М.К., Уильямса Р.С. и Аливисатоса П. / Пер. с англ. Хачояна А.В. под ред. Андриевского Р.А. М.: Мир, 2002.
Молекулярно-лучевая эпитаксия и гетероструктуры / Под ред. Ченга Л., Плога К. / Пер. с англ. под ред. Алферова Ж.И. М.: Мир, 1989. 582 с.
Suntola T. Atomic layers epitaxy // Mater. Sci. Rep. 1989. V. 4. № 7. P. 261–312.
Seidel T., Londergan A., Winkler L. Progress and opportunities in Atomic Layer Deposition // Solid State Technol. 2003. № 5. P. 67–71.
Miikkulainen V., Leskela M., Ritala M., Puurunen R.L. Crystallinity of inorganic films grown by atomic layer deposition: Overview and general trends // J. Appl. Phys. 2013. V. 113. № 2. P. 021301–021401.
Nishizava J., Kurabayash T. Latest Molecular Layer Epitaxy Technology // Chemistry for Sustainable Development. 2000. № 8. P. 5–12.
Ming X. Assault on it RC road blocks led by atomic layer deposition // Solid State Technol. 2001. V. 44. P. 70–74.
Gelatos J., Chen L., Chung H., Thakur R. ALD for sub-90nm device node barriers, contacts and capacitors // Solid State Technol. 2003. V. 2. P. 44–48.
Алесковский В.Б. Химическая сборка материалов // Вестн. АН СССР. 1975. № 6. С. 48–54.
Ежовский Ю.К. Химическая нанотехнология оксидных и нитридных низкоразмерных структур на полупроводниковых матрицах // Микроэлектроника. 2010. Т. 39. № 3. С. 202–209.
Ежовский Ю.К. Количественная оценка реакционной способности поверхности твердых тел на основе индуктивных постоянных // Успехи химии. 2004. Т. 73. № 2. С. 209–219.
Аззам Р., Башара Н. Эллипсометрия и поляризованный свет. М.: Мир, 1981. 583 с.
Громов В.К. Введение в эллипсометрию. Л.: Изд. ЛГУ, 1986. 192 с.
Ежовский Ю.К. Формирование и диэлектрические характеристики нанослоев оксидов тантала и алюминия // Микроэлектроника. 2013. Т. 42. № 6. С. 447–453.
Цыганенко А.А., Мардилович П.П., Лысенко Г.М., Трохимец А.И. ИК-спектроскопия в исследовании поверхности // Успехи фотоники. Вып. 9. Cб – Л. ЛГУ, 1987. С. 28–68.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника





