Микроэлектроника, 2019, T. 48, № 2, стр. 97-105
Исследование режимов профилирования поверхности кремния методом фокусированных ионных пучков
И. Н. Коц 1, *, А. С. Коломийцев 1, С. А. Лисицын 1, В. В. Полякова 1, В. С. Климин 1, О. А. Агеев 2, **
1 Институт нанотехнологий, электроники и приборостроения, Южный федеральный университет
347928 Таганрог, ул. Шевченко, 2, Россия
2 Научно-образовательный центр “Нанотехнологии”, Южный федеральный университет
347928 Таганрог, ул. Шевченко, 2, Россия
* E-mail: inkots@sfedu.ru
** E-mail: ageev@sfedu.ru
Поступила в редакцию 23.10.2018
Аннотация
Представлены результаты экспериментальных исследований режимов субмикронного и наноразмерного профилирования поверхности подложек кремния КДБ-10 (100) методом фокусированных ионных пучков. Установлено, что при увеличении тока ионного пучка от 1 до 300 пА, диаметр и глубина наноразмерных структур увеличивается от 45 до 380 нм и от 82 до 494 нм соответственно. Лучшее разрешение, определяемое минимальным расстоянием между вытравленными линиями составило10 нм. Показано, что при уменьшении тока ионного пучка от 7 нА до 1 пА и времени воздействия от 100 до 0.2 мкс уменьшается отклонение стенок вытравленной структуры от вертикали (до 30°). Результаты проведенных исследований могут быть использованы при разработке технологических процессов создания элементов наноэлектроники и микросистемной техники методом фокусированных ионных пучков.
ВВЕДЕНИЕ
Повышение плотности интеграции элементов СБИС определяется совершенствованием технологических процессов формирования электронной компонентной базы, и в частности процессов литографии. Современные литографические процессы, такие как оптическая литография в экстремальном ультрафиолете и электронно-лучевая литография, требуют последующего применения жидкостного или плазменного травления, что зачастую создает артефакты при переносе топологического рисунка шаблона, усложняет процесс управляемого формирования наноразмерных структур и ухудшает разрешающую способность метода [1, 2]. В связи с этим актуальными становятся исследования методов безмасочного формирования топологического рисунка, и в частности метод локального ионно-лучевого травления фокусированным ионным пучком (ФИП) [3–10].
Метод ФИП, благодаря использованию ионного пучка сверхмалого диаметра и возможности прецизионно управлять параметрами его воздействия на поверхность, позволяет формировать наноразмерные структуры с контролируемыми геометрическими параметрами [10–16].
При травлении методом ФИП на результирующую геометрию поверхности структур, кроме топологии шаблона, оказывают влияние большое число факторов: особенности взаимодействия ионов и материала подложки, степень кристаллического совершенства подложки, параметры ионного пучка (ток и ускоряющее напряжение), режимы сканирования (шаг, overlap – степень перекрытия диаметра ионного пучка при пошаговом перемещении), а также эффекты переосаждения распыляемого в процессе травления материала [17–20]. Анализ и учет данных факторов необходим для повышения точности формирования наноразмерных структур на поверхности подложки.
Целью работы является определение закономерностей влияния режимов профилирования поверхности подложек кремния методом фокусированных ионных пучков на разрешающую способность метода, шероховатость поверхности и отклонение стенок от вертикали.
ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
Экспериментальные исследования производились с использованием двухлучевого электронно-ионного сканирующего микроскопа Nova NanoLab 600 (“FEI Company”, Нидерланды) и сканирующей зондовой нанолаборатории Ntegra Vita (ЗАО “НТ-МДТ”, Россия). В качестве подложки использовались пластины кремния марки КДБ-10 (100), которые предварительно подвергались химической очистке. Анализ морфологии и геометрических характеристик вытравленных структур проводился методом растровой электронной микроскопии (РЭМ) и полуконтактной атомно-силовой микроскопии (АСМ). Статистическая обработка полученных АСМ-изображений производилась с использованием программного пакета Image Analysis 2.0 (ЗАО “НТ-МДТ”, Россия).
На первом этапе исследований, для определения влияния воздействия ионного пучка на поверхность, на кремниевой подложке методом ФИП формировался массив из 25 структур в виде углублений, при различных режимах профилирования. При травлении был использован растровый шаблон, представляющий собой потоковый ASCII-файл, содержащий координаты точек травления, время воздействия в каждой точке и число проходов ионного луча по структуре. Перемещение ионного луча по подложке, в соответствии с шаблоном, осуществлялось последовательно, от точки к точке. Параметры, используемые в ходе эксперимента представлены в табл. 1.
Таблица 1.
Параметры травления фокусированным ионным пучком
№ этапа |
Параметры | ||||
|---|---|---|---|---|---|
| ток, пА | количество проходов, тыс. шт | время воздействия в точке, мкс | заданная глубина травления, нм | область перекрытия (overlap), % | |
| Первый этап | 1, 10, 30, 50, 100, 300, 500, 1000, 3000, 5000 | 6, 7, 8, 9.6, 12, 24, 46 | 1.5 | Задается количеством проходов | 50 |
| Второй этап | Задается глубиной травления | 0.25, 0.5, 0.75, 1, 1.5, 2 | 10, 20, 30, 40, 50, 60, 70, 80, 90, 100 | ||
| Третий этап | 10, 30, 50, 100, 300, 500, 1000, 3000 | 1.5 | 50 | 10, 20, 30, 40, 50, 60, 70, 80, 90 | |
| Четвертый этап | 1, 10, 30, 50, 100, 300, 500, 1000, 3000, 5000, 7000 | 0.2, 0.4, 0.6, 0.8, 1 | 100 | 50 | |
На втором этапе экспериментальных исследований производилась оценка влияния технологических параметров ФИП на разрешающую способность локального ионно-лучевого травления. Для этого, с помощью встроенных средств проектирования в программе управления ФИП, был сформирован шаблон для травления, состоящий из параллельных линий, расположенных на расстоянии от 5 до 100 нм друг от друга. Ширина линий определялась единичным воздействием ионного пучка (при overlap = 50%) и зависела от выбранных режимов (табл. 1). Особенностью данного шаблона является отсутствие областей перекрытия ионного пучка между соседними линиями.
На третьем этапе экспериментальных исследований, для определения влияния параметров ФИП на шероховатость обработанной ионным пучком поверхности, формировались углубления прямоугольной формы, размером 1 × 1 мкм, дно которых исследовалось методом АСМ. Используемые параметры травления ФИП представлены в табл. 1.
На четвертом этапе исследований, для определения влияния параметров ФИП на отклонение стенок вытравленной структуры от вертикали, формировались тестовые структуры в виде прямоугольников при различных режимах ионно-лучевого травления. Шаблон для травления формировался стандартными средствами программы управления ФИП при параметрах, представленных в табл. 1. Отклонение стенок вытравленной структуры от вертикали оценивалось по углу наклона стенок, для чего методом ФИП производилось формирование поперечных сечений структур после предварительного осаждения защитного слоя углерода. Измерения угла наклона производились на основе РЭМ-изображений при помощи специализированного программного обеспечения SIS Software Scandium.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
На рис. 1 представлены РЭМ и АСМ изображения структур, полученных на первом этапе исследований при токе 10 пА и количестве проходов 6000.
Рис. 1.
Структуры, сформированные методом ФИП: (а) – РЭМ изображение, (б) – АСМ изображение, (в) – профилограмма.

На основе полученных АСМ-изображений определялись диаметр и глубина структур относительно усредненной поверхности подложки, что позволяет исключить артефакты, образованные при переосаждении.
На рис. 2 представлены зависимости диаметра и глубины структур от режимов травления ФИП.
Рис. 2.
Зависимости диаметра (а), (в), (д) и глубины (б), (г), (е) структур от тока ФИП (а), (б), количества проходов пучка (в), (г) и времени воздействия пучка в точке (д), (е).

Анализ зависимостей, представленных на рис. 2 показывает, что диаметр и глубина структур увеличиваются с ростом тока ФИП, времени воздействия в точке и количества проходов.
Установлено, что наиболее интенсивно диаметр и глубина возрастают с увеличением тока ФИП. Так в диапазоне токов от 1 пА до 0.5 нА при времени воздействия в точке 1500 мкс и количестве проходов 9000 диаметр увеличивается с 44 ± 1 до 370 ± 7.6 нм, а глубина с 82 ± 27 до 495 ± 55 нм (рис. 2а, б). Данный эффект можно объяснить увеличением плотности потока энергии и увеличением диаметра ионного луча. При этом увеличение количества проходов с 6000 до 12 000 приводит к увеличению диаметра с 118 ± 20 до 150 ± 1.5 нм, а глубины – с 20 ± 1.4 до 33 ± 2 нм. Отмечается, что при дальнейшем увеличении количества проходов зависимость диаметра ионного пучка насыщается, тогда как глубина травления монотонно возрастает (рис. 2в, г). Это объясняется тем, что при увеличении количества проходов ФИП диаметр пучка остается неизменным, что сводит к минимуму латеральное растравливание. За счет относительно большого числа проходов (более 12000) и небольшого времени воздействия в точке (около 1.5 мкс) при токе 50 пА эффекты переосаждения не оказывают существенного влияния на скорость нормального травления. Увеличение времени воздействия ионного пучка в точке существенно влияет на скорость нормального травления и в меньшей степени на скорость латерального травления (рис. 2д, е), что объясняется постоянством диаметра ионного пучка и влиянием эффекта переосаждения распыляемого материала подложки.
Анализируя полученные экспериментальные данные, можно сделать вывод о том, что для формирования методом ФИП на поверхности подложек кремния структур субмикронных размеров целесообразно применять токи ионного пучка выше 100 пА и времена воздействия пучка в точке более 5 мкс, при количестве проходов ионного пучка >12 000. Для формирования структуры с размерами до 100 нм необходимо использовать токи ионного пучка менее 50 пА, а управлять нормальной составляющей скорости травления возможно путем увеличения времени воздействия ионного пучка в точке и количества проходов.
Для определения разрешающей способности травления кремния методом ФИП проводились измерения минимального расстояния между соседними вытравленными линиями (рис. 3).
Рис. 3.
Структуры состоящие из параллельных линий,полученные методом ФИП: (а) – АСМ изображение, (б) –профилограмма по линии на АСМ изображении.

По результатам измерений были построены зависимости минимального расстояния между соседними линиями от тока ФИП при заданной программными средствами глубине травления 20 нм и времени воздействия 0.5 мкс, от времени воздействия в точке при токе травления 10 пА и заданной программными средствами глубине травления 50 нм, а также от заданной программными средствами глубины травления при токе травления 10 пА и времени воздействия в точке 0.5 мкс (рис. 4).
Рис. 4.
Зависимости минимального расстояния между вытравленными линиями от (а) тока ионного пучка, (б) времени воздействия в точке, (в) заданной глубины травления.

Заданная глубина травления рассчитывается программой управления ФИП, путем определения времени воздействия в точке, количества проходов и др. для заданного тока ионного пучка и ускоряющего напряжения. Анализ зависимостей на рис. 4 показывает, что при увеличении тока ФИП, времени воздействия пучка в точке и заданной глубины травления происходит увеличение ширины вытравленной линии, что приводит к снижению расстояния между соседними линиями. Влияние тока ФИП объясняется увеличением диаметра ионного зонда, механизм влияния времени воздействия в точке и заданной глубины травления заключается в латеральном растравливании из-за Гауссова распределения энергии пучка ФИП по диаметру [21]. Наилучшее разрешение, соответствующее минимальному расстоянию между вытравленными линиями составило 10 нм. При токе ионного пучка 1 пА, времени воздействия в точке 0.25 мкс, заданной глубиной травления 10 нм, области перекрытия (overlap) 50%.
Анализ значений шероховатости дна вытравленных структур, полученных на третьем этапе экспериментальных исследований показал, что значения тока ионного пучка и времени воздействия пучка в точке не оказывают на нее существенного влияния.
Из зависимости шероховатости дна структур, полученных травлением методом ФИП, от значения параметра overlap (рис. 5) следует, что наименьшая шероховатость структур, полученных ионно-лучевым травлением методом ФИП наблюдается при значениях overlap близких к 50%, что объясняется наиболее равномерным распределением плотности потока энергии ионов по заданной площади [22].
С помощью встроенных средств обработки РЭМ изображений был проведен анализ влияния режимов ФИП на угол наклона стенок полученных структур (рис. 6).
Анализ полученных зависимостей (рис. 7а, б) показывает, что с увеличением тока ионного пучка (при заданной глубине травления 100 нм и времени воздействия 1 мкс) и времени воздействия пучка в точке (при токе травления 10 пА и времени воздействия 1 мкс) возрастает угол наклона, а значит и отклонение стенок от вертикали.
Рис. 7.
Зависимости угла наклона стенок вытравленных структур от тока ФИП (а) и времени воздействия ФИП в точке (б).
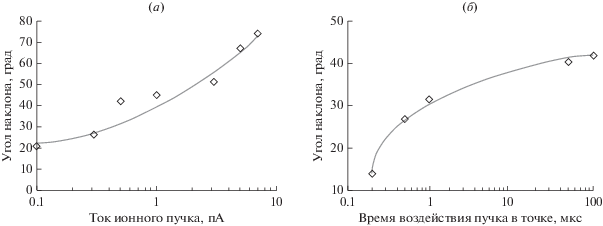
Влияние тока может быть объяснено двумя причинами. Во-первых – увеличением диаметра и плотности потока энергии ионного пучка при увеличении тока, что приводит к дополнительному подтравливанию стенки за счет периферийных участков ионного пучка. Во-вторых – увеличением интенсивности переосаждения материала, при этом у граней структуры образуются “наплывы”, сглаживающие рельеф поверхности после травления. Увеличение угла наклона с увеличением времени воздействия в точке также объясняется влиянием переосаждения распыляемого материала. Общее время травления структуры определяется временем воздействия в точке, числом точек и количеством проходов, поэтому при малых значениях времени воздействия в точке количество проходов велико, что позволяет минимизировать переосаждение за счет стравливания части переосажденного материала при последующем проходе ионного пучка. При больших значениях времени воздействия в точке и малом количестве проходов количество переосаждаемого материала увеличивается, следовательно, угол наклона стенок выше, и его зависимость от времени воздействия в точке насыщается в диапазоне значений времени свыше 50 мкс, так как при этом количество проходов близко к 1, и количество переосажденного материала является максимальным.
Таким образом, для формирования методом ФИП на кремниевой подложке структур с минимальным отклонением стенок от вертикали рекомендуется применять токи ионного пучка до 1 пА и времена воздействия ионного пучка в точке до 1 мкс, при количестве проходов более 1000.
ЗАКЛЮЧЕНИЕ
В результате проведенной работы исследованы режимы формирования субмикронных и наноразмерных структур на подложке кремния марки КДБ-10 (100) травлением методом фокусированных ионных пучков. Получены зависимости геометрических параметров структур от тока ионного пучка, количества проходов и времени воздействия в точке. Установлено, что для формирования субмикронных структур целесообразно применять токи ионного пучка свыше 100 пА и времена воздействия пучка в точке более 5 мкс при малом числе проходов ионного пучка по шаблону (<12 000), тогда как для формирования структур с размерами до 100 нм необходимо использовать токи ионного пучка менее 50 пА, при этом контролировать нормальные составляющие скорости травления возможно путем увеличения времени воздействия ионного пучка в точке и количества проходов.
Установлено, что определяющим фактором, влияющим на латеральную разрешающую способность процесса ионно-лучевого травления при постоянном ускоряющем напряжении, является ток ионного пучка. Достигнуто значение разрешающей способности, соответствующей расстоянию между вытравленными линиями, равное 10 нм.
Определено, что изменяя параметр overlap можно управлять шероховатостью дна области травления в пределах от 5.5 до 2.4 нм. Минимальные значения шероховатости на кремнии (2.4 нм) получены при значении overlap 50%.
Для формирования структур с отклонением стенок от вертикали до 30° рекомендуется применять токи ионного пучка до 1 пА и времена воздействия ионного пучка в точке до 1мкс при количестве проходов свыше 1000.
Полученные результаты могут быть использованы при разработке технологических процессов формирования элементной базы наноэлектроники и наносистемной техники с использованием метода фокусированных ионных пучков.
Работа выполнена при финансовой поддержке Российского Фонда Фундаментальных Исследований (проект № 18-29-11019мк) и внутреннего гранта Южного Федерального Университета (проекты: № ВнГр-07-/2017-26 и № ВнГр-07/2017-02)с использованием оборудования Научно-образовательного центра и Центра коллективного пользования “Нанотехнологии” Южного Федерального Университета.
Список литературы
Лучинин В.В. Нанотехнологии: физика, процессы, диагностика, приборы. М.: Физматлит, 2006. 552 с.
Bhushan B. Springer Handbook of Nanotechnology (3rd edition) / Ed. by Bharat Bhushan. New York: Springer, 2010. 1964 p.
Ageev O.A., Kolomiytsev A.S., Konoplev B.G. Formation of nanosize structures on a silicon substrate by method of focused ion beams // Semiconductors. 2011. V. 45. № 13. P. 89–92.
Агеев О.А., Алексеев А.М., Внукова А.В. и др. Исследование разрешающей способности наноразмерного профилирования методом фокусированных ионных пучков // Российские нанотехнологии. 2014. Т. 9. № 1–2. С. 40–43.
Ageev O.A., Kolomiytsev A.S., Bykov A.V., Smirnov V.A., Kots I.N. Fabrication of advanced probes for atomic force microscopy using focused ion beam // Microelectronics Reliability. 2015. № 55. P. 2131–2134.
Tseng A. Recent developments in micromilling using focused ion beam technology // J. of Micromechanics and Microengineering. 2004. № 14. P. 15–34.
Giannuzzi L.A., Stevie F.A. Introdution to focused ion beams: instrumentation, theory, techniques and practice. NewYork: Springer, 2004. 357 p.
Левин Д.Д., Неволин В.К., Царик К.А. Формирование наноразмерных графеновых структур фокусированным ионным пучком // Наноиндустрия. 2011. № 5. С. 46–50.
Yongqi Fu, NgoiKok Ann Bryan, Ong Nan Shing, Hung Nguyen Phu Wyan. Influence analysis of dwell time on focused ion beam micromachining in silicon // Sensors and Actuators. 2000. V. 79. № 03. P. 230–234.
Бараш С.В., Лосев В.В., Царик К.А. Формирование нанометровых слоев фокусированным ионным пучком // Изв. вузов. Электроника. 2008. № 3. С. 63–67.
Wilhelmi O. Nanofabrication and rapid prototyping with Dual Beam instruments // FEI Company application note. 2007. URL: http://www.fei.com.
Korsunsky A.M., Salvati E., Lunt A.G.J., Sui T., Mughal M.Z., Daniel R., Keckes J., Bemporad E., Sebastiani M. Nanoscale residual stress depth profiling by Focused Ion Beam milling and eigenstrain analysis // Materials and Design. 2018. V. 145. P. 55–64.
Salvati E., Brandt L.R., Papadaki C., Zhang H., Mousavi S.M., Wermeille D., Korsunsky A.M. Nanoscale structural damage due to focused ion beam milling of silicon with Ga ions // Mater. Lett. 2018. V. 21. P. 346–349.
Lunt A.J.G., Korsunsky A.M. A review of micro-scale focused ion beam milling and digital image correlation analysis for residual stress evaluation and error estimation // Surf. Coat. Technol. 2015. V. 283. P. 373–388.
Wang Y.-C., Xie D.-G., Ning X.-H., Shan Z.-W., Thermal treatment-induced ductile-tobrittle transition of submicron-sized Si pillars fabricated by focused ion beam // Appl. Phys. Lett. 2015. V. 106 (8). P. 081905.
Korsunsky A.M., Guénolé J., Salvati E., Sui T., Mousavi M., Prakash A., Bitzek E. Quantifying eigenstrain distributions induced by focused ion beam damage in silicon // Mater. Lett. 2016. V. 185. P. 47–49.
Schöngrundner R., Treml R., Antretter T., Kozic D., Ecker W., Kiener D., Brunner R. Critical assessment of the determination of residual stress profiles in thin films by means of the ion beam layer removal method // Thin Solid Films. 2014. V. 564. P. 321–330.
Salvati E., Sui T., Lunt A.J.G., Korsunsky A.M. The effect of eigenstrain induced by ion beam damage on the apparent strain relief in FIB-DIC residual stress evaluation // JMADE. 2016. V. 92. P. 649–658.
Baxter F., Garner A., Topping M., Hulme H., Preuss M. Phase stability of zirconium oxide fi lms during focused ion beam milling // J. of Nuclear Materials. 2018. V. 504. P. 176–180.
Ageev O.A., Balakirev S.V., Bykovet A.V. et al. Development of New Metamaterials for Advanced Element Base of Micro- and Nanoelectronics, and Microsystem Devices / In: Advanced Materials – Manufacturing, Physics, Mechanics and Applications. Parinov, Chang, Topolov (Eds.). Springer International Publishing Switzerland. 2016. P. 563–580.
Ageev O.A. et al. Modeling of the substrate topography upon nanosized profiling by focused ion beams // Nanotechnologies in Russia. 2014. V. 9. № 1–2. P. 31–37.
Агеев О.А., Коломийцев А.С., Коноплев Б.Г. Исследование параметров взаимодействия фокусированных ионных пучков с подложкой // Известия высших учебных заведений. Электроника. 2011. Т. 89. № 3. С. 20–25.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника