Микроэлектроника, 2019, T. 48, № 1, стр. 38-46
Травление GaAs в плазме смеси фреона R-12 с аргоном (CCl2F2/Ar)
Д. Б. Мурин 1, **, А. В. Дунаев 1, *
1 ФГБОУ ВО “Ивановский государственный химико-технологический университет”
НИИ Т и К Ивановского государственного химико-технологического университета
153000 г. Иваново, Шереметевский пр., 7,
Россия
** E-mail: dim86@mail.ru
* E-mail: dunaev-80@mail.ru
Поступила в редакцию 22.04.2018
После доработки 22.04.2018
Принята к публикации 22.04.2018
Аннотация
Галогенсодержащая плазма, в частности фреоны, часто используется для формирования топологии на поверхности полупроводников. В данной статье проведено исследование кинетики взаимодействия фреона R-12 и его смеси с аргоном, с поверхностью арсенида галлия. Выяснено, что в исследованном диапазоне условий имеет место полное разложение исходной молекулы до атомарного углерода. Подтверждено, что основными химически активными частицами, обеспечивающими травление GaAs, являются атомы хлора. Показано, что процесс травления протекает в режиме ионно-стимулированной химической реакции, где существенную роль в очистке поверхности играет десорбция продуктов под действием ионной бомбардировки. Изучен спектральный состав плазмообразующей среды в присутствии полупроводниковой пластины арсенида галлия. Выбраны контрольные линии и полосы для спектрального контроля скорости процесса травления по интенсивности излучения линий и полос продуктов травления. В данной работе контроль поверхности образцов проводился посредством атомно-силового микроскопа Solver-P47Pro.
ВВЕДЕНИЕ
Плазма хлорсодержащих газов широко применяется в технологии современной электроники для очистки и “сухого” травления поверхности полупроводниковых пластин и функциональных слоев интегральных микросхем. Одним из основных процессов здесь является формирование топологического рельефа на поверхности полупроводниковой структуры. На данный момент арсенид галлия (GaAs) является одним из наиболее востребованных материалов современной микро- и наноэлектроники. Причина этого заключаются в сочетании большой ширины запрещенной зоны и высокой подвижности носителей заряда, что позволяет создавать на основе GaAs широкий спектр высокочастотных быстродействующих приборов и фотоэлектронных устройств. В технологии производства микросхем на основе арсенида галлия используются процессы плазмохимического и ионнохимического отравления, для чего применяются, как правило, хлорсодержащие газы, такие как Cl2, BCl3, CCl4 и другие [1].Использование хлорсодержащих газовых сред связано с тем, что основными продуктами травления арсенида галлия в хлорсодержащей плазме в диапазоне температур 300–600 К являются ненасыщенные хлориды галлия и мышьяка (GaClх, AsClх при х ≤ 3) [2–6], которые обладают высоким давлением насыщенных паров (1–100 кПа в диапазоне 300–400 К для AsCl3 и 0.1–100 кПа в диапазоне 300–470 К для GaCl3), что обеспечивает переход этих соединений с поверхности материала в газовую фазу уже при температурах, незначительно превышающих комнатную.
Одним из газов, который может использоваться при травлении арсенида галлия является дифтордихлорметан (фреон R-12, CCl2F2). Поскольку связь C–F более прочна, чем C–Cl, преобладающим процессом диссоциации молекулы CCl2F2 в плазме является ее распад с образованием атома хлора [7]. На практике часто используют многокомпонентные газовые смеси такие как, на пример, смесь фреона R-12/Ar, которая обладает комбинированными свойствами травления поверхности химически активными фрагментами молекулярного газа и эффективным физическим распылением обрабатываемого материала в аргоне. Условия получения оптимального выхода атомов хлора, которые обеспечивают травление арсенида галлия, могут быть найдены из анализа спектров излучения плазмы дифтордихлорметана.
Целью данной работы являлось исследование кинетических закономерностей плазмохимического травления GaAs в смеси CCl2F2/Ar переменного состава и исследование спектров излучения плазмы указанных плазмообразующих сред, а также контроль поверхности образцов GaAs после травления посредством атомно-силовой микроскопии.
МЕТОДИЧЕСКАЯ ЧАСТЬ
Для исследования плазмохимических процессов в условиях ВЧ-разряда использовалась установка “Платран-100ХТ”. Она предназначена для плазмохимического травления полупроводниковых материалов, а также металлических пленок. Установка обеспечивает возможность обработки пластин диаметром до 100 мм, а также меньших размеров толщиной от 0.3 до 2 мм.
Откачка системы производилась механическим пластинчато-роторным (Leybold BCS, производительность 30 м3/ч) и турбомолекулярным (TMP 803 LMTC, производительность 800 л/с) насосами до предельного давления остаточных газов порядка 10–6 торр. Контроль рабочего давления в реакторе осуществлялся баратроном с верхним пределом измерения 0.1 торр. Измерение и контроль расхода плазмообразующего газа проводились при помощи расходомеров с верхним пределом 200 см3/мин. Система контроля температуры предусматривает возможность автоматической стабилизации температуры подложки за счет регулирования скорости потока охлаждающей жидкости. В качестве компонентов газовой смеси в работе использовались фреон R-12 и аргон. Фреон R-12 и аргон брали из баллонов с маркой “чистый” (МРТУ 51-77-66), содержание основного газа не менее 99.985%.
Подвергаемые травлению образцы представляли собой фрагменты полированных пластин GaAs (толщина 400 мкм, площадь 1 см2). Контроль рельефа поверхности образцов проводился посредством атомно-силового микроскопа Solver P47-PRO, который позволяет исследовать поверхность образцов на участках размером до 50 × 50 мкм. Использовался полуконтактный метод сканирования.
Спектральные измерения проводились с использованием оптоволоконных спектрометров AvaSpec-2048 и AvaSpec-3648 с фотоэлектрической системой регистрацией сигнала и накоплением данных на ЭВМ в диапазоне длин волн 200–1000 нм, отбор излучения для анализа проводился через кварцевое окно в плазмохимическом реакторе. При расшифровке спектров использовались справочники [8, 9].
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Оптическая эмиссионная спектроскопия – один из основных методов исследования, как состава газовой фазы разряда, так и кинетики плазмохимических процессов. Для его использования необходимо точно идентифицировать спектр газовой фазы, поэтому, необходимо проанализировать спектры чистых газов, используемых в процессе плазмохимического травления, что было сделано в наших работах [7, 10].
Исследование эмиссионных спектров плазмы смеси CCl2F2–Ar показало наличие в них излучения как атомарных, так и молекулярных компонентов (см. табл. 1). Примеры спектров излучения приведены на рис. 1 и рис. 2 для коротковолновой и длинноволновой областей спектра соответственно. Для коротковолновой области характерен широкий максимум излучения молекулярного хлора (длина волны в максимуме 256.8 нм, на фоне которого проявляются линии мышьяка, галлия и углерода и полосы радикалов CF2 и CCl). Наиболее интенсивными, стабильно проявляющимися и свободными от перекрывания с соседними максимумами являются линии: Cl (438.99, 452.6, 725.67, 837.82 нм), С(247.62 нм), F (685.48, 703.76 нм), Ar (811.76, 912.26 нм) и полосы: Cl2 (256.4 нм), CCl (277.78, 278.46 нм).
Таблица 1.
Атомарные и молекулярные компоненты, обнаруженные в ВЧ-разряде смеси CF2Cl2/Ar при травлении GaAs
| Элемент | λ (нм) | Eth(эВ) |
|---|---|---|
| C | 247.90 | 7.68 |
| 290.47 | 13.11 | |
| 296.14 | 4.18 | |
| 296.69 | 4.18 | |
| 462.15 | 2.68 | |
| 473.39 | 10.56 | |
| 474.06 | 10.56 | |
| 476.39 | 10.08 | |
| 476.93 | 10.08 | |
| 477.92 | 10.08 | |
| C2 | 466.9 | – |
| 468.5 | ||
| 469.7 | ||
| 471.5 | ||
| 473.7 | ||
| Cl | 452.62 | 11.94 |
| 460.1 | 11.98 | |
| 462.39 | 11.96 | |
| 465.4 | 11.87 | |
| 725.67 | 10.63 | |
| 741.41 | 10.59 | |
| 754.71 | 10.63 | |
| 771.76 | 10.59 | |
| 792.46 | 10.59 | |
| 819.44 | 10.50 | |
| 837.59 | 10.40 | |
| Cl2 | 256.4 | 8.2 |
| 271.4 | – | |
| 295.7 | ||
| 306.42 | ||
| F | 685.56 | 14.50 |
| 690.25 | 14.53 | |
| 703.74 | 14.75 | |
| CCl | 277 | – |
| 278 | ||
| Ar | 419.07 | 14.5 |
| 420.06 | 14.49 | |
| 750.38 | 13.47 | |
| 811.53 | 13.08 | |
| 912.29 | 12.9 | |
| As | 228.77 | – |
| 234.98 | ||
| Ga | 287.46 | 4.31 |
| 294.41 | 4.31 | |
| 403.36 | 3.07 | |
| 417.21 | 3.07 | |
| GaCl | 248.3 | – |
| 251.95 | ||
| GaF | 211.27 | |
| CF | 209.04 | |
| CF2 | 262.5 | |
| 271.96 |
Рис. 1.
Спектр излучения ВЧ-разряда смеси фреон R-12/Ar при травлении арсенида галлия (W = 1150 Вт, Udc = 200 Вт, состав смеси 90/10%, общее давление газа 2.4 мторр, λ = 200–480 нм).

Рис. 2.
Общий спектр излучения ВЧ-разряда смеси фреон R-12/Ar при травлении арсенида галлия (W = 1150 Вт, Udc = = 200 Вт, состав смеси 90/10%, общее давление газа 2.4 мторр, λ = 200–1000 нм).

На рис. 3 и рис. 4 показаны зависимости интенсивностей излучения линий атомарного хлора и полос молекул хлора и радикала CCl от ВЧ-мощности и давления газа. Интенсивности излучения линий и полос хлорсодержащих компонентов, а, следовательно, и их относительные концентрации возрастают с увеличением вкладываемой мощности и не зависят от напряжения смещения (Udc). Влияние давления и скорости потока газа на интенсивности излучения характеризуется наличием максимумов при давлении 3–5 мторр и расходах газа порядка 60–100 см3/мин. Это связано с тем, что при малых давлениях преобладающим фактором является увеличение концентрации исходных молекул, а при высоких давлениях основным фактором становится уменьшение энергии электронов и, следовательно, убыль константы скорости процесса возбуждения.
Рис. 3.
Зависимость интенсивности излучения от вкладываемой мощности, смесь фреона R-12 с аргоном (W = 1150 Вт, Udc = 200 Вт, состав смеси 50/50%, общее давление газа 2.4 мторр).

Рис. 4.
Зависимость интенсивности излучения от давления газа, смесь фреона R-12 с аргоном (W = 1150 Вт, Udc = 200 Вт, состав смеси 50/50%).

В целом плазма фреона R-12 весьма сложный объект исследования. Ее состав включает значительное число нейтральных компонент (молекул, атомов и радикалов), столько же положительных ионов, а список процессов с участием электронов, ионов и нейтральных частиц достигает двухсот наименований [11]. Механизмы образования и гибели каждой частицы, включающие более десятка различных процессов, могут быть выявлены лишь при детальном математическом моделировании плазмы дифтордихлорметана, но некоторые предположения, вытекающие из данных по влиянию параметров разряда на интенсивность излучения линий и полос могут быть сделаны. Данные предположения необходимо учитывать при анализе механизмов травления.
1) В исследованном диапазоне условий имеет место полное разложение исходной молекулы до атомарного углерода. Об этом свидетельствует не только излучение C и C2, но и CCl. Так как доминирующим механизмом диссоциации молекулы CCl2F2 при электронном ударе являются процессы с отрывом атомов хлора [11, 12], то образование радикалов CCl может быть обусловлено только реакциями вида C + Cl → CCl, протекающими как в объеме плазмы, так и на поверхности разрядной камеры.
2) Присутствие в плазме радикалов CF и CF2 будет способствовать образованию фторуглеродной полимерной пленки на поверхностях, контактирующих с плазмой. Это явление обсуждалось в большом количестве работ, посвященных исследованиям плазмы фреонов, например, CF4 [13, 14].
Наиболее простые и однозначные корреляции между концентрацией невозбужденного компонента в газовой фазе и интенсивностью излучения соответствующих возбужденных частиц наблюдаются, когда образование возбужденного состояния происходит прямым электронным ударом, а дезактивация является чисто излучательной. В этом случае заселенность верхнего (возбужденного) состояния частицы и интенсивность излучения (I) пропорциональны скорости возбуждения (Rex): I ~ Rex = kexneN, где kex – коэффициент скорости возбуждения, ne – концентрация электронов, N – концентрация частиц в основном состоянии. Если пороговая энергия возбуждения εth превышает среднюю энергию электронов в разряде, коэффициент скорости возбуждения, становится зависимым от внешних параметров разряда. Появление такой зависимости ведет к нелинейной связи интенсивности излучения с концентрацией соответствующих невозбужденных частиц.
С увеличением вкладываемой в разряд мощности коэффициент скорости возбуждения меняется сравнительно мало, а основным фактором, определяющим характер соответствующей зависимости, является концентрация электронов. Поскольку образование возбужденного состояния любого из рассматриваемых фрагментов протекает как минимум в две стадии, то можно ожидать несколько более быстрого по сравнению с линейным роста интенсивности излучения с мощностью разряда.
В спектрах излучения плазмы фреона в присутствии арсенида галлия появляются линии и полосы продуктов травления: As (228.77, 234.98 нм), Ga (294.41, 403.36, 417.21 нм) и полосы: GaCl (248.3, 251.95 нм). В качестве контрольной была выбрана резонансная линия галлия 417.21 нм. Энергия возбуждения этой линии составляет 3.07 эВ, что существенно ниже средней энергии электронов в плазме. Это предполагает низкую чувствительность коэффициента скорости возбуждения к изменению параметров плазмы, при этом можно ожидать, что при постоянных мощности, вкладываемой в разряд, и давлении газа интенсивность излучения линии Ga 417.21 нм пропорциональна концентрации соответствующих частиц в газовой фазе, а, следовательно, и скорости травления. Кроме этого, линия Ga 417.21 нм наиболее интенсивна среди эмиссионных максимумов, принадлежащих продуктам реакции и не перекрывается излучением других компонентов плазмы.
Эксперименты показали, что длительная (более 30 мин) выдержка GaAs в атмосфере CCl2F2 без разряда при температурах 573–623 К не приводит к химическому взаимодействию на поверхности. Поэтому исходные молекулы CCl2F2 могут быть исключены из набора химически активных частиц и в условиях плазменного травления. Известно также, что при плазменном травлении широкого круга неорганических материалов химическая активность радикалов вида CFx (x = 1–3) и CClx (x = 1–3) пренебрежимо мала по сравнению с активностью (вероятностью взаимодействия с поверхностью) атомов фтора или хлора [2, 15]. Таким образом, в качестве основных химически активных частиц при травлении GaAs в плазме CF2Cl2 следует рассматривать только атомы фтора и хлора. Доминирующая роль последних, по нашему мнению, предопределяется двумя основными причинами. Во-первых, механизм диссоциации вида CFnClm + e → CFnClm– 1 + Cl + e при близких константах скоростей рекомбинации атомов [11, 12] неизбежно приведет к диспропорционированию их концентраций в плазме с выполнением условия nCl $ \gg $ nF. Во-вторых, фториды галлия являются значительно менее летучими соединениями, чем хлориды. Например, температура плавления GaCl3 составляет менее 80°C, в то время как аналогичная величина для GaF3 превышает 1000°C [16]. Таким образом, взаимодействие GaAs c атомами фтора не обеспечивает развития процесса травления из-за пассивации поверхности нелетучими фторидами галлия.
На рис. 5 и рис. 6 приведены зависимости убыли массы от времени травления в смеси фреона R-12 с аргоном, скорости травления арсенида галлия и интенсивности излучения линий атомарного галлия от давления газа в смеси фреона R-12 с аргоном соответственно.
Рис. 5.
Зависимость убыли массы от времени травления, смесь фреона R-12 с аргоном (W = 1150 Вт, Т = 100°С, состав смеси 50/50%, общее давление газа 2.4 мторр).
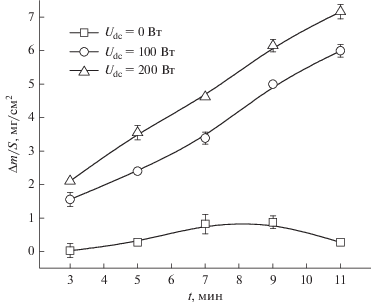
Рис. 6.
Зависимости: 1 – скорости травления арсенида галлия от давления газа: 2 – интенсивности излучения линии атомов Ga (417.21 нм) от давления газа, смесь фреона R-12 с аргоном (Udc = 200 Вт, Т = 100°С, tтрав = 5 мин, состав смеси 50/50%).
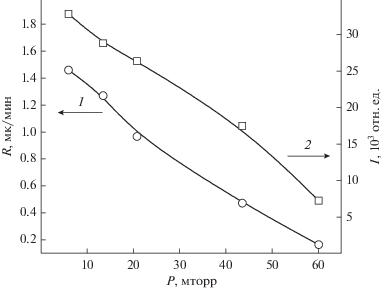
Кинетические зависимости (рис. 5) в пределах погрешности эксперимента линейно возрастают, что соответствует процессам первого кинетического порядка. При смещении (Udc), равном нулю, травление практически отсутствует, что характерно для процессов с участием ионной бомбардировки. Незначительные скорости травления арсенида галлия в отсутствие ионной бомбардировки позволяют заключить, что ионная составляющая процесса травления в данном случае является доминирующей.
Скорость травления арсенида галлия и интенсивность излучения атомов галлия с увеличением давления газа монотонно уменьшаются (рис. 6), что связано с уменьшением энергии ионов, бомбардирующих обрабатываемую поверхность, а, следовательно, и с уменьшением вклада ионной составляющей в суммарную скорость процесса. Таким образом, можно полагать, что лимитирующей стадией травления в данном случае являются процессы взаимодействия ионов с поверхностью.
Несколько слов хочется сказать и о шероховатости поверхности полупроводника, после травления во фреоне и его смеси с аргоном. Одним из важнейших параметров процесса травления, здесь является показатель качества поверхности, характеризуемый ее средней квадратичной шероховатостью σ. Шероховатость поверхности после травления в плазме “чистого” фреона в течение 150 с увеличивается от 7 до 14 нм (рис. 7а), что вполне ожидаемо и характерно для галогенсодержащих газов и приемлемо с точки зрения технологии [17–19]. При обработке образцов в газовой смеси R-12/Ar скорость травления несколько уменьшаетcя, при этом заметно улучшая качество поверхности. Так, например, (рис. 7б) после плазменного травления в течение 90 с в газовой смеси σ ≈ 5 нм (в “чистом” фреоне – 12 нм), что обеспечивает получение равномерной и чистой поверхности.
ЗАКЛЮЧЕНИЕ
Исследована кинетика и режимы плазмохимического травления GaAs в условиях индукционного ВЧ-разряда в смеси CCl2F2/Ar. Проведен анализ основных излучательных компонентов плазмы смеси CCl2F2/Ar. Выяснено, что в исследованном диапазоне условий имеет место полное разложение исходной молекулы до атомарного углерода. Наличие в плазме радикалов CF и CF2 способствует образованию фторуглеродной полимерной пленки на поверхности, находящейся в зоне плазмы. Подтверждено, что основными химически активными частицами, обеспечивающими травление GaAs, являются атомы хлора. Показано, что процесс травления протекает в режиме ионно-стимулированной химической реакции, где существенную роль в очистке поверхности играет десорбция продуктов под действием ионной бомбардировки. Решающую роль при выборе режима травления в исследуемой системе играют электрофизические параметры разряда. Проведен анализ качества поверхности обработанных образцов при помощи атомно-силовой микроскопии, показано, что плазма смеси R-12/Ar обеспечивает получение более равномерной и чистой поверхности, за счет снижения концентрации активных части (атомов хлора) в травящей среде и как следствие, некоторого снижения скорости взаимодействия с поверхностью полупроводника.
Исследование проведено с использованием ресурсов Центра коллективного пользования научным оборудованием ФГБОУ ВО “ИГХТУ”. Работа выполнена в рамках Государственного задания (проектная часть), проект № (3.1371.2017/4.6 – Рыбкин В.В.).
Список литературы
Данилин Б.С., Киреев В.Ю. Применение низкотемпературной плазмы для травления и очистки материалов. М.: Энергоатомиздат, 1987. С. 264.
Толливер Д., Новицки Р., Хесс Д. Плазменная технология в производстве СБИС. Под ред. Айнспрукa Н., Брауна Д. пер. с англ. М.: Мир, 1987. С. 420.
Leonhardt D., Eddy C.R., Shamamian V.A., Holm R.T., Glembocki O.J., Butler J.E. Surface chemistry and damage in the high density plasma etching of gallium arsenide // J. Vac. Sci. Technol. A 16. 1998. P. 1547
Simpson W.C., Shuh D.K., Hung W.H., Hakansson M.C., Kanski J., Karlsson U.O., Yarmoff J.A. Role of surface stoichiometry in the Cl2/GaAs(001) reaction // J. Vac. Sci. Technol. A 14. 1996. P. 1815.
Hahn Y.B., Lee J.W., Vawter G.A., Shul R.J., Abernathy C.R., Hays D.C., Lambers E.S., Pearton S.J. Reactive ion beam etching of GaAs and related compounds in an inductively coupled plasma of Cl2-Ar mixture // J. Vac. Sci. Technol. B 17. 1999. P. 366.
Bond P., Brier P. N., Fletcher J., Jia W. J., Price H., Gorry P.A. Reactive scattering study of etching dynamics: Cl2 on GaAs(100) // Surface Science. 1998. V. 418. P. 181.
Ефремов А.М., Мурин Д.Б., Левенцов А.Е. Кинетика и режимы плазмохимического травления GaAs в условиях индукционного ВЧ разряда в CF2Cl2 // Микроэлектроника. 2014. Т. 43. № 6. С. 429–434.
Pearse R.W.B., Gaydon A.G. The identification of molecular spectra. Fourth edition. NY.: John Wiley & Sons, inc. 1976. P. 407.
Стриганов А.Р., Свентицкий Н.С. Таблицы спектральных линий нейтральных и ионизированных атомов. М.: Атомиздат., 1966. С. 899.
Пивоваренок С.А., Дунаев А.В., Мурин Д.Б., Ефремов А.М., Светцов В.И. Влияние состава смеси на электрофизические параметры и спектры излучения плазмы HCl–O2 и HCl–Ar // Теплофизика высоких температур. 2011. Т. 49. № 4. С. 491–494.
Stoffels W.W., Stoffels E., Haverlag M. The chemistry of a CCl2F2 radio frequency discharge // J. Vac. Sci. Technol. A. 1995. V. 13. № 4. P. 2058–2066.
Stoffels E., Stoffels W.W., Vender D. Negative ions in a CCl2F2 radio frequency discharge // J. Vac. Sci. Technol. A. 1995. V. 13. № 4. P. 2051–2057.
Da Zhang, Kushner M.J. Mechanisms for CF2 radical generation and loss on surfaces in fluorocarbon plasmas // J. Vac. Sci. Technol. 2000. V. 18. № 6. P. 2661–2668.
Edelson D., Flamm D.L. Computer simulation of a CF4 plasma etching silicon // J. Appl. Phys. 1984. V. 56. № 5. P. 1522–1531.
Ивановский Г.Ф., Петров В.И. Ионно-плазменная обработка материалов. М.: Радио и связь, 1986. С. 232.
Grigonis A. The surface composition of GaAs affected by reactive plasma // Surf. Coat. Technol. 1998. V. 110. № 1–2. P. 31–34.
Пасынков В.В., Сорокин В.С. Материалы электронной техники. СПб.: Лань, 2001. С. 368.
Rawal D.S., Sehgal B.K., Muralidharan R., Malik H.K. Experimental study of the influence of process pressure and gas composition on GaAs etching characteristics in Cl2/BCl3 based inductively coupled plasma // Plasma Sci. Technol. 2011. V. 13. № 2. P. 223–229.
Дунаев А.В., Мурин Д.Б., Пивоваренок С.А. Исследование поверхности GaAs после травления в плазме высокочастотного и тлеющего разрядов методом атомно-силовой микроскопии // Физика и техника полупроводников. 2016. Т. 50. № 2. С. 167–170.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника



