Микроэлектроника, 2019, T. 48, № 1, стр. 47-55
Влияние дефектов с глубокими уровнями на С-V-характеристики мощных AlGaN/GaN/SiC НЕМТ
К. Л. Енишерлова 1, *, Ю. В. Колковский 1, Е. А. Боброва 1, Э. М. Темпер 1, С. А. Капилин 1
1 АО “НПП Пульсар”
105187 Москва, Окружной поезд 27, Россия
* E-mail: Enisherlova@pulsarnpp.ru
Поступила в редакцию 09.06.2018
После доработки 09.06.2018
Принята к публикации 09.06.2018
Аннотация
Исследовались вольт-фарадные (С-V)-характеристики областей затвор–сток кристаллов мощных СВЧ НЕМТ транзисторов с большой периферией затвора S- и Х-диапазона с пробивным напряжением исток-сток VDS от 30 до 150 В, а так же тестовые диоды Шоттки, сформированные в едином технологическом цикле с НЕМТ. Методом емкостной релаксационной спектроскопии глубоких уровней (DLTS) исследовались структурные дефекты, формирующие глубокие уровни. В процессе исследования показано, что у кристаллов НЕМТ на С-V-кривых всегда наблюдались два участка изменения емкости с разными углами наклона и отсутствие таких перегибов у тестовых БШ. Методом DLTS у НЕМТ и тестовых БШ обнаружены электронно-подобные и дырочно-подобные ловушки, находящиеся, скорее всего, в буферном слое, а также обнаружен пик дырочного типа с аномальным поведением. Перегиб на С-V-кривых НЕМТ связан с высокими электрическими полями, возникающими на краю затвора транзисторных структур.
ВВЕДЕНИЕ
Для электронных приборов, сформированных на широкозонных нитридных гетероструктурах, весьма актуальна проблема захвата носителей заряда на различных структурных дефектах, создающих глубокие уровни (ГУ) в запрещенной зоне полупроводников. Интерес к дефектам такого рода в настоящее время возрос, так как захват носителей заряда вблизи канала транзистора на ловушках в структурах AlGaN/GaN может уменьшить уровень тока стока транзистора до 90% [1]. Захват носителей заряда на ГУ является одним из главных факторов, определяющих работоспособность и надежность НЕМТ-транзисторов при работе на высоких частотах и высоких мощностях [1–3]. На данном этапе имеется много работ по исследованию ловушечных состояний как на границе AlGaN/GaN, так и в объеме барьерного (AlGaN) и буферного (GaN) слоев, изменяющих плотность двумерного газа в канале; определены их основные параметры: энергия активации, сечение захвата, концентрация [1–6]. Значительные успехи достигнуты в изучении поведения собственных точечных дефектов и таких примесей, как углерод, кислород, водород, которые могут вводиться в материал в процессе эпитаксиального роста слоев AlGaN и GaN [6]. При высокой плотности дислокаций в таких эпитаксиальных слоях надо так же учитывать, что собственные точечные дефекты и многие примеси могут декорировать дислокации, формируя целый спектр дефектов. В частности считается, что дислокации, имеющие краевую компоненту, отрицательно заряжены, в то время как чистые винтовые дислокации, ответственные за токи утечек, не заряжены [6, 7]. Комплексы вакансии галлия с тремя атомами кислорода, сегрегирующие на выходах винтовых дислокаций, нейтральны и могут стабилизировать поверхность, в то же время вакансии галлия с кислородом, образуя комплекс (VGa–O)–2, могут формировать ГУ в n-GaN с энергией активации EV + (1.1–1.2 эВ) [6].
Наблюдение с использованием микроскопа атомных сил (С-АСМ, conductive atomic force microscope) локальных участков высокой плотности дислокаций показали, что скопления краевых дислокаций окружены областью отрицательного заряда, а повышенная плотность винтовых дислокаций, как правило, приводит к более высоким токам утечки в гетероструктурах [7]. Надо учитывать, что процесс формирования современных НЕМТ и НЕМТ-МIS приборов – это сложный комплекс ряда технологических операций, включая и высокотемпературные, которые могут приводить к возникновению новых структурных дефектов с ГУ, а также могут приводить к трансформации дефектов, имеющихся в слоях и на границах раздела слоев. Поэтому представляет интерес исследование возможной трансформации дефектов гетероструктур в процессе формирования элементов НЕМТ. Для оценки изменения зарядового состояния дефектов в приборных структурах, сформированных на нитридных эпитаксиальных слоях, обычно используется метод С-V-характеристик при различных частотах, позволяющий оценивать распределение электрического заряда в объеме и на границах слоев гетероструктур. Для определения параметров ловушечных состояний, связанных с ГУ, используются токовая и емкостная спектроскопия глубоких уровней (DLTS), а также оптическая спектроскопия глубоких уровней (DLOS) [6, 8].
Цель данной работы – исследование особенностей С-V-характеристик областей затвор–сток AlGaN/GaN/SiC НЕМТ транзисторов с учетом их конструктивно-технологических особенностей и тестовых диодов Шоттки, сформированных в едином технологическом цикле с НЕМТ, а также влияние на емкостные характеристики дефектов с ГУ в активных областях исследуемых приборных структур.
МЕТОДИКА ЭКСПЕРИМЕНТА
Исследовались кристаллы мощных СВЧ-транзисторов с большой периферией затвора (long gate periphery) S- и Х-диапазона с длиной затвора 0.4 мкм, с пробивным напряжением сток–исток VDS от 80 до 150 В, шириной затвора одного пальца – 400 мкм, количеством пальцев (fingers) (от 60 до 80) и планарным расположением контактных окон к областям исток, затвор, сток. Транзисторы отличались конструктивно-технологическими особенностями, в частности, расположением металлизированных отверстий выводов контактов к областям истока (рис. 1), конструкцией полевых электродов (FP).
Рис. 1.
Вид участков анализируемых структур: а – HEMT-1; б – HEMT-2. Вставка A и B : фрагменты рабочих областей транзисторов после удаления слоев металлизации и пассивации: 1 – сток; 2 – исток; 3 – затвор; 4 –металлизированные отверстия выводов контактов к истоку.
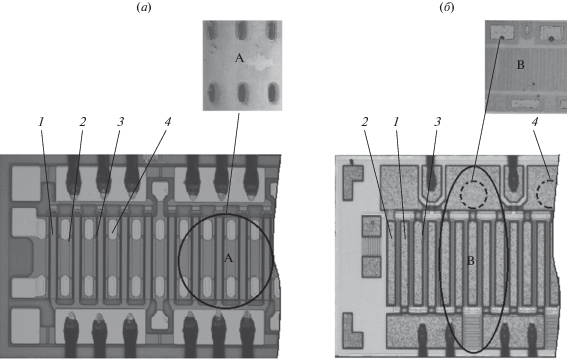
Транзисторы с металлизированными выводами на обратную сторону структур, расположенными практически в активных областях приборов (рис. 1а), условно были обозначены как НЕМТ-1; транзисторы с металлизированными выводами, вынесенными из активных областей приборов (рис. 1б), были обозначены как НЕМТ-2. Транзисторы были изготовлены на гетероструктурах GaN/AlGaN/GaN, выращенных MOCVD-технологией на подложках SiC с ориентацией рабочих поверхностей (0001), с барьерным слоем AlGaN толщиной 180–200 мкм при мольной доле алюминия 0.26–0.3 и спейсером толщиной 20–25 Å. Гетероструктуры этих двух видов транзисторов отличались толщиной слоев GaN: транзисторы НЕМТ-1 имели толщину буферного слоя – 2–2.5 мкм, НЕМТ-2 – 1.5–1.7 мкм.
В качестве объектов исследования были выбраны также тестовые круглые структуры с диодом Шоттки. Такие тестовые структуры формировались на тех же гетероструктурах, что и исследуемые НЕМТ транзисторы и в том же технологическом процессе при напылении металлов затвора (Ni/Ti/Au). Омические контакты к тестовым диодам формировались одновременно с изготовлением омических контактов к областям истока и стока НЕМТ. Площадь тестовых БШ составляла 7 × 10–5 см2. В качестве пассивирующих слоев в исследуемых транзисторах и тестовых структурах использовались толстые слои Si3N4 и SiNx.
В ходе исследования измерялись также НЕМТ-транзисторы с меньшими длиной (0.25 мкм), и шириной затвора (количеством пальцев от 6 до 40 штук).
Измерение вольт-фарадных характеристик проводилось на установке CSM/WIN System в диапазоне частот от 10 кГц до 1 МГц, при планарном расположении измерительных зондов на контактных окнах транзисторов и тестовых элементов. Емкостные зависимости снимались как по параллельной (индекс-р), так и по последовательной (индекс-s) схемам замещения с дополнительной оценкой изменения проводимости и сопротивления от частоты. При емкостных измерениях на кристаллах приборов записывались С-V-характеристики областей затвор–сток без приложения напряжения между истоком и стоком. Для некоторых исследуемых транзисторов С-V-характеристики записывались при разных температурах: 291, 323, 363, 473 K.
Методом емкостной релаксационной спектроскопии глубоких уровней исследовался спектр ГУ. Для выбора режима измерений спектра ГУ HEMT-структур и тестовых барьеров Шоттки измерялись C-V-характеристики при температурах 80, 300, 380 K.
При записи спектров DLTS использовалось стробирование сигнала релаксации емкости в моменты времени 4–8–16–32–64 мс при однократном сканировании по температуре. Энергия активации и сечение захвата определялись по зависимости Аррениуса. На основе C-V-характеристик выбиралось исходное смещение на структуре. Использовались импульсы инжекции с разной полярностью, так как возможны разные механизмы заполнения ловушек (туннелирование и др.) в зависимости от режима записи. Импульс инжекции имел длительность не более 89 мс.
РЕЗУЛЬТАТЫ ИССЛЕДОВАНИЯ
Практически у всех исследуемых транзисторов (Смах от 2.5 до 75 пФ) на С-V-кривых в области перехода от обогащения к обеднению наблюдались ступенька и два участка изменения емкости с разными углами наклона кривой (рис. 2). Использование двух схем измерения С-V-характеристик показало совпадение величин емкости Сs и Сp (рис. 2) и отсутствие частотной дисперсии на верхнем плато в интервале напряжений от 0 до –1.5 В, что свидетельствует об отсутствии влияния на результаты этих измерения поверхностных состояний на границе раздела полупроводник/пассивация [9]. При измерении на низких частотах (<200 кГц) для многих транзисторов характерно появление на СS-V-кривых дополнительных пиков (рис. 2а, 2в).
Рис. 2.
C-V-характеристики областей затвор–сток при f = 10 кГц–1 МГц; а, б – HEMT-1; в, г – HEMT-2; а, в – последовательная схема измерения; б, г – параллельная схема измерения.

При охлаждении структур от Тком до Таз наблюдался сдвиг С-V-кривых в сторону положительных напряжений (рис. 3, кривые 1 и 2), что свидетельствует об уменьшении положительного заряда в барьерном слое или на границе AlGaN/GaN.
Рис. 3.
C-V-характеристики транзисторных структур HEMT-1, HEMT-2 и тестовых БШ; f = 500 кГц, при разных температурах (C-V для HEMT-2 смещена на 15 пФ вверх): 1 – HEMT-1; 2 – HEMT-2; 3 – диод Шоттки.
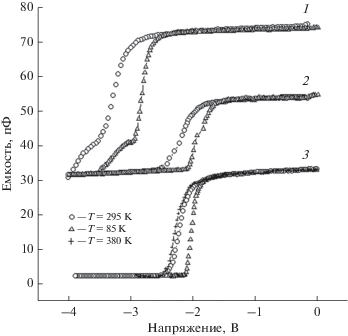
На тестовых БШ не наблюдается каких-либо перегибов на С-V-характеристиках при измерении на тех же частотах, что и транзисторные структуры (рис. 3, кривая 3). Охлаждение тестовых БШ до температуры азота приводило к более резкому наклону С-V-кривых и сдвигу кривых в сторону положительных значений напряжения.
Нагрев при измерениях от Т = 290 до 473 K в большинстве случаев приводил к незначительному изменению формы С-V-кривых (рис. 4а), за исключением участка со ступенькой на кривой (рис. 4а, вставка). У транзисторов НЕМТ-1 происходило резкое уменьшению изгиба С-V-кривой, так что углы наклона двух участков кривой (выше и ниже ступеньки) становились близки друг к другу (рис. 4б), при этом необходимо отметить, что максимальные изменения формы происходили на нижнем участке С-V-кривой (рис. 4б).
Рис. 4.
C-V-характеристики областей затвор–сток транзисторных структур при f = 500 кГц; а – HEMT-2; б – HEMT-1 при нагреве от 293 до 473 K. Вставка – участок C-V-кривой в области ступеньки при T = Tком.
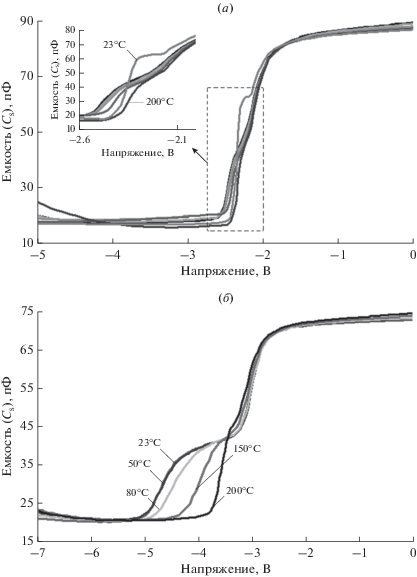
При исследовании методом DLTS в транзисторных структурах НЕМТ-1 и тестовых БШ наблюдались электронно-подобные ловушки с энергией активации 0.59–0.6 эВ и сечением захвата σ ≈ 1 × 10–14 см2 (рис. 5а, кривая 1). На спектрах пики электронных ловушек показаны с положительной полярностью, а дырочных с отрицательной. Перезарядка ловушек в НЕМТ-1 структурах наблюдалась при выборе режима со смещением, соответствующим положению вблизи ступеньки на C-V-характеристике (рис. 2) или ниже и с отрицательным импульсом инжекции, как и в работе [8]. В этом случае захват электронов на ловушки во время импульса может происходить при туннелировании электронов через барьерный слой или при их перемещении по дислокациям в барьерном слое [10].
Рис. 5.
Спектры DLTS областей затвор–сток транзисторов HEMT-1 и HEMT-2: а – ΔCt = 0/Cb = 1% 1 – HEMT-1; 2, 3 – HEMT-2; ΔC/C (3) = 2.9 × ΔC/C (2); б – ΔCt = 0/Cb = 2.4% HEMT-2 1 – электронно-подобная ловушка, 2– дырочно-подобная ловушка, 3, 4, 5 – аномальные пики: режимы измерения: 1, 2, 5 – Vb = –2.1 B, Vp = –7 B; 3 – Vb = –2.1 B, Vp = +3 B; 4 – Vb = –2.3 B, Vp = +3 B.

Для транзисторов типа НЕМТ-2 в спектре DLTS наблюдался широкий пик, который, учитывая его положение по температуре, связан с той же ловушкой, что и в НЕМТ-1 и с другой ловушкой с пиком близким к первому, что не позволило их разделить (рис. 5а, кривые 2 и 3). Присутствие второго уровня в НЕМТ-2, по-видимому, определяется выбранным технологическим циклом и конструкцией прибора. При большом отрицательном импульсе напряжения наблюдалась также дырочная ловушка с энергией активации ≈1.1 эВ (рис. 5б, кривая 2) и существенное возрастание сигнала от электронных ловушек.
При подаче положительного импульса инжекции в транзисторных структурах наблюдался центр дырочного типа с анoмальным поведением. Положение пиков для этого центра при используемых в записи 4-х окнах скорости эмиссии практически совпадало по температуре (рис. 5б, кривые 3, 4, 5). Изменение режима записи (исходного смещения или длительности импульса инжекции) приводило к смещению пиков по температуре и изменению их амплитуды. Энергия активации в данном случае не постоянна, и релаксация емкости имеет не экспоненциальный характер. При использовании большого отрицательного смещения также наблюдался аномальный пик небольшой амплитуды (рис. 5б, кривая 5).
Такая же аномалия наблюдалась для отрицательного пика в спектре тестового БШ, но при отрицательном импульсе инжекции и при температуре около 100 К. При положительном импульсе инжекции у тестовых БШ появлялся положительный пик, соответствующий уровню с энергией 0.6 эВ близкому к наблюдаемому в структуре HЕМТ-1.
ОБСУЖДЕНИЕ РЕЗУЛЬТАТОВ
При измерении на тестовых БШ область пространственного заряда (W) может быть определена с помощью известной аппроксимации области обеднения:
Расчет показывает, что в области верхнего плато при Uизм → 0 область пространственного заряда “перекрывает” весь барьерный слой, т.е. W = dAlGaN. Говорить о глубине проникновения поля в объем кристалла транзисторных структур сложно, поскольку “пальцы” затвора транзистора включены параллельно друг другу, и образующееся общее электрическое поле под всем затвором может быть неоднородно. Использование стандартного расчета области объемного заряда будет неточным.
Методом DLTS обнаружены два глубоких центра – электронный и дырочный, а также электронный центр, пик от которого не удалось разделить с пиком центра с Еа = 0.59–0.6 эВ у НЕМТ-2; этот пик также может быть связан с дислокационной структурой транзисторных кристаллов.
Отметим, что уровень электронной ловушки с Еa = 0.59–0.6 эВ наблюдался и при смещении к более отрицательному напряжению относительно ступеньки на C-V-характеристике. По-видимому, связанные с этим уровнем дефекты, распределены в объеме GaN.
Перезарядка глубокой дырочной ловушки в спектре DLTS происходила при большом отрицательном импульсе напряжения (рис. 5, кривая 2, Vp = –7 В), вызывавшем, по-видимому, генерацию дырок в GaN и захват их ловушкой. При использовании импульса напряжения –3 В и начальном смещении –2.1 B пик ловушки не виден, т.е. напряжение импульса еще не достаточно для перезарядки центра. В таком случае при измерении С-V-характеристик необходимо приложить отрицательное напряжение U < –5 B, чтобы произошла презарядка данного дефекта. Эта точка на C-V-кривой попадает на нижнее плато, где наблюдать уровень невозможно. Таким образом, из зарегистрированных в спектре DLTS уровней, со ступенькой на С-V-кривых исследуемых НЕМТ-транзисторов, по-видимому, связаны дефекты с Еa = 0.59–0.6 эВ.
Можно предположить, что наличие центра дырочного типа с анoмальным поведением связано с изменениями заселенности электронами уровней двумерного газа. Полярность сигнала релаксации соответствует тому, что положительный импульс напряжения обедняет слой 2DEG электронами, уменьшая ширину ОПЗ в GaN и увеличивая общую емкость структуры. Обеднение слоя двумерного газа может быть связано с туннелированием электронов в барьерный слой. После окончания импульса заселенность уровней в 2DEG восстанавливается, и емкость структуры релаксирует с положительной полярностью к равновесному значению.
Авторы работы [8] считают, что верхний участок С-V-кривой транзисторных структур до ступеньки (рис. 2) связан с дефектами в барьерном слое и у верхней границы канала двумерного газа (непосредственно на границе AlGaN/GaN), а нижний участок кривой – с нижней границей канала и прилегающей подканальной частью слоя GaN. Это предположение подтверждают результаты измерений С-V-характеристик транзисторных структур при нагреве: изменения формы С-V-кривых при нагреве до Т = 150–200°С происходят, в основном, или на участке, где при Тком присутствует ступенька на С-V-кривой (рис. 4а, вставка) или при сильном обеднении на нижнем участке С-V-кривой (рис. 4б). Восстановление С-V-кривых после нагрева происходит за время более 2–3-х часов, что свидетельствует об участии в процессе медленных состояний, связанных с дефектами в GaN. Появление непосредственно ступеньки, возможно, связано с моментом, когда ОПЗ распространяется в область канала двумерного газа.
Разница в спектре электронных состояний в исследуемых НЕМТ структурах связана с конструкторско-технологическими особенностями изготовления приборов, а также с наличием разных поставщиков исходных гетероструктур. Электронная ловушка с энергией активации Еа = (0.59–0.6 эВ) хорошо известный центр, часто наблюдаемый в структурах AlGaN/GaN. Ловушка с Еа = 0.6 эВ чаще всего наблюдается в n-типе GaN [6, 11]. В данной работе наиболее четко эта ловушка фиксируется в НЕМТ-1. В литературе упоминается так же дырочная ловушка с энергией активации ≈1 эВ [6]. Появление других ловушечных центров в НЕМТ-2 (рис. 5б) объясняется разницей технологии и конструкции приборов, например, изменением расположения металлизированных отверстий в приборе НЕМТ-2 по сравнению с НЕМТ-1 (рис. 1).
В тестовых БШ методом DLTS наблюдался тот же уровень с энергией 0.6 эВ, что и в транзисторных структурах, и аномальный пик, который появлялся при более низких температурах (100 К). Однако они наблюдались при импульсах инжекции с другой полярностью по сравнению с HEMT структурами. Это свидетельствует о различных механизмах заполнения центров в БШ и HEMT. Кроме того, в отличие от транзисторных структур, у тестовых БШ на C-V-кривых не наблюдалось характерных ступенек, которые не появлялись также и при охлаждении или нагреве образцов.
Появление характерных ступенек на С-V-характеристиках при измерениях транзисторных структур и отсутствие их у тестовых БШ связано, по нашему мнению, с малыми размерами и формой затвора транзисторных структур. Дело в том, что на краях затвора возникают сильные электрические поля (краевые эффекты из-за соизмеримости длины затвора и толщины барьерного слоя). Известно, что максимальные продольные поля в объеме НЕМТ транзисторов возникают при приложении обратного смещения на краю затвора, обращенного к стоку [12], что может приводить к перезарядке дефектов с ГУ, расположенных в зоне действия поля. На факт возможной перезарядки дефектов на краю затвора из-за возникновения высоких электрических полей при обратном смещении уже указывали некоторые исследователи [13]. Более того, под затвором может быть и более высокая плотность дефектов, формирующих ГУ, например, из-за действия обратного пьезоэффекта в процесс импульсного воздействия при работе транзисторов.
Разный наклон на двух участках С-V-кривой у транзисторных структур можно объяснить еще и тем, что в процессе измерения при сильном обеднении может изменяться электрическая цепочка схемы замещения, связанная с емкостями, возникающими при перезарядке ловушечных центров (рис. 6). В частности, в работе [13] предложено схематичное изображение поперечного сечения края затвора при сильном обеднении с указанием группы дополнительных емкостей, которые могут возникать в результате сложного перераспределения электрического заряда на краю затвора транзистора. Вся эта сложная картина развертывается практически только под затвором [13, 14].
В случае измерения C-V-характеристик тестовых диодов Шоттки из-за выбранной конструкции тестов и несоизмеримости продольных и поперечных размеров (диаметр БШ – 100 мкм, а толщины слоев гетероструктуры – наномикроны, в частности, толщина барьерного слоя AlGaN – 200 Å) при приложении в процессе измерения тех же по величине напряжений не возникает сильных электрических полей (краевые эффекты не играют определяющую роль) и, скорее всего, этим объясняется отсутствие ступеньки при измерении C-V-характеристик барьеров Шоттки.
ЗАКЛЮЧЕНИЕ
Методом DLTS для всех исследуемых структур, включая тестовые БШ, обнаружены электронно-подобная ловушка с энергией активации 0.59–0.6 эВ и дырочная ловушка с энергией активации ≈1.1 эВ, находящиеся, скорее всего, в буферном слое. Экспериментально показано, что набор дефектов с ГУ в транзисторных структурах определяется их технологически-конструкторскими особенностями и особенностями исходных гетероструктур.
Ступенька на С-V-кривых НЕМТ-транзисторов, в отличие от тестовых БШ, связана с ролью больших электрических полей, которые возникают на краю затвора транзисторных структур при приложении одинаковых по величине напряжений на затвор транзистора и БШ.
Центр дырочного типа с аномальным поведением при измерении методом DLTS, как у транзисторных структур, так и у тестовых БШ, по нашему мнению, связан с особенностями процессов в слое двумерного электронного газа на границе AlGaN/GaN и требует дальнейших исследований.
Список литературы
Binari S.C., Ikossi K., Roussos J.R., Kruppa W., Park D., Dietrich H., Koleske D.D., Wickenden A.E., Henry R.L. Trapping effects and microwave power performance in AlGaN/GaN HEMTs // IEEE Trans. Electron Dev. 2001. V. 48. P. 565.
Fang Z.-Q., Look D.C. Traps in AlGaN/GaN/SiC heterostructures studied by deep level transient spectroscopy // Applied Physics Letters. 2005. V. 87. P. 182115-1–1822115-5.
Tirado Lose Maria, Sanchez-Rojas Jose Luis, Izpura Ignacio. Trapping effects in the transient response of AlGaN/GaN HEMT devices // IEEE Transactions on electron Devices 2007. V. 54. № 3. P. 410–417.
Balandin A.A., Lui W.L., Chen Y.L., Wang K.L. Capacitance-Voltage Spectroscopy of trapping states in GaN/AlGaN heterostructure field-effect transistors // J. Nanoelectronics and Optoelectronics. 2006. V. 1. P. 258–263.
Lo C.F., Ren Fan, Pearton S.J., Polyakov A.Y., Smir-nov N.B., Govorkov A.V., Belogorokhov I.A., Belogo-rokhov A.I., Reznik V.Y. Deep traps and thermal measurements on AlGaN/GaN on Si trasistors // J. Vac. Sci. Technol. B 29(4), Jul./Aug 2011. P. 042201-1–042201-5.
Polyakov A.Y., Lee I.-H. Deep traps in GaN-based structures as affecting the performance of GaN devices // Mater. Sci. and Eng. 2015. V. 94. P. 1–56.
Simpkins B.S., Yu E.T., Waltereit P., Speck J.S. Correlated scanning Kelvin probe and conductive atomic force microscopy studies of doslocations in gallium nitride // J. Appl. Phys. 2003. V. 94. P. 1448–1453.
Polyakov A.Y., Smirnov N.B., Dorofeev A.A., Gladysheva N.B., Kondratyev E.S., Shemerov I.V., Turutin A.V., Ren F., Pearton S.J. Deep Traps in AlGaN/GaN High Electron Mobility Transistors on SiC // ECS J. Solid State Science and Technology. 2016. V. 5. № (10). P. Q260–Q265.
Yatabe Zenji, Asubar Joel T., Hashizume Tamotsu. Insulated gate and surface passivation structures for GaN-based power transistors // J. Phys. D: Appl. Phys. 2016. V. 49. 393001. P. 1–20.
Zhang H., Miller E.J., Yu E.T. Analysis of leakage current mechanisms in Schottky contacts to GaN and grown by molecular-beam epitaxy // J. Applied Physics 2006. V. 99. P. 023703-1–0223703-6.
Lee I.-H., Polyakov A.Y., Smirnov N.B., Hahn C.-K., Pearton S.J. Spatial location of the Ec-0.6 eV electron trap in AlGaN/GaN heterojunctions // J. Vac. Sci. Technol. 2014. B 32. 050602.
Ando Y., Okamoto Y., Miyamoto H., Nakamyama T., Inoue T. Kuzuhara M. 10-W/mm AlGaN-GaN HFET with a Field Modulatine Plate // IEEE Electron Device Letters”. 2003. V. 24. № 5. P. 289–291
Zhang Aixi, Zhang Lining, Tang Zhikai, Cheng Xiaoxu, Wang Yan, Chen Kevin J., Chan Mansun. Analytical Modeling of Capacitances for GaN HEMTs, Including Parasitic Components // IEEE Transactions on electron Devices. March 2014. V. 61. № 3. P. 755–761.
Hayashi Kazuo, Yamaguchi Yutaro, oishi Toshiyiki, Otsuka Hiroshi, Yamanaka Koji, Nakayama Masatoshi, Miuamoto Yasuyuki. Mechanism Study of Gate Leakage Current for AlGaN/GaN High Electron Transistor Structure Under High Reverese Bias by Thin Surface Barrier Model and Technology Computer Aided Design Simulation // Japanese J. Applied Phisics. 2013. V. 52. P. O4CF12 1-5.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника