Микроэлектроника, 2021, T. 50, № 6, стр. 428-434
Моделирование ВАХ ультра тонких КНИ КМОП нанотранзисторов с полностью охватывающим затвором
Н. В. Масальский *
Федеральное государственное учреждение Федеральный научный центр Научно-исследовательский институт системных исследований Российской АН
117218 Москва, Нахимовский проспект, 36, корп. 1, Россия
* E-mail: volkov@niisi.ras.ru
Поступила в редакцию 18.01.2021
После доработки 19.04.2021
Принята к публикации 21.04.2021
Аннотация
Рассматривается методика моделирования электро-физических характеристик кремниевых ультра тонких полевых нанотранзисторов с полностью охватывающим затвором, длины каналов которых находятся в суб 20 нм диапазоне. Методика представляет собой комбинирование уравнений 3D Пуассона, 2D Шредингера и 1D Больцмана при условии самосогласованности их решений. Для достижения этой цели упрощена модель рассеяния, используя приближение времени релаксации. Линеаризация по времени релаксации позволяет нам получить прямое решение 1D транспортного уравнения Больцмана очень эффективным способом. Численно проанализированы прототипы нанотранзисторов с топологическими параметрами близкими к границе масштабирования в диапазоне управляющих напряжений до 0.4 В. Результаты моделирования в полном объемы иллюстрируют уникальные электро-физические свойства рассматриваемой транзисторной архитектуры. Это полноценное функционирование при низком напряжении питания и идеальные подпороговые характеристики в очень широком диапазоне топологических параметров.
ВВЕДЕНИЕ
Внедрение ультра тонких транзисторных архитектур напрямую связано с успешной реализацией целого ряда научных и прикладных проблем, в частности, создания технологической платформы для решения задачи современной микроэлектроники – повышения степени интеграции и быстродействия электронных микросхем [1, 2]. Однако, к настоящему моменту полностью исчерпан потенциал кремниевых планарных транзисторных структур [2]. И более того влияние деградирующих механизмов стало несоизмеримо больше, чем в начале “эры нанотранзисторов”. Это связано с тем, что длина свободного пробега носителей существенно зависит от толщины пленки кремния и резко снижается по мере ее уменьшения. В результате топология транзисторной структуры начинает определенным образом влиять на его электрические характеристики [3]. Поэтому конструктивно-технологические особенности прибора фундаментальным образом трансформируют требования к его модели вплоть до перехода к трехмерному квантово-механическому представлению.
Среди различных направлений развития нанотранзисторных архитектур конструкция транзистора с полностью охватывающим затвором отличается наиболее высокой способностью противостоять деградационным эффектам [2, 4]. Задача моделирования ультра тонких полевых нанотранзисторов с полностью охватывающим затвором на основе трехмерного квантово-механического представления очень актуальна, поскольку они являются первоочередными кандидатами для элементной базы современных микросхем [2, 3]. Работа посвящена обоснованию эффективной стратегии моделирования электро-физических характеристик кремниевых ультра тонких полевых нанотранзисторов с полностью охватывающим затвором. Стратегия представляет собой комбинирование уравнений 3D Пуассона, 2D Шредингера и 1D Больцмана при условии самосогласованности их решений. Рассмотрен один из возможных алгоритмов решения кинетического уравнения Больцмана, сформулированный на основе линеаризации интеграла рассеяния при помощи приближения времени релаксации [5]. Линеаризация по времени релаксации позволяет получить прямое решение транспортного уравнения Больцмана очень эффективным способом [6]. Этот подход включает все существенные особенности квазибаллистического переноса в суб 20 нм масштабе [5].
Цель работы – при помощи разработанной методики моделирования вольт-амперных характеристик (ВАХ) кремниевых полевых наноразмерных транзисторов с полностью охватывающим затвором, длины каналов которых находятся в суб 20 нм диапазоне, исследовать их электро-физические свойства при очень низких управляющих напряжениях.
1. Методика моделирования
Рис. 1 иллюстрирует трехмерное представление анализируемой приборной структуры, где на кремниевой пластине (Si) расположен слой оксида кремния (SiO2), на верхней грани которого помещена транзисторная структура. Она включает исток (поз. 1), сток (поз. 2) и рабочую область (поз. 3). Координатная ось z направлена вдоль рабочей области от истока к стоку. Внутренние края истока (поз. 1) и стока (поз. 2) расположены в z = 0 и z = Lg соответственно, где Lg – длина рабочей области и длина затвора транзистора.
Рис. 1.
Структурная схема МОП транзистора с полностью охватывающим затвором, где 1 – исток, 2 – сток, 3 – рабочая область, 4 – подзатворный диэлектрик, Lg – длина рабочей области, R – радиус рабочей области, tox – толщина подзатворного диэлектрика.
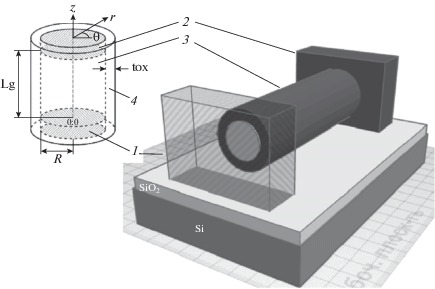
Выше показано, что для расчета электрических характеристик рассматриваемого устройства следует использовать трехмерное моделирование. Однако, такой подход приводит к немыслимым вычислительным затратам, а при некорректном разбиении транзисторной структуры к возрастанию погрешности или к неверному результату. Одним из направлений эффективного моделирования является построение математической модели сформулированной на физических обоснованных приближениях процессов протекающих в транзисторе. В таком случае допускаем, что транспорт носителей в наноразмерном транзисторе совершается через одномерные поддиапазоны общей энергетической зоны проводимости. Это следует из того, что волновые функции каждого поддиапазона ограничены поперечным сечением прибора [4, 5]. Для ультра тонких структур можно моделировать электронный транспорт при нормальных условиях, используя либо квазиклассическое мульти зонное уравнение переноса Больцмана [6], либо квантово-механический неравновесный формализм функции Грина (ФФР) [7, 8]. Есть несколько причин рассматривать мульти зонный подход транспортного уравнения Больцмана (ТУБ) вместо ФФР, когда длина рабочей области транзистора Lg не меньше 10 нм [4, 5, 9]. Во-первых, ФФР требует достаточно больших вычислительных ресурсов, так как требует детальной информации о распространении электронного волнового пакета, инжектируемого в устройство. Кроме того, микроскопические механизмы рассеяния, отличные от электрон-фононных взаимодействий [10], трудно включить в ФФР, поскольку соответствующие энергетические члены обычно являются нелокальными функциями пространственной координаты [9]. Наконец, основные явления квантового переноса в устройствах с параметрами близкими к границе масштабирования – туннелирование от истока к стоку и флуктуация проводимости, вызванная квантовой интерференцией, становятся значимыми только тогда, когда длина Lgстановится меньше 10 нм [11]. Поэтому для более длинных устройств квазиклассические формулировки, основанные на 1D мульти зонном TУБ, позволяют получить достоверные транзисторные характеристики, когда уравнение Больцмана решается самосогласованно с 3D уравнением Пуассона и 2D уравнением Шредингера для получения самосогласованных потенциалов и энергий поддиапазонов и волновых функций. Квази аналитическое решение 3D уравнения Пуассона на основе метода разделения переменных подробно рассмотрено [12]. Там же показано, что такой подход практические не снижает точность решения относительно прямых численных методов вычисления потенциала. Метод разделения переменных положен в основу решения 2D уравнения Шредингера, которое детально представлено в [13], и там же сделаны оценки погрешности вычисления волновых функций. Однако, решение ТУБ требует самых значительных вычислительных ресурсов в основном из-за наличия микроскопических процессов рассеяния, которые связывают функцию распределения в разных поддиапазонах и энергиях [14]. Для достижения этой цели мы упрощаем модель рассеяния, используя приближение времени релаксации, которое аналогично подходу Бюттикена [15] в формализме ФФР, где последний вводится для феноменологического учета эффектов рассеяния [8]. Линеаризация по времени релаксации позволяет нам получить прямое решение 1D ТУБ очень эффективным способом. Этот подход включает все существенные особенности квазибаллистического переноса в декананометровом масштабе, где рассеяние не является ни незначительным, ни столь же важным, как в длинно-канальных устройствах [16]. Кроме того, ТУБ в данном приближении по-прежнему превосходит макроскопические транспортные модели, поскольку они также требуют введения дополнительных аппроксимаций [5, 9]. Из-за этих упрощений макроскопические транспортные модели не всегда дают правильных результатов для наноразмерных транзисторов с полностью охватывающим затвором [17].
Мы использовали приближение эффективной массы, предполагающее обычную эллипсоидальную зонную структура, поскольку установлено, что зонные эффекты, вызванные непараболичностью полосы [18], не изменяют ток транзистора значительно даже для самых малых радиусов рабочей области, вплоть до 1 нм [5]. Поскольку зонные эффекты структуры становятся менее важными по мере увеличения радиуса, аппроксимация эффективной массы дает возможность обосновать транзисторные характеристики в широком диапазоне тонких структур.
Очень удобно, что время релаксации связано с эффективной подвижностью $\mu $ простым соотношением вида $\frac{1}{{{{\tau }^{{(\nu )}}}}} = \frac{q}{{m_{{eff}}^{{(\nu )}}}}\frac{1}{\mu }$, где q и m – заряд и эффективная масса носителя в поддиапазоне $\nu $ [6, 8]. Здесь $\mu $ рассматривается как корректирующийся параметр, который может отличаться от низко-полевой подвижности. Это примерно усредненная подвижность во всей рабочей области, которая обычно меньше, чем низко-полевая подвижность. Такая связь необходима, поскольку в математических выражениях удобнее использовать $\tau $, а при анализе электро-физических характеристик параметр $\mu $.
Отметим, что в отличии от ультра коротких транзисторных структур где рассеяние фононов и туннелирование от источника к стоку довольно значительны, однако их влияние по мере увеличения длины рабочей области становится менее значимым и при продольных размерах не ниже 10 нм не существенными [3]. Поэтому, и квантовые явления переноса представляются незначительными, а использование ТУБ является вполне обоснованным.
2. Численное моделирование и обсуждение результатов
Компьютерное моделирование выполнено для транзисторных структур с различными геометрическими размерами рабочей области. В расчетах длина рабочей области Lg изменяется в диапазоне 11–25 нм, радиус от 1.5 до 5 нм. Фиксированы размеры стока/истока, длина которых составляла 25 нм, ширина и высота составляют 50 нм. Они равномерно легированы с концентрацией 0.5 × 1021 см–3. Кремниевая рабочая область полагается нелегированной с собственной концентрацией носителей 1 × 1013 см–3. Границы примыкания рабочей области и к истоку/стоку являются резкими. Нет перекрытия между затвором и областями истока и стока. Толщина подзатворного диэлектрика (tox) составляет 1.0 нм. Дальнейшее масштабирование будет ограничено чрезмерным туннельным током утечки затвора [19]. Для зоны проводимости рассмотрим три пары вырожденных долин с анизотропной эффективной массой (ml, mt, mt), (mt, ml, mt) и (mt, mt, ml). Здесь ml = 0.916m0 и mt = = 0.19m0 являются продольной и поперечной эффективной массой соответственно и m0 – масса свободного электрона. В расчетах учитывается проникновение волновой функции в подзатворный диэлектрик, который обеспечивает высоту потенциального барьера 3.15 эВ. При этом эффективная масса носителей изотропна и соответствует 0.5m0. При моделировании полагаем, что температура решетки постоянна и равна 300 К.
Первоначально мы изучили электростатическую устойчивость исследуемой транзисторной архитектуры к проявлению коротко-канальных эффектов (ККЭ). В нашем случае, при фиксированном tox, радиус R будет самым важным параметром, контролирующим влияния ККЭ. Для получения требуемой устойчивости, мы используем известное понятие электростатической длины масштабирования LE (характеристическая длина) которая несет информацию об электростатической связи между смещением стока и потенциалом внутри канала [1, 20 ] . Для частного случая транзистора с полностью охватывающим затвором, параметр LE можно получить из неявного уравнения [16]:
(1)
$\frac{{{{Y}_{1}}({{\pi {{r}_{1}}} \mathord{\left/ {\vphantom {{\pi {{r}_{1}}} {{{L}_{E}}}}} \right. \kern-0em} {{{L}_{E}}}})}}{{{{J}_{1}}({{\pi {{r}_{1}}} \mathord{\left/ {\vphantom {{\pi {{r}_{1}}} {{{L}_{E}}}}} \right. \kern-0em} {{{L}_{E}}}})}} = {{\varepsilon }_{r}}\frac{{{{Y}_{0}}({{\pi R} \mathord{\left/ {\vphantom {{\pi R} {{{L}_{E}}}}} \right. \kern-0em} {{{L}_{E}}}})}}{{{{J}_{0}}({{\pi R} \mathord{\left/ {\vphantom {{\pi R} {{{L}_{E}}}}} \right. \kern-0em} {{{L}_{E}}}})}} + (1 + {{\varepsilon }_{r}})\frac{{{{Y}_{0}}({{\pi R{\kern 1pt} '} \mathord{\left/ {\vphantom {{\pi R{\kern 1pt} '} {{{L}_{E}}}}} \right. \kern-0em} {{{L}_{E}}}})}}{{{{J}_{0}}({{\pi R{\kern 1pt} '} \mathord{\left/ {\vphantom {{\pi R{\kern 1pt} '} {{{L}_{E}}}}} \right. \kern-0em} {{{L}_{E}}}})}},$На рис. 2 представлены результаты расчетов, выполненные при помощи (1). Из них можно определить диапазон параметров R и tox для заданного значения Lg при которых выполняется условие полного подавления ККЭ: Lg < 2LE [4].
На рис. 3 приведено, полученное при помощи метода представленного [12], распределение поверхностного потенциала прототипа с минимально рассматриваемые размерами рабочей области Lg = 11 нм и R = 1.5 нм.
Для дальнейших расчетов нужно выбрать разумное время релаксации. В настоящей работе мы корректируем время релаксации с помощью метода ФФР. В данном случае параметр $\mu $ рассматривается как корректирующийся табличный параметр, величина которого может отличаться от значения низко-полевой подвижности в кремнии. На рис. 4 приведены численно-рассчитанные ВАХ трех различных прототипов при µ =320 см2/(В ⋅ с).
Рис. 4.
ВАХ Ids(Uds) при Ug = 0.4 В, 1 – Прототип I Lg = 11 нм, R = 3 нм, 3 – Прототип III Lg = 11 нм, R = 1.5 нм, 2 – Прототип II Lg = 25, R = 3 нм и во всех структурах tox = 1 нм.
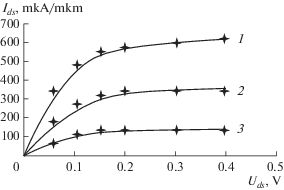
Сопоставление результатов моделирования дает достаточно точный ток стока (Ids) по сравнению с данными по методу ФФР. Поскольку подгонка выполняется в области насыщения, наша модель немного занижает ток стока в линейной области. Это ожидаемо, потому что низко-полевая подвижность электронов для всех прототипов, полученная из метода ФФР, составляет около 600 см2/(В ⋅ с).
На следующем рис. 5 представлены результаты моделирования ВАХ прототипа 1.
Рис. 5.
Результаты моделирования. Прототип I (верхний) ВАХ Ids(Ud), где 1 – Ug = 0.1 В, 2 – Ug = 0.2 В, 3 – Ug = 0.3 В, 4 – Ug = 0.4 В; (средний) ВАХ Ids(Ug), где 1 – Uds = 0.01 В, 2 – Uds = 0.4 В; (нижний) Ids_max(R) для прототипа с Lg = 11 нм, tox = 1 нм, при Uds = Uds = 0.4 В.

Следует отметить, что соотношение между током стока и подвижностью в нашей модели отличается от того, что обычно предполагается в дрейфово-диффузионных моделях (ДДМ), где ток стока, как известно, прямо пропорционален подвижности [1]. Вместо этого ток стока, полученный при помощи разработанной модели, характеризуется относительно слабой зависимостью от подвижности, поскольку она (модель) также содержит баллистическую составляющую, которая доминирует в деконаноразмерных структурах. Поэтому традиционные модели, предполагающие полностью диффузионный перенос, не могут дать точного значения данного тока в этом режиме. С другой стороны, феноменологические модели подвижности для сильного электрического поля, широко используемые в ДДМ, не могут быть использованы в нашем случае, поскольку они в сильных полях в значительной степени переоценивают деградацию подвижности в коротко-канальных устройствах [3, 16].
На рис 6 приведены экстрагированные из численно рассчитанных ВАХ Ids(Ug) во всем рассматриваемом диапазоне длин и радиусов рабочей области транзистора при постоянном значение подвижности μ = 320 см2/(В ⋅ с) крутизны подпороговой характеристики SS.
Экстракция показывает, что SS улучшается по мере уменьшения радиуса рабочей области. Однако, и пороговое напряжение синхронно увеличивается с уменьшением радиуса. При этом оно становится более чувствительным к изменению радиуса при его малых значениях. Такой быстрый рост порогового напряжения обусловлен квантово-механическими эффектами [10]. Это следует если рассмотреть цилиндрическую квантовую яму (потенциал равен нулю внутри кремния и бесконечности снаружи). Для нее собственное значение энергии представляется в виде ${{E}_{{nm}}} = \frac{{{{\hbar }^{2}}J_{{nm}}^{2}}}{{2m{\text{*}}{{R}^{2}}}}$, где Jnm – нуль функции Бесселя порядка m [9]. Поэтому небольшие изменения величины радиуса могут привести к существенному скачку порогового напряжения. Это характерно для диапазона маленьких значений радиусов, при условии $\frac{{\partial {{E}_{{nm}}}}}{{\partial R}} \propto {{R}^{{ - 3}}}$ [16].
Существенно, что радиус лучше характеризует свойства масштабирования, чем характеристическая длина, что может быть связано с квантовыми эффектами [11]. При анализе свойств масштабирования следует в большей степени опираться на радиус, который в данном случае выступает лучшим характеризатором проявления ККЭ. Действительно, что для того, чтобы транзистор был электростатически устойчивым (т.е. с SS < 80 мВ/дек), радиус кремниевой рабочей области должен быть меньше 1/3 длины затвора.
На рис. 7 показаны зависимости Ids(Lg, R) в диапазоне длины затвора 11–25 нм.
Одним из интересных результатов является зависимость максимального тока от длины рабочей области Ids_max(Lg). Если рассматривать степенную зависимость между Lg и Ids в виде ${{I}_{{ds}}} \propto L_{g}^{{ - \beta }}$, где параметр β – эмпирический, то для рассматриваемого диапазона Lg 11–25 нм, эти зависимости практически линейны при любых разумных значениях подвижности. При этом β естественно изменяется от 0 до 1. Поскольку ток стока почти не зависит от длины затвора в чисто баллистическом пределе, тогда как β равен 1 в диффузионном пределе. На рис. 8 представлены модельные зависимости для разных подвижностей. Так для µ = 300 см2/(В ⋅ с) β принимает значение приблизительно равное 0.5, тогда как для µ = 200 см2/(В ⋅ с) значение β составляет 0.6. Следует отметить, что аналогичный результат β = 0.5 был получен при помощи метода ФФР для µ = 300 см2/(В ⋅ с).
Мы рассмотрели наиболее значимые электро-физические характеристики ультра тонких кремниевых полевых транзисторов с полностью охватывающим затвором, топологические параметры которых близки к границе масштабирования. Полученные расчетные характеристики определяют высокую практическую значимость исследуемой нанотранзисторной архитектуры для разработки электронных устройств, предназначенных для эффективного решения разнонаправленных прикладных задач.
Следует отметить, что аномальное поведение порогового напряжения в диапазоне малых радиусов и рассеяние на шероховатости могут стать важными факторами в ограничении масштабирования рассматриваемой транзисторной архитектуры. Данная проблема характерна для всех транзисторных устройств с ультратонкими рабочими областями [2, 16].
Внедрение ультра тонких транзисторных архитектур с полностью охватывающим затвором также связано с успешным решением задачи разработка масштабируемой измерительной платформы для определения физико-химических и электрических параметров наноразмерных объектов физической, химической и биологической природы, поскольку анализируемая транзисторная структура обладает исключительной чувствительностью к изменению электрического потенциала вблизи поверхности канала [21]. Такая платформа для определения физических параметров наноразмерных биологических объектов в конечном итоге будет способствовать прорывному развитию биоинформатики.
ЗАКЛЮЧЕНИЕ
На основе 3D квантово-механического представления разработана эффективная стратегия моделирования электро-физических свойств кремниевых ультра тонких полевых нанотранзисторов с полностью охватывающим затвором состоящая из комбинирования уравнений 3D Пуассона, 2D Шредингера и 1D Больцмана при условии самосогласованности их решений. И требующая значительно меньших вычислительных ресурсов, чем известный подход моделирования с использованием формализма функций Грина.
Численно проанализированы прототипы нанотранзисторов с топологическими параметрами близкими к границе масштабирования. Результаты моделирования в полном объемы иллюстрируют уникальные электро-физические свойства рассматриваемой транзисторной архитектуры. Это полноценное функционирование при низком напряжении питания и идеальные подпороговые характеристики в очень широком диапазоне топологических параметров.
Полученные результаты исследований дополняют ранее известные и определяют необходимость формирования технологической платформы для успешного решения задачи разноплановых прикладных задач.
Работа выполнена в рамках государственного задания ФГУ ФНЦ НИИСИ РАН (Фундаментальные исследования 47 ГП) по теме № 0580-2021-0001 “Математическое обеспечение и инструментальные средства для моделирования, проектирования и разработки элементов сложных технических систем, программных комплексов и телекоммуникационных сетей в различных проблемно-ориентированных областях” (121031300047-6).
Список литературы
Schwierz F., Wong H., Liou J.J. Nanometer CMOS // Pan Stanford Publishing. Singapore. 2010.
Ferain I., Colinge C.A., Colinge J. Multigate transistors as the future of classical metal–oxide–semiconductor field-effect transistors // Nature. 2011. V. 479. P. 310–316.
Nanoelectronics: Devices, Circuits and Systems // Editor by Brajesh Kumar Kaushik. Elsevier. 2018.
Moon D., Choi S., Duarte J., Chio Y. Investigation of silicon nanowire gate – all-around junction less transistors built on a bulk substrate // IEEE Trans Electron Devices. 2013. V. 60. P. 1355–1360.
Avilla-Herrerea F., Paz B., Cerdeira A., Estrada M., Pavanello M. Charge-based compact analytical model for junction less triple-gate nanowire transistors // Solid-State Electronics. 2016. V. 121. P. 23–27.
Briggs S., Leburton J.P. Size effects in multisubband quantum wire structures // Phys. Rev. B. 1988. V. 38. P. 8163–8170.
Gilbert M.J., Ferry D.K. Efficient quantum three-dimensional modeling of fully depleted ballistic silicon-on-insulator metal-oxide-semiconductor field-effect-transistors // J. Appl. Phys. 2004. V. 95. P. 7954–7960.
Shao X., Yu Z. Nanoscale FinFET simulation: A quasi-3D quantum mechanical model using NEGF // Solid-State Electron. 2005. V. 49. P. 1435–1445.
Holtij T., Kloes A., Iniquez B. 3-D compact model for nanoscale junctionless triple-gate nanowire MOSFETs, including simple quantization effect // Solid-State Electronics. 2015. V. 112. P. 85–89.
Jin S., Park Y.J., Min H.S. A three-dimensional simulation of quantum transport in silicon nanowire transistor in the presence of electron-phonon interactions // J. Appl. Phys. 2006. V. 99. P. 123719-1–123719-10.
Sahay S., Kumar M. Junctionless Field-Effect Transistors: Design, Modeling, and Simulation // Wiley-IEEE Press, 2019.
Mani Manoj P., Pandey K. Surface potential and threshold voltage model of fully depleted narrow channel SOI MOSFET using analytical solution of 3D Poisson’s equation // J. Nano- and Electronic Physics. 2015. V. 7. P. 2002–2007.
Orlikovsky A., Vyurkov V., Lukichev V., Semenikhin I., Khomyakov A. All quantum simulation of ultrathin SOI MOSFET in nanoscale semiconductor-on-insulator structures and devices. Springer. 2007.
Sahay S., Kumar M. Spacer design guidelines for nanowire FETs from gate-induced drain leakage perspectives // IEEE Transactions on Electron Devices. 2017. V. 64. P. 3000–3015.
Büttiker M. Four-terminal phase-coherent conductance // Phys. Rev.Lett. 1986. V. 57. P. 1761–1764.
Tomar G., Barwari A. Fundamental of electronic devices and circuits. Springer. 2019.
Oproglidis T., Tassis D., Tsormpatzoglou A., Karatsori T.A. Analytical drain current compact model in the depletion operation region of short-channel triple-gate junctionless transistors // IEEE Trans on Lectron Devices. 2017. V. 64. № 1. P. 66–72.
Wang J., Rahman A., Ghosh A., Klimeck G., Lundstrom M. On the validity of the parabolic effective-mass approximation for the I–V calculation of silicon nanowire transistors // IEEE Trans. Electron Devices. 2005. V. 52. P. 1589–1595.
Oproglidis T., Barraud S., Karatsori T.A., Ghibaudo G. Leakage current conduction in metal gate junctionless nanowire transistors // Solid-State Electronics. 2017. V. 131. P. 20–23.
Amara A., Rozeau O. Planar double-gate transistor // Springer, 2009.
Robinson J., Jorgolli M., Shalek A., Yoon M., Gertner R., Park H. Vertical nanowire electrode arrays as a scalable platform for intracellular interfacing to neuronal circuits // Nat. Nanotechnol. 2012. V. 7. P. 180–184.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника