Микроэлектроника, 2021, T. 50, № 4, стр. 314-320
Эффект самонагревания в субмикронных КНИ КМОП транзисторах
С. В. Румянцев a, *, А. С. Новоселов a, **, Н. В. Масальский a, ***
a Федеральное государственное учреждение Федеральный научный центр Научно-исследовательский институт системных исследований Российской АН
117218 Москва, Нахимовский проспект, 36, корп. 1, Россия
* E-mail: Sergey_Rumyancev@srisa.ru
** E-mail: Anton_Novoselov@srisa.ru
*** E-mail: volkov@niisi.ras.ru
Поступила в редакцию 14.07.2020
После доработки 05.11.2020
Принята к публикации 07.12.2020
Аннотация
Обсуждаются результаты исследования вклада механизма самонагревания в вольт-амперные характеристики частично обедненных КНИ МОП транзисторов с топологическими нормами 0.25, 0.35 и 0.5 микрон при высоких управляющих напряжениях и температуре 25 и 300°С. Показано, что действие данного механизма существенно изменяет вольт-амперные характеристики всех исследуемых типов транзисторов. Определены отличия во влиянии механизма самонагревания на характеристики транзисторов n- и p-типа для анализируемых технологических норм.
ВВЕДЕНИЕ
Эффект самонагревания для субмикронных КНИ транзисторов обладает редким деградационным свойством, он является самым серьезным ограничением при высоких значениях затворных (Ugs) и стоковых (Uds) напряжений на транзисторе [1–3]. В данном случае его проявление приводит к резкому росту локального перегрева устройства. Поэтому его не учет при разработке микроэлектронной аппаратуры сопряжен с высокой вероятностью неконтролируемой работы микросхем входящих в ее состав, чаще всего в предельных режимах работы. Несомненно, от этого пострадает и надежность аппаратуры в целом.
Отметим, что технология КНИ является основной технологической платформой высокотемпературной электроники [4]. Она способна эффективно снижать температурную деградацию ключевых характеристик кремниевого МОП транзистора.
В проведенных исследованиях решается задача в условиях стационарных электрических и тепловых полей определить вклад эффекта самонагревания в вольт-амперные характеристики (ВАХ) субмикронных n- и p- канальных КНИ МОП транзисторов в температурном диапазоне от 25 до 300°С для трех технологических процессов с топологическими нормами 0.25, 0.35 и 0.5 мкм.
Представляемая работа является продолжением нашей работы [5]. Мы в своих настоящих исследованиях используем экспериментальные методики и математические модели, апробированные в ней.
1. ТЕСТОВЫЕ ТРАНЗИСТОРЫ
Для исследований были разработаны тестовые кристаллы для соответствующих топологических норм, каждый из которых содержал конструктивные варианты работающих в режиме частичного обеднения n- и p- транзисторов А- и Н-типов [6, 7]. Все использованные КНИ структуры изготовлены по технологии SIMOX. Основные параметры КНИ-структуры приведены ниже в табл. 1–3, где W, L – ширина и длина активной области транзистора.
Таблица 1.
Толщины слоев КНИ-структуры
| Наименование слоев и областей | Толщина, мкм | ||
|---|---|---|---|
| 0.25КНИ | 0.35КНИ | 0.5КНИ | |
| Области скрытого изолирующего окисла | 0.14–0.16 | 0.14–0.16 | 0.15 |
| Области истока и стока N- и P-канальных транзисторов | 0.18–0.20 | 0.18–0.20 | 0.19 |
| Области боковой изоляции | 0.20–0.25 | 0.20–0.25 | 0.19 |
| Области подзатворного окисла | 0.0040–0.0045 | 0.006–0.007 | 0.0110–0.012 |
| Области поликремния затвора | 0.25–0.27 | 0.25–0.27 | 0.24–0.28 |
Таблица 2.
Концентрации слоев
| Наименование области | Легирующая примесь | Уровень легирования, 1/см–3 | ||
|---|---|---|---|---|
| 0.25КНИ | 0.35КНИ | 0.5КНИ | ||
| PWELL | Бор | 4.00E + 17 | 2.50E + 17 | 1.90E + 17 |
| NWELL | Фосфор | 6.00E + 17 | 2.70E + 17 | 2.10E + 17 |
| PLDD | Бор | 9.00E + 18 | 9.00E + 18 | 9.00E + 18 |
| NLDD | Фосфор | 1.10E + 19 | 1.10E + 19 | 1.10E + 19 |
| PPLUS | Бор | 1.50E + 20 | 1.50E + 20 | 1.50E + 20 |
| NPLUS | Фосфор | 2.00E + 20 | 2.00E + 20 | 2.00E + 20 |
Таблица 3.
Топология транзисторов
| Технология 0.25КНИ | ||||
| Тип | А | Н | ||
| Проводимость | n | p | n | p |
| L, мкм | 0.24 | 0.24 | 0.28 | 0.28 |
| W, мкм | 4.8 | 4.8 | 2.66 | 4.76 |
| Технология 0.35КНИ | ||||
| Тип | А | Н | ||
| Проводимость | n | p | n | p |
| L, мкм | 0.35 | 0.35 | 0.35 | 0.35 |
| W, мкм | 3.5 | 7.0 | 3.5 | 7.0 |
| Технология 0.5КНИ | ||||
| Тип | А | Н | ||
| Проводимость | n | p | n | p |
| L, мкм | 0.5 | 0.5 | 0.5 | 0.5 |
| W, мкм | 8.6 | 8.6 | 10.0 | 10.0 |
2. РЕЗУЛЬТАТЫ ИЗМЕРЕНИЯ И МОДЕЛИРОВАНИЯ
В работе решалась задача – определить вклад механизма самонагревания в ВАХ для стационарных электрических и тепловых полей. Мы тестировали КНИ пластины, на всех гранях которых происходит свободный теплообмен с окружающей средой, температура которой постоянна. Измерения ВАХ транзисторов выполнялись на измерительном комплексе Keysight Technologies с зондовой станцией Suss Microtech, позволяющем проводить измерения на пластине в диапазоне температур от –60 до 300°С. Измерения выполнялись по истечении длительного промежутка времени, в течении которого, по нашим оценкам, прекращались все тепловые переходные процессы.
Вклад самонагревания экстрагируется из результатов моделирования, поскольку экспериментально его необходимо экстрагировать из измерений стоковой проводимости в импульсном режиме [8]. Это путь очень ресурсно-затратный, поскольку в каждом случае необходимо подбирать длительность импульса.
Для моделирования электротепловых характеристик КНИ МОП транзистора мы рассматривали четырехслойную структуру, схема которой приведена на рис. 1.
Рис. 1.
Структурная схема КНИ КМОП транзистора, где 1 – тонкая кремневая пленка, 2 – тепловой источник (активная область транзистора), 3 – пленка SiO2 (захороненный BOX окисел), 4 – кремневая подложка, 5 – пленка SiO2 (межслойный диэлектрик).
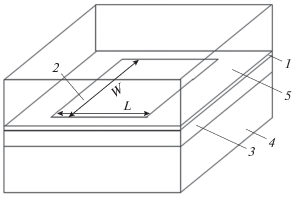
Каждый слой характеризуется собственным температурным распределением и теплофизическими параметрами: плотностью, теплоемкостью, теплопроводностью [1, 9]. Источник тепла расположен внутри структуры и является активной (рабочей) областью транзистора с площадью sa = W × L. Геометрические размеры слоев 1, 3, 4 и 5 по длине и ширине совпадают и составляют 20 мкм. Размеры слоя 2 (значения L и W) выбираются из таблицы для каждой технологии, типа конструкции и типа проводимости транзистора. Толщина слоев 1, 2 и 3 выбираются из таблиц по тому же правилу. Для всех образцов толщина слоя 4 равна 0.6 мм и толщина слоя 5–10 мкм.
ВАХ для каждого типа КНИ МОП транзисторов вычисляются с помощью апробированной токовой модели с учетом эффекта самонагревания [5], откалиброванной на основе экспериментальных данных для температуры 25°С.
Температурное поле в рассматриваемой структуре для стационарного случая определяем из решения системы уравнений теплопроводности и электротепловой обратной связи [10] с учетом того, что, во-первых, температура активной области транзистора Та постоянна по всему ее объему, во-вторых, рассеиваемая транзистором мощность зависит от Та, в третьих градиент температуры активной области транзисторов n- и p-типов с ростом окружающей температуры одинаков [5]. Распределения температуры рассчитываются численно с использованием итерационного алгоритма во взаимодействии с программной средой COMSOL Multiphysics [11] до тех пор, пока рассеиваемая мощность не будет изменяться.
На рисунках ниже приведены ВАХ КНИ МОП транзистора n- и p-типа Ids(Uds), которые позволяют оценить влияние механизма самонагревания в диапазоне температур окружающей среды от 25 до 300°С.
3. МОДЕЛИРОВАНИЕ И ОБСУЖДЕНИЕ
Согласно приведенным результатам калибровка моделей транзисторов проведена на приемлемом уровне – максимальное отклонение данных составляет менее 5%. Отличие для n- и p- транзисторов напрямую связано с температурно-зависимыми особенностями переноса заряда в обоих типах транзисторов [12].
По результатам моделирования видно, что действие механизма самонагревания для КНИ МОП транзисторов обоих типов существенно изменяют ВАХ. Относительное уменьшение максимального тока транзистора, в этом случае для n- и p-транзисторов достигает 22 и 20.6% соответственно. Что также объясняется особенностями переноса заряда. При температуре 300°С этот вклад существенно снижается и составляет около 8% для всех типов транзисторов.
На рис. 2–7 приведены численно рассчитанные зависимости вклада самонагревания в ВАХ исследуемых транзисторов от ширины транзистора (ΔIds(W)) для температур окружающей среды от 25 до 300°С.
Рис. 2.
ВАХ для p- и n-транзисторов A-типа 0.25КНИ 25°С (верхний) и 300°С (нижний) при Ugs = 3.3 В: сплошная – экспериментальные данные; длинная штриховая – расчет с учетом самонагревания; короткая штриховая – без учета самонагревания.

Рис. 3.
ВАХ для p- и n-транзисторов H-типа 0.25КНИ 25°С (верхний) и 300°С (нижний) при Ugs = 3.3 В. (Обозначения соответствуют подписи рис. 2.)

Рис. 4.
ВАХ для p- и n-транзисторов A-типа 0.35КНИ 25°С (верхний) и 300°С (нижний) Ugs = 3.5 В. (Обозначения соответствуют подписи рис. 2.)

Рис. 5.
ВАХ для p- и n-транзисторов H-типа 0.35КНИ 25°С (верхний) и 300°С (нижний) Ugs = 3.5 В. (Обозначения соответствуют подписи рис. 2.)

Рис. 6.
ВАХ p- и n-транзисторов по технологии 0.5КНИ при Ugs = 5.5 В, где блок (а) – транзистор A-типа при 25°С, блок (б) – транзистор A-типа при 300°С, блок (в) – транзистор H-типа при 25°С, блок (г) транзистор – H-типа при 300°С. (Обозначения соответствуют подписи рис. 2.)

Рис. 7.
Зависимость приращения тока (ΔIds) от ширины активной области (W) для трех технологии: блок (а) 0.25КНИ при Ugs = 3.3 В, блок (б) 0.35КНИ при Ugs = 3.3 В, блок (в) 0.5КНИ при Ugs = 5.5 В. В каждом блоке левый рисунок для транзистора H-типа и правый рисунок для транзистора А-типа. На всех рисунках самая верхняя n-тип и Т = 25°С, ниже р-тип и Т = 25°С, следующая n-тип и Т = 300°С и самая нижняя р-тип и Т = 300°С.

Из полученных данных следует, что все зависимости ΔIds(W) нелинейные, однако на них можно выделить линейный участок характерный для области W > 3L (при максимальных стоковом и затворном напряжениях). Также следует отметить, что вклад для транзисторов с n-проводимостью всегда превалирует над р-типом. Это отличие также зависит от температуры. Разница между вкладом самонагревания для n- и р-типов при 25°С примерно в два раза больше, чем при 300°С.
В табл. 4 для всех исследуемых транзисторов приведены вызванное действием механизма самонагревания максимальное и минимальное уменьшение тока транзистора ΔIds, связанное с граничными значениями ширины транзистора W, которые определяются требованиями проектирования.
Таблица 4.
Минимальный и максимальный вклад самонагревания (ток в мкА)
| Тип | А | Н | ||
|---|---|---|---|---|
| проводимость | n | p | n | p |
| 0.25 | 0.0/0.2973 | 0.0/0.3839 | 0.0/0.4702 | 0.0/0.3249 |
| 0.35 | 0.0/0.4903 | 0.0/0.4910 | 0.0/0.4939 | 0.0/0.495 |
| 0.5 | 0.0/0.5681 | 0.0/0.4926 | 0.01/0.7238 | 0.0/0.5561 |
Важно, что при небольших флуктуациях температуры из-за консервативности системы вклад самонагревания практически не изменяется. Для 25°С численно установлено, что если флуктуации составляют до 1.5°С, то вклад самонагревания практически не изменяется. При 300°С максимальное значение отклонения температуры может достигать 8°С.
При снижении затворного напряжениях эффект самонагревания проявляется менее значительно в основном из-за изменения транспорта носителей, связанного с уменьшением напряженности продольного электрического поля. Уровень рассеиваемой мощности ниже из-за более низкого тока транзистора, температура активной области также заметно снижается [5]. Это приводит к ослаблению эффекта самонагревания.
ЗАКЛЮЧЕНИЕ
На основе экспериментальных данных численно исследован вклад эффекта самонагревания в ВАХ частично обедненных КНИ МОП транзисторов, выполненных по технологии с топологическими нормами 0.25, 0.35 и 0.5 микрон при высоких управляющих напряжениях и температуре 25 и 300°С. Из результатов моделирования на апробированной токовой модели с учетом механизма самонагревания видно, что действие механизма самонагревания существенно изменяет ВАХ всех исследуемых типов транзисторов. Относительное уменьшение максимального тока транзистора, в этом случае для n- и p-транзисторов достигает 22 и 20.6% соответственно. При температуре 300°С этот вклад существенно снижается и составляет около 8% для всех типов транзисторов. Численно рассчитанные зависимости вклада самонагревания от ширины транзистора нелинейные, однако на них можно выделить линейный участок характерный для области W > 3L (при максимальных стоковом и затворном напряжениях). Следует отметить, что вклад для транзисторов с n-проводимостью всегда превалирует над р-типом. Это отличие также зависит от температуры. Разница между вкладом самонагревания для n- и р-типов при 25°С примерно в два раза больше, чем при 300°С.
Полученные результаты позволяют критически оценить влияние эффекта самонагревания на характеристики транзисторов, что является чрезвычайно актуальной и важной задачей при разработке термостабильных микросхем.
Публикация выполнена в рамках государственного задания ФГУ ФНЦ НИИСИ РАН на 2021 год (Проведение фундаментальных научных исследований (47 ГП) по теме № 0580-2021-0006).
Список литературы
Fiegna C., Yang Y., Sangiorgi E., O’Neill A.G. Analysis of self-heating effects in ultra thin body SOI MOSFETs by device simulation // IEEE Trans. Electron. Devices. 2008. V. 55. № 1. P. 233–244.
Neamen D. Semiconductor physics & devices: basic principles. New York, McGaw-Hill. 2011. P. 760.
Watson J., Castro G. High temperature electronic pose design and reliability challenge. Analog Dialog. 2012. V. 46. http://www.analog.com/(дата обращения: 12.03.2019).
Wolpert D., Ampadu P. Managing temperature effects in nanoscale adaptive system. Springer-Verlag New York. 2012.
Румянцев С.В., Новоселов А.С., Масальский Н.В. Исследование электротепловых характеристик частично обедненных субмикронных КНИ КМОП транзисторов в расширенном диапазоне температур // Микроэлектроника. 2020. Т. 49. № 1. С. 33–39.
Волков С.И. Опыт разработки радиационно-стойких библиотек и СБИС с применением специализированной САПР. URL: http://www.myshared.ru/ slide/467770/ (дата обращения: 2018).
Транзистор со структурой метал–оксид–полупроводник на подложке кремний на изоляторе: пат. 2477904 Рос. Федерация: МПК H01L29/78/Бабкин С.И., Волков С.И., Глушко А.А.; заявитель и патентообладатель Учреждение Российской академии наук Научно-исследовательский институт системных исследований РАН (НИИСИ РАН) (RU); заявл. 25.07.2011; опубл. 20.03.2013.
Jin W., Liu W., Fung S., Chan P., Hu C. SOI thermal impedance extraction methodology and Its significance for circuit simulation // IEEE Trans Electron Device. 2001. V. 48. № 4. P. 730–736.
Marani R., Perri A.G. Analytical electro thermal modeling of multi layer structure electronic devices // The Open Electrical & Electronic Engineering J. 2010. № 4. P. 32–39.
Vassighi A., Sachdev M. Thermal and power management of integral circuits. New York, NY, USA: Springer-Verlag, 2006.
URL: https://www.comsol.ru/heat-transfer-module. Программное обеспечение для расширенного моделирования теплопередачи (дата обращения 17.02.2018).
Зи С. Физика полупроводниковых приборов. М.: Мир, 1984.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника


