Микроэлектроника, 2020, T. 49, № 4, стр. 304-313
Высоковольтные LDMOS транзисторы на КНИ структуре для экстремальной электроники
С. И. Бабкин a, *, С. И. Волков a, **, А. А. Глушко a, С. А. Морозов a, А. С. Новоселов a, А. А. Столяров a
a Федеральное государственное учреждение Федеральный научный центр Научно-исследовательский институт системных исследований Российской АН
117218 Москва, Нахимовский проспект, 36, корп. 1, Россия
* E-mail: Sergey_Babkin@srisa.ru
** E-mail: Sviatoslav_Volkov@srisa.ru
Поступила в редакцию 11.11.2019
После доработки 20.11.2019
Принята к публикации 25.11.2019
Аннотация
Исследованы параметры высоковольтных LDMOS транзисторов на структуре кремний на изоляторе, сформированных в технологическом цикле, совмещенном с технологией изготовления низковольтных КМОП БИС. LDMOS исследовались в условиях изменения температуры в диапазоне –60…+300°С и воздействия ионизирующего излучения.
ВВЕДЕНИЕ
В настоящее время в автомобильной электронике, системах промышленного контроля, телекоммуникациях и космической электронике широкое применение находят интеллектуальные монолитные интегральные схемы (ИМИС). ИМИС состоят из низковольтных и высоковольтных МОП транзисторов. Последние изготавливают с использованием технологии High Voltage LDMOS, далее – HV LDMOS. Диапазон рабочих напряжений HV LDMOS достаточно широк и определяется назначением ИМИС. Большое распространение получили ИМИС класса низковольтной мощной электроники (Low-LVPE) [1]. LVPE включают в себя преобразователи напряжений, контроллеры для управления двигателями, различные мощные переключатели. Рабочие напряжения LVPE находятся в пределах 50 В. Часто к LVPE предъявляется требование сохранения работоспособности в экстремальных условиях, характеризующихся, прежде всего широким диапазоном рабочих температур (от –60 до +250°С), а также воздействием ионизирующего излучения.
Решение может быть найдено в использовании технологии кремний-на-изоляторе (КНИ) [2]. При этом формирование HV LDMOS транзисторов сочетается с традиционной КМОП КНИ технологией [3]. Эти преимущества позволяют использовать монолитную интеграцию нескольких силовых устройств, низковольтных схем управления и процессорных ядер на одном чипе. До настоящего времени фирма X-FAB использует КНИ процесс формирования HV LDCMOS транзисторов в сочетании с традиционными КМОП транзисторами с проектными нормами 1 мкм. ИМИС, изготовленные в этом процессе, имеют рабочий диапазон температур от минус 40 до +250°С [4].
В данной работе была поставлена задача разработки технологии и исследование параметров HV LDCMOS транзисторов в экстремальных условиях, изготовление которых совмещенно с ранее разработанными базовыми технологическими процессами КМОП КНИ с проектными нормами 0.25–0.5 мкм.
КОНСТРУКТИВНО-ТЕХНОЛОГИЧЕСКИЕ ОСОБЕННОСТИ HV LDMOS КНИ ТРАНЗИСТОРОВ
В зависимости от требуемых параметров используются различные конструкции LDMOS транзисторов [5]. В данном варианте конструкция во многом определялась параметрами уже применяемой ранее КНИ структуры: толщина рабочего слоя кремния (SOI) 190 нм, толщина изолирующего захороненного слоя окисла (BOX) , полученного по технологии SIMOX 150 нм, удельное сопротивление кремниевой подложки р-типа 10–20 Ом ⋅ см. На рис. 1а схематично представлено сечение конструкции LDMOS транзистора. На нем показаны основные конструктивные размеры, влияние которых на электрофизические параметры исследовалось в процессе разработки технологии [6].
Рис. 1.
Конструкция LDMOS КНИ транзистора (а), фото на пластине сборки LDMOS КНИ транзистора (б), SEM сечение LDMOS КНИ транзистора (в).
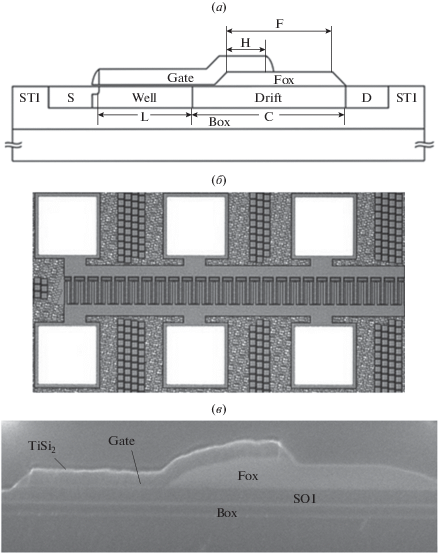
Конструкция предполагает работу LDMOS КНИ транзистора в режиме частичного обеднения (PDSOI). Контакт к карману осуществляется за счет вставок в области истока с тем же типом проводимости, что и в кармане. Воспроизводилась конструкция транзистора А-типа. В таком варианте наиболее просто реализовать конструкцию мощного транзистора, состоящего из параллельно включенных транзисторов А-типа (сборки) с суммарной шириной затвора W = 1 мм, длиной канала L = 0.8 мкм и DRIFT области 6 мкм площадью 6550 мкм2. Фотография мощного транзистора на пластине показана на рис. 1б. Технология формирования полевого изолирующего окисла (FOX) сохраняла исходную толщину слоя SOI, что предполагает снижение сопротивления DRIFT области. Преемственность технологии n‑канальных (NLDMOS) и p-канальных (PLDMOS) транзисторов с базовыми технологическими процессами изготовления низковольтных КМОП транзисторов заключалась в использовании апробированных технологических приемов:
– изоляции LDMOS транзисторов по технологии STI;
– использование режимов ионной имплантации при создании областей исток-стока (S-D),
– ретроградных карманов (WELL) и DRIFT областей;
– затвора (GATE) на основе поликристаллического кремния толщиной 250–270 нм;
– использование быстрых термических процессов (RTP) при формировании затворного окисла и активации имплантированной примеси в кремнии;
– использование технологии SALICIDE для шунтирования областей легированного монокристаллического и поликристаллического кремния низкоомным силицидом титана TiSi2.
Сечение сформированного LDMOS КНИ транзистора, полученное методом SEM, с указанием отмеченных выше областей представлено на рис. 1в.
Оптимизация процесса создания транзисторной структуры проводилась с использованием методов технологического моделирования [7].
ОСНОВНЫЕ ПАРАМЕТРЫ LDMOS КНИ ТРАНЗИСТОРОВ
Оценка электрофизических параметров LDMOS КНИ транзисторов проводилась на измерительном комплексе Keysight Technologies с зондовым устройством, позволяющим проводить измерения на пластине в диапазоне температур от –60 до +300°С, а также имеющим в своем составе импульсный генератор (SPGU) и высокомощный источник (HPSMU).
Проведенные ранее исследования показали, что величина напряжения пробоя LDMOS КНИ транзисторов в закрытом состоянии слабо зависит от длины канала L и в большей степени определяется протяженностью DRIFT и FOX областей [7] и составляет 44–45 В для NLDMOS и 55–60 В для PLDMOS. В открытом состоянии влияние указанных параметров на напряжение пробоя наиболее сильно проявляется для NLDMOS транзисторов. На рис. 2 представлены ВАХ NLDMOS и PLDMOS транзисторов с шириной затвора W = = 20 мкм и разными значениями длины канала L и величины перекрытия затвора и FOX области-H.
Рис. 2.
ВАХ NLDMOS-а и PLDMOS-б транзисторов при напряжении на затворе Vgs = +5 и –5 В и значениях H = 1, 2, 3 мкм кривые 1, 2, 3 соответственно.

Для NLDMOS резкое увеличение тока стока Ids при больших напряжениях, обусловленное “Kink”-эффектом, наиболее критично для транзисторов с меньшей длиной канала L и FOX области. Для них же в большей степени проявляется эффект “саморазогрева” и связанное с ним уменьшение тока. Из представленных ВАХ следует, что выбор конструктивного варианта может определяться, исходя из требований к параметрам, необходимых для работы схемы. Для заявленных рабочих напряжений 28–30 В с учетом необходимого запаса, целесообразно использовать вариант транзистора с L = 0.8 мкм и FOX = 6 мкм, который обеспечивает больший ток.
Все варианты PLDMOS транзисторов сохраняют работоспособность во всем исследуемом диапазоне напряжений стока. Учитывая указанные выше рабочие напряжения, возможно использование транзистора с длиной канала 0.5 мкм и области FOX = 3 мкм, при которых обеспечиваются максимальные токи. Принимая во внимание полученные результаты для обоих типов транзисторов, при проектировании схем, использующих комплементарную пару LDMOS транзисторов, целесообразно придерживаться соотношений ширины затвора NLDMOS и PLDMOS транзисторов как 1 : 1.5.
На рис. 3 представлены вольт амперные характеристики мощных NLDMOS-а и PLDMOS-б транзисторов, измеренных в режиме DC и в импульсном режиме в рабочем диапазоне напряжений. При максимальном напряжении на стоке Vds 30 В рассеиваемая мощность составляет Рmах-3.6 и 1.65 Вт для NLDMOS-а и PLDMOS-б соответственно. В этом случае эффект “саморазогрева” наблюдается для обоих типов транзисторов. Импульсный режим работы мощных транзисторов исследовался при длительности импульса на стоке в диапазоне 6–500 мкс с периодом следования 40 мс, а длительность импульса на затворе составила 1 мс с амплитудой от 1 до 5 В. В импульсном режиме эффект “саморазогрева” в значительной степени нивелируется для PLDMOS. Для NLDMOS наиболее полное восстановление характеристик происходит при самых коротких импульсах 6 мкс.
Рис. 3.
ВАХ мощных NLDMOS-а и PLDMOS-б транзисторов, снятых в режиме DC – 1 и импульсном режимах – 2, 3.

В табл. 1 приведены диапазоны изменения основных параметров n- и p-канальных LDMOS транзисторов с W = 20 мкм при различных значениях длины канала L и области FOX, а также мощных LDMOS на основе сборки этих транзисторов с L = 0.8 мкм и W = 1 мм. Измерения проводились по методике, описанной в работе [4]. Определялись следующие параметры: Ion – ток стока в открытом состоянии при напряжениях на истоке-подложке Vs = 0 В, стоке Vds = 5 В и затворе Vgs = 5 В; Vbr – напряжение пробоя стока при Vs = = 0 В, Vgs = 0 В по уровню тока стока Ids = 10 нА и Ids = 1 мкА для сборки транзисторов; Vth – пороговое напряжение; Ron – сопротивление в открытом состоянии при Vs = 0 В, Vds = 0.2 В и Vgs = 5 В; Be – крутизна транзистора.
Таблица 1.
Основные параметры LDMOS транзисторов
| Тип LDMOS | Параметры LDMOS транзисторов | ||||
|---|---|---|---|---|---|
| Vth [В] | Ion [мA] | Vbr [В] | Be [В/А2] | Ron [Ом] | |
| NLDMOS | 1.6–1.5 | 2.5–4.0 | 42–45 | (4.5–5.3)E-5 | 950–1250 |
| PLDMOS | –1.2…–1.4 | –1.0…–2.2 | –52…–55 | (1.0–1.5)E-5 | 1700–3700 |
| NLDMOS сборка |
1.58 | 100 | 42 | 5.0E-5 | 14 |
| PLDMOS сборка |
–1.2 | 87 | –54 | 1.28E-5 | 40 |
ИССЛЕДОВАНИЕ НАДЕЖНОСТИ HVLDMOS ТРАНЗИСТОРОВ
Рабочий диапазон напряжений LDMOS транзистора, как правило, существенно уже предельно допустимого диапазона напряжений. Это связано с необходимостью обеспечения надежности работы транзистора в экстремальных условиях. Как и для низковольтных МОП транзисторов в этом случае необходим режим работы, обеспечивающий минимальное воздействие на затворный диэлектрик. Таким воздействием является ток неосновных носителей, возникающий в результате ионизации в области пространственного заряда на границе областей WELL-DRIFT. Наиболее заметно это должно проявляться в PLDMOS транзисторе, где неосновными носителями являются электроны, и который характеризуется большими напряжениями пробоя. На рис. 4 представлены зависимости тока затвора PLDMOS транзистора от напряжения на стоке в закрытом состоянии (Vgs = = 0 В) с W = 20 мкм и различной длиной канала L, измеренные при 25°С. Из представленных зависимостей следует, что при рабочих напряжениях до 65 В ток затвора не превышает 20 пА. При работе в открытом состоянии (Vgs = –5 В) ток затвора достигал сравнимых значений при существенно больших напряжениях. В аналогичных условиях ток затвора Igs для NLDMOS транзистора был в несколько раз меньше.
Рис. 4
. Зависимость тока затвора Igs PLDMOS транзистора с длиной канала 1 – 0.5 мкм, 2 – 0.8 мкм, 3 – 1.5 мкм от напряжения на стоке Vds в (а) закрытом и (б) открытом состоянии.

Надежность LDMOS транзисторов в закрытом состоянии оценивалась при подаче на сток напряжения, близкого к напряжению пробоя в течение длительного времени. В процессе испытания измерялись ток стока и затвора. Результаты представлены на рис. 5. Для PLDMOS в начальный период наблюдается снижение тока стока и его стабилизация в процессе измерений. Ток затвора не превышал значения 5–10 пА за все время наблюдения. Аналогичные зависимости получены для NLDMOS. При этом ток затвора был меньше.
Рис. 5.
Зависимости тока стока Ids и тока затвора Igs от времени T, поданного на сток максимального напряжения для PLDMOS (а) и NLDMOS (б) транзисторов.

Таким образом, можно предположить, что при рабочих напряжениях 28–30 В и соответственно меньших стрессовых нагрузках реализованная конструкция LDMOS транзисторов будет обеспечивать работоспособность в течение длительного времени.
ИССЛЕДОВАНИЕ ПАРАМЕТРОВ ТРАНЗИСТОРОВ В ШИРОКОМ ДИАПАЗОНЕ ТЕМПЕРАТУР
На рис. 6 представлены зависимости основных параметров LDMOS транзисторов от температуры. Из них следует, что LDMOS транзисторы сохраняют работоспособность во всем исследуемом диапазоне температур. Температурный коэффициент порогового напряжения составляет 2–2.2 мВ/°С что сопоставимо со значениями, полученными для низковольтных МОП транзисторов [8].
Рис. 6.
Зависимости порогового напряжения Vth (а), тока насыщения Ion (б) и сопротивления в открытом состоянии Ron (в), NLDMOS-1 и PLDMOS-2 транзисторов от температуры t, °C.

Температурные ограничения могут быть обусловлены допустимыми токами потребления транзисторов в схеме. На рис. 7 представлены зависимости тока стока PLDMOS транзистора в закрытом состоянии от температуры. Принимая во внимание рассмотренную выше методику определения напряжения пробоя по уровню тока стока 10 нА, из рис. 7 следует, что максимальная температура составляет +125°С при сохранении значения напряжения пробоя в прежних пределах. При допущении значений стока ~100 нА максимальная температура составит +225°С. При температурах более +125°С зависимость тока стока от напряжения имеет более плавный “резистивный” характер и может быть обусловлена большим вкладом тока утечки по поверхности.
Рис. 7.
Зависимость тока стока Ids от напряжения на стоке Vds NLDMOS (а) и PLDMOS (б) транзистора при Vg = 0 В от температуры t, °C: 1 – –60°С, 2 – +25°С, 3 – +75°С, 4 – +125°С, 5 – +225°С, 6 – +300°С.
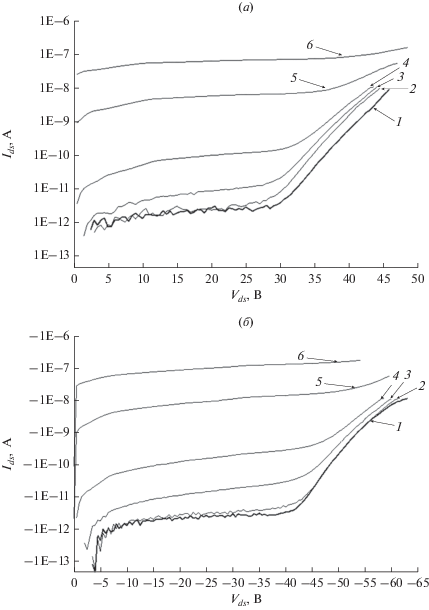
Одним из критериев работоспособности МОП в схеме является соотношение тока в открытом и закрытом состоянии Ion/Ioff. Учитывая данные, представленные на рис. 6а, 6б и 7, получим, что при температурах +300°С это соотношение находится в пределах 103–104. Для более низких температур это соотношение еще выше.
ИЗМЕНЕНИЕ ПАРАМЕТРОВ LDMOS ТРАНЗИСТОРОВ ПРИ ВОЗДЕЙСТВИИ ИОНИЗИРУЮЩЕГО ИЗЛУЧЕНИЯ
Известно, что изменение параметров МОП транзисторов на КНИ структуре связано с индуцированием и накоплением положительного заряда в окисле при воздействии ионизирующего излучения. Положительный заряд может накапливаться в подзатворном окисле, захороненном BOX окисле и окисле STI изоляции. Отличие изменения параметров высоковольтных HV LDMOS от низковольтных КМОП транзисторов может быть обусловлено влиянием подзатворного окисла большей толщины, а также изменением профиля легирования ретроградного кармана в условиях более длительного окисления подзатворного окисла в сухом кислороде. Эти факторы напрямую связаны с изменениями пороговых напряжений рабочего и паразитного “донного” МОП транзисторов. Накопленный положительный заряд в области STI-изоляции, толстого FOX окисла может повлиять на величину тока утечки при высоких напряжениях на стоке HV LDMOS, что в свою очередь сказывается на измерениях напряжения пробоя, фиксируемого по уровню тока 10 нА. Образцы высоковольтных HV LDMOS транзисторов, собранные в корпусе, подвергались воздействию гамма-излучения по методике, описанной в работе [9]. На рис. 8 представлены зависимости изменения порогового напряжения рабочего n- и р-канального транзистора (а) и донного транзистора (б) от накопленной дозы.
Рис. 8.
Зависимость изменения порогового напряжения ΔVth рабочего NLDMOS-1 и PLDMOS-2 транзистора (а) и донного транзистора (б) от накопленной дозы ионизирующего излучения D, кРад.

Из рис. 8а следует, что PLDMOS более чувствителен к накопленной дозе, чем NLDMOS транзистор. Разница обусловлена распределением примеси в приповерхностном слое кремния в ретроградных карманах транзисторов. По абсолютной величине пороговые напряжения р-канальных транзисторов увеличиваются, а n-канальных уменьшаются. Аналогично для “донных” паразитных транзисторов рис. 8б. В данном случае более чувствительным является n-канальный “донный” транзистор, что связано с распределением примеси на границе BOX окисла и кремния. С учетом исходных значений пороговых напряжений рабочих NLDMOS и PLDMOS (см. табл. 1), а также пороговых напряжений n- и p-канальных “донных” паразитных транзисторов (13 В и –15 В соответственно) можно утверждать, что работоспособность LDMOS сохраняется при дозах облучения до 600 кРад.
Образцы LDMOS транзисторов с накопленной дозой облучения 600 кРад исследовались в диапазоне температур 25–225°С [10]. Показано, что предварительное облучение существенно не влияет на характер поведения параметров LDMOS при изменении температуры. Температурный коэффициент порогового напряжения находится в тех же пределах. Кроме того, при работе при высоких температурах в условиях саморазогрева наблюдается восстановление параметров до исходных значений, что связано с отжигом накопленного заряда в подзатворном и BOX окислах. Суммарное воздействие высокой температуры и ионизирующего излучения наиболее критично для NLDMOS, для которых оба фактора приводят к уменьшению порогового напряжения. Принимая во внимание приведенные выше данные по изменению порогового напряжения NLDMOS, можно предположить, что работоспособность NLDMOS сохраняется при воздействии данных факторов в исследованных диапазонах температур и накопленной дозы гамма-облучения.
ЗАКЛЮЧЕНИЕ
Исследованы параметры высоковольтных LDMOS транзисторов, сформированных по технологии, совместимой с технологией изготовления низковольтных КМОП БИС на подложках “кремний на изоляторе”. Измерение значений параметров в экстремальных условиях, характеризующихся высокими значениями рабочих напряжений, температуры и накопленной дозой ионизирующего излучения показывает, что LDMOS транзисторы сохраняют свою работоспособность при температурах от –60 до +300°С и накопленной дозе гамма-излучения до 600 кРад. Разработанная технология высоковольтных LDMOS транзисторов может использоваться при создании ИМИС класса низковольтной мощной электроники, работающих в экстремальных условиях.
Список литературы
Edited by John D., Cressler H., Alan Mantooth. Extreme environment electronics // CRC Press© 2013 by Taylor & Francis Group, LLC. P. 978.
Udrea F., Garner D., Sheng K., Popescu A., Lim H.T., Milne V.I. SOI power devices // Electron. Commun. Eng. J. 2000. 12(1). P. 27–40.
Toulon G., Cortes I., Morancho F. Analysis and Optimization of LUDMOS Transistors on a 0.18 μm SOI CMOS Technology // International J. Microelectronics and computer science. 2010. V. 1. P. 3–8.
The XI10 series is X-Fab’s 1.0-micron Modular Silicon-On-Insulator Technology // Process SpecificationXI10 – 1.0 μm SOI CMOS 2014.
Красников Г.Я., Горнев Е.С., Игнатов П.В., Мизгинов Д.С. Конструктивно-технологические методы реализации транзисторов, ориентированных на высокое напряжение питания // Электронная техника. Серия 3: Микроэлектроника. 2017. № 4. (168). С. 12–15.
Бабкин С.И., Байдаков Д.А., Волков С.И., Глушко А.А., Морозов С.А., Новоселов А.С., Столяров А.А. Разработка технологии формирования высоковольтных LDMOSSOI транзисторов для экстремальной электроники // Труды НИИСИ РАН. 2018. Т. 8. № 3. С. 31–37.
Глушко А.А., Бабкин С.И., Амирханов А.В., Зинченко А.А., Макарчук В.В. Вопросы проектирования LDMOS транзисторов, работающих при повышенном напряжении питания // Проблемы разработки перспективных микро- и наноэлектронных сиситем (МЭС). Институт проблем проектирования в микроэлектронике РАН. 2018. № 3. С. 93–97.
Бабкин С.И., Волков С.И., Морозов С.А., Новоселов А.С., Румянцев С.В. Исследование параметров высоковольтных LDMOS транзисторов при высоких температурах // Труды НИИСИ РАН. 2018. Т. 8. № 3. С. 25–31.
Бабкин С.И., Волков С.И., Новоселов С.А., Румянцев С.В. Исследование влияния накопленной дозы ионизирующего излучения на характеристики высокотемпературных HVLDMOS транзисторов // Труды НИИСИ РАН. 2018 Т. 8. № 6. С. 147–151.
Бабкин С.И., Волков С.И., Морозов С.А., Новоселов А.С. Исследование параметров высоковольтных LDMOS транзисторов при работе в экстремальных условиях // Тезисы докладов 22-й Всероссийской научно-технической конференции “Радиационная стойкость электронных систем”, “Стойкость-2019” Научно-технический сборник. С. 53–54.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника


