Микроэлектроника, 2020, T. 49, № 3, стр. 210-225
Нелокальная динамика электронов в транзисторных гетероструктурах с донорно-акцепторным легированием
А. Б. Пашковский a, *, А. С. Богданов a, В. М. Лукашин a, С. И. Новиков a
a Акционерное общество “Научно-производственное предприятие “Исток” им. А.И. Шокина”
141195 Московская область, г. Фрязино, ул. Вокзальная, 2а, Россия
* E-mail: solidstate10@mail.ru
Поступила в редакцию 30.10.2019
После доработки 30.10.2019
Принята к публикации 22.11.2019
Аннотация
На основе самосогласованного решения уравнений Шредингера, Пуассона и системы гидродинамических уравнений разработана простая феноменологическая модель для оценки всплеска дрейфовой скорости в транзисторных гетероструктурах с сильной локализацией электронов в канале. Показано, что при влете электронов в область сильного поля донорно-акцепторное легирование увеличивает в несколько раз среднюю дрейфовую скорость электронов в обращенных гетероструктурах и примерно в 1.5 раза – в транзисторных гетероструктурах на основе гетеропереходов InxGa1– xAs–AlyGa1 – yAs и InxGa1 – xAs–InyAl1 – yAs с двусторонним легированием. При этом поверхностную плотность электронов в структурах с двухсторонним легированием без существенного ухудшения транспортных характеристик можно увеличить более, чем вдвое.
1. ВВЕДЕНИЕ
С момента своего создания [1, 2], гетероструктуры с селективным легированием (ГСЛ) выступают в двух основных качествах: как удобный объект для изучения свойств квазидвумерного электронного газа [3] и как очень удачный материал для полупроводниковых СВЧ приборов. Причем если в первом случае квазидвумерный электронный газ в таких структурах демонстрирует все особенности, связанные с размерным квантованием, особенно при низких температурах, то в традиционных полевых транзисторах на основе гетероструктур с селективным легированием (HEMT) в рабочих режимах размерное квантование на перенос электронов по каналу практически не влияет. Причина заключается в том, что влетая под затвор транзистора электроны быстро разогреваются и попадают в область квантовых уровней расстояние между которыми составляет всего единицы или доли мили электрон вольта, то есть по сути дела в область непрерывного спектра [4]. Одновременно с этим, в зависимости от типа гетероструктуры, происходит либо резкое расширение квантовой ямы, либо электроны вообще оказываются над ней и начинают переходить в широкозонный материал. Таким образом происходит делокализация электронов из сравнительно тонкого канала транзистора в котором размерно-квантовый эффект относительно велик, в область толщин, где он становится несущественен. Поэтому преимущество транзисторов в HEMT исполнении перед обычными в основном обусловлено тем, что в них большинство электронов движется по нелегированному узкозонному слою с высокой подвижностью – слою канала, окруженного слоями более широкозонных полупроводников, что создает условия для относительно большого всплеска дрейфовой скорости. Несмотря на активное развитие нитрид-галлиевых технологий, гетероструктурные транзисторы на основе арсенида галлия и фосфида индия продолжают широко использоваться и демонстрировать рекордные характеристики [5–7]. Важной особенностью традиционных гетероструктур для полевых транзисторов является интенсивный поперечный пространственный перенос горячих электронов – при достаточно сильном разогреве электронов происходит их переход из потенциальной ямы слоя канала (узкозонного материала) в широкозонный материал с более низкой подвижностью носителей. Этот эффект по своей сути является паразитным и заметно ухудшает характеристики приборов [8]. Существенное уменьшение отрицательного влияния поперечного пространственного переноса и возможность усиления положительного влияния размерно-квантовых эффектов на электронный транспорт в канале транзистора стало возможным лишь с появлением гетероструктур с донорно-акцепторным легированием (DA-DpHEMT) [9–12], что сразу привело к почти двукратному увеличению коэффициента усиления и выходной мощности приборов. Появились и другие перспективные идеи как для усиления роли размерного квантования в таких структурах [13], так и для снижения роли поперечного пространственного переноса [14], поэтому представляет интерес подробно рассмотреть весь комплекс этих вопросов.
2. ОСОБЕННОСТИ ТРАНЗИСТОРНЫХ ГЕТЕРОСТРУКТУР
На первом этапе развития транзисторных гетероструктур [15–20] было предложено и разработано три основных варианта конструкции по расположению δ-слоя легирующей примеси доноров (или тонкого объемно легированного донорами слоя) относительно канала транзистора
А) прямая структура – легированный донорами широкозонный слой расположен между затвором и каналом рис. 1а
Рис. 1.
Схематические зонные диаграммы структур с контактом Шоттки: (а) – прямой HEMT структуры, (б) – обращенной HEMT структуры, (в) – двойной HEMT структуры.
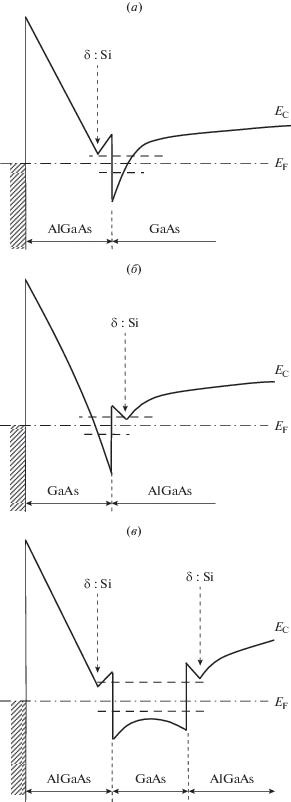
Б) обращенная (в западной литературе инвертированная) структура – легированный донорами широкозонный слой расположен между каналом и подложкой рис. 1б
В) двойная гетероструктура – легированные широкозонные слои расположены с обеих сторон канала рис. 1в.
При промышленном производстве транзисторов обычно используется два основных типа гетероструктур: для малошумящих приборов – прямая гетероструктура, для мощных – двойная. По существу, использование двух этих типов структур после почти двух десятилетий упорного труда мирового сообщества привело к примерно двукратному улучшению основных характеристик промышленных транзисторов, таких как удельная мощность, коэффициент усиления и коэффициент шума по сравнению с транзисторами на арсенидгаллиевых гомоструктурах. На начальных этапах развития транзисторных гетероструктур канал транзистора выращивали из чистого GaAs, в настоящее время для улучшения характеристик применяют InxGa1 – xAs канал, обычно при не слишком высокой мольной доле индия ($x \leqslant 0.2$) для сохранения достаточно больших пробивных напряжений. В принципе, возможны различные вариации структур каждого типа, по существу не меняющие ситуацию. Например, в прямой структуре после InxGa1 –xAs канала со стороны буфера может формироваться слой GaAs, образуя на границе с каналом барьер высотой порядка 0.1 эВ, или в канал двойной гетероструктуры встраиваться тонкие вставки с повышенным содержанием In [21, 22] и т.д. Интересной особенностью каждого типа структур является поведение квантовой ямы при увеличении отрицательного напряжения на затворе. В прямой структуре она расширяется и расстояние между уровнями размерного квантования уменьшается [4]. В двойной структуре характерный размер ямы меняется слабо – больше меняется ее форма – из условно прямоугольной она становится трапециевидной, также не слишком сильно меняется и расстояние между уровнями. Для обращенной структуры характерно сужение квантовой ямы при увеличении отрицательного потенциала на затворе [13] и соответственно, увеличение разности энергии соседних размерно-квантовых уровней. На первый взгляд, благодаря этому и таким особенностям, как близость канала к затвору и, как следствие, существенно увеличенная крутизна [23, 24], обращенные гетероструктуры представлялись очень перспективными. Однако, не смотря на большое количество экспериментов, это направление гетероструктурных полевых транзисторов развития не получило. По-видимому, это связано с тем, что обращенная структура (рис. 1б) имеет два существенных недостатка. Первый: при обратном смещении на затворе появляется возможность сильного туннелирования электронов из затвора в канал. Второй: продольный транспорт электронов по слою канала сопровождается их разогревом и поперечным переносом в область весьма большого по толщине слоя AlGaAs где интенсивность рассеяния электронов велика, что приводит к резкому падению их дрейфовой скорости. Проблема интенсивного поперечного пространственного переноса электронов, а соответственно и усиления интенсивности рассеяния в сильных полях, в обращенной структуре может быть достаточно просто решена по аналогии с DA-DpHEMT транзисторами [9–12] (рис. 2а). Для этого ниже слоя канала можно сформировать дополнительный pin – потенциальный барьер, а выше слоя канала – дополнительный широкозонный слой AlAs, формирующий потенциальный барьер над слоем канала [13] (рис. 2б). Кроме этого, в принципе, ничто не мешает увеличивать степень локализации электронов в квантовой яме (КЯ) канала за счет увеличения высоты гетеропереходных барьеров на границах слоя канала, например, за счет увеличения содержания индия в слое канала. Однако при этом заметно уменьшается ширина запрещенной зоны в слое канала, и как следствие, пробивное напряжение таких приборов. В этом аспекте очень перспективным выглядит предложение [14] не увеличивать содержание индия, а выше и ниже слоя канала использовать другие материалы, например, In0.2Al0.8As. В гетеропереходе (In0.2Ga0.8As-канал) – In0.2Al0.8As перепад энергии дна зоны проводимости вырастает примерно до 0.5 эВ. На первый взгляд, это увеличение потенциального барьера малосущественно, так как оно составляет всего лишь около 0.2–0.15 эВ. Однако если учесть, что высота квантового уровня в яме может составлять около 0.2 эВ, то это в зависимости от мольной доли индия в узкозонном материале увеличивает эффективную величину барьера в два–три раза и делает ее практически равной величине междолинного зазора. Такое увеличение эффективной высоты барьера на границах слоя канала может достаточно существенно сказаться на транспорте горячих электронов под затвором транзистора. Естественно, наиболее перспективным выглядит одновременное увеличение не только перепада энергии дна зоны проводимости на гетерограницах слоя канала, но и построение с помощью донорно-акцепторного легирования дополнительных потенциальных барьеров, усиливающих локализацию горячих электронов в слое канала, что открывает новые возможности конструирования транзисторных гетероструктур с улучшенными характеристиками.
Рис. 2.
Схематические зонные диаграммы структур с контактом Шоттки: (а) – DA-DpHEMT структуры, (б) – обращенной структуры с дополнительным слоем ${{p}^{ + }}$-AlGaAs и слоем AlAs над GaAs каналом.
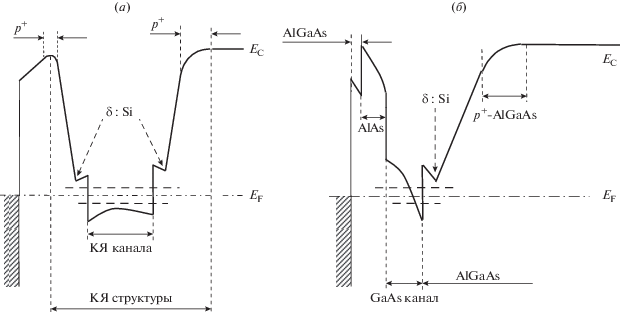
Как отмечалось выше, переход с арсенид-галлиевых транзисторных гомоструктур на гетероструктуры привел к двукратному улучшению основных параметров промышленных транзисторов. Переход с обычных гетероструктур на основе арсенида галлия с двухсторонним легированием на гетероструктуры с донорно-акцепторным легированием также примерно вдвое улучшил коэффициент усиления и удельную выходную мощность полевых транзисторов. Возникает естественный вопрос: за счет каких физических эффектов произошел этот, по существу, качественный скачок. В принципе в [10] возможные механизмы обсуждались довольно подробно. Как отмечалось выше одним из основных может быть увеличение дрейфовой скорости электронов при их пролете под затвором за счет уменьшения поперечного пространственного переноса. Однако, как для понимания физики происходящих явлений, так и в практических целях очень важно на основании достаточно адекватных моделей оценить величину этого увеличения. Кроме того, даже на современном уровне развития технологии достаточно сложно экспериментально проводить оперативный анализ сравнительной перспективности всего многообразия транзисторных структур. Поэтому для сравнения и выбора возможных вариантов конструкций структур представляет интерес проводить теоретические оценки. Как известно, современные полевые транзисторы имеют длины затвора порядка десятков нанометров [5–7]. Наиболее точно динамика электронов в таких приборах описывается на основе решения кинетического уравнения [25–28]. Однако, как показывает опыт, для быстрых и простых оценок перспективности различных вариантов транзисторных структур часто бывает вполне достаточно анализа формы и величины всплеска дрейфовой скорости электронов, развивающегося во времени при включении ступенчатого или импульсного внешнего электрического поля [29–31].
3. ОПИСАНИЕ МОДЕЛИ
Для расчета всплеска дрейфовой скорости используем простую феноменологическую модель [32], предназначенную для анализа нелокального разогрева электронов в транзисторных гетероструктурах с идеализированным (бесконечно длинным) затвором, построенную с учетом поперечного пространственного переноса горячих электронов. Аналогичный анализ нелокального разогрева электронов как в гетероструктурах с односторонним легированием [33], так и полевых транзисторах на их основе [34] ранее проводился в приближении треугольной потенциальной ямы и системы гидродинамических уравнений описывающих два связанных ансамбля электронов – в широкозонном и узкозонном материале. Обмен частицами между ансамблями рассчитывался в приближении термоэлектронной эмиссии, а времена релаксации по энергии и импульсу брались такие же как в объемных материалах. В случае классических (прямых) НЕМТ структур с практически непрерывным спектром горячих электронов [4] такой подход выглядел вполне оправданным, однако в случае жесткой локализации электронов, когда число уровней конечно, а расстояние между ними может быть достаточно велико такие приближения выглядят не совсем корректным. Поэтому в отличие от [33, 34], в используемой модели включены возможности точного учета сильного размерного квантования в квантовой яме структуры и сложного потенциального рельефа в поперечном (по оси “x”) направлении, перпендикулярном поверхности структуры. Потенциальный рельеф и уровни размерного квантования для этого направления определяются на основе численного самосогласованного решения уравнений Шредингера и Пуассона [13]:
(1)
$\begin{gathered} - \frac{{{{\hbar }^{2}}}}{2}\frac{d}{{dx}}\left( {\frac{1}{{m{\text{*}}(x)}}\frac{{d{{\Psi }_{i}}(x)}}{{dx}}} \right) + U(x){{\Psi }_{i}}(x) + {{E}_{x}}(x){{\Psi }_{i}}(x) = {{E}_{i}}{{\Psi }_{i}}(x), \\ U(x) = {{E}_{{c0}}}(x) - q\varphi (x), \\ \frac{d}{{dx}}\left( {\kappa (x)\frac{{d\varphi (x)}}{{dx}}} \right) = - \frac{{\rho (x)}}{{{{\kappa }_{0}}}}, \\ {{E}_{x}}(x) = - \frac{{{{q}^{2}}}}{{4\pi \kappa (x){{\kappa }_{0}}}}{{\left( {\frac{3}{\pi }n(x)} \right)}^{{\frac{1}{3}}}}. \\ \end{gathered} $Здесь и далее Ψi(x) и Ei – собственные функции и собственные значения оператора Гамильтона, Ex(x) – обменная энергия электрона [35], Ec0(x) –функция, задающая на гетерограницах и внутри структуры форму, величину и расположения перепадов потенциальной энергии, соответствующей электрическому потенциалу дна зоны проводимости в отсутствии свободных зарядов, EF – энергия Ферми, Ek – кинетическая энергия электронов в зоне проводимости,
– эффективная плотность состояний в зоне проводимости, ND(x) и NA(x) – концентрации ионизованных доноров и акцепторов [36], q – абсолютное значение заряда электрона, κ(x), κ0 – диэлектрическая проницаемость полупроводника и вакуума, m* – эффективная масса электрона в зоне проводимости, kB – постоянная Больцмана, Te –температура электронного газа, $\hbar $ – постоянная Планка. Для упрощения расчетов, надбарьерным и туннельным током из металла пренебрегается. Соответственно пренебрегается экспоненциально малыми поправками к концентрации электронов, связанными с изменением уровня Ферми вблизи границы. Поэтому в полупроводнике вдоль оси “x” уровень Ферми считается постоянным, а его значение определяется из равновесных условий в глубине полупроводника. На границе металл–полупроводник он терпит разрыв, величина которого определяется напряжением, подаваемым на затвор. Граничными условиями для решения уравнения Пуассона служат потенциал, задаваемый на границе металл–полупроводник, и отсутствие электрического поля в глубине структуры.
В областях координатного пространства, где движение можно считать классическим, а также, выше последнего найденного уровня (в этом случае считается, что дно зоны проводимости совпадает с U(x) или самим уровнем), энергетический спектр считается непрерывным, и плотность объемного заряд вычисляется по формулам:
(2)
$\begin{gathered} \rho (x) = q\left( {{{N}_{D}}(x) - {{N}_{A}}(x)} \right) + {{\rho }_{c}}(x), \\ {{\rho }_{c}}(x) = - q{{n}_{c}}(x) = - q{{N}_{с}}\left( x \right)\int\limits_0^\infty {\frac{{\sqrt {{{E}_{k}}\left( x \right)} d{{E}_{k}}}}{{1 + \exp \left( {\frac{{{{E}_{k}}\left( x \right) - {{E}_{F}}}}{{{{k}_{B}}{{T}_{e}}}}} \right)}}} . \\ \end{gathered} $В области пространства, в которой локализованы волновые функции дискретного энергетического спектра (квантовой области):
(3)
$\begin{gathered} \rho (x) = q\left( {{{N}_{D}}(x) - {{N}_{A}}(x)} \right) + {{\rho }_{c}}(x) - q\sum\limits_i {{{n}_{i}}{{{\left| {{{\Psi }_{i}}(x)} \right|}}^{2}}} , \\ {{n}_{i}} = \left( {\frac{{m{\text{*}}(x){{k}_{B}}{{T}_{e}}}}{{\pi {{\hbar }^{2}}}}} \right)\ln \left\{ {1 + \exp \left[ {\frac{{{{E}_{F}} - {{E}_{i}}}}{{{{k}_{B}}{{T}_{e}}}}} \right]} \right\}. \\ \end{gathered} $Для анализа нелокального разогрева электронов, используем подход аналогичный примененному в работах [33, 34]. Как и там предположим, что в каждой точке канала в поперечном (по оси “x”) направлении устанавливается квазиравновесие, определяемое температурой электронов. Однако в отличие от структур с практически непрерывным спектром энергий электронов, для систем с сильной локализацией электронов в слое канала и с сильным размерным квантованием, более приемлемой выглядит форма описания, учитывающая вероятности нахождения электронов в различных слоях структуры. При этом электроны описываются общим ансамблем для которого законы сохранения энергии и импульса описываются с помощью уравнений, аналогичных системе уравнений [29].
(4)
$\begin{gathered} \frac{{\partial \left[ {m{\text{*}}\left( {\varepsilon \left( t \right)} \right)V\left( t \right)} \right]}}{{\partial t}} = qE\left( t \right) - \frac{{m{\text{*}}(\varepsilon \left( t \right))V\left( t \right)}}{{{{\tau }_{p}}(\varepsilon \left( t \right))}}, \\ \frac{{\partial \varepsilon \left( t \right)}}{{\partial t}} = qE\left( t \right)V\left( t \right) - \frac{{\varepsilon \left( t \right) - {{\varepsilon }_{0}}}}{{{{\tau }_{\varepsilon }}(\varepsilon \left( t \right))}}. \\ \end{gathered} $Такая модель очень удобна возможностью привязки к расчетным или экспериментально определенным характеристикам материалов, а также тем что расчеты по ней очень хорошо согласуются с непосредственными расчетами методом Монте-Карло для GaAs, InP и сплавов на их основе [29, 37]. Здесь и далее q, V, m*, ε – заряд, скорость, усредненная эффективная масса и энергия электронов соответственно, E – напряженность продольного электрического поля, τp, τε – времена релаксации электронов по импульсу и энергии.
Введем вероятность нахождения электрона в соответствующем j-слое через поверхностную плотность электронов в нем:
(5)
${{p}_{j}} = \frac{{n_{s}^{j}}}{{{{n}_{s}}}},\,\,\,\,n_{s}^{j} = \int\limits_{{{X}_{{j - 1}}}}^{{{X}_{j}}} {\rho \left( x \right)dx} = \int\limits_{{{X}_{{j - 1}}}}^{{{X}_{j}}} {{{\rho }_{с}}\left( x \right)dx} + \int\limits_{{{X}_{{j - 1}}}}^{Xj} {\sum\limits_i {{{n}_{i}}{{{\left| {{{\Psi }_{i}}(x)} \right|}}^{2}}} dx} .$В выражениях (5): ns – полная поверхностная плотность свободных электронов. Для частоты рассеяния электронов ν во всех слоях структуры используем следующее простейшее приближение:
где νj – частота рассеяния в объемном материале соответствующего слоя “j”.Для двух слоев (узкозонный канал, и обрамляющие широкозонные слои из одинакового материала, которые заменяется одним эффективным слоем с соответствующей суммарной вероятностью нахождения электронов в нем) система уравнений с учетом вида времен релаксации (частот рассеяния) [29] принимает следующий вид:
(7)
$\frac{{\partial \left( {m{\text{*}}({\varepsilon })V} \right)}}{{\partial t}} = q\left( {E - \frac{{m{\text{*}}({\varepsilon })V\left( {m_{1}^{*}({\varepsilon }){{V}_{{S1}}}({\varepsilon }){{E}_{{S2}}}({\varepsilon }){{p}_{2}} + m_{2}^{*}({\varepsilon }){{V}_{{S2}}}({\varepsilon }){{E}_{{S1}}}({\varepsilon }){{p}_{1}}} \right)}}{{m_{1}^{*}({\varepsilon }){{V}_{{S1}}}({\varepsilon })m_{2}^{*}({\varepsilon }){{V}_{{S2}}}({\varepsilon })}}} \right),$(9)
${{V}_{S}}\left( \varepsilon \right) \equiv \frac{{m_{1}^{*}(\varepsilon ){{V}_{{S1}}}(\varepsilon )m_{2}^{*}(\varepsilon ){{V}_{{S2}}}(\varepsilon )}}{{\left( {m_{1}^{*}(\varepsilon ){{p}_{1}} + m_{2}^{*}(\varepsilon ){{p}_{2}}} \right)\left( {m_{1}^{*}(\varepsilon ){{V}_{{S1}}}(\varepsilon ){{p}_{2}} + m_{2}^{*}(\varepsilon ){{V}_{{S2}}}(\varepsilon ){{p}_{1}}} \right)}},$(10)
$m{\text{*}}\left( \varepsilon \right) = m_{1}^{*}({\varepsilon }){{p}_{1}} + m_{2}^{*}({\varepsilon }){{p}_{2}}.$Здесь Vsj(ε), Esj(ε) – статические зависимости дрейфовой скорости электронов и напряженности продольного электрического поля от энергии ε = ε(E). Эти зависимости извлекаются [29, 37] из результатов расчетов методом Монте-Карло [38] стационарных полевых зависимостей дрейфовой скорости Vsj(ε) и энергии εsj(E) для объемных материалов каждого слоя структуры с индексом “j”. Vs(ε) – статическая величина дрейфовой скорости электронов во всей структуре.
Эффективная масса электронов и частота их рассеяния зависят от вероятности их нахождения в каждом слое. Эта вероятность в свою очередь строго определяется из решения системы самосогласованных уравнений Шредингера и Пуассона и зависит от температуры электронов. Таким образом поперечный пространственный перенос электронов который в [33, 34] учитывался на основе уравнений сохранения энергии и импульса для двух ансамблей электронов и переходов между этими ансамблями здесь учитывается автоматически.
Необходимо сделать важную оговорку. Всплеск дрейфовой скорости может быть достаточно велик. В этих условиях необходимо учитывать, что энергия электронов (в приближении квазимаксвелловской функции распределения) представляется как сумма двух слагаемых: условно “тепловой энергии” и “кинетической энергии направленного движения”:
иначе температура электронов в расчетах (соответственно доля электронов в широкозонном материале, а значит и интенсивность рассеяния) может быть сильно завышена. Для исследованных далее структур это приводит к уменьшению всплеска дрейфовой скорости до 20%. В то же время в системе (4) наилучшее совпадение с расчетами методом Монте-Карло для материалов на основе GaAs, InP и InAs дает модель именно с полной энергией [30, 36].
В приведенной выше модели, при расчете зонной диаграммы предполагается, что практически все электроны находятся в Г – долина полупроводника. Однако при разогреве электронов как в квантовых ямах транзисторных гетероструктур так и в обрамляющих слоях в какой-то момент начинаются их переходы в верхние долины. При этом эффективная масса перешедших электронов резко возрастает, а температура на какое-то время падает. Кроме того, для электронов типичных транзисторных гетероструктур в L – долине рельеф дна зоны проводимости существенно меняется, и яма в узкозонном материале становится гораздо более мелкой. Не смотря на это, до какого-то момента (в не слишком сильных полях) тепловая энергия тяжелых электронов (электронов в L – долине) будет меньше разрыва зон по L – долине. Это должно приводить к тому, большая часть этих электронов, до того, как их температура сильно увеличится, должна локализоваться (по сути дела конденсироваться) в минимумах потенциала по L – долине, то есть в основном в узкозонном материале, где рассеяние существенно ниже чем в широкозонном. Как показывают оценочные расчеты [39], этот эффект должен особенно сильно проявляться в транзисторах с донорно-акцепторным легированием, однако сама его величина, по сравнению с величиной эффекта от введения донорно-акцепторного легирования невелика.
Данная модель легко обобщается на произвольное число разных слоев (в расчетах использовалось три типа слоев: слой узкозонного канала, сильно легированный широкозонный слой и слой нелегированного широкозонного спейсера). Из-за отсутствия надежных данных, проявления различных тонких эффектов [40], а главное простоты модели использовался упрощенный вариант задания параметров структур. При расчетах слой узкозонного канала задавался как GaAs без примеси индия. Для улучшения характеристик транзистора, в канале часто используют слой InxGa1– xAs с долей индия x ≈ 0.1–0.15. Предварительные расчеты показали, что замена GaAs на слой InxGa1– xAs со столь малой долей индия дает очень слабое увеличение амплитуды (всего лишь на 5%) и слабое сжатие распределения скорости дрейфа, что не позволяет делать какие-либо существенные выводы о работе транзистора в рамках предлагаемой модели. Поэтому при малом (<0.2) содержании In, cлой InxGa1– xAs канала характеризовался параметрами объемного нелегированного GaAs. Слои, обрамляющие канал, описывалось параметрами слоя Al0.3Ga0.7As с величинами перепада дна зоны проводимости на гетеропереходах равными 0.3 и 0.5 эВ – соответственно для слоев Al0.3Ga0.7As и In0.2Al0.8As.
При продольном дрейфе по каналу во внешнем поле энергия электронов под затвором транзистора возрастает, также возрастает и поперечная разность потенциалов между затвором и каналом (текущий потенциал канала). Для корректного учета этих эффектов необходимо построение более точной модели – модели полевого транзистора, однако для оценки динамики изменения дрейфовой скорости в различных типах структур и их перспективности достаточно учесть только первый эффект – без привязки к конструкции транзистора.
В простейшем приближении (полностью баллистический транспорт) можно также учесть и текущий потенциал канала, задавая отрицательное смещение на затворе, определяемое энергией электронов
Для описания динамики электронов при задаваемой во времени зависимости напряженности внешнего электрического поля E(t) все уравнения модели решаются самосогласованно.
Далее представлены результаты расчета V(t)- отклика дрейфовой скорости и вероятности нахождения электронов p в широкозонном слое (как сильнолегированном слое, так и в слое спейсера) на изменяемую во времени напряженность электрического поля. Задавалось, что в течение 0.2 пс электроны движутся при внешнем поле с напряженностью 1 кВ/см. Затем подается импульс поля амплитудой 20 кВ/см (примерно средняя величина поля под открытым затвором транзистора мм диапазона длин волн) длительностью 1 пс. Далее дрейф электронов продолжается в электрическом поле напряженностью 1 кВ/см. Предварительные расчеты показали, что форма зависимости V(t) сохраняется для всех типов рассмотренных структур при других сравнимых по величине амплитудах поля.
Построенная модель не учитывает эффекты, связанные с изменением интенсивности рассеяния за счет отличия волновых функций электронов от плоских волн (возрастания роли размерного квантования) и т.д. Соответственно в данном приближении наилучшую динамику электронов (максимальную величину всплеска дрейфовой скорости) в расчетах будут демонстрировать электроны движущиеся только по узкозонному материалу.
4. РЕЗУЛЬТАТЫ РАСЧЕТОВ
На рис. 3 приведены результаты упрощенных расчетов зависимости от времени всплеска дрейфовой скорости в структурах вида Al0.3Ga0.7As/GaAs при исходно задаваемой (а не вычисляемой) различной величине вероятности нахождения электронов в широкозонном слое Al0.3Ga0.7As.
Рис. 3.
Зависимость дрейфовой скорости электронов от времени, р – задаваемая вероятность нахождения электронов в слое Al0.3Ga0.7As: 1 – p = 0 (слой Al 0.3Ga0.7As отсутствует), 2 – p = 0.05, 3 – p = 0.1, 4 – p = 0.2, 5 – p = 0.7, 6 – p = 0.5, 7 – легированный Al0.3Ga0.7As Nd = 2 × 1018 см–3.
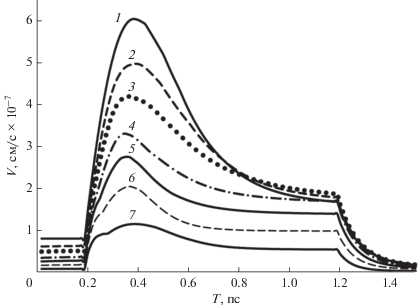
На рис. 3 обращает на себя внимание то, что даже при малой вероятности нахождения электронов в слое Al0.3Ga0.7As, всплеск дрейфовой скорости заметно падает. Так при 10% вероятности нахождения электронов в слое Al0.3Ga0.7As (зависимость 3 на рис. 3) величина всплеска уменьшается в 1.5 раза в сравнении со всплеском при нулевой вероятности (зависимость 1 на рис. 3).
На рис. 4 приведены зависимости от времени дрейфовой скорости электронов и вероятности нахождения электронов в широкозонном материале для трех типов классических HEMT структур (рис. 1) и структуры в DA-DpHEMT исполнении (рис. 2а).
Рис. 4.
Зависимость от времени: (а) – дрейфовой скорости электронов, (б) – вероятности их нахождения в широкозонном материале. Прямая pHEMT структура напряжение на затворе 1 – Ug = –0.5 В, 2 – Ug = 0, 3 – Ug = 0.5 В, 4 – DA-DpHEMT структура Ug = 0, 5 – DpHEMT структура Ug = 0, 6 – обращенная pHEMT структура Ug = 0.

В этих структурах задавалось: расстояние от затвора до канала 350 Å, толщины спейсеров 20 Å, ширина квантовой ямы канала в структурах с двусторонним легированием 170 Å. Классические HEMT структуры предполагались δ – легированными с поверхностной концентрацией доноров ns = 2 × 1012 см–2 в каждом δ-слое.
Для симметричных DA-DpHEMT структур с поверхностной плотностью акцепторов ps = 6 × × 1012 см–2, поверхностная плотность доноров в дельта слоях задавалась одинаковой и равной ns = = 8 × 1012 см–2 в каждом δ-слое. При этом задавалась такая же величина поверхностной плотности электронов в структуре ns = 4 × 1012 см–2, как и в случае безакцепторного легирования. Расстояние между δ-слоем доноров и соседним слоем акцепторов составляло 50 Å. Результаты расчетов при увеличении этого расстояния до 100 Å отличались незначительно – приобретенная энергия электронов для используемых амплитуд электрического поля остается меньше глубины КЯ в DA-DpHEMT структуре. Незначительно изменялись результаты для DA-DpHEMT структур и при изменении поверхностной плотности электронов в структуре в пределах (2–6) × 1012 см–2. По-видимому, это связано как с достаточно большой глубиной КЯ всей структуры, так и с тем, что в данной модели рассеяние на примеси описывается достаточно грубо – только параметрами слоя, сильно легированного широкозонного материала. Данный результат показывает возможность существенного (в 2 и более раз) увеличения поверхностной плотности электронов практически с сохранением величины и формы всплеска дрейфовой скорости, как следствие, возможность существенного увеличения удельной выходной мощности DA-DpHEMT полевых транзисторов.
Как и предполагалось, минимальный как по амплитуде, так и по длительности всплеск дрейфовой скорости наблюдался в обращенной гетероструктуре. В такой структуре около 70% электронов при разогреве в сильном электрическом поле переходят из канала в широкозонный слой Al0.3Ga0.7As рис. 4б. Таким образом, расчет показал, что в классических обращенных структурах средняя дрейфовая скорость под затвором транзисторов должна быть в разы меньше средней дрейфовой скорости в других типах структур. Это приводит к уменьшению максимальной частоты усиления по току ft и как следствие, уменьшает почти на порядок коэффициента усиления K, (K ~ $f_{t}^{{\text{2}}}$) и может объяснить многочисленные неудачи при работе с традиционным вариантом конструкции обращенных структур (рис. 1б).
По видам зависимостей V(t) следует отметить существенное количественное отличие между обращенной pHEMT структурой и DpHEMT структурой (структурой с двухсторонним обогащением канала электронами). При внешней схожести ситуаций (и там и там горячие электроны почти свободно уходят в сторону подложки), вероятность нахождения электронов в широкозонном материале обращенной структуры оказывается почти вдвое больше. Поэтому по величине всплеска, а значит и по средней дрейфовой скорости электронов под затвором, обращенная гетероструктура металл–In0.15Ga0.85As–Al0.3Ga0.7As намного хуже, чем обычная DpHEMT структура. По сути дела, из-за сильного поперечного пространственного переноса обращенная pHEMT структура металл–In0.15Ga0.85As–Al0.3Ga0.7As по всплеску дрейфовой скорости занимает промежуточное положение между прямой pHEMT структурой и объемным Al0.3Ga0.7As. Малость всплеска в обращенной структуре можно объяснить сужением квантовой ямы и подъемом квантовых уровней при увеличении обратного смещения на затворе, что дает усиление интенсивности поперечного переноса электронов из канала в широкозонный материал.
Наибольшую величину всплеска в рамках данной модели демонстрирует прямая pHEMT структура рис. 1а с односторонним относительно слоя канала легированием, особенно при увеличении обратного смещения на затворе. В других типах структур зависимость величины и формы всплеска от напряжения на затворе существенно меньше. Это вполне объяснимо, так как в прямой структуре с ростом прямого смещения на затворе квантовая яма расширяется, размерно-квантовые уровни опускаются, переход горячих электронов в широкозонный слой ослабевает. Поэтому вероятность их нахождения в слое Al0.3Ga0.7As оказывается очень низкой – заметно ниже, чем в других структурах.
В DpHEMT структурах мощных транзисторов с двусторонним, относительно слоя канала, легированием, введение в локализующих барьерах DA-легирования существенно увеличивает глубину КЯ структуры рис. 2а. Это усиливает локализацию электронов в канале и существенно увеличивает величину и длительность всплеска дрейфовой скорости, делая их существенно больше, чем в обычных (см. рис. 1в) DpHEMT структурах.
Сравнивая между собой различные гетероструктуры, надо учитывать, для какого типа транзисторов они предназначены. Малошумящие транзисторы обычно работают в условиях подачи на затвор относительно больших обратных смещений. Для такого режима работы характерен большой всплеск дрейфовой скорости. Для мощных полевых транзисторов все меняется. Преимущество прямых структур по всплеску дрейфовой при большом положительном потенциале на затворе, а именно этот режим определяет максимальный ток стока – одну из главных характеристик мощного транзистора, существенно скромнее: что-то среднее между всплеском в pHEMT и DA-DpHEMT структурах.
После впечатляющих экспериментальных результатов полученных на DA-DpHEMT структурах [9–12] в работе [14], было предложено локализовать электроны в In0.2Ga0.8As канале при сохранении достаточно широкой запрещенной зоны за счет использования гетеропары In0.2Al0.8As/In0.2Ga0.8As. Расчеты показали, что при прочих равных условиях (слабополевая подвижность в слое канала одинакова) в структуре In0.2Al0.8As–In0.2Ga0.8As–In0.2Al0.8As всплеск дрейфовой скорости оказывается гораздо больше, чем в обычном DpHEMT транзисторе, что напрямую связано с большим перепадом дна зоны проводимости на гетеропереходе (0.5 эВ, а не 0.3 эВ).
Эффективная высота барьеров на границах слоя канала (расстояние от уровня Ферми до вершины барьера на краях канала) за счет этого возрастает почти втрое. Однако, такого увеличения эффективной высоты барьера для хорошей локализации горячих электронов в слое канала оказывается все же недостаточно, поэтому длительность всплеска в структуре In0.2Al0.8As–In0.2Ga0.8As–In0.2Al0.8As оказывается меньше, чем в DA-DpHEMT структуре Al0.3Ga0.7As–In0.15Ga0.85As–Al0.3Ga0.7As, рис. 5а.
Рис. 5.
Зависимость от времени (а) дрейфовой скорости электронов (б) их вероятности нахождения в широкозонном материале: прямая структура напряжение на затворе 1 – In0.2Al0.8As–In0.2Ga0.8As–In0.2Al0.8As с DA – легированием Ug = 0, 2 – HEMT Ug = –0.5 В, 3 – DA-pHEMT Ug = 0, 4 – In0.2Al0.8As–In0.2Ga0.8As–In0.2Al0.8As Ug = 0, 5 – DpHEMT Ug = 0.
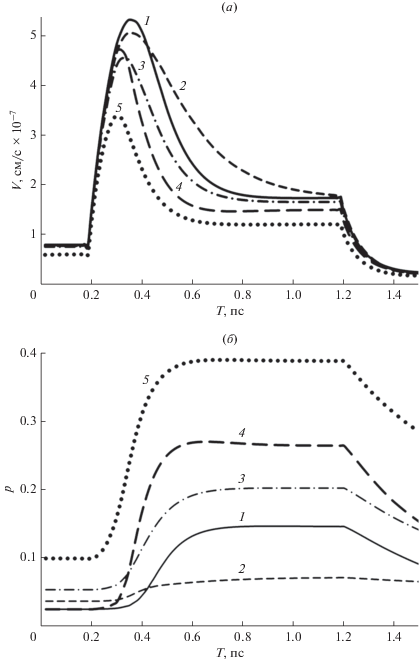
Самой эффективной по амплитуде и ширине всплеска оказалась структура металл–In0.2Al0.8As–In0.2Ga0.8As–In0.2Al0.8As с донорно-акцепторным (DA) легированием. В такой структуре всплеск оказывается практически таким же, как и в прямой структуре при обратном смещении на затворе, что соответствует близким вероятностям нахождения электронов в широкозонных слоях рис. 5б.
Видно, что как обычно в материалах со сходными характеристиками, наблюдается сильная корреляция между всплеском дрейфовой скорости электронов и ее статической зависимостью от поля, однако численные различия могут быть достаточно существенны. Следует отметить, что несмотря на простоту используемой модели, результаты сравнения расчетов дрейфовой скорости в DA-DpHEMT и DpHEMT структурах рис. 6 неплохо коррелируют с данными непосредственных измерений дрейфовой скорости [41], показавшими увеличение дрейфовой скорости электронов в DA-DpHEMT структурах на 20–30%. В то же время, как неоднократно отмечалось [29–31], средняя скорость электронов под субмикронным затвором транзистора во многом определяется не только величиной всплеска дрейфовой скорости, но и его длительностью, которая в структурах с донорно-акцепторным легированием почти вдвое больше чем в обычных DpHEMT структурах с донорным легированием. Поэтому оценка роста средней дрейфовой скорости электроном под затвором транзистора по проведенным расчетам оказывается ближе к экспериментальным результатам работы [11], где увеличение средней дрейфовой скорости электронов оценивалось в 1.4–1.6 раза, что еще раз демонстрирует для таких приборов важность анализа именно нелокального разогрева электронов.
Рис. 6.
Зависимость дрейфовой скорости электронов от напряженности электрического поля. 1 – объемный нелегированный GaAs, 2 – In0.2Al0.8As–In0.2Ga0.8As–In0.2Al0.8As с донорно-акцепторным легированием, 3 – HEMT Ug = –0.5 В, 4 – DA-pHEMT, 5 – In0.2Al0.8As–In0.2Ga0.8As–In0.2Al0.8As, 6 – DpHEMT Ug = 0, 7 – объемный легированный Al0.3Ga0.7As.
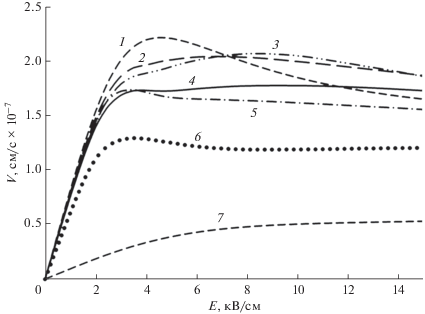
Если в DpHEMT структурах введение донорно-акцепторного легирования существенно, примерно в 1.5 раза, увеличивает среднюю дрейфовую скорость электронов под затвором транзистора, то в обращенных структурах происходит качественное улучшение.
Как отмечалось выше, по величине всплеска обращенная гетероструктура металл–In0.15Ga0.85As–Al0.3Ga0.7As оказывается намного хуже, чем прямая pHEMT структура с контактом Шоттки. По-видимому, это как раз и связано с сужением квантовой ямы и подъемом уровней в ней при увеличении обратного смещения на затворе и интенсивным переходом электронов из канала в широкозонный слой.
Для структуры металл–In0.2Ga0.8As–In0.2Al0.8As (см. рис. 7) картина несколько другая – из-за большего перепада дна зоны проводимости на гетерограницах слоя канала, всплеск дрейфовой скорости электронов довольно велик и даже несколько больше, чем в DpHEMT структуре, но происходит на меньших временах. Такая обращенная структура по всплеску стала ближе к прямой структуре pHEMT транзистора.
Рис. 7.
Зависимость от времени (а) дрейфовой скорости электронов (б), их вероятности нахождения в широкозонном материале: 1 – металл–In0.2Ga0.8As–In0.2Al0.8As с донорно-акцепторным легированием, 2 – металл–GaAs–Al0.3Ga0.7As с донорно-акцепторным легированием, 3 – металл–In0.2Al0.8As–In0.2Ga0.8As–In0.2Al0.8As, 4 – DpHEMT Ug = 0, 5 – металл–GaAs–Al0.3Ga0.7As.
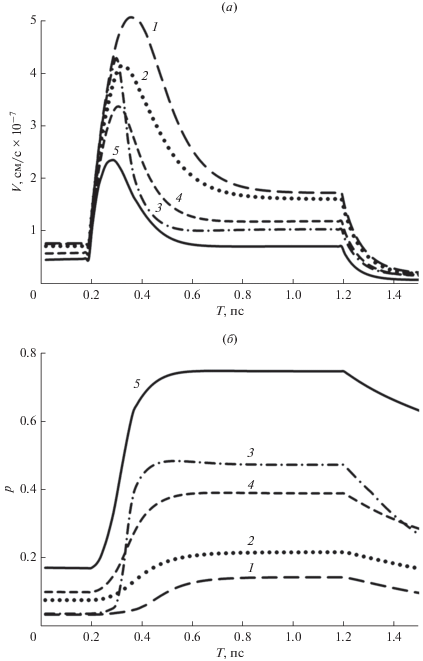
В обращенной гетероструктуре с донорно-акцепторным легированием, формирующим дополнительный pin – потенциальный барьер со стороны подложки, поперечный пространственный перенос из канала подавлен. В результате этого в широкозонном слое оказывается менее 30% электронов, а всплеск дрейфовой скорости оказывается близок по величине к всплеску дрейфовой скорости в DA-DpHEMT структуре. Таким образом, средняя дрейфовая скорость меняется в несколько раз. Крайне эффективным оказывается и введение pin – потенциального барьера со стороны подложки и в структуре металл–In0.2Ga0.8As–In0.2Al0.8As. В этом случае в широкозонный материал переходит менее 15% электронов (зависимость 1 на рис. 7), а величина всплеска оказывается практически такой же, как и в соответствующей DA-DpHEMT структуре.
Проведенные расчеты позволили обнаружить одно интересное свойство обращенных гетероструктур – несмотря на сильную зависимость ширины квантовой ямы от напряжения на затворе, всплеск дрейфовой скорости от него зависит слабо. Это характерно как для обычных pHEMT структур (рис. 1б), так и для DA-pHEMT структур с дополнительными барьерами, усиливающими локализацию электронов в слое канала (рис. 2б).
То есть получается, что обычная обращенная структура рис. 1б настолько неудачна (слишком много горячих электронов переносится в широкозонный материал), что режим работы на нее почти не влияет. В свою очередь, обращенная структура с дополнительными барьерами настолько хороша (так мало электронов выходит из слоя канала) что и ее работа (по расчетам в данном приближении) тоже почти не зависит от напряжения на затворе.
Таким образом, обращенные гетероструктуры c дополнительным pin-барьером со стороны подложки и с широкозонной вставкой AlAs между затвором и каналом сохраняют такие полезные особенности, как увеличение крутизны за счет близости канала к затвору [13, 42] и определенное улучшение линейности передаточной характеристики при достаточно высоких напряжениях на затворе. Для таких структур характерны: квантовая яма, сужающаяся с повышением обратного смещения на затворе, большое расстояние между подзонами размерного квантования (в разы больше энергии оптического фонона), всплеск дрейфовой скорости электронов, близкий к величинам, характерным для DA-DpHEMT гетероструктур на соответствующих материалах.
Как отмечалось выше, использование донорно-акцепторного легирования наиболее эффективно в структурах для мощных полевых транзисторов, и в условиях, когда нет дополнительных существенных механизмов, влияющих на работу прибора. Для малошумящих транзисторов наиболее эффективной, по всей видимости, останется традиционная прямая гетероструктура с односторонним легированием. С другой стороны, в сантиметровом и в длинноволновой части миллиметрового диапазона длин волн для мощных полевых транзисторов более эффективным выглядит использование структур с двухсторонним легированием, а не обращенных. Однако, в миллиметровом диапазоне длин волн, где длина затвора транзистора становится менее 0.1 мкм, усиливается влияние краевых и других двумерных эффектов. Там, для транзисторов средней мощности необходимость увеличения крутизны для уменьшения влияния паразитных элементов, а также необходимость эффективного перекрытия канала с горячими электронами и т.д. обращенная гетероструктура с донорно-акцепторным легированием может стать весьма перспективной, особенно с учетом возможности уменьшения вероятности рассеяния электронов за счет квантовых эффектов. В принципе, это создает возможность впервые реализовать эффективные полевые СВЧ транзисторы на работу, которых может существенно сказываться квантование электронных уровней в канале.
Ранее отмечалось [10], что высокочастотные характеристики DA-DpHEMT могут быть близки к характеристикам метаморфных (mHEMT) полевых транзисторов и транзисторов на подложках на основе фосфида индия и это, в определенной мере, подтверждается расчетами по разработанной модели. На рис. 8 приведен отклик дрейфовой скорости электронов на импульс внешнего электрического поля для mHEMT структур на основе гетеропереходов In0.53Ga0.47As–In05.2Al0.48As с двусторонним легированием слоя In05.2Al0.48As.
Рис. 8.
Зависимость от времени дрейфовой скорости электронов: 1 – объемный нелегированный In0.53Ga0.47As, 2 – металл–In0.52Al0.48As–In0.53Ga0.47As–In0.52Al0.48As с донорно-акцепторным легированием, 3 – металл–In0.52Al0.48As–In0.53Ga0.47As–In0.52Al0.48As, 4 – металл–In0.2Al0.8As–In0.2Ga0.8As–In0.2Al0.8As с донорно-акцепторным легированием, 5 – DA-pHEMT, 6 – DpHEMT Ug = 0.

Из рис. 8 видно, что из-за заметно отличающихся характеристик узкозонного слоя In0.53Ga0.47As, всплеск в таких структурах заметно больше чем в структурах с высоким содержанием GaAs. Если сравнивать между собой двусторонне легированные DmHEMT структуры с гетеропереходами In0.53Ga0.47As–In05.2Al0.48As и DpHEMT структуры с гетеропереходами GaAs–Al0.3Ga0.7As, то средняя дрейфовая скорость в приборе на основе DmHEMT структуры будет почти в 2 раза выше. С другой стороны, хотя всплеск дрейфовой скорости в DmHEMT структуре, почти в полтора раза больше, чем в структуре DA-pHEMT транзистора, но он заметно короче. Следовательно, можно ожидать, что средние дрейфовые скорости под затвором будут отличаться не слишком сильно. Учитывая, что в DA-pHEMT структурах можно увеличить содержание индия в слое канала, эти скорости могут оказаться даже близкими по величине. Возможно в приборах на основе DA-pHEMT гетероструктур с гетеропереходами In0.2Ga0.8As–In0.2Al0.8As средняя дрейфовая скорость даже может превысить соответствующую величину в DmHEMT структурах с гетеропереходами In0.53Ga0.47As–In05.2Al0.48As. В тоже время, как и следовало ожидать, (см. рис. 8) применение донорно-акцепторного легирования для структур на основе In0.53Ga0.47As–In05.2Al0.48As также должно приводить к росту средней дрейфовой скорости примерно в полтора раза, делая их в плане быстродействия вообще самыми перспективными из всех рассмотренных. Как отмечалось выше, для корректных численных оценок необходима не просто разработанная модель расчета дрейфовой скорости электронов в заданном электрическом поле, а полная модель транзистора со сравнимым уровнем точности описания динамики электронов.
5. ЗАКЛЮЧЕНИЕ
На основе теоретических оценок показано, что донорно-акцепторное легирование увеличивает в несколько раз среднюю дрейфовую скорость электронов в обращенных гетероструктурах и примерно в 1.5 раза – в транзисторных гетероструктурах на основе гетеропереходов InxGa1 – xAs–AlyGa1 – yAs и InxGa1 – xAs–InyAl1 – yAs с двусторонним легированием. При этом поверхностную плотность электронов в структурах с двухсторонним легированием без существенного уменьшения всплеска дрейфовой скорости электронов можно увеличить более, чем вдвое. Таким образом, донорно-акцепторное легирование оказывается эффективным способом создания дополнительных потенциальных барьеров в различных видах транзисторных гетероструктур с селективным легированием, усиливающим локализацию горячих электронов в канале полевых транзисторов и увеличивающим их поверхностную плотность.
Список литературы
Dingle R., Stormer H.L., Gossard A.C., Wigman W. Electron Mobilities in Modulated – Doped Semiconductors Heterojunction Superlaties // Appl. Phys. Letters. 1978. V. 33. № 7. P. 665–667.
Stormer H.L., Dingle R., Gossard A.C., Wiegmann W., Sturge M.D. Two-Dimensional Electron Gas at Semiconductor – Semiconductor Interface // Solid State Communication. 1978. V. 29. № 10. P. 705–709.
Андо Т., Фаулер А., Стерн Ф. Электронные свойства двумерных систем. М.: “Мир”, 1985. 416 с.
Кальфа А.А., Пашковский А.Б. Двумерный электронный газ в пространственно неоднородной потенциальной яме // Физика и техника полупроводников. 1988. Т. 22. № 11. С. 2090–2092.
Mei X., Yoshida W., Lange M., Lee J., Zhou J., Liu P.H., Leong K., Zamora A., Padilla J., Sarkozy S., Lai R., Deal W.R. First Demonstration of Amplification at 1 THz Using 25-nm InP High Electron Mobility Transistor Process // IEEE Electron Device Letters. 2015. V. 36. № 4. P. 327–329.
Moschetti G., Leuther A., Maßler H., Aja B., Rösch M., Schlechtweg M., Ambacher O., Kangas V., Geneviève-Perichaud M. A 183 GHz Metamorphic HEMT Low-Noise Amplifier With 3.5 dB Noise Figure // IEEE Microwave and Wireless Components Letters. 2015. V. 25. № 9. P. 618–620.
Amado-Rey B., Campos-Roca Y., Friesicke C., Tessmann A., Lozar R., Wagner S., Leuther A., Schlechtweg M., Ambacher O. A 280 GHz stacked-FET power amplifier cell using 50 nm metamorphic HEMT technology // 11th European Microwave Integrated Circuits Conference (EuMIC). 2016. P. 189–192.
Пашковский А.Б. Оценка влияния полупроводниковой структуры на шумовые характеристики гетероструктурных полевых транзисторов // Микроэлектроника. 1993. Т. 22. № 5. С. 26–32.
Лукашин В.М., Пашковский А.Б., Журавлев К.С., Торопов А.И., Лапин В.Г., Соколов А.Б. Уменьшение роли поперечного пространственного переноса электронов и рост выходной мощности гетероструктурных полевых транзисторов // Письма в ЖТФ. 2012. Т. 38. № 17. С. 84–89.
Лукашин В.М., Пашковский А.Б., Журавлев К.С., Торопов А.И., Лапин В.Г., Голант Е.И., Капралова А.А. Перспективы развития мощных полевых транзисторов на гетероструктурах с донорно-акцепторным легированием // Физика и техника полупроводников. 2014. Т. 48. № 5. С. 684–692.
Борисов А.А., Зырин С.С., Лапин В.Г., Лукашин В.М., Маковецкая A.A., Новоселец В.И., Пашковский А.Б., Урсуляк Н.Д., Щербаков С.В., Журавлев К.С., Торопов А.И. Анализ малосигнальных СВЧ-характеристик DA-рНЕМТ // Электронная техника, Сер. 1, СВЧ-техника. 2016. В. 1(528). С. 65–69.
Zhuravlev K.S., Protasov D.Yu., Gulyaev D.V., Bakarov A.K., Toropov A.I., Lapin V.G., Lukashin V.M., Pashkovskii A.B. Advances in Microelectronics: Reviews, Editor Sergey Y. Yurish. “New Heterostructures for Higer Power Microwave DA-pHEMTs”, 2019. V. 2. Chapter 8. P. 251–287.
Пашковский А.Б., Новиков С.И., Лапин В.Г., Лукашин В.М. Двумерный электронный газ в обращенных гетероструктурах с донорно-акцепторным легированием // Письма в ЖТФ. 2017. Т. 43. № 12. С. 42–51.
Васильевский И.С., Виниченко А.Н., Каргин Н.И. Электронные транспортные свойства и морфология структур с метаморфной квантовой ямой In0.2Al0.8As/In0.2Ga0.8As // 8-я Международная научно-практическая конференция по физике и технологии наногетероструктурной СВЧ-электроники. Мокеровские чтения. 24.05.2017. Тез. докладов. С. 28–29.
Тагер А.С., Кальфа А.А. А.С. 897062 (СССР). Полевой транзистор. Приоритет от 0.3.09.1980.
Кальфа А.А., Тагер А.С. Гетероструктуры с селективным легированием и их применение в полевых транзисторах СВЧ // Электронная техника, Сер. 1, Электроника СВЧ. 1980. В. 12(348). С. 26–38.
Mimura T., Hiyamizi S., Fuji T., Numbu K. A New Field-Effect Transistor with Selectively Doped GaAs/n–AlxGa1 – xAs Heterostructures // Jap. J. Appl. Phys. 1980. V. 19. № 5. P. L225–L227.
Mimura T., Hiyamizi S., Hashimoto H., Fukuta M. High – Electron Mobility Transistors with Selectively Doped GaAs/n-AlGaAs Heterojunction // IEEE Trans. on Electron Dev., 1980. V. ED-27. № 11. P. 2197.
Delagebeaudeuf D., Delescluse P., Etinne P., Laviron M., Chaplart J., Linh N.T. Two – Dimensional Electron GaAs MESFET Inversion Channels Structure // Electron Lett. 1980. № 17. P. 667–668.
Delagebeaudeuf D., Linch N.T. Chage Charge Control of the Heterojunction Two Dimensional Electron Gas for MESFET Application // IEEE Trans. on Electron Dev. 1981. V. ED-28. № 7. P. 790–795.
Галиев Г.Б., Васильевский И.С., Климов Е.А., Клочков А.Н., Лаврухин Д.В., Пушкарев С.С., Мальцев П.П. Особенности фотолюминесценции HEMT-наногетероструктур с составной квантовой ямой InAlAs/InGaAs/InAs/InGaAs/InAlAs // Физика и техника полупроводников. 2015. Т. 49. № 2. С. 241–248.
Шиленас А., Пожела Ю., Пожела К., Юцене В., Васильевский И.С., Галиев Г.Б., Пушкарев С.C., Климов Е.А. Максимальная дрейфовая скорость электронов в селективно легированных гетероструктурах InAlAs/InGaAs/InAlAs с введенной InAs-вставкой // Физика и техника полупроводников. 2013. Т. 47. № 3. С. 348–352.
Nicolas C., Cirillo Jr., Shur M.S., Jonatan K.A. Inverted GaAs/AlGaAs Modulation – Doped Field-Effect Transistors with Extremely High Transconductances // IEEE Electron Dev. Lett. 1986. V. EDL-7. № 2. P. 71–74.
Крещук A.M., Лаурс Е.П., Новиков С.В., Савельев И.Г., Семашко Е.М., Стовповой М.А., Шик А.Я. Инвертированная гетероструктура InP/In0.53Ga0.47As для полевого транзистора // Физика и техника полупроводников. 1990. Т. 24. № 6. С. 1145–1147.
Glisson T.H., Hauser J.R., Littlejohn M. Monte Carlo simulation of real-space electron transfer in GaAs–AlGaAs heterostructures // J. Appl. Phys., 1980. V. 51. № 10. P. 5445–5449.
Sakamoto R., Akai K., Inoue M. Real-Space Transfer and Hot-Electron Transport Properties in III–V Semiconductor Heterostructures // IEEE Trans. on Electron Dev. 1989 V. 36. № 10. P. 2344.
Kobayashi E., Hamaguchi C., Matsuoka T., Taniguchi K. Monte Carlo Study of Hot-Electron Transport in an InGaAs/InAlAs Single Heterostructure // IEEE Trans. on Electron Dev., 1989. V. 36. № 10. P. 2353–2360.
Банов Н.А., Рыжий В.И. Численное моделирование нестационарных кинетических процессов в субмикронных полевых транзисторах с затвором Шоттки // Микроэлектроника. 1986. Т. 15. № 6. С. 490–501.
Shur M. Influence of Nonuniform Field Distribution on Frequency Limits of GaAs Field-Effect Transistors // Electronics Letters. 1976. V. 12. № 23. P. 615–616.
Cappy A., Carnez B., Fauquembergues R., Salmer G., Constant E. Comparative Potential Performance of Si, GaAs, GaInAs, InAs Submicrometer-Gate FET,s // IEEE Trans. Electron. Dev. 1980. V. 27. № 11. P. 2158–2160.
Foutz B.E., O’Leary S.K., Shur M.S., Eastman L.F. Transient electron transport in wurtzite GaN, InN, and AlN // J. Appl. Phys., 1999. V. 85. № 11. P. 7727–7734.
Пашковский А.Б., Новиков С.И., Лапин В.Г., Лукашин В.М., Мартынов Я.Б. Особенности всплеска дрейфовой скорости электронов в DA-pHEMT // Письма в ЖТФ. 2018. Т. 44. № 17. С. 103–110.
Кальфа А.А., Пашковский А.Б. Пространственный перенос двумерных электронов в структуре металл–AlxGa1 – xAs-GaAs с селективным легированием // Физика и техника полупроводников. 1990. Т. 24. № 3. С. 521–526.
Кальфа А.А., Пашковский А.Б., Тагер А.С. Влияние поперечного пространственного переноса электронов на высокочастотные характеристики гетероструктурных полевых транзисторов с селективным легированием // Микроэлектроника. 1991. Т. 20. № 4. С. 383–391.
Харрисон У. Электронная структура и свойства твердых тел. Физика химической связи: пер. с англ. М.: Мир. 1983. Т. 2. 332 с.
Фистуль В.И. Сильно легированные полупроводники. М.: Издательство “Наука”, 1967. 415 с.
Шур М. Современные приборы на основе арсенида галлия. М.: Мир, 1991. С. 56.
Гарматин А.В. Программа моделирования методом Монте-Карло нестационарных процессов разогрева электронов электрическим полем в полупроводниках // Электронная техника, Сер. 1. Электроника СВЧ. 1985. № 3(377). С. 66.
Пашковский А.Б., Богданов С.А. Локализация электронов верхних долин в узкозонном канале – возможный дополнительный механизм увеличения тока в DA-DpHEMT // Письма в ЖТФ. 2019. Т. 45. № 20. С. 11–14.
Сафонов Д.А., Виниченко А.Н., Каргин Н.И., Васильевский И.С. Эффективная масса и время релаксации импульса электронов в односторонне delta-легированных PHEMT квантовых ямах AlGaAs/ InGaAs/GaAs с высокой электронной плотностью // Письма в ЖТФ. 2018. Т. 44. № 7. С. 120–127.
Протасов Д.Ю., Гуляев Д.В., Бакаров А.К., Торопов А.И., Ерофеев Е.В., Журавлев К.С. Увеличение насыщенной скорости дрейфа электронов в pHEMT-гетероструктурах с донорно-акцепторным легированием // Письма в ЖТФ. 2018. Т. 44. № 6. С. 77–84.
Богданов Ю.М., Пашковский А.Б., Тагер А.С. Полевые транзисторы с низкой модуляционной чувствительностью для малошумящих СВЧ устройств // Радиотехника и Электроника. 1993. Т. 33. № 2. С. 346–355.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника



