Микроэлектроника, 2020, T. 49, № 3, стр. 198-209
Особенности применения реактивного ионного травления кварца при изготовлении маятниковых узлов Q-flex акселерометров
М. С. Харламов a, *, О. С. Гусева a, **, С. Ф. Коновалов a
a Акционерное общество “Российская корпорация ракетно-космического приборостроения и информационных систем” (АО “Российские космические системы”)
111250 Москва, ул. Авиамоторная, 53, Россия
* E-mail: kharlamov.ms@spacecorp.ru
** E-mail: guseva.o.s@list.ru
Поступила в редакцию 09.07.2019
После доработки 10.10.2019
Принята к публикации 18.10.2019
Аннотация
Представлены особенности применения сквозного реактивного ионного травления кварцевых мембран толщиной от 20 мкм в технологии группового изготовления маятниковых узлов Q-flex акселерометров. Проведен сравнительный анализ тонкопленочного маскирующего материала (алюминий, хром, титан, медь, никель) для сквозного реактивного ионного травления кварца по параметрам селективности и вносимых в мембрану температурных напряжений. Рассмотрен механизм взаимодействия медной маски с фторсодержащей плазмой, а именно образование фторидов меди на маскирующей поверхности и последующее увеличение общей толщины маски с длительностью травления. Выявлен эффект локального увеличения скорости травления кварца в области термонапряжений мембраны вблизи маскирующего металлического рисунка. Для исследования эффекта разработан метод декорирования кварцевой поверхности микроиглами с помощью режима травления с повышенным напряжением смещения.
ВВЕДЕНИЕ
Плавленый аморфный кварц является распространенным и перспективным конструкционным материалом при изготовлении различных элементов устройств микросистемной техники, таких как микрофлюидные чипы, а также чувствительные элементы высокоточных датчиков инерции: акселерометров типа Q-flex и твердотельных волновых гироскопов. Традиционные методы объемной микрообработки кварца имеют различные технологические проблемы: механическая обработка приводит к образованию дефектов и напряженных слоев в кварце, а жидкостное химическое травление формирует изотропный профиль, дает значительные подтравы и вносит относительно большую погрешность размеров. Применение технологии микроэлектромеханических систем (МЭМС) для объемной микрообработки кварца, к которым относятся нанесение тонких маскирующих пленок, фотолитография, плазменное травление через селективную маску и прочее, значительно повышает технологичность и точность изготовления микроструктур в кварце, и, следовательно, увеличивает точность и воспроизводимость их выходных параметров, а также снижает стоимость приборов в целом благодаря групповой технологии. В работе [1] приводится пример применения плазменного травления кварца при изготовлении маятниковых узлов (МУ) Q-flex акселерометров (рис. 1), а авторы [2] разработали групповой способ формирования МУ в кварцевых пластинах диаметром 100 мм и выше с использованием жидкостного химического травления (ЖХТ) и последующего сквозного реактивного ионного травления (РИТ) для формирования упругих перемычек подвеса и высвобождения элементов. К преимуществам данной технологии можно отнести относительно высокую точность (погрешность порядка микрона) формирования вертикальных стенок с контролируемым подтравом, что особенно важно при формировании центрального технологического отверстия и внешнего установочного диаметра МУ, а также дает возможность создавать переходы проводников по торцевой поверхности методом двустороннего магнетронного напыления металла.
Рис. 1.
Конструктивная схема компенсационного Q-flex акселерометра (а) и фотография кварцевого МУ, полученного методами жидкостного и плазменного травления (б): 1 – лопасть маятника; 2 – упругая перемычка подвеса маятника; 3, 8 – магнитная система; 4 – катушка датчика силы; 5 – кольцо МУ с установочными платиками; 6 – полюсный наконечник; 7 – постоянный магнит [3].
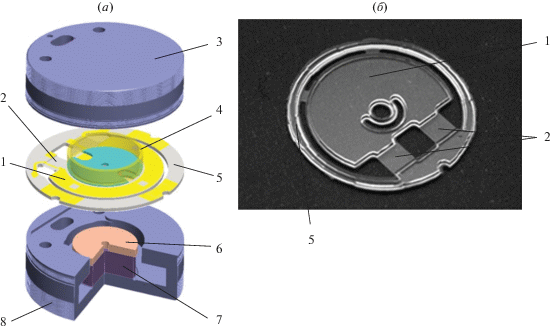
Основной целью данной работы стала разработка режима и анализ особенностей сквозного РИТ кварцевых мембран толщиной от 20 мкм для изготовления кварцевых МУ акселерометров типа Q-flex. При этом решались следующие задачи: подбор материала маскирующего рисунка путем экспериментального сравнения селективности и моделирования вносимых в кварцевую мембрану термодеформаций; исследование влияния локальных напряжений кварцевой мембраны на скорость травления с использованием метода декорирования вытравливаемой поверхности микроиглами с помощью режима травления с повышенным напряжением смещения.
ОПИСАНИЕ ЭКСПЕРИМЕНТА
Для экспериментов использовались кварцевые пластины диаметром 100 мм, толщиной 0.6 мм, чистотой 99.999% и с допуском на не плоскостность 2 мкм. На пластинах с помощью фотолитографии и ЖХТ формировался двусторонний рисунок из селективной маски, использующийся в технологии изготовления МУ согласно [2], а затем через него в растворе плавиковой кислоты вытравливались мембраны толщиной 20 мкм и более. Для дальнейшей отработки РИТ использовалась установка с источником индуктивно-связанной плазмы, вакуумной системой, включающей в себя двухступенчатую откачку (механическим и турбомолекулярным насосом), и охлаждаемым подложкодержателем. Подложки обрабатывались в среде фторсодержащего газа (SF6 или CF4) с добавлением аргона. В ходе отработки режима была достигнута скорость травления кварца около 0.6 мкм/мин с формированием вертикальных стенок (наклон около 89°) при следующих параметрах процесса: давление в камере – 4 Па, расход SF6 – 52 см3/мин, расход Ar – 36 см3/мин, высокочастотная мощность – 200 Вт. Подробное описание особенностей подбора режима РИТ кварца описываются в работе [4]. Далее в статье режим с приведенными выше параметрами называется рабочим. Контроль травления и исследование получаемых структур проводились с использованием оптической и сканирующей электронной микроскопии (СЭМ), зондовой и конфокальной профилометрии, энергодисперсионной спектрометрии (ЭДС), четырехзондового метода измерения удельного сопротивления тонких пленок, атомно-силовой микроскопии (АСМ).
ОСОБЕННОСТИ ВЫБОРА МАСКИ ДЛЯ РЕАКТИВНОГО ИОННОГО ТРАВЛЕНИЯ
Основным ограничивающим фактором для сквозного РИТ кварцевых мембран толщиной свыше 20 мкм является селективность маскирующего материала. Известно [5–8], что высокой стойкостью к фторсодержащей плазме обладают металлы. Было проведено экспериментальное сравнение селективности различных металлических масок, нанесенных магнетронным напылением: титан, хром, алюминий, никель и медь. Рисунок маски формировался с помощью фотолитографии по шаблону, соответствующему конструкции МУ с общей открытой площадью до 15%, и последующего ЖХТ металла. Для контроля результатов после каждого цикла РИТ длительностью 5 минут проводилось измерение толщины металлической пленки и глубины вытравленной канавы с помощью зондовой профилометрии, конфокальной профилометрии и измерения удельного сопротивления тонких металлических пленок [9], а также спектральный анализ и исследование морфологии поверхностей и профиля скола на СЭМ со встроенным спектрометром. В табл. 1 приведены данные экспериментального сравнения селективности различных металлов к кварцу при травлении в рабочем режиме, а также минимальные требуемые толщины пленок металлов для формирования в кварцевой мембране толщиной 20 мкм сквозных отверстий и основные характеристики материалов. Значения минимальной толщины маски выбраны с учетом того, что на вертикальных поверхностях ступеней в кварце толщина металла после магнетронного напыления примерно в три раза меньше, чем на планарных поверхностях.
Таблица 1.
Результаты экспериментального исследования селективности различных металлов для РИТ в рабочем режиме; данные, используемые для моделирования деформации кварцевой мембраны с маскирующими рисунками различных металлов
| Маска | Ti | Cr | Al | Ni | Cu | Кварц |
|---|---|---|---|---|---|---|
| Селективность, кварц/металл | 6/1 | 20/1 | 15/1 | 125/1 | 20/1 | – |
| Минимальная толщина для травления 20 мкм кварца, мкм | 10 | 3 | 4 | 0.48 | 3 | 20 |
| ТКЛР, 10–6 × 1/К | 8.6 | 4.9 | 23.1 | 13.4 | 16.5 | 0.55 |
| Плотность, кг/м3 | 4506 | 7150 | 2700 | 8900 | 8960 | 2200 |
| Модуль Юнга, ГПа | 115.7 | 279 | 70 | 219 | 120 | 71.4 |
| Коэффициент Пуассона, 1 | 0.321 | 0.21 | 0.35 | 0.31 | 0.34 | 0.17 |
| Предел текучести, МПа | 280 | 300 | 120 | 120 | 240 | – |
Помимо селективности при выборе материала маски важным критерием является наличие температурных напряжений в мембране, создаваемых металлом защитной маски. Напряжения в кварцевой мембране с маскирующим рисунком возникают при переходе от температуры напыления металла (до 150°С) до комнатной температуры вследствие разницы ТКЛР кварца и металла защитной маски. Эти напряжения не снимаются отжигом и, в случае приближения к пределу прочности кварца, приводят к появлению трещин в кварцевой мембране, что недопустимо в области упругих перемычек подвеса маятникового узла. Абсолютные значения вносимых в мембрану напряжений зависят от толщины маскирующей пленки, а также таких параметров металла, как ТКЛР, модуль Юнга и прочих, указанных в табл. 1. Для количественного сравнения деформации упругих перемычек с различными масками было проведено конечно-элементное моделирование (рис. 2). Моделировался температурный переход участка кварцевой мембраны толщиной 20 мкм с рисунком маски из представленных металлов, имеющих толщину и параметры материалов согласно табл. 1, от температуры напыления (нулевая деформация) до комнатной температуры, с учетом пластической деформации металла и без учета зависимости параметров материалов от температуры. На рис. 2б представлена абсолютная деформация профиля поперечного сечения кварцевой упругой перемычки маятника для различных металлов. Согласно рис. 2б, наибольшую деформацию мембрана испытывает с титановой маской, причем напряжения в кварце в этих случаях могут достигать предела прочности (55 МПа), что делает этот металл не пригодным для сквозного травления кварцевых мембран толщиной от 20 мкм.
Рис. 2.
Результат моделирования деформации кварцевой упругой перемычки с различными маскирующими металлами (выбрана минимальная толщина металла для РИТ кварца на глубину 20 мкм); (а) фрагмент деформированной мембраны (лицевая сторона пластины с титановой маской – сверху) с коэффициентом деформации ×30; (б) график абсолютной деформации профиля поперечного сечения кварцевой упругой перемычки с различными металлами (сечение проходит через область максимальной деформации).
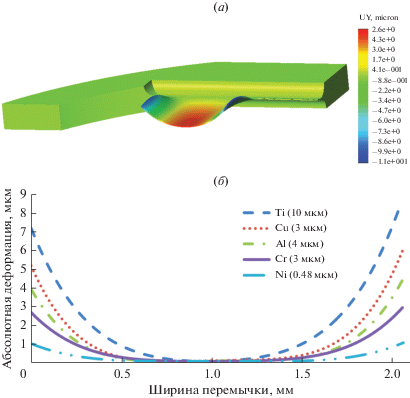
Пленки хрома и алюминия имеют высокую селективность и, согласно модели, приводят к значительно меньшим деформациям мембраны по сравнению с медью и титаном. Однако, из-за низкой скорости распыления этих металлов, при длительном процессе напыления постепенный разогрев подложки будет приводить к росту напряжений в металлической пленке и кварцевой мембране, что не учитывалось в вышеописанной модели.
Наименьшую деформацию кварцевая мембрана испытывает при использовании никелевой маски. Это обусловлено высокой селективностью никеля и, следовательно, наименьшей необходимой толщиной маскирующей пленки (0.48 мкм). Однако, при исследовании влияния никелевой маски на процесс травления в рабочем режиме наблюдалось значительное падение скорости травления кварца с ростом глубины вытравливаемой структуры. Этот процесс сопровождался увеличением шероховатости дна открытой поверхности кварца с последующим образованием микроигл (эффект “травы”). Предположительно, изменение морфологии кварца связано с микромаскированием [4, 10, 11] открытой поверхности перераспыляемыми элементами маски, замедляющим травление. Таким образом, для сквозного травления кварцевой мембраны толщиной от 20 мкм через никелевую маску основным ограничивающим фактором является уменьшение скорости травления кварца вплоть до полной остановки с ростом глубины из-за микромаскирования и образования микроигл. Как пример, при травлении кварцевой мембраны толщиной 35 мкм в рабочем режиме, рост шероховатости кварца наблюдался при уходе на глубину от 7 мкм, а полная остановка травления произошла при высоте игл 18.2 мкм (рис. 3) и остаточной толщине мембраны около 10 мкм.
Рис. 3.
СЭМ изображения профилей сечения дна кварцевой поверхности с микроиглами при травлении с никелевой маской в рабочем режиме (а) после 40 мин травления; (б) после полной остановки травления.
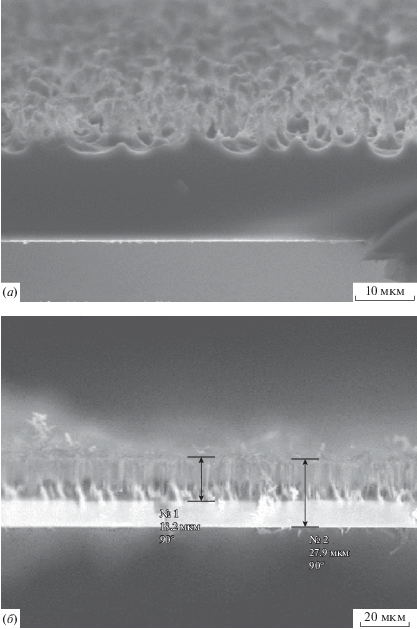
По данным [5, 12], медь имеет бесконечную селективность при ее использовании для плазменного травления различных материалов в SF6. Это свойство меди объясняется высокой скоростью образования нелетучих фторидов на поверхности маски в результате реакции с фторсодержащей плазмой. Так как плотность фторида меди меньше, чем плотность металлической меди, образование сплошной пленки фторида меди на поверхности маски приводит к увеличению ее общей толщины со временем травления и “отрицательной” селективности [5]. Однако, при исследовании перехода меди во фторидную форму в процессе травления в рабочем режиме, было выяснено, что уменьшение толщины меди со временем продолжается и после образования сплошной пленки фторидов на ее поверхности. На рис. 4 показан вид маски и профиль скола после травления кварца в течение 50 мин в рабочем режиме. Изначальная толщина медной маски составляла 5 мкм. На изображениях отчетливо видно, что пленка фторида меди имеет крупнозернистую пористую структуру, а также имеются растрескивания и отслоения от металла. Таким образом, фторидная пленка не экранирует полностью медь от взаимодействия с фторсодержащей плазмой и обладает плохими маскирующими свойствами. Скорость перехода меди во фторидную форму во многом зависит от параметров процесса травления, в том числе – от температуры. При травлении отведение тепла от металла к держателю подложки проходит через кварц, который имеет низкую теплопроводность и большие перепады толщины по пластине (мембраны толщиной порядка 20 мкм и пластина толщиной 600 мкм), что приводит к неравномерности охлаждения маски и градиенту температур по площади пластины. Влияние эффекта на другие металлические маски в данной статье не рассматривалось. Также на скорость роста фторидной пленки влияет удаленность от открытых участков, что вызвано процессом перераспыления фторидов на свободную от маски поверхность. С учетом вышеописанных эффектов, скорость травления меди в рабочем режиме РИТ лежала в пределах от 0.008 до 0.03 мкм/мин по поверхности пластины (селективность в пределах 20/1–75/1). При длительном травлении кварца после полного перехода меди во фторидную форму маска теряет свои защитные свойства, наблюдаются отслоения пленки и протравы кварца под маской, что обусловлено плохой адгезией, рыхлостью и пористой структурой фторида меди.
Рис. 4.
СЭМ изображения кварцевой мембраны толщиной 35 мкм под медью после РИТ; (а, б) изображение маски под углом 45° к поверхности при различных увеличениях; (в) профиль скола кварца под маской; 1 – фторид меди, 2 – медь, 3 – хром (адгезионный подслой), 4 – кварц.
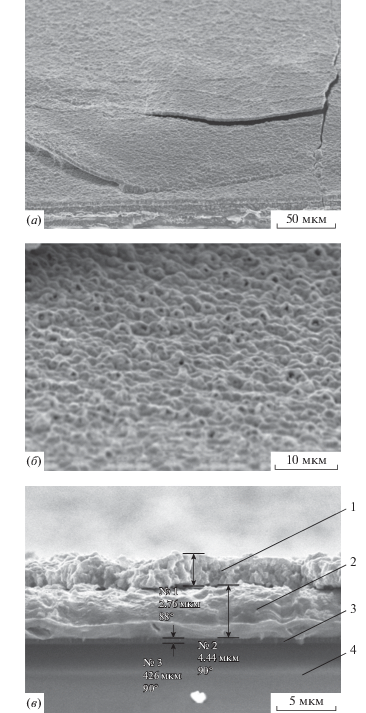
Стоит отметить, что, как и для никелевой маски, в случае меди также наблюдался эффект “травы” на открытой кварцевой поверхности, однако рост шероховатости проявлялся при больших глубинах травления и только близ маски около склонов перехода мембраны на толщину пластины (рис. 5), где переосаждение проходит наиболее интенсивно.
Рис. 5.
Фото с оптического микроскопа (увеличение ×5) области мембраны после сквозного вскрытия мембраны в рабочем режиме; (а) изображение в темном поле; (б) изображение с экспозицией с обратной стороны пластины.
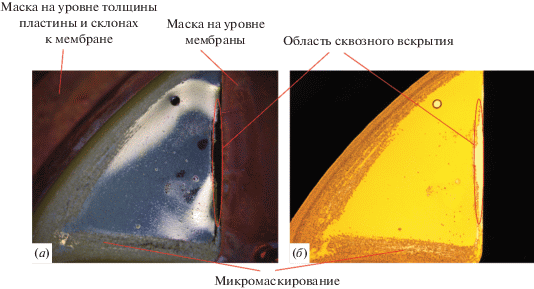
В случае РИТ кварца с использованием CF4 по данным спектроскопии на меди не наблюдалось появление фторида меди. В дальнейшем планируется провести более подробный анализ процесса травления кварца с различными металлическими масками с использованием CF4, а также отработку режима глубинного травления кварца с этим газом.
Таким образом, выяснено, что титан непригоден в качестве маски для травления кварца из-за низкой селективности и больших вносимых напряжений, а получение алюминиевых и хромовых пленок требуемой толщины не технологично. Медь является оптимальным вариантом для глубинного РИТ кварца, хотя и не обладает бесконечной селективностью, описанной в некоторых источниках. Никель наиболее перспективен в качестве маски для травления кварца благодаря высокой по сравнению с другими металлами стойкости к фторсодержащей плазме, однако требует оптимизации режима при травлении на глубину от 20 мкм из-за наличия микромаскирования, эффекта “травы” и остановки травления.
ОСОБЕННОСТИ ТРАВЛЕНИЯ ДЕФОРМИРОВАННОЙ МЕМБРАНЫ
При исследовании процесса травления кварцевой мембраны с медной маской в рабочем режиме на всех элементах в пластине было обнаружено, что сквозное вскрытие мембраны происходит неравномерно: определенная область вблизи маски, лежащей на самой мембране, вскрывается раньше (рис. 5). Предположительно связано это с локальным увеличением скорости травления кварца. Для подтверждения этого эффекта был разработан метод косвенного сравнения скорости травления кварцевой мембраны по площади с использованием декорирующих микроигл на открытой поверхности. Известно [4], что шероховатость дна открытой области кварца сильно зависит от энергии ионов, которая, в свою очередь, растет с ростом напряжения смещения в реакторе. Таким образом, был разработан режим с повышенным напряжением смещения, который способствовал возникновению на открытой поверхности кварца микроигл (аналогично рабочему режиму с никелевой маской), и по их распределению по площади сравнивалась скорость травления кварца. В результате РИТ мембран в режиме с повышенным напряжением смещения получено, что в областях, вскрывающихся первыми в эксперименте с рабочим режимом (рис. 5), микроиглы образовывались значительно медленнее, а толщина мембраны оказалась меньше (рис. 6), что подтверждает локальное увеличение скорости травления кварца.
Рис. 6.
Область мембраны с медной маской после травления в режиме с повышенным напряжением смещения; (а) фото с оптического микроскопа (увеличение ×5); (б) СЭМ изображение профиля скола (плоскость скола показано на рис. 6а).
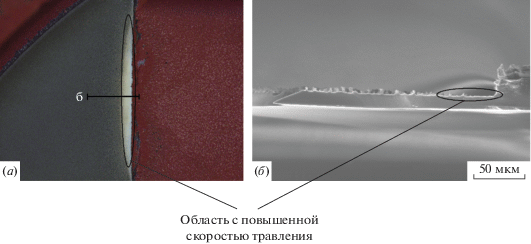
Существует ряд работ [13–15], в которых описывается эффект увеличения скорости травления напряженных кристаллических материалов при ЖХТ и ПХТ. Рост скорости объясняется дополнительной энергией деформации кристаллической решетки, локализованной вокруг дислокаций, которая увеличивает интенсивность удаления атомов поверхностного слоя при травлении [15]. Хотя механизм данного процесса известен давно, его проявление при РИТ мембран из плавленого кварца, испытывающих термодеформацию на контакте с маской, в литературе не найден.
Для подтверждения связи напряженного состояния кварца и скорости РИТ был проведен эксперимент, в ходе которого на обратной стороне мембраны толщиной 35 мкм в области между упругими перемычками подвеса МУ по всей длине были сформированы четыре параллельные металлические дорожки из меди с подслоем хрома шириной 280 мкм и толщиной 5 мкм (рис. 7а). Металлические дорожки на обратной стороне создавали периодическую деформацию мембраны и в то же время не контактировали с травящей газовой смесью в реакторе РИТ. Профиль деформированной мембраны, представленный на рис. 7б, получен с помощью контактной профилометрии. Травление проводилось в режиме с повышенным напряжением смещения с лицевой стороны пластины на глубину от 15 мкм, когда на открытой области отчетливо прослеживались микроиглы. Результат распределения микроигл по поверхности мембраны представлен на рис. 8а. Из рисунков видно, что распределение микроигл по поверхности мембраны связано с профилем деформации и при этом не зависит от переосаждения материала проводников.
Рис. 7.
Фото с оптического микроскопа (увеличение ×5) с лицевой стороны участка кварцевой мембраны с сформированными металлическими дорожками (а) и профиль деформированной поверхности (контактная профилометрия) мембраны.

Рис. 8.
Фото с оптического микроскопа (увеличение ×5) с лицевой стороны участка кварцевой мембраны с сформированными металлическими дорожками после травления в режиме с повышенным смещением на глубину 15 мкм (а) и СЭМ-изображение под углом 30° к поверхности скола кварцевой мембраны над металлической дорожкой (б).
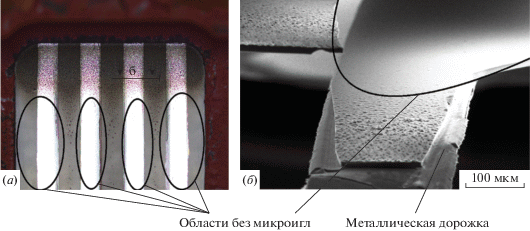
Также для более подробного исследования связи термонапряжений со скоростью травления было проведено конечно-элементное моделирование термодеформации полученной структуры. Моделировался температурный переход участка мембраны МУ толщиной 35 мкм с рисунком маски на лицевой стороне и металлическими дорожками на обратной стороне от температуры напыления (нулевая деформация) до комнатной температуры, с учетом пластической деформации и без учета зависимости параметров материалов от температуры (рис. 9). При сопоставлении данных моделирования (рис. 9) и экспериментальных результатов (рис. 8) был сделан вывод, что увеличение скорости травления кварца, выраженное локальным отсутствием микроигл на открытой поверхности, проявляется в областях мембраны, испытывающих на поверхности с лицевой стороны растягивающие термонапряжения (рис. 9в). Стоит отметить, что в результате эксперимента (рис. 8а) в верхней части мембраны присутствуют микроиглы, хотя, согласно модели (рис. 9в) там имеются области растягивающих напряжений. Наличие микроигл обусловлено близостью к маске на склоне перехода к мембране и интенсивным переосаждением, показанным в эксперименте на рис. 5. Полученные результаты также совпадают с результатами предыдущих экспериментов при травлении в рабочем режиме и режиме с повышенным напряжением смещения в областях около упругих перемычек подвеса (рис. 5, 6).
Рис. 9.
Результаты моделирования термодеформации кварцевой мембраны с металлом с двух сторон; (а) общий вид мембраны с металлом (вид с лицевой стороны); (б) вид деформированного фрагмента мембраны с металлом (коэффициент деформации ×30); (в) график объемной деформации, выделенная область соответствует положительному значению деформации на вытравливаемой поверхности кварца.
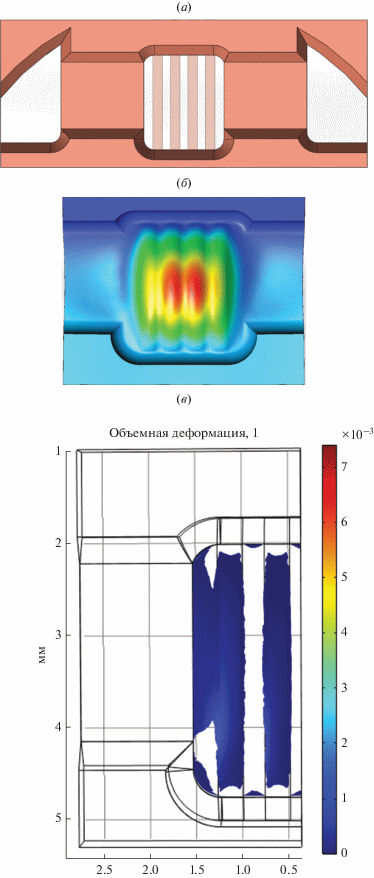
Авторами [15] описан эффект влияния плотности дислокаций в монокристаллическом кварце на скорость жидкостного травления, однако этот механизм нельзя применять напрямую для объяснения результатов проведенных экспериментов, так как в данной работе использовался плавленый кварц с аморфной структурой. В работе [16] деформация аморфных материалов объясняется зарождением и движением квазидислокаций (дислокации Сомилианы), обладающих короткодействующими, экспоненциально затухающими напряжениями в отличии от дислокаций монокристаллической решетки. Поле напряжений вокруг квазидислокаций может сказываться на скорости травления кварца. В дополнение к вышесказанному, на примере полимерных стекол механизм накопления поверхностной энергии в процессе деформирования подробно рассматривается авторами [17].
ЗАКЛЮЧЕНИЕ
В результате работы предложен режим глубинного анизотропного РИТ плавленого кварца на глубину от 20 мкм, использующийся для сквозного травления в технологии изготовления маятниковых узлов Q-flex акселерометров. Проведен обзор различных металлических масок (титан, медь, алюминий, хром, никель) для сквозного РИТ кварцевых мембран, в который входило экспериментальное исследование селективности металлов и их влияние на процесс травления, а также конечно-элементное моделирование термодеформаций, возникающих в кварцевой мембране на границе контакта с металлической пленкой. Выяснено, что титан непригоден в качестве маски для травления из-за низкой селективности и больших вносимых напряжений, а получение алюминиевых и хромовых пленок требуемой толщины нетехнологично. Никель обладает наивысшей стойкостью к фторсодержащей плазме среди представленных металлов, однако требует оптимизации режима при травлении на глубину от 20 мкм из-за наличия микромаскирования, роста микроигл и остановки травления. В опытах с медной маской проводилось исследование механизма травления меди во фторсодержащей плазме с образованием фторидной пленки. Выяснено что фторидная пленка на поверхности металла обладает плохими маскирующими свойствами и не придает маске бесконечную селективность. Тем не менее, медь остается оптимальным вариантом маски для глубинного РИТ благодаря своей технологичности.
В ходе экспериментов РИТ кварцевых мембран различной толщины было выявлено локальное увеличение скорости травления кварца, не связанное явно с удаленностью от маски или особенностью геометрии камеры реактора. Данный эффект особенно четко демонстрируется при травлении кварца в режиме с повышенным напряжением смещения, когда на открытой кварцевой поверхности наблюдается рост микроигл, так как в областях с увеличенной скоростью травления микроиглы образуются значительно медленнее. Для более подробного исследования связи термонапряжений кварца со скоростью РИТ был проведен эксперимент по травлению мембраны с предварительно сформированными на обратной стороне металлическими дорожками, создающими дополнительное периодическое напряжение в кварце без непосредственного контакта с травящей газовой средой. В результате травления в режиме с повышенным напряжением смещения было получено, что распределение микроигл по открытой поверхности кварца соответствует областям мембраны, где лицевая сторона испытывает растягивающие напряжения. Данные напряженного состояния получены из экспериментального анализа деформации и конечно-элементным моделированием структуры. Полученный эффект может быть объяснен механизмом накопления кварцем поверхностной энергии деформации, которая увеличивает интенсивность удаления атомов напряженных слоев при травлении.
Список литературы
Сагателян Г.Р., Новоселов К.Л., Шишлов А.В., Щукин С.А. Применение нанотехнологических методов для изготовления пластины маятникового акселерометра // Инженерный журн.: наука и инновации (электронное научно-техническое издание). 2013. № 6(18). 23 с.
Пат. 2656109 С1 РФ, МПК H 01 L 21/308. Способ изготовления чувствительного элемента акселерометра / Д.В. Козлов, И.П. Смирнов, А.С. Корпухин, В.М. Запетляев, Г.А. Исакова; АО “Российская корпорация ракетно-космического приборостроения и информационных систем” (АО “Российские космические системы”). № 2017109870; заявл. 24.03.2017; опубл. 31.05.2018, Бюл. № 16. 12 с.
Бом С.Дж. Оптимизация параметров и моделирование рабочих режимов в компенсационных акселерометрах типа Q-flex и Si-flex: дис. … канд. техн. наук: М.: 2012. 239 с.
Jung H.C. Design and fabrication of microfluidic devices for electrokinetic studies: a thesis for the Degree Master of Science: The Ohio State University. 2008. 81 p.
Kim D.W., Lee H.Y., Park B.J., Kim H.S., Sung Y.J., Chae S.H., Ko Y.W., Yeom G.Y. High rate etching of 6H–SiC in SF6-based magnetically-enhanced inductively coupled plasmas // Thin Solid Films. 2004. № 447–448. P. 100–104.
Park J.H., Lee N.-E., Jaechan Lee, Park J.S., Park H.D. Deep dry etching of borosilicate glass using SF6 and SF6/Ar inductively coupled plasmas // Microelectronic Engineering. 2005. № 82. P. 119–128.
Chen H., Fu C. An investigation into the characteristic of deep reactive ion etching of quartz using SU-8 as a mask // J. Micromec. Microeng. 2008. № 18. 105001. P. 1–8.
Ujile T., Kikuchi T., Ichiki T., Horiike Y. Fabrication of quartz microcapillary electrophoresis chips using plasma etching // J. Appl. Phys. 2000. V. 39. Part 1. № 6A. P. 3677–3682.
Макарчук М.В., Королев А.П. Физика тонких пленок: конспект лекций. Тамбов: Изд-во ФГБОУ ВПО “ТГТУ”. 2013. 44 с.
Abe T., Esashi M. One-chipmulti channelquartzcrystal microbalance (QCM) fabric atedby Deep RIE // Sensors and Actuators. 2000. № 82. P. 139–143.
Lallement L. et al. Etching studies of silica glasses in SF6/Ar inductively coupled plasmas: Implications for microfluidic devices fabrication // J. Vac. Scl. Technol. A. 2010.V. 28. № 2. P. 277–286.
Дунаев А.В., Мурин Д.Б. Кинетика травления меди в ВЧ-разряде фреона R-12 // Микроэлектроника. 2017. Т. 46. № 4. С. 294–289.
Youtsey C., Romano L.T., Adesida I. Gallium nitride whiskers formed by selective photoenhanced wet etching dislocations // Applied physics letters. 1998. V. 73. № 6. P. 797–799.
Albert J. et al. Maskless writing of submicrometer gratings in fused silica by focused ion beam implantation and differential wet etching // Appl. Phys. Lett. 1993. V. 63 2309. P. 11.
Blum A.E., Yund R.A., Lasaga A.C. The effect of dislocation density on the dissolution rate of quartz // Geochimica et Cosmochimica Acta. 1989. V. 54. P. 283–297.
Емалетдинов А.К., Нуруллаев Р.Л. Линейные дефекты и микроскопические механизмы деформации аморфных материалов // Вестник ТГУ. 2003. Т. 8. Вып. 4. С. 762–765.
Волынский А.Л., Бакеев Н.Ф. Структурные аспекты неупругой деформации стеклообразных полимеров // Высокомолекулярные соединения. Серия С. 2005. Т. 47. № 7. С. 1332–1367.
Григорьев Ф.И. Плазмохимическое и ионно-химическое травление в технологии микроэлектроники: Учебное пособие. Московский государственный институт электроники и математики. М.: 2003. 48 с.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника


