Микроэлектроника, 2020, T. 49, № 3, стр. 170-178
О влиянии вида фторуглеродного газа на выходные характеристики процесса реактивно-ионного травления
А. М. Ефремов a, *, Д. Б. Мурин a, K.-H. Kwon b
a Федеральное государственное бюджетное образовательное учреждение высшего образования
“Ивановский государственный химико-технологический университет”, кафедра технологии приборов
и материалов электронной техники
г. Иваново, Шереметевский просп., 7, Россия
b Korea University, Department of Control and Instrumentation Engineering
339-700 Sejong, South Korea
* E-mail: efremov@isuct.ru
Поступила в редакцию 04.06.2019
После доработки 28.08.2019
Принята к публикации 10.10.2019
Аннотация
Выполнено сравнительное исследование параметров, стационарного состава и эффектов гетерогенного взаимодействия в плазме фтор-углеродных газов CxHyFz c различными соотношениями $z{\text{/}}x$ в условиях индукционного ВЧ (13.56 МГц) разряда. В качестве объектов исследования использовались бинарные системы CxHyFz + Ar на основе CF4 ($z{\text{/}}x$ = 4), CHF3 ($z{\text{/}}x$ = 3) и C4F8 ($z{\text{/}}x$ = 2). При совместном использовании методов диагностики и моделирования плазмы выявлены: а) причины различий электрофизических (температура и концентрация электронов, энергия ионной бомбардировки) параметров плазмы в исследуемых системах; б) особенности кинетики плазмохимических процессов, определяющих стационарные концентрации атомов фтора и полимеробразующих радикалов; и в) особенности кинетики гетерогенных процессов, формирующих выходные параметры (скорость, селективность, анизотропия) реактивно-ионного травления Si и SiO2.
1. ВВЕДЕНИЕ
Фторуглеродные газы вида CxHyFz и смеси на их основе широко используются в технологии интегральной микро- и наноэлектроники при проведении размерного травления (структурирования) поверхности кремния и его соединений в реактивно-ионных процессах [1–3]. Известно, что выходные характеристики таких процессов (скорость, селективность, анизотропия) в значительной степени зависят от соотношения $z{\text{/}}x$ в молекуле фторуглеродного газа. Фактически, значение $z{\text{/}}x$ задает соотношение концентраций атомов фтора $\left( {{{n}_{{\text{F}}}}} \right)$ и полимеробразующих радикалов CHyFz с $y$ + $z$ ≤ 2$\left( {{{n}_{{{\text{pol}}}}}} \right)$ в газовой фазе [4] и, таким образом, предопределяет ключевые особенности кинетики травления (газификации атомов обрабатываемого материала) и поверхностной полимеризации (высаживания фторуглеродной полимерной пленки на контактирующих с плазмой поверхностях) для данного газа [2, 4]. Так, например, в плазме CF4 ($z{\text{/}}x$ = 4) выполняется условие ${{n}_{{\text{F}}}}$ $ \gg $ $~{{n}_{{{\text{pol}}}}}~$ [5], что способствует доминированию скорости травления над скоростью полимеризации [4, 6]. Такая система характеризуется высокими скоростями травления и чистотой обрабатываемой поверхности, но формирует изотропный профиль травления и отличается низкой селективностью в системе SiO2/Si. Напротив, в плазме таких газов как CHF3 ($z{\text{/}}x$ = 3) и C4F8 ($z{\text{/}}x$ = 2) справедливо соотношение ${{n}_{{\text{F}}}}$ $ \ll $ ${{n}_{{{\text{pol}}}}}$ [7, 8], что обуславливает низкие скорости травления, но высокую анизотропию процесса (за счет маскирования полимером боковых стенок формируемого рельефа [1, 2]) и селективность в системе SiO2/Si (за счет меньшей толщины полимерной пленки на поверхности SiO2 [6, 9]). Очевидно, что выбор оптимального плазмообразующего газа для целей конкретного процесса требует понимания сути физико-химических явлений, формирующих стационарный состав плазмы и определяющих ключевые особенности различных фторуглеродных систем в плане выходных характеристик реактивно-ионного травления. На протяжении последних лет было выполнено достаточное количество исследований фторуглеродных плазменных систем, в том числе и систем на основе CF4 [5, 10–12], CHF3 [7, 12–14] и C4F8 [8, 11, 15]. По результатам этих работ: 1) определены механизмы процессов образования и гибели нейтральных и заряженных частиц; 2) выявлены зависимости концентраций атомов фтора и полимеробразующих радикалов от внешних параметров плазмы; и 3) сформированы кинетические схемы (наборы процессов и соответствующих констант скоростей), обеспечивающие адекватное описание кинетики плазмохимических процессов. Кроме этого, опубликован ряд работ по изучению взаимосвязей кинетики травления и полимеризации на поверхностях различных материалов [6, 16, 17]. В то же время, анализ имеющихся работ открывает ряд направлений, по которым необходимы дополнительные исследования. Во-первых, полученные ранее результаты не обеспечивают возможности детального сравнения различных фторуглеродных плазменных систем из-за различий в исследованных диапазонах внешних параметров плазмы, типах и геометрии плазмохимических реакторов. Поэтому, в большинстве случаев, нет четкого понимания того, как и почему изменяются электрофизические параметры и состав плазмы в ряду газов с одинаковыми или различными значениями $z{\text{/}}x$ при одинаковых условиях возбуждения разряда. И, во-вторых, недостаточное внимание уделялось исследованию взаимосвязей между параметрами газовой фазы и кинетикой гетерогенных плазмохимических процессов. Такая ситуация затрудняет интерпретацию экспериментальных данных по выходным параметрам реактивно-ионных процессов в различных газах и, таким образом, ограничивает возможность выбора оптимального плазмообразующего газа для целей того или иного процесса.
Цель данной работы – сравнительное исследование электрофизических параметров плазмы, состава плазмы и кинетики гетерогенных процессов, определяющих выходные характеристики реактивно-ионного травления (скорость, селективность, анизотропия), во фторуглеродных газах CxHyFz c различными соотношениями $z{\text{/}}x.$ В качестве объектов исследования были выбраны плазменные системы вида CxHyFz + Ar на основе CF4 ($z{\text{/}}x$ = 4), CHF3 ($z{\text{/}}x$ = 3) и C4F8 ($z{\text{/}}x$ = 2). Основное внимание было направлено на 1) выявление различий электрофизических параметров плазмы (температура и концентрация электронов, энергия ионной бомбардировки), определяющих кинетику процессов при электронном ударе и взаимодействия ионов с поверхностью; 2) анализ кинетики плазмохимических процессов, определяющих стационарные концентрации атомов фтора и полимеробразующих радикалов; и 3) установление взаимосвязей между параметрами газовой фазы и гетерогенными характеристиками процесса травления.
2. МЕТОДИЧЕСКАЯ ЧАСТЬ
2.1. Экспериментальные методики и оборудование
Эксперименты проводились при возбуждении индукционного ВЧ (13.56 МГц) разряда в смесях CF4 + Ar, CHF3 + Ar и C4F8 + Ar в реакторе планарного типа с цилиндрической ($r$ = 13 см, $l$ = 16 см) рабочей камерой из анодированного алюминия [18]. В качестве неизменных входных параметров плазмы выступали общее давление плазмообразующего газа $p$ = 6 мторр (∼0.8 Па), вкладываемая мощность $W$ = 700 Вт и мощность смещения ${{W}_{{dc}}}$ = 200 Вт. В качестве варьируемого параметра использовался начальный состав плазмообразующей смеси, который устанавливался изменением индивидуальных расходов соответствующих газов при постоянном общем расходе $q$ = = 40 станд. см3/мин. Максимальное значение ${{q}_{{{\text{Ar}}}}}$ = = 30 станд. см3/мин соответствовало доле аргона в смеси ${{y}_{{{\text{Ar}}}}}$ = 75%.
Диагностика плазмы осуществлялась двойным зондом Лангмюра DLP2000 (Plasmart Inc., Korea). Для минимизации погрешности измерений зондовых вольт-амперных характеристик (ВАХ) из-за полимеробразования на зондах применялась система импульсной очистки зондов ионной бомбардировкой. Предварительные эксперименты показали отсутствие принципиальных искажений ВАХ, последовательно измеряемых в чистых CF4, CHF3 и С4F8 в течение ~5 мин после зажигания разряда. Обработка ВАХ базировалась на известных положениях теории двойного зонда [19] с использованием максвелловской функции распределения электронов по энергиям (ФРЭЭ). Результатом обработки выступали данные по температуре электронов $\left( {{{T}_{e}}} \right)$ и плотности ионного тока $\left( {{{J}_{ + }}} \right).$ Суммарная концентрация положительных ионов $\left( {{{n}_{ + }}} \right)$ определялась из соотношения ${{J}_{ + }} \approx 0.61e{{n}_{ + }}{{v}_{B}}$ [20], где ${{v}_{B}} \approx \sqrt {{{e{{T}_{e}}} \mathord{\left/ {\vphantom {{e{{T}_{e}}} {{{m}_{i}}}}} \right. \kern-0em} {{{m}_{i}}}}} $ – скорость ионов на внешней границе двойного электрического слоя у поверхности зонда [4]. Эффективная масса ионов ${{m}_{i}}$ оценивалась в предположении, что мольная доля каждого типа положительного иона пропорциональна $~{{{{k}_{{iz}}}{{y}_{x}}} \mathord{\left/ {\vphantom {{{{k}_{{iz}}}{{y}_{x}}} {\sqrt {{1 \mathord{\left/ {\vphantom {1 {{{m}_{x}}}}} \right. \kern-0em} {{{m}_{x}}}}} }}} \right. \kern-0em} {\sqrt {{1 \mathord{\left/ {\vphantom {1 {{{m}_{x}}}}} \right. \kern-0em} {{{m}_{x}}}}} }},$ где ${{k}_{{iz}}}$ и ${{y}_{x}}$ – константа скорости ионизации и мольная доля соответствующей нейтральной частицы массой ${{m}_{x}}.$
Величина отрицательного смещения на нижнем электроде $ - {{U}_{{dc}}}$ при ${{W}_{{dc}}}$ = const измерялась высоковольтным зондом AMN-CTR (Youngsin Eng, Korea). В предварительных экспериментах было найдено, что варьирование ${{W}_{{dc}}}$ в пределах 0–200 Вт не оказывает влияния на вид зондовых ВАХ и, следовательно, на параметры газовой фазы разряда.
2.2. Моделирование плазмы
Для получения данных по составу плазмы использовалась 0-мерная кинетическая модель, базирующаяся на типовых предпосылках для разрядов низкого ($p$ < 20 мторр) давления во фторуглеродных газах [10–15]: 1) максвелловская ФРЭЭ обеспечивает адекватное описание кинетики процессов под действием электронного удара; 2) температура газа ${{T}_{{{\text{gas}}}}}$ ≈ const в условиях $p,~W$ = const; 3) гетерогенная рекомбинация атомов и радикалов подчиняется механизму Или-Ридила; и 4) низкая электроотрицательность плазмы CF4,CHF3 и C4F8 дает возможность полагать ${{{{n}_{ - }}} \mathord{\left/ {\vphantom {{{{n}_{ - }}} {{{n}_{e}}}}} \right. \kern-0em} {{{n}_{e}}}} \ll 1$ и ${{n}_{e}}$ ≈ ${{n}_{ + }}.$ Наборы реакций и их кинетических характеристик (констант скоростей объемных процессов, вероятностей гетерогенной рекомбинации атомов и радикалов) в плазме CF4 + Ar, CHF3 + Ar и C4F8 + Ar были заимствованы из работ [5, 8, 11–15]. Корректность используемых кинетических схем в этих системах подтверждается удовлетворительным согласием расчетных и измеренных параметров плазмы и концентраций частиц [10, 11, 13]. В качестве входных параметров модели использовались экспериментальные данные по ${{T}_{e}}$ и ${{n}_{ + }}.$ Выходными параметрами служили средние по объему реактора скорости процессов образования и гибели нейтральных частиц, их концентрации и плотности потоков на поверхность, контактирующую с плазмой.
2.3. Анализ кинетики процессов травления/полимеризации
Для анализа взаимосвязей кинетики объемных и гетерогенных процессов использовались известные положения по механизмам реактивно-ионных процессов во фторуглеродной плазме [4, 6, 21–25]:
− Любой канал физического взаимодействия плазмы с обрабатываемой поверхностью (ионное распыление основного материала и/или фторуглеродной полимерной пленки, ионно-стимулированная десорбция продуктов химических реакций) характеризуется скоростью ${{Y}_{S}}{{{\Gamma }}_{ + }},$ где ${{Y}_{S}}$ – выход процесса (атом/ион) и ${{{\Gamma }}_{ + }} \approx {{{{J}_{ + }}} \mathord{\left/ {\vphantom {{{{J}_{ + }}} e}} \right. \kern-0em} e}$ – плотность потока ионов. Полагая ${{Y}_{S}}$ ~ $\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} ,$ где ${{\varepsilon }_{i}} = e\left| { - {{U}_{f}} - {{U}_{{dc}}}} \right|$ – энергия бомбардирующих ионов, $ - {{U}_{f}} \approx 0.5{{T}_{e}}{\text{ln}}\left( {{{{{m}_{e}}} \mathord{\left/ {\vphantom {{{{m}_{e}}} {2.3{{m}_{i}}}}} \right. \kern-0em} {2.3{{m}_{i}}}}} \right)$ – плавающий потенциал, ${{M}_{i}}$ – эффективная молярная масса ионов, изменение скорости любого ионного процесса при варьировании условий обработки отслеживается параметром $~\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}.$
− Образования фторуглеродной полимерной пленки характеризуется скоростью $~{{\gamma }_{{{\text{pol}}}}}{{{\Gamma }}_{{{\text{pol}}}}},$ где ${{\gamma }_{{{\text{pol}}}}}$ – эффективная вероятность полимеризации и ${{{\Gamma }}_{{{\text{pol}}}}}$ – плотность потока полимеробразующих радикалов CHyFz с $y$ + $z$ ≤ 2. Известно, что в условиях постоянства температуры поверхности величина ${{\gamma }_{{{\text{pol}}}}}~$ возрастает при снижении концентрации атомов фтора в газовой фазе. Поэтому, полагая ${{\gamma }_{{{\text{pol}}}}}$ ~ ${1 \mathord{\left/ {\vphantom {1 {{{{\Gamma }}_{{\text{F}}}}}}} \right. \kern-0em} {{{{\Gamma }}_{{\text{F}}}}}},$ изменение скорости связывания радикалов с поверхностью может быть отслежено отношением ${{{{{\Gamma }}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{\Gamma }}_{{{\text{pol}}}}}} {{{{\Gamma }}_{{\text{F}}}}}}} \right. \kern-0em} {{{{\Gamma }}_{{\text{F}}}}}},$ а толщина пленки ${{h}_{{{\text{pol}}}}}$ ~ ~ ${{{{{\Gamma }}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{\Gamma }}_{{{\text{pol}}}}}} {\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}{{{\Gamma }}_{{\text{F}}}}}}} \right. \kern-0em} {\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}{{{\Gamma }}_{{\text{F}}}}}}.$
− Взаимодействие атомов фтора с обрабатываемой поверхностью характеризуется скоростью $~{{\gamma }_{R}}{{{\Gamma }}_{F}},$ где ${{\gamma }_{R}}$ – эффективная вероятность взаимодействия. Основным фактором, определяющим ${{\gamma }_{R}}~$ в условиях постоянства температуры поверхности и образования летучих продуктов взаимодействия является затруднение доступа атомов фтора к поверхностным активным центрам за счет маскирования поверхности фторуглеродной полимерной пленкой. Для области ${{h}_{{{\text{pol}}}}}$ < 2 нм справедливо соотношение ${{\gamma }_{R}}$ ~ ${1 \mathord{\left/ {\vphantom {1 {{{h}_{{{\text{pol}}}}}}}} \right. \kern-0em} {{{h}_{{{\text{pol}}}}}}}.$
3. РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Влияние внешних параметров процесса реактивно-ионного травления (давление и скорость потока плазмообразующего газа, вкладываемая мощность, мощность смещения) на электрофизические параметры плазмы CF4, CHF3 и C4F8 изучалось ранее в работах [5, 12, 13, 15]. Поэтому остановимся лишь на ключевых моментах, имеющих принципиальное значение для сравнения свойств этих систем в условиях $p,~W$ = const:
− Температура электронов возрастает в ряду CF4–C4F8–CHF3, при этом характер зависимостей ${{T}_{e}} = f\left( {{{y}_{{{\text{Ar}}}}}} \right)$ в соответствующих смесях не является одинаковым (рис. 1). Максимальное значение ${{T}_{e}}$ в плазме CHF3 является следствием низких потерь энергии на ионизацию HF (как доминирующих нейтральных частиц) по сравнению с фторуглеродными компонентами вида CFx ($x$ = 4 для плазмы CF4 и $x$ = 2 для плазмы C4F8). Данный вывод однозначно следует из сравнения констант скоростей и пороговых энергий для R1: HF + e → → HF+ + 2e (${{\varepsilon }_{1}}$ = 16.1 эВ, ${{k}_{1}}$ = 4.6 × 10–10 см3/с при ${{T}_{e}}$ = 5 эВ), R2: CF4 + e → ${\text{CF}}_{{\text{3}}}^{ + }$ + F + 2e (${{\varepsilon }_{2}}$ = 15.9 эВ, ${{k}_{2}}$ = 1.6 × 10–9 см3/с при ${{T}_{e}}$ = 3 эВ) и R3: CF2 + e → → ${\text{CF}}_{{\text{2}}}^{ + }$ + 2e (${{\varepsilon }_{3}}$ = 10.0 эВ, ${{k}_{3}}$ = 2.1 × 10–9 см3/с при ${{T}_{e}}$ = 3 эВ). Выполнение условия ${{T}_{e}}$ (CF4) < ${{T}_{e}}$ (C4F8) обусловлено более высокими потерями энергии на колебательное возбуждение CF4 по сравнению с CF2. Увеличение доли аргона в смеси CF4 + Ar сопровождается практически пропорциональным снижением потерь энергии на электронное и колебательное возбуждение компонентов вида CFx и ростом потерь энергии на ионизацию за счет R4: Ar + e → Ar+ + 2e (${{\varepsilon }_{4}}$ = 15.6 эВ, ${{k}_{3}}$ = = 3.0 × 10–9 см3/с при ${{T}_{e}}$ = 5 эВ). Поэтому варьирование начального состава смеси CF4 + Ar приводит к ${{T}_{e}}$ ≈ const. В то же время, увеличение ${{y}_{{{\text{Ar}}}}}$ в системах CHF3 + Ar и C4F8 + Ar сопровождается более резким (в силу ${{\varepsilon }_{1}}{{k}_{1}}$ $ \ll $ ${{\varepsilon }_{2}}{{k}_{2}}$ и ${{\varepsilon }_{3}}{{k}_{3}}$) ростом потерь энергии на ионизацию, которое приводит к снижению ${{T}_{e}}.$
Рис. 1.
Температура электронов (сплошные линии) и концентрации заряженных частиц (пунктир) в плазме смесей CF4 + Ar (1), CHF3 + Ar (2) и C4F8 + Ar (3) переменного начального состава.
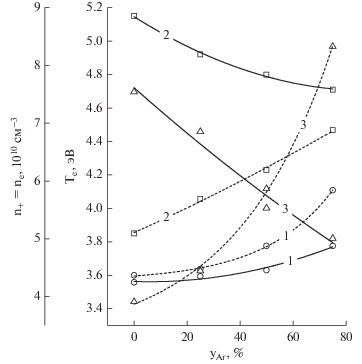
− Концентрации заряженных частиц возрастают в ряду C4F8–CF4–CHF3 (рис. 1), что согласуется с различиями суммарных частот в данных системах. Однотипные зависимости величин ${{n}_{ + }}~$ и ${{n}_{e}}$ от содержания аргона в смеси обусловлены ростом суммарных частот ионизации (2.7 × 104–6.5 × 104 c–1 для CF4 + Ar, 1.2 × 105–1.7 × 105 c–1 для CHF3 + Ar и 9.5 × 104–2.1 × 105 c–1 для C4F8 + Ar при 0–75% Ar) в силу 1) $~{{k}_{4}}$ > ${{k}_{1}}$, ${{k}_{2}}$ и ${{k}_{3}};$ и 2) увеличения эффективности ионизации за счет R5: Arm + e → Ar+ + 2e c участием метастабильных атомов аргона Arm = = Ar(3P0, 1, 2). Аналогичные различия имеют место и для плотностей ионных токов ${{J}_{ + }}$ (0.95–1.63 мА/см2 для CF4 + Ar, 1.55–2.20 мА/см2 для CHF3 + Ar и 1.05–2.36 мА/см2 для C4F8 + Ar при 0–75% Ar), определяющих потоки ионов на обрабатываемую поверхность. Выполнение условия ${{J}_{{ + ,{{{\text{C}}}_{{\text{4}}}}{{{\text{F}}}_{8}}}}}$ > ${{J}_{{ + ,{\text{C}}{{{\text{F}}}_{4}}}}}$ в области малых ${{y}_{{{\text{Ar}}}}}~$ (что формально противоречит $~{{n}_{{ + ,{{{\text{C}}}_{{\text{4}}}}{{{\text{F}}}_{8}}}}}$ < ${{n}_{{ + ,{\text{C}}{{{\text{F}}}_{4}}}}}$) связано с различиями транспортных коэффициентов и масс доминирующих ионов.
− Отрицательное смещение на нижнем электроде в условиях ${{W}_{{dc}}}$ = const увеличивается в ряду CHF3–CF4–C4F8, при этом рост ${{y}_{{{\text{Ar}}}}}$ сопровождается снижением параметра $ - {{U}_{{dc~}}}$ (рис. 2). Это приводит к аналогичным изменениям энергий ионов, бомбардирующих обрабатываемую поверхность (285–211 эВ для CF4 + Ar, 261–208 эВ для CHF3 + Ar и 307–221 эВ для C4F8 + Ar при 0–75% Ar). Достаточно близкие значения $\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} $ обуславливают тот факт, что эффективность ионной бомбардировки поверхности в исследуемых смесях определяется, в основном, различиями в плотностях потоков ионов. Из данных рис. 2 можно видеть, что в области ${{y}_{{{\text{Ar}}}}}$ < 60% параметр $\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}$ имеет максимальную величину для системы CHF3 + Ar и минимальную – для CF4 + Ar. При более высоких содержаниях аргона ситуация изменяется по причине резкого роста ${{{\Gamma }}_{ + }}$ в смеси C4F8 + Ar из-за аналогичного изменения концентрации ионов.
Рис. 2.
Отрицательное смещение при ${{W}_{{dc}}}$ = const (сплошные линии) и параметр $\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }},$ характеризующий плотность потока энергии ионов (пунктир) в плазме смесей CF4 + Ar (1), CHF3 + Ar (2) и C4F8 + Ar (3) переменного начального состава.
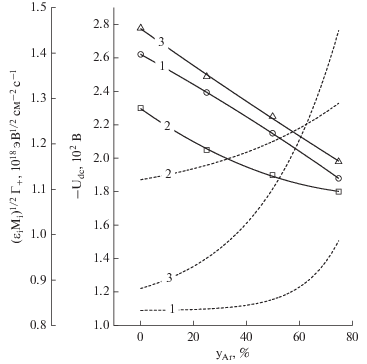
Расчеты показали, что доминирующими нейтральными частицами в плазме тетрафторетана являются молекулы CF4 и атомы F (рис. 3а). Снижение концентраций компонентов вида CFx с уменьшением параметра $x$ обусловлено 1) ступенчатым образованием этих частиц по механизму R6: CFx + e → CFx – 1 + F + e; и 2) более высокими вероятностями гетерогенной гибели для менее насыщенных радикалов. Наиболее значимыми (~80% от общей скорости образования) источниками атомов фтора являются R6 с участием CFx ($x$ = 3, 4) и диссоциативная ионизация R7: CF4 + e → → ${\text{CF}}_{{\text{3}}}^{ + }$ + F + 2e. Гибель атомов фтора происходит гетерогенно в процессах вида R8: F + F(s) → F2 и R9: F + CFx(s) → CFx + 1, где индекс “(s)” соответствует адсорбированному состоянию частицы. Основными компонентами газовой фазы в плазме CHF3 + Ar являются HF, CHF3 и СFx (x = 1–3) (рис. 3б). Доминирование HF является следствием двух факторов, а именно 1) прямого образования этих частиц из исходных молекул по R10: CHF3 + e → HF + CF2 + e; и 2) высокой эффективности объемных реакций вида R11: CHFx + F → → CFx + HF (${{k}_{{11}}}$ ~ 3.0 × 10–11 см3/с для $x$ = 1, 2), R12: CHFx + H → CHFx –1 + HF (${{k}_{{12}}}$ ~ 3.0 × 10–10 см3/с для $x$ = 1, 2) и R13: CFх + H → CFх– 1 + HF (${{k}_{{13}}}$ ~ ~ 8 × 10–11 см3/с для $x$ = 3 и ~4 × 10–11 см3/с для x = = 2). Соответственно, определяющими каналами генерации атомов фтора являются R14: HF + e → → H + F + e и R6 с участием CFx ($x$ = 2, 3). Отметим также, что вклад R11 в суммарную скорость гибели атомов фтора является более значимым по сравнению с R8 и R9. Газовая фаза плазмы C4F8 + Ar представлена, в основном, фторуглеродными компонентами вида CFx ($x$ = 1, 2, 3) и C2Fx ($x$ = 3, 4) (рис. 3в). Эти частицы образуются как при диссоциации исходных молекул в процессах электронного удара R13: C4F8 + e → 2C2F4 + e и R14: C4F8 + e → C3F6 + CF2 + e, так и в последующих превращениях продуктов распада по R6 (для $x$ = 2), R15: C3F6 + e → C2F4 + CF2 + e, R16: C2F4 + + e → 2CF2 + e и R17: C2F4 + e → C2F3 + F + 2e. Основным источником атомов фтора в системе C4F8 + + Ar служит R6 с участием CFx ($x$ = 1, 2, 3), при этом суммарная скорость гибели атомов формируется при заметном участии объемной реакции R18: C2F4 + F → CF2 + CF3 (${{k}_{{18}}}$ ~ 4 × 10–11 см3/с).
Рис. 3.
Стационарные концентрации нейтральных частиц в плазме смесей CF4 + Ar (а), CHF3 + Ar (б) и C4F8 + Ar (в) переменного начального состава.
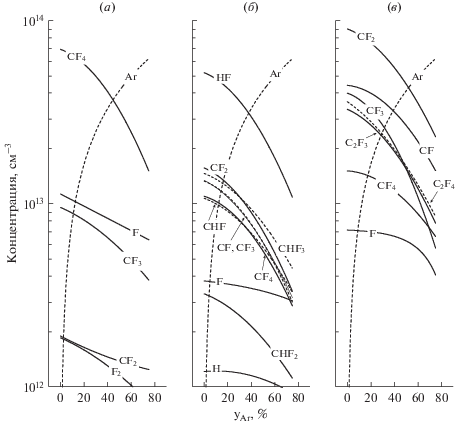
Полученные данные по кинетике нейтральных частиц и составу плазмы позволяют сформулировать ряд заключений, имеющих принципиальное значение для оптимизации реактивно-ионных процессов в рассматриваемых системах:
− Суммарная концентрация полимеробразующих частиц ${{n}_{{{\text{pol}}}}}$ (${{n}_{{{\text{CF}}}}} + {{n}_{{{\text{C}}{{{\text{F}}}_{{\text{2}}}}}}}$ в смесях CF4 + Ar и C4F8 + Ar, ${{n}_{{{\text{CF}}}}} + {{n}_{{{\text{C}}{{{\text{F}}}_{{\text{2}}}}}}} + {{n}_{{{\text{CHF}}}}}~$ в смеси CHF3 + Ar) возрастает в ряду CF4–CHF3–C4F8, при этом разрыв между первой и последней системами достигает двух порядков величины. Такая ситуация обусловлена высокими скоростями генерации CF2 в плазме C4F8 + Ar в реакциях R14, R16 и R18. Увеличение ${{y}_{{{\text{Ar}}}}}$ сопровождается пропорциональным снижением npol в системах CHF3 + Ar (в ~4.2 раза при 0–75% Ar) и C4F8 + Ar (в ∼3.8 раза при 0–75% Ar), но значительно более медленным изменением этой величины в плазме CF4 + Ar (в ~1.4 раза при 0–75% Ar). Причиной последнего эффекта является увеличение частот диссоциации CF4 по механизмам R6 и R7 (16.2–34.4 с–1 при 0–75% Ar), а также CF3 (28.8–51.0 с–1при 0–75% Ar ) и CF2 (40.2–74.1 с–1 при 0–75% Ar) по R6 из-за одновременного увеличения температуры и концентрации электронов. Аналогичные закономерности наблюдаются и для плотностей потоков полимеробразующих частиц на обрабатываемую поверхность.
− Концентрация $\left( {{{n}_{{\text{F}}}}} \right)$ и плотность потока $\left( {{{{\Gamma }}_{{\text{F}}}}} \right)$ атомов фтора уменьшается в ряду CF4–C4F8–CHF3, при этом величины обоих параметров в последней системе существенно ниже. Такая особенность плазмы CHF3 + Ar обусловлена 1) низкими скоростями генерации атомов фтора по причине ${{k}_{{14}}}$ < ${{k}_{6}};$ и 2) высокими скоростями конверсии F → HF по механизму R11. Менее значимые различия ${{n}_{{\text{F}}}}$ и ${{{\Gamma }}_{{\text{F}}}}$ в плазме смесей iCF4 + Ar и C4F8 + Ar (что согласуется с данными работы [11]) связаны с более высокой скоростью гибели атомов в последней системе из-за R18. Увеличение ${{y}_{{{\text{Ar}}}}}$ во всех смесях сопровождается более медленном снижением концентрации атомов фтора, чем это следует из изменения параметра $\left( {1 - {{y}_{{{\text{Ar}}}}}} \right).$ В системе CF4 + Ar (${{n}_{{\text{F}}}}$ = 1.1 × 1013–6.4 × 1012 см–3, или в ~1.8 раза при 0–75% Ar) причиной данного эффекта является аналогичное изменение суммарной скорости генерации атомов в R6 и R7. Напротив, в смесях CHF3 + Ar (${{n}_{{\text{F}}}}$ = 3.8 × 1012–3.0 × 1012 см–3, или в ~1.3 раза при 0–75% Ar) и C4F8 + Ar (${{n}_{{\text{F}}}}$ = 7.1 × × 1012–4.1 × 1012 см–3, или в ~1.7 раза при 0–75% Ar) имеет место снижение суммарной частоты гибели атомов за счет объемных процессов R11 и R18.
Расчеты показали, что полимеризационная нагрузка плазмы на контактирующие с ней поверхности, определяемая отношением ${{{{{\Gamma }}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{\Gamma }}_{{{\text{pol}}}}}} {{{{\Gamma }}_{{\text{F}}}}}}} \right. \kern-0em} {{{{\Gamma }}_{{\text{F}}}}}},$ максимальна в системе C4F8 + Ar и минимальна в плазме смеси CF4 + Ar (рис. 4а). Аналогичным образом различаются и стационарные толщины фторуглеродных полимерных пленок (рис. 4б), что согласуется с изменением параметра $z{\text{/}}x$ (или F/C) в молекуле CxHyFz. Особенностью системы CF4 + Ar в условиях ${{y}_{{{\text{Ar}}}}}$ = 0–75% являются близкие к постоянным значения параметров ${{{{{\Gamma }}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{\Gamma }}_{{{\text{pol}}}}}} {{{{\Gamma }}_{{\text{F}}}}}}} \right. \kern-0em} {{{{\Gamma }}_{{\text{F}}}}}}$ и ${{{{{\Gamma }}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{\Gamma }}_{{{\text{pol}}}}}} {\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}{{{\Gamma }}_{{\text{F}}}}}}} \right. \kern-0em} {\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}{{{\Gamma }}_{{\text{F}}}}}},$ что указывает на слабую зависимость скорости поверхностной полимеризации и остаточного количества полимера от начального состава плазмообразующей смеси. Этот вывод качественно согласуется с данными работы [6]. В то же время, увеличение доли аргона в смесях CHF3 + Ar и C4F8 + Ar сопровождается близким к пропорциональному снижению ${{h}_{{{\text{pol}}}}}$ (в ~3.3 раза и ~3.8 раза, соответственно, при 0–75% Ar). Такими образом, варьирование параметра ${{y}_{{{\text{Ar}}}}}$ в этих системах является эффективным инструментом регулирования толщины фторуглеродной полимерной пленки и связанных с этим выходных параметров реактивно-ионных процессов – скорости и анизотропии. Отметим также, что вывод о более высокой полимеризационной способности системы C4F8 + Ar по сравнению с CHF3 + Ar имеет прямое экспериментальное подтверждение. В частности, в работе [6] было показано, что значения ${{h}_{{{\text{pol}}}}}$ на Si, SiO2 и Si3N4 при обработке в плазме CHF3 в 1.5–2 раза ниже, чем в плазме C4F8. Близкое значение ~2.1 дает и отношение параметров ${{{{{\Gamma }}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{\Gamma }}_{{{\text{pol}}}}}} {\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}{{{\Gamma }}_{{\text{F}}}}}}} \right. \kern-0em} {\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}{{{\Gamma }}_{{\text{F}}}}}}$ для этих систем по данным рис. 4б.
Рис. 4.
Отношения плотностей потоков активных частиц, характеризующие эффекты гетерогенного взаимодействия плазмы с поверхностью.
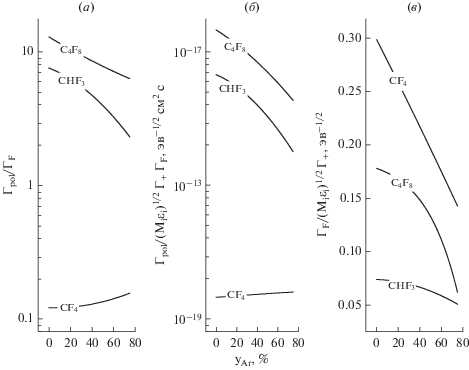
Отмеченные различия систем CF4 + Ar, CHF3 + + Ar и C4F8 + Ar по параметрам $~\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }},$ ${{h}_{{{\text{pol}}}}}$ и ${{{\Gamma }}_{{\text{F}}}}$ позволяют интерпретировать экспериментальные данные по выходным характеристикам реактивно-ионного травления Si и SiO2 [6, 26] с точки зрения механизмов гетерогенного взаимодействия. В частности, в работе [6] сообщается о близких скоростях травления кремния в плазме чистых CHF3 и C4F8 в близком к нашему диапазоне условий. Очевидно, что более толстая полимерная пленка, образующаяся на поверхности кремния в плазме C4F8, обеспечивает низкие значения эффективной вероятности взаимодействия атомов фтора (в предположении ${{\gamma }_{R}}$ ~ ${1 \mathord{\left/ {\vphantom {1 {{{h}_{{{\text{pol}}}}}}}} \right. \kern-0em} {{{h}_{{{\text{pol}}}}}}}$) и, таким образом, сводит на нет преимущество данной системы по величине ${{{\Gamma }}_{{\text{F}}}}.$ Это подтверждается близким значениями параметров ${{\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}{\Gamma }_{{\text{F}}}^{2}} \mathord{\left/ {\vphantom {{\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}{\Gamma }_{{\text{F}}}^{2}} {{{{\Gamma }}_{{{\text{pol}}}}}}}} \right. \kern-0em} {{{{\Gamma }}_{{{\text{pol}}}}}}}$ по результатам наших расчетов. В то же время, существенные различия в скоростях травления SiO2 (~400 нм/мин в плазме CHF3 и ~520 нм/мин в плазме C4F8 [6]) указывают на протекание процесса травления в режиме классической ионно-стимулированной реакции с ${{\gamma }_{R}}$ ~ $\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}$ [4, 11, 24]. Соответственно, отношение скоростей травления SiO2 в чистых C4F8 и CHF3 (~1.3) хорошо согласуется с отношением параметров $~\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}{{{\Gamma }}_{{\text{F}}}}$ в этих системах (~1.4).Такая ситуация обеспечивается условием ${{h}_{{{\text{pol}}}}}$(SiO2) $ \ll $ ${{h}_{{{\text{pol}}}}}$(Si) [6] и, как следствие, отсутствием лимита скорости травления SiO2 диффузией атомов фтора в слое полимера. Можно ожидать также, что с увеличением доли аргона в плазмообразующей смеси преимущество системы C4F8 + Ar по селективности травления SiO2/Si будет снижаться за счет относительного (по сравнению с CHF3 + Ar) роста скорости травления кремния. Причиной данного эффекта может служить снижение величины ${{h}_{{{\text{pol}}}}},$ способствующее переходу от диффузионно-лимитируемого к кинетическому режиму травления, скорость которого определяется скоростью спонтанной химической реакции Si + xF → → SiFx. Очевидно, что в такой ситуации соотношение скоростей травления кремния в системах CHF3 + Ar и C4F8 + Ar в условиях одинаковой температуры поверхности будет определяться соотношением величин ${{{\Gamma }}_{F}}.$ Аналогичные аргументы могут быть использованы и для объяснения различий скоростей травления Si и SiO2 в плазме CF4 и C4F8 по данным работы [26]. Так, близкие значения скорости травления SiO2 (∼320 нм/мин в плазме CF4 и ~290 нм/мин в плазме C4F8) соответствуют близким значениям параметров $\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}{{{\Gamma }}_{{\text{F}}}},$ определяющим скорость ионно-стимулированной химической реакции без учета влияния ${{h}_{{{\text{pol}}}}}.$ Значительные различия в скоростях травления кремния (~250 нм/мин в плазме CF4 и ~50 нм/мин в плазме C4F8) не могут быть связаны лишь с различием величин ${{{\Gamma }}_{{\text{F}}}}$ (~2.5 × 1017 см–2 с–1 в плазме CF4 и ~1.8 × 1017 см–2 с–1 в плазме C4F8), но обусловлены ${{\gamma }_{R}}$ (C4F8) $ \ll $ ${{\gamma }_{R}}$ (CF4) по причине ${{h}_{{{\text{pol}}}}}$ (C4F8) $ \gg $ ${{h}_{{{\text{pol}}}}}$ (CF4) (рис. 4б). Таким образом, анализ кинетики процессов травления и полимеризации в плазме смесей CF4 + Ar, CHF3 + Ar и C4F8 + Ar с использованием расчетных отношений плотностей потоков частиц показывает хорошее согласие с экспериментальными данными и обеспечивает адекватное понимание особенностей этих систем.
В заключение отметим, что максимальная среди исследованных систем полимеризационная способность плазмы C4F8 (рис. 4б) обеспечивает ей очевидные преимущества в анизотропии травления кремния за счет лучшего маскирования полимером боковых стенок формируемого рельефа [4]. При переходе к смесям с высоким содержанием аргона (и, как следствие, снижении количества и маскирующей способности высаживаемого полимера) определяющее влияние на показатель анизотропии приобретает параметр $~{{{{{\Gamma }}_{{\text{F}}}}} \mathord{\left/ {\vphantom {{{{{\Gamma }}_{{\text{F}}}}} {\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}}}} \right. \kern-0em} {\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}}},$ отражающий соотношение скоростей спонтанной и ионно-стимулированной химической реакции. Можно видеть (см. рис. 4в), что в таких условиях системы CHF3 + Ar и C4F8 + Ar демонстрируют близкие характеристики и сохраняют очевидное преимущество по сравнению с CF4 + Ar.
ЗАКЛЮЧЕНИЕ
Проведено сравнительное исследование электрофизических параметров плазмы, кинетики активных частиц и стационарного состава газовой фазы в смесях CF4 + Ar, CHF3 + Ar и C4F8 + Ar в условиях индукционного ВЧ (13.56 МГц) разряда. В качестве основных методов исследования выступали диагностика плазмы зондами Лангмюра и моделирование плазмы. При совместном анализе расчетных и экспериментальных данных: 1) выявлены механизмы процессов, формирующих стационарные электрофизические параметры плазмы (температура и концентрация электронов, энергия ионной бомбардировки) в исследуемых системах; 2) определены ключевые плазмохимические процессы, определяющие различие исследуемых систем по концентрациям и плотностям потоков атомов фтора и полимеробразующих радикалов; 3) показана возможность отслеживать выходных характеристик реактивно-ионных процессов (скорость, селективность, анизотропия) с помощью модельных параметров, характеризующих основные механизмы гетерогенного взаимодействия (взаимодействие атомов фтора с атомами поверхности, образование и деструкция фторуглеродной полимерной пленки). Установлено, что в исследованном ряду газов полимеризационная активность плазмы (скорость высаживания полимерной пленки и ее стационарная толщина) однозначно коррелируют с параметром $z{\text{/}}x$ в молекуле CxHyFz. В то же время, концентрация атомов фтора и параметры ионной компоненты плазмы (плотность потока ионов, энергия ионной бомбардировки) в значительной степени определяются индивидуальными особенностями кинетики плазмохимических процессов в рассматриваемых системах.
Исследование выполнено при финансовой поддержке РФФИ в рамках научных проектов 19-07-00804А (А.М. Ефремов) и 18-37-00064мол_а (Д.Б. Мурин)
Список литературы
Wolf S., Tauber R.N. Silicon Processing for the VLSI Era. Volume 1. Process Technology. Lattice Press, N.Y., 2000. 416 p.
Roosmalen A.J., Baggerman J.A.G., Brader S.J.H. Dry etching for VLSI. Plenum Press, N.Y., 1991. 490 p.
Rossnagel S.M., Cuomo J.J., Westwood W.D. (Eds.). Handbook of plasma processing technology. NoyesPublications, ParkRidge, 1990. 338 p.
Lieberman M.A., Lichtenberg A.J. Principles of plasma discharges and materials processing. JohnWiley & Sons Inc., N.Y., 1994. 757 p.
Kimura T., Ohe K. Model and probe measurements of inductively coupled CF4 discharges // J. Appl. Phys. 2002. V. 92. P. 1780–1787.
Standaert T.E.F.M., Hedlund C., Joseph E.A., Oehrlein G.S. Role of fluorocarbon film formation in the etching of silicon, silicondioxide, silicon nitride, and amorphous hydrogenated silicon carbide // J. Vac. Sci. Technol. A. 2004. V. 22. P. 53–60.
Proshina O., Rakhimova T.V., Zotovich A., Lopaev D.V., Zyryanov S.M., Rakhimov A.T. Multifold study of volume plasma chemistry in Ar/CF4 and Ar/CHF3 CCP discharges // Plasma Sources Sci. Technol. 2017. V. 26. P. 075005.
Kokkoris G., Goodyear A., Cooke M., Gogolides E. A global model for C4F8 plasmas coupling gas phase and wall surface reaction kinetics // J. Phys. D: Appl. Phys. 2008. V. 41. P. 195211.
Lee H.K., Chung K.S., Yu J.S. Selective Etching of Thick Si3N4, SiO2 and Si by Using CF4/O2 and C2F6 Gases with or without O2 or Ar Addition // J. Korean Phys. Soc. 2009. V. 54. P. 1816–1824.
Kimura T., Ohe K. Probe measurements and global model of inductively coupled Ar/CF4 discharges // Plasma Sources Sci. Technol. 1999. V. 8. P. 553–560.
Chun I., Efremov A., Yeom G.Y., Kwon K.-H. A comparative study of CF4/O2/Ar and C4F8/O2/Ar plasmas for dry etching applications // Thin Solid Films. 2015. V. 579. P. 136–148.
Ефремов А.М., Мурин Д.Б., Kwon K.-H. Параметры плазмы и кинетика активных частиц в смесях CF4 (CHF3) + Ar переменного начального состава // Микроэлектроника. 2018. Т. 47. № 6. С. 414–423.
Ho P., Johannes J.E., Buss R.J. Modeling the plasma chemistry of C2F6 and CHF3 etching of silicon dioxide, with comparisons to etch rate and diagnostic data // J. Vac. Sci. Technol. A. 2001. V. 19. P. 2344–2367.
Bose D., Rao M.V.V.S., Govindan T.R., Meyyappan M. Uncertainty and sensitivity analysis of gas-phase chemistry in a CHF3 plasma // Plasma Sources Sci. Technol. 2003. V. 12. P. 225–234.
Rauf S., Ventzek P.L.G. Model for an inductively coupled Ar/c-C4F8 plasma discharge // J. Vac. Sci. Technol. A. 2002. V. 20. P. 14–23.
Yeom G.Y., Kushner M.J. Si/SiO2 etch properties using CF4 and CHF3 in radio frequency cylindrical magnetron discharges // Appl. Phys. Lett. 1990. V. 56. P. 857–859.
Lele C., Liang Z., Linda X., Dongxia L., Hui C., Tod P. Role of CF2 in the etching of SiO2, Si3N4 and Si in fluorocarbon plasma // J. Semicond. 2009. V. 30. P. 033005-1.
Son J., Efremov A., Yun S.J., Yeom G.Y., Kwon K.-H. Etching characteristics and mechanism of SiNxfilms for Nano-Devices in CH2F2/O2/Ar inductively coupled plasma:EffectofO2 mixing ratio // J. Nanosci. Nanotech. 2014. V. 14. P. 9534–9540.
Johnson E.O., Malter L. A floating double probe method for measurements in gas discharges // Phys. Rev. 1950. V. 80. P. 58–70.
Sugavara M. Plasma etching: Fundamentals and applications. Oxford University Press. N.Y., 1998. 469 p.
Kay E., Coburn J., Dilks A. Plasma chemistry of fluorocarbons as related to plasma etching and plasma polymerization. In: Veprek S., Venugopalan M. (eds) Plasma Chemistry III. Topics in Current Chemistry. V. 94. Springer, Berlin, Heidelberg. 1980.
Kay E., Dilks A. Plasma polymerization of fluorocarbons in rfcapacitively coupled diode system // J. Vac. Sci. Tech. 1981. V. 18. P. 1–11.
Stoffels W.W., Stoffels E., Tachibana K. Polymerization of fluorocarbons in reactive ion etching plasmas // J. Vac. Sci. Tech. A. 1998. V. 16. P. 87–95.
Gray D.C., Tepermeister I., Sawin H.H. Phenomenological modeling of ion enhanced surface kinetics in fluorine-based plasma etching // J. Vac. Sci. Technol. B. 1993. V. 11. P. 1243–1257.
Matsui M., Tatsumi T., Sekine M. Relationship of etch reaction and reactive species flux in C4F8–Ar–O2 plasma for SiO2 selective etching over Si and Si3N4 // J. Vac. Sci. Technol. A. 2001. V. 19. P. 2089–2096.
Doh H.-H., Kim J.-H., Lee S.-H., Whang K.-W. Mechanism of selective SiO2/Si etching with fluorocarbon gases (CF4, C4F8) and hydrogen mixture in electron cyclotron resonance plasma etching system // J. Vac. Sci. Technol. A. 1993. V. 14. P. 2827–2834.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника


