Микроэлектроника, 2019, T. 48, № 5, стр. 334-342
Одноэлектронный транзистор на линейной структуре из трех туннельно-связанных КТ с электрическим и оптическим управлением
Физико-технологический институт имени К.А. Валиева Российской АН
117218 Москва, Нахимовский проспект 34, корп. 1, Россия
* E-mail: tsukanov@ftian.ru
** E-mail: a-v-ts@mail.ru
Поступила в редакцию 16.01.2019
После доработки 27.02.2019
Принята к публикации 15.03.2019
Аннотация
Рассмотрена принципиальная схема одноэлектронного транзистора с чувствительным элементом на основе резонансно-туннельной наноструктуры из трех полупроводниковых квантовых точек. Электронная плотность в установившемся режиме (ток) на выходе из структуры рассчитывалась численно в рамках модели с некогерентным транспортом электронов между крайними точками и металлическими контактами-резервуарами. Получены зависимости электронной плотности от времени и параметров системы. Показано, что существуют наборы параметров, которые могут обеспечить высокую чувствительность и надежность измерений внешнего электрического поля. Также предложена альтернативная схема транзистора с оптическим управлением, в которой электронный транспорт через структуру поддерживается с помощью резонансного лазерного поля.
1. ВВЕДЕНИЕ
Миниатюризация основных элементов электронных схем обуславливает появление у них новых физических свойств и открывает новые возможности их использования [1]. Если характерные размеры устройств оказываются сопоставимыми с длиной волны де Бройля, то при их разработке и моделировании необходимо учитывать квантовые эффекты. Пожалуй, наиболее известным объектом, чьи минимальные размеры служат в качестве характеристики не только устройства в целом, но и технологии изготовления, является транзистор. В формулировке эмпирического закона Мура, иллюстрирующего рост вычислительной производительности компьютеров за последние несколько десятилетий, количество транзисторов на одном кристалле-чипе фигурирует как мера внутренней интегрированности данного чипа. Простейший транзистор состоит из трех элементов: стока, источника и затвора. Протекание тока от источника к стоку через полупроводниковый кристалл (канал) зависит от электрического потенциала затвора. В классическом варианте затвор представляет собой металлический электрод, который, в зависимости от поданного на него напряжения, либо открывает, либо закрывает канал для электрического тока.
В начале 90-х годов XX века, когда стало возможным изготовление полупроводниковых и металлических структур с субмикронным разрешением, появилась принципиально новая модификация транзистора. Теперь сплошное пространство между стоком и источником заменяется металлической или полупроводниковой квантовой точкой (КТ), электронный спектр которой обладает высокой степенью дискретности [2]. Носители заряда переносятся из резервуара-источника в центральную область, где расположена КТ, и далее в резервуар-сток, за счет эффекта электронного туннелирования. Главным условием такого переноса является расположение транспортного уровня в КТ ниже уровня Ферми источника и выше уровня Ферми стока. При этом энергия кулоновского взаимодействия электронов в КТ оказывается настолько высокой, что инжекция второго электрона смещает энергию транспортного уровня выше энергии Ферми источника. Это немедленно приводит к падению тока через КТ (т.н. эффект кулоновской блокады). Таким образом, в токовом режиме только один электрон может находиться в КТ. Это обстоятельство и отражает название устройства – одноэлектронный транзистор (ОЭТ) [3]. Варьирование электрического потенциала на затворе плавно смещает энергию транспортного уровня в КТ за счет эффекта Штарка. Результатом этого смещения может быть как усиление, так и ослабление туннельного тока. В ходе дальнейшего усовершенствования было предложено несколько разновидностей данной схемы, ориентированных на оптимизацию ее рабочих характеристик. В настоящее время ОЭТ с одиночной КТ широко используются в качестве высокочувствительных детекторов электрических полей и, в частности, в квантовых измерениях (мониторинг состояния зарядового кубита [4]).
В нашей работе рассматриваются два новых подхода к улучшению свойств ОЭТ. Во-первых, предлагается заменить одиночную КТ линейной структурой-“молекулой” из трех туннельно-связанных КТ. В этом случае транспортный уровень молекулы, представляющий собой суперпозицию уровней отдельных КТ, оказывается более чувствительным к изменению внешнего электрического поля. Так, для подавления туннельного тока достаточно отстроить энергии уровней соседних КТ на величину порядка энергии туннелирования, что существенно меньше энергии кулоновского взаимодействия в описанной выше схеме с одной КТ. Во-вторых, если асимметрия уровней в КТ-молекуле, возникшая в процессе ее синтеза и связанная с различием параметров КT (химического состава, размеров и т.д.), ухудшает транспортные (туннельные) свойства структуры, то можно воспользоваться альтернативным способом перемещения электронов с помощью оптического резонансного поля. В самом деле, если наложить на структуру лазерное поле с частотой, близкой к отстройке уровней соседних КТ, то последние теперь будут связаны за счет косых дипольных переходов электрона между данными уровнями. Для контроля такой динамики ОЭТ могут быть адаптированы известные из атомной оптики алгоритмы.
В ходе проведенного численного моделирования динамики электронов в открытой структуре получены зависимости заселенностей ее одно- и двухэлектронных состояний от времени и некоторых рабочих параметров. Как будет показано, существуют такие наборы их значений, для которых чувствительность ОЭТ к изменениям в электрическом окружении оказывается чрезвычайно высокой. С другой стороны, ток через ОЭТ в стационарном режиме демонстрирует устойчивость по отношению к флуктуациям структурных параметров, которые обычно приводят к нарушению электронного когерентного транспорта в замкнутой структуре.
2. МОДЕЛЬ ОДНОЭЛЕКТРОННОГО ТРАНЗИСТОРА С НЕКОГЕРЕНТНОЙ ТУННЕЛЬНОЙ НАКАЧКОЙ И ЭЛЕКТРООПТИЧЕСКИМ УПРАВЛЕНИЕМ
Рассмотрим квазиодномерную наноструктуру, состоящую из двух металлических контактов, которые представляют собой электронные резервуары (источник S и сток D), и цепочки из трех КТ (L, C и R). Благодаря конфигурации уровней Ферми εS(D) контактов и уровней КТ, показанной на рис. 1, возможно движение электронов через структуру слева направо. Для описания процесса попадания электрона из источника в левую КТ и из правой КТ в сток мы воспользуемся реалистичной и общепринятой моделью некогерентного (одностороннего) туннелирования [5]. Внутри наноструктуры электрон туннелирует между КТ когерентным образом. Будем предполагать наличие связанных состояний $\left| L \right\rangle $ в левой КТ и $\left| R \right\rangle $ в правой КТ, и двух состояний $\left| C \right\rangle $ и $\left| g \right\rangle $ в центральной КТ, с энергиями ${{\varepsilon }_{L}},$ ${{\varepsilon }_{R}},$ ${{\varepsilon }_{C}}$ и ${{\varepsilon }_{g}},$ соответственно. При наложении на структуру электрического поля E энергии смещаются вследствие эффекта Штарка:
Рис. 1.
Вверху: принципиальная схема одноэлектронного транзистора с центральной частью, представленной наноструктурой из трех туннельно-связанных КТ. Внизу: потенциальный профиль наноструктуры и энергетические уровни КТ. Пунктиром отмечено положение энергии состояния $\left| C \right\rangle $ в центральной КТ в отсутствие внешнего поля (см. текст).
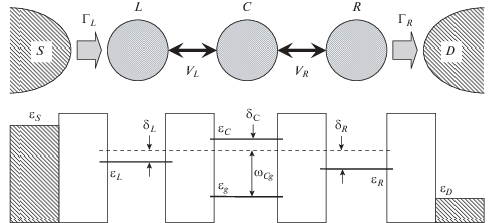
где
(2)
${{H}_{0}} = {{\varepsilon }_{L}}\left| L \right\rangle \left\langle L \right| + {{\varepsilon }_{R}}\left| R \right\rangle \left\langle R \right| + {{\varepsilon }_{C}}\left| C \right\rangle \left\langle C \right| + {{\varepsilon }_{g}}\left| g \right\rangle \left\langle g \right|,$(3)
${{H}_{V}} = - {{V}_{L}}\left( {\left| C \right\rangle \left\langle L \right| + \left| L \right\rangle \left\langle C \right|} \right) - {{V}_{R}}\left( {\left| C \right\rangle \left\langle R \right| + \left| R \right\rangle \left\langle C \right|} \right),$(4)
$\begin{gathered} {{H}_{{{\text{coul}}}}} = {{U}_{{L,R}}}\left| {L,R} \right\rangle \left\langle {L,R} \right| + {{U}_{{L,C}}}\left| {L,C} \right\rangle \left\langle {L,C} \right| + {{U}_{{R,C}}}\left| {R,C} \right\rangle \left\langle {R,C} \right| + {{U}_{{L,g}}}\left| {L,g} \right\rangle \left\langle {L,g} \right| + {{U}_{{R,g}}}\left| {R,g} \right\rangle \left\langle {R,g} \right| - \\ - \,\,{{V}_{{L - C,R}}}\left( {\left| {L,R} \right\rangle \left\langle {C,R} \right| + \left| {C,R} \right\rangle \left\langle {L,R} \right|} \right) - {{V}_{{R - C,L}}}\left( {\left| {R,L} \right\rangle \left\langle {C,L} \right| + \left| {C,L} \right\rangle \left\langle {R,L} \right|} \right). \\ \end{gathered} $Наложение на структуру лазерного поля с частотой ${{\omega }_{L}},$ близкой к частоте перехода ${{\omega }_{{Cg}}} = {{\varepsilon }_{C}} - {{\varepsilon }_{g}}$ в центральной КТ, вызывает прямой $\left| g \right\rangle \leftrightarrow \left| C \right\rangle $ и косые $\left| g \right\rangle \leftrightarrow \left| {R(L)} \right\rangle $ оптические переходы. Их интенсивность (частота Раби) ${{\Omega }_{{k,g}}} = {{{{{\mathbf{E}}}_{L}}{{{\mathbf{d}}}_{{k,g}}}} \mathord{\left/ {\vphantom {{{{{\mathbf{E}}}_{L}}{{{\mathbf{d}}}_{{k,g}}}} 2}} \right. \kern-0em} 2}$ зависит от напряженности поля EL и величины матричного элемента ${{{\mathbf{d}}}_{{k,g}}} = \left\langle k \right| - e{\mathbf{r}}\left| g \right\rangle .$ Кроме того, отношение отстройки ${{\Delta }_{L}} = {{\omega }_{{Cg}}} - {{\omega }_{L}}$ частот перехода и поля к частоте Раби определяет характер переходов (резонансный при ${{\Omega }_{{k,g}}} \gg \left| {{{\Delta }_{L}}} \right|$ или нерезонансный при ${{\Omega }_{{k,g}}} \ll \left| {{{\Delta }_{L}}} \right|$). Для двухэлектронных конфигураций частоты Раби $\tilde {\Omega }_{{k,g}}^{j}$ переходов будут немного отличаться от одноэлектронных вследствие изменения координатной зависимости волновых функций в КТ с учетом кулоновского отталкивания. Гамильтониан взаимодействия структуры с лазерным полем выглядит следующим образом:
(5)
$\begin{gathered} {{H}_{L}} = 2\left( {{{\Omega }_{{C,g}}}\left| C \right\rangle \left\langle g \right| + {{\Omega }_{{L,g}}}\left| L \right\rangle \left\langle g \right|} \right. + \left. {{{\Omega }_{{R,g}}}\left| R \right\rangle \left\langle g \right|} \right)\cos \left( {{{\omega }_{L}}t} \right) + 2\left( {\tilde {\Omega }_{{C,g}}^{L}\left| {C,L} \right\rangle \left\langle {g,L} \right|} \right. + \\ + \,\,\left. {\tilde {\Omega }_{{C,g}}^{R}\left| {C,R} \right\rangle \left\langle {g,R} \right|} \right)\cos \left( {{{\omega }_{L}}t} \right) + 2\left( {\tilde {\Omega }_{{R,g}}^{L}\left| {L,R} \right\rangle \left\langle {g,L} \right|} \right. + \left. {\tilde {\Omega }_{{L,g}}^{R}\left| {L,R} \right\rangle \left\langle {g,R} \right|} \right)\cos \left( {{{\omega }_{L}}t} \right) + {\text{э }}{\text{.с }}. \\ \end{gathered} $Выбирая за начало отсчета энергию ${{\varepsilon }_{g}}$ основного состояния $\left| g \right\rangle ,$ а затем, переходя в систему отсчета, связанную с лазером, можно с учетом приближения вращающейся волны переписать гамильтониан в стационарном виде, где теперь
(6)
${{H}_{0}} = \left( {{{\Delta }_{L}} + {{\delta }_{{L,0}}} + {{\delta }_{L}}} \right)\left| L \right\rangle \left\langle L \right| + \left( {{{\Delta }_{L}} + {{\delta }_{{R,0}}} + {{\delta }_{R}}} \right)\left| R \right\rangle \left\langle R \right| + \left( {{{\Delta }_{L}} + {{\delta }_{C}}} \right)\left| C \right\rangle \left\langle C \right|,$(7)
$\begin{gathered} {{H}_{L}} = {{\Omega }_{{C,g}}}\left| C \right\rangle \left\langle g \right| + {{\Omega }_{{L,g}}}\left| L \right\rangle \left\langle g \right| + {{\Omega }_{{R,g}}}\left| R \right\rangle \left\langle g \right| + \tilde {\Omega }_{{C,g}}^{L}\left| {C,L} \right\rangle \left\langle {g,L} \right| + \\ + \,\,\tilde {\Omega }_{{C,g}}^{R}\left| {C,R} \right\rangle \left\langle {g,R} \right| + \tilde {\Omega }_{{R,g}}^{L}\left| {L,R} \right\rangle \left\langle {g,L} \right| + \tilde {\Omega }_{{L,g}}^{R}\left| {L,R} \right\rangle \left\langle {g,R} \right| + {\text{э }}{\text{.с }}. \\ \end{gathered} $Параметры, входящие в уравнения (6) и (7), являются или константами, или медленно меняющимися функциями времени.
Чтобы изучить эволюцию состояния нашей системы, представленную матрицей плотности ρ, мы воспользуемся уравнением Линдблада
которое включает в себя и диссипативные компоненты. Такой подход дает возможность рассматривать открытую структуру в токовом режиме. Электроны попадают в левую КТ из источника S со скоростью ΓL (при условии, что состояние $\left| L \right\rangle $ не заселено) и уходят из правой КТ в сток D со скоростью ΓR. Кроме того, учитывается туннельное взаимодействие резервуаров со структурой, уже содержащей один электрон в состоянии |k〉, со скоростями ΓL(R),k, где k = g, С, R(L). Все эти процессы необратимы и моделируются операторами Линдблада $D\left( A \right) = A\rho {{A}^{\dag }} - {{\left[ {{{A}^{\dag }}A,\rho } \right]} \mathord{\left/ {\vphantom {{\left[ {{{A}^{\dag }}A,\rho } \right]} 2}} \right. \kern-0em} 2}.$ Состояние $\left| {va{{c}_{{L\left( R \right)}}}} \right\rangle $ соответствует незаселенной левой (правой) КТ.
Аналогично вводятся и другие диссипативные процессы, оказывающие влияние на динамику носителей заряда в наноструктурах – релаксация и дефазировка. Скорости релаксации при прямом переходе в центральной КТ равны γgС и γgС,L(R) в структуре с одно- и двухэлектронным заселением, соответственно. Косые переходы, связывающие крайние КТ с центральной, характеризуются скоростями релаксации γgL(R), γgL,R и γgR,L. Поскольку для питания ОЭТ применяется некогерентная накачка со скоростью, значительно превышающей скорость фононной дефазировки, то уширение уровней будет определяться параметрами ΓL(R). Что касается релаксации электрона, то ее скорость зависит от частоты перехода. В GaAs-соединениях при частотах, меньших 1 мэВ, релаксация связана с акустическими фононами, а выше 10–15 мэВ она обусловлена двухчастичными процессами распада полярона [6]. Влияние диссипации на когерентную эволюцию КТ – кубитов препятствует выполнению квантовых операций. В установившемся режиме, напротив, она может повышать скорость измерения [7].
Уравнение (8) интегрируется на достаточно длительном отрезке времени T $ \gg $ 1/ΓL(R), в конце которого система переходит в стационарный режим. В качестве начального условия выбирается вакуумное чистое состояние, когда в структуре нет электронов. Наш подход применим к КТ любого типа (кристаллическим или электрическим). Все параметры выражаются в единицах частоты перехода ωСg, которая принадлежит интервалу от 0.05 до 0.1 эВ. Энергия туннелирования обычно не превышает 0.1–1 мэВ при толщине барьера 10–20 нм между соседними КТ. Напротив, энергия кулоновского отталкивания двух электронов достаточно большая и может достигать значений 1–10 мэВ и выше. Что касается туннельных и оптических переходов между двухэлектронными конфигурациями, то их энергии берутся меньше, чем для одноэлектронных процессов. Конечным результатом расчетов является заселенность ρRR состояния $\left| R \right\rangle $ правой КТ. Ток на выходе ОЭТ в установившемся режиме, I = eΓRρRR/h (h – постоянная Планка) пропорционален величине ρRR, которая зависит от различных факторов. Учитывая, что в экспериментах, связанных с электронным транспортом через КТ, сила тока составляет несколько наноампер, и используя соотношение e/h = 2.4 × 1014 А/Дж, получаем ΓL(R) ~ 10–5–10–4.
3. ДИНАМИКА ОЭТ В ОТСУТСТВИЕ ЛАЗЕРНОГО ПОЛЯ
Прежде всего, мы изучим основные свойства ОЭТ в отсутствие лазерного поля. Как уже упоминалось, принцип работы любого транзистора базируется на зависимости тока через канал от внешнего электрического поля. Если он используется в качестве детектора элементарных зарядов [8], то приход/уход электрона, вызывающий скачок энергии транспортного уровня КТ, должен приводить к заметному изменению квантового тока. В нашем случае оно связано не с подъемом уровня КТ выше энергии Ферми источника, а с изменением условий туннелирования электронов между КТ. Целесообразно выбирать параметры ОЭТ для измерения таким образом, чтобы малым сдвигам уровней КТ отвечали значительные колебания силы тока. Это позволит расположить ОЭТ на достаточном удалении от области измерения. На интуитивном уровне чувствительность ОЭТ, работающего по такому принципу, можно связать с производной заселенности правой КТ ρRR по каждой из отстроек. Другой его важной характеристикой является отношение сигнала к шуму, которое ограничивается процессами рассеяния в структуре, например, электронной релаксацией, вызываемой фононами. Наконец, серьезную роль в практических приложениях ОЭТ играет быстродействие, обусловленное процессом его перехода в стационарный токовый режим.
В первую очередь интерес представляет отклик структуры на изменение в ее электрическом окружении, влияющем на протекание тока. Наложение дополнительного электрического поля приводит к смещению электронных уровней в КТ и к изменению высоты разделяющих их потенциальных барьеров. Это, в свою очередь, вызывает резкое изменение энергии туннелирования вследствие ее экспоненциальной зависимости от мощности (произведения высоты на толщину) барьера. При этом кулоновские энергии меняются слабо, завися главным образом от фиксированного расстояния между центрами КТ. Следовательно, с практической точки зрения, важно изучить поведение заселенностей структуры от параметров ${{\delta }_{k}}$ и VL(R). Более конкретно, на электронный транспорт оказывают влияние разности ${{\delta }_{C}} - {{\delta }_{L}}$ и ${{\delta }_{R}} - {{\delta }_{L}},$ являющиеся мерами относительных смещений энергий в разных КТ.
Прежде всего, нужно убедиться, что электрон может свободно туннелировать внутри структуры, изолированной от резервуаров. Для этого положим ΓL = ΓR = 0 и ρ(0) = ρLL. Графики 2а иллюстрируют когерентную эволюцию электрона в симметричной структуре в резонансном (вверху) и нерезонансном (внизу) режиме, представленную трех- и двухуровневыми осцилляциями Раби, соответственно. На рис. 2б показан пример эволюции заселенностей состояний этой же структуры с выходом в установившийся режим при строгом совпадении энергий уровней всех КТ, исключении уровня $\left| g \right\rangle $ (γ = 0) и балансе скоростей некогерентного туннелирования (ΓL = ΓR). Как видно, сильная туннельная связь внутри структуры способствует синхронному заселению левой и правой КТ, причем значительный вклад дают двухэлектронные компоненты ρtwo-el матрицы плотности. Чтобы ответить на вопрос, как поведет себя заселенность ρRR при отклонении от симметрии, построим ее зависимость от отстроек δC – δL и δR – δL. На рис. 3 приведены одномерный (слева) и двумерный (справа) графики этой величины. Можно заметить, что при совпадении энергий уровней левой и правой КТ (δR – δL = 0) центральный пик электронной плотности в правой КТ становится резче и выше с ростом отклонения энергии уровня в центральной КТ (|δC – δL| > VL(R)). В данном случае симметрия гамильтониана относительно центральной КТ сохраняется, но состояние $\left| C \right\rangle $ заселяется виртуально. При этом туннельная связь оказывается крайне чувствительной даже к небольшим отстройкам δR – δL, нарушающим симметрию. Следовательно, выбор данной конфигурации уровней КТ будет способствовать более точному измерению внешнего электрического поля E, которое обуславливает штарковскую отстройку, особенно при больших значениях |δC – δL|. Кроме центрального пика, связанного с одноэлектронным туннелированием, на графике присутствует небольшой пик, положение и величина которого меняется при варьировании отстроек. Он обусловлен кулоновским взаимодействием электронов в соседних КТ, которое при определенной комбинации отстроек способствует перемещению электрона между КТ. Исследуем возможность детектирования прихода электрона в КТ, которая находится на оси, соединяющей КТ L, C и R, на расстоянии l от КТ R. Расстояние между центрами соседних КТ в ОЭТ полагаем одинаковым и равным b, а характерный размер всех КТ равен r0. Тогда отстройки можно оценить как
Рис. 2.
Графики зависимостей заселенностей состояний КТ от времени для изолированной (слева) и открытой (справа) наноструктуры. Когерентная одноэлектронная эволюция изолированной структуры представлена для резонансной (вверху) и нерезонансной (внизу) конфигураций уровней КТ.

Рис. 3.
Заселенность правой КТ в установившемся режиме как функция отстроек энергий уровней в центральной и правой КТ от симметричной конфигурации.

Для кремниевых КТ (ε = 12) и набора геометрических параметров l = 100 нм, r0 = 10 нм, b = 25 нм получаем оценки δC – δL = 0.22 × 10–4 эВ и δR – δL = = 0.59 × 10–4 эВ, что в наших единицах соответствует 0.22 × 10–3 и 0.59 × 10–3. Выбор симметричной конфигурации с большой отстройкой (10–1 и выше, тонкая сплошная линия на рис. 3) в центральной КТ позволяет пренебречь дополнительным сдвигом 0.22 × 10–3, вызываемым электроном. При этом дополнительный сдвиг δR – δL в правой КТ приводит к практически полной блокаде тока через ОЭТ, что указывает на рождение электрона в тестируемой области.
Другим параметром, который непосредственно влияет на электронный транспорт, является энергия туннелирования VL(R) между соседними КТ. Она зависит от высоты и толщины барьера, разделяющего КТ L (R) и C. Можно предполагать, что чем слабее будет туннельная связь между КТ, тем чувствительнее будет и ОЭТ. Это предположение подтверждают графики (рис. 4). При совпадении энергий уровней в левой и центральной КТ (δC – δL = 0) мерой отклонения от симметрии является отстройка энергии уровня в правой КТ. Ее влияние на электронный транспорт усиливается с уменьшением параметра VL(R). При этом амплитуда пика сохраняется на всем интервале изменения VL(R), обеспечивая высокий измерительный контраст для VL(R) < 10–3. С ростом отстройки δC – δL в центральной КТ эта тенденция сохраняется, причем центральный пик становится еще резче, а боковой пик пропадает.
Рис. 4.
Заселенность правой КТ в установившемся режиме как функция отстройки энергии уровня в правой КТ и энергии туннелирования между КТ.

Кроме смещения уровней КТ, внешнее поле может приводить к независимым вариациям энергий туннелирования VL и VR. В случае когерентной одноэлектронной динамики в замкнутой трехуровневой системе подобный дисбаланс вызывает отклонения от идеальной рабиевской схемы, затрудняя перенос электрона между крайними КТ. В установившемся режиме даже значительная разность этих величин (вплоть до 50%) не приводит к заметному спаду заселенности в правой КТ (рис. 5). Это указывает, с одной стороны, на невозможность использования данного эффекта для высокочувствительных измерений, и, с другой стороны, на устойчивость канала ОЭТ к технологическим отклонениям в процессе изготовления, вызывающим разброс параметров VL и VR. Если рассматривать этот тип асимметрии совместно с отстройками в правой и центральной КТ, то можно заметить одну интересную особенность. При δC – δL = 0 наблюдается постепенное размытие и уменьшение центрального пика ρRR с увеличением разности VL – VR, однако при большой отстройке (δC – δL = 0.05) имеет место противоположная тенденция: происходит сужение пика. Определенный интерес представляет зависимость заселенности правой КТ от скоростей некогерентной накачки ΓL и отвода ΓR электронов. Эта информация может быть актуальной для оптимизации быстроты срабатывания ОЭТ (перехода системы в установившийся режим). Данный вопрос будет исследован отдельно в последующих работах.
4. ОПТИЧЕСКИЙ ТРАНСПОРТ ЭЛЕКТРОНОВ ЧЕРЕЗ ОЭТ
Довольно часто в КТ присутствуют уровни, которые не участвуют в транспорте электронов и даже представляют собой “ловушки” для них. Структура из трех КТ, имеющая такой уровень $\left| g \right\rangle $ в центральной КТ, показана на рис. 1. Если электрон находится на уровне $\left| C \right\rangle ,$ то за время τ ~ γCg он релаксирует в состояние $\left| g \right\rangle ,$ являющееся основным для данной КТ, и остается там неограниченно долго. При этом движение других электронов останавливается вследствие кулоновской блокады в центральной КТ. Чтобы восстановить транспортные свойства структуры, можно наложить на нее резонансное (лазерное) поле, которое будет “возвращать” электрон из ее основного состояния в возбужденное, компенсируя тем самым процесс релаксации и устраняя блокаду.
Альтернативный вариант переноса электрона при помощи резонансного лазерного поля базируется на возбуждении диагональных (или косых) переходов между уровнями соседних КТ. Следуя принятой в атомной оптике терминологии, будем рассматривать трехуровневую V-схему, соединяющую состояния $\left| L \right\rangle ,$ $\left| g \right\rangle $ и $\left| R \right\rangle $ двумя косыми переходами. Будем предполагать, что энергии состояний $\left| L \right\rangle $ и $\left| R \right\rangle $ достаточно близки, а их туннельная связь с состоянием $\left| C \right\rangle $ отсутствует. При этом заселено только состояние $\left| L \right\rangle ,$ и ток через ОЭТ не протекает. Если же наложить на структуру лазерное поле с частотой, близкой к частоте перехода $\left| {L(R)} \right\rangle \leftrightarrow \left| g \right\rangle $, то электрон получает возможность перейти из состояния $\left| L \right\rangle $ в состояние $\left| R \right\rangle $ через промежуточное состояние $\left| g \right\rangle $ в центральной КТ. Скорость косого перехода между соседними КТ будет значительно ниже, чем для прямого перехода $\left| C \right\rangle \leftrightarrow \left| g \right\rangle $ в КТ C, вследствие слабого перекрытия волновых функций их состояний в области барьера [9]. Поэтому следует использовать интенсивное поле для достижения приемлемой скорости оптического переноса, сопоставимой со скоростями туннельного переноса. При этом графики (рис. 6) зависимостей заселенности ρRR от отстройки δR напоминают результаты для ОЭТ с туннельной связью. Уменьшение частоты Раби ΩL(R),g в симметричной структуре, как и уменьшение величины VL(R) (рис. 4), вызывает сужение графика, что говорит об увеличении чувствительности ОЭТ к штарковским сдвигам уровней в КТ (рис. 6). При этом, однако, наблюдается тенденция к понижению максимума кривой, т.е. к уменьшению отношения сигнал/шум.
Рис. 6.
Заселенность правой КТ в установившемся режиме как функция отстройки энергии уровня в правой КТ для нескольких значений энергии Раби лазерного поля, вызывающего резонансные косые переходы в симметричной структуре из трех КТ.

Зависимость ρRR от отстройки ΔL частоты лазерного поля от положения строгого однофотонного резонанса в симметричной структуре (δL = = δR = ΔL) и от штарковкого сдвига δR уровня в правой КТ также указывает на особый режим для конфигурации δL = δR = 0 (рис. 7). В этом случае, как и для туннельного взаимодействия, чувствительность растет с ростом ΔL, указывая на преимущество измерений в режиме с большими отстройками. Продолжая аналогию между туннельной и оптической связью соседних КТ, можно отметить устойчивость тока через ОЭТ к разности оптических частот Раби. Учет релаксации приводит к резкому падению тока для частот Раби меньше некоторой критической величины и для широкого интервала изменения скорости релаксации.
ЗАКЛЮЧЕНИЕ
В работе предложена новая схема одноэлектронного транзистора с чувствительным элементом на основе резонансно-туннельной наноструктуры из трех полупроводниковых квантовых точек. Показано, что существуют наборы параметров, которые могут обеспечить высокую чувствительность и надежность измерений внешнего электрического поля. Кроме того, предложена альтернативная схема транзистора с оптическим управлением, в которой электронный транспорт через структуру поддерживается с помощью резонансного лазерного поля.
Работа выполнена в рамках Государственного задания ФТИАН им. К.А. Валиева РАН Минобрнауки РФ по теме № 0066-2019-0005 “Фундаментальные исследования в области квантовых вычислений и прикладные разработки твердотельной элементной базы квантовых компьютеров 2019”.
Список литературы
Ono Y., Fujiwara A., Nishiguchi K., Inokawa H., Takahashi Y. Manipulation and detection of single electrons for future information processing // J. Appl. Phys. 2005. V. 97. P. 031101.
Joyce B.A., Kelires P.C., Naumovets A.G., Vvedensky D.D. Quantum Dots: Fundamentals, Applications, and Frontiers (NATO Science Series, 2003).
Kastner M.A. The single-electron transistor // Rev. Mod. Phys. 1992. V. 64. P. 849.
Gorman J., Hasko D.G., Williams D.A. Charge-Qubit Operation of an Isolated Double Quantum Dot // Phys. Rev. Lett. 2005. V. 95. P. 090502.
Kulkarni M., Cotlet O., Türeci H.E. Cavity-coupled double-quantum dot at finite bias: Analogy with lasers and beyond // Phys. Rev. B. 2014. V. 90. P. 125402.
Zibik E.A., Grange T., Carpenter B.A., Porter N.E., Ferreira R., Bastard G., Stehr D., Winnerl S., Helm M., Liu H.Y., Skolnick M.S., Wilson L.R. Long lifetimes of quantum-dot intersublevel transitions in the terahertz range // Nature Mat. 2009. V. 8. P. 803.
Majumdar A., Bajcsy M., Rundquist A., Kim E., Vučko-vić J. Phonon-mediated coupling between quantum dots through an off-resonant microcavity // Phys. Rev. B. 2012. V. 85. P. 195301.
Croke E.T., Borselli M.G., Gyure M.F., Bui S.S., Milosavljevic I.I., Ross R.S., Schmitz A.E., Hunter A.T. Single-gate accumulation-mode InGaAs quantum dot with a vertically integrated charge sensor // Appl. Phys. Lett. 2010. V. 96. P. 042101.
Цуканов А.В. Резонансные переходы электрона между тремя полупроводниковыми квантовыми точками под действием лазерного излучения // ФТП. 2004. Т. 38. С. 1382–1365.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника





