Микроэлектроника, 2019, T. 48, № 4, стр. 279-283
Влияние добавки N2 на скорость травления GaAs в плазме CF2Cl2
С. А. Пивоваренок *
Ивановский государственный химико-технологический университет НИИ Т и К
Ивановского государственного химико-технологического университета
153000 Иваново, пр. Шереметевский, 7, Россия
* E-mail: sap@isuct.ru
Поступила в редакцию 04.10.2018
После доработки 04.10.2018
Принята к публикации 04.10.2018
Аннотация
Проведено исследование кинетики травления GaAs в CF2Cl2 и CF2Cl2/N2. Показано, что вид зависимостей скорости травления от потока газа обусловлен энергией ионов, бомбардирующих обрабатываемую поверхность. Было показано, что при разбавлении рабочего газа 1/1 скорость травления образца уменьшилась приблизительно в 1.6 раза. Увеличение мощности (Wrf или Wbias) приводит к значительным изменениям в скорости травления GaAs.
ВВЕДЕНИЕ
В технологии важно правильно подобрать плазмообразующую среду для травления того или иного материала. Необходимо, чтобы рабочий газ обеспечивал достаточную скорость, селективность и анизотропию процесса травления, а также образовывал с исследуемым материалом продукты травления, обладающие высокой летучестью. В технологии микроэлектроники для травления кремния и его соединений традиционно использовались фторсодержащие газы из семейства фреонов CxHyFz, которые удовлетворяют вышеописанным характеристикам.
Арсенид галлия имеет ряд преимуществ по сравнению с кремнием: высокие значения подвижности носителей заряда и их максимальная дрейфовая скорость, а также большая ширина запрещенной зоны, что позволяет расширить диапазон рабочих частот элементной базы, понизить напряжение питания интегральной схемы (ИС) и увеличить температуру эксплуатации [1, 2]. Однако скорость взаимодействия GaAs с атомами фтора очень мала вследствие образования на его поверхности продуктов травления, обладающих малой летучестью. Дихлордифторметан (CF2Cl2) является источником атомарного фтора и хлора, поэтому достаточно часто используется при реактивном ионном травлении широкого круга неорганических материалов, в частности, при плазменной обработке полупроводниковых материалов группы A3B5.
В технологии при проведении процессов сухого травления в качестве плазмообразующих сред широкое использование получили двух и более компонентные газовые смеси. Это связано с тем, что различные газовые добавки (инертные – Ar, He либо молекулярные – H2, O2) оказывают определенное влияние на протекание процесса травления. Например, инертная добавка к галогенсодержащим газам может привести к тому, что скорость травления материала может либо в разы увеличиваться, либо незначительно уменьшаться, так как происходит влияние на электрофизические параметры плазмы и кинетику плазмохимических процессов [3]. Добавка водорода способствует как разрушению пленки естественного оксида, так и полирующему травлению полупроводниковых материалов группы A3B5, а кислород подавляет полимеризацию ненасыщенных продуктов распада углеродсодержащих молекул на поверхности материала [4].
Целью данной работы являлось исследование влияния добавки азота на скорость травления арсенида галлия в условиях ВЧ-плазмы CF2Cl2.
МЕТОДИЧЕСКАЯ ЧАСТЬ
Для исследования плазмохимических процессов в условиях ВЧ-разряда использовалась установка “Платран-100ХТ”. Она предназначена для плазмохимического травления полупроводниковых материалов, а также металлических пленок, продукты реакции которых с плазмообразующими газовыми смесями на основе хлора и фтора образуют летучие соединения. Установка обеспечивает возможность обработки пластин диаметром до 100 мм, а также меньших размеров толщиной от 0.3 до 2 мм.
Откачка системы производилась механическим пластинчато-роторным (Leybold BCS, производительность 30 м3/ч) и турбомолекулярным (TMP 803 LMTC, производительность 800 л/с) насосами до предельного давления остаточных газов порядка 10–6 Торр. Контроль рабочего давления в реакторе осуществлялся емкостным датчиком (баратрон) с верхним пределом измерения 0.1 Торр. Измерение и контроль расхода плазмообразующего газа проводились при помощи расходомеров с верхним пределом 500 см3/мин. Система контроля температуры предусматривает возможность автоматической стабилизации температуры подложки за счет регулирования скорости потока охлаждающей жидкости.
В экспериментах вкладываемая в разряд мощность (Wrf) являлась величиной постоянной и составляла 950 Вт, мощность смещения Wbias = 0–300 Вт, расход плазмообразующего газа 20 см3/мин (~1.4 мТорр). Температура образцов поддерживалась постоянной и составляла 373 К. Время травления изменялось от 60 до 180 секунд с интервалом 30 секунд. Первая партия образцов обрабатывалась в отсутствии мощности смещения на подложкодержателе, вторая – при мощности смещении 150 Вт, третья – при максимальной мощности 300 Вт.
Образцы представляли собой фрагменты полированных пластин GaAs толщиной ~400 мкм с размерами 10 × 10 мм.
Скорость травления определялась гравиметрическим методом, путем взвешивания образцов до и после обработки в плазме на аналитических весах WA-34 с точностью ±5 × 10–5 г.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Плазма на основе CF2Cl2 сама по себе является многокомпонентной системой и поэтому, чтобы понять какой вклад вносит использование газовых добавок, следует проанализировать ее в чистом виде.
Сначала остановимся на анализе типов активных частиц плазмы CF2Cl2, способных участвовать в процессе химического взаимодействия с поверхностью GaAs. В экспериментах, проведенных ранее, было найдено, что молекулы CF2Cl2 химически не взаимодействуют с GaAs при отсутствии разряда, так как после обработки визуально отсутствует какое-либо изменение поверхности, а изменение массы образца после обработки находится на уровне погрешности весовых измерений. Это позволяет говорить либо об отсутствии реакции на поверхности, либо о крайне низкой скорости взаимодействия молекул CF2Cl2 с арсенидом галлия, а в качестве основных химически активных частиц рассматриваются атомы хлора [5].
В таблице 1 представлены зависимости скорости травления арсенида галлия в плазме CF2Cl2. Зависимости скорости травления образца от времени обработки имеют линейный характер, что свидетельствует о протекании процесса в стационарной области.
На рис. 1 представлена зависимость скорости травления GaAs от потока газа (CF2Cl2). Как видно из зависимости при отсутствии мощности смещения на подложкодержателе (Wbias = 0 Вт) скорость травления материала уменьшается с ростом потока газа. Можно предположить, что при таких условиях взаимодействие ионов с поверхностью выступает в качестве лимитирующей стадии при травлении образца, что, в свою очередь, согласуется с влиянием потока газа на плотность потока ионов на поверхность в условиях плазмы [6]. Однако при мощностях смещения 150 и 300 Вт скорость травления арсенида галлия увеличивается линейно с ростом потока газа, и лимитирующей стадией при травлении может выступать химическая реакция на чистой поверхности.
Рис. 1.
Зависимость скорости травления GaAs от потока газа (CF2Cl2) при Wrf = 950 Вт и T = 100°С: 1 – Wbias = 0 Вт; 2 – Wbias = 150 Вт; 3 – Wbias = 300 Вт.

На рис. 2 приведена зависимость скорости травления GaAs от мощности, вкладываемой в разряд. Как можно видеть, при варьировании мощности смещения от 0 до 300 Вт скорость травления материала линейно возрастает с ростом мощности, вкладываемой в плазму, что связано с ростом концентрации химически активных частиц (атомов хлора), так как с увеличением Wrf происходит рост концентрации электронов в объеме плазмы, и в результате степень диссоциации молекул плазмообразующего газа будет увеличиваться.
Рис. 2.
Зависимость скорости травления GaAs от мощности, вкладываемой в плазму, при p = 1.4 мТорр: 1 – Wbias = 0 Вт; 2 – Wbias = 150 Вт; 3 – Wbias = 300 Вт.
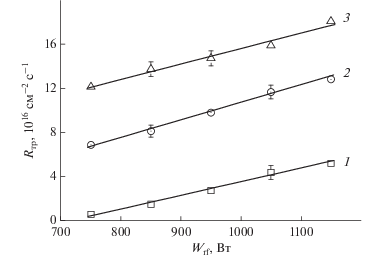
Теперь рассмотрим, что происходит при введении второго газа в систему. На рис. 3 представлена зависимость скорости травления образца от времени обработки в плазме CF2Cl2/N2 в соотношении 1/1. Данная зависимость так же линейна, как и в плазме CF2Cl2, что свидетельствует о протекании процесса в стационарной области. Как видно из зависимости, при травлении материала от 1 до 3 мин скорость травления образца увеличилась в 2.6 раза (от 0.5 × 1016 до 1.3 × 1016 см–2 с–1).
Рис. 3.
Зависимость скорости травления арсенида галлия в плазме CF2Cl2/N2 от времени обработки при p = 1.4 мТорр, Wrf = 950 Вт и T = 100°С: 1 – Wbias = 0 Вт; 2 – Wbias = 150 Вт; 3 – Wbias = 300 Вт.

Сравнивая среднее абсолютное значение скорости травления образца в данной системе со средним абсолютным значением скорости травления образца в плазме CF2Cl2 можно сказать, что данная величина уменьшилась в 1.6 раза. Однако при разбавлении рабочего газа азотом в соотношении 1/1 следовало бы ожидать, что скорость травления образца также изменится в два раза согласно эффекту концентрационного разбавления. При увеличении доли азота в системе будет происходить уменьшение концентрации основного газа, который является источником химически активных частиц (атомов хлора) в условиях плазмы, и скорость взаимодействия должна уменьшаться пропорционально разбавлению. Такое несоответствие, вероятно, связано с тем, что при введении второго газа происходит изменение электрофизических параметров плазмы. Вероятнее всего, происходит деформация функции распределения электронов по энергиям (ФРЭЭ) при разбавлении электроотрицательного газа электроположительным. Доля высокоэнергетичных электронов и средняя энергия электронов будут возрастать, что приведет к росту коэффициентов скоростей пороговых элементарных процессов вследствие снижения потерь энергии электронами на процессы возбуждения и ионизации частиц из-за малых величин сечений и высоких пороговых энергий процессов для молекул азота (εth = 15.6 эВ). За счет изменения электрофизических параметров разряда могут возрасти скорости диссоциации молекул основного газа прямым электронным ударом, что, в свою очередь, может привести к изменению скорости генерации основных химически активных частиц (атомов хлора) в объеме плазмы [7].
В обеих системах (CF2Cl2, CF2Cl2/N2) происходит значительное увеличение скорости травления материала при подаче мощности смещения на подложкодержатель. Например, при подаче мощности смещения на подложкодержатель 150 Вт в плазме CF2Cl2 средние абсолютные значения скоростей травления образца увеличиваются практически в 5 раз, а при 300 Вт – в 8 раз (см. табл. 1). При подаче мощности смещения 150 или 300 Вт на подложкодержатель, в плазме CF2Cl2/N2 также наблюдается увеличение средних абсолютных значений скоростей травления образца (например, приблизительно в 3.5 раза при 150 Вт и в 5.8 раза при 300 Вт). Увеличение мощности смещения может привести как к более эффективной ионно-стимулированной десорбции продуктов травления, так и физическому распылению материала. По сравнению с плазмой CF2Cl2 средние абсолютные значения скоростей травления образца в плазме CF2Cl2/N2 при подаче мощности смещения уменьшились в среднем приблизительно в 2 раза при тех же условиях. Подобные результаты наблюдались в системах CF2Cl2/Ar и CF2Cl2/He [7].
Таблица 1.
Скорости травления арсенида галлия в плазме CF2Cl2
| Время травления, с | Скорость травления без смещения Rтр, 1016 (см–2с–1) | Скорость травления при смещении 150 Вт Rтр, 1016 (см–2с–1) | Скорость травления при смещении 300 Вт Rтр, 1016 (см–2с–1) |
|---|---|---|---|
| 60 | 0.42 | 5.55 | 11.11 |
| 90 | 1.02 | 8.01 | 13.19 |
| 120 | 1.41 | 7.43 | 12.67 |
| 150 | 2.19 | 7.80 | 12.99 |
| 180 | 2.78 | 9.30 | 14.35 |
ЗАКЛЮЧЕНИЕ
Проведено исследование влияния добавки азота на скорость травления арсенида галлия в условиях ВЧ-плазмы CF2Cl2. Показано, что в смеси CF2Cl2/N2 в соотношении 1/1 изменения в средних абсолютных значениях скоростей травления образца не согласуются с эффектом концентрационного разбавления, что может свидетельствовать об увеличении скорости диссоциации молекул основного газа. Разбавление CF2Cl2 азотом в соотношении 1/1 приводит к несущественной потере в скорости травления, что позволяет снизить расход газа-реагента, продлить срок службы откачных систем. При подаче мощности смещения на подложкодержатель в обеих системах (CF2Cl2, CF2Cl2/N2) наблюдается существенное увеличение в скорости травления образца.
Работа выполнена при финансовой поддержке Минобрнауки РФ (проект 3.1371.2017/4.6).
Список литературы
Материалы электронной техники: уч. для студ. вузов по спец. электронной техники / В.В. Пасынков, В.С. Сорокин. СПб.: Лань, 2001. 368 с.
Пивоваренок С.А., Дунаев А.В., Ефремов А.М., Светцов В.И. Плазменное наноразмерное травление GaAs в хлоре и хлороводороде // Нанотехника. 2011. № 1. С. 69–71.
Мурин Д.Б., Ефремов А.М., Светцов В.И., Пивоваренок С.А., Овцын А.А., Шабадаров С.С. Интенсивности излучения и концентрации активных частиц в плазме тлеющего разряда в смесях хлористого водорода с аргоном и гелием // Изв. вузов. Химия и хим. технология. 2013. Т. 56. № 4. С. 29–32.
Мурин Д.Б., Ефремов А.М., Светцов В.И., Пивоваренок С.А., Годнев Е.М. Интенсивности излучения и концентрации нейтральных частиц в плазме тлеющего разряда постоянного тока в смесях HCl–H2 и HCl–O2 // Изв. вузов. Химия и хим. технология. 2013. Т. 56. № 8. С. 41–44.
Пивоваренок С.А., Дунаев А.В., Мурин Д.Б. Кинетика взаимодействия высокочастотного разряда CCl2F2 с арсенидом галлия // Микроэлектроника. 2016. Т. 45. № 5. С. 374–378.
Ефремов А.М., Пивоваренок С.А., Светцов В.И. Кинетика и механизмы плазмохимического травления меди в хлоре и хлороводороде // Микроэлектроника. 2007. Т. 36. № 6. С. 409–417.
Пивоваренок С.А. Влияние добавок Ar и He на кинетику травления GaAs в плазме CF2Cl2 // Микроэлектроника. 2017. Т. 46. № 3. С. 231–235.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника


