Микроэлектроника, 2019, T. 48, № 2, стр. 125-133
Особенности кинетики объемных и гетерогенных процессов в плазме смесей CHF3 + Ar и C4F8 + Ar
Д. Б. Мурин 1, А. М. Ефремов 1, *, K.-H. Kwon 2
1 Федеральное государственное бюджетное образовательное учреждение высшего образования
“Ивановский государственный химико-технологический университет”
153000 г. Иваново, Шереметевский пр., д. 7, Россия
2 Korea University
339-800 Chochiwon, 208 Seochang-Dong, Korea
* E-mail: efremov@isuct.ru
Поступила в редакцию 03.07.2018
Аннотация
Проведено сравнительное исследование кинетики плазмохимических процессов и состава плазмы в смесях CHF3 + Ar и C4F8 + Ar в условиях индукционного ВЧ (13.56 МГц) разряда. При совместном использовании методов диагностики и моделирования плазмы: а) выявлены общие черты и различия электрофизических параметров плазмы в исследуемых системах; б) установлены ключевые объемные процессы, определяющие стационарные концентрации нейтральных частиц; в) показано, что система CHF3 + Ar в диапазоне 0–75% Ar характеризуется более низкими значениями плотностей потоков атомов фтора и полимер образующих радикалов. При модельном анализе кинетики гетерогенных процессов (травление, полимеризация, деструкция полимерной пленки) подтверждено преимущество системы C4F8 + Ar по анизотропии травления кремния и селективности травления в системе SiO2/Si.
1. ВВЕДЕНИЕ
Плазмообразующие смеси на основе фторуглеродных (CxFy) и гидрофторуглеродных (CxHyFz) газов традиционно используются в технологии кремниевой микро- и наноэлектроники при проведении размерного структурирования поверхностей моно- и поли-Si, SiO2 и Si3N4 [1–3]. Характерной особенностью плазмы таких газов является одновременное протекание процессов травления (газификации атомов обрабатываемого материала) и поверхностной полимеризации (высаживания фторуглеродной полимерной пленки на любой поверхности, контактирующей с плазмой). Поэтому конечный результат обработки зависит от отношения F/C в исходной молекуле, которое определяет соотношение концентраций атомов фтора и ненасыщенных фторуглеродных радикалов в газовой фазе. В частности, газы с высокой полимеризационной способностью (с низким значением F/C, например – C4F8, C2F4, CHF3 и CH2F2) часто выступают в качестве основного или дополнительного компонента плазмообразующих смесей, обеспечивающих получение анизотропного профиля травления и максимальной селективности травления в системе SiO2/Si. Высокая анизотропия травления здесь достигается за счет низких значений отношений потоков атомов фтора и положительных ионов, а также маскирования фторуглеродным полимером боковых стенок формируемого рельефа [3, 4]. Преимуществу по селективности травления в системе SiO2/Si также способствует комбинация двух факторов, а именно:
1) лимит скоростей травления Si и SiO2 транспортом атомов фтора через сплошную толстую (${{h}_{{{\text{pol}}}}}$ > 100 нм) полимерную пленку [4, 5];
2) меньшая величина ${{h}_{{{\text{pol}}}}}$ на SiO2 из-за деструкции полимера атомами кислорода [5, 6].
Высокая востребованность плазменных систем на основе CHF3 и C4F8 в технологических процессах обуславливает большой интерес к изучению их физико-химических свойств. Имеющиеся на настоящий момент времени исследования электрофизических параметров и состава плазмы CHF3 [7–9] и C4F8 [10–12] содержат экспериментальные и расчетные данные по зависимостям концентраций нейтральных и заряженных частиц от внешних параметров плазмы, а также представляют кинетические схемы (наборы реакций и кинетических коэффициентов), обеспечивающие адекватное описание кинетики плазмохимических процессов при моделировании плазмы. Кроме этого, существует ряд экспериментальных работ по изучению закономерностей и взаимосвязей кинетики травления и поверхностной полимеризации в данных системах [5, 13, 14]. В то же время, анализ опубликованных работ показывает необходимость дальнейших исследований по ряду направлений. В частности, имеющиеся данные не предоставляют возможности прямого сравнения параметров и состава плазмы CHF3 и C4F8 из-за различий в исследованных диапазонах условий, типах и геометрии плазмохимических реакторов. Очевидно, что отсутствие информации по особенностям кинетики плазмохимических процессов в данных системах при одинаковых внешних параметрах разряда ограничивает возможность осознанного выбора плазмообразующего газа для целей того или иного процесса. Кроме этого, недостаточное внимание было уделено исследованию взаимосвязей между параметрами газовой фазы и кинетикой гетерогенных плазмохимических процессов. Такая ситуация ограничивает возможность оптимизации режимов процессов травления в соответствии с требуемым результатом.
Целью настоящего исследования являлось сравнение кинетики плазмохимических процессов и состава плазмы в смесях CHF3 + Ar и C4F8 + Ar в условиях индукционного ВЧ (13.56 МГц) разряда. Основное внимание было направлено на:
1) выявление общих черт и различий объемных процессов, определяющих стационарные концентрации нейтральных частиц;
2) анализ взаимосвязей между параметрами газовой фазы и кинетикой гетерогенных плазмохимических процессов(травление, полимеризация, деструкция полимерной пленки).
2. МЕТОДИЧЕСКАЯ ЧАСТЬ
2.1. Диагностика плазмы
Эксперименты проводились в реакторе планарного типа с цилиндрической ($r$ = 13 см, $l$ = 16 см) рабочей камерой из анодированного алюминия в условиях индукционного ВЧ (13.56 МГц) разряда [9, 12]. В качестве постоянных внешних параметров плазмы выступали вкладываемая мощность $W$ = 700 Вт, мощность смещения ${{W}_{{dc}}}$ = 200 Вт, давление газа $p$ = 6 мТорр и общий расход плазмообразующего газа $q$ = 40 станд. см3/мин. Начальный состав смесей CHF3 + Ar и C4F8 + Ar устанавливали варьированием индивидуальных расходов компонентов в рамках $q$ = const. Максимальное значение ${{q}_{{{\text{Ar}}}}}$ = 30 станд. см3/мин соответствовало содержанию аргона в плазмообразующей смеси ${{y}_{{{\text{Ar}}}}}$ в количестве 75%.
Диагностика плазмы осуществлялась двойным зондом Лангмюра DLP2000 (PlasmartInc., Korea). Для минимизации погрешности измерений из-за полимер образования на зондах была задействована система импульсной очистки зондов ионной бомбардировкой. Предварительные эксперименты показали отсутствие принципиальных искажений зондовых вольт-амперных характеристик (ВАХ), последовательно измеряемых в чистых CHF3 и C4F8 в течении ~5 мин после зажигания разряда. Кроме этого, перед каждым измерением зондовая головка дополнительно очищалась в плазме 50% Ar + 50% O2 в течении ~2 мин. Обработка зондовых ВАХ базировалась на известных положениях теории двойного зонда [15, 16] с использованием максвелловской функции распределения электронов по энергиям (ФРЭЭ). Результатом обработки выступали экспериментальные данные по температуре электронов (${{T}_{e}}$) и плотности ионного тока (${{J}_{ + }}$). Суммарная концентрация положительных ионов (${{n}_{ + }}$) определялась по соотношению $\quad{{J}_{ + }} \approx 0.61e{{n}_{ + }}{{\upsilon }_{{\text{B}}}}$ [16], где ${{\upsilon }_{{\text{B}}}} \approx \sqrt {{{e{{T}_{e}}} \mathord{\left/ {\vphantom {{e{{T}_{e}}} {{{m}_{i}}}}} \right. \kern-0em} {{{m}_{i}}}}} $ – скорость ионов на внешней границе двойного электрического слоя у поверхности зонда (скорость Бома). Ранее в наших работах [17, 18] было показано, что такой подход обеспечивает удовлетворительное согласие экспериментальных и расчетных (полученных при моделировании плазмы с учетом состава ионной компоненты и длин свободного пробега ионов) значений ${{J}_{ + }}.$ Эффективная масса ионов (${{m}_{i}}$) оценивалась по закону Бланка в предположении, что доля ионов данного сорта пропорциональна произведению мольной доли соответствующей нейтральной частицы на константу скорости ионизации электронным ударом.
Величина отрицательного смещения на нижнем электроде ($ - {{U}_{{dc}}}$) измерялась высоковольтным зондом AMN-CTR (YoungsinEng, Korea). В предварительных экспериментах было установлено, что варьирование ${{W}_{{dc}}}$ в пределах 0–200 Вт оказывает пренебрежимо малое влияние на вид зондовых ВАХ и, следовательно, на параметры газовой фазы разряда.
2.2. Моделирование плазмы
Для получения данных по составу плазмы и анализа кинетики плазмохимических процессов, протекающих в газовой фазе, использовалась глобальная (0-мерная) кинетическая модель. Наборы реакций и их кинетических характеристик (констант скоростей объемных процессов, вероятностей гетерогенной рекомбинации атомов и радикалов) для смесей CHF3 + Ar и C4F8 + Ar были заимствованы из наших работ [9, 12]. Корректность используемых кинетических схем в обеих системах подтверждается удовлетворительным согласием расчетных и измеренных параметров плазмы и концентраций частиц [7, 11]. Алгоритм моделирования базировался на следующих предпосылках:
1) Максвелла ФРЭЭ обеспечивает адекватное описание кинетики процессов под действием электронного удара [7, 11]. Соответственно, для определения констант скоростей таких процессов могут быть использованы функциональные соотношения вида $k = f\left( {{{T}_{e}}} \right),$ известные по литературным данным [7–12].
2) Температура газа в условиях  = const не зависит от начального состава исследуемых смесей. Фактически, это предполагает
постоянство констант скоростей объемных атомно-молекулярных процессов и транспортных
коэффициентов нейтральных частиц. В расчетах использовалась величина ${{T}_{{{\text{gas}}}}}$ = 600 K, как характерное значение для данного типа реакторов в исследуемом диапазоне
условий [12, 17, 18].
= const не зависит от начального состава исследуемых смесей. Фактически, это предполагает
постоянство констант скоростей объемных атомно-молекулярных процессов и транспортных
коэффициентов нейтральных частиц. В расчетах использовалась величина ${{T}_{{{\text{gas}}}}}$ = 600 K, как характерное значение для данного типа реакторов в исследуемом диапазоне
условий [12, 17, 18].
3) Гетерогенная рекомбинация атомов и радикалов подчиняется механизму Или–Ридила. Соответственно, константы скоростей рекомбинации могут быть определены как $k \approx \gamma {{{{\upsilon }_{T}}} \mathord{\left/ {\vphantom {{{{\upsilon }_{T}}} {2r}}} \right. \kern-0em} {2r}},$ где r – радиус рабочей камеры реактора, ${{\upsilon }_{T}} = {{\left( {8{{k}_{{\text{B}}}}{{{{T}_{{{\text{gas}}}}}} \mathord{\left/ {\vphantom {{{{T}_{{{\text{gas}}}}}} {\pi m}}} \right. \kern-0em} {\pi m}}} \right)}^{{{1 \mathord{\left/ {\vphantom {1 2}} \right. \kern-0em} 2}}}}$ и γ вероятность рекомбинации [7, 8, 10].
4) Низкая электроотрицательность плазмы чистых CHF3 и C4F8 в области $p$ < 10 мТорр дает возможность полагать ${{{{n}_{ - }}} \mathord{\left/ {\vphantom {{{{n}_{ - }}} {{{n}_{e}}}}} \right. \kern-0em} {{{n}_{e}}}} \ll $ 1 [7, 10], где ${{n}_{ - }}$ и ${{n}_{e}}$ – концентрации отрицательных ионов и электронов, соответственно. Таким образом, условие квази нейтральности плазмы в виде ${{n}_{e}}$ ≈ ${{n}_{ + }}$ позволяет игнорировать взаимосвязи подсистем заряженных и нейтральных частиц через кинетику процессов диссоциативного прилипания.
В качестве входных параметров модели использовались экспериментальные данные по ${{T}_{e}}$ и ${{n}_{ + }}.$ Выходными параметрами служили усредненные по объему реактора скорости процессов образования и гибели нейтральных частиц, их концентрации и плотности потоков на поверхность, контактирующую с плазмой.
3. РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
Влияние внешних условий процесса (вкладываемая мощность, давление и скорость потока газа) на электрофизические параметры плазмы CHF3 и C4F8, а также их смесей с аргоном фиксированного состава ранее изучено в работах [7–11]. Поэтому остановимся лишь на ключевых моментах, имеющих принципиальное значение для сравнения свойств этих систем:
− Температура электронов в плазме C4F8 (~4.7 эВ) ниже значения для плазмы CHF3 (~5.2 эВ) при одинаковых условиях возбуждения разряда (рис. 1а). Причиной этого – комбинация двух факторов:
Рис. 1.
Электрофизические параметры плазмы в смесях CHF3 + Ar (1, 3) и C4F8 + Ar (2, 4): а – 1, 2 – температура электронов (${{T}_{e}}$); 3, 4 – концентрация электронов (${{n}_{e}}$) и суммарная концентрация положительных ионов (${{n}_{ + }}$; б – 1, 2 – отрицательное смещение на подложкодержателе ($ - {{U}_{{dc}}}$); 3, 4 – плотность потока энергии ионов ($\sqrt {{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}$). Условия процесса: $p$ = 6 мТорp, $W$ = 700 Вт, ${{W}_{{dc}}}$ = 200 W.
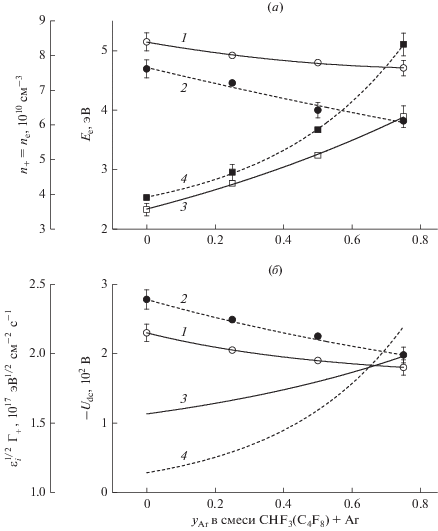
− а) меньшие потери энергии электронов на ионизацию доминирующих нейтральных частиц в плазме CHF3;
− б) большая плотность газа в плазме C4F8 при одинаковом начальном давлении, что обуславливает большую частоту столкновений электронов с “тяжелыми” частицами. Действие первого фактора определяется условием:
– Наличие второго фактора обусловлено тем, что исходные молекулы C4F8 не воспроизводятся при рекомбинации продуктов их диссоциации в плазме. Таким образом, реальное давление газа в реакторе выше начального [10]. Увеличение доли аргона в обеих смесях приводит к снижению потерь энергии электронов на колебательное и электронное возбуждение, которое с избытком компенсируется ростом потерь энергии на ионизацию за счет R3:
− В результате имеет место снижение
− ${{T}_{e}}$ (5.2–4.7 эВ для CHF3 + Ar и 4.7–3.8 эВ для C4F8 + Ar при 0–75% Ar)
− и констант скоростей процессов под действие электронного удара.
− Концентрации положительных ионов (а, следовательно, и электронов в предположении
${{n}_{e}}$≈ ${{n}_{ + }}$) в плазме C4F8 и CHF3 в условиях  = const достаточно близки (~3.9 × 1010 и ~3.6 × 1010 см–3 соответственно, см. рис. 1а), что обусловлено близкими значениями суммарных частот ионизации. Более заметные
различия в плотностях ионных токов, найденные по результатам диагностики плазмы (~1.6
мА/см2 в CHF3 и ~1.1 мА/см2 в C4F8), связаны с различиями транспортных коэффициентов и масс доминирующих ионов. Увеличение
доли аргона в обеих смесях сопровождается ростом суммарных частот ионизации (в силу
${{k}_{3}}$ > ${{k}_{1}}$ и ${{k}_{2}}$), а также снижением частот гибели ионов из-за изменения ${{T}_{e}}.$ Все это ожидаемо приводит к росту ${{n}_{ + }}$ (3.6 × 1010–6.2 × 1010 см–3 для CHF3 + Ar и 3.9 × × 1010–8.3 × 1010 см–3 для C4F8 + Ar, что соответствует ${{j}_{ + }}$ = 1.6–2.2 и 1.1–2.4 мА/см2 при 0–75% Ar).
= const достаточно близки (~3.9 × 1010 и ~3.6 × 1010 см–3 соответственно, см. рис. 1а), что обусловлено близкими значениями суммарных частот ионизации. Более заметные
различия в плотностях ионных токов, найденные по результатам диагностики плазмы (~1.6
мА/см2 в CHF3 и ~1.1 мА/см2 в C4F8), связаны с различиями транспортных коэффициентов и масс доминирующих ионов. Увеличение
доли аргона в обеих смесях сопровождается ростом суммарных частот ионизации (в силу
${{k}_{3}}$ > ${{k}_{1}}$ и ${{k}_{2}}$), а также снижением частот гибели ионов из-за изменения ${{T}_{e}}.$ Все это ожидаемо приводит к росту ${{n}_{ + }}$ (3.6 × 1010–6.2 × 1010 см–3 для CHF3 + Ar и 3.9 × × 1010–8.3 × 1010 см–3 для C4F8 + Ar, что соответствует ${{j}_{ + }}$ = 1.6–2.2 и 1.1–2.4 мА/см2 при 0–75% Ar).
− Величина отрицательного смещения на нижнем электроде при ${{W}_{{dc}}}$ = const в плазме CHF3 (~230 В) заметно ниже, чем в плазме C4F8 (~278 В) (рис. 1б), что согласуется с отмеченными различиями ${{j}_{ + }}.$ Увеличение доли аргона в обеих смесях сопровождается снижением параметра $ - {{U}_{{dc}}}$ (230–180 В для CHF3 + Ar и 278–198 В для C4F8 + Ar при 0–75% Ar) и приводит к аналогичным изменениям энергий ионов, бомбардирующих обрабатываемую поверхность
– где $ - {{U}_{f}} \approx 0.5{{T}_{e}}{\text{ln}}\left( {{{{{m}_{e}}} \mathord{\left/ {\vphantom {{{{m}_{e}}} {2.3}}} \right. \kern-0em} {2.3}}{{m}_{i}}} \right)$ – плавающий потенциал.
Расчеты показали, что основными компонентами газовой фазы в плазме CHF3 + Ar являются HF, CHF3 и СFx (x = 1–3) (рис. 2а). Преобладание HF над другими типами частиц (и, в частности, справедливость соотношения ${{{{n}_{{{\text{HF}}}}}} \mathord{\left/ {\vphantom {{{{n}_{{{\text{HF}}}}}} {{{n}_{{{\text{C}}{{{\text{F}}}_{x}}}}}}}} \right. \kern-0em} {{{n}_{{{\text{C}}{{{\text{F}}}_{x}}}}}}}$ > 1) в плазме трифторметана хорошо согласуется с результатами предшествующих исследований [19, 20]. Так, в работе [20] было показано, что в условиях $p$ < 10 мТорр и ${{n}_{e}}$ > 1011 см–3 доля HF в суммарной концентрации нейтральных частиц может превышать 80%. На наш взгляд, такая ситуация обусловлена 1) прямым образованием HF из исходных молекул CHF3 по R4: CHF3 + e → HF + CF2 + e; и 2) высокими скоростями объемных процессов R5:
Рис. 2.
Концентрации нейтральных части в плазме смесей CHF3 + Ar (а) и C4F8 + Ar (б). Условия процесса соответствуют рис. 1.
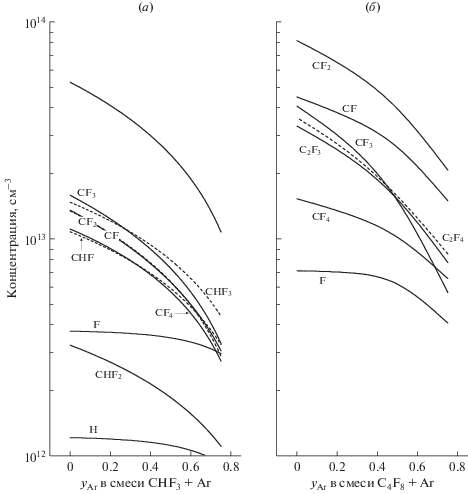
с участием продуктов диссоциации CHF3 первой и второй ступеней. Основными источниками атомов фтора в плазме трифтор-метана служат процессы диссоциации доминирующих фторсодержащих частиц по реакциям R8: HF + e → H + F + e и R9: CFx + e → CFx– 1 + F + e (x = 2, 3). Отметим, что вклад R10: CHF3 + e → F + CHF2 + e в общую скорость генерации атомов фтора является пренебрежимо малыми из-за условия ${{k}_{{10}}}$ $ \ll $ ${{k}_{8}}$ и ${{k}_{9}}.$ Увеличение доли аргона в смеси сопровождается пропорциональным (в ~4.3 раза при 0–75% Ar) снижением суммарной скорости R8 + R9, но значительно более медленным падением ${{n}_{{\text{F}}}}$ (в ~1.3 раза при 0–75% Ar). Причиной этого является снижение скорости R5, абсолютная величина которой превышает скорость гетерогенной рекомбинации атомов. Отметим также, что высокая скорость гибели атомов фтора по R5 является основной причиной их низкой концентрации в плазме.
Основными компонентами газовой фазы в плазме C4F8 + Ar являются фторуглеродные частицы вида CFx (x = 1, 2, 3) и C2Fx (x = 3, 4) (рис. 2б). Качественно аналогичные результаты были получены ранее в работах [11, 21] при экспериментальном исследовании и моделировании плазмы C4F8. Большинство из этих частиц, а именно C2F4, C2F3 и CF2, образуются либо при распаде исходных молекул
Высокая концентрация CF обеспечивается высокой скоростью их образования по R9 из CF2 и R16: C2F3 + e → CF2 + CF + e. Высокая концентрация CF3 поддерживается за счет гетерогенной рекомбинации
Основными источниками атомов фтора в плазме C4F8 служит R9 с участием CFx (x = 1, 2, 3), при этом гибель атомов, кроме гетерогенной рекомбинации, происходит при практически равноценном вкладе R17. Соответственно, эффективная конверсия F → CF2/CF3 по R17 приводит к выполнению условия ${{n}_{{\text{F}}}} \ll {{n}_{{{\text{C}}{{{\text{F}}}_{{\text{2}}}}}}},$ ${{n}_{{{\text{C}}{{{\text{F}}}_{3}}}}}.$ Увеличение доли аргона в смеси приводит к снижению скоростей R11–R15 и, как следствие, концентраций всех фторуглеродных частиц. Более быстрое изменение для ${{n}_{{{\text{C}}{{{\text{F}}}_{3}}}}}$ (в ~7.2 раза при 0–75% Ar) и более медленное для ${{n}_{{\text{F}}}}$ (в ~1.7 раза при 0–75% Ar) обусловлены с кинетикой R17. Действительно, если первый реагент в R17 образуется непосредственно из исходных молекул по R11, то снижение содержания C4F8 в поступающем газе одновременно снижает скорость образования CF3 и скорость гибели F. Полученные данные позволяют выделить две принципиальные особенности кинетики основных нейтральных частиц в исследуемых системах. Во-первых, плазма в смеси CHF3 + Ar в диапазоне 0–75% Ar характеризуется систематически более низкими (на порядок величины и более, что согласуется с экспериментальными данными [22]) концентрациями фторуглеродных радикалов CFx (x = 1, 2, 3). Причиной этого являются: a) более низкие скорости образования радикалов из исходных молекул из-за ${{k}_{4}}$ < ${{k}_{{12}}}$; и б) эффективная конверсия CFx (x = 1, 2, 3) в HF по реакции R7. И, во-вторых, плазма в смеси C4F8 + Ar в диапазоне 0–75% Ar характеризуется систематически более высокими концентрациями атомов фтора. Такая ситуация обеспечивается: а) более высокими скоростями генерации атомов по R9 из-за более высоких концентраций CFx (x = 1, 2, 3); и б) условием ${{k}_{8}}$ < ${{k}_{9}},$ ограничивающего скорость образования атомов фтора в системе CHF3 + Ar.
Для анализа кинетики гетерогенных процессов в плазме смесей CHF3 + Ar и C4F8 + Ar воспользуемся рядом положений, отражающих специфику ионно-стимулированной химической реакции в полимеробразующей плазме:
1) Скорость взаимодействия атомов фтора с обрабатываемой поверхностью (фактически – скорость травления) определяется соотношением ${{\gamma }_{{\text{R}}}}{{{\Gamma }}_{{\text{F}}}},$ где ${{\gamma }_{{\text{R}}}}$ – эффективная вероятность взаимодействия и ${{{\Gamma }}_{{\text{F}}}}$ – плотность потока атомов фтора [12, 23]. Характер зависимости ${{\gamma }_{{\text{R}}}}$ от условий процесса при постоянной температуре поверхности определяется: а) кинетикой десорбции продуктов травления и/или деструкции связей между поверхностными атомами под действием ионной бомбардировки; и б) кинетикой формирования и/или деструкции фторуглеродной полимерной пленки, определяющей ее толщину $\quad{{h}_{{{\text{pol}}}}}$ [4, 5].
2) Любой процесс взаимодействия ионов с поверхностью (распыление поверхностных атомов, ионно-стимулированная десорбция продуктов химических реакций, деструкция фторуглеродной полимерной пленки) характеризуется скоростью ${{Y}_{S}}{{{\Gamma }}_{ + }}$ [5, 12], где ${{Y}_{S}}$ – выход процесса (атом/ион) и ${{{\Gamma }}_{ + }}$ – плотность потока ионов. Характер зависимости ${{Y}_{S}}$ от внешних параметров плазмы определяется изменением энергии ионов, при этом в диапазоне ${{\varepsilon }_{i}}$ < 500 эВ можно полагать ${{Y}_{S}}$ ~ $\sqrt {{{\varepsilon }_{i}}} $ [24]. Таким образом, относительное изменение скорости любого ионного процесса отслеживается парамером $\quad\sqrt {{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}$ [12].
3) В образовании полимерной пленки на обрабатываемой поверхности принимают участие фторуглеродные радикалы с двумя и более свободными связями, при этом вероятность полимеризации снижается с ростом концентрации атомов фтора [5, 6, 25]. Поэтому относительное изменение скорости связывания радикалов с поверхностью отслеживается отношением ${{{{{\Gamma }}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{\Gamma }}_{{{\text{pol}}}}}} {{{{\Gamma }}_{{\text{F}}}},}}} \right. \kern-0em} {{{{\Gamma }}_{{\text{F}}}},}}$ а скорость роста полимерной пленки в бескислородной плазме (а, следовательно, и величина ${{h}_{{{\text{pol}}}}}$ при фиксированном времени процесса) однозначно определяются параметром ${{{{{\Gamma }}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{\Gamma }}_{{{\text{pol}}}}}} {\sqrt {{{\varepsilon }_{i}}} }}} \right. \kern-0em} {\sqrt {{{\varepsilon }_{i}}} }}{{{\Gamma }}_{ + }}{{{\Gamma }}_{{\text{F}}}}.$
Данные рис. 1б показывают, что параметр $\sqrt {{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}$ в исследуемых системах имеет близкие как абсолютные значения, так и характер изменения при увеличении доли аргона в плазмообразующей смеси. В то же время, из рис. 3 можно видеть, что суммарная плотность потока полимеробразующих радикалов в системе
Рис. 3.
Плотности потоков нейтральных частиц и отношения плотностей потоков в плазме смесей CHF3 + Ar (сплошные линии) и C4F8 + Ar (пунктирные линии). Обозначения на кривых: F – атомы фтора (${{{\Gamma }}_{{\text{F}}}}$), pol – полимеробразующие радикалы (${{{\Gamma }}_{{{\text{pol}}}}}$), pol/F – ${{{{{\Gamma }}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{\Gamma }}_{{{\text{pol}}}}}} {{{{\Gamma }}_{{\text{F}}}}}}} \right. \kern-0em} {{{{\Gamma }}_{{\text{F}}}}}},$ pol/F+ – ${{{{{\Gamma }}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{\Gamma }}_{{{\text{pol}}}}}} {\sqrt {{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}{{{\Gamma }}_{{\text{F}}}},}}} \right. \kern-0em} {\sqrt {{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}{{{\Gamma }}_{{\text{F}}}},}}$ F/+ – ${{{{{\Gamma }}_{{\text{F}}}}} \mathord{\left/ {\vphantom {{{{{\Gamma }}_{{\text{F}}}}} {\sqrt {{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}.}}} \right. \kern-0em} {\sqrt {{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}.}}$ Условия процесса соответствуют рис. 1.
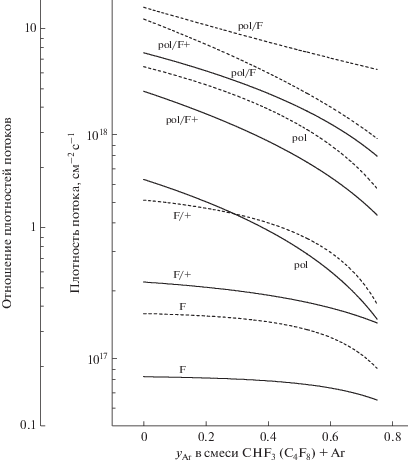
Таким образом, плазма смеси C4F8 + Ar является более полимеробразующей системой, что обеспечивает ей очевидные преимущества в анизотропии травления кремния (за счет лучшего маскирования полимером боковых стенок формируемого рельефа) и селективности травления в системе SiO2/Si. Вывод о более высокой способности полимеризации системы C4F8 + Ar хорошо согласуется с экспериментальными данными стандарта [5], полученными в близком к нашему диапазоне условий. В частности, авторы данной работы сообщают, что характерные значения ${{h}_{{{\text{pol}}}}}$ на Si, SiO2 и Si3N4 после обработки в плазме C4F8 в среднем в 1.5–2 раза выше, чем в плазме CHF3. Близкую величину (~2.2, см. рис. 3) дает и отношение параметров ${{{{{\Gamma }}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{\Gamma }}_{{{\text{pol}}}}}} {\sqrt {{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}{{{\Gamma }}_{{\text{F}}}}}}} \right. \kern-0em} {\sqrt {{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}{{{\Gamma }}_{{\text{F}}}}}}$ для чистых C4F8 и CHF3. Из данных работы [5] можно видеть также, что преимущество по селективности травления SiO2/Si достигается за счет более высоких скоростей травления SiO2 (~400 нм/мин в CHF3 vs. ~520 нм/мин в C4F8) при близких (~100 нм/мин в CHF3 vs. ~ 120 нм/мин в C4F8) скоростях травления кремния. С учетом наших данных, механизм этого эффекта может быть интерпретирован следующим образом. Более толстая полимерная пленка на поверхности Si приводит к тому, что процесс травления в обеих исследуемых системах лимитируется диффузией атомов фтора в слое полимера [4, 5], при этом в первом приближении можно полагать ${{\gamma }_{R}}$ ~ ${1 \mathord{\left/ {\vphantom {1 {{{h}_{{{\text{pol}}}}}}}} \right. \kern-0em} {{{h}_{{{\text{pol}}}}}}}.$ Соответственно, более высокое значение ${{{\Gamma }}_{{\text{F}}}}$ на внешней границе полимерной пленки в плазме C4F8 практически полностью компенсируется низкой ${{\gamma }_{{\text{R}}}}.$ В то же время, более тонкая полимерная пленка на поверхности SiO2 не лимитирует доступ атомов фтора к обрабатываемой поверхности. Поэтому кинетика травления SiO2 близка к кинетике классической ионно-стимулированной химической реакции, для которой ${{\gamma }_{R}}$ ~ $\sqrt {{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}.$ Действительно, отношение скоростей травления SiO2 в чистых C4F8 и CHF3 (~1.3) хорошо согласуется с отношением параметра $\sqrt {{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}{{{\Gamma }}_{{\text{F}}}}$ в этих системах (~1.4, см. рис. 3). Таким образом, анализ кинетики процессов травления и полимеризации в плазме смесей CHF3 + Ar и C4F8 + Ar с использованием расчетных отношений плотностей потоков частиц показывает хорошее согласие с экспериментальными данными и обеспечивает адекватное понимание особенностей этих систем. Такая ситуация открывает перспективу для априорной (без проведения натурного эксперимента) оптимизации режимов процессов плазменного травления в среде фторуглеродных газов.
4. ЗАКЛЮЧЕНИЕ
Проведено сравнительное исследование электрофизических паромеров, кинетики плазмохимических процессов и концентраций активных частиц в смесях CHF3 + Ar и C4F8 + Ar в условиях индукционного ВЧ (13.56 МГц) разряда. При совместном использовании методов диагностики и моделирования плазмы выявлены ключевые объемные процессы, определяющие стационарный состав плазмы. Установлено, что принципиальными особенностями системы CHF3 + Ar в диапазоне 0–75% Ar являются:
а) доминирование молекул HF над фторуглеродными радикалами CFx (x = 1–3);
б) более низкая концентрация плотности потоков фторуглеродных радикалов CFx (x = 1–3) и атомов фтора. При модельном анализе кинетики гетерогенных процессов с использованием расчетных отношений плотностей потоков частиц показана более высокая способность полимеризации системы C4F8 + Ar, а также подтверждено преимущество данной системы по анизотропии травления кремния и селективности травления SiO2/Si.
Исследование выполнено при финансовой поддержке РФФИ в рамках научного проекта № 18-37-00064 мол_а.
Список литературы
Rossnagel S.M., Cuomo J.J., Westwood W.D. (Eds.). Handbook of plasma processing technology. Noyes Publications, Park Ridge, 1990. 338 p.
Wolf S., Tauber R.N. Silicon Processing for the VLSI Era. Volume 1. Process Technology. Lattice Press, New York, 2000. 416 p.
Roosmalen A.J., Baggerman J.A.G., Brader S.J.H. Dry etching for VLSI. Plenum Press, New-York, 1991. 490 p.
Lieberman M.A., Lichtenberg A.J. Principles of plasma discharges and materials processing. John Wiley & Sons Inc., New York, 1994. 757 p.
Standaert T.E.F.M., Hedlund C., Joseph E.A., Oehrlein G.S. Role of fluorocarbon film formation in the etching of silicon, silicondioxide, silicon nitride, and amorphous hydrogenated silicon carbide // J. Vac. Sci. Technol. A. 2004. V. 22. P. 53–60.
Stoffels W.W., Stoffels E., Tachibana K. Polymerization of fluorocarbons in reactive ion etching plasmas // J. Vac. Sci. Tech. A. 1998. V. 16. P. 87–95.
Ho P., Johannes J.E., Buss R.J. Modeling the plasma chemistry of C2F6 and CHF3 etching of silicon dioxide, with comparisons to etch rate and diagnostic data // J. Vac. Sci. Technol. A. 2001. V. 19. P. 2344–2367.
Bose D., Rao M.V.V.S., Govindan T.R., Meyyappan M. Uncertainty and sensitivity analysis of gas-phase chemistry in a CHF3 plasma // Plasma Sources Sci. Technol. 2003. V. 12. P. 225–234.
Lim N., Efremov A., Yeom G.Y., Kwon K.-H. On the etching characteristics and mechanisms of HfO2 thin films in CF4/O2/Ar and CHF3/O2/Ar plasma for nano-devices // J. Nanosci. Nanotechnol. 2014. V. 14. P. 9670–9679.
Kokkoris G., Goodyear A., Cooke M., Gogolides E. A global model for C4F8 plasmas coupling gas phase and wall surface reaction kinetics // J. Phys. D: Appl. Phys. 2008. V. 41. P. 195211.
Rauf S., Ventzek P.L.G. Model for an inductively coupled Ar/c–C4F8 plasma discharge // J. Vac. Sci. Technol. A. 2002. V. 20. P. 14–23.
Chun I., Efremov A., Yeom G.Y., Kwon K.-H. A comparative study of CF4/O2/Ar and C4F8/O2/Ar plasmas for dry etching applications // Thin Solid Films. 2015. V. 579. P. 136–148.
Yeom G.Y., Kushner M.J. Si/SiO2 etch properties using CF4 and CHF3 in radio frequency cylindrical magnetron discharges // Appl. Phys. Lett. 1990. V. 56. P. 857–859.
Lele C., Liang Z., Linda X., Dongxia L., Hui C., Tod P. Role of CF2 in the etching of SiO2, Si3N4 and Si in fluorocarbon plasma // J. Semicond. 2009. V. 30. P. 033005–1.
Johnson E.O., Malter L. A floating double probe method for measurements in gas discharges // Phys. Rev. 1950. V. 80. P. 58–70.
Sugavara M. Plasma etching: Fundamentals and applications. Oxford University Press, New York, 1998. 469 p.
Efremov A., Min N.K., Choi B.G., Baek K.H., Kwon K.-H. Model-based analysis of plasma parameters and active species kinetics in Cl2/X (X = Ar, He, N2) inductively coupled plasmas // J. Electrochem. Soc. 2008. V. 155. P. D777–D782.
Kwon K.-H., Efremov A., Kim M., Min N.K., Jeong J., Kim K. A model-based analysis of plasma parameters and composition in HBr/X (X = Ar, He, N2) inductively coupled plasmas // J. Electrochem. Soc. 2010. V. 157. P. H574–H579.
Turban G., Grolleau B., Launay P., Briaud P. A mass spectrometric diagnostic of C2F6 and CHF3 plasmas during etching of SiO2 and Si // Revue Phys. Appl. 1985. V. 20. P. 609–620.
Takahashi K., Hori M., Goto T. Characteristics of fluorocarbon radicals and CHF3molecule in CHF3electron cyclotron resonance downstream plasma // Jpn. J. Appl. Phys. 1994. V. 33. P. 4745–4758.
Font G.I., Morgan W.L., Mennenga G. Cross-section set and chemistry model for the simulation of c-C4F8 plasma discharges // J. Appl. Phys. 2002. V. 91. P. 3530–3538.
Ho P., Johannes J.E., Buss R.J., Meeks E. Chemical reaction mechanisms for modeling the fluorocarbon plasma etch of silicon oxide and related materials // Sandia reportSAND2001-1292. 2001. 114 p.
Gray D.C., Tepermeister I., Sawin H.H. Phenomenological modeling of ion enhanced surface kinetics in fluorine-based plasma etching // J. Vac. Sci. Technol. B. 1993. V. 11. P. 1243–1257.
Lee C., Graves D.B., Lieberman M.A. Role of etch products in polysilicon etching in a high-density chlorine discharge // Plasma Chem. Plasma Proc. 1996. V. 16. P. 99–118.
Matsui M., Tatsumi T., Sekine M. Relationship of etch reaction and reactive species flux in C4F8–Ar–O2 plasma for SiO2 selective etching over Si and Si3N4 // J. Vac. Sci. Technol. A. 2001. V. 19. P. 2089–2096.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника


