Микроэлектроника, 2021, T. 50, № 5, стр. 363-369
Компьютерное исследование влияния неоднородностей металлического контакта на резистивные переключения в гетероструктуре на основе селенида висмута
В. В. Сироткин *
Федеральное государственное бюджетное учреждение науки Институт проблем микроэлектроники и особо чистых материалов Российской академии наук
142432 Московская область, г. Черноголовка, ул. Академика Осипьяна, 6, Россия
* E-mail: sirotkin@iptm.ru
Поступила в редакцию 07.02.2021
После доработки 16.02.2021
Принята к публикации 17.02.2021
Аннотация
В рамках ранее предложенной модели “критического поля” исследовано влияние наноразмерных неоднородностей (выступов) металлического контакта на биполярные резистивные переключения в планарной гетероструктуре на основе селенида висмута. Численные расчеты продемонстрировали, что подобные неоднородности в зависимости от их формы, размера и расположения относительно края контакта могут вносить существенные изменения в высоко- и низкорезистивное состояния данной гетероструктуры, а также заметно влиять на величину напряжений, требуемых для переключений между этими состояниями.
ВВЕДЕНИЕ
Электрически индуцированные биполярные резистивные переключения (БРП), наблюдаемые во многих системах металл-изолятор-металл, характеризуются воспроизводимостью и стабильностью высокорезистивных (ВРС) и низкорезистивных состояний (НРС). Подобные системы интересны с точки зрения создания нового поколения энергонезависимой памяти – мемристоров (см., например, [1]). В работах [2, 3] было продемонстрировано, что мемристивные структуры можно формировать, используя функциональные свойства селенида висмута (Bi2Se3).
В данной статье рассмотрена планарная гетероструктура на основе Bi2Se3 с верхним металлическим (серебренным) контактом в виде круга, диаметр которого значительно меньше общего размера структуры (рис. 1). Изолятором в гетероструктуре является поверхностный слой толщиной несколько сотен нанометров с удельной проводимостью значительно ниже объемной. Этот слой формирует дефектная фаза, возникающая вокруг верхнего контакта при предварительном электроформинге (локальном нагревании с помощью пропускания достаточно большого тока). Предполагается, что верхний контакт может содержать наноразмерные неоднородности в виде выступов, направленных вглубь поверхностного слоя. Подобные выступы могут возникать в ходе изготовления гетероструктуры, например, при постметализационном отжиге [2].
БРП в данной гетероструктуре, вызванные приложением к верхнему (управляющему) контакту напряжения U разной полярности, связаны с образованием или разрушением проводящих (перколяционных) каналов через поверхностный слой [2–4]. Предполагается, что такие БРП обусловлены эффектом Пул–Френкеля и электродиффузией ионов селена. Очевидно, что эти процессы должны наблюдаться в зонах, которые характеризуются сильным локальным повышением напряженности электрического поля. Такие зоны формируются вблизи края верхнего контакта. Присутствие на этом контакте нановыступов, также может вызывать образование подобных зон и, следовательно, влиять на протекание БРП. Экспериментальное исследование такого влияния является весьма сложной задачей. Поэтому представляет интерес привлечение математического моделирования для изучения зависимости характеристик БРП от параметров указанных выше неоднородностей.
В работах [5, 6] для компьютерного исследования БРП в гетероструктурах, подобных изображенной на рис. 1, была предложена модель “критического поля” (МКП). В этой модели полагается, что изменение проводимости происходит в тех областях поверхностного слоя, где напряженность электрического поля превышает некоторое критическое значение EC. При этом вопрос о механизмах, отвечающих за рост или разрушение проводящих каналов, в модели не рассматривается.
МКП основана на численном решении уравнения, связывающего распределение удельной проводимости σ в гетероструктуре с распределением электрического потенциала ϕ:
Изменение размеров и формы проводящих каналов в МКП происходит по следующему алгоритму:
1. По текущему распределению удельной проводимости σ в гетероструктуре с помощью (1) рассчитывается распределение электрического потенциала ϕ.
2. Определяется распределение напряженности электрического поля E.
3. Если в поверхностном слое присутствуют области, где |Е| ≥ EC, в них σin заменяется на σout (σin и σout принимают значения σВРС или σНРС в зависимости от полярности приложенного напряжения).
4. Если распределение σ изменилось, то осуществляется переход к шагу 1. В противном случае процесс переключения считается завершившимся.
Результаты, полученные с помощью МКП для гетероструктур на основе Bi2Se3, показали достаточно хорошее соответствие с экспериментальными данными [4].
Далее в статье описано применение МКП для анализа БРП в рассматриваемой Bi2Se3 гетероструктуре и проведен анализ полученных результатов.
МЕТОДИКА МОДЕЛИРОВАНИЯ
Численные эксперименты проводились для набора параметров, значения которых выбирались, исходя из результатов ранее выполненных экспериментальных работ по исследованию мемристивных свойств гетероструктур на основе монокристаллов и пленок Bi2Se3 [2–4]. Радиус верхнего контакта был равен r0 = 10 мкм, а толщина поверхностного слоя составляла zL = 500 нм. Использовались следующие величины удельных сопротивлений: исходного (объемного) Bi2Se3 – ρB = 1.4 × 10–3 Ом ⋅ см, поверхностного слоя – ρL = 200 Ом ⋅ см (σВРС = 1/ρL) и проводящего канала – ρcc = 0.14 Ом ⋅ см (σНРС = 1/ρcc). БРП осуществлялись при напряжениях ±1 В (если не указано иначе). Критическое значение напряженности электрического поля EC полагалось равным 3.75 × 104 В/см.
При моделировании гетероструктура представлялась в виде цилиндра радиусом и высотой 1 мм. Управляющий (верхний) контакт располагался в центре верхнего основания цилиндра. Заземляющий контакт размещался на боковой поверхности цилиндра. Поверхностный слой находился непосредственно под верхним контактом и охватывал его край, закругляясь к поверхности по радиусу zL.
В качестве основных тестовых объектов в статье использовались кубические выступы с длиной ребра либо h = 15 нм (P1), либо H = 45 нм (P2). Кроме того, рассматривались “плоские” выступы: H × H × h (P3) и 3H × 3H × h (P4). Позиции выступов задавались расположением их центра относительно края верхнего контакта: r0 – d, где d могло принимать значения zL/2, zL, 2zL и 3zL.
Наибольший практический интерес представляет исследование интегрального вклада в БРП от достаточно большого числа выступов. Вместе с тем важно отследить влияние на этот вклад размеров выступов и их расположения. Поэтому при моделировании рассматривались варианты, в которых предполагалось наличие на верхнем контакте равномерно расположенных одинаковых выступов, находящихся на одном и том же расстоянии d от края. Для исключения взаимного влияния выступов при БРП они размещались друг от друга на расстоянии примерно равном 2zL, что при указанных выше параметрах гетероструктуры соответствовало присутствию на контакте 60 выступов. Из-за осевой симметрии описываемой конфигурации при ее моделировании решение уравнения (1) определялось лишь в части гетероструктуры – в цилиндрическом секторе с центральным углом 6°. Сектор содержал только один выступ, который располагался на биссектрисе центрального угла. На боковых сторонах сектора задавались однородные условия Неймана.
Расчеты осуществлялись с помощью компьютерной программы, в которой для реализации МКП использовался численный алгоритм, сочетающий интегро-разностную аппроксимацию уравнения (1) [7] и многосеточный метод с локальным сгущением узлов [8].
РЕЗУЛЬТАТЫ МОДЕЛИРОВАНИЯ И ОБСУЖДЕНИЕ
Пример расчетов по МКП для Bi2Se3 гетероструктуры с выступами P1 и P2 приведен на рис. 2. Изображения на рисунке представлены в декартовой системе координат, начало отсчета которой расположено в центре верхнего контакта, а ось x направлена вдоль биссектрисы центрального угла цилиндрического сектора, рассматриваемого при моделировании. На рисунке показано сечение гетероструктуры, проходящее через начало координат.
Рис. 2.
Результаты расчетов по МКП для Bi2Se3 гетероструктуры с выступами P1 (вверху) и P2 (внизу). Слева показано состояние поверхностного слоя после перехода гетероструктуры из исходного состояния в НРС, справа – после последующего перехода из НРС в ВРС (см. также дополнительную информацию в тексте).
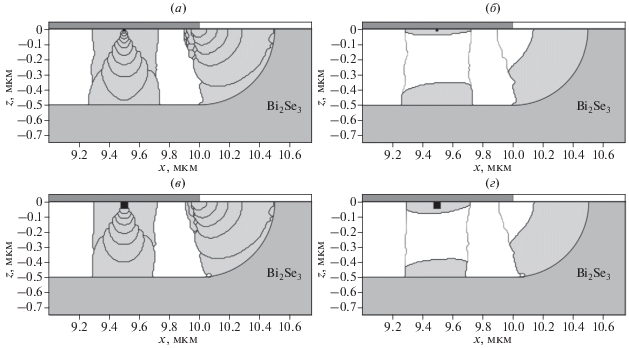
Рис. 2а и 2в демонстрируют процесс образования проводящих каналов (на рисунках им соответствуют светло серые области) в окрестностях края верхнего контакта, а также вблизи выступов P1 и P2, удаленных от этого края на расстояние zL, при переходе гетероструктуры из исходного состояния в НРС. Видно, что все каналы начинают расти от верхнего контакта. Семейства кривых на рисунках отражают разные этапы этого роста. Результаты моделирования показали, что рост каналов от выступов является более медленным, чем у проводящего канала от края. Эти каналы еще продолжают расти в то время, когда “периферийный” канал большей частью уже сформировался. Следует отметить, что оба “внутренних” канала после завершения их формирования близки по форме к цилиндрам с радиусами порядка 200 нм (т.е. поперечные размеры каналов намного превышают размеры выступов). При этом канал, образовавшийся возле выступа P1, оказывается несколько шире в своей нижней части, чем канал возле выступа P2. Причиной этого является различие в размерах зон с превышением EC, возникающих вокруг выступов P1 и P2 при росте каналов. Такие зоны заметно крупнее в непосредственной близости от выступа P2. Поэтому канал от него быстрее достигает границы раздела между поверхностным слоем и Bi2Se3, меньше разрастаясь в ширину. Выявленное соотношение между размерами нижних оснований каналов сохраняется и тогда, когда выступы P1 и P2 находятся на большем расстоянии от края верхнего контакта (рис. 3).
Рис. 3.
Проводящие каналы, сформировавшиеся при переходе Bi2Se3 гетероструктуры из исходного состояния в НРС, возле выступов (а) P1 и (б) P2, находящихся на расстоянии 3zL от края верхнего контакта.

Параллельный рост каналов от выступов и от края вызывает значительные изменения конфигурации электрического поля в области поверхностного слоя, разделяющей эти каналы. Это может приводить к взаимному влиянию формирующихся каналов друг на друга. В случаях, рассматриваемых на рис. 2, данное влияние проявляется в незначительном изменении формы “периферийного” канала по сравнению со случаем, который соответствует отсутствию выступов, а также в асимметрии “внутренних” каналов. При увеличении расстояния от края контакта до выступов эти проявления сходят на нет (см., например, рис. 3). Напротив, сокращение расстояния d вызывает усиление указанного влияния, а при d = zL/2 наблюдается смыкание “внутренних” и “периферийного” каналов.
На рис. 2б и 2г показано состояние поверхностного слоя в окрестностях выступов P1 и P2 после завершения перехода гетероструктуры из НРС в ВРС, последовавшего за переходом из исходного состояния в НРС. Видно, что окончание этого перехода не приводит к полному исчезновению проводящих каналов. В поверхностном слое сохраняются достаточно протяженные, но не связанные между собой низкорезистивные зоны. При этом “периферийный” канал частично разрушается только сверху, а частичное разрушение “внутренних” каналов наблюдается только в их центральной части (на рассматриваемых рисунках для наглядности пунктиром обозначены контуры проводящих каналов до разрушения). Важно отметить, что в рассматриваемом случае разрывы в проводящих каналах, идущих от выступов, начинают формироваться только после того, как происходит полное отсоединение “периферийного” канала от верхнего контакта. Это событие знаменуется резкой перестройкой конфигурации электрического поля вблизи “внутренних” каналов. Таким же образом разрушаются каналы от выступов P1 и P2, расположенных от края контакта на расстоянии d = 2zL. При увеличении d до 3zL ситуация меняется. В ходе перехода гетероструктуры в ВРС канал от выступа P1 разрушается, а от выступа P2 – нет. Это связано, прежде всего, с тем, что при указанной величине d даже радикальные изменения в структуре “периферийного” канала уже никак не сказываются на распределении электрического поля в окрестностях “внутренних” каналов. Поэтому возникновение зон с превышением критического поля обуславливается исключительно формой боковой поверхности самих проводящих каналов. На рис. 3 видно, что канал возле выступа P1, в отличие от канала возле выступа P2, имеет локальное сужение в своей средней части. Наличие этого сужения как раз и способствует началу процесса разрушения.
Важным показателем для мемристивных сртруктур является воспроизводимость характеристик ВРС и НРС при многократных БРП. На рис. 4 показано относительное изменение сопротивлений Bi2Se3 гетероструктуры в ходе пяти последовательных БРП при отсутствии выступов на верхнем контакте. На рисунке использованы следующие обозначения: $\delta _{{{\text{on}}}}^{m} = {{R_{{on}}^{m}} \mathord{\left/ {\vphantom {{R_{{on}}^{m}} {R_{{{\text{on}}}}^{*}}}} \right. \kern-0em} {R_{{{\text{on}}}}^{*}}}$ и $\delta _{{{\text{off}}}}^{m} = {{R_{{{\text{off}}}}^{m}} \mathord{\left/ {\vphantom {{R_{{{\text{off}}}}^{m}} {R_{{{\text{off}}}}^{*}}}} \right. \kern-0em} {R_{{{\text{off}}}}^{*}}},$ где m – номер БРП, $R_{{{\text{on}}}}^{m}$ – сопротивление гетероструктуры в очередном НРС, $R_{{{\text{off}}}}^{m}$ – сопротивление гетероструктуры в очередном ВРС, $R_{{{\text{on}}}}^{*} = R_{{{\text{on}}}}^{1}$ и $R_{{{\text{off}}}}^{*} = R_{{{\text{off}}}}^{1}.$ Исходное сопротивление “бездефектной” гетероструктуры равно R0 ≈ 3037 Ом. После перехода из исходного состояния в НРС ее сопротивление из-за образования “периферийного” проводящего канала снижается приблизительно в 82 раза: $R_{{{\text{on}}}}^{1} \approx 37\,\,{\text{Ом}}{\text{.}}$ При последующем переходе из НРС в ВРС, несмотря на присутствие возле края верхнего контакта сохранившейся низкорезистивной зоны, сопротивление гетероструктуры оказывается достаточно близким к значению R0: $R_{{{\text{off}}}}^{1} \approx 2891\,\,{\text{Ом}}{\text{.}}$ Как следует из рис. 4, при дальнейших БРП сопротивление гетероструктуры в ВРС фактически не меняется. Сопротивление гетероструктуры в НРС, немного снижается при втором БРП из-за того, что в этом случае образование “периферийного” канала происходит уже в присутствие остаточной низкорезистивной зоны, а затем меняется едва заметно.
Рис. 4.
Относительное изменение сопротивлений Bi2Se3 гетероструктуры в ходе пяти последовательных БРП при отсутствии выступов на верхнем контакте (см. пояснения в тексте).

На рис. 5 и 6 представлены относительные изменения сопротивлений при пяти последовательных БРП для гетероструктуры с выступами P1 и P2, находящимися на разном удалении от края верхнего контакта. Важно указать, что графики на этих рисунках построены с использованием значений $R_{{{\text{on}}}}^{*}$ и $R_{{{\text{off}}}}^{*},$ соответствующих “бездефектной” гетероструктуре. Из рисунков следует, что наличие выступов на верхнем контакте может заметно сказываться на величине сопротивления гетероструктуры в НРС. Моделирование показало, что сопротивления одиночных проводящих каналов, возникающих возле выступов, имеют значения в диапазоне примерно от 2 до 6 кОм. Однако, включение 60 таких каналов параллельно проводящему каналу, идущему от края верхнего контакта, может значительно уменьшить сопротивление гетероструктуры в целом. Как уже отмечалось выше, образование проводящих каналов, начиная со второго БРП, происходит в присутствие довольно протяженных остаточных низкорезистивных зон. В окрестностях выступов эти зоны расположены как под верхним контактом, так и у границы раздела между поверхностным слоем и Bi2Se3. Проводящие каналы, сформировавшиеся в таких условиях, уже не имеют форму, близкую к цилиндрической, как, например, на рис. 3. На них могут образовываться достаточно крупные уширения и сужения. Поскольку это меняет сопротивление каналов, то соответствующим образом меняется и сопротивление гетероструктуры. На рис. 5 и 6 видно, что при d = 3zL сопротивление гетероструктуры в НРС стабилизируется после 2–3 БРП. Это означает, что, начиная с этого момента, форма проводящих каналов перестает существенно меняться. При меньших значения d изменение формы каналов (и, следовательно, сопротивления гетероструктуры) наблюдается на протяжении всех пяти БРП. Изменение сопротивления гетероструктуры при d = zL/2 и d = zL дополнительно обусловлено смыканием “внутренних” и “периферийного” каналов. Причем если в первом случае смыкание каналов происходит уже при первом БРП, то во втором – несколько позднее. Графики на рисунках демонстрируют, что присутствие на верхнем контакте выступов P1 и P2 может вызывать снижение сопротивление гетероструктуры в НРС более чем в два раза.
Рис. 5.
Относительное изменение сопротивлений Bi2Se3 гетероструктуры с выступами P1 в ходе пяти последовательных БРП при разных значениях d (см. пояснения в тексте).

Рис. 6.
Относительное изменение сопротивлений Bi2Se3 гетероструктуры с выступами P2 в ходе пяти последовательных БРП при разных значениях d (см. пояснения в тексте).

Из графиков на рис. 5 и 6 также можно заключить, что сопротивления в ВРС гетероструктуры с выступами P1 и P2 при переходе от одного БРП к другому меняется незначительно и достаточно близко к соответствующему сопротивлению “бездефектной” гетероструктуры. Исключение составляет вариант с выступом P2, расположенным от края верхнего контакта на расстоянии 3zL. Наблюдаемое при этом аномально низкое сопротивление (примерно 89 Ом) связано, как уже отмечалось, с тем, что в этом случае при переходе гетероструктуры в ВРС “внутренние” проводящие каналы остаются неразрушенными. Увеличение напряжения Uoff, используемого для перевода гетероструктуры из НРС в ВРС, до 1.05 В приводит к разрушению этих каналов (см. рис. 7а).
Рис. 7.
Относительное изменение сопротивлений Bi2Se3 гетероструктуры с выступами P2, P3 и P4, находящимися на расстоянии 3zL от края верхнего контакта, в ходе пяти последовательных БРП при повышенных абсолютных значениях переключающих напряжений (см. пояснения в тексте).

Важно отметить, что изменение переключающих напряжений относительно ранее указанных значений позволяет также “активировать” выступы P3 и P4. Эти выступы имеют меньшее аспектное отношение по сравнению с выступами P1 и P2. Поэтому при напряжении Uon = –1 В, используемом для перевода гетероструктуры из ВРС в НРС, зоны с превышением критического поля вблизи выступов P3 и P4 не возникают, и, следовательно, проводящие каналы от этих выступов не растут. Пороговыми для образования проводящих каналов возле выступов P3 и P4 являются значения напряжения Uon равные –1.05 и –1.1 В соответственно (рис. 7б и 7в). Поскольку проводящие каналы, порождаемые выступами P3 и P4, исходно имеют сложную форму (см., например, рис. 8), при последовательных БРП их эволюция к некоторому установившемуся состоянию происходит достаточно медленно и сопровождается снижением сопротивления гетероструктуры в НРС, более значительным, чем в случае выступов P1 и P2 (ср. рис. 5–7).
Рис. 8.
Состояние поверхностного слоя в зоне выступа P4, находящегося на расстоянии 3zL от края контакта. (а) После перехода Bi2Se3 гетероструктуры из исходного состояния в НРС, (б) после последующего перехода из НРС в ВРС.
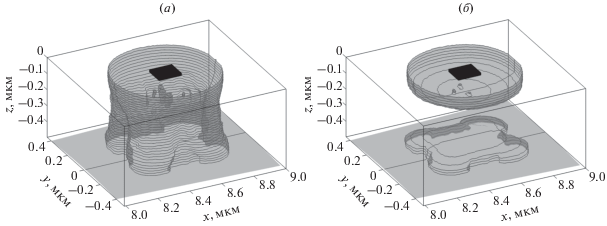
Результаты моделирования, представленные на рис. 7, показывают, что в ситуации, когда верний контакт может содержать разнообразные выступы, отличающиеся размерами, формой и расположением относительно края этого контакта, у исследуемой гетероструктуры возможно наличие нескольких воспроизводимых и стабильных как низкорезистивных, так и высокорезистивных состояний. Другими словами, моделирование продемонстрировало, что подобные гетероструктуры могут служить основой для создания многоуровневых мемристоров. Экспериментально наличие нескольких высокорезистивных состояний у Bi2Se3 гетероструктур недавно подтверждено в [9].
ЗАКЛЮЧЕНИЕ
В статье в рамках ранее предложенной модели “критического поля” исследованы переходы между высоко- и низкорезистивными состояниями планарной мемристивной гетероструктуры на основе селенида висмута. Данная гетероструктура содержит микроразмерный металлический контакт, под которым находится тонкий слой из изолирующей дефектной фазы. С помощью численного моделирования установлено, что наличие на этом контакте наноразмерных выступов, направленных вглубь дефектной фазы, может приводить к формированию проводящих каналов в дополнение к проводящему каналу, образующемуся у края контакта. Присутствие этих дополнительных проводящих каналов в дефектной фазе, в свою очередь, может существенно менять величину сопротивления рассматриваемой гетероструктуры как в низкорезистивном, так и в высокорезистивном состоянии. Кроме того, в зависимости от формы, размеров и расположения относительно края контакта указанных выступов могут меняться значения напряжений, вызывающих переходы гетероструктуры из одного резистивного состояния в другое. Таким образом, показано, что в подобных гетероструктурах возможно возникновение нескольких воспроизводимых и стабильных низко- или высокорезистивных состояний.
Автор выражает признательность Н.А. Тулиной за плодотворное обсуждение материала данной статьи.
Выполнение данной работы финансировалось за счет гранта РФФИ № 19-29-03011мк.
Список литературы
Pershin Y.V., Ventra M.P. Memory effects in complex materials and nanoscale systems // Advances in Physics. 2011. V. 60. P. 14–227.
Tulina N.A., Rossolenko A.N., Shmytko I.M., Kolesnikov N.N., Borisenko P.N., Bozhko S.I., Ionov A.M. Rectification and resistive switching in mesoscopic heterostructures based on Bi2Se3 // Materials Letters. 2015. V. 158. P. 403–405.
Тулина Н.А., Россоленко А.Н., Шмытько И.М., Колесников Н.Н., Борисенко Д.Н., Сироткин В.В., Борисенко И.Ю. Частотные свойства гетероструктур на основе селенида висмута в эффектах резистивных переключений. эксперимент, численное моделирование // Известия РАН, сер. Физическая. 2016. Т. 80. № 6. С. 741–743.
Тулина Н.А., Россоленко А.Н., Шмытько И.М., Колесников Н.Н., Борисенко Д.Н., Сироткин В.В., Борисенко И.Ю., Тулин В.А. Исследование динамических эффектов в мемристорных структурах на основе селенида висмута. Нужен ли мемристору “хвост шаттла” // Известия РАН, сер. Физическая. 2019. Т. 83. № 6. С. 813–817.
Тулина Н.А., Сироткин В.В., Борисенко И.Ю., Иванов А.А. Моделирование резистивных переключений в гетероструктурах на основе оксидных соединений // Известия РАН, сер. Физическая. 2013. Т. 77. № 3. С. 297–299.
Tulina N.A., Borisenko I.Yu., Sirotkin V.V. Bipolar resistive switchings in Bi2Sr2CaCu2O8 + δ // Solid State Communications. 2013. V. 170. № 1. P. 48–52.
Марчук Г.И. Методы вычислительной математики. М.: Наука, 1977.
Trottenberg U., Oosterlec C.W., Schiiller A. Multigrid. London: Acad. Press, 2001.
Zotov A.V., Sirotkin V.V., Il’in A.I., Trofimov O.V., Bori-senko P.N., Kolesnikov N.N., Tulin V.A. Multilevel memristive structures based on bismuth selenide microcrystals // Chaos, Solitons and Fractals. 2021. V. 143. P. 110542.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника