Микроэлектроника, 2021, T. 50, № 5, стр. 339-346
Особенности кинетики реактивно-ионного травления Si и SiO2 в смеси CF4 + O2 в режиме малой вкладываемой мощности
А. М. Ефремов a, *, В. Б. Бетелин b, K.-H. Kwon c
a ФГБОУ ВО “Ивановский государственный химико-технологический университет”
153000 Иваново, Шереметевский просп., 7, Россия
b ФГУ ФНЦ НИИСИ РАН
Москва, Нахимовский просп., 36, к. 1, Россия
c Korea University
339-700 Sejong, South Korea
* E-mail: amefremov@mail.ru
Поступила в редакцию 04.12.2020
После доработки 18.02.2021
Принята к публикации 20.02.2021
Аннотация
Проведено исследование кинетики реактивно-ионного травления Si и SiO2 в плазме индукционного ВЧ (13.56 МГц) разряда в смеси CF4 + O2 в диапазоне вкладываемой мощности 200–600 Вт (0.02–0.06 Вт/см3). При совместном использовании диагностики плазмы зондами Лангмюра и 0-мерного (глобального) моделирования плазмы а) выявлены ключевые плазмохимические процессы, формирующие стационарные электрофизические параметры и состав газовой фазы; и б) определены плотности потоков нейтральных и заряженных частиц на обрабатываемую поверхность. Установлено, что доминирующим механизмом травления обоих материалов является ионно-стимулированная химическая реакция, протекающая в кинетическом режиме и лимитируемая потоком атомов фтора. Показано, что снижение эффективной вероятности взаимодействия в системах Si/SiO2 + F с ростом вкладываемой мощности и давления газа может быть обусловлено гетерогенными процессами с участием атомов кислорода.
1. ВВЕДЕНИЕ
Кремний и диоксид кремния традиционно используются в технологии микро- и нано-электроники в качестве подложек и функциональных слоев различного назначения, формирующих основу интегральных микросхем (ИМС) [1, 2]. Большинство применений этих материалов в структуре ИМС требуют формирования прецизионного топологического рельефа на предварительно сформированных сплошных поверхностях, которое достигается методами сухого (плазменного) травления в среде фторуглеродных газов [2, 3]. Таким образом, исследование кинетики и выявление механизмов взаимодействия активных частиц плазмы с обрабатываемой поверхностью является неотъемлемым условием оптимизации существующих и разработки новых технологических плазмохимических процессов для Si и SiO2.
В настоящее время имеется большое количество экспериментальных работ, посвященных различным аспектам взаимодействия фторуглеродной плазмы с поверхностью Si и SiO2 [4–12]. Результаты этих работ могут быть кратко обобщены в виде следующих положений:
1) Структурирование поверхностей Si и SiO2 преимущественно обеспечивается реактивно-ионными процессами в газах семейства CxFy (например – CF4, C2F6, C3F6 и C4F8). Типичными условиями проведения таких процессов являются давления газа p < 10 мтор и вкладываемые мощности W > 0.1 Вт/см3, что обеспечивает плотность плазмы (стационарные концентрации заряженных частиц) на уровне 1010–1011 см–3 [4, 5]. Использование смесей фторуглеродных газов с Ar и/или O2, а также комбинирование двух фторуглеродных компонентов в одной смеси дает возможность гибкого регулирования кинетики и профиля травления через изменение плотности потока атомов фтора и толщины фторуглеродной полимерной пленки на обрабатываемой поверхности [4, 7–9].
2) Гетерогенная реакция Si + xF → SiF xимеет беспороговый характер и протекает самопроизвольно с образованием летучего тетрафторида кремния [4]. В условиях малой полимеризационной нагрузки плазмы на обрабатываемую поверхность, кинетика травления кремния однозначно определяется плотностью потока атомов фтора, при этом отличительными особенностями процесса являются а) слабо выраженный активирующий эффект со стороны ионной бомбардировки; б) экспоненциальная зависимость скорости от температуры поверхности для кинетического режима процесса; и в) близкий к изотропному профиль травления [4, 13].
3) Гетерогенная реакция SiOy + xF → SiFx + yO характеризуется высокой пороговой энергией (как это следует из сравнения энергии связей Si–O ∼ 799 кДж/моль и Si–F ∼ 552 кДж/моль [14]) и не может протекать самопроизвольно при характерных температурах процесса [8–11]. Соответственно, основным механизмом травления SiO2 является ионно-стимулированная химическая реакция, в которой ионная бомбардировка обеспечивает образование центров хемосорбции для атомов фтора и очистку поверхности от труднолетучих ненасыщенных фторидов кремния. При энергиях бомбардирующих ионов ∼150–200 эВ происходит смена режима травления от лимитирования потоком ионов к лимитированию потоком атомов фтора. Признаками последнего являются а) немонотонная (с максимумом) зависимость скорости травления от доли кислорода в смеси CF4 + O2 [6, 15]; и б) увеличение скорости травления с ростом давления газа [16].
Одной из насущных задач современной технологии реактивно-ионного травления (РИТ) является формирование структур с высоким аспектным соотношением для щелевой изоляции элементов ИМС. Необходимая при этом высокая анизотропия травления достигается за счет пассивирования боковых стенок фторуглеродным полимером (Бош-процесс) или нелетучими продуктами травления (криогенный процесс). Исследования последних лет показали, что существенное увеличение показателя анизотропии может быть достигнуто в обычном РИТ процессе в условиях низкой (менее 0.1 Вт/см3) вкладываемой мощности [17–19]. Другими достоинствами таких процессов являются низкая шероховатость обработанной поверхности [18] и минимальные радиационные повреждения кристаллических структур [19]. Очевидно, что практическое использование таких процессов требует знания особенностей состава плазмы и кинетики гетерогенного взаимодействия в системе “плазма–твердое тело” в нехарактерном для большинства существующих РИТ технологий диапазоне условий. Поэтому в качестве целей данной работы выступали: 1) исследование электрофизических параметров и стационарного состава плазмы CF4 + O2 в условиях малой (0.02–0.06 Вт/см3) вкладываемой мощности при различных давлениях газа; и 2) изучение кинетических закономерностей и выявление механизмов травления для Si и SiO2, как основных материалов кремниевой электроники.
2. МЕТОДИЧЕСКАЯ ЧАСТЬ
2.1. Оборудование и техника эксперимента
Эксперименты проводились в условиях индукционного ВЧ (13.56 МГц) разряда в реакторе планарного типа (с верхним расположением плоского спиралевидного индуктора) [12, 16]. В качестве постоянных внешних параметров плазмы выступали общий расход плазмообразующего газа (q = 40 станд. см3/мин), мощность смещения на нижнем электроде (Wdc = 200 Вт) и начальный состав плазмообразующей смеси CF4 + O2. Последний задавался равными парциальными расходами тетрафторметана и кислорода, что соответствовало 50% CF4 + 50% O2. Варьируемыми параметрами являлись вкладываемая мощность (W = 200–600 Вт или 0.02–0.06 Вт/см3) и давление газа (p = 4 и 12 мторр).
Диагностика плазмы осуществлялась двойным зондом ЛангмюраDLP2000 (PlasmartInc., Korea), снабженного системой импульсной очистки ионной бомбардировкой для измерений в полимеробразующих газах. В дополнение к этому, перед каждым измерением зонды очищались в плазме 50% Ar + 50% O2 в течение ∼2 мин. Обработка зондовых вольт-амперных характеристик (ВАХ) обеспечивала данные по температуре электронов (Te) и плотности ионного тока (J+) [20, 21]. Отрицательное смещение на нижнем электроде – Udc контролировали с помощью высоковольтного зонда AMN-CTR (YoungsinEng, Korea). В предварительных экспериментах было найдено, что варьирование Wdc в диапазоне 0–200 Вт не оказывает принципиального влияния на вид зондовых ВАХ и, следовательно, на параметры газовой фазы разряда.
В качестве объектов травления использовались фрагменты (∼2 × 2 см) не окисленных и термически окисленных пластин Si(100), которые располагались в центральной части нижнего электрода. Температура образцов поддерживалась на постоянном уровне с помощью системы водяного охлаждения. Скорости травления определяли как R = Δh/τ, где τ – время травления и Δh – высота ступеньки травления на границе маскированной и немаскированной областей обрабатываемой поверхности, измеряемая с помощью профилометра Alpha-step D-500 (KLA-Tencor, USA). В качестве маскирующего покрытия использовался фоторезист AZ1512 толщиной ∼2 мкм. Предварительные эксперименты показали, что 1) кинетические кривые травления Δh = f(τ) для обоих материалов являются квазилинейными; 2) увеличение площади обрабатываемой поверхности не приводит к снижению скоростей травления; и 3) присутствие образца в реакторе не приводит к заметными искажениям зондовых ВАХ по сравнению с “чистой” плазмой. Это позволяет заключить, что в данном диапазоне условий процесс травления Si и SiO2 протекает в кинетическом режиме при пренебрежимо малом влиянии продуктов травления на параметры газовой фазы.
2.2. Моделирование плазмы
Для получения данных по стационарному составу плазмы использовалась 0-мерная кинетическая модель, оперирующая усредненными по объему реактора параметрами. Алгоритм расчета базировался на совместном решении уравнений химической кинетики нейтральных и заряженных частиц c использованием типовых допущений для области давлений p < 20 мторр [4, 12, 22–24]. В частности, полагалось, что:
1) Максвэлловское приближение функции распределения электронов по энергиям (ФРЭЭ) обеспечивает адекватное описание кинетики процессов при электронном ударе.
2) Низкая электроотрицательность плазмы низкого давления позволяет полагать ${{n}_{e}}$ ≈ ${{n}_{ + }},$ где ${{n}_{ + }} \approx {{{{J}_{ + }}} \mathord{\left/ {\vphantom {{{{J}_{ + }}} {0.61e{{\upsilon }_{B}}}}} \right. \kern-0em} {0.61e{{\upsilon }_{B}}}}$ – суммарная концентрация положительных ионов, ${{\upsilon }_{B}} \approx \sqrt {{{e{{T}_{e}}} \mathord{\left/ {\vphantom {{e{{T}_{e}}} {{{m}_{i}}}}} \right. \kern-0em} {{{m}_{i}}}}} $ – скорость ионов на внешней границе двойного электрического слоя у поверхности зонда и ${{m}_{i}}$ – эффективная масса ионов, определяемая составом ионной компоненты плазмы. Последний может быть оценен в предположении, что ${{y}_{{{{X}^{ + }}}}}\sim {{{{k}_{{iz}}}{{y}_{X}}} \mathord{\left/ {\vphantom {{{{k}_{{iz}}}{{y}_{X}}} {\sqrt {{1 \mathord{\left/ {\vphantom {1 {{{m}_{{{{X}^{ + }}}}}}}} \right. \kern-0em} {{{m}_{{{{X}^{ + }}}}}}}} }}} \right. \kern-0em} {\sqrt {{1 \mathord{\left/ {\vphantom {1 {{{m}_{{{{X}^{ + }}}}}}}} \right. \kern-0em} {{{m}_{{{{X}^{ + }}}}}}}} }},$ где$~{{y}_{{{{X}^{ + }}}}}$ – мольная доля иона с массой ${{m}_{{{{X}^{ + }}}}},$ а ${{k}_{{iz}}}$ и ${{y}_{X}}$ – константа скорости ионизации и мольная доля соответствующей нейтральной частицы.
3) Температура нейтральных частиц ${{T}_{{{\text{gas}}}}}$ слабо зависит от давления газа, но является линейной функцией вкладываемой мощности. Принимая для данного реактора близким к истине значение ${{T}_{{{\text{gas}}}}}$ ∼ 700 К при $W$ = 900 W [22, 24], диапазону 200–600 W отвечает ${{T}_{{{\text{gas}}}}}$ ∼ 350–550 К.
4) Гетерогенная рекомбинация атомов и радикалов описывается механизмом Или-Ридила. Константы скоростей соответствующих процессов могут быть определены как $k \approx {{\gamma {{\upsilon }_{T}}} \mathord{\left/ {\vphantom {{\gamma {{\upsilon }_{T}}} {2r}}} \right. \kern-0em} {2r}},$ где $\gamma $ вероятность рекомбинации [22, 23], $r$ – радиус рабочей камеры реактора и ${{\upsilon }_{T}} = {{\left( {{{8{{k}_{B}}{{T}_{{{\text{gas}}}}}} \mathord{\left/ {\vphantom {{8{{k}_{B}}{{T}_{{{\text{gas}}}}}} {\pi m}}} \right. \kern-0em} {\pi m}}} \right)}^{{{1 \mathord{\left/ {\vphantom {1 2}} \right. \kern-0em} 2}}}}.$
Кинетическая схема (набор реакций и констант скоростей) для смеси CF4 + O2 была позаимствована из нашей работы [22]. Выходными параметрами модели служили скорости процессов образования и гибели частиц, их концентрации и плотности потоков на поверхность, контактирующую с плазмой.
2.3. Анализ кинетики травления
Анализ кинетики травления Si и SiO2 базировался на литературных данных по механизмам реактивно-ионных процессов в фторуглеродной плазме [4, 7–9, 25, 26], которые были обобщены в наших работах [12, 16, 24]. В частности, полагалось, что:
1) Процессы физического взаимодействия плазмы с поверхностью (распыление основной поверхности, деструкция полимерной пленки и ионно-стимулированная десорбция продуктов взаимодействия) характеризуется скоростью ${{Y}_{S}}{{{{\Gamma }}}_{ + }},$ где ${{Y}_{S}}$ – выход процесса (атом/ион) и ${{{{\Gamma }}}_{ + }} \approx {{{{J}_{ + }}} \mathord{\left/ {\vphantom {{{{J}_{ + }}} e}} \right. \kern-0em} e}$ – плотность потока ионов. Изменение скорости ионного процесса при варьировании условий обработки отслеживается параметром $\sqrt {{{\varepsilon }_{i}}} {{{{\Gamma }}}_{ + }},$ где ${{\varepsilon }_{i}} = e\left| { - {{U}_{f}} - {{U}_{{dc}}}} \right|$ – энергия бомбардирующих ионов, ${{U}_{f}}$ – плавающий потенциал.
2) Процессы химического взаимодействия плазмы с поверхностью (травление основной поверхности атомами фтора, деструкция полимерной пленки атомами кислорода) характеризуется скоростью ${{\gamma }_{X}}{{{{\Gamma }}}_{X}},$ где ${{\gamma }_{X}}$ – эффективная вероятность взаимодействия, а ${{{{\Gamma }}}_{X}}$ – плотность потока атомов. Изменение скорости химического процесса в условиях малых изменений температуры поверхности может быть отслежено параметром ${{{{\Gamma }}}_{X}}.$
3) Формирование фторуглеродной полимерной пленки обеспечивается радикалами CFx (х = = 1, 2), при этом изменение скорости связывания радикалов с поверхностью характеризуется отношением ${{{{{{\Gamma }}}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{{\Gamma }}}_{{{\text{pol}}}}}} {{{{{\Gamma }}}_{{\text{F}}}}}}} \right. \kern-0em} {{{{{\Gamma }}}_{{\text{F}}}}}},$ где ${{{{\Gamma }}}_{{{\text{pol}}}}} = {{{{\Gamma }}}_{{{\text{CF}}}}} + {{{{\Gamma }}}_{{{\text{C}}{{{\text{F}}}_{{\text{2}}}}}}}.$ Соответственно, относительное изменение толщины пленки за счет действия физического и химического механизмов травления отслеживается параметрами ${{{{{{\Gamma }}}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{{\Gamma }}}_{{{\text{pol}}}}}} {\sqrt {{{\varepsilon }_{i}}} {{{{\Gamma }}}_{ + }}{{{{\Gamma }}}_{{\text{F}}}}}}} \right. \kern-0em} {\sqrt {{{\varepsilon }_{i}}} {{{{\Gamma }}}_{ + }}{{{{\Gamma }}}_{{\text{F}}}}}}$ и ${{{{{{\Gamma }}}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{{\Gamma }}}_{{{\text{pol}}}}}} {{{{{\Gamma }}}_{{\text{O}}}}{{{{\Gamma }}}_{{\text{F}}}}}}} \right. \kern-0em} {{{{{\Gamma }}}_{{\text{O}}}}{{{{\Gamma }}}_{{\text{F}}}}}}.$
3. РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
На рис. 1 показаны зависимости скоростей травления Si и SiO2 от давления газа и вкладываемой мощности. Анализ этих данных с учетом предшествующих работ [12, 16, 27, 28] позволяет сформулировать предварительные выводы по кинетике и механизмам травления. Во-первых, качественно однотипные изменения скоростей травления обоих материалов от переменных параметров процесса фактически означают идентичные режимы травления, определяемые механизмами гетерогенного взаимодействия и типами активных частиц. Во-вторых, оценка скоростей физического распыления по известным коэффициентам распыления Si и SiO2 (∼0.5 атом/ион при 500 эВ [29, 30]) и плотностям потоков ионов ${{{{\Gamma }}}_{ + }} \approx {{{{J}_{ + }}} \mathord{\left/ {\vphantom {{{{J}_{ + }}} e}} \right. \kern-0em} e}$ (4.6 × 1014–3.6 × 1015 см–2 с–1 для $p$ = 4 мторр и 4.6 × 1014–3.6 × 1015 см–2 с–1 для $p$ = 12 мторр при $W$ = 200–600 Вт) позволяет заключить, что максимальный вклад ${{R}_{{{\text{phys}}}}}$ в наблюдаемую скорость травления $R$ не превышает 20% (рис. 1). Справедливость соотношений ${{R}_{{{\text{phys}}}}}$ $ \ll $ ${{R}_{{{\text{chem}}}}}$ и $R$ ≈ ${{R}_{{{\text{chem}}}}}$ указывает на то, что основным механизмом травления для обоих материалов в исследованном диапазоне условий является ионно-стимулированная химическая реакция. И, в-третьих, увеличение скорости травления с ростом вкладываемой мощности (например, 71–126 нм/мин для Si и 109–177 нм/мин для SiO2 при $W$ = 200–600 Вт и $p$ = 4 мторр) и давления газа (например, 105–121 нм/мин для Si и 154–183 нм/мин для SiO2 при $p$ = 4–12 Вт и $W$ = = 400 Вт) является характерным для ионно-стимулированной химической реакции, протекающей в режиме лимитирования потоком нейтральных частиц (в данном случае – атомов фтора). Поэтому можно предположить, что наблюдаемая кинетика травления Si и SiO2 отражает кинетику гетерогенной реакции Si + xF → SiFx. В случае SiO2 это означает также, что деструкция оксидных связей ионной бомбардировкой не является лимитирующей стадией процесса. В пользу последнего предположения говорят и близкие абсолютные значения скоростей травления Si и SiO2.
Рис. 1.
Скорости реактивно-ионного травления Si и SiO2 в плазме смеси 50% CF4 + 50% O2. Пунктирные кривые с индексами “физ.” и “хим.” иллюстрируют вклады физического распыления и ионно-стимулированной химической реакции соответственно.

Для получения дополнительной информации по кинетике ионно-стимулированной химической реакции в рассматриваемых условиях необходимы данные о параметрах плазмы, определяющих плотности потоков активных частиц на обрабатываемую поверхность. Результаты диагностики плазмы, приведенные в табл. 1, могут быть кратко обобщены в виде следующих положений:
Таблица 1.
Электрофизические параметры плазмы смеси 50% CF4 + 50% O2
| W, Вт | ${{T}_{e}}$, эВ | ${{J}_{ + }}$, мА/см2 | $ - {{U}_{{dc}}}$, В | $\sqrt {{{\varepsilon }_{i}}} {{{{\Gamma }}}_{ + }}$, 1016 эВ1/2 см–2 с–1 | ||||
|---|---|---|---|---|---|---|---|---|
| 4 мторр | 12 мторр | 4 мторр | 12 мторр | 4 мторр | 12 мторр | 4 мторр | 12 мторр | |
| 200 | 5.9 | 4.2 | 0.07 | 0.05 | 440 | 458 | 0.9 | 0.7 |
| 400 | 5.8 | 4.1 | 0.18 | 0.13 | 412 | 433 | 2.4 | 1.7 |
| 600 | 5.7 | 4.1 | 0.58 | 0.41 | 356 | 369 | 7.1 | 5.0 |
1) Температура электронов (${{T}_{e}}$) слабо чувствительна к варьированию вкладываемой мощности при $p$ = const, но заметно снижается с ростом давления газа в условиях $W$ = const. Последний эффект определенно связан с увеличением потерь энергии электронами за счет увеличения частоты их столкновений с частицами газа.
2) Плотность ионного тока (${{J}_{ + }}$) следует изменению кинетики образования и концентрации ионов в газовой фазе. Так, увеличение $W$ при $p$ = const сопровождается ростом скорости ионизации нейтральныx частиц и величины ${{n}_{ + }}$(2.2 × 109–1.8 × × 1010 см–3 для $p$ = 4 мторр и 1.9 × 109–1.5 × 1010 см–3 для $p$ = 12 мтор при $W$ = 200–600 Вт) из-за аналогичного изменения концентрации электронов. Однозначная зависимость ${{n}_{e}} = f\left( W \right)$ устанавливается уравнением баланса вкладываемой мощности [4]. Напротив, рост давления газа в условиях $W$ = const подавляет ионизацию из-за снижения ${{T}_{e}}$ и констант скоростей ионизации$.$ Это приводит к уменьшению концентраций заряженных частиц.
3) Отрицательное смещение на нижнем электроде ($ - {{U}_{{dc}}}$) в условиях ${{W}_{{dc}}}$ = const является переменной величиной и зависит от плотности потока ионов. Обратный характер соответствующих зависимостей обусловлен частичной компенсацией наведенного отрицательного заряда в двойном электрическом слое на границе “плазма-поверхность” ионами, приходящими из газовой фазы. Малые изменения энергии ионов (474–389 эВ для $p$ = 4 мторр и 482–393 эВ для $p$ = 12 мторр при $W$ = 200–600 Вт) не нарушают корреляции между плотностью потока ионов и параметром $\sqrt {{{\varepsilon }_{i}}} {{{{\Gamma }}}_{ + }},$ характеризующим интенсивность ионной бомбардировки обрабатываемой поверхности. Величина последнего ожидаемо возрастает с ростом вкладываемой мощности, но снижается при увеличении давления газа.
В целом, можно заключить, что характер зависимостей электрофизических параметров плазмы от варьируемых условий процесса соответствует аналогичным зависимостям, наблюдаемым в условиях классического РИТ. Основной особенностью режима малой вкладываемой мощности являются низкие (на порядок величины и более) абсолютные значения концентраций заряженных частиц, которые отражаются как на характеристиках ионной компоненты плазмы (через концентрацию и плотность потока ионов), так и кинетике нейтральных частиц (через концентрацию электронов). Так, из рис. 2(а) можно видеть, что область $W$ < 500 Вт (0.02–0.05 Вт/см3) характеризуется доминированием стабильных молекулярных продуктов плазмохимических реакций – F2, CF2O, CO и CO2, что является нетипичной ситуацией для условий классического РИТ [23, 24, 31]. Высокие концентрации CF2O, CO и CO2 в данном случае обеспечиваются их эффективным образованием в реакциях R1: CFx + O → CFx– 1O + F, R2: CFxO + O/O(1D) → CO2 + xF и R3: CFx + CFO → → CO + CFx + 1 в сочетании с низкими скоростями диссоциации электронным ударом. Соответственно, высокая концентрация молекул фтора является следствием R4: CF2O + O(1D) → F2 + CO2 и гетерогенной рекомбинации R5: F + F → F2, которая преобладает над параллельными механизмами R6: F + O → FO и R7: F + CFx → CFx + 1. Причиной последнего эффекта являются низкие концентрации O и CFx из-за их быстрого расходования в реакциях R1–R3. Увеличение вкладываемой мощности при $p$ = const ожидаемо сопровождается ростом концентраций атомов и менее насыщенных радикалов, что обеспечивает аналогичные изменения плотностей потоков этих частиц (рис. 2(б)). Увеличение давления в условиях $W$ = const приводит к росту концентрации атомов фтора (из-за увеличения скоростей процессов R1, R2, R8: F2 + e → 2F + e и R9: CFxO + + e → CFx– 1O + F + e), но вызывает снижение концентраций CFx (из-за увеличения скорости их гибели в R1). Поэтому область высоких давлений отличается большими плотностями потоков атомов фтора, но меньшими – полимеробразующих радикалов (рис. 2(б)). Сочетание этих свойств приводит к тому, что увеличение давления при постоянной вкладываемой мощности снижает как скорость высаживания полимерной пленки (как это следует из сравнения величин ${{{{{{\Gamma }}}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{{\Gamma }}}_{{{\text{pol}}}}}} {{{{{\Gamma }}}_{{\text{F}}}}}}} \right. \kern-0em} {{{{{\Gamma }}}_{{\text{F}}}}}}$ по данным рис. 3(а)), так и ее толщину. Последний вывод иллюстрируется значительно более низкими значениями параметров ${{{{{{\Gamma }}}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{{\Gamma }}}_{{{\text{pol}}}}}} {\sqrt {{{\varepsilon }_{i}}} {{{{\Gamma }}}_{ + }}{{{{\Gamma }}}_{{\text{F}}}}}}} \right. \kern-0em} {\sqrt {{{\varepsilon }_{i}}} {{{{\Gamma }}}_{ + }}{{{{\Gamma }}}_{{\text{F}}}}}}$ и ${{{{{{\Gamma }}}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{{\Gamma }}}_{{{\text{pol}}}}}} {{{{{\Gamma }}}_{{\text{O}}}}{{{{\Gamma }}}_{{\text{F}}}}}}} \right. \kern-0em} {{{{{\Gamma }}}_{{\text{O}}}}{{{{\Gamma }}}_{{\text{F}}}}}}$ для $p$ = 12 мторр по сравнению с $p$ = = 4 мторр. Из рис. 3(а) можно видеть также, что увеличение $W$ при $p$ = const также сопровождается снижением толщины полимерной пленки, которое обеспечивается ростом скоростей ее деструкции по физическому и химическому механизмам. Это следует из резкого роста плотностей потока энергии ионов (табл. 1) и атомов кислорода (рис. 2(б)). Таким образом, увеличение как вкладываемой мощности, так и давления газа способствует подавлению поверхностной полимеризации и снижению пассивирующего эффекта на боковых стенках формируемого рельефа. Данный вывод согласуется с экспериментально наблюдаемым эффектом увеличения анизотропии травления в режиме малой вкладываемой мощности [17, 18].
Рис. 2.
Концентрации (а) и потоки (б) нейтральных частиц в плазме смеси 50% CF4 + 50% O2. Сплошные и пунктирные кривые относятся к $p$ = 4 и 12 мторр соответственно. Кривые с индексом “pol”: б) отражают суммарный поток полимеробразующих радикалов CFx (x = 1, 2).
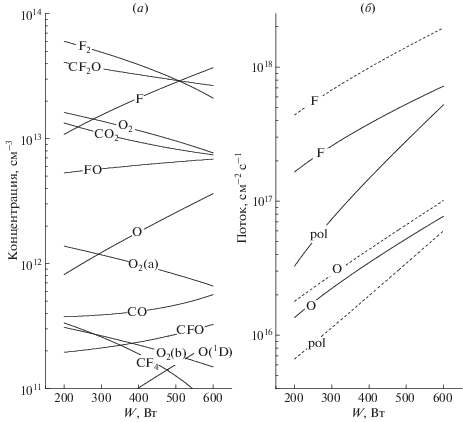
Рис. 3.
Отношения потоков (а) и эффективные вероятности взаимодействия атомов фтора с Si и SiO2 (б) в плазме смеси 50% CF4 + 50% O2. Сплошные и пунктирные кривые относятся к $p$ = 4 и 12 мторр соответственно. Обозначения кривых: а) “pol/F” – ${{{{{{\Gamma }}}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{{\Gamma }}}_{{{\text{pol}}}}}} {{{{{\Gamma }}}_{{\text{F}}}}}}} \right. \kern-0em} {{{{{\Gamma }}}_{{\text{F}}}}}};$ “pol/F+” – ${{{{{{\Gamma }}}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{{\Gamma }}}_{{{\text{pol}}}}}} {\sqrt {{{\varepsilon }_{i}}} {{{{\Gamma }}}_{ + }}{{{{\Gamma }}}_{{\text{F}}}}}}} \right. \kern-0em} {\sqrt {{{\varepsilon }_{i}}} {{{{\Gamma }}}_{ + }}{{{{\Gamma }}}_{{\text{F}}}}}};$ “pol/FO” – ${{{{{{\Gamma }}}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{{\Gamma }}}_{{{\text{pol}}}}}} {{{{{\Gamma }}}_{{\text{O}}}}{{{{\Gamma }}}_{{\text{F}}}}}}} \right. \kern-0em} {{{{{\Gamma }}}_{{\text{O}}}}{{{{\Gamma }}}_{{\text{F}}}}}}.$
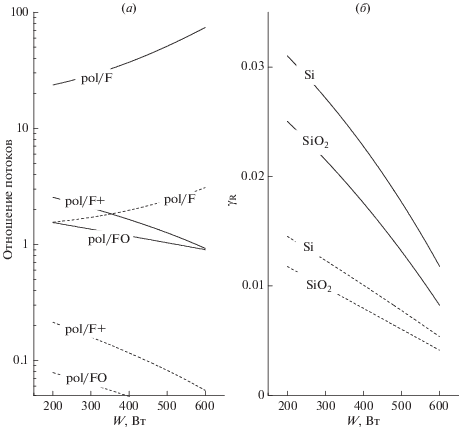
На рис. 3(б) представлены эффективные вероятности взаимодействия атомов фтора с Si и SiO2, определенные как ${{\gamma }_{R}} = {{{{R}_{{{\text{chem}}}}}} \mathord{\left/ {\vphantom {{{{R}_{{{\text{chem}}}}}} {{{{{\Gamma }}}_{{\text{F}}}}}}} \right. \kern-0em} {{{{{\Gamma }}}_{{\text{F}}}}}}.$ Можно видеть, что величина ${{\gamma }_{R}}$ для обоих материалов монотонно снижается при увеличении как вкладываемой мощности (например, 0.029–0.013 для Si и 0.024–0.009 для SiO2 при $p$ = 4 мторр и $W$ = 200–600 Вт), так и давления газа (например, 0.023–0.011 для Si и 0.018–0.008 для SiO2 при $W$ = 400 Вт и $p$ = = 4–12 мторр). Сравнение данных рис. 3 позволяет заключить, что спадающий характер зависимости ${{\gamma }_{R}} = f\left( W \right)$ не согласуется с изменениями как толщины фторуглеродной полимерной пленки, так и параметра $\sqrt {{{\varepsilon }_{i}}} {{{{\Gamma }}}_{ + }},$ характеризующего скорости процессов ионно-стимулированной десорбции продуктов взаимодействия и дефторирования полимера (генерации дополнительных атомов фтора в слое полимера при прохождении через него ионов). По нашему мнению, отмеченный ингибирующий эффект может быть связан с гетерогенными реакциями атомов кислорода, результатом которых является уменьшение числа центров адсорбции для атомов фтора. Наиболее вероятными механизмами здесь являются: 1) окисление фторидов кремния в менее летучие соединения вида SiOxFy, что обуславливает снижение усредненной (эффективной) летучести продуктов травления; 2) конкурентная адсорбция атомов кислорода, приводящая к образованию (в случае Si) или восстановлению (в случае SiO2) связей Si–O с поверхностными атомами кремния. Естественно предположить, что скорости обоих процессов следуют изменению плотности потока атомов кислорода, который увеличивается с ростом $W$ при $p$ = const и $p$ при $W$ = const (рис. 2(б)). Отметим, что хотя первый из предложенных механизмов не имеет прямого экспериментального подтверждения для фторуглеродной плазмы, аналогичные процессы протекают при травлении Si и SiO2 атомами хлора и брома в присутствии кислорода [32, 33]. Возможность второго механизма убедительно показана в работе [34] при травлении SiO2в плазме смеси C4F8 + O2 + Ar. Тем не менее, однозначная интерпретация взаимосвязей вкладываемой мощности и давления газа с эффективной вероятностью взаимодействия требует исследований химического состава обработанных поверхностей.
4. ЗАКЛЮЧЕНИЕ
Проведено исследование кинетики и механизмов реактивно-ионного травления Si и SiO2 в плазме смеси 50% CF4 + 50% O2 в условиях малой (0.02–0.06 Вт/см3) вкладываемой мощности. При совместном использовании методов диагностики и моделирования плазмы получены данные по влиянию вкладываемой мощности и давления газа на стационарные электрофизические параметры и состав газовой фазы. Установлено, что особенностями состава газовой фазы в исследованном диапазоне условий являются: а) низкая концентрация электронов; б) доминирование стабильных молекулярных продуктов плазмохимических реакций – F2, CF2O, CO и CO2; и в) эффективное подавление радикалов CFx объемными и гетерогенными процессами вида CFx + + O → CFx – 1O + F и CFx + O → CFxO. Установлено, что наблюдаемые в эксперименте скорости травления Si и SiO2 обеспечиваются ионно-стимулированной химической реакцией, протекающей в режиме лимитирования потоком атомов фтора. Показано, что снижение эффективной вероятности взаимодействия в системах Si/SiO2 + F с ростом вкладываемой мощности и давления газа не объясняется изменением толщины фторуглеродной полимерной пленки, но в обоих случаях отражает увеличение плотности потока атомов кислорода. Соответственно, основными механизмами данного явления могут служить окисление поверхности и/или снижение летучести продуктов взаимодействия за счет образования соединений вида SiOxFy.
Публикация выполнена в рамках государственного задания ФГУ ФНЦ НИИСИ РАН (проведение фундаментальных научных исследований) по теме № 0580-2021-0006 “Фундаментальные и прикладные исследования в области литографических пределов полупроводниковых технологий и физико-химических процессов травления 3D нанометровых диэлекрических структур для развития критических технологий производства ЭКБ. Исследование и построение моделей и конструкций элементов микроэлектроники в расширенном диапазоне температур (от –60 до +300°С)”.
Список литературы
Wolf S., Tauber R.N. Silicon Processing for the VLSI Era. V.1. Process Technology. Lattice Press. N.Y. 2000. 416 p.
Advanced plasma processing technology. John Wiley & Sons Inc. N.Y. 2008. 479 p.
Nojiri K. Dry etching technology for semiconductors. Springer International Publishing. Tokyo. 2015. 116 p.
Lieberman M.A., Lichtenberg A.J. Principles of plasma discharges and materials processing. N.Y., John Wiley & Sons Inc. 2005. 757 p.
Jansen H., Gardeniers H., Boer M. de, Elwenspoek M., Fluitman J. A survey on the reactive ion etching of silicon in microtechnology // J. Micromech. Microeng. 1995. V. 6. P. 14–28.
Mogab C.J., Adams A.C., Flamm D.L. Plasma Etching of Si and SiO2 – The Effect of Oxygen Additions to CF4 Plasmas // J. Appl. Phys. 1978. V. 49. P. 3796–3803.
Standaert T.E.F.M., Hedlund C., Joseph E.A., Oehrlein G.S. Role of fluorocarbon film formation in the etching of silicon, silicon dioxide, silicon nitride, and amorphous hydrogenated silicon carbide // J. Vac. Sci. Technol. A. 2004. V. 22. P. 53–60.
Matsui M., Tatsumi T., Sekine M. Relationship of etch reaction and reactive species flux in C4F8–Ar–O2 plasma for SiO2 selective etching over Si and Si3N4 // J. Vac. Sci. Technol. A. 2001. V. 19. P. 2089–2096.
Schaepkens M., Standaert T.E.F.M., Rueger N.R., Sebel P.G.M., Oehrlein G.S., Cook J.M. Study of the SiO2-to-Si3N4 etch selectivity mechanism in inductively coupled fluorocarbon plasmas and a comparison with the SiO2-to-Si mechanism // J. Vac. Sci. Technol. A. 1999. V. 17. P. 26–37.
Kastenmeier B.E.E., Matsuo P.J., Oehrlein G.S. Highly selective etching of silicon nitride over silicon and silicon dioxide // J. Vac. Sci. Technol. A. 1999. V. 17. P. 3179–3184.
Lele C., Liang Z., Linda X., Dongxia L., Hui C., Tod P. Role of CF2 in the etching of SiO2, Si3N4 and Si in fluorocarbon plasma // J. Semicond. 2009. V. 30. P. 033005(1–10).
Lee J., Efremov A., Yeom G.Y., Lim N., Kwon K.-H. Application of Si and SiO2 etching mechanisms in CF4/C4F8/Ar inductively coupled plasmas for nanoscale patterns // J. Nanosci. Nanotechnol. 2015. V. 15. P. 8340–8347.
Enomoto T., Denda M., Yasuoka A., Nakata H. Loading effect and temperature dependence of etch rate in CF4 plasma // Jpn. J. Appl. Phys. 1979. V. 18. P. 155–167.
Handbookof Chemistry and Physics. CRCPress. N.Y. 1998.
Li X., Ling L., Hua X., Fukasawa M., Oehrlein G.S., Barela M., Anderson H.M. Effects of Ar and O2 additives on SiO2 etching in C4F8-based plasmas // J. Vac. Sci. Technol. A. 2003. V. 21. P. 284–293.
Lim N., Efremov A., Kwon K.-H. Gas-phase chemistry and etching mechanism of SiNx thin films in C4F8 + Ar inductively coupled plasma // Thin Solid Films. 2019. V. 685. P. 97–107.
Veselov D.S., Bakun A.D., Voronov Yu.A. Reactive ion etching of silicon using low-power plasma etcher // J. Phys.: Conf. Series. 2016. V. 748. P. 012017(1–4).
Ashraf M., Sundararajan S.V., Grenc G. Low-power, low-pressure reactive-ion etching process for silicon etching with vertical and smooth walls for mechanobiology application // J. Micro/Nanolith. MEMSMOEMS. 2017. V. 16. P. 034501(1–8).
Osipov A.A., Aleksandrov S.E., Solov’ev Yu.V., Uvarov A.A., Osipov A.A. Etching of SiC in low power inductively-coupled plasma // Russian Microelectronics.2018. V. 47. № 6. P. 427–433.
Johnson E.O., Malter L. A floating double probe method for measurements in gas discharges // Phys. Rev. 1950. V. 80. P. 58–70.
Shun’ko E.V. Langmuir probe in theory and practice. Universal Publishers. Boca Raton. 2008. 245 p.
Efremov A., Lee J., Kim J. On the control of plasma parameters and active species kinetics in CF4 + O2 + Ar gas mixture by CF4/O2 and O2/Ar mixing ratios // Plasma Chem. Plasma Process. 2017. V. 37. P. 1445–1462.
Kimura T., Noto M. Experimental study and global model of inductively coupled CF4/O2 discharges // J. Appl. Phys. 2006. V. 100. P. 063303(1–9).
Chun I., Efremov A., Yeom G.Y., Kwon K.-H. A comparative study of CF4/O2/Ar and C4F8/O2/Ar plasmas for dry etching applications // Thin Solid Films. 2015. V. 579. P. 136–148.
Stoffels W.W., Stoffels E., Tachibana K. Polymerization of fluorocarbons in reactive ion etching plasmas // J. Vac. Sci. Tech. A. 1998. V. 16. P. 87–95.
Gray D.C., Tepermeister I., Sawin H.H. Phenomenological modeling of ion enhanced surface kinetics in fluorine-based plasma etching // J. Vac. Sci. Technol. B. 1993. V. 11. P. 1243–1257.
Lee J., Kwon K.-H., Efremov A. On the relationships between plasma chemistry, etching kinetics and etching residues in CF4 + C4F8 + Ar and CF4 + CH2F2 + Arplasmas with various CF4/C4F8 and CF4/CH2F2 mixing ratios // Vacuum 148. 2018. P. 214–223.
Son J., Efremov A., Chun I., Yeom G.Y., Kwon K.-H. On the LPCVD-Formed SiO2 Etching Mechanism in CF4/Ar/O2 Inductively Coupled Plasmas: Effects of Gas Mixing Ratios and Gas Pressure // Plasma Chem. Plasma Proc. 2014. V. 34. P. 239–257.
Seah M.P., Nunney T.S. Sputtering yields of compounds using argon ions // J. Phys. D: Appl. Phys. 2010. V. 43 P. 253001(1–24).
Chapman B. Glow Discharge Processes: Sputtering and Plasma Etching. John Wiley & Sons Inc. N.Y. 1980. 432 p.
Zhang Y.-R., Tinck S., Schepper P.D., Wang Y.-N., Bogaerts A. Modeling and experimental investigation of the plasma uniformity in CF4/O2 capacitively coupled plasmas, operating in single frequency and dual frequency regime // J. Vac. Sci. Technol. A. 2015. V. 33. P. 021310(1–15).
Cunge G., Kogelschatz M., Joubert O., Sadeghi N. Plasma-wall interactions during silicon etching processes in high-density HBr/Cl2/O2 plasmas // Plasma Sources Sci. Technol. 2005. V. 14. № 2. P. S42–S51.
Tinck S., Boullart W., Bogaerts A. Modeling Cl2/O2/Ar inductively coupled plasmas used for silicon etching: effects of SiO2 chamber wall coating // Plasma Sources Sci. Technol. 2011. V. 20. P. 045012(1–10).
Krastev V., Reid I., Galassi C., Hughes G., McGlynn E. Influenceof C4F8/Ar/O2 plasmaetchingon SiO2 surfacechemistry // J. Mater. Sci. Mater. Electron. 2005. V. 16. P. 541–547.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника


