Микроэлектроника, 2020, T. 49, № 6, стр. 403-408
Кинетика и механизмы реактивно-ионного травления Si и SiO2 в плазме смеси HBr + O2
А. М. Ефремов a, b, *, В. Б. Бетелин b, K.-H. Kwon c
a ФГБОУ ВО “Ивановский государственный химико-технологический университет”
153000 г. Иваново, Шереметевский просп., 7, Россия
b ФГУ ФНЦ НИИСИ Российской АН
117218 г. Москва, Нахимовский просп., 36, корп. 1, Россия
c Korea University
339-700 Sejong, South Korea
* E-mail: amefremov@mail.ru
Поступила в редакцию 19.03.2020
После доработки 16.05.2020
Принята к публикации 20.05.2020
Аннотация
Проведено исследование кинетики и механизмов реактивно-ионного травления Si и SiO2 в плазме смеси HBr + O2 переменного начального состава в условиях индукционного ВЧ (13.56 МГц) разряда. При экспериментальном и теоретическом (модельном) исследовании параметров плазмы выявлены ключевые плазмохимические процессы, формирующие стационарный состав газовой фазы, а также определены плотности потоков активных частиц на обрабатываемую поверхность. Установлено, что увеличение доли O2 в плазмообразующей смеси сопровождается снижением кинетических коэффициентов (эффективной вероятности взаимодействия и выхода травления), характеризующих гетерогенные стадии процесса травления. Предположено, что основным механизмом данного эффекта является окисление продуктов травления SiBrx в низко летучие соединения вида SiBrxOy.
1. ВВЕДЕНИЕ
Плазма галогенсодержащих газов нашла широкое применений в технологии интегральной микро- и нано-электроники для размерного структурирования поверхностей полупроводниковых пластин и функциональных слоев различной природы [1, 2]. В частности, в процессах реактивно-ионного травления кремния и его соединений (SiO2, Si3N4 и SiC) традиционно используется плазма фторуглеродных газов, при этом широкая номенклатура соответствующих соединений (CF4, C2F6, C4F8, CHF3 и др.) позволяет эффективно оптимизировать выходные характеристики процесса – скорость травления, анизотропию и селективность по отношению к над или под- лежащему слою. В то же время, существенным недостатком фторной химии является возможность спонтанной реакции атомов фтора с кремнием, что обеспечивает близкий к изотропному профиль травления данного материала [2, 3]. Таким образом, поиск альтернативных плазмообразующих сред для реактивно-ионного травления Si и SiO2 является актуальной задачей, направленной на оптимизацию как технологических, так и функциональных параметров конечных изделий. Неотъемлемой частью такой задачи, на наш взгляд, является изучение взаимосвязей между внешними параметрами плазмы, ее составом и кинетикой процессов на обрабатываемой поверхности. Это обеспечивает комплексное понимание механизма взаимодействия в системе плазма-поверхность и, как следствие, возможность целенаправленного воздействия на его результат.
В настоящее время существует ряд работ, посвященных исследованием закономерностей травления Si и SiO2 в плазме на основе HBr [5–12]. Результаты этих работ могут быть обобщены в виде следующих положений:
− Спонтанная химическая реакция в системе SiO2 + Br термодинамически невозможна [4, 5] из-за того, что энергия связи Si–O (∼800 кДж/моль [6]) значительно выше по сравнению с Si–Br (∼358 кДж/моль [6]). Как следствие, травление SiO2 в плазме HBr следует механизму ионно-стимулированной химической реакции, в которой ионная бомбардировка обеспечивает образование (через разрыв Si–O связей) и очистку (через распыление труднолетучих ненасыщенных продуктов взаимодействия SiBrx) центров адсорбции для атомов брома [3, 4, 8, 9].
− Вероятность спонтанной химической реакции в системе Si + Br значительно ниже по сравнению с Si + F [5, 7]. Причина такого различия, скорее всего, связана с большим размером атома брома, затрудняющим его внедрение в решетку кремния. Поэтому стационарный режим травления Siв плазме HBr также обеспечивается ионно-стимулированной химической реакцией [10–12] и отличается значительно более низкими абсолютными значениями скоростей процесса по сравнению с фторной химией.
− Добавка кислорода к HBr снижает скорость травления кремния, но способствует увеличению анизотропии процесса [10, 12]. Экспериментально показано, что последний эффект достигается за счет маскирования боковых стенок формируемого рельефа соединениями вида SiBrxOy, которые обладают еще меньшей летучестью (и, следовательно, меньшими коэффициентами распыления) по сравнению с SiBrx [10].
К сожалению, практически все упомянутые исследования выполнены в рамках чисто экспериментального подхода и не анализируют гетерогенные эффекты на обрабатываемой поверхности во взаимосвязи с параметрами газовой фазы. В такой ситуации, большинство заключений о механизмах травления, в том числе – Si и SiO2 в плазме смеси HBr + O2, носят декларативный характер и требуют независимой верификации. В наших предшествующих работах [13, 14] был проведен комплексный (с использованием методов диагностики и моделирования плазмы) анализ кинетики и механизмов травления Si и SiO2 в плазме трехкомпонентной смеси HBr + Cl2 + O2, отличающейся одновременным действием двух типов химически активных частиц – атомов брома и хлора. Основная идея данной работы заключается в использовании аналогичного подхода для исследования бинарной системы HBr + O2 с целью определить, как начальный состав смеси влияет на а) кинетику травления Si и SiO2; б) электрофизические параметры и состав плазмы; и в) механизмы гетерогенного взаимодействия.
2. МЕТОДИЧЕСКАЯ ЧАСТЬ
2.1. Оборудование и техника эксперимента
Эксперименты по травлению и исследованию параметров плазмы проводились в реакторе планарного типа [15] с рабочей камерой из нержавеющей стали при возбуждении индукционного ВЧ (13.56 МГц) разряда. В качестве неизменных внешних параметров плазмы выступали общий расход плазмообразующего газа q = 40 станд. см3/мин, его давление p = 6 мтор (∼0.8 Па) и вкладываемая мощность W = 700 Вт. Варьируемым параметром являлся начальный состав плазмообразующей смеси HBr + O2, задаваемый соотношением индивидуальных расходов ее компонентов. В частности, изменение ${{q}_{{{{{\text{O}}}_{2}}}}}$ в диапазоне 0–30 станд. см3/мин обеспечивало долю кислорода в подаваемом газе ${{y}_{{{{{\text{O}}}_{2}}}}}$ = 0–75%. Данные по электрофизическим параметрам плазмы получали с помощью двойного зонда Лангмюра (DLP2000, PlasmartInc., Korea). Обработка измеренных вольт-амперных характеристик (ВАХ) с использованием известных положений теории двойного зонда [16] обеспечивала данные по температуре электронов (Te) и плотности ионного тока (J+). Отрицательное смещение на нижнем электроде (–Udc), задаваемое независимым ВЧ (12.56 МГц) генератором с постоянной мощностью смещения Wdc = 200 Вт, измерялось высоковольтным зондом (AMN-CTR, Youngsin Eng, Korea). Эксперименты показали, что варьирование Wdc в диапазоне 0–200 Вт не оказывает принципиального влияния на вид зондовых ВАХ и, следовательно, на параметры газовой фазы разряда.
В качестве объектов травления использовались фрагменты не окисленных и окисленных пластин Si(100) со средней площадью ∼4 см2. Обрабатываемые образцы располагались в центральной части нижнего электрода, температура которого поддерживалась на постоянном уровне с помощью системы водяного охлаждения. Скорость травления определяли как R = Δh/τ, где τ – время травления и Δh – высота ступеньки травления на границе маскированной и немаскированной областей поверхности образца. В качестве маскирующего покрытия использовался фоторезист AZ1512. Величина Δh измерялась профилометром (Alpha-step D-500, KLA-Tencor, USA). Предварительные эксперименты показали, что даже пятикратное увеличение площади обрабатываемой поверхности не сопровождается существенными (в пределах погрешности эксперимента) изменениями зондовых ВАХ и не вызывает снижения скоростей травления Si и SiO2. Таким образом, в исследованном диапазоне условий процесс травления обоих материалов отвечает кинетическому режиму ионно-стимулированной химической реакции и характеризуется пренебрежимо малым влиянием продуктов травления на параметры газовой фазы.
2.2. Моделирование плазмы
Для получения данных по кинетике плазмохимических процессов и составу плазмы HBr + O2 использовалась 0-мерная кинетическая модель, подробно описанная в наших работах [13, 14]. Базовая кинетическая схема (набор реакций и соответствующих констант скоростей) для смеси HBr + O2 была позаимствована из работы [14]. Адекватность данной кинетической схемы при описании кинетики плазмохимических процессов в индивидуальных газах-компонентах смеси подтверждена ранее в работах [17, 18] удовлетворительным согласием результатов диагностики и моделирования плазмы. В качестве входных параметров модели выступали данные зондовой диагностики плазмы по Te и J+. Выходные параметрами модели служили усредненными по объему реактора скорости процессов образования и гибели частиц, их концентрации и плотности потоков на поверхность, контактирующую с плазмой.
3. РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
На рис. 1 приведены данные по влиянию начального состава смеси HBr + O2 на кинетику травления Si и SiO2. Из рис. 1а можно видеть, что скорости травления обоих материалов монотонно снижаются с ростом ${{y}_{{{{{\text{O}}}_{2}}}}}$ (27.8–2.7 нм/мин, или в ∼10 раз для Si и 8.0–2.1 нм/мин, или в ∼4 раза для SiO2 при 0–75% O2), при этом характер снижения более резок в области ${{y}_{{{{{\text{O}}}_{2}}}}}$ < 30%. Такое поведение скоростей травления соответствует снижению селективности травления Si/SiO2 в диапазоне 3.1–1.2 при 0–75% O2. Таким образом, добавка кислорода к HBr способствует “выравниванию” скоростей травления исследованных материалов, что качественно аналогично эффектам, достигаемым в плазме фторуглеродных газов с высокой полимеризационной способностью [1–3, 19]. Из анализа работ [19–21] можно заключить, что изменение скорости реактивно-ионного процесса при варьировании соотношения компонентов в плазмообразующей смеси может быть вызвано действием нескольких факторов, а именно: а) изменениями концентраций и плотностей потоков активных частиц (атомов брома, положительных ионов) из-за изменений кинетики плазмохимических процессов в газовой фазе; и б) влиянием начального состава смеси на кинетические характеристики (вероятности, константы скоростей) гетерогенного взаимодействия. Поэтому корректная интерпретация данных рис. 1а требует информации по электрофизическим параметрам и составу плазмы.
Рис. 1.
Кинетика травления Si и SiO2 в плазме смеси HBr + O2 переменного начального состава: а – скорость травления R (сплошные линии) и селективность травления ${{{{R}_{{{\text{Si}}}}}} \mathord{\left/ {\vphantom {{{{R}_{{{\text{Si}}}}}} {{{R}_{{{\text{Si}}{{{\text{O}}}_{{\text{2}}}}}}}}}} \right. \kern-0em} {{{R}_{{{\text{Si}}{{{\text{O}}}_{{\text{2}}}}}}}}}$ (пунктир); б – кинетические коэффициенты γR = R/ΓBr и YR = R/$\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{\Gamma }_{ + }},$ характеризующие химическую и физическую составляющие гетерогенного взаимодействия.
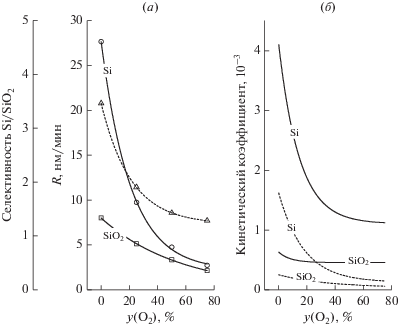
При диагностике плазмы было найдено, что разбавление HBr кислородом в условиях p = const вызывает незначительный рост температуры электронов (3.2–3.3 эВ при 0–75% O2), но более заметное увеличение плотности ионного тока (1.7–2.5 мА/см2, или в ∼1.5 раза при 0–75% O2) (рис. 2а). Первый эффект является следствием того, что снижение потерь энергии электронов на возбуждение и ионизацию основных молекулярных компонентов плазмы чистого HBr практически полностью компенсируется аналогичными процессами для O2. В то же время, последние характеризуются меньшими потерями энергии на колебательное возбуждение по сравнению с HBr и H2 [22], что и обеспечивает слабый рост Te. Характер изменения J+ с ростом ${{y}_{{{{{\text{O}}}_{2}}}}}$ ожидаемо следует поведениюсуммарной концентрации положительных ионов (7.5 × 1010–9.0 × 1010 см–3 при 0–75% O2, см. рис. 2б), при этом формальное различие форм соответствующих кривых обеспечивается уменьшением эффективной массы ионов. Расчеты показали, что основной причиной роста n+ является снижение частоты объемной гибели положительных ионов в процессах вида A+ + B– → A + B (из-за n– = 3.5 × 1010–1.9 × 1010 см–3 при 0–75% O2) на фоне малых изменений суммарной частоты ионизации. Последнее обеспечивается близкими значениями констант скоростей ионизации Br (∼1.9 × 10–10 см3/с при Te = 3 эВ) и O2 (∼1.3 × × 10–10 см3/с при Te = 3 эВ), как доминирующих нейтральных компонентов газовой фазы (рис. 3а). Из рис. 2б можно видеть также, что концентрация электронов в условиях n–/ne < 1 следует изменению n+. Фактически, это является следствием снижения эффективного коэффициента диффузии и частоты диффузионной гибели электронов при уменьшении электроотрицательности плазмы (n–/ne = 0.85–0.26 при 0–75% O2) из-за соответствующих различий констант скоростей процессов R1: HBr + e → H + Br– (k1 ∼ 3.0 × 10–10 см3/с при Te = 3 эВ) и R2: O2 + e → O + O– (k2 ∼ 2.1 × 10–11 см3/с при Te = 3 эВ). Отметим также, что суммарный эффект от снижения отрицательного смещения на нижнем электроде (–Udc = 296–280 В при 0–75% O2, см. рис. 2в) и эффективной массы ионов с избытком компенсируется увеличением плотности потока ионов (рис. 3б). В результате, с ростом ${{y}_{{{{{\text{O}}}_{2}}}}}$ имеет место увеличение параметра $\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{\Gamma }_{ + }}$ (рис. 2в), характеризующего интенсивность ионной бомбардировки обрабатываемой поверхности [13, 14].
Рис. 2.
Электрофизические параметры плазмы смеси HBr + O2 переменного начального состава: 1 – температура электронов; 2 – плотность ионного тока; 3 – суммарная концентрация положительных ионов; 4 – концентрация электронов; 5 – отрицательное смещение на подложкодержателе; 6 – параметр $\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{\Gamma }_{ + }},$ характеризующий плотность потока энергии ионов.

Рис. 3.
Концентрации (а) и плотности потоков (б) активных частиц в плазме смеси HBr + O2 переменного начального состава.
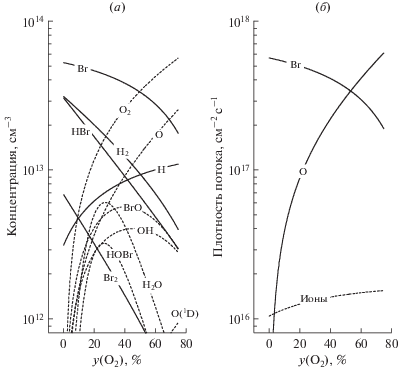
При анализе кинетики нейтральных частиц было найдено, что в исследованном диапазоне условий плазма HBr сохраняет практически все особенности, отмеченные ранее в работах [17, 23, 24]. В частности, расчеты показали, что реакции R3: HBr + e → H + Br + e (k3 ∼ 1.6 × 10–9 см3/с при Te = = 3 эВ) и R4: Br2 + e → 2Br + e (k4 ∼ 1.2 × 10–8 см3/с при Te = 3 эВ) являются близкими по эффективности источниками атомов брома даже в условиях ${{n}_{{{\text{B}}{{{\text{r}}}_{2}}}}} < {{n}_{{{\text{HBr}}}}}.$ В то же время, низкая константа скорости R5: H2 + e → 2H + e (k5 ∼ 8.1 × 10–10 см3/с при Te = 3 эВ) в сочетании с быстрой гибелью атомов водорода в атомно-молекулярных процессах R6: HBr + H → H2 + Br (k6 ∼ 1.2 × 10–11 см3/с) and R7: Br2 + H → HBr + Br (k7 ∼ 1.2 × 10–10 см3/с) приводят к ${{n}_{{\text{H}}}} \ll {{n}_{{{\text{Br}}}}}.$ Кроме этого, выполнение условия ${{k}_{4}} \gg {{k}_{6}}$ и эффективное образование молекул H2 по R6 обеспечивают ${{n}_{{{{{\text{H}}}_{2}}}}} > {{n}_{{{\text{B}}{{{\text{r}}}_{2}}}}}$ (рис. 3а). Разбавление HBr кислородом сопровождается как ростом частот диссоциации молекулярных частиц в процессах электронного удара (например, k3ne = 72–137 с–1 и k4ne = 512–938 с–1 при 0–75% O2), так и появлением механизмов ступенчатой диссоциации с участием O и OH. Наиболее эффективными среди последних являются R8: HBr + OH → H2O + Br (k8 ∼ 8.0 × 10–12 см3/с), R9: Br2 + O → BrO + Br (k9 ∼ 1.3 × 10–11 см3/с) и R10: Br2 + OH → HOBr + Br (k10 ∼ 3.1 × 10–11 см3/с). Это приводит к быстрому снижению концентраций HBr и Br2 (в ∼4 раза и ∼7 раз, соответственно, при 0–50% O2), но к значительно более медленному изменению величины nBr (в ∼1.5 раза при 0–50% O2). Аналогичное поведение характерно и для плотности потока атомов брома на обрабатываемую поверхность ΓBr (рис. 3б).
Сравнение данных рис. 1, 2 и 3 позволяет заключить, что монотонное снижение скоростей травления Si и SiO2 с ростом ${{y}_{{{{{\text{O}}}_{2}}}}}$ противоречит поведению $\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{\Gamma }_{ + }},$ но качественно согласуется с характером изменения ΓBr. Такая ситуация характерна для ионно-стимулированной химической реакции в режиме лимитирования потоком нейтральных частиц [19, 20], скорость которой может быть представлена как γRΓBr, где γR – эффективная вероятность взаимодействия. Из рис. 1б. можно видеть, что увеличение доли кислорода в смеси HBr + O2 вызывает монотонное снижение γR для Si и SiO2, при этом характер снижения существенно замедляется в области ${{y}_{{{{{\text{O}}}_{2}}}}}$ > 30–40%. Принимая во внимание, что последний эффект коррелирует с насыщением на соответствующей зависимости плотности потока энергии ионов (рис. 2в), механизмы травления Si и SiO2 в исследованном диапазоне условий могут быть интерпретированы следующим образом. В бескислородной плазме, травление обеспечивается химической реакцией кремния с атомами брома с последующей ионно-стимулированной десорбцией продуктов взаимодействия:
(R11)
${\text{Si}}\left( {{\text{s}}{\text{.}}} \right) + x{\text{Br}} \to {\text{SiB}}{{{\text{r}}}_{x}}\left( {{\text{s}}.} \right),$(R12)
${\text{SiB}}{{{\text{r}}}_{x}}\left( {{\text{s}}.} \right) \to {\text{SiB}}{{{\text{r}}}_{x}},$(R13)
${\text{SiB}}{{{\text{r}}}_{x}}\left( {{\text{s}}{\text{.}}} \right) + y{\text{O}} \to {\text{SiB}}{{{\text{r}}}_{x}}{{{\text{O}}}_{y}}\left( {{\text{s}}.} \right),$(R14)
${\text{SiB}}{{{\text{r}}}_{x}}{{{\text{O}}}_{y}}\left( {{\text{s}}.} \right) \to {\text{SiB}}{{{\text{r}}}_{x}}{{{\text{O}}}_{y}}.$Очевидно, что увеличение ${{y}_{{{{{\text{O}}}_{2}}}}}$ вызывает аналогичное изменение скорости R13 и, таким образом, способствует увеличению доли SiBrxOy среди продуктов взаимодействия. Низкая летучесть SiBrxOy по сравнению с SiBrx обуславливает снижение эффективного выхода ионно-стимулированной десорбции продуктов, которое в области ${{y}_{{{{{\text{O}}}_{2}}}}}$ < 30–40% с избытком компенсирует рост интенсивности ионной бомбардировки поверхности. Это вызывает снижение γR из-за уменьшения доли свободной поверхности, доступной для адсорбции атомов Br. Можно предположить, что в области ${{y}_{{{{{\text{O}}}_{2}}}}}$ > > 30–40% доминирующим продуктом взаимодействия становится SiBrxOy, при этом эффект R13 на состав продуктов взаимодействия и эффективный выход их ионно-стимулированной десорбции существенно ослабевает. В таких условиях, малые изменения γR согласуются с соответствующей зависимостью параметра $\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{\Gamma }_{ + }}.$ Отметим также, что в области ${{y}_{{{{{\text{O}}}_{2}}}}}$ < 30–40% величина ${{y}_{{R,{\text{Si}}{{{\text{O}}}_{2}}}}}$ характеризуется более слабой зависимостью от содержания кислорода в смеси по сравнению γR, Si (рис. 1б). По нашему мнению, это связано с тем, что травление SiO2 инициируется ионным процессом
(R15)
${\text{Si}}{{{\text{O}}}_{x}}\left( {{\text{s}}{\text{.}}} \right) \to {\text{Si}}\left( {{\text{s}}{\text{.}}} \right) + x{\text{O}},$4. ЗАКЛЮЧЕНИЕ
Исследовано влияние начального состава смеси HBr + O2 на кинетику и механизмы реактивно-ионного травления Si и SiO2 в условиях индукционного ВЧ (13.56 МГц) разряда. Найдено, что увеличение доли кислорода в смеси сопровождается монотонным снижением как скоростей травления, так и кинетических коэффициентов характеризующих химическую (эффективная вероятность взаимодействия) и физическую (эффективный выход травления) составляющие гетерогенного взаимодействия. Последнее обеспечивается монотонным, но более медленным по сравнению со скоростью травления, снижение плотности потока атомов брома, а также увеличением плотности потока энергии ионов. Наличие удовлетворительной корреляции изменений гетерогенных кинетических коэффициентов с плотностью потока атомов кислорода позволяет предположить, что имеет место окисление продуктов травления в низколетучие соединения вида SiBrxOy. Это сопровождается снижением как коэффициента ионно-стимулированной десорбции (распыления) продуктов травления, так и доли свободной поверхности, доступной для адсорбции атомов брома.
Публикация выполнена в рамках государственного задания ФГУ ФНЦ НИИСИ РАН (проведение фундаментальных научных исследований) по теме № 0065-2019-0006 “Фундаментальные и прикладные исследования в области субволновой голографической литографии, физико-химических процессов травления 3D нанометровых диэлектрических структур для развития критических технологий производства ЭКБ”.
Список литературы
Advanced plasma processing technology. John Wiley & Sons Inc. N.Y. 2008. 479 p.
Wolf S., Tauber R.N. Silicon Processing for the VLSI Era. Volume 1. Process Technology. Lattice Press. N.Y. 2000. 416 p.
Nojiri K. Dry etching technology for semiconductors. Springer International Publishing. Tokyo. 2015. 116 p.
Coburn J.W. Plasma etching and reactive ion etching (AVS Monograph Series). IOP Publishing. N.Y. 1982. 83 p.
Vitale S.A., Chae H., Sawin H.H. Silicon etching yields in F2, Cl2, Br2, and HBr high density plasmas // J. Vac. Sci. Technol. A. 2001. V. 19(5). P. 2197–2206.
Handbook of chemistry and physics. CRC Press. N.Y. 2003–2004. 2475 p.
Belen R.J, Gomez S., Kiehlbauch M., Aydil E.S. Feature scale model of Si etching in SF6/O2/HBr plasma and comparison with experiments // J. Vacuum. Sci. Technol. A. 2006. V. 24(2). P. 350–361.
Tokashiki K., Ikawa E., Hashimoto T., Kikkawa T., Teraoka Y., Nishiyama I. Influence of Halogen Plasma Atmosphere on SiO2 Etching Characteristics // Jpn. J. Appl. Phys. 1991. V. 30(11b). P. 3174–3177.
Donnelly V.M., Klemens F.P., Sorsch T.W., Timp G.L., Baumann F.H. Oxidation of Si beneath thin SiO2 layers during exposure to HBr/O2 plasmas, investigated by vacuum transfer x-ray photoelectron spectroscopy // Appl. Phys. Lett. 1999. V. 74(9). P. 1260–1262.
Cunge G., Kogelschatz M., Joubert O., Sadeghi N. Plasma-wall interactions during silicon etching processes in high-density HBr/Cl2/O2 plasmas // Plasma Sources Sci. Technol. 2005. V. 14(2). P. S42–S52.
Yeom G.Y., Ono Y., Yamaguchi T. Polysilicon Etchback Plasma Process Using HBr, Cl2, and SF6 Gas-Mixtures for Deep-Trench Isolation // J. Electrochem. Soc. 1992. V. 139(2). P. 575–579.
Kim D.K., Kim Y.K., Lee H. A study of the role of HBr and oxygen on the etch selectivity and the post-etch profile in a polysilicon/oxide etch using HBr/O2 based high density plasma for advanced DRAMs // Mat. Sci. Semicon. Proc. 2007. V. 10(1). P. 41–48.
Lee B.J., Efremov A., Kim J., Kim C., Kwon K.-H. Peculiarities of Si and SiO2 etching kinetics in HBr + Cl2 + O2 inductively coupled plasma // Plasma Chem. Plasma Proc. 2019. V. 39(1). P. 339–358.
Lee B.J., Efremov A., Kwon K.-H. Plasma parameters, gas-phase chemistry and Si/SiO2 etching mechanisms in HBr + Cl2 + O2 gas mixture: Effect of HBr/O2 mixing ratio // Vacuum. 2019. V. 163. P. 110–118.
Son J., Efremov A., Yun S.J., Yeom G.Y., Kwon K.-H. Etching Characteristics and Mechanism of SiNx Films for Nano-Devices in CH2F2/O2/Ar Inductively Coupled Plasma: Effect of O2 Mixing Ratio // J. Nanosci. Nanotechnol. 2014. V. 14. P. 9534–9540.
Shun’ko E.V. Langmuir probe in theory and practice. Universal Publishers. Boca Raton. 2008. 245 p.
Kwon K.-H., Efremov A., Kim M., Min N.K., Jeong J., Kim K. A Model-Based Analysis of Plasma Parameters and Composition in HBr/X (X = Ar, He, N2) Inductively Coupled Plasmas // J. Electrochem. Soc. 2010. V. 157(5). P. H574–H579.
Hsu C.C., Nierode M.A., Coburn J.W., Graves D.B. Comparison of model and experiment for Ar, Ar/O2 and Ar/O2/Cl2 inductively coupled plasmas // J. Phys. D: Appl. Phys. 2006. V. 39(15). P. 3272–3284.
Lieberman M.A., Lichtenberg A.J. Principles of plasma discharges and materials processing. John Wiley & Sons Inc. N.Y. 2005. 730 p.
Jin W.D., Vitale S.A., Sawin H.H. Plasma-surface kinetics and simulation of feature profile evolution in Cl2 + HBr etching of polysilicon // J. Vac. Sci. Technol. A. 2002. V. 20(6). P. 2106–2114.
Gray D.C., Tepermeister I., Sawin H.H. Phenomenological modeling of ion-enhanced surface kinetics in fluorine-based plasma-etching // J. Vac. Sci. Technol. B. 1993. V. 11(4). P. 1243–1257.
Chistophorou L.G., Olthoff J.K. Fundamental electron interactions with plasma processing gases. Springer Science + Business Media. N.Y. 2004. 780 p.
Efremov A., Kim Y., Lee H.W., Kwon K.-H. A Comparative Study of HBr-Ar and HBr-Cl2 Plasma Chemistries for Dry Etch Applications // Plasma Chem. Plasma Proc. 2011. V. 31(2). P. 259–271.
Efremov A., Lee J., Kwon K.-H. A comparative study of CF4, Cl2 and HBr + Ar inductively coupled plasmas for dry etching applications // Thin Solid Films. 2017. V. 629. P. 39–48.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника


