Микроэлектроника, 2019, T. 48, № 3, стр. 163-175
Модель на языке Verilog-A многоуровневого биполярного мемристора с учетом девиаций параметров переключения
Г. С. Теплов 1, *, Е. С. Горнев 1, **
1 Научно-исследовательский институт молекулярной электроники (АО “НИИМЭ”)
124460 Зеленоград, 1-ый Западный проезд, 12, с. 1, Россия
* E-mail: gteplov@niime.ru
** E-mail: egornev@niime.ru
Поступила в редакцию 20.11.2018
После доработки 12.12.2018
Принята к публикации 16.12.2018
Аннотация
Представлено описание биполярного мемристора на языке Verilog-A. Предлагаемые модельные представления учитывают в процессе переключения мемристора между состояниями проводимости следующие девиации параметров: разбросы параметров проводимости в высокорезистивном и низкорезистивном состоянии, разбросы порогов переключения и разброс количества циклов переключения.
ВВЕДЕНИЕ
Развитие отрасли носимой электроники, примерами которой могут служить такие устройства, как смартфоны, умные браслеты, планшеты, умные очки, диктует все более жесткие требования к микросхемам и чипам по энергопотреблению и миниатюризации. Постоянное снижение минимальных топологических норм, выраженное в постоянной смене техпроцессов, не всегда может удовлетворить запросы разработчиков [1]. В свою очередь технология энергонезависимой памяти на основе FLASH имеет ограничения по масштабированию, что подтолкнуло к поиску новых элементов энергонезависимой памяти.
Множество новых компонентов элементной базы энергонезависимой памяти обладают схожими параметрами по масштабированию [2], так например, MRAM уже внедряется на техпроцессе 32 нм, для PCM идет отработка процесса 22 нм, Re RAM на основе мемристоров, также отрабатывается на техпроцессе 22 нм. Преимуществом, выгодно отличающим мемристор из всего множества новых компонентов, является его многоуровневость, т.е., возможность получения более двух устойчивых дискретных состояний на одном элементе [3].
Традиционный подход к описанию мемристора позволяет определить его как элемент энергонезависимой памяти, имеющий два контакта. Реализация функции памяти на элементе осуществляется, за счет изменения состояния проводимости между высокорезистивным (HRS) и низкорезистивным состояниями (LRS). Теоретическое описание компонента впервые предложил L. Chua в работе [4]. Первые экспериментальные образцы были получены в лаборатории HP десятилетие назад [5]. Проектирование на основе компактных моделей мемристоров уже активно применяется разработчиками [6–9]. Мемристоры могут быть использованы в качестве элемента синапса нейрона с нелинейными значениями весовых коэффициентов [10].
Внедрение мемристивных элементов памяти [11, 12] в технологические процессы производства сдерживается плохими показателями воспроизводимости устройств. Требования воспроизводимости, предъявляемые к мемристорам, могут быть снижены за счет более корректного учета дисперсии выходного сигнала в последующих схемах его обработки, что в свою очередь влечет необходимость учета девиации параметров при изменении проводимости. Существующие модели не учитывают ряд электрофизических особенностей мемристивных ячеек памяти, влияющих на состояния проводимости и наработку до отказа [13]. Построение модели биполярного мемристивного элемента на основе оксидов металлов, учитывающей экспериментально подтвержденные девиации параметров ячеек при переключении между состояниями проводимости, и является целью данной работы.
ОБЗОР СУЩЕСТВУЮЩИХ ПОДХОДОВ И МОДЕЛЕЙ
К одному из первых примеров построения компактной модели мемристоров относится работа [14], ориентированная на биполярный механизм переключения. Подходы к описанию мемристивных компонентов изначально базировались на модели линейного ионного дрейфа, представленной в работе [5]. Модель использовала линейную зависимость процесса миграции кислородных вакансий для объяснения изменения механизма проводимости:
Рис. 1.
Процесс изменения проводимости мемристора. T.E. – верхний электрод, B.E. – нижний электрод, A.L. – активный слой, красные точки – образующийся канал проводимости (филамент), SET – перевод мемристора в высокопроводящее состояние, RESET – перевод мемристора в низкопроводящее состояние. D – толщина активного слоя, w – длина филамента.
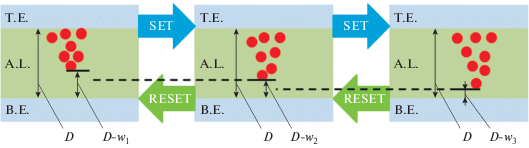
Модель линейного дрейфа на языке Verilog-A представлена в исследовании [15]. Предложенный метод использует декомпозицию функции изменения проводимости на “функцию окна” и линейную функцию изменения проводимостив зависимости от протекающего через мемристор тока. Функция окна ${{f}_{w}}\left( w \right)$ ограничивает выход за пределы значений ROFF и RON состояния проводимости мемристора.
Модель, учитывающая множественность состояний проводимости с учетом разброса параметров, представлена в работе [26]. К недостаткам подхода можно отнести необходимость отдельного, заранее определяемого моделью, описания каждого из уровней проводимости, что не позволяет определить влияние разброса параметров на количество получаемых промежуточных состояний. Исследование влияния разбросов параметров проводимости HRS и LRS выполнено тем же коллективом в работе [27]. Переключение между двумя состояниями проводимости HRS и LRS от цикла к циклу представлено без учета девиации порогов переключения, наблюдаемых экспериментально. Более подробные обзоры моделей и исследования их параметров можно найти в [28, 29].
МАТЕМАТИЧЕСКОЕ ОПИСАНИЕ КОМПАКТНОЙ МОДЕЛИ МЕМРИСТОРА
Предлагаемая авторами модель описания мемристора средствами САПР Cadence на языке высокого уровня Verilog-A основывается на модели линейного дрейфа кислородных вакансий с механизмом переключения по напряжению [14]. Выходной сигнал с мемристора представляется простой омической зависимостью:
(1)
$I\left( t \right) = {{V\left( t \right)} \mathord{\left/ {\vphantom {{V\left( t \right)} {R\left( {V\left( t \right),x,t} \right)}}} \right. \kern-0em} {R\left( {V\left( t \right),x,t} \right)}},$Изменение проводимости имеет следующую связь с предыдущим состоянием:
(2)
$R\left( {V\left( t \right),x,t + 1} \right) = R\left( {V\left( t \right),x,t} \right) - x\left( {V\left( t \right),t + 1} \right).$(3)
$\frac{{dx}}{{dt}} = a{{f}_{w}}\left( x \right)\left\{ {\begin{array}{*{20}{c}} {\mathop \smallint \limits_0^{{{t}_{S}}} \left( {V\left( t \right) - {{V}_{{thS}}}} \right)dt,V\left( t \right) > {{V}_{{thS}}}} \\ {\mathop \smallint \limits_0^{{{t}_{{RS}}}} \left( {V\left( t \right) - {{V}_{{thRS}}}} \right)dt,V\left( t \right) < {{V}_{{thRS}}}} \\ {0,{{V}_{{thRS}}} < V\left( t \right) < {{V}_{{thS}}}} \end{array}} \right.,$Для учета разбросов по количеству циклов переключения мемристора, была введена переменная ресурса переключения. Количество циклов переключения задается напрямую параметром модели, аналогично подходу, применяемому в работах [26, 27]. Отличие от подхода, применяемого в указанной работе, заключается в использовании не количества циклов напрямую, а применении переменного значения ресурса переключения мемристора определяемого по формуле:
где Cyc – значение ресурса на текущей итерации; NumCyc – количество циклов переключения. Изменение значений ресурса переключений описывается выражением:Указанные особенности описания мемристора позволяют добиться переменного количества циклов переключения при изменении состояния проводимости мемристора в зависимости от порогов переключений в высокорезистивное и низкорезистивное состояния, а также, в зависимости от разбросов параметров низкорезистивного и высокорезистивного состояний при переключении.
ОПИСАНИЕ НА ЯЗЫКЕ VERILOG-A И ВЕРИФИКАЦИЯ МОДЕЛИ
Алгоритм моделирования изменения состояний проводимости мемристора включает следующие основные блоки: блок первого шага моделирования, блок ветвления для абсолютных значений напряжений превышающих абсолютные значения порогов переключений, блок обработки сигнала ниже порога стирания (RESET), блок обработки сигнала выше порога записи (SET) и блок работы мемристора в режиме считывания. Листинг кода мемристивного компонента представлен в приложении. Схема работы алгоритма представлена на рис. 2.
Блок первого шага моделирования включает операторы присвоения начальных значений переменным, используемым в процессе моделирования. Cyc – переменная ресурса переключения. RRon, RRoff – текущие значения с учетом разброса LRS и HRS соответственно. RVon, RVoff – значения порогов переключения с учетом разброса. Блок ветвления использует составные логические условия для переключения между режимами SET, RESET и считывания. Условия ветвления включают конъюнкцию следующих условий: значение ресурса переключения больше нуля, абсолютное значение напряжения превышает абсолютное значение одного из порогов и текущее значение сопротивления лежит в диапазонах текущих с учетом разброса значений HRS и LRS. Блок работы мемристора в режиме считывания включаетперезадание значений переменных порогов переключения, значений HRS и LRS в задаваемых моделью в программируемых диапазонах. Для вычисления текущего значения сопротивления при переключениях в HRS и LRS используются функции dFx и dFrx соответственно. Изменение значения переменной ресурса переключения выполняется также специализированными функциями dFC и dFrC.
Верификация модели биполярного мемристора на языке Verilog-A выполнялась в среде САПР Cadence. Схема моделирования представлена на рис. 3. Идеальный гистерезис ВАХ мемристора может быть получен уменьшением разброса параметров порогов переключения и снижением разбросов HRS и LRS. Данные моделирования идеальной ВАХ гистерезиса представлены на рис. 4. Девиации параметров мемристора при переключении между LRS и HRS представлены на рис. 5 и рис. 6 соответственно. Применение переменной ресурса переключения позволяет моделировать различные типы отказов мемристоров. Первый тип – отказ в LRS состоянии (рис. 7), второй – отказ в HRS (рис. 8). Получение множественности состояний проводимости на мемристоре достигается либо ограничением импульсов по току, либо ограничением импульсов по напряжению [31 ] . В рамках данной работы проводилось определение, для предлагаемого Verilog-A описания мемристора, наиболее выгодной стратегии переключения при ограничении импульсов по напряжению и длительности. График получаемых промежуточных состояний проводимости мемристора представлен на рис. 9. Влияние амплитуды импульса напряжений на скорость переключения рис. 10.
Рис. 4.
Идеальная ВАХ биполярного мемристора. Vset = 0.5 В; ∆Vset = ±0.01 В, Vreset = –0.5 В; ∆Vreset = ±0.01 В, Ron = 1 kОм; ∆Ron = ±1 Ом, Roff = 20 k Ом; ∆Roff = ±1 Ом.

Рис. 5.
Девиация параметра LRS. Выходной ток – синяя линия. Подаваемое на вход напряжение – черная линия.

ЗАКЛЮЧЕНИЕ
Нами была предложена компактная модель описания биполярного мемристора на языке Verilog-A. Модельные представления позволяют учитывать в дисперсии выходного сигнала следующие девиации параметров: разбросы параметров напряжения порогов переключения между состояниями проводимости мемристора, разбросы LRS и HRS состояний, отказы мемристора в различных состояниях проводимости. Введение переменной ресурса количества циклов переключения в модель позволяет получить разброс наработки до отказа для различных компонентов схемы. Предложенная модель для описания множественности состояний проводимости не требует отдельного описания каждого из состояний, что является ее существенным преимуществом. Из результатов моделирования можно сделать следующие выводы:
• Для снижения дисперсии выходного сигнала мемристора наиболее перспективным является снижение разбросов состояний LRS.
• Снижение параметров разбросов порогов переключения мемристивных структур позволит получить большее количество состояний проводимости.
• Оптимальным подходом к получению множественности состояний проводимости является метод переключения базирующийся на переключении короткими (не более 15 нс) малоамплитудными (не более 0.15 В выше порога переключения) импульсами напряжения.
Предложенная нами компактная модель может применятся при разработке схем на основе биполярных мемристоров в качестве библиотечного элемента САПР и может быть модифицирована с учетом конкретных параметров имплементируемых на производстве элементов.
Список литературы
Красников Г.Я., Орлов О.М. Отличительные особенности и проблемы КМОП-технологии при уменьшении проектной нормы до уровня 0.18 мкм и меньше // Российские нанотехнологии. 2008. Т. 3. № 7–8. С. 124–128.
Лукичев В.Ф., Шиколенко Ю.Л. Современная элементная база запоминающих устройств // Нано- и микросистемная техника 2015. № 11(184). С. 40–53.
Алексеева Л.Г., Иванов А.С., Лучинин В.В. Новая электронная компонентная база. Мемристор // Нано- и микросистемная техника. 2016. Т. 18. № 5. С. 297–308.
Chua L. Memristor – the missing circuit element // IEEE Transactions on circuit theory. 1971. V. 18. № 5. P. 507–519.
Strukov D.B. et al. The missing memristor found // Nature. 2008. V. 453. № 7191. P. 80.
Маевский О.В., Писарев А.Д., Бусыгин А.Н. и др. Логический коммутатор и запоминающее устройство на основе мемристивных ячеек для электрической принципиальной схемы нейропроцессора // Вестник Тюменского государственного университета. Физико математическое моделирование. Нефть, газ, энергетика. 2016. Т. 2. № 4. С. 100–111.
Lupo N. et al. An Approximated Verilog-A Model for Memristive Devices // Circuits and Systems (ISCAS), 2018 IEEE International Symposium on. IEEE. 2018. P. 1–5.
Yang Y. et al. Verilog-A based effective complementary resistive switch model for simulations and analysis // IEEE Embedded Systems Letters. 2014. V. 6. № 1. P. 12–15.
Wang X., Xu B., Chen L. Efficient memristor model implementation for simulation and application // IEEE Transactions on Computer-Aided Design of Integrated Circuits and Systems. 2017. V. 36. № 7. P. 1226–1230.
Горнев Е.С., Теплов Г.С. Математическая модель конечного автомата абстрактного нейрона и сетей на его основе//Нано- и микросистемная техника. Т. 20. № 7. 2018. С. 434–442
Батурин А.С., Булах К.В., Григал И.П., Горнев Е.С. и др. Эффект резистивного переключения в оксидных пленках HfxAl1–xOy с переменным составом, выращенных методом атомно-слоевого осаждения // Нано- и микросистемная техника. 2013. № 6. С. 13–18.
Чуприк А.А., Батурин А.С., Горнев Е.С. Прототип мемристорной ячейки на основе МДМ структур с использованием диэлектрической пленки HfxAl1–xOy с переменным составом // Журнал Радиоэлектроники. 2013. № 6. С. 10.
Орлов О.М., Маркеев А.М., Зенкевич А.В. и др. Исследование особенностей элементов энергонезависимой памяти FRAM и ReRAM, полученных с использованием метода атомно-слоевого осаждения // Электронная техника. Серия 3. Микроэлектроника. 2015. Т. 4. № 1(160). С. 62–68.
Benderli S., Wey T.A. On SPICE macromodeling of TiO2 memristors // Electronics letters. 2009. V. 45. № 7. P. 377–379.
Emara A.A., Aboudina M.M., Fahmy H.A.H. Corrected and accurate Verilog-A for linear dopant drift model of memristors // Circuits and Systems (MWSCAS). 2014 IEEE 57th International Midwest Symposium on. IEEE. 2014. P. 499–502.
Biolek Z., Biolek D., Biolkova V. SPICE Model of Memristor with Nonlinear Dopant Drift // Radioengineering. 2009. V. 18. № 2.
Joglekar Y.N., Wolf S.J. The elusive memristor: propeties of basic electrical circuits // European J. Physics. 2009. V. 30. № 4. P. 661.
Prodromakis T. et al. A versatile memristor model with nonlinear dopant kinetics // IEEE transactions on electronic devices. 2011. V. 58. № 9. P. 3099–3105.
Kvatinsky S. et al. Models of memristors for SPICE simulations // Electrical & Electronics Engineers in Israel (IEEEI), 2012 IEEE 27th Convention of. IEEE. 2012. P. 1–5.
Pickett M.D. et al. Switching dynamics in titanium dioxide memristive devices // J. Applied Physics. 2009. V. 106. № 7. P. 074508.
Kvatinsky S. et al. TEAM: Threshold adaptive memristor model // IEEE Transactions on Circuits and Systems I: Regular Papers. 2013. V. 60. № 1. P. 211–221.
Yakopcic C. et al. A memristor device model // IEEE Electron Device Letters. 2011. V. 32. № 10. P. 1436–1438.
Zeng G. et al. PolynominalMetamodel integrated Verilog-AMS for memristor-based mixed-signal system design // Circuits and Systems (MWSCAS), 2013 IEEE 56th International Midwest Symposium on. IEEE. 2013. P. 916–919.
Corinto F., Ascoli A. A boundary condition-based approach to the modeling of memristor nanostructures // IEEE Transactiion on Circuits and Systems I: Regular Papers. 2012. V. 59. № 11. P. 2713–2726.
Kvatinsky S. et al. VTEAM: A general model for voltage-controlled memristors // IEEE Transactions on Circuits and Systems II: Express Briefs. 2015. V. 62. № 8. P. 786–790.
Garcia-Redondo F. et al. SPICE compact modeling of bipolar/unipolar memristor switching governed by electrical thresholds // IEEE Transactions on Circuits and System I: Regular Papers. 2016. V. 63. № 8. P. 1255–1264.
Garcia-Redondo F., Lôpez-Vallejo M., Barrio C.L. Advanced integration of variability and degradation in RRAM SPICE compact models // Synthesis, Modeling, Analysis and Simulation Methods and Applications to Circuit Design (SMACD), 2017 14th International Conference on IEEE. 2017. P. 1–4.
Hajri B. et al. Oxide-based RRAM models for circuit designers: A comparative analysis // Design & Technology of Integrated Systems In Nanoscale Era (DTIS), 2017 12th International Conference on. IEEE. 2017. P. 1–6.
Panda D., Sahu P.P., Tseng T.Y. A collective study on modeling and simulation of resistive random access memory // Nanoscale research letters. 2018. V. 13. № 1. P. 8.
Фетисова А.И., Киртаев Р.В., Матвеев Ю.А. и др. Наноразмерные электронные синапсы на основе HFO2 в геометрии кросс-баров // 58 научная конференция МФТИ, 23–28 ноября. Тезисы. 2015.
Bai Y. et al. Study of multi-level characteristics for 3D vertical resistive switching memory // Scientific Reports. 2014. V. 4. P. 5780.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника