Химия высоких энергий, 2023, T. 57, № 2, стр. 144-148
Влияние состава смеси на электрофизические параметры и спектры излучения плазмы тетрафторметана и трифторметана с азотом
С. А. Пивоваренок a, *, Д. Б. Мурин a, А. Ю. Граждян a
a Ивановский государственный химико-технологический университет
153000 Иваново, просп. Шереметевский, 7, Россия
* E-mail: sap@isuct.ru
Поступила в редакцию 14.09.2022
После доработки 08.11.2022
Принята к публикации 10.11.2022
- EDN: NGWHZG
- DOI: 10.31857/S0023119323020080
Аннотация
Проведен анализ влияния состава смеси на электрофизические параметры и спектры излучения плазмы смесей тетрафторметана и трифторметана с азотом в условиях тлеющего разряда постоянного тока. Установлено, что приведенная напряженность электрического поля нелинейно изменяется с увеличением доли второго газа в обеих смесях. Показано, что при доле азота 0.2 в смеси CF4/N2 приведенная интенсивность излучения атомарного фтора проходит через максимум, а в смеси CHF3/N2 наблюдается монотонное изменение данной зависимости. Приведенные интенсивности излучения радикалов CF2 монотонно уменьшаются с ростом доли азота в обеих смесях.
ВВЕДЕНИЕ
Основными задачами современной микро- и наноэлектроники являются повышение степени интеграции и информационной емкости интегральных микросхем с одновременным уменьшением стоимости бита информации.
Для изготовления структурных элементов интегральных микросхем использовались процессы жидкостного травления, которые в свою очередь достаточно хорошо изучены и отработаны. Однако со временем данные процессы перестали удовлетворять технологическим нормам производства элементов, поэтому для достижения необходимых требований в технологии стали применяться процессы «сухого» травления и очистки поверхности (металлов, полупроводников), с помощью которых можно добиться большей селективности и анизотропии процесса по сравнению со многими жидкостными травителями [1, 2]. Наибольший интерес в технологии представляют двух- или трехкомпонентные газовые смеси, которые сочетают основной плазмообразующий газ с функциональной добавкой (в качестве добавки может выступать инертный или молекулярный газ). В таких системах исходный состав смеси можно считать добавочным инструментом регулирования характеристик плазмы и концентраций активных частиц в ней [3–8].
В данной работе объектами исследования являются тетрафторметан (CF4) и трифторметан (CHF3), которые инертны в химическом отношении, невзрывоопасны при контакте с открытым пламенем. Эти газы используются в качестве плазмообразующих сред для размерного структурирования кремния и его соединений [9, 10]. Скорость, анизотропия и селективность процесса травления существенно будут зависеть от соотношения числа атомов фтора к числу атомов углерода (F/C) в исходной молекуле. Таким образом, используя плазму тетрафторметана, можно достичь высоких скоростей процесса травления при этом процесс полимеризации будет менее выраженным по сравнению с плазмой трифторметана [10, 11]. Однако по селективности процесса травления плазма трифторметана будет преобладать над плазмой тетрафторметана (например, в системе SiO2/Si) [12, 13].
Целью данной работы являлось исследование влияния состава смеси на электрофизические параметры и эмиссионные спектры плазмы тлеющего разряда постоянного тока в смесях CF4/N2 и CHF3/N2.
МЕТОДИЧЕСКАЯ ЧАСТЬ
Эксперименты проводились в плазмохимической установке с цилиндрическим (радиус r = 1.4 см, длина зоны разряда l = 36 см) реактором проточного типа, изготовленного из молибденового стекла С-49.
Тетрафторметан, трифторметан и азот набирались из баллонов с маркой “чистый” (МРТУ 51-77-66) с содержанием основного газа не менее 99.985%. Набор газов осуществлялся в предварительно откачанные хлорвиниловые емкости. Газовые смеси готовились непосредственно в самой вакуумной системе методом объемного смешения компонентов. Начальный состав плазмообразующей смеси задавался изменением парциальных давлений компонентов в рамках постоянного общего давления.
По спектрам излучения (наличию/отсутствию полос излучения OH и CO) осуществлялся контроль примесей в основном газе. Во всех случаях режимы набора газов оптимизировались таким образом, чтобы интенсивности излучения полос указанных примесей отсутствовали или были минимальными.
В качестве внешних (задаваемых) параметров разряда выступали ток разряда (i = 15–35 мА), давление газа (p = 40–200 Па) и расход газа (q = = 2 см3/с при нормальных условиях).
Для определения температуры нейтральных частиц (T) был использован расчетный метод, основанный на решении уравнения теплового баланса разрядной трубки в условиях естественного охлаждения, с использованием измеренных значений температуры наружной стенки разрядной трубки (Tw) [14]. Напряженность электрического поля (E) измерялась зондовым методом [15]. Кроме этого, была внедрена система очистки зондов, позволяющая бороться с полимеризационными явлениями.
Запись спектров излучения плазмы осуществлялась с помощью оптоволоконных спектрометров AvaSpec-2048-2 и AvaSpec-3648 с фотоэлектрической системой регистрации сигнала и накоплением данных на ЭВМ. Рабочий диапазон длин волн составлял 200–1000 нм. Отбор излучения для анализа проводился через кварцевое окно в торцевой части реактора. При расшифровке спектров излучения использовались справочники [16, 17].
РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
Исследуя любую плазменную систему важно установить закономерности, чтобы с помощью них можно было прогнозировать влияние внешних параметров разряда (ток, давление и расход газа) на концентрации всех типов активных частиц и их потоки на поверхность, ограничивающую объем зоны разряда. Стационарный массовый состав газовой фазы разряда формируется совокупностью объемных и гетерогенных процессов образования и гибели частиц (нейтральных и заряженных). Основным параметром физической кинетики неравновесной низкотемпературной газоразрядной плазмы является величина E/N (приведенная напряженность электрического поля). Параметр E/N характеризует электрофизические свойства разряда, а также коэффициенты скоростей различных процессов с участием электронов, а изменение температуры газа связано с равновесными процессами между тяжелыми частицами. Рассмотрим электрофизические параметры плазмы смесей CF4/N2 и CHF3/N2.
Эксперименты показали, что температура газа, в каждой из исследуемой смеси, практически не изменяется с увеличением доли азота в смеси и лишь при содержании азота более 80% начинает монотонно уменьшаться до значений, соответствующих плазме азота (в диапазоне 0 – 100% N2 в смеси CF4/N2 при i = 25 мА с 354 до 315 К в 1.12 раза; а в смеси CHF3/N2 при i = 25 мА с 366 до 315 К в 1.16 раза). Возможным объяснением поведения полученных зависимостей может являться изменение эффективного коэффициента теплопроводности газа в смеси (например, в диапазоне 0–100% N2 в смеси CF4/N2 при i = 25 мА с 17.5 до 26.1 мВт/(м ⋅ К), а в смеси CHF3/N2 при i = 25 мА с 17.1 до 26.1 мВт/(м ⋅ К)).
Если к тетрафторметану или трифторметану добавлять другие газы, то в результате можно ожидать изменений как свойств плазмы на основе такой плазмообразующей смеси, так и ее электрофизических параметров. На рис. 1 показана зависимость приведенной напряженности электрического поля в плазме смесей тетрафторметана или трифторметана с азотом переменного состава. При разбавлении CF4 или CHF3 азотом величина E/N с увеличением доли второго компонента в смеси снижается незначительно вплоть до 50% разбавления (~ в 1.1 раза для обеих смесей при p = = 100 Па, i = 25 мА), что не согласуется с эффектом концентрационного разбавления. Предположительно, это может быть связано с менее резким снижением эффективности гибели электронов в процессах диссоциативного прилипания как к молекулам тетрафторметана или трифторметана, так и к их фрагментам при добавлении азота, поэтому при увеличении доли второго газа в смесях для поддержания стационарной плазмы при одинаковом токе разряда требуются значения E/N близкие к значениям, характерным для плазмы чистых тетрафторметана или трифторметана. Аналогичным образом выглядят и зависимости удельной мощности, вкладываемой в разряд, для поддержания заявленных в работе токов (рис. 2).
Рис. 1.
Приведенная напряженность электрического поля в смесях переменного состава (p = 100 Па, i = = 25 мА): 1 – в плазме CF4/N2; 2 – в плазме CHF3/N2.
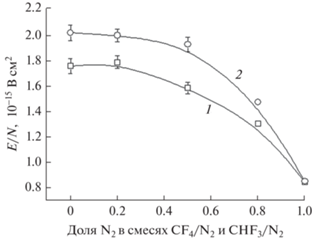
Рис. 2.
Зависимость удельной мощности, вкладываемой в разряд, от доли второго газа в исходной смеси (p = 100 Па, i = 25 мА): 1 – в плазме CF4/N2; 2 – в плазме CHF3/N2.
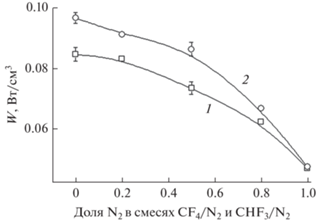
Также можно отметить, что по сравнению с плазмой чистого тетрафторметана величина приведенной напряженности электрического поля в плазме чистого трифторметана немного выше, что может быть связано (при условии соизмеримых значений сечений процесса) с более эффективной гибелью электронов в процессах диссоциативного прилипания к молекулам трифторметана [18, 19]:
(1)
${\text{CH}}{{{\text{F}}}_{{\text{3}}}}{\text{ + e}} \to {\text{ CH}}{{{\text{F}}}_{{\text{2}}}}{\text{ + }}{{{\text{F}}}^{--}}\,\,\left( {{{\varepsilon }_{{{\text{th}}}}} = 0{\text{ эВ}}} \right);$(2)
${\text{C}}{{{\text{F}}}_{{\text{4}}}}{\text{ + e}} \to {\text{C}}{{{\text{F}}}_{{\text{3}}}}{\text{ + }}{{{\text{F}}}^{--}}~~\left( {{{\varepsilon }_{{{\text{th}}}}} = {\text{ }}4.3{\text{ эВ}}} \right),$где εth – пороговая энергия процесса.
Сюда можно добавить и процесс диссоциативного прилипания электронов к молекулам HF, учитывая, что они являются одними из доминирующих нейтральных частиц в плазме CHF3 [18]:
(3)
${\text{HF}} + {\text{e}} \to {\text{H}} + {{{\text{F}}}^{--}}\,\,\left( {{{\varepsilon }_{{{\text{th}}}}}\sim 2.5{\text{ эВ }}\left[ {20,{\text{ }}21} \right]} \right).$Успешное диагностирование процессов плазменного травления невозможно без использования простых и невозмущающих методов контроля состава плазмы. Относительную концентрацию частиц в плазме можно определить спектрально, отслеживая интенсивности излучения их возбужденных состояний [3, 4].
Спектр излучения плазмы CF4/N2 представлен атомарными и молекулярными компонентами. Так, в спектрах были обнаружены линии атомарного фтора в диапазоне от 620 до 880 нм (самые интенсивные 685.6 нм (εth = 14.50 эВ, $^{4}D_{{7/2}}^{^\circ }$ – 4Р5/2) и 703.7 нм (εth = 14.74 эВ, $^{2}Р_{{3/2}}^{^\circ }$ – 2Р3/2)). Излучение молекулярных компонентов представлено полосами CF в интервале от 200 до 230 нм (наиболее интенсивные 202.4 и 208.3 нм, B2Δ – X2Π), CF2 в интервале от 250 до 330 нм (наиболее интенсивные 255.0, 262.8 и 279.9 нм, A2Σ – X 2Π). Излучение молекул углерода представлено системами полос Свана (468.4, 471.5, 473.7, 512.9, 516.5, 547.0, 550.1, 554.0, 558.5, 563.5 нм, A3Πg – X '3Πu). Излучение азота представлено большим количеством интенсивных полос: 1 (B3Πg – ${{A}^{3}}\Sigma _{u}^{ + }$) и 2 (C3Πu – B3Πg) положительных систем азота (наиболее интенсивные 337.1, 357.6 нм и др.), менее интенсивными полосами 4 (${{D}^{3}}\Sigma _{u}^{ + }$ – B3Πg) и 5 (${{x}^{1}}\Sigma _{g}^{ - }$ – $a{\kern 1pt} '{{~}^{1}}\Sigma _{u}^{ - }$) положительной системы азота (244.8 и 258.6 нм).
В спектрах излучения CHF3/N2 кроме вышеупомянутых излучательных состояний были дополнительно зафиксированы линии атомарного водорода (самые интенсивные 486.1 и 656.2 нм) системы Бальмера и полосы H2 (519.6 нм) и альфа-системы Фулхера (603.1 и 612.1 нм, a3Σg – ${{a}^{3}}\Pi _{u}^{ - }$).
Для дальнейшего анализа были выбраны аналитические максимумы, которые представлены ниже:
– CF4/N2: F (703.7 нм), CF2 (262.8 нм);
– CHF3/N2: F (703.7 нм), CF2 (262.8 нм).
CF4 и CHF3 достаточно инертны в газовой фазе, однако в плазме распадаются с образованием большого количества новых частиц. Доминирующими радикалами и положительными ионами будут являться фторсодержащие частицы, так как связь C–H слабее, чем связь C–F [13]. Наибольшие концентрации (в условиях более низких давлений относительно наших экспериментов) в плазме CF4 имеют такие радикалы как CF3 и атомарный F [18], тогда как в плазме CHF3 – CF3, CF2 и HF [18].
Каналы образования частиц в плазме чистого тетрафторметана (εth – пороговая энергия процесса, k – константа скорости процесса) [18, 19, 22]:
(4)
${\text{C}}{{{\text{F}}}_{4}} + {\text{e}} \to {\text{C}}{{{\text{F}}}_{3}} + {\text{F}} + {\text{e}}\,\,~\left( {{{\varepsilon }_{{{\text{th}}}}} = 5.6{\kern 1pt} --{\kern 1pt} 12{\text{ эВ}}} \right);$(5)
${\text{C}}{{{\text{F}}}_{{\text{3}}}}{\text{ + e}} \to {\text{C}}{{{\text{F}}}_{{\text{2}}}}{\text{ + F + e}}\,\,~\left( {{{\varepsilon }_{{{\text{th}}}}} = 3.8{\kern 1pt} --{\kern 1pt} 10.4{\text{ эВ}}} \right);$(6)
${\text{C}}{{{\text{F}}}_{{\text{2}}}}{\text{ + e}} \to {\text{CF + F + e}}\,\,~\left( {{{\varepsilon }_{{{\text{th}}}}} = 5.4{\kern 1pt} --{\kern 1pt} 11.2{\text{ эВ}}} \right);$(7)
${\text{CF + e}} \to {\text{C + F + e}}\,\,({{\varepsilon }_{{{\text{th}}}}} = 5.6{\kern 1pt} --{\kern 1pt} 12{\text{ эВ}}).$Каналы образования частиц в плазме чистого трифторметана (εth – пороговая энергия процесса, k – константа скорости процесса) [13, 18, 19, 23]:
(8)
${\text{CH}}{{{\text{F}}}_{{\text{3}}}}{\text{ + e}} \to {\text{C}}{{{\text{F}}}_{{\text{3}}}}{\text{ + H + e}}~\,\,\left( {{{\varepsilon }_{{{\text{th}}}}} = 4.5{\kern 1pt} --{\kern 1pt} 12.2{\text{ эВ}}} \right);$(9)
${\text{CH}}{{{\text{F}}}_{{\text{3}}}}{\text{ + e}} \to {\text{CH}}{{{\text{F}}}_{{\text{2}}}}{\text{ + F + e}}\,\,\left( {{{\varepsilon }_{{{\text{th}}}}} = 6.9{\kern 1pt} --{\kern 1pt} 13{\text{ эВ}}} \right);$(10)
${\text{CH}}{{{\text{F}}}_{{\text{3}}}}{\text{ + e}} \to {\text{CF + H + 2F + e}}\,\,\left( {{{\varepsilon }_{{{\text{th}}}}} = 13.3{\text{ эВ}}} \right);$(11)
${\text{CH}}{{{\text{F}}}_{{\text{2}}}}{\text{ + e}} \to {\text{CHF + F + e}}\,\,\left( {{{\varepsilon }_{{{\text{th}}}}} = 4.8{\text{ эВ}}} \right);$(12)
${\text{CH}}{{{\text{F}}}_{{\text{2}}}}{\text{ + e}} \to {\text{C}}{{{\text{F}}}_{{\text{2}}}}{\text{ + H + e}}\,\,\left( {{{\varepsilon }_{{{\text{th}}}}} = 2.7{\text{ эВ}}} \right);$(13)
${\text{CHF + e}} \to {\text{CF + H + e}}\,\,\left( {{{\varepsilon }_{{{\text{th}}}}} = 3.3{\text{ эВ}}} \right);$(14)
${\text{C}}{{{\text{F}}}_{{\text{3}}}}{\text{ + e}} \to {\text{C}}{{{\text{F}}}_{{\text{2}}}}{\text{ + F + e}}\,\,\left( {{{\varepsilon }_{{{\text{th}}}}} = 3.8{\kern 1pt} --{\kern 1pt} 10.4{\text{ эВ}}} \right);$(15)
${\text{C}}{{{\text{F}}}_{{\text{3}}}}{\text{ + e}} \to {\text{CF + 2F + e}}\,\,\left( {{{\varepsilon }_{{{\text{th}}}}} = 9.2{\text{ эВ}}} \right);$(16)
${\text{C}}{{{\text{F}}}_{{\text{2}}}}{\text{ + e}} \to {\text{CF + F + e}}\,\,\left( {{{\varepsilon }_{{{\text{th}}}}} = 5.4{\kern 1pt} --{\kern 1pt} 11.2{\text{ эВ}}} \right);$(17)
${\text{CF + e}} \to {\text{C + F + e}}\,\,~\left( {{{\varepsilon }_{{{\text{th}}}}} = 5.6{\kern 1pt} --{\kern 1pt} 12{\text{ эВ}}} \right);$(18)
${\text{HF + e}} \to {\text{H + F + e}}\,\,\left( {{{\varepsilon }_{{{\text{th}}}}} = 5.45{\kern 1pt} --{\kern 1pt} 5.9{\text{ эВ}}} \right);$(19)
${\text{CH}}{{{\text{F}}}_{{\text{3}}}} + {\text{F}} \to {\text{C}}{{{\text{F}}}_{{\text{3}}}} + {\text{HF}}\,(k = 1.5 \times {{10}^{{--13}}}{\text{ }}{{{\text{с}}{{{\text{м}}}^{{\text{3}}}}} \mathord{\left/ {\vphantom {{{\text{с}}{{{\text{м}}}^{{\text{3}}}}} {\text{с}}}} \right. \kern-0em} {\text{с}}}{\text{);}}$(20)
${\text{CH}}{{{\text{F}}}_{{\text{2}}}}{\text{ + F}} \to {\text{C}}{{{\text{F}}}_{{\text{2}}}}{\text{ + HF}}\,\,(k = 5 \times {{10}^{{--11}}}{\text{ }}{{{\text{с}}{{{\text{м}}}^{{\text{3}}}}} \mathord{\left/ {\vphantom {{{\text{с}}{{{\text{м}}}^{{\text{3}}}}} {\text{с}}}} \right. \kern-0em} {\text{с}}});$(21)
${\text{CHF + F}} \to {\text{CF + HF}}\,\,{\text{(}}k = 5 \times {{10}^{{--11}}}{\text{ }}{{{\text{с}}{{{\text{м}}}^{{\text{3}}}}} \mathord{\left/ {\vphantom {{{\text{с}}{{{\text{м}}}^{{\text{3}}}}} {\text{с}}}} \right. \kern-0em} {\text{с}}}{\text{)}};$(22)
${\text{C}}{{{\text{F}}}_{{\text{3}}}}{\text{ + H}} \to {\text{C}}{{{\text{F}}}_{{\text{2}}}}{\text{ + HF}}\,\,(k = 8.9 \times {{10}^{{--11}}}{\text{ }}{{{\text{с}}{{{\text{м}}}^{{\text{3}}}}} \mathord{\left/ {\vphantom {{{\text{с}}{{{\text{м}}}^{{\text{3}}}}} {\text{с}}}} \right. \kern-0em} {\text{с}}}).$На рис. 3 приведены зависимости приведенных интенсивностей излучения атомов фтора от степени разбавления тетрафторметана или трифторметана азотом. Видно, что зависимость, соответствующая смеси тетрафторметана с азотом, имеет экстремальный характер, что не согласуется с эффектом концентрационного разбавления. Вследствие увеличения доли азота, следовало бы ожидать уменьшение приведенной интенсивности излучения атомов фтора пропорционально разбавлению. Однако при доле азота 0.2 наблюдается ее существенное увеличение (~ в 1.6 раза). Такой характер зависимости может быть связан с тем, что добавка азота оказывает влияние на электрофизические параметры плазмы. При снижении электроотрицательности плазмы будет происходить изменение режима диффузии электронов от свободного к амбиполярному, и в результате произойдет снижение как частоты прилипания, так и диффузионной гибели электронов, а также увеличится доля высокоэнергетичных электронов и их средняя энергия. В итоге с ростом средней энергии электронов увеличится эффективность ионизации нейтральной компоненты плазмы, и скорость образования электронов возрастет, что, в свою очередь, может привести к изменению скорости генерации основных химически активных частиц (атомов фтора) в объеме плазмы (процессы (4)–(7)) [24].
Рис. 3.
Влияние начального состава смеси на приведенную интенсивность излучения F (703.7 нм) (p = 100 Па, i = 25 мА): 1 – в плазме CF4/N2; 2 – в плазме CHF3/N2.
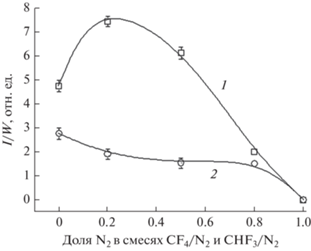
В системе CHF3/N2 наблюдается монотонное изменение приведенной интенсивности излучения атомов фтора с увеличением доли второго газа в смеси. Ход зависимости также не согласуется с эффектом концентрационного разбавления, так как приведенная интенсивность излучения атомов фтора практически не изменяется при доле азота 0.2–0.8. Здесь также происходит влияние азота на электрофизические параметры плазмы, вследствие чего будет происходить рост средней энергии и концентрации электронов, что приведет к увеличению скорости диссоциации молекул основного газа прямым электронным ударом (процессы (9)–(11), (14)–(18)). Однако в системе CHF3/N2 количество атомов фтора должно быть значительно меньше из-за их эффективной гибели в атомно-молекулярных реакциях (процессы (19)–(21)).
На рис. 4 приведены зависимости приведенных интенсивностей излучения радикалов CF2 от степени разбавления тетрафторметана или трифторметана азотом. Обе зависимости монотонно уменьшаются с ростом доли азота в смеси. Однако, количество радикалов CF2 в трифторметане значительно (~ в 3.6 раза) превышает их наличие в тетрафторметане, что может быть связано с различными каналами образования CF2 (процессы (12), (14), (20), (22)).
ЗАКЛЮЧЕНИЕ
Проведены измерения электрофизических параметров плазмы смесей CF4/N2 и CHF3/N2 в зависимости от внешних параметров разряда. Увеличение доли второго газа в смесях сопровождается немонотонным снижением величины приведенной напряженности электрического поля, которое может быть связано с менее резким снижением эффективности гибели электронов в процессах диссоциативного прилипания как к молекулам тетрафторметана или трифторметана, так и к их фрагментам.
Получены и проанализированы спектры излучения плазмы смесей CF4/N2 и CHF3/N2. Показано, что зависимость приведенной интенсивности излучения атомов фтора от доли азота в смеси CF4/N2 проходит через максимум (при доле N2 0.2 увеличивается ~ в 1.6 раза), а в смеси CHF3/N2 происходит монотонное ее изменение. Для обеих систем ход зависимостей не согласуется с эффектом концентрационного разбавления. Обе зависимости приведенных интенсивностей излучения радикалов CF2 от степени разбавления тетрафторметана или трифторметана монотонно уменьшаются с ростом доли азота в смеси.
Список литературы
Ситанов Д.В., Пивоваренок С.А. // Химия высоких энергий. 2017. Т. 51. № 4. С. 307.
Пивоваренок С.А., Дунаев А.В., Ефремов А.М. и др. // Нанотехника. 2011. № 1 (25). С. 69.
Мурин Д.Б., Ефремов А.М., Светцов В.И. и др. // Известия высших учебных заведений. Серия: Химия и химическая технология. 2013. Т. 56. № 8. С. 41.
Мурин Д.Б., Ефремов А.М., Светцов В.И. и др. // Известия высших учебных заведений. Серия: Химия и химическая технология. 2013. Т. 56. № 4. С. 29.
Пивоваренок С.А., Бакшина П.И. // Химия высоких энергий. 2021. Т. 55. № 3. С. 231.
Пивоваренок С.А., Дунаев А.В., Мурин Д.Б. // Микроэлектроника. 2016. Т. 45. № 5. С. 374.
Дунаев А.В., Мурин Д.Б., Пивоваренок С.А. // Физика и техника полупроводников. 2016. Т. 50. № 2. С. 167.
Pivovarenok S.A., Dunaev A.V., Murin D.B. et al. // High Temperature. 2011. V. 49. № 4. P. 491.
Advanced plasma processing technology. New York: John Wiley & Sons Inc. 2008. 479 p.
Nojiri K. Dry etching technology for semiconductors. Tokyo: Springer Internat. Publ. 2015. 116 p.
Lieberman M.A., Lichtenberg A.J. Principles of plasma discharges and materials processing. New York: John Wiley & Sons Inc. 2005. 730 p.
Gaboriau F., Cartry G., Peignon M-C. et al. // J. Vac. Sci. Technol. B. 2002. V. 20. P. 1514.
Пивоваренок С.А., Мурин Д.Б. // Химия высоких энергий. 2022. Т. 56. № 3. С. 223.
Рохлин Г.Н. Разрядные источники света. 2-е изд.; перераб. и доп. М.: Энергоатомиздат, 1991. 720 с.
Иванов Ю.А., Лебедев Ю.А., Полак Л.К. Методы контактной диагностики в неравновесной плазмохимии. М.: Наука. 1981. 143 с.
Pearse R.W.B., Gaydon A.G. The identification of molecular spectra. Ed. 4th. New York: John Wiley & Sons, Inc. 1976. 407 p.
Стриганов А.Р., Свентицкий Н.С. Таблицы спектральных линий нейтральных и ионизированных атомов. М.: Атомиздат., 1966. 899 с.
Proshina O., Rakhimova T.V., Zotovich A. et al. // Plasma Sources Sci. Technol. 2017. V. 26. P. 075005.
Sugawara H., Ishihara Y., Saito R. et al. // Proc. of 27th ICPIG. (Eindhoven, The Netherlands), 2005. P. 18.
Abouaf R., Teillet-Bill D. // Chem. Phys. Lett. 1980. V. 73. № 1. P. 106.
Gallup G.A., Xu Y., Fabrikant I.I. // Phys. Rev. A. 1998. V. 57. № 4. P. 2596.
Ho P., Johannes J.E., Buss R.J. // J. Vac. Sci. Technol. A. 2001. V. 19. № 5. P. 2344.
Bose D., Rao M.V.V.S., Govindan T.R. et al. // Plasma Sources Sci. Technol. 2003. V. 12. P. 225.
Пивоваренок С.А. // Микроэлектроника. 2019. Т. 48. № 4. С. 279.
Дополнительные материалы отсутствуют.
Инструменты
Химия высоких энергий