Химия высоких энергий, 2020, T. 54, № 1, стр. 54-59
Адгезия к монокристаллическому кремнию пленок диазохинон-новолачного фоторезиста, имплантированных ионами бора и фосфора
С. А. Вабищевич a, С. Д. Бринкевич b, *, Д. И. Бринкевич b, В. С. Просолович b
a Полоцкий государственный университет
214400 Новополоцк, ул. Блохина, 29, Беларусь
b Белорусский государственный университет
220050 Минск, пр. Независимости, 4, Беларусь
* E-mail: brinkevichsd@bsu.by
Поступила в редакцию 24.07.2019
После доработки 24.07.2019
Принята к публикации 12.08.2019
Аннотация
В работе исследовано влияние ионной имплантации на удельную энергию отслаивания пленок диазохинон-новолачного фоторезиста ФП9120, нанесенных на пластины монокристаллического кремния. Установлено, что при имплантации ионов бора и фосфора на границе раздела фоторезист–кремний происходит образование сложноэфирных сшивок между гидроксильными группами на поверхности оксидного слоя кремниевой пластины и карбоксильной группой 1-Н-инден-3-карбоновой кислоты, привитой к полимеру, что приводит к увеличению удельной энергии отслаивания G-пленки от подложки. Указанный эффект наблюдается далеко за пределом области пробега ионов и более выражен при внедрении ионов фосфора.
ВВЕДЕНИЕ
Интерес к исследованию индуцированных ионным облучением процессов в полимерных материалах обусловлен потребностью в разработке новых материалов для космической техники, электроники и медицины [1]. Ионная имплантация позволяет в широких пределах модифицировать физико-химические и биологические свойства приповерхностных слоев полимеров [2]. Это открывает новые возможности для практического применения полимерных материалов.
Ионная имплантация широко используется в современной электронике и позволяет с высокой точностью управлять концентрацией легирующей примеси в полупроводниковых материалах. В качестве масок в процессах субмикронной и нанолитографии важную роль играют диазохинон-новолачные резисты, представляющие собой композит из светочувствительного О-нафтхинондиазида и фенолформальдегидной смолы [3, 4]. Взаимодействие фоторезистов с ультрафиолетовым, рентгеновским и видимым излучением исследовано достаточно подробно, в то время как процессы, индуцированные ионным облучением, практически не изучены, несмотря на то, что они могут оказывать существенное влияние на качество создаваемых приборов [3].
Одной из наиболее важных характеристик фоторезистивных пленок является их адгезия к подложке монокристаллического кремния. Ранее в [4] показано, что ионная имплантация Sb может существенным образом изменить физико-механические свойства диазохинон-новолачных пленок у границы раздела с кремниевой подложкой. Целью настоящей работы было исследование влияния имплантации ионов В+ и Р+ на адгезию пленок диазохинон-новолачного фоторезиста ФП9120 к монокристаллическому кремнию.
МЕТОДИКА ЭКСПЕРИМЕНТА
Пленки позитивного фоторезиста ФП9120, толщиной 1.0 и 1.8 мкм наносились на поверхность Si методом центрифугирования [5]. В качестве подложек использовались пластины (диаметром 100 мм) монокристаллического кремния марки КДБ-10 с ориентацией (111). Толщина h пленки фоторезиста определялась скоростью вращения и составляла: 1.0 мкм при скорости вращения v = 8300 об./мин; 1.8 мкм – при v = 2900 об./мин. Толщина пленок фоторезиста контролировалась с помощью микроинтерферометра МИИ-4 по 5 фиксированным точкам, расположенным на двух взаимно перпендикулярных диаметрах на каждой пластине.
Имплантация ионами B+ (энергия Е = 100 кэВ) и Р+ (энергия 60 кэВ) в интервале доз 5 × 1014–1 × × 1016 cм–2 проводилась при плотности ионного тока j = 4 мкA/cм2 в остаточном вакууме не хуже 10–5 мм рт. ст. на ионно-лучевом ускорителе “Везувий-6”.
Индентирование проводилось при комнатной температуре на приборе ПМТ-3 по стандартной методике [6]. В качестве индентора использовался алмазный наконечник в форме четырехгранной пирамиды с квадратным основанием и углом при вершине α = 136°. Нагрузка (Р) на индентор варьировалась в пределах 1–100 г. Длительность нагружения составляла 2 с; выдержка под нагрузкой 5 с. Удельная энергия отслаивания пленок (G) рассчитывалась по формуле (1), широко используемой для исследования различных полимерных пленок на стеклянных подложках [7, 8]
(1)
$G = \frac{{0.627{{H}^{2}}h\left( {1 - {{\nu }^{2}}} \right)}}{{E{{{\left( {1 + \nu + 2\left( {1 - \nu } \right)H{{l}^{2}}{\text{/}}P} \right)}}^{2}}}},$ЭКСПЕРИМЕНТАЛЬНЫЕ РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
Формула (1) применима, если глубина проникновения индентора в структуру фоторезист–кремний существенно превышает толщину пленки. В нашем случае для фоторезистивной пленки толщиной 1 мкм это условие выполняется при нагрузках свыше 20 г, когда индентор проникает в кремниевую подложку на глубину более 4 мкм. По этой причине исследование влияния ионной имплантации на адгезионные свойства фоторезиста к кремнию проводились при нагрузках 50–100 г, когда выполняется условие преобладания латеральной составляющей нагрузки и дисперсия измеренных значений G мала (не превышает 10%).
Имплантация ионов B+ и P+ приводила к увеличению удельной энергии отслаивания G пленок (рис. 1), причем при имплантации ионов фосфора (рис. 1, кривая 2) рост G происходит быстрее, чем при имплантации бора (рис. 1, кривая 1). Отметим, что увеличение микротвердости полимерной пленки вблизи границы раздела фоточувствительный полимер–кремний при ионной имплантации, которое может быть интерпретировано как усиление адгезии полимерной пленки к кремнию, отмечалось также в работе [10].
Рис. 1.
Зависимости удельной энергии отслаивания G пленки толщиной 1.0 мкм, измеренные при нагрузке 50 г, от дозы имплантации ионов бора (1) и фосфора (2).
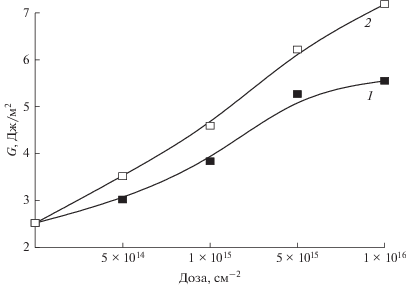
Толщина диазохинон-новолачных пленок более чем в 10 раз превышает величину рассчитанного с использованием программы SRIM-2010 (www.srim.org) проецированного пробега Rp ионов фосфора, который при использованной в настоящей работе энергии 60 кэВ составляет 96 нм. Для ионов бора Rp составлял ~400 нм. Таким образом, экспериментальные данные свидетельствуют о том, что модификация физических свойств (и, соответственно, структуры) диазохинон-новолачного резиста при ионной имплантации происходит далеко за областью внедрения ионов.
Для объяснения экспериментальных данных необходимо принимать во внимание особенности молекулярной и надмолекуляной структуры полимера. Воздействие высокоэнергетических ионов на фенолформальдегидную смолу приводит к возбуждению (реакция 2) и ионизации макромолекул (реакция 3). Необходимо принимать во внимание и возможность ядерного торможения ионов фосфора и бора в образце. Непосредственное воздействие высокоэнергетических ионов на ядра атомов, входящих в состав полимера, приводит к их выбиванию из макромолекул, что проявляется в деструкции и карбонизации фенолформальдегидной смолы вдоль треков ионов.
Основной особенностью радиационной химии фенолов по сравнению с превращениями большинства других органических соединений, в частности, алифатических спиртов [11–13], является их высокая радиационная стойкость. Низкие радиационно-химические выходы образования продуктов радиолиза связаны с относительно небольшими временами жизни ионных пар и высокими выходами возбужденных состояний, которые вследствие распределения энергии по сопряженным π-связям достаточно устойчивы и менее склонны к реакциям фрагментации [14].
Гомолитические превращения фенол-формальдегидной смолы могут индуцировать различные ион-молекулярные реакции, например (4), распад возбужденных молекул по реакции (5) и радикал-молекулярные реакции, например (6). В результате происходит образование радикалов преимущественно феноксильного (I) и метиленового (II) типа, проявляющих термодинамическую стабильность за счет делокализации спиновой плотности по ароматической системе. Поэтому доминирующим механизмом гибели радикалов фенолформальдегидной смолы будет рекомбинация с формированием ковалентных сшивок между полимерными цепями [4], например, вследствие реакции (7).
Образование новой химической связи при рекомбинации радикалов приводит к выделению 3.9–4.4 эВ, которые распределяются в виде энергии возбуждения по макромолекуле полимера. Наличие длинных молекулярных цепочек в структуре фенолформальдегидной смолы может способствовать передаче энергии из области пробега ионов на сравнительно большие расстояния, особенно если избыточная энергия недостаточна для распада молекул на радикалы по реакции (5).
В полимерах возможны два механизма передачи энергии: через колебания атомов (упругие волны), а также по электронной подсистеме молекул [15–18]. На наш взгляд, передача энергии возбуждения на границу раздела фоторезист–кремний в условиях ионной имплантации протекает в основном с помощью первого механизма. Вблизи границы раздела фаз вследствие интерференции упругих волн возможно увеличение избыточной энергии на макромолекулах полимера, в результате чего существует возможность образования свободных радикалов и последующей химической модификации приповерхностного слоя фоторезиста.
Однако основной причиной наблюдаемого увеличения адгезии фенолформальдегидного фоторезиста ФП9120 к кремнию после ионной имплантации являются процессы с участием его фоточувствительного компонента – орто-нафтохинондиазида. Это соединение, химически привитое к фенолформальдегидной смоле, способно поглощать УФ излучение с энергией 2.8–4.0 эВ, вследствие чего переходит в возбужденное состояние [3]. Последующий распад (деазотирование) по реакции (8) приводит к образованию высокореакционного кетена (III).
Пленка фоторезиста после сушки содержит небольшое количество воды (~1% от веса). Поэтому в условиях фотолитографии кетен присоединяет воду по реакции (9) и превращается в 1-Н-инден-3-карбоновую кислоту, увеличивающую растворимость фенолформальдегидной смолы в 0.1–0.3 М водных растворах NaOH и других щелочных травителях [4].
В условиях ионной имплантации (остаточный вакуум 10–5 мм рт. ст.) вода полностью удаляется из полимера и реакция (9) протекать не может. С другой стороны, макромолекулы фенолформальдегидной смолы могут передавать энергию возбуждения на орто-нафтохинондиазид, вызывая образование кетена (III). Этому способствует то обстоятельство, что энергия менее 4 эВ недостаточна для реализации реакций гомолитической деструкции, аналогичных (5). Поэтому такое низкоэнергетичное возбуждение может свободно перемещаться по макромолекуле полимера вне зависимости от того, образовалось ли оно при воздействии корпускулярного излучения на полимер (реакция 2), вследствие рекомбинации радикалов (реакция 7) или нейтрализации разноименно заряженных ионов.
При имплантации фоторезиста ионами Sb+ взаимодействие кетена (III) в объеме полимера c ОН-группами фенолформальдегидной смолы приводит к образованию сложноэфирных сшивок, что проявляется в увеличении микротвердости и охрупчивании резистивной пленки [4]. Реализация аналогичной реакции с участием гидроксильных групп на поверхности кремниевой пластины (реакция 10) может быть причиной наблюдаемого нами увеличения адгезии фоторезиста к подложке.
Таким образом, образование сложноэфирных сшивок между гидроксильными группами на поверхности оксидного слоя кремниевой пластины и карбоксильной группой 1-Н-инден-3-карбоновой кислоты по реакции (10) приводит к увеличению удельной энергии отслаивания полимерной пленки G.
Отдельно следует остановиться на обнаруженных отличиях в свойствах фоторезистов, имплантированных ионами Р+ и В+ . При меньшей поглощенной дозе в случае ионов фосфора наблюдается более выраженное увеличение адгезии к кремниевой подложке. Этот экспериментальный факт связан с тем, что при имплантации В+ вклад ядерного торможения мал – не превышает 10–15% от электронного торможения. Это существенно ниже, чем при имплантации фосфора, для которой потери на ядерное (около 40%) и электронное (~60%) торможение сопоставимы [2]. Кроме того, линейная передача энергии – потери энергии излучения на единицу длины пути в образце – при имплантации ионами бора будет значительно меньше. Это с одной стороны обуславливает более низкую энергию упругих волн при имплантации В+ (чем при внедрении ионов фосфора) и, соответственно, меньшее количество энергии, передаваемой на границу раздела фоторезист-подложка. С другой стороны, более высокие значения линейной передачи энергии в случае фосфора предопределяют более высокую вероятность рекомбинации ионов и радикалов вдоль трека частицы и, как следствие, значительно более высокие выходы электронно-возбужденных состояний макромолекул, которые в конечном итоге вызывают деазотирование орто-нафтохинондиазида с образованием сложноэфирных сшивок на границе раздела фаз полимер–кремний.
ЗАКЛЮЧЕНИЕ
В процессе имплантации ионов бора и фосфора вблизи границы раздела фоторезист–кремний происходит образование сложноэфирных сшивок между гидроксильными группами на поверхности оксидного слоя кремниевой пластины и карбоксильными группами 1-Н-инден-3-карбоновой кислоты, что приводит к увеличению удельной энергии отслаивания полимерной пленки G. Указанный эффект наблюдается далеко за пределом области пробега ионов и более выражен при внедрении Р+.
Список литературы
Kondyurin A., Bilek M. Ion beam treatment of polymers: application aspects from medicine to space. Elsevier. 2015. 256 p.
Оджаев В.Б., Козлов И.П., Попок В.Н., Свиридов Д.В. Ионная имплантация полимеров . Минск: Белгосуниверситет. 1998. 197 с.
Моро У. Микролитография. Принципы, методы, материалы. В 2-х ч. Ч. 2. М.: Мир, 1990. 632 с.
Бринкевич Д.И., Бринкевич С.Д., Вабищевич Н.В., Оджаев В.Б., Просолович В.С. // Микроэлектроника. 2014. Т. 43. № 3. С. 193.
Бринкевич Д.И., Харченко А.А., Просолович В.С., Оджаев В.Б., Бринкевич С.Д., Янковский Ю.Н. // Микроэлектроника. 2019. Т. 48. № 3. С. 235.
Бринкевич Д.И., Просолович В.С., Янковский Ю.Н., Вабищевич С.А., Вабищевич Н.В., Гайшун В.Е // Приборы и методы измерений. 2016. Т. 7. № 1. С. 77.
Rosenfeld L.G., Ritter J.R., Lardner T.J., Lin M.R. // J. Applied Physics. 1990. V. 67. № 7. P. 3291.
Malzbender J., den Toonder J.M.J., Balkenende A.R., de With G. // Materials Science and Engineering R. 2002. V. 36. P. 47.
Бринкевич Д.И., Вабищевич Н.В., Просолович В.С. // Неорганические материалы. 2012. Т. 48. № 8. С. 878.
Вабищевич С.А., Вабищевич Н.В., Бринкевич Д.И., Просолович В.С., Бринкевич С.Д. // Вестник Полоцкого государственного университета. Серия С. Фундаментальные науки. 2016. № 12. С. 51.
Бринкевич С.Д., Резцов И.А., Шадыро О.И. // Химия высоких энергий. 2014. Т. 48. № 5. С. 350.
Бринкевич С.Д., Малиборский А.Я., Капусто И.А., Свердлов Р.Л., Григорьев Ю.В., Ивашкевич О.А., Шадыро О.И. // Химия высоких энергий. 2019. Т. 53. № 2. С. 140.
Бринкевич С.Д., Кузьмук Д.А. Свердлов Р.Л., Шадыро О.И. // Химия высоких энергий. 2019. Т. 53. № 6. С. 478.
Neta P., Steenken S. // The chemistry of phenols. Edited by Z. Rappoport. John Wiley & Sons. 2003. P. 1097.
Экспериментальные методы химии высоких энергий / Под ред. Мельникова М.Я. М.: МГУ, 2009. С. 169.
Харченко А.А., Бринкевич Д.И., Бринкевич С.Д., Лукашевич М.Г., Оджаев В.Б. // Поверхность. Рентгеновские, синхротронные и нейтронные исследования. 2015. № 1. С. 94.
Бринкевич Д.И., Харченко А.А., Бринкевич С.Д., Лукашевич М.Г., Оджаев В.Б., Валеев В.Ф., Нуждин В.И., Хайбуллин Р.И. // Поверхность. Рентгеновские, синхротронные и нейтронные исследования. 2017. № 8. С. 25.
Харченко А.А., Бринкевич Д.И., Бринкевич С.Д., Лукашевич М.Г., Оджаев В.Б. // Поверхность. Рентгеновские, синхротронные и нейтронные исследования. 2015. № 4. С. 60.
Дополнительные материалы отсутствуют.
Инструменты
Химия высоких энергий








