Вестник Военного инновационного технополиса «ЭРА», 2023, T. 4, № 3, стр. 269-272
Характеристики транзисторов на основе гетероструктур нитрида галлия на пластинах кремния с эпитаксиальным слоем высокоомного кремния
И. С. Езубченко 1, *, А. А. Андреев 1, М. Я. Черных 1, И. В. Куликов 1, Д. А. Мамичев 1, Ю. В. Грищенко 1, П. А. Перминов 1, И. А. Черных 1, М. Л. Занавескин 1, С. Д. Федотов 2, Е. М. Соколов 2, В. Н. Стаценко 2
1 Национальный исследовательский центр “Курчатовский институт”
Москва, Россия
2 Акционерное общество “Эпиэл”
Зеленоград, Москва, Россия
* E-mail: ezivan9@gmail.com
Поступила в редакцию 27.09.2023
После доработки 27.09.2023
Принята к публикации 05.10.2023
Аннотация
На AlN/GaN-гетероструктурах на пластинах кремния с эпитаксиально дорощенным слоем высокоомного кремния созданы транзисторы с топологической нормой затвора 0.1–0.25 мкм и исследованы их характеристики. Транзисторы характеризуются значением максимального тока насыщения выше 1.1 А/мм и крутизной передаточной характеристики более 350 мСм/мм. Переход MSG/MAG располагается на частотах 20, 37.5 и более 40 ГГц при коэффициенте усиления на частоте 10 ГГц, равном 15.63, 15.92 и 16.55 дБ для транзисторов с длиной затвора 250, 150 и 100 нм соответственно. Потери СВЧ-сигнала на частоте 30 ГГц составили 0.89 дБ/мм.
ВВЕДЕНИЕ
В настоящее время подложки кремния активно используются для эпитаксии гетероструктур на основе нитрида галлия [1–3]. Основой повышенного интереса к пластинам кремния являются низкая стоимость по сравнению с пластинами карбида кремния, а также наличие пластин большого диаметра вплоть до 300 мм. Отсутствие в Росии технологии роста высокоомных подложек Si диаметром более 100 мм, получаемых методом бестигельной зонной плавки, значительно ограничивают возможность их применения для роста гетероструктур GaN транзисторов с высокой подвижностью электронов (high electron mobility transistor, HEMT) под СВЧ-применения. В связи с этим было предложено в качестве альтернативы использовать уникальные сверхвысокоомные эпитаксиальные структуры кремния [4]. Ранее проведенные технологические работы показали возможность применения данного материала для получения GaN HEMT-гетероструктур [5, 6]. Актуальным вопросом являются характеризация гетероструктур и транзисторов, созданных на пластинах со сверхвысокоомной эпитаксиальной структурой кремния, и определение эффективности их использования для создания СВЧ-устройств. Данная работа посвящена исследованию характеристик транзисторов с топологическими нормами 0.1–0.25 мкм на отечественных пластинах, созданных по технологии эпитаксиального доращивания высокоомного кремния.
ЭКСПЕРИМЕНТАЛЬНО-МЕТОДИЧЕСКАЯ ЧАСТЬ
В работе использована гетероструктура с барьерным слоем AlGaN толщиной 16 нм, мольной долей алюминия 23% и in situ-пассивацией Si3N4 толщиной 3 нм, синтезированная на структурах сверхвысокоомного эпитаксиального кремния на подложках марки КДБ-10 диаметром 100 мм. Удельное сопротивление эпитаксиального слоя Si составило 2–5 кОм∙см. В целях получения гладкой поверхности эпитаксиального слоя Si при росте на подложке с ориентацией Si(111) ± 0.5° был применен многостадийный метод роста с использованием хлоридных и гидридных кремнийсодержащих газовых реагентов. Создание сверхвысокоомного эпитаксиального слоя кремния и синтез гетероструктуры проводили АО “Эпиэл” (Зеленоград, Россия).
Были созданы двухзатворные транзисторы с периферией затвора 2 × 100 мкм, расстояние исток–сток 3 мкм (рис. 1). Контакты к двумерному электронному газу формировали путем эпитаксиального доращивания нитрида галлия с контролируемым профилем легирования кремнием [7, 8] с последующей металлизацией. Затворы создавали по технологии отдельно стоящих затворов с использованием трехслойной системы резистов с помощью метода электронно-лучевой литографии. Длина затвора составляла 0.1, 0.15 и 0.25 мкм. Далее методом плазменно-химическое осаждения из паровой фазы получали нитрид кремния толщиной 200 нм.
Характеризацию гетероструктуры и технологического процесса осуществляли при помощи специального параметрического монитора, который включал в себя тесты ван дер Пау для анализа слоевого сопротивления, тесты для анализа контактного сопротивления к двумерному электронному газу методом длинной линии, компланарные линии для анализа потерь СВЧ-сигнала. Параметрический монитор располагался в нескольких частях пластины для определения однородности параметров.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Слоевое сопротивление гетероструктуры составило 460 ± 10 Ом/квадрат, оно несколько выше типичных значений коммерчески доступных гетероструктур на кремнии (менее 400 Ом/квадрат), что может свидетельствовать о необходимости оптимизации архитектуры эпитаксиальных слоев и корректировки ростовых параметров. Контактное сопротивление составило 0.13 ± ± 0.03 Ом ⋅ мм.
На рис. 2 приведены типичные статические характеристики транзисторов с длиной затвора 100 нм. Максимальный ток насыщения стока составил 1.2 А/мм при Vgs = +2 В и напряжении на стоке Vds = +6 В. Ток насыщения при Vgs = 0 В составил 0.9 А/мм. Максимальная крутизна транзистора Gm = 407 мСм/мм. Напряжение отсечки Vотс = –3.2 В. Статические характеристики изготовленных транзисторов с различной длиной затвора приведены в табл. 1. Как и ожидалось, с увеличением длины затвора происходит незначительное снижение тока насыщения транзистора и его максимальной крутизны одновременно с повышением напряжений отсечки и пробоя [9]. Высокие значения тока насыщения для созданных транзисторов с разной длиной затвора позволяют ожидать значения выходной мощности на уровне 5 Вт/мм при напряжениях питания 28 В и более [10]. Однако высокое значение слоевого сопротивления приводит к увеличению напряжения насыщения канала двумерного газа, что в свою очередь ведет к уменьшению выходной мощности. Таким образом, для эффективного использования представленных гетероструктур для значений питания 20 В и менее необходимо уменьшение слоевого сопротивления до 300 Ом/квадрат.
Рис. 2.
Выходные статические характеристики транзисторов: а – вольт-амперная характеристика транзистора (напряжение на затворе Vg = –3…+2 В с шагом 1 В), б – крутизна транзистора.

Таблица 1.
Статические характеристики транзисторов с различной длиной затвора
| Длина затвора, нм | Максимальный ток стока Imax при Vgs = +2 В, А/мм | Ток насыщения I0 при Vgs = 0 В, А/мм | Напряжение отсечки Vотс при Ids = 1 мА/мм и Vds = 5 В, В | Максимальная крутизна Gm, мСм/мм | Пробивное напряжение Vbr при Vgs = –6 В, В | Сопротивление в открытом состоянии, Ом ⋅ мм |
|---|---|---|---|---|---|---|
| 100 | 1.2 | 0.9 | –3.2 | 407 | 80–90 | 1.5–1.6 |
| 150 | 1.19 | 0.87 | –2.7 | 374 | 100–110 | |
| 250 | 1.16 | 0.78 | –2.5 | 371 | 110–120 |
Измеренные статические характеристики соответствуют лучшим результатам на карбиде кремния [10, 11], что говорит как о высоком качестве гетероструктур, так и высоком уровне технологического процесса.
Слабосигнальные характеристики анализировали в частотном диапазоне 1–40 ГГц. На рис. 3 приведены частотные зависимости коэффициента усиления по мощности для транзисторов с различной длиной затвора. Как видно, положение точки перехода максимально стабильного коэффициента усиления по мощности (maximum stable gain, MSG) в максимально достижимый коэффициент усиления по мощности (maximum available gain, MAG) смещается в низкочастотную область с увеличением длины затвора и находится на 20, 37.5 и более 40 ГГц для транзисторов с длиной затвора 250, 150 и 100 нм соответственно. Коэффициент усиления созданных транзисторов на частоте 10 ГГц равен 15.63, 15.92 и 16.55 дБ для транзисторов с длиной затвора 250, 150 и 100 нм соответственно. Потери СВЧ-сигнала в компланарной линии составили 0.89 дБ/мм на частоте 30 ГГц.
Рис. 3.
Частотная зависимость коэффициента усиления по мощности для транзисторов с различной длиной затвора.
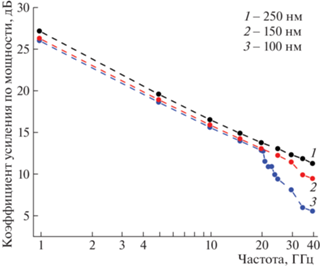
На основе исследования статических и малосигнальных характеристик можно заключить, что созданные на базе гетероструктур на подложках с высокоомным эпитаксиальным слоем кремния транзисторы могут быть использованы как активные элементы при проектировании и создании СВЧ-устройств в широком диапазоне частот вплоть до 30 ГГц.
ЗАКЛЮЧЕНИЕ
На основе гетероструктуры нитрида галлия на пластине низкоомного кремния с эпитаксиально дорощенным высокоомным слоем кремния были созданы транзисторы с длиной затвора 0.1, 0.15 и 0.25 мкм, на которых были изучены статические и малосигнальные характеристики.
Транзисторы характеризовались значением максимального тока насыщения выше 1.1 А/мм и крутизной передаточной характеристики более 350 мСм/мм. Переход MSG/MAG составил 20, 37.5 и более 40 ГГц при коэффициенте усиления на частоте 10 ГГц, равном 15.63, 15.92 и 16.55 дБ для транзисторов с длиной затвора 250, 150 и 100 нм соответственно. Потери СВЧ-сигнала на частоте 30 ГГц составили 0.89 дБ/мм.
Полученные результаты находятся на высоком мировом уровне, имеют высокий потенциал дальнейшего развития, а созданные на базе гетероструктур на подложках с высокоомным эпитаксиальным слоем кремния транзисторы имеют перспективы использования при создании СВЧ-устройств в широком диапазоне частот вплоть до 30 ГГц.
Работа выполнена по государственному заданию Национального исследовательского центра “Курчатовский институт”.
Список литературы
Zhong Y., Zhang J., Wu S. et al. // Fundam. Res. 2022. V. 2. P. 462. https://doi.org/10.1016/j.fmre.2021.11.028
Neininger P., Mikulla M., Doring P. et al. // e-Prime – Advances in Electrical Engineering, Electronics and Energy. 2023. V. 4. P. 100177. https://doi.org/10.1016/j.prime.2023.100177
Then H.W., Dasgupta S., Radosavljevic M. et al. // IEEE Int. Electron Devices Meeting Tech. Dig., 2019, San Francisco, CA, USA, 07–11 December 2019. https://doi.org/10.1109/IEDM19573.2019.8993583
Волков А.С., Дементьев В.Б., Люблин В.В. Пат. 2606809 Российская Федерация, МПК H01L21/20. Cпособ изготовления кремниевой эпитаксиальной структуры. Заявитель и патентообладатель Акционерное общество “Эпиэл”. № 2015142243, заявл. 06.10.2015, опубл. 10.01.2017, Бюл. № 1.
Федотов С.Д., Лундин В.В., Заварин Е.Е. и др. // Наноиндустрия. 2020. Т. 13. № S 5–1 (102). С. 209. https://doi.org/10.22184/1993-8578.2020.13.5s.209.212
Федотов С.Д., Лундин В.В., Заварин Е.Е. и др. // Наноиндустрия. 2021. Т. 14. № S7–14 (107), С. 197. https://doi.org/10.22184/1993-8578.2021.14.7s.197.200
Huang T., Liu C., Bergsten J. et al. // Proc. 2016 Compound Semiconductor Week (CSW). Toyama, Japan. 2016. P. 1. https://doi.org/10.1109/ICIPRM.2016.7528722
Guo H.-Y., Lv Y.-J., Gu G.-D. et al. // Chinese Phys. Lett. 2015. V. 32. № 11. P. 118501. https://doi.org/10.1088/0256-307x/32/11/118501
Saadaoui S., Fathallah O., Maaref H. // J. Phys. Chem. Solids. 2022. V. 161. P. 110418. https://doi.org/10.1016/j.jpcs.2021.110418
Liu J., Zhu J., Mi M. et al. // Appl. Phys. Lett. 2022. V. 120. P. 052101. https://doi.org/10.1063/5.0080120
Harrouche K., Kabouche R., Okada E. et al. // 2020 IEEE/MTT-S International Microwave Symposium (IMS). Los Angeles, CA, USA, 04–06 August 2020. https://doi.org/10.1109/IMS30576.2020.9223971
Дополнительные материалы отсутствуют.
Инструменты
Вестник Военного инновационного технополиса «ЭРА»