Вестник Военного инновационного технополиса «ЭРА», 2022, T. 3, № 1, стр. 52-56
ВЛИЯНИЕ СОПРОТИВЛЕНИЙ ЭЛЕКТРОДНЫХ ШИН В МАССИВЕ КРОССБАР-МЕМРИСТОРОВ НА РАЗБРОС ИХ ХАРАКТЕРИСТИК
А. И. Ильясов 1, 2, *, К. Э. Никируй 1, А. В. Емельянов 1, **, К. Ю. Черноглазов 1, В. В. Рыльков 1, 3, В. А. Демин 1
1 Национальный исследовательский центр “Курчатовский институт”
Москва, Россия
2 Московский государственный университет им. М.В. Ломоносова
Москва, Россия
3 Фрязинский филиал Института радиотехники и электроники им. В.А. Котельникова РАН
Фрязино, Россия
* E-mail: sashailyasov99@gmail.com
** E-mail: emelyanov_av@nrcki.ru
Поступила в редакцию 20.12.2021
После доработки 14.01.2022
Принята к публикации 14.01.2022
Аннотация
Применение мемристоров в качестве физических аналогов синапсов в аппаратных нейроморфных вычислительных системах – многообещающий способ повышения их энергоэффективности. При этом для реализации систем, решающих сложные когнитивные задачи, необходимо большое количество плотно упакованных мемристоров, что на практике достигается созданием их массивов в кроссбар-архитектуре. Изучены резистивные переключения в мемристивных структурах на основе нанокомпозита (Co40Fe40B20)x(LiNbO3)100 – x, созданных в кроссбар-архитектуре с относительно тонкими шинами (не более 100 нм), обнаружено заметное влияние сопротивления шин кроссбар-элементов на разброс их характеристик, а также предложен способ решения этой проблемы. Полученные результаты могут быть использованы в дальнейшей разработке массивов кроссбар-мемристоров для нейроморфных применений.
ВВЕДЕНИЕ
Мемристоры – устройства, способные изменять свою проводимость под действием приложенного напряжения, превышающего некоторый порог, а также сохранять резистивное состояние после прекращения внешнего воздействия [1–4]. По этой причине одним из наиболее перспективных направлений их применения является использование в качестве синапсов (весовых связей) в аппаратных формальных и импульсных нейронных вычислительных сетях (НВС). В рамках такого подхода в последнее время были реализованы, например, перцептроны [5, 6], кратковременная–долговременная память [7], резервуарные вычислители [8], а также распознаватели простых образов [9] и обучение шумовым сигналом [10] в спайковых нейронных сетях. Использование мемристоров в таких системах позволяет снизить их энергопотребление, однако для решения сложных задач необходимо большое количество весовых связей. В связи с этим требуется создание массивов мемристоров с высокой плотностью их расположения на подложке. На практике это достигается за счет формирования мемристивных элементов в матричном исполнении в кроссбар-геометрии (элементы находятся на пересечениях взаимно перпендикулярных электродных шин “строк” и “столбцов”) [11, 12].
Необходимым условием возможности создания НВС являются невысокие рабочие напряжения мемристоров кроссбара для совместимости с современной КМОП-логикой на комплементарных транзисторах металл–оксид–полупроводник, работающих при напряжениях не более 3 В, а кроме того, относительно небольшой разброс характеристик мемристоров от устройства к устройству [13].
Настоящая работа посвящена исследованию резистивных переключений (РП) мемристивных элементов кроссбара 4 × 4 при использовании относительно тонких шин (≤100 нм), а также обнаруженной при этом зависимости их вольт-амперных характеристик (ВАХ) от места подключения к проводящим шинам элементов. Получающийся разброс напряжений переключения в низкоомное состояние (Uset) может быть критичным для уменьшения энергопотребления систем на основе таких кроссбаров, а также вариабельности параметров мемристоров от устройства к устройству [14]. Один из возможных способов решения данной проблемы предлагается в работе.
МЕТОДЫ
Как показано в [15–17], многообещающим направлением в разработке мемристоров с низким энергопотреблением является использование двухслойных структур типа металл/нанокомпозит/диэлектрик/метал (М/НК/Д/М) на основе нанометровых слоев НК = = (Co40Fe40B20)x(LiNbO3)100 – x и Д = LiNbO3 (LNO) с суммарной толщиной активной области ≤100 нм. Одной из проблем при создании кроссбар-структур с относительно толстыми шинами (≥100 нм) являются краевые эффекты, которые могут приводить к утечкам тока и локальному диэлектрическому пробою структуры. В связи с этим в работе использовали относительно тонкие шины из Au (толщиной не более 100 нм). Дополнительно формировали изоляцию нанокомпозита от проводящих шин с использованием плазмохимического осаждения (например, Si3N4) при температуре 300°С. В этом случае формируется плотный диэлектрик, поэтому при относительно небольшой толщине диэлектрической пленки (5–10 нм) эффекты туннелирования электронов должны быть пренебрежимо малы.
Мемристивные матрицы были созданы с использованием лазерной фотолитографии (литограф Heidelberg 66fs с разрешением 1 мкм), плазмохимического осаждения (Trion Oracle III) и ионно-лучевого распыления составной мишени на оригинальной установке, позволяющей получать слои НК различного состава в едином цикле [18]. Важная особенность при создании структур состояла в том, что при осаждении НК- и LNO‑слоев использовали теневые маски, что позволило сформировать полоски НК необходимых размеров без использования химического травления, которое трудноосуществимо при различных составах НК. Шины из Au создавали с помощью термического напыления на предварительно нанесенные адгезионные слои из Ti (Cr) толщиной ~25 нм.
Как верхний, так и нижний защитные слои Si3N4 создавали с помощью плазмохимического осаждения. Для подавления нежелательного влияния краевых эффектов, результатом которых могут быть токовые утечки и локальный электрический пробой структуры, размер окон в защитном слое Si3N4 на обеих шинах был выбран заметно меньшим, чем их ширина (50 мкм) (рис. 1). Были изготовлены массивы мемристоров в кроссбар-геометрии с числом элементов 4 × 4 площадью S = 50 × 50 мкм2 каждый. Содержание металла в НК составляло x ≈ 19 ат. %.
Рис. 1.
Схематическое изображение сечения отдельного мемристивного кроссбар-элемента на базе структур М/(CoFeB)x(LiNbO3)100 – x/LiNbO3/М с защитными изолирующими слоями Si3N4, выращенными плазмохимическим осаждением.
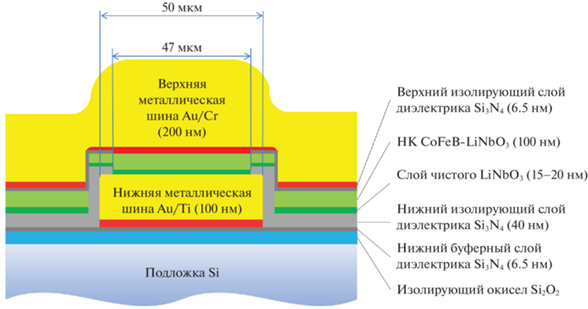
Электрофизические измерения мемристивных свойств М/НК/LNO/М кроссбар-элементов проводили при комнатной температуре с помощью многофункционального источника-измерителя Keithley 2636B и аналитической зондовой станции EPS4 (Swin).
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Механизм РП в НК-мемристорах основан на движении вакансий кислорода под действием электрического поля по большому числу филаментов [17]. На рис. 2 представлены ВАХ для одного из мемристоров кроссбара, измеренные для двух разных способов подключения зондов к нижней и верхней шинам. Скорость развертки по напряжению составляла 2 В/с, тогда как токи ограничения были установлены на уровне 100 мА для обеих полярностей приложенного напряжения. Для каждого метода подключения было измерено по пять кривых ВАХ. Отметим, что различия от цикла к циклу при одинаковом подключении невелики, однако ВАХ для разных подключений различаются между собой весьма заметно – как общим наклоном петель гистерезиса, так и напряжением достижения ограничения по току при положительных напряжениях на структурах (напряжение включения, Uset), при этом общий вид кривых принципиальных различий не имеет.
Рис. 2.
Вольт-амперные характеристики одного из мемристоров массива. Схематично изображены его положение в кроссбаре и способы подключения зондов к шинам при каждом из измерений.
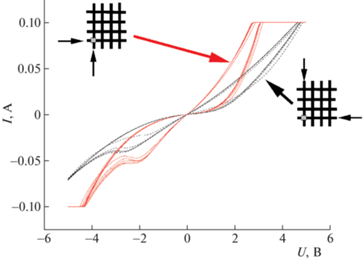
Это может быть вызвано собственным последовательным сопротивлением участков шин от выбранного контакта до исследуемого мемристора. Это приводит к падению части приложенного напряжения на шинах, эффективно увеличивая сопротивление мемристора и напряжение Uset с ростом суммарной длины задействованных частей шин.
Для проверки этой гипотезы были измерены ВАХ для всех 16 мемристоров одного кроссбар-массива. Подключение при этом происходило только с двух сторон (с одной для нижних шин и одной для верхних). После этого по полученным кривым были найдены значения напряжения Uset для каждого мемристора при данном подключении.
Полученные значения представлены в виде “тепловой” карты на рис. 3. Нетрудно заметить, что напряжение монотонно возрастает при увеличении суммарного расстояния от мемристора до контактов, которые используются для измерения ВАХ. Этот факт подтверждает предположение о влиянии сопротивления шин на эффективные мемристивные параметры кроссбар-элементов массива. Прямые измерения сопротивления шин дают значения 7.6 и 22.6 Ом для верхней и нижней шин соответственно, т.е. удельное сопротивление нижних шин превосходит сопротивление верхних. По этой причине для мемристоров, расположенных ниже главной диагонали, для которых суммарная длина участков шин до контактов приходится в большей степени на нижние шины (вертикальные на рисунке), напряжение Uset превосходит Uset для мемристоров, симметричных первым относительно главной диагонали (т.е. таких, для которых при прежнем суммарном расстоянии до контактов, оно в большей степени приходится на верхние горизонтальные шины).
Рис. 3.
Тепловая карта напряжений перевода в высокопроводящее состояние мемристоров кроссбар-массива. Стрелками показаны места подключения к шинам.
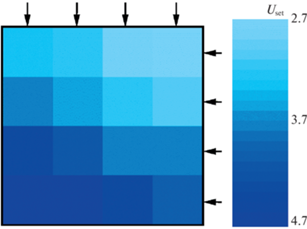
На рис. 4 показана гистограмма распределения напряжений Uset для всех 16 мемристоров кроссбар-массива. Форма гистограммы близка к гауссовой, однако разброс напряжений преимущественно связан с влиянием сопротивления шин кроссбара. Разброс характеристик оказывается довольно велик, максимальное и минимальное значения Uset различаются почти в 2 раза.
Значительная деградация характеристик препятствует эффективному использованию для создания импульсных и формальных нейронных сетей всего кроссбар-массива целиком, ограничивая его рабочую область матрицы мемристорами, расположенными вблизи центра структуры (четыре мемристора для кроссбаров 4 × 4, т.е. всего 25%). Это обстоятельство снижает преимущество кроссбар-геометрии, состоящее в высокой плотности упаковки мемристивных элементов. Кроме того, энергоэффективность матрицы снижается за счет повышения напряжений РП.
Решением данной проблемы может являться увеличение внутреннего сопротивления кроссбар-мемристоров в матрице, например, посредством использования дополнительных тонких оксидных слоев с большой шириной запрещенной зоны и низкими значениями подвижности вакансий (Al2O3, SiO2), а также уменьшения сопротивления металлических шин за счет увеличения их толщины. При этом, очевидно, влияние сопротивления шин на характеристики РП окажется несущественным.
ЗАКЛЮЧЕНИЕ
Сформированы массивы мемристивных кроссбар-элементов на основе нанокомпозита CoFeB–LiNbO3 с прослойкой чистого LiNbO3 на кремниевой подложке, демонстрирующие обратимые РП с хорошей повторяемостью от цикла к циклу. Обнаружена зависимость величины напряжений Uset от способа подключения к кроссбару, которая, как показано, вызвана влиянием конечного сопротивления токопроводящих шин структуры. Предложен способ решения данной проблемы с помощью увеличения внутреннего сопротивления мемристоров.
Исследования выполнены на оборудовании Ресурсного центра электрофизических методов Национального исследовательского центра “Курчатовский институт” (приказ № 2753).
Список литературы
Mikhaylov A.N., Guseinov D.V., Belov A.I. et al. // C-haos, Solitons Fractals. 2021. V. 144. P. 110723. https://doi.org/10.1016/j.chaos.2021.110723
Mikheev V., Chouprik A., Lebedinskii Y. et al. // Nanotechnology. 2020. V. 31. № 21. P. 215205. https://doi.org/10.1088/1361-6528/ab746d
Bobylev A.N., Udovichenko S.Y. // Russ. Microelectron. 2016. V. 45. № 6. P. 396. https://doi.org/10.1134/S1063739716060020
Wang W., Panin G.N., Fu X. et al. // Sci. Rep. 2016. V. 6. № 1. P. 31224. https://doi.org/10.1038/srep31224
Prezioso M., Merrikh-Bayat F., Hoskins B.D. et al. // Nature. 2015. V. 521. № 7550. P. 61. https://doi.org/10.1038/nature14441
Emelyanov A.V., Lapkin D.A., Demin V.A. et al. // AIP Adv. 2016. V. 6. № 11. https://doi.org/10.1063/1.4966257
Li C., Wang Z., Rao M. et al. // Nat. Mach. Intell. 2019. V. 1. № 1. P. 49. https://doi.org/10.1038/s42256-018-0001-4
Moon J., Ma W., Shin J.H. et al. // Nat. Electron. 2019. V. 2. № 10. P. 480. https://doi.org/10.1038/s41928-019-0313-3
Feldmann J., Youngblood N., Wright C.D. et al. // Nature. 2019. V. 569. № 7755. P. 208. https://doi.org/10.1038/s41586-019-1157-8
Surazhevsky I.A., Demin V.A., Ilyasov A.I. et al. // Chaos, Solitons Fractals. 2021. V. 146. P. 110890. https://doi.org/10.1016/j.chaos.2021.110890
Xia Q., Yang J.J. // Nat. Mater. 2019. V. 18. № 4. P. 309. https://doi.org/10.1038/s41563-019-0291-x
Pi S., Li C., Jiang H. et al. // Nat. Nanotechnol. 2019. V. 14. № 1. P. 35. https://doi.org/10.1038/s41565-018-0302-0
Ryu J.-H., Kim S. // Chaos, Solitons Fractals. 2020. V. 140. P. 110236. https://doi.org/10.1016/j.chaos.2020.110236
Demin V.A., Surazhevsky I.A., Emelyanov A.V. et al. // J. Comput. Electron. 2020. V. 19. № 2. P. 565. https://doi.org/10.1007/s10825-020-01470-0
Рыльков В.В., Емельянов А.В., Николаев С.Н. и др. // ЖЭТФ. 2020. Т. 158. № 1 (7). С. 164. https://doi.org/10.31857/s0044451020070159
Emelyanov A.V., Nikiruy K.E., Serenko A.V. et al. // Nanotechnology. 2020. V. 31. № 4. P. 045201. https://doi.org/10.1088/1361-6528/ab4a6d
Martyshov M.N., Emelyanov A.V., Demin V.A. et al. // Phys. Rev. Appl. 2020. V. 14. № 3. P. 034016. https://doi.org/10.1103/PhysRevApplied.14.034016
Никируй К.Э., Емельянов А.В., Рыльков В.В. и др. // Радиотехника и электроника. 2019. Т. 64. № 10. С. 1019. https://doi.org/10.1134/S0033849419100103
Дополнительные материалы отсутствуют.
Инструменты
Вестник Военного инновационного технополиса «ЭРА»



