Микроэлектроника, 2021, T. 50, № 6, стр. 461-466
Исследование процесса перемагничивания спин-туннельного перехода с использованием модели когерентного вращения намагниченности свободного слоя
В. В. Амеличев a, **, Д. В. Васильев a, *, Д. В. Костюк a, Ю. В. Казаков a, С. И. Касаткин b, О. П. Поляков b, c, П. А. Поляков c, В. С. Шевцов b, c
a Федеральное государственное бюджетное научное учреждение “Научно-производственный комплекс “Технологический центр”,
124498 Зеленоград, Москва, пл. Шокина, 1, стр. 7, Россия
b Федеральное государственное бюджетное учреждение науки Институт проблем управления
им. В.А. Трапезникова Российской академии наук
117997 Москва, ул. Профсоюзная, 65, Россия
c Московский государственный университет им. М.В. Ломоносова
119991 Москва, Ленинские горы, 1, Россия
** E-mail: V.Amelichev@tcen.ru
* E-mail: D.Vasilyev@tcen.ru
Поступила в редакцию 05.03.2021
После доработки 01.06.2021
Принята к публикации 29.06.2021
Аннотация
Рассмотрено влияние магнитного поля, направленного ортогонально оси легкого намагничивания спин-туннельного перехода (СТП) эллиптической формы на основе структуры Ta/CoFe/CoFeB/MgO/CoFeB/Ru/CoFe/FeMn/Ta, на зависимость сопротивления СТП от внешнего магнитного поля. Проведен расчет данной зависимости с использованием модели когерентного вращения намагниченности свободного слоя. Результаты расчетов сопоставимы с экспериментальными исследованиями и могут применяться при моделировании конструкции преобразователей магнитного поля на основе спин-туннельных магниторезистивных наноструктур.
ВВЕДЕНИЕ
Развитие технологии формирования многослойных магниторезистивных (МР) наноструктур способствовало созданию высокочувствительных преобразователей магнитного поля (ПМП) с низким уровнем шумов в выходном напряжении и порогом обнаружения магнитных полей на уровне единиц пТл [1–3]. Спин-туннельные магниторезистивные (СТМР) наноструктуры отличаются от других гигантских магниторезистивных (ГМР) наноструктур высоким МР эффектом и повышенной термостабильностью. ПМП на основе СТМР наноструктур применяются в навигационных системах в составе магнитометров, для контроля величины тока в электрических сетях, устройствах дефектоскопии и биосенсорных устройствах [4–6]. Исследования мозговой активности, где сигналы имеют очень низкую интенсивность на низких частотах (единицы пТл в диапазоне от 0 до 100 Гц), нуждаются в измерительных устройствах с чрезвычайно низким порогом обнаружения магнитного поля при комнатной температуре. Данные требования могут удовлетворить ПМП на основе СТМР наноструктур, например, в [3] представлены результаты разработки и исследований высокочувствительных ПМП на основе СТМР наноструктур для электромагнитных измерений нейронов на уровне отдельных клеток.
Создание ПМП на основе СТМР наноструктур трудоемко, так как содержит ряд сложных технологических процессов и включает в себя решение следующих основных задач: подбор состава СТМР наноструктуры с максимальной величиной СТМР эффекта и минимальной коэрцитивностью свободного слоя, оптимизация геометрического фактора спин-туннельного перехода, линеаризация зависимости магнитосопротивления в области нуля.
Зависимость сопротивления СТП от магнитного поля в области нуля имеет гистерезисную петлю, обусловленную перемагничиванием свободного слоя СТМР наноструктуры при параллельной конфигурации свободного и фиксированного слоев. При ортогональной конфигурации намагниченности данных слоев зависимость магнитосопротивления СТП принимает линейный вид.
Существует ряд подходов для обеспечения ортогональной конфигурации намагниченности свободного и фиксированного слоев. Первый способ предполагает увеличение внутреннего размагничивающего поля свободного слоя за счет роста аспектного соотношения СТП, при котором размагничивающее поле превышает поле анизотропии, и передаточная характеристика принимает линейный вид. Наряду со снижением коэрцитивности свободного слоя увеличивается линейный диапазон и снижается коэффициент преобразования СТП [7].
При втором подходе свободный слой фиксируется антиферромагнитным слоем, и ортогональная конфигурация намагниченности слоев создается в результате двухэтапной термомагнитной обработки (ТМО). В процессе первой стадии ТМО задается направление намагниченности фиксированного слоя, во время второго этапа устанавливается ортогональное направление намагниченности свободного слоя, причем температура обработки второго этапа не должна превышать температуру блокировки антиферромагнетика фиксированного слоя [8].
Третий подход подразумевает снижение толщины свободного слоя до появления сверхпарамагнитных свойств в нем. В сверхтонкой структуре CoFeB/MgO/CoFeB (толщина CoFeB менее 1.5 нм) перпендикулярная анизотропия конкурирует с анизотропией в плоскости, что приводит к линейному виду характеристики в области нуля независимо от геометрической формы СТМР элемента [9].
Четвертый способ линеаризации заключается в интеграции постоянного магнита, создающего равномерное магнитное поле в области СТМР элемента для стабилизации намагниченности свободного слоя и создания ортогональной конфигурации намагниченности слоев. Изменяя геометрические размеры и положение постоянного магнита, можно прецизионно контролировать величину создаваемого им магнитного поля [10].
Модель когерентного вращения намагниченности свободного слоя позволяет оценить величину коэрцитивности свободного слоя и внешний вид характеристики при воздействии ортогонального магнитного поля и оптимально подобрать величину данного магнитного поля.
ЭКСПЕРИМЕНТАЛЬНЫЕ ИССЛЕДОВАНИЯ
Объектом исследования является СТП в форме эллипса, структура и состав которого представлены на рис. 1, и зависимость его сопротивления от внешнего магнитного поля.
Рис. 1.
Эскиз СТП со структурой вида Si/SiO2/Ta (100 Å)/CoFe (20 Å)/CoFeB (30 Å)/MgO (35 Å)/CoFeB (30 Å)/Ru (8.5 Å)/CoFe (20 Å)/FeMn (100 Å)/Ta (100 Å).

В состав СТП входит синтетическая антиферромагнитная структура, состоящая из двух противоположно намагниченных слоев (CoFe и CoFeB), связанных косвенным антиферромагнитным взаимодействием через слой рутения (Ru). Это позволяет исключить (или существенно уменьшить) влияние магнитостатического поля фиксирующего магнитного слоя на свободный слой СТП.
СТП сформирован в виде эллипса с полуосями a = 12 мкм и b = 6 мкм. Ось обменной (однонаправленной) анизотропии (ООА) между антиферромагнитным слоем (FeMn) и ферромагнитным слоем (CoFe) и ось легкого намагничивания (ОЛН) свободного слоя CoFeB направлены вдоль большей полуоси a эллипсов. Вдоль оси трудного намагничивания (вдоль полуоси b эллипсов) прикладывается постоянное магнитное поле ${{\vec {H}}_{ \bot }}.$
Вдоль ОЛН (вдоль полуоси a эллипсов) прикладывается переменное перемагничивающее поле ${{\vec {H}}_{0}},$ которое изменяет ориентацию вектора намагниченности $\vec {M}$ свободного слоя, т.е. угол φ между $\vec {M}$ и направлением оси координат X (рис. 2). Координатная ось X проведена в направлении ОЛН, как показано на рис. 2.
Рис. 2.
Ориентация свободного слоя, вектора намагниченности $\vec {M},$ напряженностей внешних магнитных полей ${{\vec {H}}_{0}}$ и ${{\vec {H}}_{ \bot }}$ относительно координатных осей.

На рис. 2 вектором ${{\vec {M}}_{2}}$ показано направление намагниченности в фиксирующем слое, которое ориентировано вдоль координатной оси X. При изменении ориентации вектора намагниченности свободного слоя $\vec {M}$ будет меняться сопротивление туннельного тока СТМР наноструктуры (ГМР сопротивление) по закону
На рис. 3 представлена экспериментальная зависимость сопротивления СТП Rm от величины внешнего поля H0 при изменении данного поля от –300 до 300 Э, обратный ход зависимости при изменении магнитного поля H0 от 300 до –300 Э изображен сплошной кривой без меток. На рис. 3 представлены две зависимости R(H): при H⊥ = 0 и H⊥ = 10 Э.
Рис. 3.
Экспериментальная зависимость сопротивления от Rm перемагничивающего поля H0 при H⊥ = 0 (темно-красная кривая) и H⊥ = 10 Э (оранжевая кривая).

При воздействии постоянного магнитного поля H⊥ = 10 Э происходит существенное уменьшение ширины петли перемагничивания свободного слоя.
Теория равновесного состояния намагниченности в рамках модели когерентного вращения намагниченности свободного слоя
В рамках модели когерентного вращения намагниченности $\vec {M}$ свободного слоя СТП, изображенного на рис. 2, плотность магнитной энергии w будет равна
(2)
$\begin{gathered} w = \frac{1}{2}{{H}_{{{\text{an}}}}}M{{\sin }^{2}}{\kern 1pt} \varphi - (\vec {M} \cdot {{{\vec {H}}}_{0}}) - \\ - \,\,(\vec {M} \cdot {{{\vec {H}}}_{ \bot }}) + {{w}_{m}} + {{w}_{c}}. \\ \end{gathered} $Полагая, что свободный слой имеет форму сильно сплюснутого вдоль оси Z эллипсоида с полуосью равной c, для проекций размагничивающего поля на оси координат будем иметь
(4)
$\begin{gathered} {{H}_{{m,x}}} = - 4\pi {{n}^{{(x)}}}{{M}_{x}},\,\,\,\,{{H}_{{m,x = y}}} = - 4\pi {{n}^{{(y)}}}{{M}_{y}}, \\ {{H}_{{m,z}}} = - 4\pi {{n}^{{(z)}}}{{M}_{z}}, \\ \end{gathered} $(5)
$\begin{gathered} {{n}^{{(x)}}} = \frac{{abc}}{2}\int\limits_0^\infty {\frac{{{\text{d}}t}}{{({{a}^{2}} + t)R(t)}}} ,\,\,\,\,{{n}^{{(y)}}} = \frac{{abc}}{2}\int\limits_0^\infty {\frac{{{\text{d}}t}}{{({{b}^{2}} + t)R(t)}}} ,\, \\ {{n}^{{(z)}}} = \frac{{abc}}{2}\int\limits_0^\infty {\frac{{{\text{d}}t}}{{({{c}^{2}} + t)R(t)}}} , \\ \end{gathered} $Плотность магнитостатической энергии связи с фиксирующим слоем wc определяется выражением:
где ${{\vec {H}}_{c}}$ – напряженность магнитного поля, обусловленная намагниченностью ${{\vec {M}}_{2}}$ фиксируемого слоя. В соответствии с рис. 2 для величины этого поля приближенно будем иметьУчитывая, что фиксирующий слой представляет собой синтетический антиферромагнетик, состоящий из двух почти одинаковых слоев с противоположной ориентацией намагниченности, в первом приближении будем пренебрегать энергией связи wc.
Принимая во внимание выражения (2)–(6) и проектируя все векторные величины на координатные оси, ориентированные согласно рис. 2, несложно выразить плотность магнитной энергии (2) через полярный угол φ
(9)
$\begin{gathered} w = \frac{1}{2}{{{\tilde {H}}}_{{{\text{an}}}}}M{\kern 1pt} {{\sin }^{2}}{\kern 1pt} \varphi + {{H}_{0}}M{\kern 1pt} \cos {\kern 1pt} \varphi - \\ - \,\,{{H}_{ \bot }}M{\kern 1pt} \sin {\kern 1pt} \varphi + 2\pi {{n}^{{(x)}}}{{M}^{2}}, \\ \end{gathered} $(10)
${{\tilde {Н}}_{{{\text{an}}}}} = {{H}_{{{\text{an}}}}} + 4\pi M({{n}^{{(y)}}} - {{n}^{{(x)}}}),$Угол φ локальной равновесной ориентации вектора намагниченности свободного слоя $\vec {M},$ будет определяться минимумом функции (9), т.е. корнями уравнения
(11)
$\begin{gathered} \frac{{\partial ({w \mathord{\left/ {\vphantom {w M}} \right. \kern-0em} M})}}{{\partial \varphi }} = {{{\tilde {H}}}_{{{\text{an}}}}}\sin {\kern 1pt} \varphi \cos {\kern 1pt} \varphi - \\ - \,{{H}_{0}}\sin {\kern 1pt} \varphi - {{H}_{ \bot }}\cos {\kern 1pt} \varphi = 0. \\ \end{gathered} $Магнитная энергия (2) может иметь два локальных минимума, соответствующих двум устойчивым ориентациям вектора намагниченности $\vec {M}.$ При определенных значениях напряженностей внешнего магнитного поля H⊥ и H0 функция (9) будет иметь только один минимум. Кривая инверсии (кривая инверсии Стонера-Вольфарта), определяющая переход от состояния с двумя минимумами энергии к состоянию с одним минимумом, определяется из условия равенства нулю первых двух производных по углу φ плотности энергии (9), т.е. уравнения (11) и уравнения
(12)
$\frac{{{{\partial }^{2}}({w \mathord{\left/ {\vphantom {w M}} \right. \kern-0em} M})}}{{\partial {{\varphi }^{2}}}} = {{\tilde {H}}_{{{\text{an}}}}}{\kern 1pt} \cos {\kern 1pt} 2\varphi - {{H}_{0}}{\kern 1pt} \cos {\kern 1pt} \varphi + {{H}_{ \bot }}{\kern 1pt} \sin {\kern 1pt} \varphi = 0.$Из уравнений (11) и (12) несложно получить значение критического угла инверсии φu, при превышении которого ориентация вектора намагниченности $\vec {M}$ скачком переходит в другое устойчивое состояние
(13)
$\sin {\kern 1pt} {{\varphi }_{{\text{u}}}} = {{\left( {\frac{{{{H}_{ \bot }}}}{{{{{\tilde {H}}}_{{{\text{an}}}}}}}} \right)}^{{{1 \mathord{\left/ {\vphantom {1 3}} \right. \kern-0em} 3}}}}.$Соответственно, значение внешнего поля H0, u, при котором происходит скачок ориентации вектора намагниченности $\vec {M},$ будет равно
(14)
${{H}_{{0,{\text{u}}}}} = {{\cos }^{3}}{\kern 1pt} {{\varphi }_{{\text{u}}}}{{\tilde {H}}_{{{\text{an}}}}} = {{\left( {1 - {{{\left( {\frac{{{{H}_{ \bot }}}}{{{{{\tilde {H}}}_{{{\text{an}}}}}}}} \right)}}^{{{2 \mathord{\left/ {\vphantom {2 3}} \right. \kern-0em} 3}}}}} \right)}^{{{3 \mathord{\left/ {\vphantom {3 2}} \right. \kern-0em} 2}}}}{{\tilde {H}}_{{{\text{an}}}}}.$Таким образом, при прямом и обратном перемагничивании свободного слоя происходит скачок ориентации вектора намагниченности $\vec {M}$ от одной равновесной кривой к другой.
Это приводит к гистерезису ГМР сопротивления (1) при перемагничивании свободного слоя (рис. 3). Ширина этого гистерезиса равна 2H0,u. Если H⊥ = 0, то ширина гистерезиса наибольшая и равна $2{{\tilde {H}}_{{{\text{an}}}}}.$
Проведем расчет зависимости магнитосопротивления СТП на основе рассмотренной теории Стонера-Вольфрата. Свободный слой СТП (рис. 1) состоит из пленки Co40Fe40B20 толщиной 3 нм и обменно-связанного с ним слоя Co95Fe5 толщиной 2 нм. Намагниченность первого слоя согласно литературным данным [11] равна 4πM = 1.1 × × 104 Гс, намагниченность второго слоя толщиной 2 нм оценим по процентному составу намагниченности насыщения входящих в него элементов, в результате получим 4πM = 1.27 × 104 Гс. Для среднего значения 4πM составного свободного слоя толщиной 5 нм возьмем среднее значение, пропорциональное их толщинам
(15)
$4\pi M = \left( {\frac{3}{5}1.1 + \frac{2}{5}1.27} \right) \times {{10}^{4}}\,\,{\text{Гс}} = 1.17 \times {{10}^{4}}\,\,{\text{Гс}}.$Размагничивающие коэффициенты для a = = 12 мкм, b = 6 мкм, c = 2.5 нм согласно выражению (5) равны
Соответственно, для поля анизотропии формы, получим
Согласно экспериментальным измерениям (рис. 3) ширина гистерезиса при H⊥ = 0 равна
Тогда, согласно (10) для эффективного поля одноосной анизотропии Han, получим
(19)
$\begin{gathered} {{H}_{{{\text{an}}}}} = {{{\tilde {H}}}_{{{\text{an}}}}} - 4\pi M({{n}^{{(y)}}} - {{n}^{{(x)}}}) = \\ = {\text{16}}\,\,{\text{Э}} - {\text{2}}{\text{.83}}\,\,{\text{Гс}} = {\text{13}}{\text{.17}}\,\,{\text{Э}}. \\ \end{gathered} $При наличии поля H⊥ = 10 Э экспериментальная ширина гистерезиса уменьшится (рис. 3) и будет равна
Теоретическая ширина гистерезиса 2H0,u, рассчитанная по формуле (14) при Han, равному полученному значению (19), будет равна
что в 1.3 раза меньше экспериментального значения.Для выявления специфических особенностей перемагничивания свободного слоя на образце была проведена дополнительная серия измерений зависимости Rm(H) при значениях H⊥ от 0 до 12 Э с шагом 2 Э. На рис. 4 представлены кривые зависимости Rm при изменении внешнего поля H0 от –150 до 150 Э, обратный ход зависимости при изменении магнитного поля H0 от 150 до –150 Э изображен сплошной кривой без меток.
Рис. 4.
Зависимости Rm от H0 при воздействии Н⊥ от 0 до 12 Э с шагом 2 Э: темно-красная кривая Н⊥ = 0 Э, зеленая кривая Н⊥ = 2 Э, синяя кривая Н⊥ = 4 Э, фиолетовая кривая Н⊥ = 6 Э, голубая кривая Н⊥ = 8 Э, оранжевая кривая Н⊥ = 10 Э, черная кривая Н⊥ = 12 Э.
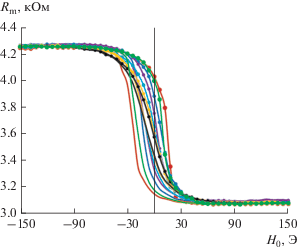
В табл. 1 представлены экспериментальные и расчетные значения ширины гистерезиса ΔHэксп на половине высоты изменения сопротивления Rm.
Таблица 1.
Зависимость ширины гистерезиса Rm от поля H⊥
| H⊥, Э | 0 | 2 | 4 | 6 | 8 | 10 | 12 |
| ΔHэксп, Э | 37 | 27 | 21 | 12.5 | 9.5 | 7 | 5.5 |
| 2Han, Э | 37.45 | 25.55 | 19.29 | 14.52 | 10.66 | 7.48 | 4.87 |
Для данной серии измерений Han согласно (19) будет составлять
(22)
$\begin{gathered} {{H}_{{{\text{an}}}}} = {{{\tilde {H}}}_{{{\text{an}}}}} - 4\pi M({{n}^{{(y)}}} - {{n}^{{(x)}}}) = \\ {\text{ = }}\,\,{\text{18}}{\text{.5}}\,\, - \,\,{\text{2}}{\text{.83}}\,\,{\text{Гс}} = {\text{15}}{\text{.67}}\,\,{\text{Э}}. \\ \end{gathered} $Для более точной аппроксимации Han было подобрано таким образом, чтобы теоретическая кривая (14) имела наименьшее квадратичное отклонение от всех экспериментальных точек табл. 1. В этом случае наилучшее приближение получалось при
В табл. 1 в третьей строке приведены значения теоретической ширины гистерезиса 2Han, посчитанные по формуле (14) при значении Han = 15.89 Э и $4\pi M({{n}^{{(y)}}} - {{n}^{{(x)}}})$ = 2.83 Гс. На рис. 5 приведен теоретический график зависимости ширины гистерезиса 2Han от H⊥ (сплошная линия) и экспериментальные значения в соответствии с табл. 1.
Рис. 5.
Теоретическая зависимость ширины гистерезиса $2{{\tilde {H}}_{{{\text{an}}}}}$ от H⊥ (сплошная линия) и экспериментальные значения (точки).

В рамках рассмотренной теории построим кривые зависимости сопротивления Rm СТП от внешнего магнитного поля. Согласно формуле (1) это сопротивление определяется равновесным значением cos φ. Значение cos φ определяется уравнением (11), которое можно представить в следующем виде
(24)
$\begin{gathered} {{{\tilde {H}}}_{{{\text{an}}}}}\sqrt {1 - {{{\cos }}^{2}}{\kern 1pt} \varphi } \cos {\kern 1pt} \varphi - \\ - \,\,{{H}_{0}}\sqrt {1 - {{{\cos }}^{2}}{\kern 1pt} \varphi } - {{H}_{ \bot }}\cos {\kern 1pt} \varphi = 0. \\ \end{gathered} $Это уравнение относительно cosφ можно преобразовать в полином 4-го порядка, которое имеет громоздкие аналитические решения. Используя их или непосредственное численное решение уравнения (24), можно получить следующие теоретические кривые для зависимости сопротивления Rm от внешнего поля H0. На рис. 6 представлена такая теоретическая зависимость при H⊥ = 0. Теоретическая кривая построена при Han = 14.5 Э в соответствие с экспериментальными результатами на рис. 3. На рис. 7 представлена теоретическая зависимость Rm от внешнего поля H0 при H⊥ = 10 Э.
Рис. 6.
Зависимость сопротивления Rm от внешнего поля ${{\vec {H}}_{0}}$ при H⊥ = 0 (синяя кривая) и экспериментальные значения (голубая кривая).
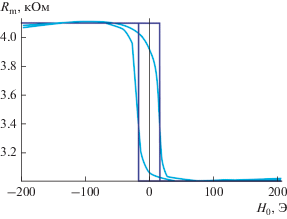
Рис. 7.
Зависимость сопротивления Rm от внешнего поля ${{\vec {H}}_{0}}$ при H⊥ = 10 Э (синяя кривая) и экспериментальные значения (голубая кривая).
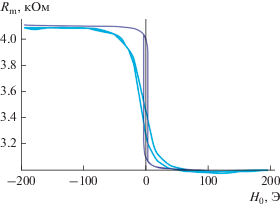
Из результатов рис. 6 и 7 следует, что рассмотренная теория приближенно соответствует экспериментальным результатам. Величины теоретического и экспериментального гистерезиса близки. Однако, перемагничивание свободного слоя происходит не так резко как предсказывает теория, особенно при достаточно больших значениях H⊥ (рис. 7). Этот факт, возможно, свидетельствует о наличии неоднородного механизма перемагничивания свободного слоя [12].
ЗАКЛЮЧЕНИЕ
Получены теоретические зависимости перемагничивания СТП элемента эллиптической формы при различных значениях магнитного поля, перпендикулярного внешнему магнитному полю. Результаты экспериментальных исследований и теоретические значения, полученные в рамках модели когерентного вращения намагниченности свободного слоя, имеют близкое совпадение, что позволяет достаточно точно описывать процесс перемагничивания СТМР элемента.
На основе полученных моделей перемагничивания свободного слоя при воздействии постоянного магнитного поля, направленного ортогонально измерительному полю, представляется возможным спрогнозировать ширину гистерезиса, наклон характеристики в области малых магнитных полей и подобрать оптимальное значение ортогонального магнитного поля, которое определяет геометрические размеры постоянного магнита и его остаточную намагниченность.
Список литературы
Pannetier M., Fermon C., Le Goff G., Simola J., Kerr E. Femtotesla magnetic field measurement withmagnetoresistive sensors // Science. 2004. V. 304. № 5677. P. 1648–1650.
Amaral J., Cardoso S., Freitas P.P., Sebastiao A.M. Toward a system to measure action potential on micebrain slices with local magnetoresistive probes // J. Applied Physics. 2011. V. 109. № 7. P. 07B308.
Amaral J., Pinto V., Costa T., Gaspar J., Ferreira R., Paz E., Cardoso S., Freitas P. Integration of TMRsensors in silicon microneedles for magnetic measurements of neurons // Magnetics, IEEE Transactions on. 2013. V. 49. P. 3512–3515.
Lopes A., Cardoso S., Ferreira R., Paz E., Deepak F., Sanchez J., Ramirez D., Ravelo S., Freitas P. Mg Omagnetic tunnel junction electrical current sensor with integrated Ru thermal sensor // Magnetics, IEEE Transactions on. 2013. V. 49. P. 3866–3869.
Cardoso F.A., Rosado L., Ferreira R., Paz E., Cardoso S., Ramos P.M., Piedade M., Freitas P.P. Magnetic tunnel junction based eddy current testing probe for detection of surface defects // J. Applied Physics. 2014. V. 115. № 17. P. 17E516.
Freitas P.P., Cardoso F.A., Martins V.C., Martins S.A.M., Loureiro J., Amaral J., Chaves R.C., Cardoso S., Fonseca L.P., Sebastiao A.M., Pannetier-Lecoeur M., Fermon C. Spintronic platforms for biomedical applications // Lab on a Chip. 2012. V. 12. P. 546–557.
Freitas P.P., Ferreira R., Cardoso S., Cardoso F. Magnetoresistive sensors // J. Physics: Condensed Matter. 2007. V. 19. № 16. P. 165221.
Negulescu B., Lacour D., Montaigne F., Gerken A., Paul J., Spetter V., Marien J., Duret C., Hehn M. Wide range and tunable linear magnetic tunnel junctionsensor using two exchange pinned electrodes // Applied Physics Letters. 2009. V. 95. № 11. P. 112502.
Skowronski W., Wisniowski P., Stobiecki T., Cardoso S., Freitas P.P., Dijken S. Magnetic field sensorwith voltage-tunable sensing properties // Applied Physics Letters. 2012. V. 101. № 19. P. 192401.
Chaves R.C., Cardoso S., Ferreira R., Freitas P.P. Low aspect ratio micron size tunnel magnetoresistance sensors with permanent magnet biasing integrated in the top lead // J. Applied Physics. 2011. V. 109. № 7. P. 07E506.
Choi G.-M. Exchange stiffness and damping constants of spin waves in CoFeB films // J. Magnetism and Magnetic Materials. 2020. V. 516. P. 167335.
Шевцов В.С., Поляков О.П., Амеличев В.В., Касаткин С.И., Поляков П.А. Вестник Московского университета. Серия 3: Физика, астрономия. 2019. № 5. С. 40–44.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника


