Микроэлектроника, 2019, T. 48, № 6, стр. 403-420
Создание и развитие ионно-лучевых технологий
Ю. П. Маишев *
Физико-технологический институт им. К.А. Валиева Российской академии наук,
117218 Москва, Нахимовский проспект, 36, корп. 1, Россия
* E-mail: maishev@ftian.ru
Поступила в редакцию 05.03.2019
После доработки 03.04.2019
Принята к публикации 12.04.2019
Аннотация
Представлен обзор развития отечественных ионно-лучевых технологий. Показано, что широкому применению ИЛТ способствовало: создание метода компенсации положительного объемного заряда внутри ускоряющего промежутка источника ионов отрицательным объемным зарядом электронов, удерживаемых в скрещенных электрическом и магнитном полях, что позволило повысить плотность отбираемого ионного тока в десятки раз сверх ограничений, накладываемых законом Чайльда–Ленгмюра; разработка оригинальных источников ионов с холодным катодом, формирующих пучки практически из любых соединений; создание метода реактивного ионно-лучевого травления, обладающего прецизионностью травления пучками ионов инертных газов и селективностью жидкостного травления. На основе этих достижений был разработан ряд модификаций источников ионов и технологического оборудования для применения в производстве изделий микро- и наноэлектроники, оптики, пьезокварцевой техники, в медицине и других областях промышленности. Показаны пути совершенствования ИЛТ путем создания источников быстрых нейтральных частиц и технологий с их применением.
Исследования и разработки мощных источников ионов в конце 50-х годов прошлого столетия было продиктовано появлением таких научных и технических направлений как термоядерный синтез, ракетные ионные двигатели, сепараторы ионов, линейные ускорители. Во главе этих разработок стояли такие ученые как А.И. Морозов, Н.Н. Семашко, М.Д. Габович, Р.А. Демирханов, Н.В. Плешивцев и др.
В НИИ вакуумной техники (НИИВТ) работы по созданию мощного инжектора ионов специального назначения возглавил Г.А. Ковальский. Основная задача при разработке этих источников состояла в повышении интенсивности пучков ионов, плотность тока которых, как и в источниках электронов, ограничивалась законом Чайльда–Ленгмюра (закон “3/2”). Для решения этой проблемы нами в 1965 году был предложен и экспериментально проверен метод компенсации положительного пространственного заряда пучка ионов пространственным зарядом электронов, удерживаемых в скрещенных электрическом и магнитном полях внутри ускоряющего промежутка размером порядка одного ларморовского радиуса электрона [1, 2]. При такой величине напряженности магнитного поля его влияние на траекторию ионов, особенно ионов с большой массой, практически отсутствует.
Схема компенсации положительного пространственного заряда представлена на рис. 1. Видно, что при H = Hкр поток электронов, выходящих с катода, не достигает анода и ток в промежутке анод–катод равен нулю, а отрицательный пространственный заряд у поверхности анода (эмиттер ионов) максимален. Если изменять величину магнитного поля в промежутке анод–катод по специальному закону, то теоретически можно добиться полной компенсации положительного пространственного заряда пространственным зарядом электронов и ограничение законом “3/2” снимается. Закон Чайльда–Ленгмюра
Рис. 1.
Схемы компенсации положительного пространственного заряда отрицательным пространственным зарядом в промежутке “анод (граница плазмы)–катод (ускоряющий электрод)” и распределение плотности пространственного заряда электронов ρe и ионов ρi в промежутке “анод–катод” в относительных единицах (а) – H = 0; (б) – H = Hкр; (в) – H = f(x/d).

Экспериментальные исследования показали возможность увеличения плотности тока пучка ионов ji за счет компенсации в десятки раз, о чем нами было доложено в 1965 г. на научной конференции в Институте атомной энергии, проводимой под председательством А.И. Морозова.
В конце 60-х годов быстрое развитие микроэлектроники вызвало необходимость замены жидкостных изотропных процессов на анизотропные “сухие” процессы с высокой прецизионностью и контролем. Эти требования мог обеспечить метод ионно-лучевого травления структур через резистивные маски. Для его реализации необходимо было создать источники ионов, обеспечивающие необходимую энергию ионов, состав пучка и его интенсивность. В источниках ионов, разрабатываемых для технологических процессов, в соответствии с законом “3/2” ji ограничивается энергией ионов eU, повышение которой может привести к деградации обрабатываемой поверхности, и значительной массой ионов, превышающей обычно 40 единиц массы (ионы инертных газов, сложных соединений). Поэтому для получения плотности тока пучка ионов, приемлемой для промышленных технологий, был использован метод компенсации.
В 1965–1970 годах был создан метод увеличения интенсивности пучка ионов сверх ограничений законом Чайльда–Ленгмюра, а также разработаны на основе метода компенсации источники “Луч”, формирующие моноэнергетические пучки ионов инертных газов (табл. 1, рис. 2) [3–6]. Моноэнергетичность пучка обусловлена отбором ионов с границы плазмы, сформированной в кольцевом отверстии газоразрядной камеры. Поток электронов, формирующих отрицательный пространственный заряд внутри ускоряющего промежутка, поступает из “пучковой” плазмы, образующейся при распространении пучка.
Таблица 1.
Параметры источников ионов аргона
| Параметры | “Луч” | “Луч-1” | “Луч-2” | “Луч-3” | “Луч-4” | “Луч-Р” |
|---|---|---|---|---|---|---|
| Год разработки | 1968 | 1969 | 1973 | 1974 | 1976 | 1976 |
| Энергия ионов, кэВ | 1–10 | 0.5–3 | 1–10 | 0.5–5 | 0.5–5 | 3 |
| Ток ионного пучка, мА | 20–100 | 15–75 | 20–130 | 100–300 | 215–700 | 800 |
| Плотность отбираемого ионного тока, мА/см2 | 4–13 | 3–15 | 5–35 | 15–50 | 20–60 | 50 |
| Ток разряда, А | 20 | 10 | 20 | 25 | 35 | 30 |
| Напряжение на разряде, В | 50 | 50 | 50 | 50 | 50 | 35 |
| Размеры выходного канала, мм | 35 × 5 | 53 × 3 | 40 × 3 | 67 × 3 | 123 × 3 | 160 × 3 |
| Габаритные размеры источника | ||||||
| длина, мм | 260 | 150 | 130 | 130 | 130 | 120 |
| диаметр, мм | 270 | 150 | 200 | 210 | 240 | 160 |
| Тип оборудования | ЖК2.003.000 | УРМ3.279.029 | УНП | УРМ3.279.036 УРМ3.279.038 УРМ3.279.041 |
Опытный образец | Опытный образец |
Рис. 2.
Источники “Луч”: 1 – анод; 2 – катод; 3 – корпус разрядной камеры; 4 – канал напуска газа; 5 – корпус источника; 6 – соленоид; 7 – ускоряющий электрод; 8 – магнитопровод; 9 – катод нейтрализации.

Первая отечественная установка ионно-лучевого распыления (ЖК2.003.000) была создана в 1968 г. с участием НИИ “Пульсар” (нач. отдела Ю.П. Докучаев) и НИИВТ в части источника “Луч”. В 1969 году на машиностроительном заводе в г. Калининграде (нач. отдела Ю.П. Терентьев) была разработана и изготовлена первая серийная установка ионно-лучевого травления УРМ3.279.029.
В 1970 году в связи с реорганизацией отдела Г.А. Ковальского группа сотрудников отдела (Ю.П. Маишев, Ю.А. Дмитриев, Б.А. Егоров, Е.А. Жуков, и Т.А. Смирнова), разрабатывающая источники ионов и ионно-лучевые технологии, перешла в лабораторию Г.Ф. Ивановского.
В 1971 г. была решена проблема создания бездефектных фотошаблонов путем создания полупрозрачных фотошаблонов. Маскирующий слой (окислы железа) наносился методом реактивного ионно-плазменного распыления железа в среде кислорода устройством с инжекцией плазмы в вакуум “Поток” [7–9]. Ионно-лучевая технология использовалась для травления маскирующего слоя фотошаблона. В 1972 г. был поставлен комплект установок с источниками ионов “Луч” (УРМ3.279.029) и с устройствами ионно-плазменного распыления “Поток” (УРМ3.279.026) для изготовления фотошаблонов в производственном объединении ЛОЭП “Светлана” (нач. отдела В.П. Зубрицкий) [10].
В 1973 г. на коллегии министерства электронной промышленности СССР было доложено о получении впервые в мире структур с размером 0.3 мкм методом ИЛТ (фотопечать выполнялась в НИИ “Пульсар”, ионно-лучевое травление источником “Луч” – в НИИВТ) и создании впервые в мире нового метода реактивно-лучевого травления (РИЛТ) пучками ионов химически активных веществ [11–13]. За рубежом метод РИЛТ появился лишь через пять лет (рис. 3, 4).
Рис. 3.
Фотографии из технической рекламы фирмы “Сименс” (слева – химическое травление; справа – травление ионами аргона (1976 год, лабораторная проба)).
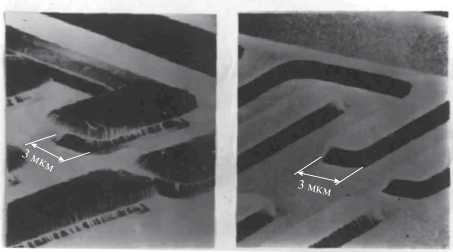
Рис. 4.
Ионно-лучевое травление по технологии НИИВТ (слева – травление ионами хладона – СВЧ-транзистор “Причал” НИИВТ и ПТО “Электроника”, 1975‑1976 годы, промышленный образец; справа – травление ионами аргона, НИИВТ и “Пульсар”, 1973 год, лабораторная проба) [14].
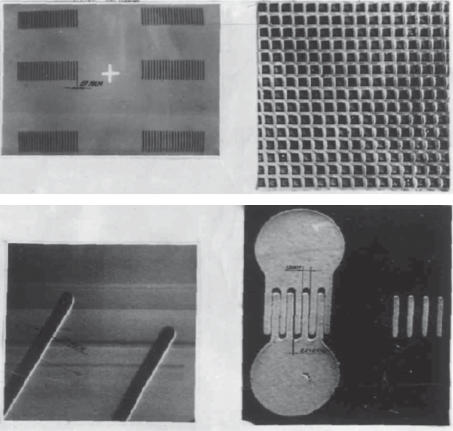
Суть метода РИЛТ состояла в том, что электроны, удерживаемые в скрещенных электрическом и магнитном полях и дрейфующие внутри ускоряющего промежутка, осуществляли как ионизацию рабочего вещества, так и компенсацию положительного пространственного заряда пучка. Высокая энергия электронов и отсутствие накаленных элементов позволяет осуществлять ионизацию практически любых веществ, включая химически активных [15–17].
Схема ускоряющего промежутка источника представлена на рис. 5. Критерии для источников ионов с холодным катодом и замкнутым дрейфом электронов:
Рис. 5.
Сечение ускоряющего промежутка источника (1 – анод; 2 – катод из магнито-мягкого материала (ускоряющий электрод); 3 – отверстие для выхода ионного пучка; 4 – силовые линии магнитного поля; 5 – эквипотенциали; (а) – силовые линии магнитного поля; (б) – конфигурация эквипотенциалей).

Движение электронов в скрещенных электрическом и магнитном полях осуществляется со скоростью дрейфа
где E – напряженность электрического поля; B – магнитная индукция; c – скорость света. Движение электрона вдоль магнитных силовых линий в линзообразном магнитном поле описывается выражениемДля практической реализации метода РИЛТ были разработаны источники ионов с холодным катодом, получившим название “Радикал” (табл. 2, рис. 6) [16–28].
Таблица 2.
Параметры многопучковых источников ионов “Радикал-М”
| Источник ионов | Радикал М-100 | Радикал М-160 | Радикал М-200 | Радикал М-300 | Радикал М-450 |
|---|---|---|---|---|---|
| Диаметр пучка ионов, мм | 100 | 160 | 200 | 300 | 450 |
| Плотность тока пучка, мА/см2 | 7 | 2.5 | 2.5 | 1.5 | 1.0 |
| Энергия ионов пучка, эВ | 300–1000 | 300–1000 | 150–1000 | 150–1000 | 150–1000 |
| Диаметр области равномерности, мм | 80 | 100 | 170 | 220 | 350 |
Рис. 6.
(а) Источник ионов химически активных веществ “Радикал” [15]; (б) источник ионов с ленточным протяженным пучком (энергия 1–2.5 кэВ; ток пучка ионов 0.1–2 А; ширина пучка 200–2000 мм) [23, 24]; (в) многопучковые источники ионов “Радикал М-100”, “Радикал М-200”,”Радикал М-450”, [16, 21, 22, 25–27]; (г) источники ионов с радиально-расходящимся пучком “Радикал-Р” (ток пучка ионов 5 А; энергия пучка ионов 100–2500 эВ; зона равномерности 3000 см2) [18, 24, 28]; (д) источник ионов для нанесения пленок ионно-лучевым распылением “Холодок-1” со сходящимся пучком ионов [21, 22, 24].

В 1974 году министру электронной промышленности СССР А.И. Шокину был представлен отчет по результатам внедрения ионно-лучевых и ионно-плазменных процессов и о перспективах их использования (копии были разосланы в 50 предприятий МЭП). Авторами отчета были В.К. Попов (директор), В.В. Иванов (главный инженер), Г.Ф. Ивановский, Ю.П. Маишев. В том же году появился приказ министра, который содержал следующие пункты:
• создать НПО “Вакууммашприбор” в составе: НИИВТ – головной институт, ПО “Кварц” – оборудование ИЛТ, завод “Токамак” – источники ионов и блоки питания к ним;
• организовать в НИИВТ головной в министерстве отдел ионно-лучевой и ионно-плазменной техники;
• разработать программу “Плазма–Ион”;
• организовать на заводе “Токамак” серийный выпуск источников ионов “Радикал” с блоками питания;
• организовать отраслевую лабораторию по диагностике плазмы на базе Харьковского университета (1975–1976 гг.);
• организовать проведение раз в два года научно-технических конференций “Тонкие пленки в производстве полупроводниковых приборов и интегральных схем”;
• работы по данной тематике не публиковать в открытой печати.
Руководителем программы “Плазма–Ион” был назначен Г.Ф. Ивановский, а заместителем руководителя – Ю.П. Маишев. Широкое внедрение в производство ионно-плазменных и ионно-лучевых процессов, а также регулярное проведение научных конференций (их прошло 6) способствовали созданию активных творческих групп: в НИИВТ (Г.Ф. Ивановский, Ю.П. Маишев, Ю.А. Дмитриев, Е.А. Жуков, А.Ф. Васильев, А.В. Алексеев, Б.А. Егоров, В.И. Петров, Т.А. Смирнова, В.В. Слепцов), НИИ “Сапфир” (Ю.М. Золотарев, В.А. Кальнов), НИИ “Пульсар” (В.М. Сутырин, С.А. Иноземцев, С.М. Щербина), ЛОЭП “Светлана” (В. Зубрицкий, В.И. Минаков), НИИМЭ (Д.И. Ломоносов, Е.Ф. Шелыхманов, О.П. Гущин, А.С. Валеев), ПО “Кварц” (Ю.П. Терентьев, Э.А. Немкин), ХГУ (В.И. Фареник, А.В. Зыков, А.И. Бизюков), НПО “Элма” (Б.Г. Грибов, Д.Д. Спиваков), МИЭТ (Ю.Д. Чистяков, А.И. Мочалов), НИИТМ (В.И. Иванов, В.Е. Минайчев, В.В. Одиноков), НИИПМ (Н.Н. Федоров, Э.А. Лебедев), ВНИИМЭТ (В.Г. Козленко, М.А. Парфененок), ПО “Интеграл” (В.И. Гранько), ПО “Электроника” (И.Е. Лобов, Н.П. Бутырин) и др.
Благодаря исследованиям этих коллективов были созданы и внедрены в производство различные методы ионно-лучевой обработки (рис. 7). В 1974 г. впервые были предложены и реализованы в оборудовании методы очистки и активации поверхности подложек с последующим или одновременным нанесением пленок в едином вакуумном цикле [17], предвосхитившие создание кластерного оборудования.
Рис. 7.
Методы ионно-лучевой обработки (1 – источник ионов; 2 – подложка; 3 – мишень; 4 – испаритель).

Принцип ионно-лучевой обработки заключается в том, что рабочее вещество подается в автономный источник ионов, в котором происходит его ионизация, ускорение ионов до требуемой энергии и формирование направленного пучка ионов. Энергия ионов регулируется в зависимости от технологического процесса. Ускоренные ионы попадают в технологическую камеру без столкновений с остаточным газом и взаимодействуют с поверхностью обрабатываемого объекта, вызывая либо распыление материала (ионы аргона), либо образование летучих соединений (ионы химически активных веществ), либо осаждение материала (углеводороды, кремнийорганические материалы). На обрабатываемой поверхности происходят следующие процессы: нейтрализация пучка ионов с образованием газового потока, удаление материала в результате физического распыления или химического взаимодействия ионов с материалом подложки (табл. 3).
Таблица 3.
Технологические возможности ионно-лучевого травления
| Обрабатываемые материалы | Диэлектрики (SiO2, Si3N4, ФСС и др.), полупроводники (Si, GaAs и др.), металлы и сплавы (Cu, Au, Ti, W, AlCu, NiFe и др.) |
|---|---|
| Разрешающая способность, мкм | <0.1 |
| Скорость травления, нм/с: | |
| – двуокиси кремния | ≤14 |
| – металлов, полупроводников | ≤2–3 |
| Селективность травления: | |
| – SiO2 : Si | (15–20) : 1 |
| – SiO2 : GaAs | (10–12) : 1 |
| Неоднородность травления пластин диаметром до 350 мм, % | ≤±5 |
| Глубина травления кварца, мкм | ≤50 |
Отметим, что пучком ионов можно не только удалять материал с подложки, но и осаждать различные материалы, например, алмазоподобные пленки, оксиды, нитриды и карбиды кремния. Для этих процессов в качестве рабочих веществ используются различные углеводороды, кремнийорганические материалы и другие летучие в вакууме соединения [29–31]. Важнейшей особенностью метода осаждения материалов из пучков ионов является возможность контролируемого управления энергией осаждаемых частиц, а следовательно, и электрофизическими свойствами осаждаемых пленок.
Достоинства ионно-лучевых технологий:
• высокая направленность воздействия, обеспечивающая прецизионность; возможность получения вертикальных ступенек при травлении через маску; отсутствие ухода размеров элементов;
• возможность формирования пучков ионов как инертных, так и химически активных газов;
• возможность управления энергией ионов в широких пределах;
• возможность управления зарядом на обрабатываемой поверхности независимо от параметров пучка ионов;
• высокая однородность и воспроизводимость обработки.
В октябре 1977 года (как отмечалось в поздравлении министра электронной промышленности СССР А.И. Шокина) НИИВТ, НИИМЭ и заводу “Микрон” впервые в мире удалось замкнуть “сухой” цикл изготовления ИС “Логика”, содержащих около 200 элементов на кристалле (рис. 8). Были исключены все жидкостные операции, кроме фотопечати. Это позволило:
Рис. 8.
Цикл изготовления ИС “Логика” (окружностями обозначены операции реактивного ионно-лучевого травления).

• сократить число технологических операций с 84 до 40;
• уменьшить потребление химреактивов в сотни раз;
• исключить агрессивные реактивы (плавиковую, азотную, серную кислоты и др.).
Ионно-лучевые технологии нашли широкое применение не только в микроэлектронике, но и в других отраслях промышленности:
• микроэлектроника – травление пленок в производстве СБИС, СБИС ЗУ на ЦМД, ССИС, СВЧ-транзисторов, фотошаблонов;
• оптика – полировка поверхностей, травление элементов безаберрационной дифракционной оптики и магнитооптических дисков;
• пьезокварцевая техника – настройка частоты кварцевых резонаторов, утонение кварцевых пластин;
• матрицы ПЗС для приборов ночного видения – очистка и травление пленок;
• жесткие магнитные диски – очистка подложек и нанесение пленок;
• акустоэлектроника – травление материалов в производстве приборов, выполненных на поверхностных акустических волнах;
• лазерная техника – травление материалов для твердотельных лазеров;
• резисторостроение – подгонка номиналов прецизионных резисторов;
• теплозащитные, зеркальные и декоративные стекла – очистка и активация поверхности, реактивное нанесение пленок;
• машиностроение – нанесение защитных и упрочняющих алмазоподобных пленок.
Перечислим некоторые результаты, полученные только с помощью ионно-лучевых технологий. Оптика (1975–1976 гг.):
• безаберрационная дифракционная оптика – ЛОМО, ЛОЭП “Светлана” для космических аппаратов;
• асимметричная дифракционная решетка с шагом 0.3 мкм и шириной клинообразной канавки 0.15 мкм – ИОФАН (А.М. Прохоров).
Пьезотехника (НПО “Фонон”, 1975–1977 гг.):
• утонение кварца для кварцевых резонаторов с помощью травления с 50 до 2 мкм с сохранением высокой плоскопараллельности и качества поверхности:
• подгонка частоты кварцевых резонаторов ионно-лучевым травлением с точностью до 10–6 номинальной частоты.
Промышленное применение ИЛТ потребовало разработки и производства специального серийного оборудования [17]. Оборудование с источниками “Луч”, “Поток”, “Радикал” выпускалось на нескольких заводах. ПО “Кварц” (г. Калининград, бывший КМЗ) совместно с НИИВТ разработал более 15 типов установок и выпустил, начиная с 1970 года, более 2500 установок различного назначения [17, 32‑34] (рис. 9, а–в). 10 установок с источником “Радикал”, предназначенные для нанесения алмазоподобных пленок, поставлены в Корею (“Самсунг”). НИИВТ разработал и изготовил 20 образцов установок “Каштан” с источником ионов “Радикал‑М-250” для обработки пластин диаметром 150 мм (две установки поставлены в Милан) (рис. 9, г). Кроме того, в НИИВТ были разработаны две установки “Каштан-5” с источником ионов “Радикал‑М-350” для обработки пластин диаметром 250 мм. Завод “Токамак” (г. Петушки) с 1974 года выпустил более 3000 источников “Радикал” с блоком питания БП-94 для модернизации существующего парка вакуумного технологического оборудования. Отметим, что источники типа “Радикал” различной модификации выпускаются в настоящее время не только в России, но и за рубежом (США, Англия, Белоруссия). Разработанное оборудование работает на сотнях предприятий ВПК, а также в отраслевых и научно-исследовательских институтах.
Рис. 9.
Ионно-лучевое оборудование для производства изделий электронной техники: (а) установка УРМ3.279.029 с источником “Луч-1”; (б) цех производства фотошаблонов ЛОЭП "Светлана”, установки УРМЗ.279.035 (источник “Поток-1”) и установки УРМЗ.279.036 (источник “Луч-3”) [10]; (в) установка с совмещенными процессами реактивного ионно-лучевого травления (источник “Радикал”) и ионно-плазменного распыления четырех различных материалов (источник “Поток-4”) (УРМЗ.279.050) [17]; (г) установка “Каштан” с источником ионов “Радикал-М250” для обработки пластин диаметром 150 мм; (д) линия производства жестких магнитных дисков (США).

Подводя итоги развития ионно-лучевых технологий за период с середины 60-х гг. до середины 80-х гг., можно отметить, что впервые в мире созданы:
– метод и устройства для компенсации положительного объемного заряда внутри ускоряющего промежутка источника ионов размером порядка ларморовского радиуса электрона объемным зарядом электронов, удерживаемых в скрещенных электрическом и магнитном полях, что позволило повысить плотность отбираемого ионного тока в десятки раз сверх ограничений, накладываемых законом Чайльда–Ленгмюра;
– источники ионов с холодным катодом, использующие метод компенсации для формирования пучков ионов практически любых химически активных соединений, отличающиеся высокой интенсивностью пучков ионов, простотой конструкции, большой долговечностью и позволяющие проводить ионно-лучевую обработку изделий с площадью от долей квадратных сантиметров до нескольких квадратных метров;
– метод прецизионного селективного реактивного ионно-лучевого травления материалов направленными пучками ионов химически активных соединений, обеспечивающий разрешение минимальных размеров менее 0.1 мкм и избирательность более 15 : 1;
– методы очистки и активации поверхности подложек с последующим или одновременным нанесением пленок в едином вакуумном цикле.
На методы и источники получены 24 авторских свидетельства, 5 патентов России и 15 патентов США, Англии, Франции, Германии и других стран.
Развитие отечественной микроэлектроники в 70-е годы шло вровень с достижениями в США; в одних направлениях они были впереди, в других – опережали отечественные наука и техника. Это позволило начальнику Научно-технического управления Министерства электронной промышленности СССР В.М. Пролейко заявить, что в 70-е годы в области микроэлектроники мы шли “ноздря в ноздрю” с США, причем других зарубежных стран и близко не было.
С середины 80-х годов прошлого столетия развитие микроэлектроники в стране практически приостановилось. Ориентация на покупку за рубежом готовых микросхем, существенное снижение финансирования отраслевых предприятий МЭП привело к тому, что исследование и разработка новых технологических процессов и оборудования оказались невостребованными. В то же время за рубежом во многих странах началось бурное развитие микроэлектроники (США, Корея, Япония).
В 1997 году Ю.П. Маишев с группой сотрудников НИИВТ перешли в Физико-технологический институт РАН (директор В.А. Валиев) в лабораторию Л.В. Великова с целью продолжения исследований в области создания пучков ионов инертных и химически активных соединений и их применения в технологии микро- и наноэлектроники. В начале 2000 года на одной из фирм в США была внедрена технология очистки жестких магнитных дисков пучками ионов. Обработка непрерывно поступательно перемещающихся подложкодержателей размером 1 × 1 м с дисками, закрепленными с двух сторон, проводилась двумя ленточными источниками ионов с шириной пучка 1.2 м (рис. 9, д). Линия непрерывно работала 14 суток до проведения профилактических работ. Очистка пучком ионов дала следующие эффекты: повысился процент выхода годных дисков, улучшилось качество поверхности, повысилась коррозионная стойкость.
В 2004 году на базе этой группы была образована новая Лаборатория ионно-лучевых технологий (ИЛТ) в составе: Ю.П. Маишев, зав. лаб., В.П. Кудря, в.н.с., С.Л. Шевчук, с.н.с., Ю.П. Терентьев, с.н.с. и др. Основными направлениями исследований лаборатории являются [35]:
• разработка источников ионов с холодным катодом, скрещенными электрическим и магнитным полями и замкнутым дрейфом электронов, формирующих пучки ионов инертных газов и химически активных соединений;
• разработка на их основе источников пучков быстрых атомарных и молекулярных нейтральных частиц (БНЧ);
• разработка технологии ионно-лучевого травления для создания низковольтных автоэмиссионных катодов;
• разработка технологий нанесение диэлектрических (включая low-k) алмазоподобных пленок из пучков ионов и БНЧ;
• разработка технологий нанесения многослойных пленок методом ионно-лучевого распыления и их прецизионное травление;
• разработка диагностического комплекса для мониторинга пучков ионов и БНЧ.
Для реализации ионно-лучевых технологий разработан ряд источников ионов (рис. 10) [21, 22]. Основной физический принцип – формирование пучка ионов в скрещенных электрическом и магнитном полях внутри промежутка анод‑катод размером порядка одного ларморовского радиуса электронов. Наличие холодного катода позволяет формировать пучки ионов практически любых веществ: инертные газы, фтор- и хлорсодержащие соединения, углеводороды, кремнийсодержащие соединения и др.
Рис. 10.
(а) Источник ионов “Радикал” с ленточным пучком (длина пучка 100 мм, ток пучка на 1 см длины щели 7 мА, энергия ионов 150–1000 эВ); (б) многопучковый источник ионов “Радикал М-250” (диаметр пучка 250 мм, плотность тока 2.4 мА/см2, энергия ионов 100–600 эВ); (в) источник ионов “Холодок” для нанесения пленок распылением материала мишени расходящимся пучком ионов [22, 24].

Для обработки диэлектрических материалов и многослойных структур с диэлектрическими пленками (например, фоторезист/полупроводник) был предложен метод обработки пучками быстрых нейтральных частиц. Преимущества технологии нейтральных пучков [36]:
• сохраняются преимущества ионно-лучевых технологий;
• отсутствуют встроенные заряды в диэлектрических слоях;
• отсутствуют заряды на поверхности диэлектрических слоев;
• отсутствует облучение образцов ультрафиолетовым излучением при обработке.
Сравнение процессов травления диэлектриков пучками ионов и БНЧ приведено на рис. 11.
Рис. 11.
Сравнительный анализ воздействия на поверхность заряженных и нейтральных частиц. 1 – диэлектрик; 2 – подложка; 3 – проводник (металл); hν – УФ- или ВУФ-излучение плазмы.
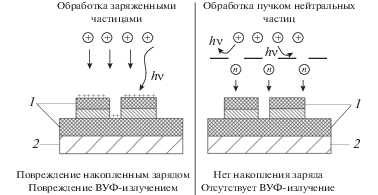
При разработке источников БНЧ в качестве источников ионов использовались разработанные нами источники с замкнутым дрейфом электронов типа “Радикал” с кольцевым или ленточным пучком. Ускоренные ионы нейтрализуются в результате резонансной перезарядки или поверхностной нейтрализации на стенках нейтрализатора (рис. 12).
Рис. 12.
Формирование пучка быстрых нейтральных частиц и характерное распределение давления в разрядном промежутке, зонах нейтрализации и сепарации пучка.
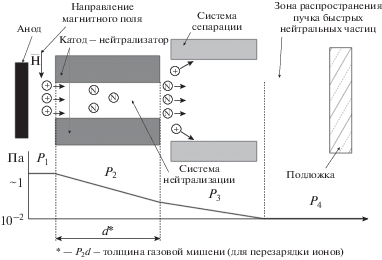
Источник быстрых нейтральных частиц (рис. 13, а) формирует пучки ионов инертных и химически активных газов (аргон, кислород, хладоны, углеводороды) со 100 процентной нейтрализацией пучка [37, 38]. Расходимость пучка БНЧ не превышает 5°, что позволяет транспортировать его на большие расстояния. Было показано, что положительный заряд в диэлектрических пленках при травлении пучком БНЧ на порядок меньше, чем при аналогичной обработке пучком ионов, при этом селективность травления различных материалов сохраняется и составляет величину порядка 10–15 (например, SiO2/Si в CF4 – 11, SiO2/W C3F8 – 16, SiO2/TiC C3F8 – 16) [39].
Рис. 13.
(а) Источник быстрых нейтральных частиц с ленточным пучком “Радикал 110-Л”; (б) модернизированная установка ионно-лучевой обработки “Каштан”; (в) установка ионно-лучевой обработки Laybold LAB 600SP.
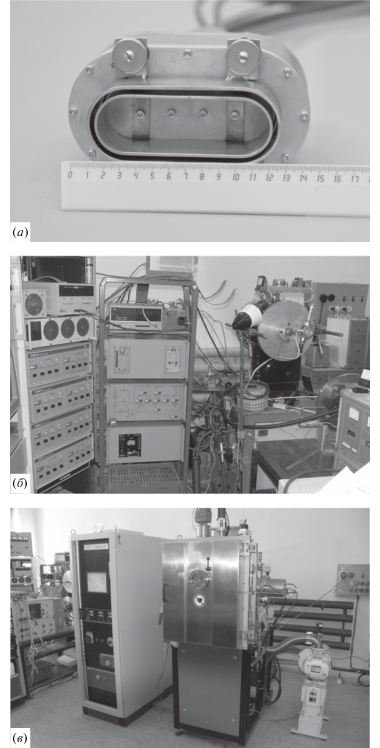
Исследование и разработка источников ионов и БНЧ проводилось на модернизированных базовых установках “Каштан” (рис. 13, б) и LAB-600 (рис. 13, в). Установки оснащались различными источниками ионов и БНЧ, а также диагностическим оборудованием для контроля за технологическим процессом.
Базовая установка “Каштан” с безмасляной откачкой (ТМН-1500) и ее модификации:
• многопучковый источник ионов с охлаждаемым вращающимся подложкодержателем ∅200 мм;
• многопучковый источник ионов с подложкодержателем, на который подается ВЧ напряжение [40, 41];
• ленточный источник ионов или БНЧ с подложкодержателем 100 × 100 мм и пьезодатчиком, совершающими возвратно-поступательное перемещение на расстояние 200 мм [42, 43];
• оснащение установки калориметрическим измерителем мощности пучков ионов и БНЧ, а также квадрупольным масс-спектрометром Extorr-200 [42];
• источник ионов с радиально-расходящимся пучком для равномерного нанесения пленок на неподвижные объекты распылением конусообразной мишени из различных материалов, включая диэлектрические [22, 44].
Базовая установка LAB 600 [45]:
• 6 подложек ∅100 мм совершают планетарное перемещение в зонах обработки;
• источники ионов или БНЧ “Радикал 110-Л” для очистки подложек и ассистирования процесса нанесения пленок и нанесения пленок распылением трех различных материалов, включая диэлектрические;
• диагностический комплекс для измерения параметров пучков ионов и БНЧ.
Ионно-лучевые технологии были применены для формирования полевых эмиссионных приборов вакуумной микроэлектроники (заказчик “НИИМЭ и завод “Микрон”). Используя различия в коэффициентах распыления материалов в зависимости от угла падения ионов (рис. 14) удалось получить кольцевой зазор между анодом и катодом 20 нм в пленке NbN (рис. 15, а). Были получены плотности тока в диодной матрице ~400 А/см2 при напряжении анод-катод ~2.5 В. На рис. 15, б представлен вакуумный микротриод. Следует отметить, что при полученных расстояниях анод–катод (~20 нм) электроны достигают поверхность анода без столкновений даже при атмосферном давлении, т.е. не требуется откачка прибора до высокого вакуума.
Рис. 14.
Последовательность технологических процессов создания массива автоэмиссионных катодов для вакуумной микро- и наноэлектроники: (а) нанесение слоя NbN; (б) распыление кромки структуры.

Рис. 15.
Экспериментальные результаты: (а) формирование 20 нм кольцевого зазора анод–катод в NbN; (б) вакуумный микротриод.
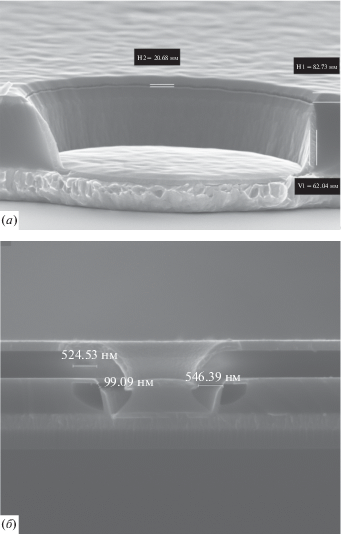
Другая конструкция автоэмиссионных приборов была разработана в НИИ точных приборов. В соответствии с конструкцией прибора травление пленок металлов проводилось через маски Al2O3 с субмикронными размерами элементов (~20 нм). Аспектное отношение составляло (50–100) : 1 [40].
В работе по формированию межпроводниковой изоляции с низким значением диэлектрической постоянной (для ОАО “НИИМЭ и завод “Микрон”) была разработана технология осаждения диэлектрических алмазоподобных пленок (АПП) из пучков ионов углеводородов. Были получены пленки с k ≤ 3 (low-k).
Использование алмазоподобных пленок, осаждаемых из пучков ионов, в медицине позволило создать впервые в России насос вспомогательного кровообращения, имплантируемый человеку [46]. Конструкция насоса была разработана ООО “Дона” и позднее модернизирована в АО ЗИТЦ (г. Зеленоград), а покрытие пленкой АПП осуществлялось во ФТИАНе источником ионов “Радикал М-250”.
На основе результатов трибологических и токсикологических испытаний создан узел трения ротора имплантируемого осевого насоса, гидравлическая машина и опора которого представлены на рис. 16. Кроме того, такое же покрытие наносилось на все поверхности насоса, соприкасающиеся с кровью. Насос весом около 200 г предназначен для имплантации (в кардиохирургии он еще называется имплантируемый искусственный левый желудочек). С 2012 г. в нескольких российский клиниках (ФНЦ трансплантологии и искусственных органов им. В.И. Шумакова, НИИ скорой помощи им. Н.В. Склифосовского, НИИ патологии кровообращения им. Е.Н. Мешалкина (г. Новосибирск), Омская областная клиническая больница) было проведено около 50 успешных операций имплантации насоса крови пациентам. Исследование деталей имплантируемого насоса после двух лет непрерывной работы (более 1010 оборотов) показало, что покрытие опор практически не изменилось, а тромбы отсутствуют [35].
Рис. 16.
Детали насоса вспомогательного кровообращения, покрытые углеродной алмазоподобной пленкой: (а) гидравлическая машина; (б) опора.

Таким образом, разработанный способ создания покрытий из алмазоподобного углерода на деталях сложной конструкции обеспечивает создание надежных и долговечных имплантируемых насосов крови, в которых практически полностью исключены износ материала опор и уменьшен риск тромбообразования.
Результаты применения в машиностроении алмазоподобных пленок, полученных с помощью источника ионов “Радикал М-250”:
• сверхскоростные турбины на воздушной подушке; испытания проводились в НПО “Криогенмаш” на образцах турбин на воздушной подушке со скоростью вращения 300 тыс. об./мин; с помощью источника ионов “Радикал М-250” осуществлялись технологические операции травления канавок специального профиля в торцевой части цилиндра и осаждения АПП на торцевую поверхность; в результате испытаний установлено, что трение контактирующих поверхностей при запуске и остановке турбины существенно уменьшилось;
• цилиндры гидравлических пар (курсоров); испытания проводились фирмой “Walvoil” (Италия) на нескольких десятках курсоров, изготавливаемых для фирмы “General Motors”; установлено, что ресурс курсоров увеличился более чем в 5 раз (100 000 циклов работы вместо 20000 циклов для курсоров без АПП) при сохранении диаметра и шероховатости исходного образца, составляющей 0.11–0.13 мкм;
• штампы для пробивания отверстий в игольных ушках; испытания проводились на Колюбакинском игольном заводе на прессах типа “Бюндгенс”, развивающих силу удара 7–10 тонн с частотой 200 ударов в минуту; установлено, что срок службы формовочных штампов увеличился в 2.5 раза, а соприкасающиеся поверхности при штамповке не залипают, в отличие от штампов, покрытых нитридом титана;
• резцы для скоростной обработки металла; испытания проводились фирмой “Ion Beam Europe” (Италия); в результате испытаний установлено, что ресурс резцов увеличился более чем в 20 раз;
• лезвия безопасных бритв; в результате испытаний, проведенных на Игольно-платинном заводе им. КИМ, установлено снижение коэффициента трения по сравнению с нитридом хрома более чем в 1.5 раза.
ЗАКЛЮЧЕНИЕ
Исследования и разработка источников ионов и ионно-лучевых технологий показали:
− ИЛТ широко используются в производстве и исследованиях на сотнях предприятий и научно-исследовательских институтах (микро- и наноэлектроника, оптика, пьезотехника, машиностроение, медицина и др.);
− применение ИЛТ позволяет увеличить выход годных приборов, улучшить их качество, либо создавать приборы с параметрами недостижимыми другими методами (элементы безаберрационной дифракционной оптики, дифракционные решетки, включая асимметричные дифракционные решетки, пьезокварцевые резонаторы максимальной частоты, автоэмиссионные катоды и др.);
− источники быстрых нейтральных частиц существенно расширяют возможности ИЛТ, особенно при обработке диэлектрических материалов или сложных слоистых структур;
− требуются дальнейшие теоретические и экспериментальные исследования источников ионов и нейтральных частиц в части оптимизации ионно-оптической системы и выбора материалов и конфигурации канала нейтрализации.
В заключении следует отметить, что создание ионно-лучевых технологий и разработка новых источников ионов, специально предназначенных для технологических процессов стали возможными благодаря фундаментальным научным исследованиям, выполненным в 60-е годы в нашей стране при создании мощных источников ионов для различных областей науки и техники. Именно опора на отечественные разработки, а не копирование зарубежных образцов, позволило в кратчайшие сроки создать оригинальные источники ионов и технологические процессы, опережающие мировой уровень, а также разработать десятки образцов оборудования для ИЛТ и организовать их серийное производство.
По прошествии десятилетий созданные источники ионов и ИЛТ продолжают широко использовать у нас в стране и за рубежом. В настоящее время в Физико-технологическом институте им. К.А. Валиева Российской академии наук на основе этих разработок создается новый класс устройств – источники быстрых нейтральных частиц (БНЧ), уровень которых должен не уступать зарубежным образцам.
Работа выполнена в рамках Государственного задания Министерства науки и высшего образования РФ.
Список литературы
Блейвас И.М., Ковальский Г.А., Маишев Ю.П. Устройство для создания ленточного ионного пучка // Авторское свидетельство СССР. № 307439 от 6.04.67.
Ковальский Г.А., Маишев Ю.П. Ионный источник // Авторское свидетельство СССР. № 240883 от 2.02.68.
Ковальский Г.А., Маишев Ю.П., Дмитриев Ю.А. Ионный источник // Авторское свидетельство СССР. № 291602 от 26.06.69.
Маишев Ю.П., Дмитриев Ю.А. Разработка источников моноэнергетических ионов повышенной интенсивности // Тезисы докладов и рекомендаций научно-технических конференций. Сер. 3. Микроэлектроника. 1977. Вып. 3.
Ковальский Г.А., Маишев Ю.П., Дмитриев Ю.А. Ионный источник // Патент США № 4.122.347. Опубликован 24.10.78.
Маишев Ю.П. Источники интенсивных ионных пучков с компенсацией положительного пространственного заряда внутри ускоряющего промежутка // Приборы и техника эксперимента. 1980. № 1. С. 183.
Ковальский Г.А., Маишев Ю.П., Егоров Б.А., Дмитриев Ю.А. Устройство для ионно-плазменного распыления металлов // Авторское свидетельство СССР. № 359976 от 26.03.70.
Маишев Ю.П., Егоров Б.А., Дмитриев Ю.А., Петров В.И. Ионно-плазменные устройства, их совершенствование и применение в микроэлектронике // Тезисы докладов и рекомендаций научно-технических конференций. Сер. 3 Микроэлектроника. 1977. Вып. 3. С. 20.
Ковальский Г.А., Маишев Ю.П., Егоров Б.А., Дмитриев Ю.А. Устройство для ионно-плазменного распыления // Патент США. № 4175029. Опубликован 20.11.79.
Егоров Б.А., Зубрицкий В.П., Ивановский Г.Ф., Маишев Ю.П., Минаков В.И., Прямицина З.А., Тыркова Г.Д. Опыт производства полупрозрачных фотошаблонов // Электронная промышленность. 1975. № 6. С. 56.
Ивановский Г.Ф., Маишев Ю.П., Иванов В.В., Алексеев В.В. Способ избирательного удаления диэлектрических пленок // Авторское свидетельство СССР. № 494999 от 10.01.74.
Алексеев В.В., Маишев Ю.П., Ивановский Г.Ф. Исследование метода ионно-химического травления // Тезисы докладов и рекомендаций научно-технических конференций. Сер. 3 Микроэлектроника. 1977. Вып. 4. С. 14.
Ивановский Г.Ф., Маишев Ю.П., Митрофанов Е.А. Способ реактивного ионно-лучевого травления // Авторское свидетельство СССР. № 1326116 от 27.03.85.
Лобов И.Е., Бутырин Н.П., Толстых В.А., Хорошков Ю.В., Булгаков С.С., Ивановский Г.Ф., Маишев Ю.П. Ионно-химическая технология в производстве СВЧ мощных транзисторов // Тезисы докладов II-й межотраслевой научно-технической конференции “Тонкие пленки в интегральных схемах и ионные методы создания пленочных структур”. Киев. 1976.
Маишев Ю.П., Алексеев В.В., Ивановский Г.Ф., Дмитриев Ю.А., Гендель Е.С., Егоров Б.А., Васильев А.Ф. Источник ионов // Авторское свидетельство СССР. № 543305 от 11.06.75.
Маишев Ю.П. Источники ионов для реактивного ионно-лучевого травления и нанесения пленок // Электронная промышленность. 1990. № 5. С. 15.
Маишев Ю.П. Источники ионов и ионно-лучевое оборудование для нанесения и травления материалов // Вакуумная техника и технология. 1992. Т. 2. № 4. С. 53.
Маишев Ю.П., Алексеев В.В., Ивановский Г.Ф., Жуков Е.А., Дмитриев Ю.А., Егоров Б.А., Гендель Е.С., Терентьев Ю.П. Источник ионов // Авторское свидетельство СССР. № 719371 от 11.12.75.
Маишев Ю.П. Ионно-химические источники и процессы в производстве ИС // Тонкие пленки в производстве полупроводниковых приборов и интегральных схем. Материалы межотраслевых научно-технических конференций, совещаний, семинаров и выставок. ВИМИ. 1982. С. 12.
Маишев Ю.П. Источники ионов с холодным катодом для ионно-лучевого травления и нанесения пленок // Электронная техника. Сер. 7 Технология, организация производства и оборудование. 1984. Вып. 4.
Маишев Ю.П., Терентьев Ю.П., Шевчук С.Л. Источники ионов и ионно-лучевые технологии нанесения и травления пленочных структур для микро- и наноэлектроники. Ч. 1. Интеграл. 2009. № 5. С. 10.
Маишев Ю.П., Терентьев Ю.П., Шевчук С.Л. Источники ионов и ионно-лучевые технологии нанесения и травления пленочных структур для микро- и наноэлектроники. Ч. 2. Интеграл. 2009. № 6. С. 18.
Маишев Ю.П., Парфененок М.А., Терентьев Ю.П. Источник ионов для реактивного ионно-лучевого травления и нанесения пленок // Патент РФ RU2030807C1 от 20.02.1992.
Maishev Yu., Ritter J., Terentyev Yu., Velikov L. Cold-cathode ion source with propagation of ions in the electron drift plane // United States Patent № 6.130.507 oт 10.10.2000.
Васильев А.Ф., Дмитриев Ю.А., Ивановский Г.Ф., Маишев Ю.П., Мурашко В.А. Многоканальный источник ионов // Авторское свидетельство. № s865043 от 12.05.80.
Маишев Ю.П. Исследование многоканальных источников ионов инертных и химически активных газов // МРС ВИМИ Техника, технология, экономика. Сер. Т. 1984. № 10.
Маишев Ю.П. Установка реактивного ионно-лучевого травления с многоканальным источником ионов “Радикал М-450” // МРС ВИМИ Техника, технология, экономика. Сер. ЭР. 1984. № 16.
Маишев Ю.П., Жуков Е.А., Ивановский Г.Ф., Дмитриев Ю.А., Микулин А.И. Интенсивный источник ионов типа “Радиан” для ионно-химического травления // Тезисы докладов третьей отраслевой научно-технической конференции “Тонкие пленки в производстве полупроводниковых приборов и интегральных схем”. Воронеж. 1989. С. 4.
Маишев Ю.П., Митрофанов Е.А. Формирование углеродных алмазоподобных, SiC, а также SixOyNz пленок из пучков ионов и исследование их свойств // Научно-технический сборник “Ученые – 850-летию Москвы. Высокие электронные технологии в народном хозяйстве”. М. 1997.
Enisherlova K.L., Kontsevoi Yu.A., Chervyakova E.N., Mitrofanov E.A., Maishev Yu.P. Investigations of diamond-like carbon films produced directly from an ion beam of industrial ion source with a cold cathode // Materials Science and Engineering B. 1997. V. 46. P. 137.
Валиев К.А., Великов Л.В., Маишев Ю.П., Митрофанов Е.А., Терентьев Ю.П. Исследование алмазоподобных углеродных пленок, осажденных непосредственно из пучков ионов // Труды ФТИАН. 1999. Т. 15. С. 27.
Дмитриев Ю.А., Егоров Б.А., Желтов М.П., Ивановский Г.Ф., Маишев Ю.П., Терентьев Ю.П., Чуранов Т.Г. Установки для ионно-плазменного нанесения и ионного травления металлических и диэлектрических слоев // Электронная промышленность. 1974. № 2Т. С. 44.
Терентьев Ю.П., Маишев Ю.П., Ивановский Г.Ф., Коробов В.Г., Дмитриев Ю.А., Егоров Б.А. Промышленные установки для ионно-плазменного нанесения и ионного травления металлических, полупроводниковых и диэлектрических пленок // Тезисы докладов и рекомендаций научно-технических конференций. Сер. 3 Микроэлектроника. 1975. Вып. 2. С. 21.
Терентьев Ю.П., Желтов М.П., Маишев Ю.П., Ивановский Г.Ф., Коробов В.Г. Серийное и разрабатываемое в десятой пятилетке оборудование для нанесения и обработки тонких пленок // Тезисы докладов и рекомендаций научно-технических конференций. Сер. 3 Микроэлектроника. 1977. Вып. 2. С. 35.
Маишев Ю.П. Развитие ионно-лучевых технология в Физико-технологическом институте РАН // История науки и техники. 2018. № 8. С. 37.
Кудря В.П., Маишев Ю.П. Применение технологии пучков быстрых нейтральных частиц в микро- и наноэлектронике // Микроэлектроника. 2018. Т. 47. С. 51.
Маишев Ю.П., Шевчук С.Л., Терентьев Ю.П., Кудря В.П. Источник быстрых нейтральных частиц // Патент на изобретение № 2395133. Зарегистрирован 20 июля 2010 г.
Маишев Ю.П., Шевчук С.Л., Терентьев Ю.П., Кудря В.П. Источник быстрых нейтральных частиц // Патент на изобретение RU № 2468465 C2. Зарегистрирован 27 ноября 2012 г.
Маишев Ю.П., Шевчук С.Л., Кудря В.П. Исследование селективности травления различных материалов пучками быстрых нейтральных частиц // Микроэлектроника. 2014. Т. 43. С. 415.
Маишев Ю.П., Терентьев Ю.П., Шевчук С.Л., Татаренко Н.И., Голиков В.А. Установка прецизионного реактивного ионно-лучевого травления наноструктур для автоэмиссионных приборов // Микроэлектроника. 2010. Т. 39. С. 253.
Маишев Ю.П., Шевчук С.Л., Терентьев Ю.П. Способ ионно-лучевой обработки // Патент на изобретение RU № 2433081 С1. Зарегистрирован 10 ноября 2011 г.
Маишев Ю.П., Шевчук С.Л., Терентьев Ю.П. Установка для травления и осаждения тонкопленочных структур с помощью пучков быстрых нейтральных частиц // Микроэлектроника. 2015. Т. 44. С. 346.
Маишев Ю.П., Шевчук С.Л., Кудря В.П. Экспериментальное исследование плотности потока пучка быстрых нейтральных частиц методом кварцевого микровзвешивания // Прикладная физика. 2018. № 2. С. 86.
Маишев Ю.П., Терентьев Ю.П., Кирьянов А.П., Кошкин В.В. Однородность толщины пленок, осаждаемых на неподвижные подложки большой площади с помощью источника ионов, формирующего направленный радиально расходящийся пучок // Труды ФТИАН. 2008. Т. 19. С. 60.
Маишев Ю.П., Шевчук С.Л., Кудря В.П. Формирование сверхтонких сплошных пленок методом ионно-лучевой обработки // Прикладная физика. 2018. № 4. С. 79.
Маишев Ю.П., Кудря В.П., Шевчук С.Л., Терентьев Ю.П., Мальгичев В.А. Осаждение пленок алмазоподобного углерода на рабочие поверхности имплантируемого насоса крови // Материалы X Международной научно-технической конференции “Вакуумная техника, материалы и технология”. 2015. С. 151.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника


